倒装芯片工艺是指通过在芯片的I/0 焊盘上直接沉积,或者通过 RDL 布线后沉积凸块(包括锡铅球、无铅锡球、铜桂凸点及金凸点等),然后将芯片翻转,进行加热,使熔融的焊料与基板或框架相结合,将芯片的 I/0 扇出成所需求的封装过程。倒装芯片封装产品示意图如图所示。
2023-04-28 09:51:34 3701
3701 
从事半导体行业,尤其是半导体封装行业的人,总绕不开几种封装工艺,那就是芯片粘接、引线键合、倒装连接技术。
2023-07-21 10:08:08 3128
3128 
芯片封装作为设计和制造电子产品开发过程中的关键技术之一日益受到半导体行业的关注和重视。本片讲述了芯片封装及底部填充(Underfill)技术。
2023-12-19 15:56:04 3189
3189 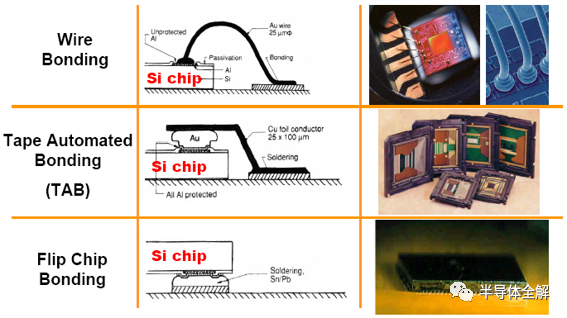
SMT工艺介绍 SMT工艺名词术语 1、表面贴装组件(SMA)(surface mount assemblys) 采用表面贴装技术完成装联的印制板组装件。2、 回流焊(reflow
2016-05-24 14:33:05
<br/>? 九. 检验工艺<br/>? 十. SMT生产中的静电防护技术<br/><
2008-09-12 12:43:03
SMT定义及技术简介什么是SMT: SMT就是表面组装技术(SurfaceMountedTechnology的缩写),是目前电子组装行业里最流行的一种技术和工艺。 SMT有何特点
2010-03-09 16:20:06
带来了一定的困难,这已成为当前研究下填充技术的两个重要方向。除上述的下填充技术以外,芯片上“重新布线层”的制备以及与现有SMT设备的兼容问题是影响FC推广应用的两个关键。3焊料凸点倒装芯片工艺典型的焊料
2018-11-26 16:13:59
); (6)下填充。 4.倒装芯片焊接的关键技术 芯片上制作凸点和芯片倒装焊工艺是推广倒装芯片焊接的技术关键。 (1)凸点制作 凸点制作工艺很多,如蒸发/溅射法、焊膏印刷-回流法、化镀法、电镀法
2020-07-06 17:53:32
的5倍;4、没有SMT工艺,没有虚焊隐患,产品可靠性更强;5、散热能力更快,热量直接通过PCB板散出,没有堆积;说起倒装cob,肯定也会有正装COB,正装和倒装相比,可以简单理解为倒装技术可以实现更小
2020-05-28 17:33:22
仪( SEM/EDX),检查焊点的微观结构,譬如,微裂纹/微孔、锡结晶、金属间化合物(IMC)、焊接及润湿情况,底部 填充是否有空洞和裂纹,分层和流动是否完整等。 完成回流焊接及底部填充工艺后的产品
2018-09-06 16:40:06
“毛 细管效应”进行底部填充的工艺分为以下几个步骤: ·基板预热; ·分配填料(点胶): ·毛细流动; ·加热使填料固化。 为什么倒装晶片焊接完后都需要进行底部填充呢?我们来看焊接完成之后组件
2018-09-06 16:40:41
为1~27 mm; ④组装在基板后需要做底部填充。 其实倒装晶片之所以被称为“倒装”是相对于传统的金属线键合连接方式(WireBonding)与植球后的工艺而言 的。传统的通过金属线键合与基板连接
2018-11-22 11:01:58
完成后,需要在元件底部和基板之间填充一种胶(一般为 环氧树脂材料)。底部填充分为基于“毛细流动原理”的流动性和非流动性(No-follow)底部填充。 上述倒装晶片组装工艺是针对C4元件(元件焊凸材料为
2018-11-23 16:00:22
助焊剂工艺在倒装晶片装配工艺中非常重要。助焊剂不仅要在焊接过程中提供其化学性能以驱除氧化物和油污 ,润湿焊接面,提高可焊性,同时需要起到黏接剂的作用。在元件贴装过程中和回流焊接之前黏住元件,使其
2018-11-23 15:44:25
/O引出端分布于整个芯片表面,故在封装密度和处理速度上Flip chip已达到顶峰,特别是它可以采用类似SMT技术的手段来加工,因此是芯片封装技术及高密度安装的最终方向。 倒装片连接有三种主要类型C4
2018-09-11 15:20:04
、PCB及元器件的设计、工艺的控制和优化等方面提供参考。 为了提高产品的可靠性,可以考虑进行底部填充工艺。对于两层堆叠,可以对上层元件进行底部填充,也可以两层元件都进行填充。如果上下层元件外形尺寸一样
2018-09-06 16:24:30
助焊剂或锡膏,如果需要底部填充工艺 的话,必须考虑助焊剂/锡膏与阻焊膜及底部填充材料的兼容性问题。 顶部元件浸蘸助焊剂还是锡膏,会有不同的考虑。锡膏装配的优点是:①可以一定程度地补偿元件及基板 的翘
2018-09-06 16:24:34
目前有两种典型的工艺流程,一种是考虑与其他元件的SMT配,首先是锡膏印刷,然后贴装CSP,回流焊接,最后如果要求底部填充,还需进行底部填充工艺,如图1所示。为了避免“桥连”或“少锡”缺陷,在组装
2018-09-06 16:24:04
的是底部填充方法——局部填充,可以应用在CSP或BGA的装配中。局部填充是将底部填充材料以 点胶或印刷的方式沉积在基板上位于元件的4个角落处或四周(如图2和图3所示)。相比毛细流动或非流动 性底部填充
2018-09-06 16:40:03
的热硬化黏胶、第二个方法使用导电黏胶和绝缘的底部填充胶。每一个测试组件都由测试电路载板和仿真芯片(dummychip)所组成。管脚阵列封装的载板也被设计在同一片聚亚酰胺载板上,以便于未来用于测试神经讯号
2018-09-11 16:05:39
多数返修工艺的开发都会考虑尽量减少对操作员的依赖以提高可靠性。但是对经过底部填充的CSP的移除 ,仅仅用真空吸嘴不能将元件移除。经过加热软化的底部填充材料对元件具有黏着力,此力远大于熔融的焊 料
2018-09-06 16:40:01
随着新型基底材料的出现,倒装芯片技术面临着新的挑战,工程师们必须解决裸片
2006-04-16 21:05:16 2035
2035 倒装芯片工艺挑战SMT组装原作者:不详 1
2006-04-16 21:37:59 1467
1467 倒装芯片的成功实现与使用包含诸多设计、工艺、设备与材料因素。只有对每一个因素都加以认真考虑和对待才能够促进工艺和技术的不断完善和进步,才能满足应用领域对倒装芯片技
2011-07-05 11:56:17 1673
1673 过来,故称其为倒装晶片。 倒装芯片的实质是在传统工艺的基础上,将芯片的发光区与电极区不设计在同一个平面这时则由电极区面朝向灯杯底部进行贴装,可以省掉焊线这一工序,但是对固晶这段工艺的精度要求较高,一般很难达到较高的良率。 倒装晶片
2017-10-24 10:12:25 8
8 在手机的实际制造过程中,往往会加入BGA底部填充胶工艺,这是为了防止在运输及日常使用中造成BGA芯片焊点开裂甚至损坏,但是这也制约了芯片元件维修的进度,容易因加热正面造成反面元件空焊,引起新的不良
2018-10-29 08:37:00 5483
5483 倒装芯片技术分多种工艺方法,每一种都有许多变化和不同应用。举例来说,根据产品技术所要求的印制板或基板的类型 - 有机的、陶瓷的或柔性的- 决定了组装材料的选择(如凸点类型、焊料、底部填充材料),并在
2019-05-31 10:16:45 5985
5985 
正装小芯片采取在直插式支架反射杯内点上绝缘导热胶来固定芯片,而倒装芯片多采用导热系数更高的银胶或共晶的工艺与支架基座相连,且本身支架基座通常为导热系数较高的铜材.
2019-10-22 14:28:34 27507
27507 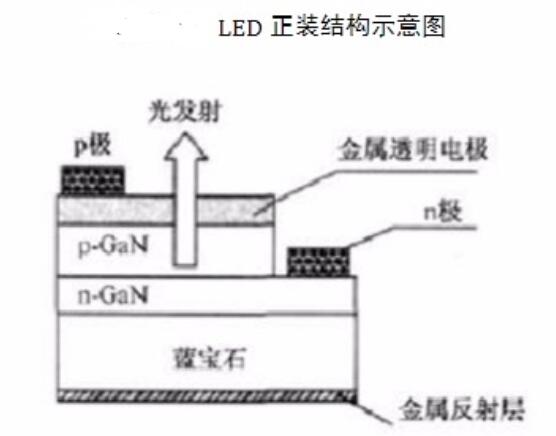
填充点胶加工具有如下优点: PCB板芯片底部填充点胶加工主要用于PCB板的CSP/BGA的底部填充,点胶工艺操作性好,点胶加工后易维修,抗冲击性能,抗跌落性能,抗振性能都比较好,在一定程度上提高了电子产品的稳定性与可靠性。 PCB板芯片底部填充点胶加工
2020-07-28 10:14:50 6716
6716 倒装芯片FC、晶圆级CSP、晶圆级封装WLP主要应用在新一代手机、DVD、PDA、模块等。 一、倒装芯片FC 倒装芯片定义为可能不进行再分布的晶圆。通常,锡球小于150um,球间距小于350um
2020-09-28 14:31:30 5721
5721 随着电子设备更小、更薄、功能更集成的发展趋势,半导体芯片封装的技术发展起到越来越关键的作用,而谈到高性能半导体封装,小编觉得很多smt贴片厂商想到的就是引线键合技术。 的确如此。不久之前,大多数
2021-03-30 16:14:07 3913
3913 什么是底部填充胶?底部填充胶简单来说就是底部填充用的胶水,主要是以主要成份为环氧树脂的胶水对BGA 封装模式的芯片进行底部填充,利用加热的固化形式,将BGA芯片底部空隙大面积 (一般覆盖80%以上)填满,从而达到加固芯片的目的,进而增强芯片和PCBA 之间的抗跌落性能。
2021-07-19 09:30:50 7986
7986 气泡一般是因为水蒸汽而导致,水蒸气产生的原因有SMT(电子电路表面组装技术)数小时后会有水蒸气附在PCB板(印制电路板)上,或胶粘剂没有充分回温也有可能造成此现象。常见的解决方法是将电路板加热到一定温度,让电路板预热后再采用三轴点胶机进行底部填充点胶加工;以及使用胶粘剂之前将胶粘剂充分回温。
2021-07-20 16:08:52 3366
3366 Flip-Chip BGA (FC-BGA)是指将芯片利用倒装(FC)技术焊接在线路基板上,并制成倒装芯片 BGA 封装形式。
2023-04-28 15:09:13 4514
4514 
基本的倒装芯片工艺在电路制造之后开始,此时在芯片表面创建金属焊盘以连接到 I/O。接下来是晶圆凸块,将焊球沉积在每个焊盘上。然后晶圆被切割,这些芯片被翻转和定位,使焊球与基板焊盘对齐。然后焊球被熔化/回流,通常使用热空气,并且安装的芯片底部填充有电绝缘粘合剂,通常使用毛细管作用。
2023-05-22 16:13:55 650
650 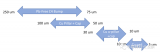
摘要:通过对导热绝缘胶本征性能、组成配方、印制板组件实际空间位置关系和主要球栅阵列(BGA)器件封装结构的特点进行分析,设计制作工艺试验件,进行了导热绝缘胶填充模型理论研究,探究了黏度、预热温度
2022-10-25 09:58:49 620
620 
手机电池保护板MOS管用底部填充胶和表面覆盖方案由汉思新材料提供1、点胶示意图2、应用场景某米手机、电池3、用胶需求手机电池保护板MOS管底部填充和表面覆盖方案MOS管左边有测试点,右边有二维码
2022-11-17 14:36:31 556
556 
平板电脑主板芯片BGA锡球底部填充加固用胶方案由汉思新材料提供01.点胶示意图02.应用场景平板电脑03.用胶需求主芯片BGA锡球底部填充加固04.客户难点终端客户使用3-6个月反馈有15%的功能
2022-11-25 16:43:53 628
628 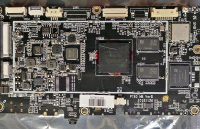
军工产品PCB板芯片元器件围坝填充加固防振用底部填充胶方案由汉思新材料提供客户是一家主要电路板的生产,电子产品表面组装技术加工、组装,电子电器产品、新能源产品、汽车材料及零件。主要应用于军工产品
2023-02-16 05:00:00 634
634 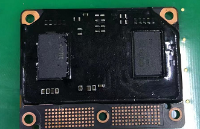
汉思新材料芯片封装胶underfill底部填充胶点胶工艺基本操作流程一、烘烤烘烤,主要是为了确保主板的干燥。实施底部填充胶之前,如果主板不干燥,容易在容易在填充后有小气泡产生,在最后的固化环节,气泡
2023-02-15 05:00:00 1335
1335 
智能家居智能门锁芯片底部填充胶和外壳结构粘接方案由汉思新材料提供01.点胶示意图02.应用场景智能门锁/儿童早教机器人/语音精灵03.用胶需求芯片底部填充和外壳结构粘接方案要求芯片填充(锡球的填充
2023-02-24 05:00:00 533
533 
汉思新材料研发生产半导体(Flipchip)倒装芯片封装用底部填充材料为了解决一些与更薄的倒装芯片封装相关的问题,汉思化学研发了一种底部填充材料,作用在于通过控制芯片和基板的翘曲来降低封装产品的应力
2023-03-01 05:00:00 536
536 
、CSP、Flipchip(倒装芯片)封装、QFP封装、QFN封装得到快速应用,封装工艺要求越来越高,底部填充胶的作用越来越重要。底部填充胶是一种单组份环氧树脂密
2023-03-10 16:10:57 466
466 
音视频设备控制板BGA芯片底部填充胶汉思底填胶应用
2023-03-13 17:32:00 439
439 
WIFI模组控制板BGA芯片底部填充胶应用由汉思化学提供客户是一家专业从事射频通讯模组、无线互联网系列模组应用的方案及产品解决方案的高新技术企业,产品有WIFI模组、GPS模组、蓝牙模组
2023-03-14 05:00:00 608
608 
平板电脑触控笔BGA芯片底部填充胶应用由汉思新材料提供客户是生产电子设备、通信数据设备、通信产品、网络通信设备、终端设备的厂家。其中终端设备用到我公司的底部填充胶水。客户产品为平板电脑的触控笔
2023-03-15 05:00:00 376
376 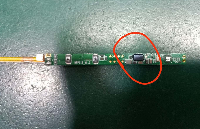
嵌入式模块板卡BGA芯片胶底部填充胶应用由汉思新材料提供客户产品为嵌入式模块板卡客户产品用胶点:嵌入式模块板卡两个BGA芯片要点胶加固。BGA芯片尺寸为:1.14*14mm、锡球289个,2.14
2023-03-16 05:00:00 512
512 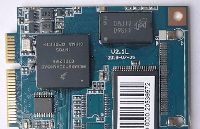
电脑优(u)盘SD卡BGA底部填充胶应用由汉思新材料提供客户产品:电脑优盘SD卡用胶部位:3个用胶点(1、BGA底部填充2、晶元包封保护3、金线包封保护)芯片大小:参考图片目的:粘接、固定施胶工艺
2023-03-22 05:30:00 471
471 
台式电脑显卡PCB上BGA芯片底部填充胶点胶应用由汉思新材料提供客户产品:台式电脑显卡用胶部位:显卡PCB电路板上BGA底部填充加固锡球数量:200左右锡球间距:0.35~0.45锡球高度:0.45
2023-03-28 15:20:45 740
740 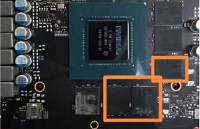
BGA芯片底部填充胶点胶工艺标准和选择与评估由汉思新材料提供由于BGA芯片存在因应力集中而出现的可靠性质量隐患问题,为了使BGA封装具备更高的机械可靠性,需对BGA进行底部填充,而正确选择底部填充
2023-04-04 05:00:00 1847
1847 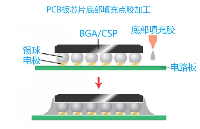
胶,对手机电池保护板芯片底部填充及封装,提高手机电池芯片系统稳定性和可靠性。对手机电池保护板芯片底部填充及封装,汉思新材料的低粘度的底部填充胶,可靠性高、流动性大、快
2023-04-06 16:42:16 785
785 
智能手势化妆镜手势识别模组芯片底部填充胶应用案例由汉思新材料提供客户是一家芯片设计方案公司,专注研发芯片十余年,拥有国内一流的专业技术团队,为客户提供优质的产品和解决方案.目前产品涵盖:Sensor
2023-04-07 05:00:00 468
468 
音响控制板BGA芯片加固保护用胶底部填充胶应用由汉思新材料提供客户是网络产品生产商.重点为客户提供OEM/ODM服务给各类客户定制与公板近100款,部分产品已经在WIFI音箱/商业WIFI/探针
2023-04-11 05:00:00 473
473 
蓝牙模组BGA芯片底部填充胶应用由汉思新材料提供客户是专注于物联网产品及服务,提供从模块,设备,APP开发,云乃至大数据分析的整体解决方案及产品服务主要产品有蓝牙模组,智能家居,智能硬件。其中蓝牙
2023-04-12 16:30:33 369
369 
电子元件的很多问题,比如BGA、芯片不稳定,质量不老牢固等,这也是underfill底部填充工艺受到广泛应用的原因之一。BGA和CSP是通过锡球固定在线路板上,存在热
2023-04-14 15:04:16 1145
1145 
平板电脑主板CPUBGA芯片底部填充胶应用由汉思新材料提供客户是一家方案公司,专注于数字音视频、移动互联产品的研究和开发主要产品有平板电脑,广告机等。其中平板电脑用到我公司的底部填充胶产品.客户产品
2023-04-18 05:00:00 484
484 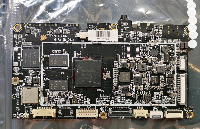
传感器控制板BGA芯片防止脱焊用底部填充胶应用案例由汉思新材料提供客户产品为:传感器控制板用胶部位:传感器控制板上面有个BGA芯片需要点胶芯片尺寸:25*25mm需要解决的问题:使用过程中
2023-04-19 15:26:25 483
483 
手机SIM卡和银行卡芯片封装和bga底部填充胶方案由汉思新材料提供涉及部件:手机SIM卡和银行卡的CSP芯片封装和周边焊点保护工艺难点:客户目前出现的问题在做三轮实验时出现胶裂,在点胶时还有个难题
2023-04-25 09:33:08 946
946 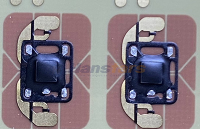
底部填充胶低粘度,流动性好,将胶水填充到芯片底部,确保芯片与PCB板粘接牢固,超声波熔接后不良率为0,且超声波熔接40次以上功能测试仍OK,远超出客户需求。
2023-04-25 16:44:32 517
517 
LED显示屏用底部填充胶应用案例分析由汉思新材料提供客户这个项目是:户外大型的LED显示屏项目用胶部位:单颗的LED灯珠之间的缝隙需要填充客户项目是LED灯面点胶,具体要求如下:1.针头
2023-05-08 16:22:45 713
713 
移动U盘主板bga芯片底部填充胶应用由汉思新材料提供客户生产产品:移动U盘用胶部位:移动U盘主板芯片,需要点胶填充加固。BGA芯片尺寸:2个芯片:13*13*1.2mm,152个锡球需要
2023-05-09 16:23:12 525
525 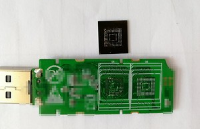
行车记录仪主板芯片加固补强用底部填充胶由汉思新材料提供客户生产产品:行车记录仪主板。客户产品用胶点:行车记录仪主板上的BGA加固补强。目前客户板上有4个IC需要加固。具体尺寸客户待确认。换胶原
2023-05-15 14:45:20 630
630 
触摸屏控制板BGA芯片底部填充胶应用由汉思新材料提供我公司工程人员有过去客户拜访,现场确认客户产品及用胶需求如下:客户产品是:开发一款触摸屏电子控制板.客户产品用胶部位:PCB板上面的BGA芯片需要
2023-05-16 05:00:00 480
480 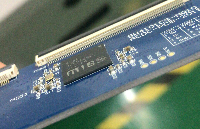
工业计算机电脑主板CPU,BGA芯片底部填充胶应用由汉思新材料提供经过联系客户技术工程人员和研究其提供相关参数。了解到以下信息。客户产品是:工业计算机电脑主板胶水使用部位:cpu/BGA填充对胶水
2023-05-17 05:00:00 611
611 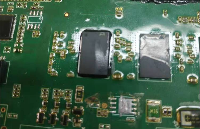
解决的问题是:摄像头感光芯片底部填充加固,起到防震动的作用和摄像头螺纹M12定焦固定.芯片尺寸:8*12mm锡球间距:0.35锡球球径:0.5施胶工艺:半自动点胶固化方式:
2023-05-17 16:56:42 464
464 
光电传感器WL-CSP封装芯片底部填充胶应用由汉思新材料提供光电传感器芯片(CCD)经过联系客户工程技术和研究其提供的封装工艺流程。了解到以下信息。客户用胶项目是:光电传感器芯片(CCD
2023-05-18 05:00:00 546
546 
压力传感器BGA芯片底部填充胶应用由汉思新材料提供通过和客户工程人员沟通了解到;客户产品是:压力传感器使用部位:BGA芯片底部填充粘接材质:玻纤PCB板芯片尺寸:2*2mm锡球球径:140微米
2023-05-19 16:18:13 394
394 
汉思HS700系列underfill胶水芯片底部填充胶是专为手机、数码相机以及手提电脑等数码产品而研发生产的,用于这些数码产品内部芯片的底部填充。那么为什么这些产品需要用到underfill底部填充
2023-05-24 10:25:04 548
548 
电力设备电源控制板BGA芯片底部填充胶应用由汉思新材料提供客户产品是电力设备电源控制板需求原因:新产品开发.用胶部位:FPC与BGA底部填充施胶用途:填充胶保护BGA芯片胶水颜色:黑施胶工艺:半自动
2023-05-25 09:16:27 349
349 
LED蓝灯倒装芯片底部填充胶应用由汉思新材料提供客户的产品是LED蓝灯倒装芯片。芯片参数:没有锡球,大小35um--55um不等有很多个,芯片厚度115um.客户用胶点:需要芯片四周填充加固
2023-05-26 15:15:45 631
631 
盲人听书机BGA芯片底部填充胶应用由汉思新材料提供客户产品是盲人听书机。盲人听书机是一款听读产品,符合人体工程学的外形设计,让盲人朋友触摸时手感舒适,能听各种影视语音文件,语音朗读效果可以多种选择
2023-05-30 10:57:55 292
292 
车载音箱bga芯片底部填充胶应用由汉思新材料提供.客户产品为车载音箱了解到他们公司主要做PCBA为主,现在他们的施胶设备还是以半自动点胶为主,只是到现在为止,这个项目还是在一个小批量试验的阶段,真正
2023-05-30 15:53:27 361
361 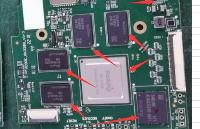
工控级固态硬盘主控芯片BGA底部填充胶应用案例分析由汉思新材料提供.客户生产产品:工控级固态硬盘用胶芯片:硬盘主控芯片客户要解决的问题:终端客户做完TC测试和振动测试后,抽检20台设备,3台设备出现
2023-05-31 05:00:00 470
470 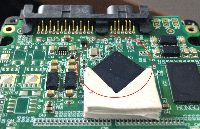
运动DVBGA芯片底部填充胶由汉思新材料提供客户生产的产品是运动DV,运动DV的主板用胶,经过初步了解,两个BGA芯片用胶点,均为比较大颗芯片,规格约为1CM*1CM,可以接受150度温度固化
2023-06-01 09:31:04 263
263 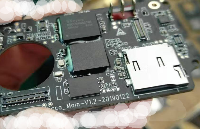
车载定位仪BGA芯片底部填充胶由汉思新材料提供客户的产品是车载定位仪,需要用胶的是一块QFN芯片,正方形10mm×10mm,18个脚×4。客户需要解决芯片加固,防止跌落时芯片脱落。客户需要做跌落测试
2023-06-01 09:31:15 407
407 
蓝牙耳机BGA芯片底部填充胶由汉思新材料提供。通过去客户现场拜访了解,客户开发一款蓝牙耳机板,上面有一颗BGA控制芯片需要找一款底部填充的胶水加固。BGA尺寸5*5mm,锡球径0.35mm,间距
2023-06-05 14:34:52 2002
2002 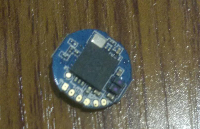
车载导航仪BGA芯片底部填充胶由汉思新材料提供客户是SMT代加工厂,用胶产品是车载导航仪的BGA芯片。第一次用胶,想加固芯片,颜色白色或黑色.目前是半自动点胶,可接受150度加热,芯片是A33芯片
2023-06-06 05:00:00 420
420 
跑步机控制板BGA芯片用底部填充胶由汉思新材料提供。客户开发一款跑步机产品,上面的控制板上有3颗BGA芯片需要底部填充加固,防止运动过程中控制BGA芯片引脚由于震动掉落脱焊,影响跑步机正常工作
2023-06-06 14:27:59 499
499 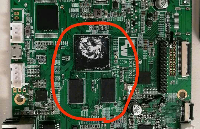
安防监控设备存储芯片用底部填充胶由汉思新材料提供经过客户电话了解情况:客户用胶产品是安防监控设备主板上8颗存储芯片+1颗处理器芯片存储芯片规格:长宽高10.5*8.0*1.1mmBGA锡球数78
2023-06-08 09:33:39 573
573 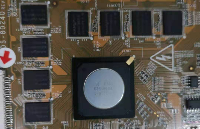
手持or车载式测绘仪器CPU芯片用底部填充胶由汉思新材料提供我司至电客户工程了解其产品的用胶情况后,了解情况如下:客户产品为手持or车载式测绘仪器(类似手机),研发后交由代加工厂代工。之前
2023-06-09 15:06:31 393
393 
摄像眼镜POP芯片用底部填充胶应用案例分析由汉思新材料提供。客户用胶产品为摄像眼镜摄像眼镜是款具有高清数码摄像和拍照功能的太阳镜,内置存储器,又名“太阳镜摄像机,可拍摄照片和高画质视频。主要功能
2023-06-12 17:13:09 613
613 
航空摄像机芯片BGA底部填充胶应用由汉思新材料提供。客户产品:客户开发一款航空摄像机产品,上面有两颗BGA芯片,芯片尺寸:15*15mm,13*12mm。锡球径0.25mm,间距0.5mm。产品
2023-06-13 05:00:00 452
452 
无人机航空电子模块用底部填充胶水由汉思新材料提供。客户产品:客户开发一款航空电子模块。用胶部位:三颗BGA芯片需要找一款合适的底部填充胶加固芯片尺寸:20*20mm锡球0.25mm,间距0.5mm
2023-06-16 14:45:44 686
686 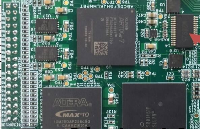
据了解,即使是最平稳的飞机,振动也是一个非常严重的问题,振动对于飞机运行的可靠性影响很大。在航空电子产品的制造过程中,往往会加入BGA底部填充胶工艺,以防止振动造成BGA芯片焊点开裂甚至损坏。BGA
2023-06-25 14:01:17 576
576 
车载电脑固态硬盘PCB芯片BGA底部填充加固用胶方案由汉思新材料提供客户公司是以SMT贴片、DIP插件、后焊、测试、组装等服务为主的加工厂,主要生产加工银行自助终端、高清播放器、读票读卡系列、汽车
2023-06-26 13:57:55 480
480 
近几年,我国的科技发现迅速,为了迎合电子市场的需求,市场上涌现出了一批底部填充胶厂家,面对这林林总总的底部填充胶厂家,我们该如何选择呢?底部填充胶什么牌子好?底部填充胶国内有哪些厂家?下面一起听一听
2023-06-28 14:53:17 1218
1218 
射频电子标签qfn芯片封装用底部填充胶由汉思新材料提供客户产品:射频电子标签。目前用胶点:qfn芯片加固。芯片尺寸:0.8MM*1.3MM客户要求:目前客户可以接受加热。颜色目前暂时没有要求
2023-06-30 14:01:42 554
554 
智能门锁指纹模组焊点补强加固用底部填充胶由汉思新材料提供。客户产品:智能门锁指纹模组,新产品工艺研发价段。产品用胶点:1,QFN芯片底部填充(无锡球,印刷锡膏导通),芯片规格11*13mm,共33
2023-07-04 14:30:11 850
850 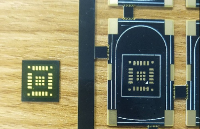
底部填充胶十大品牌排行榜之一汉思底部填充胶应运而生,通过多年验证及大量的终端客户反馈,汉思底部填充胶HS700系列完全媲美海外品牌。据了解电子产品的生产商为了满足终端销费者的各种需求,也是为了在竞争
2023-07-11 13:41:53 864
864 
手机芯片底部填充胶哪款好?客户开发一款手机相关的手持终端电子产品(如附图)。上面有两颗芯片需要填充加固,芯片具体信息通过客户确认,了解到。需要点胶的两颗BGA的相关参数。1.BGA芯片尺寸11
2023-07-18 14:13:29 872
872 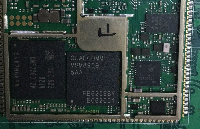
进行底部填充、角部粘接(cornerbond)或边部粘接。相对于标准的CSP/BGA工艺,堆叠工艺由于需要对多层封装同时进行点胶操作,因此将面对更多的挑战。对于Po
2023-07-24 16:14:45 545
545 
底部填充胶被填充在芯片与基板之间的间隙,来降低芯片与基板热膨胀系数不匹配产生的应力,提高封装的稳定性。
2023-07-31 10:53:43 387
387 
据了解现在很多3c电子工厂,电子产品都用底部填充胶来保护电路板芯片/BGA电子元件,其中电路板pcb也是有一定的成本,所以底部填充胶的返修也是个重要环节.底部填充胶的返修工艺步骤:1.把CSP
2023-07-31 14:23:56 905
905 
底部填充胶对SMT(电子电路表面组装技术)元件(如:BGA、CSA芯片等)装配的长期可靠性有了一定的保障性;还能很好的减少焊接点的应力,将应力均匀分散在芯片的界面上,在芯片锡球阵列中,底部填充胶能有
2023-08-07 11:24:38 354
354 据了解,现在很多电子产品都在使用底部填充胶水来保护PBC板BGA芯片和电子元件,让产品防摔,抗震,防跌落。汉思化学也进军BGA芯片用胶领域。汉思化学是面向全球化战略服务的一家创新型化学新材料科技公司
2023-08-07 14:24:47 718
718 
相对于其他的IC元件,如BGA和CSP等,倒装晶片装配工艺有其特殊性,该工艺引入了助焊剂工艺和底部填充工 艺。因为助焊剂残留物(对可靠性的影响)及桥连的危险,将倒装芯片贴装于锡膏上不是一种可采用的装配方法 。
2023-09-22 15:13:10 352
352 
汉思HS711芯片BGA底部填充胶是专为手机、数码相机以及手提电脑等数码产品而研发生产的,用于这些数码产品内部芯片的底部填充。那么为什么这些手机数码产品需要用到芯片BGA底部填充胶呢?其实芯片BGA
2023-11-06 14:54:42 154
154 
倒装芯片技术,也被称为FC封装技术,是一种先进的集成电路封装技术。在传统封装技术中,芯片被封装在底部,并通过金线连接到封装基板上。而倒装芯片技术则将芯片直接翻转并安装在封装基板上,然后使用微小的焊点
2024-02-19 12:29:08 480
480 
什么是芯片底部填充胶,它有什么特点?芯片底部填充胶是一种用于电子封装的胶水,主要用于底部填充bga芯片电子组件,以增强组件的可靠性和稳定性。它通常是一种环氧树脂,具有良好的粘接性和耐热性。底部填充
2024-03-14 14:10:51 247
247 
倒装芯片组装过程通常包括焊接、去除助焊剂残留物和底部填充。由于芯片不断向微型化方向发展,倒装芯片与基板之间的间隙不断减小,因此去除助焊剂残留物的难度不断增加。这不可避免地会导致清洗成本增加
2024-03-15 09:21:28 107
107 
 电子发烧友App
电子发烧友App











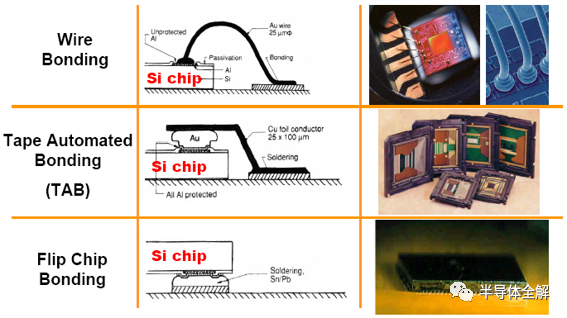


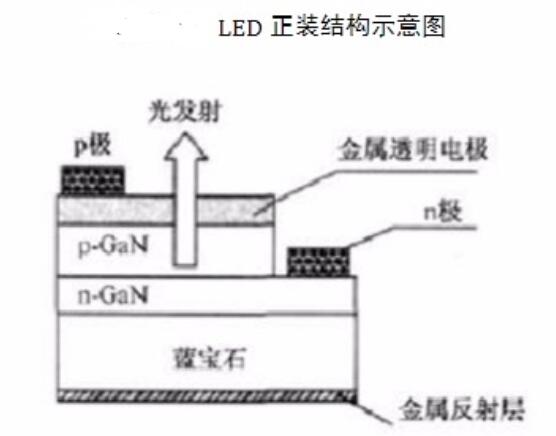

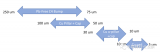


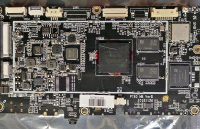
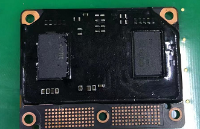






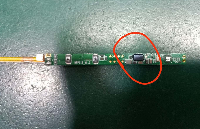
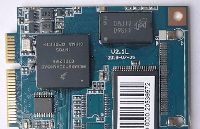

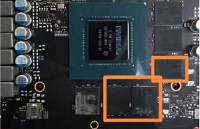
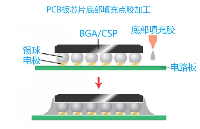





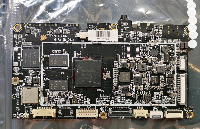

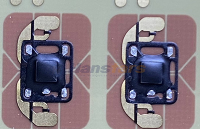


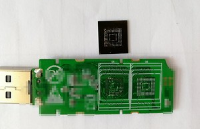

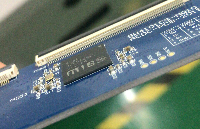
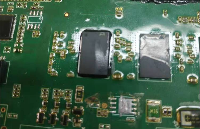







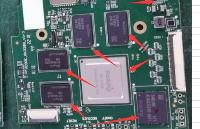
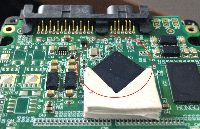
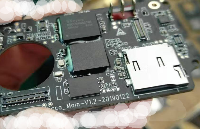

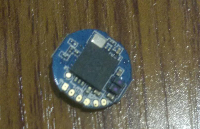

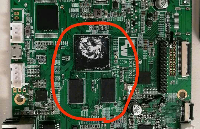
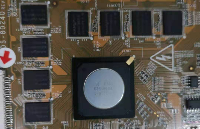



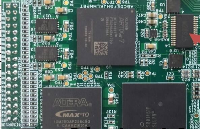




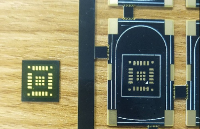

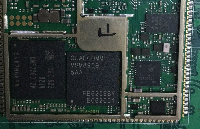

















评论