电池保护板芯片底部填充胶由汉思新材料提供
据了解,在选择智能手机的时候,
用户不仅关心手机外观颜值,更关注性能。
5G手机时代,为了满足手机性能的可靠性,维持电池充放电过程中的安全稳定,
需要用底部填充胶,
对手机电池保护板芯片底部填充及封装,
提高手机电池芯片系统稳定性和可靠性。
对手机电池保护板芯片底部填充及封装,
汉思新材料的低粘度的底部填充胶,
可靠性高、流动性大、快速填充、易返修,
用于BGA、CSP和Flipchip底部填充制程,
加热固化,将BGA底部空隙大面积填满,
有效降低由于硅芯片与基板之间的
总体温度膨胀特性不匹配或外力造成冲击,
提高芯片连接后的机械结构强度,
增强BGA封装模式芯片和PCBA间抗跌落性能。
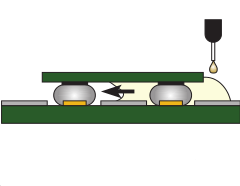
汉思底部填充胶HS700,HS702
HS702主要应用于
电池保护板芯片底部填充及封装。
具有良好的电绝缘性能,
粘度低(1400~2000)、
快速填充、覆盖加固,
对各种材料均有良好的粘接强度。
对手机电池保护板芯片底部填充及封装。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
463文章
54441浏览量
469405 -
芯片封装
+关注
关注
14文章
623浏览量
32397 -
电池
+关注
关注
85文章
11613浏览量
144552 -
电池保护器
+关注
关注
1文章
91浏览量
1019
发布评论请先 登录
相关推荐
热点推荐
超细间距倒装芯片灌封胶渗透与空洞控制 |铬锐特实业
铬锐特实业|探讨超细间距(Fine-pitch)倒装芯片封装中,底部填充胶渗透难题与空洞缺陷控制的关键技术。分析间距缩小至40-55μm时的流动性、空洞成因及行业解决方案,助力高性能

汉思新材料获得芯片底部填充胶及其制备方法的专利
年2月,授权公告日为2025年(具体月份因来源不同存在差异,但不影响专利有效性的认定)。一、专利技术背景芯片底部填充胶是电子封装领域的关键材料,主要用于

汉思新材料|芯片级底部填充胶守护你的智能清洁机器人
汉思新材料|芯片级底部填充胶守护你的智能清洁机器人智能清洁机器人的广泛应用随着现代科技的飞速发展,智能清洁机器人已覆盖家庭、商用两大场景:家庭中实现扫拖消全自动,商用领域应用于酒店(客

汉思新材料:底部填充胶返修难题分析与解决方案
,有的产品可能需要进行返修(如更换单个芯片或修复下方焊点)对于没有经验的新手返修也是个难题,以下是具体原因分析及相应的解决方案:一、底部填充胶返修困难原因分析材料特

汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利
汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利2025年4月30日消息,国家知识产权局信息显示,深圳市汉思新材料科技有限公司取得一项名为“封装

未知逆变器保护板,锂电池保护板
大家帮我看一下怎么接线?什么板子?暂时得到的信息是一个逆变器,然后一个锂电池保护板,然后一个控制板,控制板接通12伏电源有USB可以充手机电,然后保护板上面有三个B+,但是都是相通的,还有三个B-
发表于 04-27 21:04



 电池保护板芯片封胶底部填充胶
电池保护板芯片封胶底部填充胶













评论