BGA芯片底部填充胶点胶工艺标准和选择与评估由汉思新材料提供
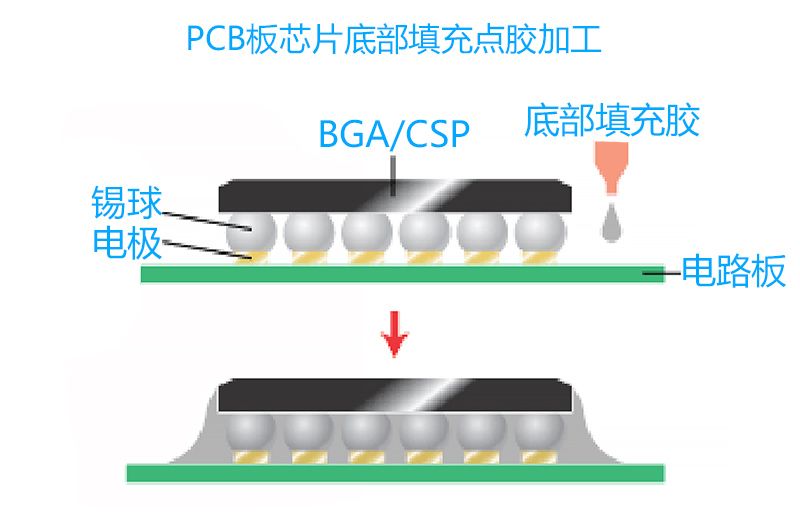
由于 BGA 芯片存在因应力集中而出现的可靠性质量隐患问题,为了使 BGA 封装具备更高的机械可靠性,需对 BGA 进行底部填充,而正确选择底部填充胶对产品可靠性有很大影响。
随着电子行业高精密、智能化的发展,BGA封装芯片在电子组装中应用越来越广泛,随之而来的则是BGA芯片容易因应力集中导致的可靠性质量隐患问题。为了使BGA封装工艺获得更高的机械可靠性,需对BGA进行底部填充。
底部填充胶简单来说就是底部填充之义,对BGA /PCB封装模式的芯片进行底部填充,利用加热的固化形式,将BGA 底部空隙大面积 (一般覆盖80%以上)填满,从而达到加固的目的,增强BGA 封装模式的芯片和PCB之间的机械可靠性。
底部填充的主要作用
1)填补PCB基板与BGA封装之间的空隙,提供机械连接作用,并将焊点密封保护起来。
2)吸收由于冲击或跌落过程中因PCB形变而产生的机械应力。
3)吸收温度循环过程中的CTE失配应力,避免焊点发生断裂而导致开路或功能失效。
4)保护器件免受湿气、离子污染物等周围环境的影响。
底部填充实际应用评估与选择
实际应用中,不同企业由于生产工艺、产品使用环境等差异,对底部填充胶的各性能需求将存在一定的差异,如何选择适合自己产品的底部填充胶,汉思化学认为需重点关注以下几个方面。
1 热膨胀系数(CTE)
焊点的寿命主要取决于芯片、PCB和底部填充胶之间的CTE匹配,理论上热循环应力是CTE、弹性模量E和温度变化的函数。但根据实验统计分析显示CTE1是最主要的影响因素。由于CTE2与CTE1相关性很强,不管温度在Tg点以下还是Tg点以上,CTE2都会随着CTE1增加而增加,因此CTE2也是关键因素.
2 玻璃转化温度(Tg)
Tg在材料高CTE的情况下对热循环疲劳寿命没有明显的影响,但在CTE比较小的情况下对疲劳寿命则有一定影响,因为材料在Tg点以下温度和Tg点以上温度,CTE变化差异很大。实验表明,在低CTE情况下,Tg越高热循环疲劳寿命越长。
3 流动性
底部填充胶应用原理是利用毛细作用使得胶水迅速流过BGA /PCB芯片底部芯片底部,其毛细流动的最小空间是10um。根据毛细作用原理,不同间隙高度和流动路径,流动时间也不同,因此不同的填充间隙和填充路径所需填充时间不同,从而容易产生“填充空洞”。为更直观的评估胶水流动性能,可采用以下方法评估胶水流动性:将刻有不同刻度的载玻片叠在PCB板的上方,中间使用50um的垫纸,使载玻片与PCB间留有间隙,在载玻片一端点一定量胶水,测试胶水流动不同长度所需的时间。由于胶水流动性将随温度变化而变化,因此,此实验可在加热平台上进行,通过设置不同温度,测试不同温度下胶水流动性。
4 与锡膏兼容性
底部填充胶起到密封保护加固作用的前提是胶水已经固化,而焊点周围有锡膏中的助焊剂残留,如果底部填充胶与残留的助焊剂不兼容,导致底部填充胶无法有效固化,那么底部填充胶也就起不到相应的作用了,因此,底部填充胶与锡膏是否兼容,是底部填充胶选择与评估时需要重点关注的项目。
与锡膏兼容性评估方法一般有两种:
一是将锡膏与底部填充胶按1:3的比例混合,通过DSC(差示扫描量热仪)测试混合锡膏后的胶水与未混合锡膏胶水热转变温度变化的差异,如没有明显差异则说明底部填充胶与锡膏兼容。
二是通过模拟实际生产流程验证,将已完成所有工序的BGA做水平金相切片实验,观察焊点周围是否存在有胶水未固化的情况,胶水与锡膏兼容胶水完全固化,是由于不兼容导致胶水未完全固化。
5 绝缘电阻
底部填充胶除起加固作用外,还有防止湿气、离子迁移的作用,因此绝缘电阻也是底部填充胶需考虑的一个性能。
评估方法,采用线宽为0.4mm、间距为0.5mm的梳型电极。在梳型电极表面涂覆已回温胶水,并参考胶水厂家提供固化曲线进行固化。将制备好的测试板放在温度85℃、湿度85%RH的高低温交变潮热试验箱中,并对试验板施加偏压为50V DC,进行168h潮热试验,使用在线监测系统对其进行阻值测定。要求测得测试板阻值必须大于108Ω。
6 长期可靠性
底部填充胶主要的作用就是解决BGA/CSP芯片与PCB之间的热应力、机械应力集中的问题,因此对底部填充胶而言,最重要的可靠性试验是温度循环实验和跌落可靠性实验。
通常选择以下评估方法:
温度循环实验:制备BGA点胶的PCBA样品,将样品放置-40℃~80℃状态下做温度循环,40℃和80℃温度下各停留30分钟,温度上升/下降时间为30min,循环次数一般不小于500次,实验结束后要求样品测试合格,金相切片观察底部填充胶胶和焊点有无龟裂现象。
跌落可靠性试验:制备BGA点胶的PCBA样品,样品跌落高度为1.2m;实验平台为水泥地或者地砖;跌落方向为PCB垂直地面,上下左右4个边循环朝下自由跌落;
跌落次数不小于500次。实验结束后要求样品测试合格,金相切片观察底部填充胶胶和焊点有无龟裂现象。
底部填充胶是增强BGA组装可靠性的重要辅料,选择底部填充胶的好坏对产品可靠性有很大影响。但目前电子行业底部填充胶供应商很多,良莠不齐,如何选择与评估至关重要.各企业由于工艺制程等的差异,还需考虑底部填充胶返修性能、固化温度、固化时间等等因素,以匹配自己公司的生产工艺。BGA底部填充胶点胶工艺标准和选择与评估相关问题可以咨询汉思新材料。
汉思新材料专业生产芯片胶,芯片封装胶,芯片底部填充胶,专注胶水领域研发生产销售15年,可以为客户作高端定制。合作客户有华为,小米,飞毛腿电池.可以为客户做免费样品测试和点胶代加工服务.
-
芯片
+关注
关注
463文章
54704浏览量
471346 -
BGA
+关注
关注
5文章
588浏览量
52103 -
芯片封装
+关注
关注
14文章
627浏览量
32446
发布评论请先 登录
汉思新材料案例研究 | 某知名汽车电子 Tier 1 如何通过优化底部填充胶提升良率 15%

芯片基板热循环测试失败?可能是你的底部填充胶CTE 匹配没做好!

汉思新材料|芯片级底部填充胶守护你的智能清洁机器人




 BGA芯片底部填充胶点胶工艺标准和选择与评估
BGA芯片底部填充胶点胶工艺标准和选择与评估
















评论