工控级固态硬盘主控芯片BGA底部填充胶应用案例分析由汉思新材料提供.
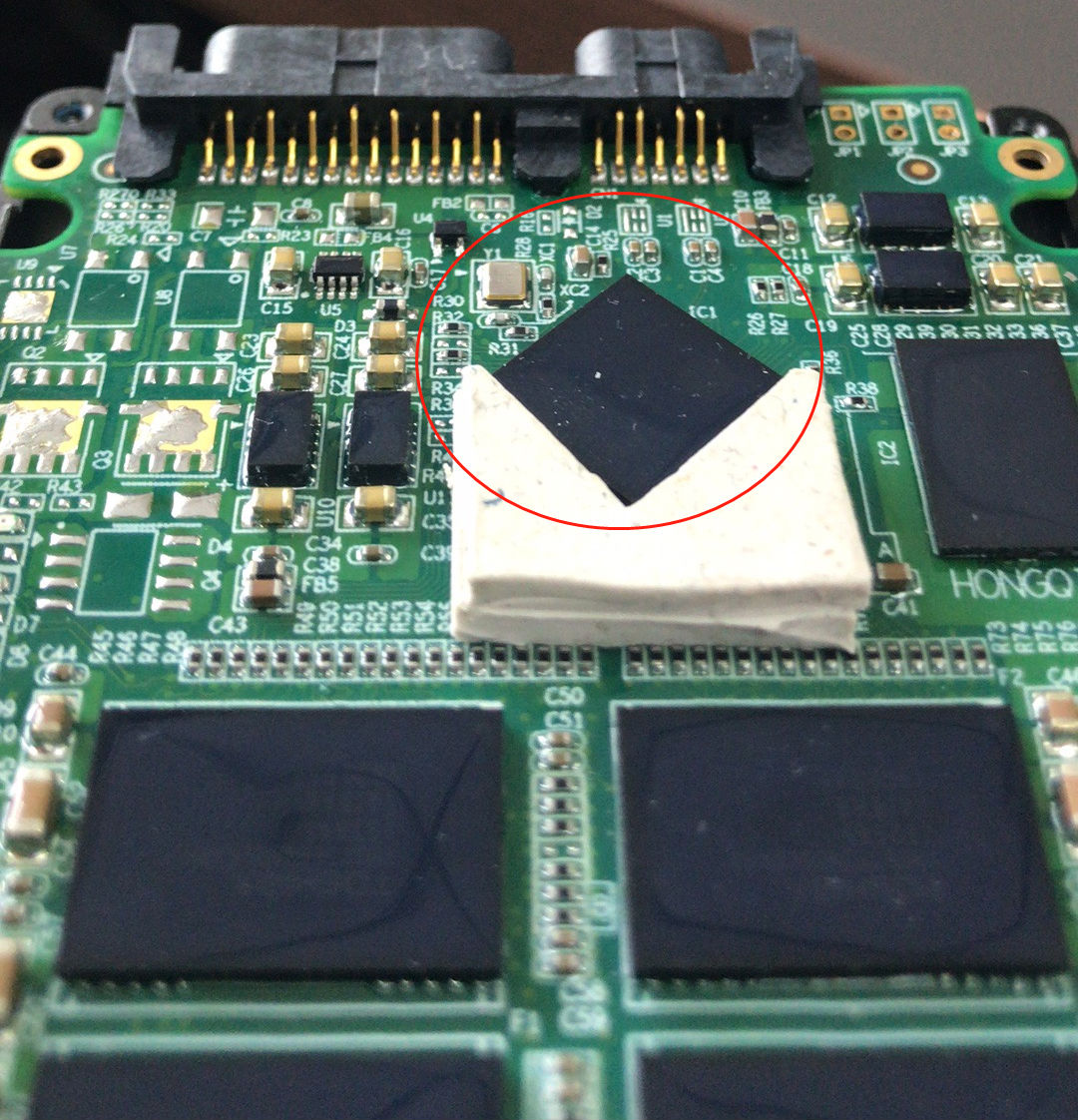
客户生产产品:工控级固态硬盘
用胶芯片:硬盘主控芯片
客户要解决的问题:终端客户做完TC测试和振动测试后,抽检20台设备,3台设备出现不良,芯片BGA锡球和芯片上焊盘接着层出现断裂纹。
芯片规格:12*12*1.35mm
BGA锡球数:288颗
球心间距:0.65mm
锡球直径:0.3mm
芯片和PCB板间隙高度:0.21mm
TC温度测试:
工厂:-55度@2h 85度@2h ,2个循环,共8小时
终端客户:-55——85度——-55度,在高温和低温区停留一段时间,升降温速率5度/分钟,一个循环4小时,共10次循环,共计40小时。
振动耐久测试:
工厂:XYZ轴各1小时,测试标准具体数值见附图
终端客户:6个小时,在工厂标准上增加6倍时间
经过我司技术工程人员专案分析,推荐HS710底部填充胶给客户试胶.
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
463文章
54463浏览量
469661 -
BGA
+关注
关注
5文章
586浏览量
51973 -
固态硬盘
+关注
关注
12文章
1650浏览量
60698
发布评论请先 登录
相关推荐
热点推荐
没有强大纠错的工业硬盘,敢叫工业级SSD固态硬盘吗?
在工业环境中,数据的精度与稳定性往往意味着设备运转的成败,甚至关乎系统安全和业务连续性。很多用户在选购“工业级SSD固态硬盘”时,只盯着读写速度,却忽略了一个至关重要的核心指标——纠错与坏块管理能力
汉思新材料|芯片级底部填充胶守护你的智能清洁机器人
汉思新材料|芯片级底部填充胶守护你的智能清洁机器人智能清洁机器人的广泛应用随着现代科技的飞速发展,智能清洁机器人已覆盖家庭、商用两大场景:家庭中实现扫拖消全自动,商用领域应用于酒店(客




 工控级固态硬盘主控芯片BGA底部填充胶应用案例分析
工控级固态硬盘主控芯片BGA底部填充胶应用案例分析

















评论