文章来源:半导体全解
原文作者:圆圆De圆
芯片封装作为设计和制造电子产品开发过程中的关键技术之一日益受到半导体行业的关注和重视。本片讲述了芯片封装及底部填充(Underfill)技术。
一、什么是芯片封装?
封装的作用主要有保护电路免受外界环境的影响、避免噪声信号的污染,屏蔽外场的串扰,支撑封装体内机械机构、电气互连,缓解封装体内部的机械应力,提供从封装体内功率器件到外界环境的热传递路径,使芯片间的引线从封装体牢固地引出而非直接装配在基片上等功能。封装技术的优劣直接关系到芯片自身性能的发挥以及与芯片连接的PCB(印制电路板)的设计和制备,因此封装是至关重要的。
高密度封装应半导体技术的发展,实现电子器件由二维(2D)平面堆集到沿Z方向的高密度集成,以缓解、延续或超越摩尔定律的发展。
二、摩尔定律及后摩尔时代
1965年,美国仙童半导体公司的Gordon Moore博士提出了著名的Moore定律:当价格不变时,集成电路上可容纳的元器件数目,每隔18-24个月就会增加一倍。
这一定律准确预测了过去五十年半导体行业的发展。随着电子信息产业的不断升级,半导体集成电路正在向超大规模、超高速、高密度、大功率方向发展,当晶体管特征尺寸达到纳米级后,进一步减小晶体管尺寸无疑是困难且昂贵的,这也意味着摩尔定律接近尾声。基于这种情况,业界提出了超越摩尔定律(More-Than-Moore,MTM),试图从其它的一些途径来延续摩尔定律的发展趋势,并且从摩尔定律的“更多更快”,发展到MTM的“更好更全面”。如通过优化晶体管的设计,寻找硅的替代品和发展先进封装技术等,使一块集成电路芯片能够同时具有多种功能,这不仅可以降低芯片的生产成本还能提高电路的等效集成度。其中先进封装技术的应用无疑是后摩尔时代集成电路发展最有效的解决方法之一,特别是电子封装维度从二维(2D)向三维(3D)发展,通过三维片上集成、硅通孔(TSV)芯片互连和三维封装堆叠的形式,在晶体管特征尺寸不变的情况下,可以成倍的增加集成电路密度,从而更好的延续摩尔定律。
封装的结构方式包括引线键合(wire bonding,WB)、载带自动键合(Tape Automated Bonding)、倒装芯片(flip chip,FC)、硅通孔技术(Through Silicon Via)等。
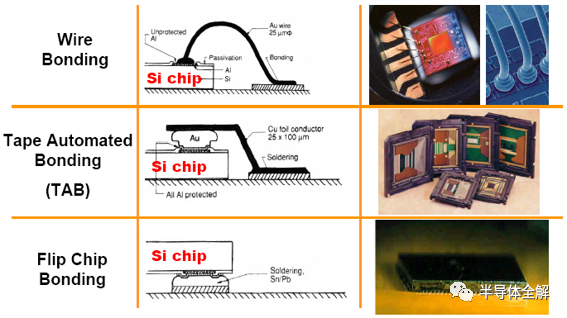
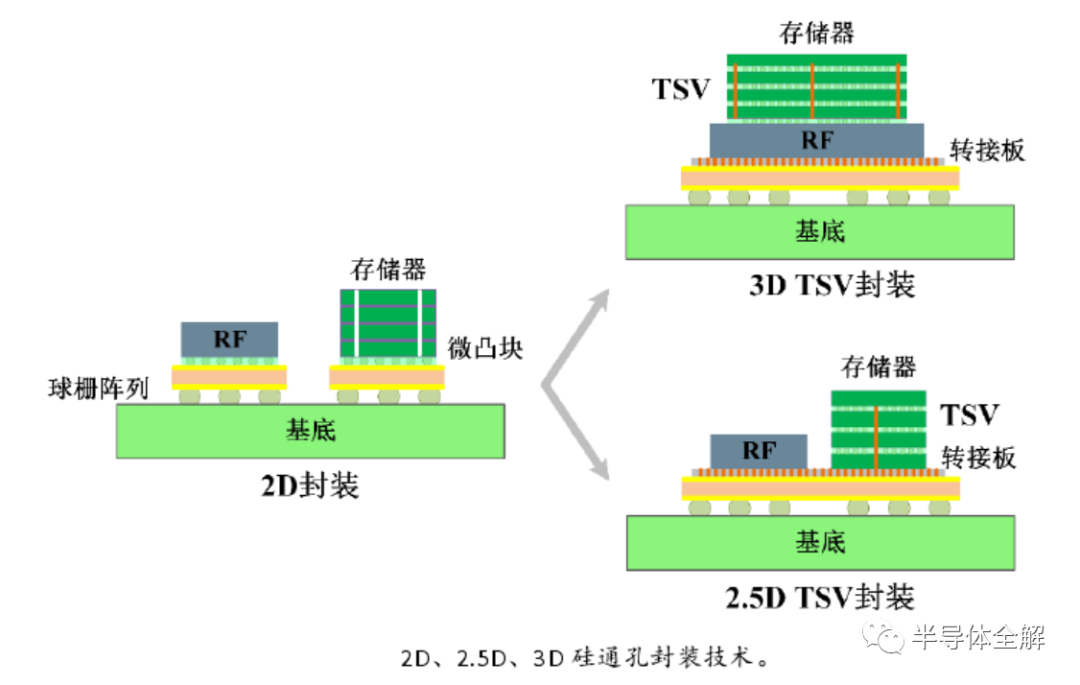
三、倒装芯片(FC)底部填充的原因
电子封装结构也由双列直插式封装(Dualin-line package, DIP)、小外型封装(Small out-line package, SOP)、四侧引脚扁平封装(Quad flat package, QFP)等传统封装形式向倒装芯片(Flip-chip, FC)、倒装芯片-球栅阵列(FC-BGA)、扇入型晶圆级封装(Fan-inwafer level package, FIWLP)、扇出型晶圆级封装(Fan-out wafer level package, FOWLP)、嵌入式芯片封装(Embedded chip package, ECP)等先进封装形式发展。其中由FC与BGA技术融合而产生的FC-BGA封装已成为广泛采用的主流封装技术之一。


但FC封装中硅基芯片与高分子基封装基板之间热膨胀系数(Coefficient of Thermal Expansion, CTE)不匹配产生的热应力易造成焊点在热载荷作用下过早产生疲劳断裂乃至失效。1987年日本日立(Hitachi)公司Nakano首次提出在环氧树脂中加入SiO2并将其填充在芯片与基板之间来提高焊点的疲劳寿命,这种填充树脂后来逐渐发展成为底部填充胶(Underfill),也称为底部填充剂或底填胶等。
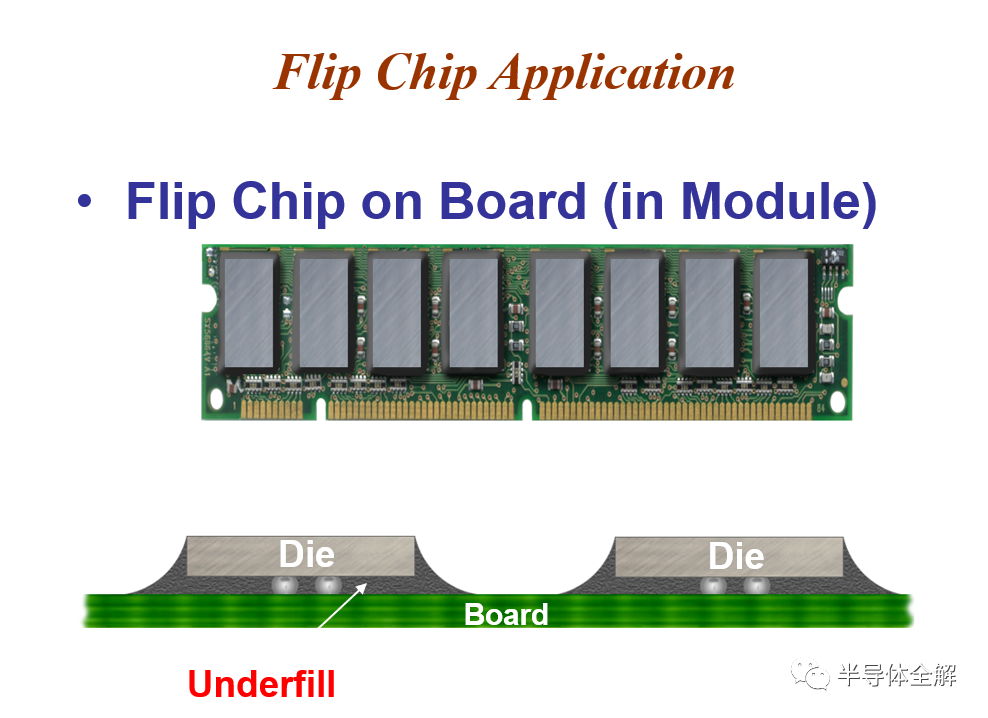
四、底部填充(Underfill)介绍
Underfill是指在集成电路芯片(Die)与芯片封装基板(Substrate)或其它芯片亦或转接板(Interposer)之间填充高分子(树脂)基复合材料进而提高封装稳定性的技术。
其中芯片与芯片或芯片与转接板的连接主要用于系统级芯片(System on chip,SoC)或系统级封装(System in package, SiP)等3D封装中。
Underfill材料应用的基本原理是通过其填充在芯片底部并经加热固化后形成牢固的粘接层和填充层,降低芯片与基板之间因热膨胀系数差异所造成的热应力失配,提高器件结构强度和可靠性,增强芯片和基板间的抗跌落性能。
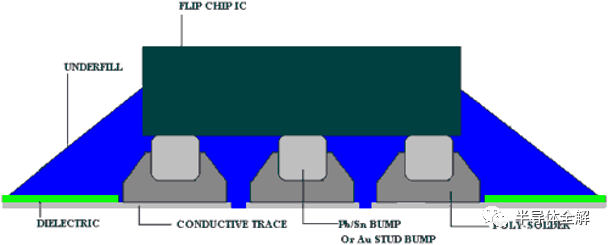
Underfill材料主要由有机粘合剂、填料、固化剂、催化剂、偶联剂、润湿剂、阻燃剂、消泡剂以及其它添加剂组成。其主要成分的常用材料及各成分发挥的作用见表:

五、不同底部填充(Underfill)技术
自underfill在工业生产中广泛应用以来,已经发展出几种典型的underfill,包括毛细流动型底部填充胶(Capillary Underfill,CUF)、非流动型底部填充胶(No-Flow Underfill,NUF)、晶圆级底部填充胶(Wafer-Level Underfill, WLUF)及模塑底部填充胶(Molded Underfill,MUF)。
每种underfill材料在应用上都各有其优缺点,所以在填充过程中要需要根据产品的特点和性能要求选用合适的underfill及相应的填充工艺。
1)毛细流动型底部填充胶(CUF)
CUF是最早出现的一类underfill,它是利用毛细作用流动填充芯片与底板间隙的一种低黏度填充胶。
CUF在FC封装回流焊接后进行填充固化,完整的工艺过程包括:助焊剂涂覆→芯片放置→加热回流→助焊剂清理→流动填充→加热固化,如图所示:
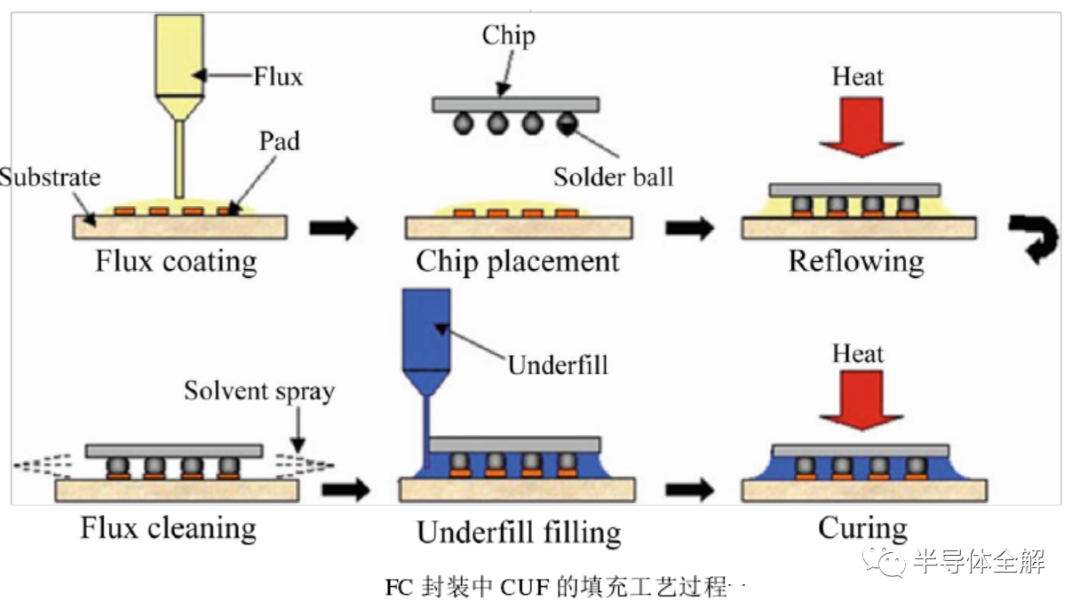
CUF是最早应用于电子封装的一种underfill。目前仍占据市场主流,应用范围很广,几乎面向各个层次的封装,如FC、CSP、BGA封装。但由于使用CUF时,工艺上多出了流动填充和加热固化的步骤,因而生产效率不高,另外毛细流动通常较慢且不够充分,从而导致固化后的underfill基体中出现空洞,还会出现填料在树脂体系中分布不均的现象,随着芯片尺寸的增大及焊点尺寸的减小,这种现象愈发严重。
2)非流动型底部填充胶(NUF)
NUF是基于摩托罗拉(Motorola)公司于1992年发展的助焊剂和底部填充胶集成专利技术(Integrated flux and underfill)启发而发展起来,NUF填充固化工艺比CUF要简单,主要包括:underfill涂覆→芯片放置→回流焊接和固化,如图所示:

与CUF相比,NUF工艺步骤减少,生产效率高。实现NUF这种新填充工艺的两个关键要素在于:潜性固化能力和固有助焊能力。NUF工艺的特性需要underfill有足够的反应潜伏期来保持低粘度,直至形成互连焊点。
由于NUF的固化和互连焊点的形成是在一个工序里完成,因此助焊剂是NUF中必不可少的成分。使用助焊剂是为了在回流过程中去除材料表面的氧化物,提高焊料的润湿性;同时,助焊剂在回流阶段应避免产生挥发性物质,保证填充稳定性。
NUF几乎可用于所有封装层次,由于NUF将传统underfill底部填充工艺上的流动填充、助焊剂涂覆清理、焊料回流、underfill固化简化成一个工艺步骤,大大提高了生产效率;但由于NUF填料少、热膨胀系数比较高,固化物常有气泡和空洞等问题,其尚未成为市场主流产品。
3)晶圆级底部填充胶(WLUF)
由于NUF工艺需要先在基板上涂敷underfill,这与表面贴装技术(Surface Mounted Technology, SMT)并不完全兼容。针对此问题后来发展出了与SMT兼容的WLUF工艺,该工艺以其低成本、高可靠性而获得了成功应用。
WLUF工艺首先在有凸点或无凸点的晶圆片上采用印制或涂敷添加一层underfill,然后进行部分固化。对于尚未制作凸点的晶圆,则需在划片前制作凸点,然后再进行划片。每单个芯片均可以通过标准的SMT工艺实现与基板的互连,工艺流程如图所示。
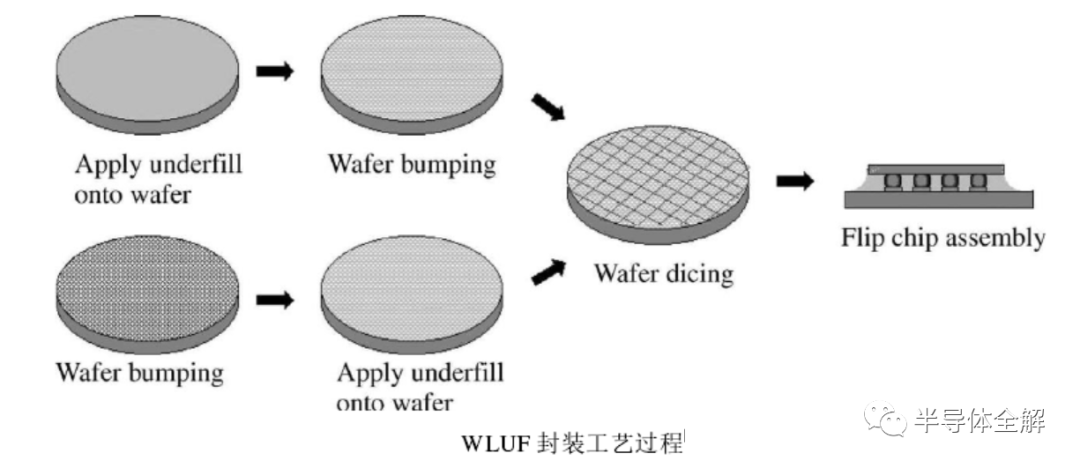
与NUF相同,WLUF也要求含有适当的助焊剂,填料含量很少甚至没有,以达到100%的焊点连通率。此外,WLUF固化物需要一定的透明度以防晶圆的切割线模糊不清;WLUF需要良好的激光可加工性,便于划片切割和打孔;此外,WLUF需要有低的介电常数和热膨胀系数来更好地实现应力均匀分布。
由于WLUF在芯片放置之前就已经将部分固化的WLUF预涂覆在裸芯片上,完全适用于标准FC设备,大大提高了生产效率。但由于几乎不含填料,还需要解决WLUF热疲劳稳定性问题。由于工艺过程的限制,WLUF只适用于FC封装。
4)模塑底部填充胶(MUF)
MUF是可以向模具直接注入,将包括芯片和底板间隙的整个器件进行封装保护的一种underfill材料。MUF直接将底部填充和二次成型(Over molding)封装在一个工艺步骤里完成,可降低成本,大大提高生产效率。MUF不仅填充芯片与基板之间的间隙,同时还包覆整个芯片并提高了器件力学稳定性。
MUF特别适用于倒装芯片封装,能够提高生产效率。据报道,MUF工艺可将传统底部填充工艺的生产效率提高4倍。
MUF工艺在模具设计和工艺方面与增压底部填充类似,只是前者采用的不是只填充芯片与基板间隙的液态密封剂,而是包封整个器件的模塑化合物。
下图所示为CUF与MUF工艺过程对比以及常见的FC-BGA封装采用MFU工艺的模具设计。
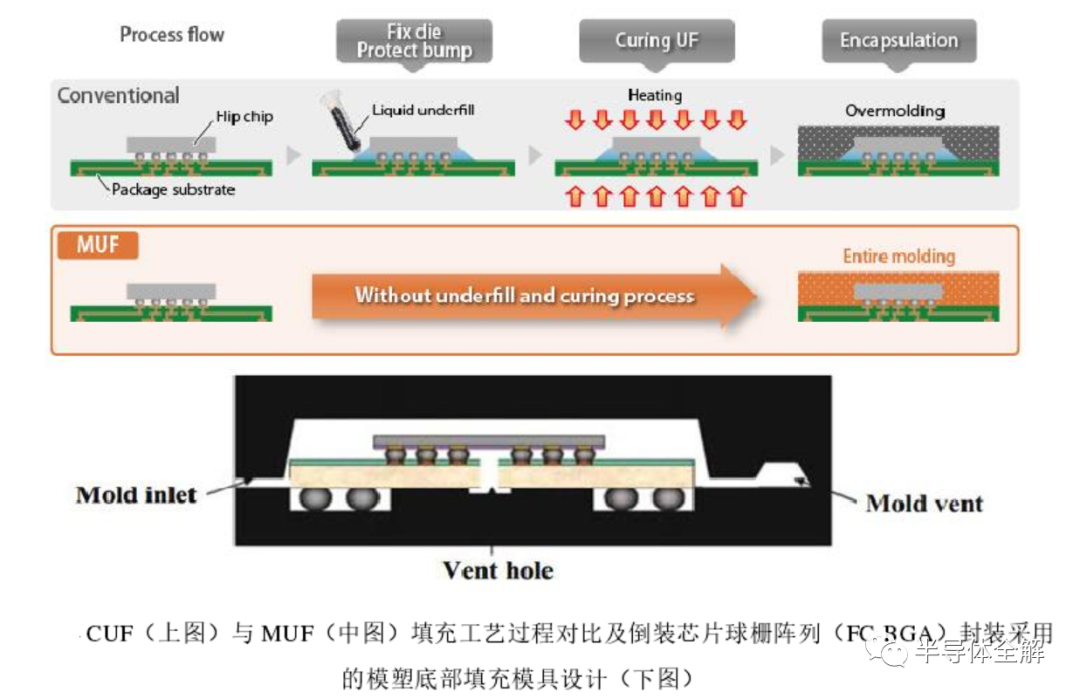
MUF封装技术将注塑工艺和underfill相结合,可大大提高生产效率,降低生产成本,同时可显著提高封装器件的可靠性;MUF可以对许多小的间隙进行填充,特别是小芯片微小间距时,填充效果好,有利于电子产品微型化和多功能化;MUF模具填充最小间隙高度可达40um;但MUF的可返修性差。MUF一般适合FC、CSP层次的单个或多个芯片的封装。
-
半导体
+关注
关注
336文章
29985浏览量
258297 -
芯片封装
+关注
关注
13文章
604浏览量
32084 -
倒装芯片
+关注
关注
1文章
117浏览量
16795
原文标题:一文了解芯片封装及底部填充(Underfill)技术
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录





 什么是芯片封装?倒装芯片(FC)底部填充的原因
什么是芯片封装?倒装芯片(FC)底部填充的原因






















评论