引言
结合离子注入工艺、激光照射和去除牺牲层,晶片键合技术是将高质量薄膜转移到不同衬底上的最有效方法之一。本文系统地总结和介绍了苏州华林科纳的晶片键合技术在电子、光学器件、片上集成中红外传感器和可穿戴传感器等领域的应用。依次介绍了基于智能剥离技术
工艺的绝缘体上硅(SOI)晶片的制作、宽带隙半导体、红外材料和电光晶体的异质集成以及薄膜转移的晶片键合技术。此外,本文还重点介绍了基于上述平台的器件设计和制造进展。他们证明,转移的薄膜可以满足高性能电力电子、分子传感器和高速调制器在5G之外的下一代应用。此外,还报道了通过晶片键合和去键合方法制备的柔性复合结构。最后,讨论了需要通过晶片键合技术实现的异质结构的进一步发展的前景和结论。
关键词:异构集成;晶片键合;薄膜转移;系统级封装(SIp);传感器;5G;6G;光子学;电力电子;物联网;物的人工智能(AIot);可穿戴电子设备
介绍
目前,我们正处于通信技术创新的风口浪尖。第五代(5G)通信技术和5G之外的替代通信技术的发展将影响世界各国的技术格局。通信技术的目标是在数据速率、延迟、大规模连接、网络可靠性和能效方面实现革命性的飞跃。因此,高数据传输要求迫使终端产品的性能迅速提高。5G时代的到来离不开针对电信基础设施的射频(RF)前端的发展,而RF前端的核心就是由压电谐振器组成的滤波器。具有高机电耦合的压电谐振器将改善射频前端的性能,。增加带宽,降低损耗。在使用各种结构和压电材料的压电谐振器中,基于铌酸锂薄膜的压电谐振器具有显著高的机电耦合。然而,目前还不可能通过传统的沉积工艺在衬底、绝缘体上制备铌酸锂薄膜。利用转移技术来移动一片体铌酸锂并结合到载体衬底上是最常见和最有效的方法。进入5G时代和5G之外,在晶圆制造过程中集成在芯片上的多样化组件和器件中,薄膜LiNbO3电光调制器在信息传输速度和带宽调制方面显示出突出的优势。对于绝缘体上铌酸锂(LNOI)平台的制作,晶圆键合为铌酸锂薄膜的片上异质集成提供了有效的技术支持。通过在LNOI晶片上设计和制备高速调制器,这种想法已经被证实是可行的,晶片使用晶片直接键合技术从块状铌酸锂晶体上剥离单晶薄膜来制造。这将有利于5G通信之外的下一代应用。
讨论
晶圆键合法制备硅基和锗基绝缘体上薄膜
半导体是各种光子和电子元件的基础。它们是器件设计和制造的基本平台。硅基和锗基材料是众多半导体中最受欢迎的,因为它们在成熟制造、低成本和大规模生产方面取得了进展[30,31]。因此,大多数互补金属氧化物半导体工艺的发展都依赖于它们。然而,用于有源和无源器件的器件层的厚度通常为纳米或微米级。为了避免信号串扰或元件扩散,插入阻挡层在相邻器件层之间是不可或缺的。因此,迫切需要解决绝缘体上硅基薄膜的制备问题。尽管这种薄膜可以通过溅射、化学气相沉积(CVD)、等离子体增强化学气相沉积(PECVD)等在特定的衬底上生长,但是非晶或多晶晶体结构对于最大化优异的材料性能是具有挑战性的。已经开发了结合离子注入的晶片键合方法(称为智能切割技术[32,33])。这项技术使得将薄层从单晶施主衬底转移到支撑晶片成为可能,克服了物理限制并改变了衬底工业的面貌。
绝缘体上硅的智能切割技术及其应用
如今,大多数用于芯片制造的行业领先的绝缘体上硅(SOI)晶片都是由智能切割技术制造的。SOI制造的标准智能切割工艺如图2a所示。首先对两个清洗过的硅晶片进行表面氧化。其中一个用作支撑衬底,用于薄膜施主晶片。然后,氢离子(H+)注入产生被破坏。植入光元件有几个优点注入施主晶片。转移层可以设计成没有缺陷。通过控制H+的注入能量,可以高精度地确定转移层的厚度。在完成离子注入后,氧化的晶片通过活化结合方法结合在一起。然后,在键合对上执行退火工艺。一方面,施主晶片将从气泡层完全破裂,使得薄膜剥离并保留在支撑晶片上。另一方面,高温处理将有利于增强薄膜与支撑衬底之间的结合界面。最后,化学机械抛光用于平整和平滑表面,以满足实际生产要求。对于施主晶片,衬底可以在每次层转移操作之后被刷新和重新使用。图2显示了制造的SOI晶片的横截面图像。透射电子显微镜可以观察到没有任何缺陷的致密而尖锐的界面,证明了智能切割技术的优势。我们应该注意到,晶片键合适用于几种材料和很宽的温度范围,为在其他衬底上实现任何薄膜材料同时保持初始晶体学特性开辟了道路。例如,锗是电子工业的另一种基本材料[35–39]。GeOI也是高性能场效应晶体管(FET)必不可少的平台。基于智能切割技术,单晶锗薄膜可以转移到其他衬底上。透射电镜研究表明,键合界面是无空隙的,证实该工艺可应用于硅材料以外的薄膜转移。此外,Smart Cut技术基于标准半导体设备,允许不同尺寸的产品。顶部薄膜层和掩埋氧化物层的厚度也可以以相当大的灵活性进行调节。此外,在均匀性、结合界面和厚度可变性的精确控制方面的优异质量是其他方法无法实现的。这项技术也为传感器、能量收集、柔性电子、光子学和微机电系统等新兴领域提供了新的机遇。
宽带隙半导体薄膜转移及其在金属氧化物半导体场效应晶体管中的应用
氮化镓(GaN)是应用于无线通信和光通信的理想材料,因为它可以在高功率和高频率下工作[91–93]。因此,氮化镓与硅互补金属氧化物半导体衬底的异质集成引起了广泛关注[94]。然而,由于GaN和Si之间的显著晶格失配,将两种材料结合成一个系统是具有挑战性的。最近,在(100)取向的硅衬底上直接外延生长氮化镓薄膜的报道。由于硅衬底的非对称表面畴,生成的氮化镓薄膜通常是多晶的,具有双畴结构。
用于高散热的碳化硅或金刚石衬底上宽带隙半导体薄膜转移的异质键合
虽然宽带隙半导体和SiCMOS的异质集成可以带来许多好处,但GaN和Ga2O3的应用主要是大功率或高频电子器件,因为它们具有优异的材料性能。然而,自加热引起的高通道温度通常会降低器件的性能和可靠性。最有效的方法之一是利用散热基板及时散热。SiC因其高导热性和与GaN的小晶格失配而被用作GaN的散热基板。不幸的是,热边界电导的存在
GaN和SiC之间的(TBC)限制了热传输,在理论计算和实验中产生了显著的误差。氮化镓可以在氮化铝中间层的辅助下生长在碳化硅衬底上,这对生长高质量的氮化镓薄膜至关重要。通常会出现位错密度等问题,使得界面热阻更加严重。除了分子束外延和金属有机化学气相沉积,晶圆键合技术是制造异质氮化镓/碳化硅结构的另一种可行方法。与薄膜生长和沉积相比,晶片键合具有许多优点,如对晶格失配不敏感、温度低、晶片级等。
为了在氮化镓和碳化硅之间实现可靠的键合,SAB方法被用于直接晶片键合[12]。与智能切割技术不同,激光剥离用于氮化镓薄膜转移。实验过程的示意图如图4a所示。氮化镓生长在蓝宝石晶片上,用作施主衬底。氮化镓/碳化硅键合后,248纳米激光照射在键合的晶片对上,使氮化镓和蓝宝石分离。键合晶片对和转移的氮化镓薄膜的光学图像分别显示在图4b和4c中。原子键合已经被TEM证实,键合界面只有3 nm,如图4d所示。这表明通过结合激光剥离工艺的SAB方法可以获得高质量的氮化镓/碳化硅异质结构。金刚石是热管理的另一种流行基底[120]。氮化镓薄膜也可以通过键合方法转移到金刚石衬底上[11]。代替无中间体的SAB方法,纳米尺度的无定形硅层被用于GaN/金刚石结合。在表面活化之前,硅被溅射到氮化镓和金刚石衬底上。随后的工艺与将氮化镓薄膜转移到碳化硅晶片上的工艺相同。
结论
基于薄压电带的柔性机械能采集器的最终分解图和俯视图如图5a所示。制造甲基汞复合结构的示意图如图5b所示。首先,通过互补金属氧化物半导体兼容工艺将具有金属电极的复合压电陶瓷沉积在硅上二氧化硅晶片上。器件结构也同时转移。其次,在晶圆表面旋涂光刻胶,防止器件结构被后续的氢氟酸溶液腐蚀。浸没处理后,沉积的具有光致抗蚀剂保护的PZT薄膜将与硅上二氧化硅晶片分离。最后,功能薄膜将被PDMS压印到植入式电子设备的聚酰亚胺基底上。基于这一过程和复合结构,已经提出了能够实现高效率的机械-电能转换的可植入装置。器件参数和结构如图5c所示。在弯曲处理的激励下,压电薄膜会产生响应变形的电信号。图5d和5e分别给出了在平坦和弯曲条件下夹持在弯曲台上的压电陶瓷的光学图像。由于聚酰亚胺具有良好的生物相容性,这种装置可用于生物体中的自供电植入装置[146]。图5f–h显示了右心室、左心室和牛心脏自由壁上的压电陶瓷的照片。不同的监控系统会产生不同的信号输出。它证明了PZT薄膜转移的有效性和依靠这种复合结构的生物相容性电子的可行性。

审核编辑:鄢梦凡
 电子发烧友App
电子发烧友App









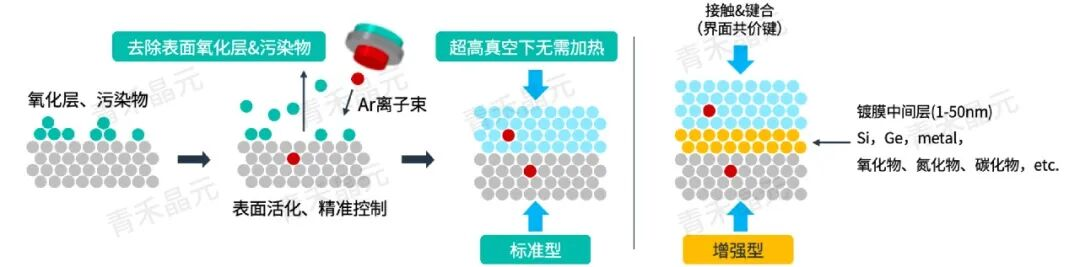


























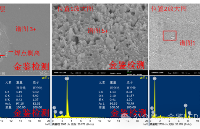
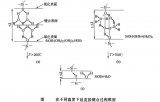

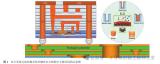
















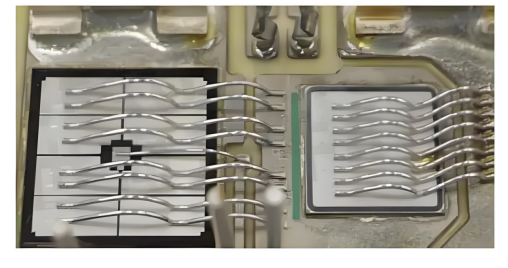
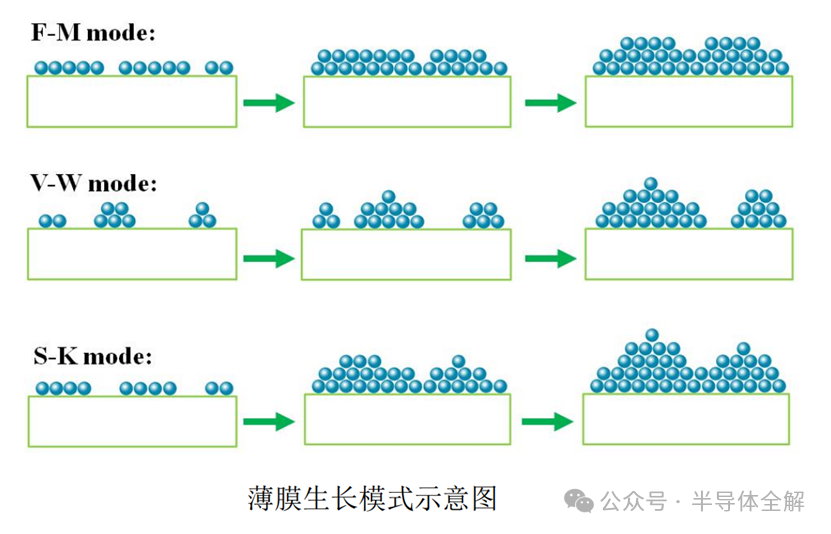












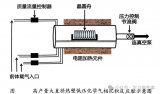

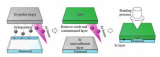






评论