来源:芯读者
一、什么是金属共晶键合
金属共晶键合是利用金属间的化学反应,在较低温度下通过低温相变而实现的键合,键合后的金属化合物熔点高于键合温度。该定义更侧重于从材料科学的角度定义。
思考:那么我们如何设计键合工艺呢?合金相图是核心,也就是要考虑温度、合金成分;第二点是,要么形成金属共晶,要么形成金属间化合物,这是金属键合的核心点。
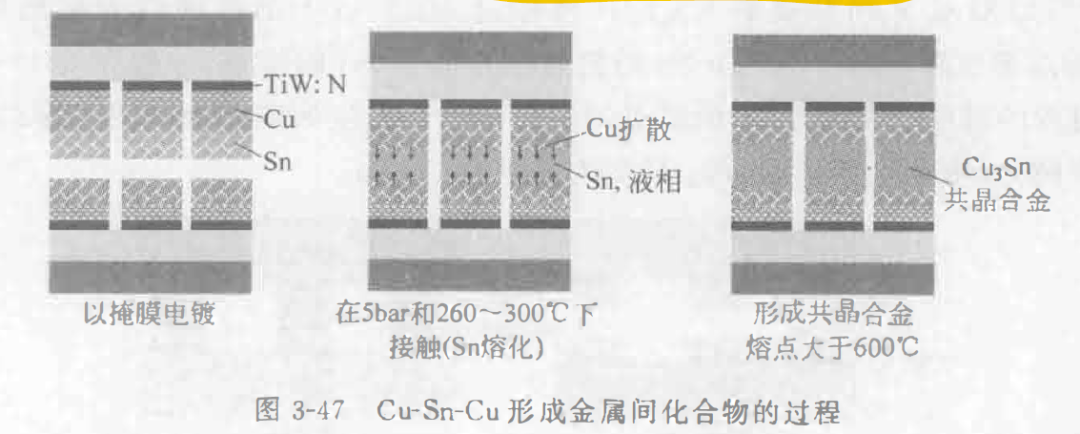
(图片来自,三维集成技术)
所以,基于以上思考,不难引出另外一种基于金属键合的晶圆键合方式,也就是固液间扩散法(Solid Liquid Inter Diffusion,SLID)。即利用低熔点金属熔化为液相,与高熔点金属扩散形成金属间化合物。
常见低熔点金属:Bi,271℃ Sn,231℃ In,156℃ (一般以400℃以下为低熔点)
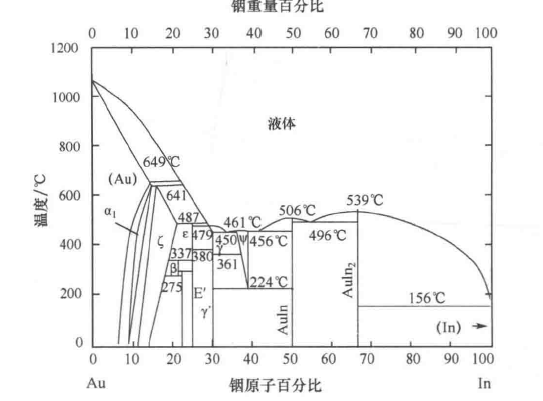
(图片,来源金属相图手册)
二、常见的共晶合金体系
Al/Si (88.7Al/11.3Si 共晶温度:577℃)
Si/Au(97.1Si/2.9Au 共晶温度:363℃)
Sn/Ag(95Sn/5Ag 共晶温度:221℃)
Au/Ge(88Au/12Ge 共晶温度:356℃)
Au/Sn(80Au/20Sn 共晶温度:280℃)
Pb/Sn(60Pb/40Sn 共晶温度:183℃)
合金相图,小编不再截图,参考我之前文章中附件中的,合金相图手册,自行下载。
三、共晶键合工艺
关于键合工艺的设计,在此小编仅仅从两种键合材料的设计来讨论这段loop的工艺。以Au-Sn合金体系键合为例。
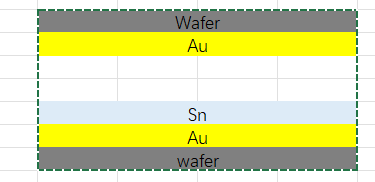
注意,此草图小编没有画氧化层以及种子层等,仅考虑键合层金属。
首先通过金属薄膜沉积,光刻,电镀定义且形成金属凸点结构,然后分别去除光刻胶与种子层,进行键合,回火。
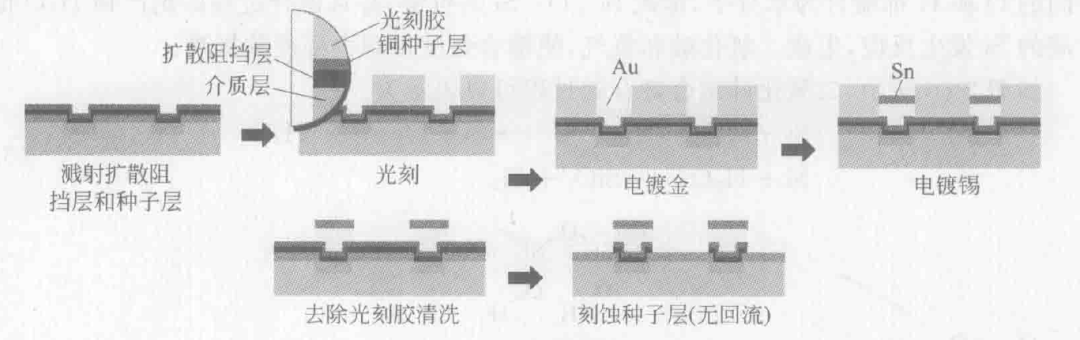
(图片来自,三维集成技术)
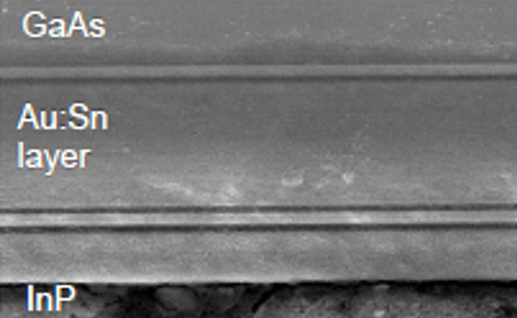
键合环节主要工艺参数:时间、温度、键合压力、键合气体环境
四、共晶键合注意事项
1.键合过程中除了施加一定压力温度外,一般还需要通入少量氢气与惰性气体。
2.键合过程形成共晶造成膜层体积减小,可能出现空洞或裂缝,可以通过温度,使低熔点金属充分熔化,同时适当增加压力保证键合界面充分接触。
3.金属共晶键合过程中,键合引起滑移较大,键合后对准精度较低。
-
晶圆
+关注
关注
53文章
5344浏览量
131653 -
工艺
+关注
关注
4文章
708浏览量
30105 -
键合
+关注
关注
0文章
87浏览量
8232
原文标题:金属共晶键合(晶圆级)
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
晶圆键合中使用的主要技术
EVG 已在全球范围建立超过 1100 个EVG 晶圆键合室
晶圆直接键合及室温键合技术研究进展

表面清洁工艺对硅片与晶圆键合的影响






 什么是金属共晶键合
什么是金属共晶键合



















评论