来源:学习那些事
引线键合技术的发展瓶颈
电气性能制约随着片外数据传输速率持续提升及键合节距不断缩小,引线键合技术暴露出电感与串扰两大核心问题。高频信号传输时,引线电感产生的感抗会阻碍信号快速通过,而相邻引线间的串扰则造成信号干扰,这些问题严重限制了其在高速电子系统中的应用场景。
高密度互连局限现代硅芯片集成度呈指数级增长,对互连密度提出更高要求。传统引线键合因物理结构限制,难以在有限空间内实现高密度布线,无法满足部分高端芯片对引脚数量与间距的严苛需求,成为芯片性能提升的关键瓶颈。例如,在高性能计算领域,随着数据处理量的爆发式增长,芯片需要集成更多的功能单元,这就要求更多的引脚来实现信号传输与电源供应。然而,传统引线键合技术在引脚数量扩展和间距缩小方面面临着物理极限,无法满足高端芯片日益增长的需求,严重制约了芯片性能的进一步提升。
功率承载能力不足当前芯片发展趋势呈现 “高功率、低电压、小节距” 特征:工作电压已降至 1V 甚至更低,而功率消耗却持续攀升。有预测显示,单颗高性能芯片未来电流需求将超 100A。若采用传统 25μm 线径的引线键合,需数百根引线并行分担电流,这对键合工艺精度、可靠性及空间布局均构成巨大挑战。
焊盘与阵列互连困境I/O 焊盘节距的不断缩短与外围焊盘数量激增,使得单排外围键合模式逼近技术极限。根据 ITRSP预测,在确保高键合良率与载流能力的前提下,单排键合最小节距约为 20-25μm。尽管现代自动键合机可实现深度超 4μm 的多排面阵列键合,但由此引入的串扰问题严重影响信号完整性,制约整体性能表现。长期来看,突破 I/O 互连限制需转向倒装芯片(如 C4、微焊球、导电聚合物等)或新型技术。
倒装芯片
1.焊球倒装
技术起源与定义焊球倒装技术(又称 C4,可控塌陷芯片连接;或 FC,倒装芯片)是目前替代引线键合的主流先进互连方案,由 IBM 于 20 世纪 60 年代中期首创。其核心原理是将芯片翻转,通过焊料凸点与基板直接互连,颠覆传统引线键合的 “垂直连接” 模式。
2.性能优势解析
电气性能卓越:单个互连引线电感低至 0.05-0.1nH,相较 25μm 线径引线的 1nH/m 电感值大幅降低,显著提升高频信号传输能力,同时有效抑制串扰与同步开关噪声。
封装密度领先:在密封陶瓷基板封装中,Si 芯片可实现 125μm(5mil)高度的紧密堆叠;采用环氧树脂底部填充的层压基板(如 PCB)时,芯片间隔约 0.5mm(20mil),为高密度集成提供可能。
散热与成本考量:焊料凸点可传导部分热量至封装体,但高运算速率器件产生的大量热量仍需从裸芯片背面(面朝上)导出。硅脂或聚合物散热方案虽成本较低,但需定制导热片 / 棒及昂贵封装体,且 I/O 焊盘需围绕植球芯片设计,导致前期投入高、量产成本难控。近年倒装芯片在 PCB 基板的应用中,通过底部填充聚合物缓解热膨胀系数(CTE)失配问题,降低封装成本,但散热能力有所折损。
工艺创新与优化:为进一步降本增效,业界探索新工艺:在现有 Al 焊盘周边采用热超声球形键合技术(省去引线)直接形成凸点,并结合导热聚合物或微球材料,简化流程的同时提升散热性能。
应用演进与趋势 :早期倒装芯片推广受阻,因需重新设计面阵列 I/O 焊盘,且传统封装难以适配。虽有程序可将外围焊盘转为面阵列格式,但此类过渡设计存在热传导效率低、串扰大等问题。随着移动电话等便携式终端对 “小体积、高频性能、高集成度” 的需求爆发,越来越多芯片直接采用原生面阵列倒装设计。当前该技术增速远超引线键合,长期来看有望成为多领域互连首选方案。
球凸点 / 柱凸点倒装技术
技术应用规模与优势:近年来,球凸点 / 柱凸点倒装技术的应用呈现迅猛增长态势。每年全球数十亿个声表面波(SAW)滤波器及数亿个集成电路(IC)都采用该技术实现互连。其核心竞争力在于工艺兼容性 —— 借助球形键合机,能够将金(Au)或铜(Cu)材质的倒装凸点,直接键合到按常规引线键合设计的现有晶圆或芯片上。这意味着无需对原有芯片布局进行大模修改,大幅降低了从传统引线键合向倒装工艺转型的成本与技术门槛。
设备与工艺配套发展:市场需求的激增促使自动键合设备制造商纷纷推出专用的球凸点键合机。此类设备具备强大的批量处理能力,可在整片晶圆上快速完成数万个凸点的键合作业。完成凸点键合的晶圆经切割后,即可进入芯片倒装环节,通常会采用导电环氧树脂或其他键合方法实现芯片与基板的连接。
载带自动键合(TAB)技术
1.技术原理与结构基础
TAB 技术诞生于 20 世纪 60 年代,其核心组件为矩形(带状、镀锡处理)的铜梁引线,这些引线通过聚酰亚胺等薄聚合物载带固定。行业标准中,载带宽度通常为 35mm。在实际工艺里,铜梁引线会通过焊接(合金化)的方式,与芯片外围预先植有金(Au)凸点的焊盘相连。不过需注意,无论是 TAB 还是引线键合技术,均难以适配倒装芯片的面阵列键合需求。下图为典型的TAB封装结构

2.多样化键合方式
凸点键合:可利用热超声工艺,将 TAB 引线与预植的球形或柱状凸点实现可靠连接;
无凸点键合:经改装的自动引线键合机,能直接将 TAB 引线键合到普通焊盘上(即无凸点 TAB 工艺)
激光焊接: 借助激光能量,可精准地将 TAB 引线焊接到凸点表面,进一步提升键合精度。
3.性能与成本特性
性能优势:矩形引线在高频环境下的阻抗低于传统圆引线;在早期(截至约1990 年),其可实现的键合节距比楔形、球形键合更小;双层金属结构的 TAB,相比引线键合,能进一步降低电感与串扰。
成本局限:TAB 载带材料本身价格高昂,且定制掩模成本不菲。芯片或封装焊盘位置哪怕出现微小变动,都需更换新的载带与掩模。此外,TAB 技术的间距通常较大,难以实现芯片叠放,散热多依赖裸芯片背面(倒装 - TAB 因引线短、电感低稍作例外,但仍需从芯片背面散热,不同于倒装芯片通过焊料凸点散热)。在大功率应用场景下,还需搭配昂贵的封装体。图示为较老的TAB载带(12mm和35mm)和焊接到基板上的TAB芯片照片。
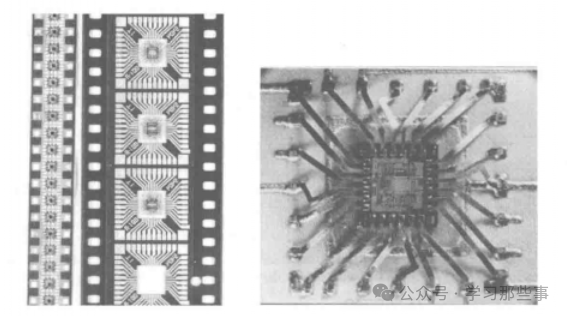
4.应用现状与趋势
在过去,TAB 技术在交付昂贵的系统级封装(SIP)或其他多芯片封装前,具备可测试性与芯片老练的显著优势。但随着已知良品裸芯片(KGD)及预测试芯片尺寸封装的广泛应用,这一优势正逐渐减弱。由于载带定制成本高且缺乏灵活性,TAB 已不再适用于主流芯片封装。不过,作为一项仍具经济效益的技术,TAB 仍在特定领域(如对成本敏感度低、对高频性能要求严苛的特殊芯片)持续寻找应用空间。
-
封装
+关注
关注
128文章
9320浏览量
149028 -
倒装芯片
+关注
关注
1文章
124浏览量
16868 -
引线键合
+关注
关注
2文章
38浏览量
8629
原文标题:引线键合替代技术
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
有偿求助本科毕业设计指导|引线键合|封装工艺
混合电路内引线键合可靠性研究
集成电路封装中的引线键合技术

LED引线键合工艺评价
引线键合工艺流程讲解
什么是引线键合?引线键合的演变

带你一文了解什么是引线键合(WireBonding)技术?

什么是引线键合?芯片引线键合保护胶用什么比较好?




 引线键合替代技术有哪些
引线键合替代技术有哪些

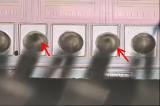







评论