文章来源:Jeff的芯片世界
原文作者:Jeff的芯片世界
本文介绍了芯片键合技术。
在半导体封装工艺中,芯片键合(Die Bonding)是指将晶圆芯片固定到封装基板上的关键步骤。键合工艺可分为传统方法和先进方法:传统方法包括芯片键合(Die Bonding)和引线键合(Wire Bonding),而先进方法主要指IBM在1960年代开发的倒装芯片键合(Flip Chip)。倒装芯片键合结合了模具键合和导线键合,通过在芯片衬垫上形成凸起来连接芯片和衬底。
芯片键合的重要性体现在多个方面:它提供机械支撑,使芯片牢固附着于封装载体,抵御外部震动和温度变化;它形成散热路径,将芯片工作时产生的热量传导到封装或散热层面;它确保精准定位,为后续电气互联(如焊线或倒装焊)奠定基础;从而提升器件的整体可靠性。如果贴装不当,可能导致后续工艺偏移或连接失败,影响器件性能。
主要键合方法
芯片键合的方法多样,主要包括胶黏剂贴片、焊料贴片、共晶贴片和倒装芯片贴片等。
胶黏剂贴片使用环氧树脂或银胶等半导体胶水进行粘接,优点包括工艺成熟、适用范围广,可在较低温度下固化;但如果胶水厚度不均,可能因热膨胀系数差异导致翘曲。
焊料贴片使用金属焊料(如Sn-Pb、Sn-Ag-Cu或Au-Sn合金)在高温下熔融,实现冶金连接,优点在于导电和导热性能优异,结构牢固,适合高功率器件;但工艺温度较高,需控制合金成分以避免空洞缺陷。
共晶贴片采用共晶焊料(如Au-Si、Au-Ge、Au-Sn等)在特定温度下熔化形成共晶组织,实现牢固结合,可靠性极佳,但需要精确温度控制且成本较高。
倒装芯片贴片是一种先进方法,芯片通过凸块翻转贴到基板上,通过回流焊实现电气和机械连接。严格来说,这更倾向于芯片互连工艺,但也可视为特殊贴装方式。
此外,模贴膜(DAF)作为一种先进粘合方法,被广泛使用。DAF是一种附着在芯片底部的薄膜,厚度可调整到更薄和恒定,不仅用于芯片与衬底的键合,还用于芯片与芯片的键合以创建多芯片封装(MCP)。使用DAF可以跳过点胶程序,避免胶水厚度不均问题,但需要高精度设备处理,且可能因空气穿透导致薄膜变形。
键合工艺流程
芯片键合的典型流程包括取放工艺、弹压和粘合步骤。首先,在取放工艺(Pick & Place)中,设备从附着在胶带上的芯片中单独取出芯片(称为“Pick”),然后将其放置在封装基板表面(称为“Place”)。这个过程可以通过输入晶圆测试结果(Go/No Go)对好的芯片进行分选。
由于芯片由弱粘性附着在胶带上,直接取放可能造成物理损伤,因此常使用弹射(Ejection)方法。弹射器对目标芯片施加物理力,使其与其他芯片产生轻微步长差异,然后从底部弹出芯片,同时用真空吸嘴从上面拉起,并用真空拉胶带底部使薄片平整。
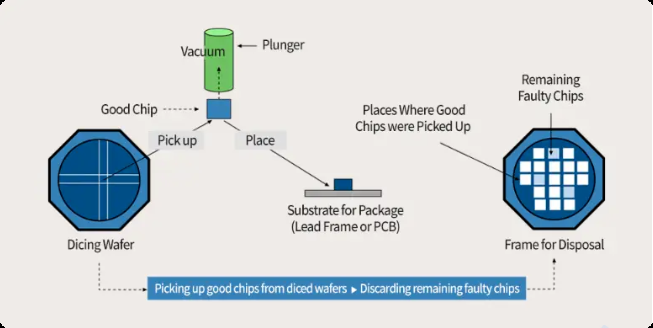
在粘合工艺中,如果使用环氧树脂,需通过点胶将少量环氧树脂精确涂在基板上,放置芯片后,在150°C至250°C下通过回流或固化硬化,将芯片和基材粘合。但环氧树脂厚度不恒定可能导致翘曲。因此,DAF方法成为首选:它将芯片和DAF从切丁带上取下后直接放置在基板上,无需点胶,简化工艺并提高厚度均匀性。
对于传统键合,首先在封装基板上涂布粘合剂,然后放上芯片(引脚朝上);对于倒装芯片键合,芯片引脚向下,焊料球凸起附着在衬垫上。组装后单元通过温度回流隧道,调节温度以熔化粘合剂或焊料球,然后冷却固定。
设备关键组成
Die Bonding设备由多个关键模块组成,确保高精度和自动化。晶圆工作台作为基础平台,承载并精确移动晶圆,保证芯片准确定位。芯片键合头是实现物理连接的关键部件,通过热压、超声波或激光等方式完成放置和焊接。框架传输系统负责芯片载体的自动传输与定位,提高生产效率。机器视觉系统利用高精度相机和图像处理算法进行定位识别和质量检测,是自动化生产不可或缺的部分。点胶系统在某些工艺中用于施加黏合剂或导电胶,控制胶量以保证键合效果。
此外,设备还包括供料和取片模块(如顶针或真空吸头从胶膜上取芯片)、对准系统(识别芯片和基板标记)、贴合头(施加压力、温度或时间)、基板承载与定位单元(固定和移动基板)、以及控制与软件系统(编排流程和监控参数)。
技术挑战与发展趋势
Die Bonding面临多项技术挑战。对准精度与速度需平衡,高精度要求微米级贴装,同时需要高吞吐量;材料兼容与热膨胀问题可能导致应力和形变;超薄芯片易弯曲或破裂,搬运方式需优化;空洞(Void)问题在焊料或胶水固化中可能降低接触面积和可靠性。
应对措施包括采用先进视觉系统和智能算法、优化贴片温度和曲线、使用柔性顶针和真空吸嘴、以及真空贴片或压力固化排除空气。
未来发展趋势包括多芯片异构封装,如系统级封装(SiP)、Chiplet和3D封装,要求设备具备多模块、多材料贴装能力;更高精度与自动化,结合AI视觉识别和精密运动控制;超薄与柔性器件贴装,向非接触传输和低应力方向发展;环保与低温贴装,发展低温熔点合金或UV固化工艺。
-
芯片
+关注
关注
463文章
54432浏览量
469386 -
晶圆
+关注
关注
53文章
5450浏览量
132762 -
键合
+关注
关注
0文章
107浏览量
8305
原文标题:Die Bonding技术介绍
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
介绍芯片键合(die bonding)工艺
MEMS工艺中的键合技术
热压键合工艺的技术原理和流程详解




 芯片键合工艺技术介绍
芯片键合工艺技术介绍













评论