文章来源:Jeff的芯片世界
原文作者:Jeff的芯片世界
本文介绍了热压键合(TCB)工艺的技术原理和流程。
热压键合(Thermal Compression Bonding,TCB)是一种先进的半导体封装工艺技术,通过同时施加热量和压力,将芯片与基板或其他材料紧密连接在一起。这种技术能够在微观层面上实现材料间的牢固连接,为半导体器件提供稳定可靠的电气和机械连接。
技术原理
热压键合的原理主要依赖于热和压力的共同作用。在键合过程中,芯片和基板的铜凸点首先进行对中,然后通过加热和施加压力,使凸点表面原子发生扩散,形成原子级的金属键合。由于电镀后的铜凸点表面粗糙且存在高度差,键合前需进行化学机械抛光等平坦化处理,以确保充分接触。

与传统的回流焊工艺相比,热压键合在控制芯片和基板翘曲方面具有显著优势。回流焊工艺中,芯片和基板的曲翘得不到有效控制,导致芯片与基板之间的距离变化大,容易引发虚焊和桥接等缺陷。而热压键合通过真空将基板和芯片分别束缚在平整的基座和键合头上,有效控制翘曲,使芯片间隙高度变化范围大幅缩小,提高了工艺稳定性和可靠性。
键合流程详解
热压键合的流程包含多个精密步骤,以最常见的TCCUF(热压键合与毛细管底部填充)为例,整个过程仅需1到5秒。基板被真空吸附在加热的基座上,温度设定在150°C到200°C之间;键合头同样加热并拾取芯片。通过相机系统进行精准对位,确保芯片与基板的凸点对齐。键合头以亚微米精度靠近基板,实时监测压力变化,一旦接触即切换至压力和位置共同控制模式。
随后,键合头迅速加热至300°C以上,使锡球熔融,并通过精确位置控制确保每个凸点键合,同时补偿热膨胀影响。最后快速冷却至锡球熔点以下完成键合。整个过程中,设备实时监控温度、应力和位移,要求亚微米级对准精度和快速温变控制,加热温度变化率可达100°C/s,冷却温度变化率约为-50°C/s。
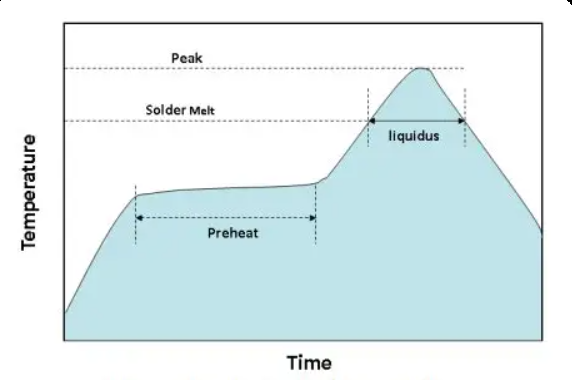
应用领域与技术优势
热压键合工艺具有高精度、高可靠性、灵活性和高效性等优势。它能够实现芯片与基板的精确对齐和原子级金属键合,形成牢固的电气和机械连接,承受更大的机械和热应力。该技术适用于多种材料和结构,如芯片到基板、芯片到晶圆等不同形式,并可与其他封装技术结合,提升整体封装效率。
在应用方面,该技术广泛应用于3D集成电路集成、倒装芯片键合和混合键合等领域。在3D IC中,它支持垂直芯片堆叠,提高集成度和性能;在倒装芯片中,能实现更小的焊料凸块,减少互连尺寸并改善电气性能;与混合键合结合时,可消除底部填充需求,直接金属接触,提升性能并缩小尺寸,适用于高性能计算和人工智能等前沿领域。
发展挑战与未来展望
热压键合技术面临成本高、技术挑战和市场竞争等问题。高精度设备和复杂工艺导致封装成本较高,同时需不断提升键合精度和可靠性以应对半导体技术发展。未来,通过技术创新、工艺优化、与其他封装技术融合以及拓展应用领域,如高性能计算和物联网,热压键合有望进一步推动半导体封装进步。
国产设备厂商已开始布局研发,但与国际先进水平仍有差距。随着HBM国产化进程推进,国内将迎来热压键合技术研究和设备开发的历史机遇,预计会有更多科研机构和半导体设备公司涌入这一赛道,为产业发展注入新动力。
-
集成电路
+关注
关注
5469文章
12759浏览量
376310 -
键合
+关注
关注
0文章
107浏览量
8314 -
倒装芯片
+关注
关注
1文章
124浏览量
16886
原文标题:TCB工艺介绍
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
倒装芯片的特点和工艺流程
芯片键合-真空热压键合机使用方法
TCB热压键合:打造高性能半导体封装的秘诀




 热压键合工艺的技术原理和流程详解
热压键合工艺的技术原理和流程详解













评论