电子发烧友网综合报道,据韩媒报道,三星近日与长江存储签署了3D NAND混合键合专利许可协议,从第10代V-NAND开始,将使用长江存储的专利技术,特别是在“混合键合”技术方面。
W2W技术是指将两片已经加工完毕的晶圆直接键合在一起。这项技术通过直接将两片晶圆贴合,省去了传统的凸点连接,从而缩短了电气路径,提高了性能和散热能力,同时优化了生产效率,是目前混合键合中最常用的技术。
据ZDNet报道,三星之前在NAND生产中使用COP(外围单元)方法,即将外围电路置于一个晶圆上,并将单元堆叠在上面。当层数超过400层时,底层外围电路的压力会显著增加,影响芯片的可靠性。
根据三星的计划,2025年下半年将量产下一代V10 NAND,预计堆叠层数将达到420至430层。因此引入W2W技术势在必行。
长江存储的混合键合技术命名为“晶栈(Xtacking)”,于四年前推出并用于3D NAND制造,同时进行了全面的专利布局。
据介绍,在晶栈Xtacking架构推出前,市场上的3D NAND主要分为传统并列式架构和CuA(CMOS under Array)架构。长江存储通过创新布局和缜密验证,经过长达9年在3D IC领域的技术积累和4年的研发验证后,终于将晶圆键合这一关键技术在3D NAND闪存上得以实现。


在指甲盖大小的面积上实现数十亿根金属通道的连接,合二为一成为一个整体,拥有与同一片晶圆上加工无异的优质可靠性表现,这项技术为未来3D NAND带来更多的技术优势和无限的发展可能。随着层数的不断增高,基于晶栈Xtacking所研发制造的3D NAND闪存将更具成本和创新优势。
晶栈Xtacking可实现在两片独立的晶圆上加工外围电路和存储单元,这样有利于选择更先进的逻辑工艺,从而让NAND获取更高的I/O接口速度及更多的操作功能。当两片晶圆各自完工后,创新的晶栈Xtacking技术只需一个处理步骤即可通过数十亿根垂直互联通道(VIA)将两片晶圆键合,合二为一。
在传统3DNAND架构中,外围电路约占芯片面积20~30%,晶栈®Xtacking技术创新的将外围电路置于存储单元之上,从而实现比传统3D NAND更高的存储密度,芯片面积可减少约25%。
晶栈Xtacking 技术充分利用存储单元和外围电路的独立加工优势,实现了并行的、模块化的产品设计及制造,产品开发时间可缩短三个月,生产周期可缩短20%。此外,这种模块化的方式也为引入NAND外围电路的创新功能以实现NAND闪存的定制化提供了可能。
在长江存储第三代系列产品中,晶栈 Xtacking已全面升级至2.0,进一步释放3D NAND闪存潜能。晶栈 Xtacking2.0充分利用架构优势为客户带来更多价值。其中包括:进一步提升闪存吞吐速率、提升系统级存储的综合性能、开启定制化闪存全新商业模式等。
根据TechInsights技术分析,致态TiPro9000固态硬盘(ZTSS3CB08B34MC)采用了长江存储的新型Xtacking4.x芯片。它由2yy 个有源层(除漏极选择栅极SGD外,总栅极数为 294层)组成,下层拥有 150 个栅极,而上层则有 144 个栅极。其TLC NAND 的位密度增至20Gbit/mm^2以上,这在业界尚属首次。
目前掌握3D NAND混合键合关键专利的公司包括美国的Xperi、中国的长江存储和中国台湾的台积电。Xperi是一家专利授权公司,台积电是一家半导体代工企业,而长江存储的“Xtaking”技术已经稳定量产,并演进到“4.x”版本。
外媒报道称,三星要开发下一代NAND几乎不可能规避长江存储的专利。同样的,SK海力士也在开发400层以上NAND产品,一旦用到混合键合技术或将不可避免地需要与长江存储签订专利授权协议。
闪存冲击400层+,混合键合技术传来消息
- 闪存(117113)
相关推荐
热点推荐
铝带键合点根部损伤研究
潘明东 朱悦 杨阳 徐一飞 陈益新 (长电科技宿迁股份公司) 摘要: 铝带键合作为粗铝线键合的延伸和发展,键合焊点根部损伤影响了该工艺的发展和推广,该文简述了铝带键合工艺过程,分析了导致铝带键合点
2024-11-01 11:08:07 3085
3085
 3085
3085
半导体晶片键合的对准方法
多年来,半导体晶片键合一直是人们感兴趣的课题。使用中间有机或无机粘合材料的晶片键合与传统的晶片键合技术相比具有许多优点,例如相对较低的键合温度、没有电压或电流、与标准互补金属氧化物半导体晶片的兼容性
2022-04-26 14:07:04 4575
4575
 4575
4575
晶圆键合中使用的主要技术
晶片键合是指通过一系列物理过程将两个或多个基板或晶片相互连接和化学过程。晶片键合用于各种技术,如MEMS器件制造,其中传感器组件封装在应用程序中。其他应用领域包括三维集成、先进的封装技术和CI制造业在晶圆键合中有两种主要的键合,临时键合和永久键合,两者都是在促进三维集成的技术中发挥着关键作用。
2022-07-21 17:27:43 3882
3882
 3882
3882铜线键合IMC生长分析
铜引线键合由于在价格、电导率和热导率等方面的优势有望取代传统的金引线键合, 然而 Cu/Al 引线键合界面的金属间化合物 (intermetallic compounds, IMC) 的过量生长将增大接触电阻和降低键合强度, 从而影响器件的性能和可靠性。
2025-03-01 15:00:09 2399
2399
 2399
2399
金丝键合的主要过程和关键参数
金丝键合主要依靠热超声键合技术来达成。热超声键合融合了热压键合与超声键合两者的长处。通常情况下,热压键合所需温度在300℃以上,而在引入超声作用后,热超声键合所需温度可降至200℃以下。如此一来
2025-03-12 15:28:38 3676
3676
 3676
3676
混合键合工艺介绍
所谓混合键合(hybrid bonding),指的是将两片以上不相同的Wafer或Die通过金属互连的混合键合工艺,来实现三维集成,在Hybrid Bonding前,2D,2.5D及3D封装都是采用
2025-06-03 11:35:24 2032
2032
 2032
2032
全球首台光学拆键合设备发布,和激光拆键合有什么不同?
晶圆与载板分离。 当前,激光拆键合是主要的拆键合技术发展方向。激光拆键合技术是将临时键合胶通过旋涂的方式涂在器件晶圆上,并配有激光响应层,当减薄、TSV加工和金属化等后面工艺完成之后,再通过激光扫描的方式,分离
2024-03-26 00:23:00 4381
4381
 4381
4381
3D NAND闪存来到290层,400层+不远了
V-NAND 1Tb TLC达290层,已开始量产。根据规划,2025年主流闪存厂商的产品都将进入300层+,甚至400层以上。至于远期,到2030年闪存有望突破1000层。 2024 年三星第9 代
2024-05-25 00:55:00 5554
5554
 5554
5554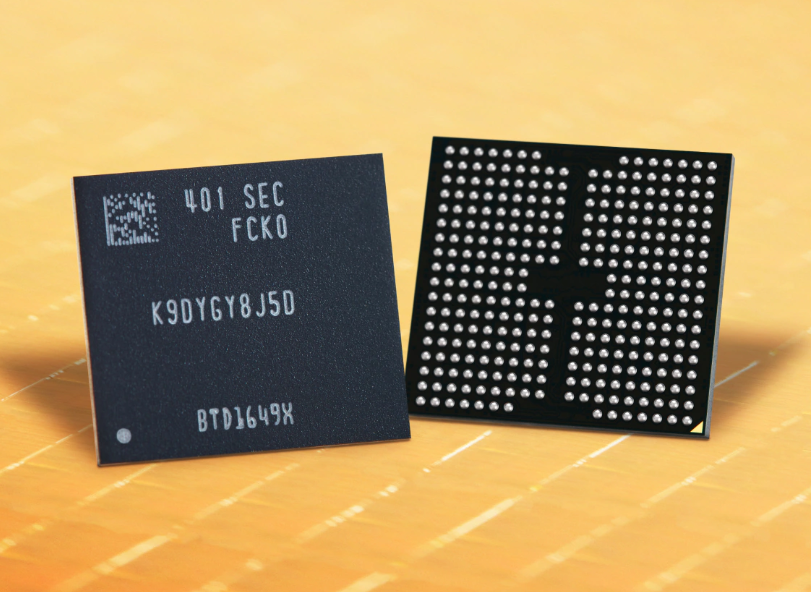
混合键合技术将最早用于HBM4E
客户对HBM的要求为增加带宽、提高功率效率、提高集成度。混合键合就是可以满足此类需求的技术。 混合键合技术预计不仅可应用于HBM,还可应用于3D DRAM和NAND Flash。SK海力士副总裁姜志浩(音译)表示,“目前的做法是分别创建DRAM单元区域和外围区域,
2025-04-17 00:05:00 1060
1060
 1060
1060混合键合市场空间巨大,这些设备有机会迎来爆发
电子发烧友综合报道 作为HBM和3D NAND的核心技术之一,混合键合在近期受到很多关注,相关设备厂商尤其是国产设备厂商的市场前景巨大。那么混合键合是什么? 混合键合是一种结合介电层键合和金
2025-06-03 09:02:18 2704
2704
 2704
2704从微米到纳米,铜-铜混合键合重塑3D封装技术格局
电子发烧友网综合报道 半导体封装技术正经历从传统平面架构向三维立体集成的革命性跃迁,其中铜 - 铜混合键合技术以其在互连密度、能效优化与异构集成方面的突破,成为推动 3D 封装发展的核心
2025-06-29 22:05:13 1519
1519
 1519
1519SiC功率器件的封装技术研究
。使用软焊可以消除应力,却要以热疲劳和低强度为代价,而硬焊具有高强度却无法消除应力。瞬态液相键合技术要求使用一个扩散势垒,以防止Si3N4衬底上的铜金属化层与用来键合SiC芯片的Au层之间的互扩散
2018-09-11 16:12:04
临时键合有人做过这个吗?
目前在做砷化镓和磷化铟,在研究bongder和debonder工艺, 主要是超薄片很难处理,so暂定临时键合解键合和薄片清洗流程,因为正面有保护可以做背面工艺,这里有前辈做过这个吗?
2018-12-17 13:55:06
有偿求助本科毕业设计指导|引线键合|封装工艺
任务要求:
了解微电子封装中的引线键合工艺,学习金丝引线键合原理,开发引线键合工艺仿真方法,通过数据统计分析和仿真结果,分析得出引线键合工序关键工艺参数和参数窗口,并给出工艺参数和键合质量之间的关系
2024-03-10 14:14:51
硅-直接键合技术的应用
硅-硅直接键合技术主要应用于SOI、MEMS和大功率器件,按照结构又可以分为两大类:一类是键合衬底材料,包括用于高频、抗辐射和VSIL的SOI衬底和用于大功率高压器件的类外延的疏水键合N+-N-或
2018-11-23 11:05:56
芯片封装键合技术各种微互连方式简介教程
芯片封装键合技术各种微互连方式简介微互连技术简介定义:将芯片凸点电极与载带的引线连接,经过切断、冲压等工艺封装而成。载带:即带状载体,是指带状绝缘薄膜上载有由覆 铜箔经蚀刻而形成的引线框架,而且芯片
2012-01-13 14:58:34
新型铜线键合技术
铜线以其良好的电器机械性能和低成本特点已在半导体分立器件的内引线键合工艺中得到广泛应用,但铜线的金属活性和延展性也在键合过程中容易带来新的失效问题,文中对这种
2009-03-07 10:30:57 16
16
 16
16阳极键合工艺进展及其在微传感器中的应用
分析了阳极键合技术的原理和当前阳极键合技术的研究进展,综述了微传感器对阳极键合的新需求,展望了阳极键合技术在传感器领域的应用前景。关键词:阳极键合; 传感器; 硅片
2009-07-18 09:37:49 27
27
 27
27混合电路内引线键合可靠性研究
摘要:本文简述了混合电路以及半导体器件内引线键合技术原理,分析了影响内引线键合系统质量的因素,重点分析了最常见的几种失效模式:键合强度下降、键合点脱落等,并提
2010-05-31 09:38:04 30
30
 30
30NAND闪存的自适应闪存映射层设计
NAND闪存的自适应闪存映射层设计
闪存存储器主要分为NAND和XOR两种类型,其中NAND型是专为数据存储设计。本文的闪存映射方法主要是针对NAND类型的
2010-05-20 09:26:23 1244
1244
 1244
1244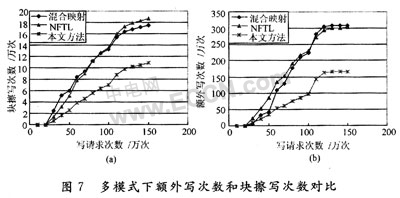
集成电路封装中的引线键合技术
在回顾现行的引线键合技术之后,本文主要探讨了集成电路封装中引线键合技术的发展趋势。球形焊接工艺比楔形焊接工艺具有更多的优势,因而获得了广泛使用。传统的前向拱丝越来越
2011-10-26 17:13:56 86
86
 86
86Ziptronix授权索尼DBI混合键合专利技术
美国北卡罗来纳州研究三角园消息—2015年3月28日—三维集成电路低温直接键合专利技术开发商和供应商Ziptronix公司今天宣布与索尼公司签署了一份用于高级图像传感器应用的专利许可协议。
2015-04-01 11:55:38 2817
2817
 2817
2817长江存储计划量产64层3D NAND闪存芯片 闪存市场将迎来一波冲击
国产存储芯片再下一城,日前有产业链方面的消息称,中国长江存储将如期在今年年底量产64层3D NAND闪存芯片,这对价格本就在不断下探的闪存市场无疑又将带来一波新的冲击。
2019-04-01 16:53:12 2056
2056
 2056
2056SK海力士全球首个量产128层堆叠4D闪存:冲击176层
SK海力士宣布,已经全球第一家研发成功,并批量生产128层堆叠的4D NAND闪存芯片,此时距离去年量产96层4D闪存只过去了八个月。
2019-06-27 15:23:28 3820
3820
 3820
3820长江存储宣布将跳过96层堆叠闪存技术直接投入128层闪存研发和量产
今年初,长江存储市场与销售资深副总裁龚翔曾公开表示,长江存储将跳过如今业界常见的96层堆叠闪存技术,直接投入128层闪存的研发和量产工作。
2020-04-08 16:38:21 1265
1265
 1265
1265阳极键合技术广泛应用于MEMS器件的制备过程中
1969年,美国的Wallis和Pomerantz两位研究人员首次提出了阳极键合技术,其键合方法如图1所示。阳极键合目前在硅片与玻璃键合中得到了较为广泛的应用,技术发展相对较为成熟。其基本原理如图2
2020-06-17 11:33:14 14919
14919
 14919
14919研发的铜混合键合工艺正推动下一代2.5D和3D封装技术
代工厂、设备供应商、研发机构等都在研发一种称之为铜混合键合(Hybrid bonding)工艺,这项技术正在推动下一代2.5D和3D封装技术。
2020-10-10 15:24:32 7955
7955
 7955
7955
银线二焊键合点剥离失效分析
银线二焊键合点剥离LED死灯的案子时常发生,大家通常争论是镀银层结合力差的问题,还是键合线工艺问题,而本案例,金鉴从百格实验和FIB截面观察的角度来判定为键合工艺导致。
2021-05-16 11:53:12 3593
3593
 3593
3593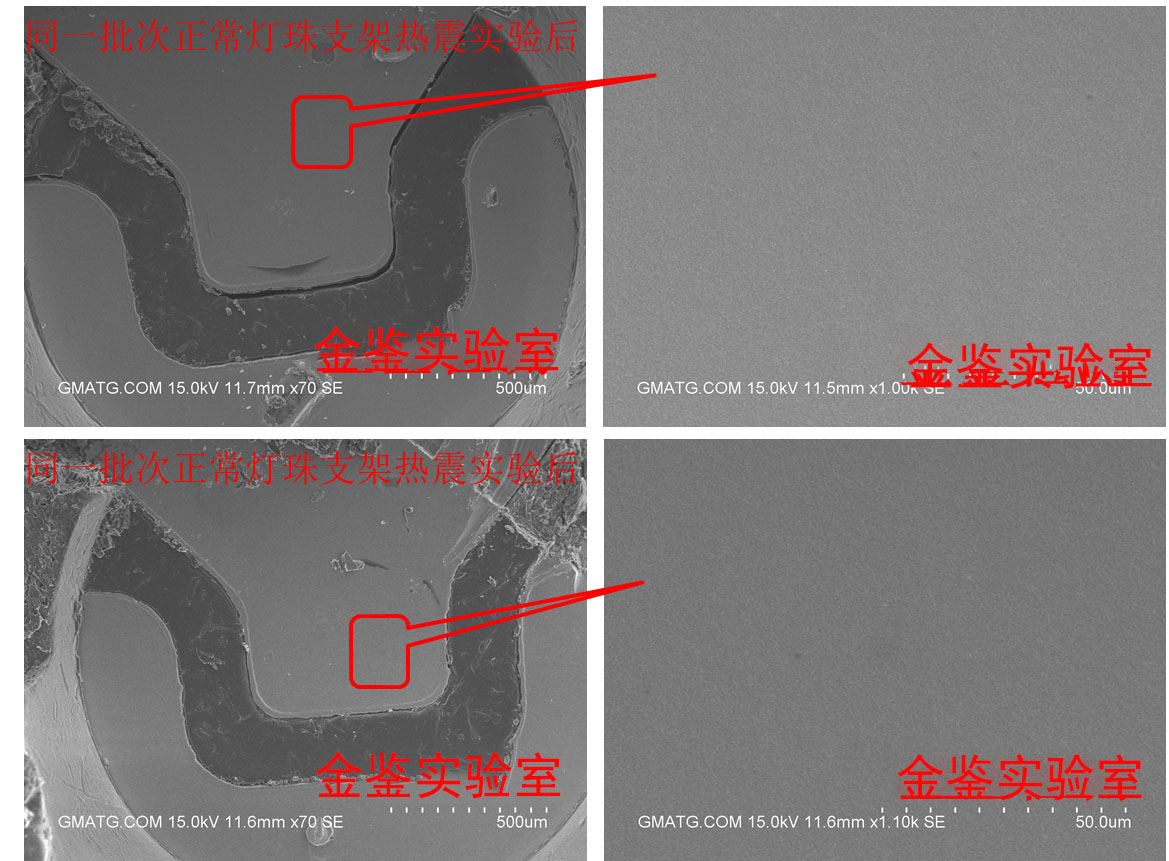
晶片键合技术和薄膜传输技术
结合离子注入工艺、激光照射和去除牺牲层,晶片键合技术是将高质量薄膜转移到不同衬底上的最有效方法之一。本文系统地总结和介绍了苏州华林科纳的晶片键合技术在电子、光学器件、片上集成中红外传感器和可穿戴传感器等领域的应用。依次介绍了基于智能剥离技术
2021-12-21 16:33:29 3325
3325
 3325
3325
三大引线材料、工艺助力陶瓷封装键合工艺
引线键合技术是一种固相键合方法,其基本原理是:在键合过程中,采用超声、加压和加热等方式破坏被焊接表面的氧化层和污染物,产生塑性变形,使得引线与被焊接面亲密接触,达到原子间的引力范围并导致界面间原子扩散而形成有效焊接。
2022-03-21 10:45:31 8016
8016
 8016
8016电镀创新实现超精细铟键合
)至关重要,混合集成是将来自不同技术的芯片组合成高性能模块的过程,例如激光雷达和其他成像应用中的混合像素探测器。曾经用于倒装芯片接合的锡焊料正在被包括铟在内的无铅替代品所取代。然而,使用传统方法制备对于形成键合必不可少的铟
2022-11-11 17:11:01 2050
2050
 2050
2050半导体封装:键合铜丝的性能优势与主要应用问题
为解决铜丝硬度大带来的键合难度,半导体封装企业通常选择应用超声工艺或键合压力工艺提升键合效果,这也导致焊接期间需要耗费更多的时间完成键合工作。
2022-12-15 15:44:46 4447
4447
 4447
4447陶瓷基板上自动键合各参数对键合形貌的影响研究
通过控制单一变量的试验方法,研究了金丝变形度、超声功率、超声时间和键合压力等参数对自动键合一致性和可靠性的影响,分析了每个参数对自动键合的影响规律,给出了自动键合参数的参考范围。
2023-02-01 17:37:31 2972
2972
 2972
2972极小焊盘的金丝键合方案
金丝键合质量的好坏受劈刀、键合参数、键合层镀金质量和金丝质量等因素的制约。传统热压键合、超声键合、热超声键合或楔形键合和球形键合分别在不同情况下可以得到最佳键合效果。工艺人员针对不同焊盘尺寸所制定
2023-02-07 15:00:25 6593
6593
 6593
6593铜混合键合的发展与应用
两片晶圆面对面键合时是铜金属对铜金属、介电值对介电质,两边键合介面的形状、位置完全相同,晶粒大小形状也必须一样。所以使用混合键合先进封装技术的次系统产品各成分元件必须从产品设计、线路设计时就开始共同协作。
2023-05-08 09:50:30 2600
2600
 2600
2600晶圆直接键合及室温键合技术研究进展
晶圆直接键合技术可以使经过抛光的半导体晶圆,在不使用粘结剂的情况下结合在一起,该技术在微电子制造、微机电系统封装、多功能芯片集成以及其他新兴领域具有广泛的应用。对于一些温度敏感器件或者热膨胀系数差异
2023-06-14 09:46:27 3533
3533
 3533
3533
表面清洁工艺对硅片与晶圆键合的影响
随着产业和消费升级,电子设备不断向小型化、智能化方向发展,对电子设备提出了更高的要求。可靠的封装技术可以有效提高器件的使用寿命。阳极键合技术是晶圆封装的有效手段,已广泛应用于电子器件行业。其优点是键合时间短、键合成本低。温度更高,键合效率更高,键合连接更可靠。
2023-09-13 10:37:36 1240
1240
 1240
1240
3D Cu-Cu混合键合技术的优点和未来发展
先进半导体封装的凸块技术已取得显着发展,以应对缩小接触间距和传统倒装芯片焊接相关限制带来的挑战。该领域的一项突出进步是 3D Cu-Cu 混合键合技术,它提供了一种变革性的解决方案。
2023-09-21 15:42:29 2585
2585
 2585
2585什么是引线键合?引线键合的演变
引线键合是在硅芯片上的 IC 与其封装之间创建互连的常用方法,其中将细线从器件上的键合焊盘连接到封装上的相应焊盘(即引线)。此连接建立了从芯片内部电路到连接到印刷电路板 (PCB) 的外部引脚的电气路径。
2023-10-24 11:32:13 3692
3692
 3692
3692
晶圆键合的种类和应用
晶圆键合技术是将两片不同结构/不同材质的晶圆,通过一定的物理方式结合的技术。晶圆键合技术已经大量应用于半导体器件封装、材料及器件堆叠等多种半导体应用领域。
2023-10-24 12:43:24 2895
2895
 2895
2895
什么是混合键合?为什么要使用混合键合?
要了解混合键合,需要了解先进封装行业的简要历史。当电子封装行业发展到三维封装时,微凸块通过使用芯片上的小铜凸块作为晶圆级封装的一种形式,在芯片之间提供垂直互连。凸块的尺寸范围很广,从 40 μm 间距到最终缩小到 20 μm 或 10 μm 间距。
2023-11-22 16:57:42 6765
6765
 6765
6765
晶圆键合设备及工艺
随着半导体产业的飞速发展,晶圆键合设备及工艺在微电子制造领域扮演着越来越重要的角色。晶圆键合技术是一种将两个或多个晶圆通过特定的工艺方法紧密地结合在一起的技术,以实现更高性能、更小型化的电子元器件。本文将详细介绍晶圆键合设备的结构、工作原理以及晶圆键合工艺的流程、特点和应用。
2023-12-27 10:56:38 3181
3181
 3181
3181
铝质焊盘的键合工艺
共读好书 姚友谊 吴琪 阳微 胡蓉 姚远建 (成都西科微波通讯有限公司) 摘要: 从铝质焊盘键合后易发生欠键合和过键合的故障现象着手,就铝焊盘上几种常见键合方式进行了探讨,得出键合的优先级为硅铝丝
2024-02-02 16:51:48 2915
2915
 2915
2915
金丝引线键合的影响因素探究
共读好书 刘凤华 中电科思仪科技股份有限公司 摘要: 键合对设备性能和人员技能的要求极高,属于关键控制工序,键合质量的好坏直接影响电路的可靠性。工艺人员需对键合的影响因素进行整体把控,有针对性地控制
2024-02-02 17:07:18 1762
1762
 1762
1762
人工智能推动混合键合技术
领域的领导企业Adeia战略副总裁Seung Kang博士表示,对计算能力的需求正在加速增长,需求将超过当前支撑当今高性能基础设施、平台和设备的芯片组技术的能力。 全球数字经济的各个垂直领域几乎都对人工智能的兴趣日益浓厚,预计将推动整个半导体行业对混合键合技术的需求激增。 Ga
2024-02-01 14:42:50 747
747
 747
747消息称三星正在整合混合键合技术
据业界消息人士透露,为了进一步提升其芯片代工能力,三星正全力推进混合键合技术的整合工作。据悉,应用材料公司和Besi Semiconductor已在三星的天安园区开始安装先进的混合键合设备,这些设备预计将用于三星的下一代封装解决方案,如X-Cube和SAINT。
2024-02-18 11:13:23 1266
1266
 1266
1266混合键合技术大揭秘:优点、应用与发展一网打尽
混合键合技术是近年来在微电子封装和先进制造领域引起广泛关注的一种新型连接技术。它通过结合不同键合方法的优点,实现了更高的封装密度、更强的机械性能和更好的热稳定性,为现代电子产品的微型化、高性能化提供了有力支持。
2024-02-18 10:06:19 4673
4673
 4673
4673
晶圆到晶圆混合键合:将互连间距突破400纳米
来源:IMEC Cu/SiCN键合技术的创新是由逻辑存储器堆叠需求驱动的 晶圆到晶圆混合键合的前景 3D集成是实现多芯片异构集成解决方案的关键技术,是业界对系统级更高功耗、性能、面积和成本收益需求
2024-02-21 11:35:29 1454
1454
 1454
1454
先进封装中铜-铜低温键合技术研究进展
用于先进封装领域的 Cu-Cu 低温键合技术进行了综述,首先从工艺流程、连接机理、性能表征等方面较系统地总结了热压工艺、混合键合工艺实现 Cu-Cu 低温键合的研究进展与存在问题,进一步地阐述了新型纳米材料烧结工艺在实现低温连接、降低工艺要求方面的优
2024-03-25 08:39:56 2316
2316
 2316
2316
混合键合能走多远?
推动了这项技术的发展,这项技术对尖端处理器和存储器至关重要。这项技术被称为混合键合,它将两个或多个芯片堆叠在同一封装中,使芯片制造商能够增加处理器和存储器中的晶体管数量,尽管曾经定义摩尔定律的传统晶体管
2024-06-18 16:57:51 2677
2677
 2677
2677三星与海力士引领DRAM革新:新一代HBM采用混合键合技术
内存(HBM)中采用先进的混合键合(Hybrid Bonding)技术,这一创新举措无疑将推动DRAM技术迈向新的高度。
2024-06-25 10:01:36 1486
1486
 1486
1486金丝键合强度测试仪试验方法:键合拉脱、引线拉力、键合剪切力
金丝键合强度测试仪是测量引线键合强度,评估键合强度分布或测定键合强度是否符合有关的订购文件的要求。键合强度试验机可应用于采用低温焊、热压焊、超声焊或有关技术键合的、具有内引线的器件封装内部的引线
2024-07-06 11:18:59 2228
2228
 2228
2228
SK海力士将在HBM生产中采用混合键合技术
在半导体技术日新月异的今天,SK海力士再次站在了行业创新的前沿。据最新消息,该公司计划于2026年在其高性能内存(High Bandwidth Memory, HBM)的生产过程中引入混合键合技术,这一举措不仅标志着SK海力士在封装技术上的重大突破,也预示着全球半导体行业将迎来新一轮的技术革新。
2024-07-17 09:58:19 1366
1366
 1366
1366SK海力士加速NAND研发,400+层闪存量产在即
韩国半导体巨头SK海力士正加速推进NAND闪存技术的革新,据韩媒最新报道,该公司计划于2025年末全面完成400+层堆叠NAND闪存的量产准备工作,并预计于次年第二季度正式开启大规模生产。这一举措标志着SK海力士在NAND闪存领域再次迈出坚实步伐,引领行业技术前沿。
2024-08-02 16:56:11 1743
1743
 1743
1743金丝键合工艺温度研究:揭秘键合质量的奥秘!
在微电子封装领域,金丝键合(Wire Bonding)工艺作为一种关键的电气互连技术,扮演着至关重要的角色。该工艺通过细金属线(主要是金丝)将芯片上的焊点与封装基板或另一芯片上的对应焊点连接起来
2024-08-16 10:50:14 4904
4904
 4904
4904
混合键合技术:开启3D芯片封装新篇章
在半导体制造领域,技术的每一次革新都标志着行业迈向新的里程碑。近年来,随着芯片性能需求的不断提升,传统的二维封装技术已难以满足日益增长的数据处理速度和功耗控制要求。在此背景下,混合键合(Hybrid
2024-08-26 10:41:54 2476
2476
 2476
2476
金刚石/GaN 异质外延与键合技术研究进展
,主要包括GaN 功率器件的器件层散热和衬底层散热。器件层散热主要有金刚石钝化散热技术,其在GaN 器件层中异质外延金刚石散热层;衬底层散热主要有键合技术、异质外延技术,其中键合技术通常需要在金刚石
2024-11-01 11:08:07 1751
1751
 1751
1751混合键合,成为“芯”宠
要求,传统互联技术如引线键合、倒装芯片键合和硅通孔(TSV)键合等,正逐步显露其局限。在这种背景下,混合键合技术以其革命性的互联潜力,正成为行业的新宠。
2024-10-18 17:54:54 1776
1776
 1776
1776
晶圆键合技术的类型有哪些
晶圆键合技术是一种先进的半导体制造工艺,它通过将两块或多块晶圆在一定的工艺条件下紧密结合,形成一个整体结构。这种技术广泛应用于微电子、光电子、MEMS(微机电系统)等领域,是实现高效封装和集成的重要步骤。晶圆键合技术不仅能够提高器件的性能和可靠性,还能满足市场对半导体器件集成度日益提高的需求。
2024-10-21 16:51:40 2454
2454
 2454
2454混合键合的基本原理和优势
混合键合(Hybrid Bonding)是半导体封装领域的新兴技术,能够实现高密度三维集成,无需传统的焊料凸点。本文探讨混合键合的基本原理、相比传统方法的优势,以及该领域的最新发展。
2024-10-30 09:54:51 4308
4308
 4308
4308
先进封装技术激战正酣:混合键合成新星,重塑芯片领域格局
随着摩尔定律的放缓与面临微缩物理极限,半导体巨擘越来越依赖先进封装技术推动性能的提升。随着封装技术从2D向2.5D、3D推进,芯片堆迭的连接技术也成为各家公司差异化与竞争力的展现。而“混合键合
2024-11-08 11:00:54 2152
2152
 2152
2152三维堆叠封装新突破:混合键合技术揭秘!
随着半导体技术的飞速发展,芯片的性能需求不断提升,传统的二维封装技术已难以满足日益增长的数据处理速度和功耗控制要求。在此背景下,混合键合(Hybrid Bonding)技术应运而生,并迅速成为三维
2024-11-13 13:01:32 3341
3341
 3341
3341
晶圆键合胶的键合与解键合方式
晶圆键合是十分重要的一步工艺,本文对其详细介绍。 什么是晶圆键合胶? 晶圆键合胶(wafer bonding adhesive)是一种用于
2024-11-14 17:04:44 3586
3586
 3586
3586
混合键合:开创半导体互联技术新纪元
功能?在众多关键技术中,晶圆键合技术虽然不像光刻技术那样广为人知,但它却默默地在我们的手机图像传感器、重力加速传感器、麦克风、4G和5G射频前端,以及部分NAND闪存中发挥着重要作用。那么,这一技术中的新兴领域——混合
2024-11-18 10:08:05 1976
1976
 1976
1976微流控多层键合技术
一、超声键合辅助的多层键合技术 基于微导能阵列的超声键合多层键合技术: 在超声键合微流控芯片多层键合研究中,有基于微导能阵列的聚碳酸酯微流控芯片超声键合技术。研究对比了大量键合方法,认为超声键合方式
2024-11-19 13:58:00 1070
1070
 1070
1070
芯片倒装与线键合相比有哪些优势
线键合与倒装芯片作为封装技术中两大重要的连接技术,各自承载着不同的使命与优势。那么,芯片倒装(Flip Chip)相对于传统线键合(Wire Bonding)究竟有哪些优势呢?倒装芯片在封装技术演进
2024-11-21 10:05:15 2313
2313
 2313
2313
从发展历史、研究进展和前景预测三个方面对混合键合(HB)技术进行分析
摘要: 随着半导体技术的发展,传统倒装焊( FC) 键合已难以满足高密度、高可靠性的三维( 3D) 互连技术的需求。混合键合( HB) 技术是一种先进的3D 堆叠封装技术,可以实现焊盘直径≤1 μm
2024-11-22 11:14:46 4487
4487
 4487
4487
带你一文了解什么是引线键合(WireBonding)技术?
微电子封装中的引线键合技术引线键合技术在微电子封装领域扮演着至关重要的角色,它通过金属线将半导体芯片与外部电路相连,实现电气互连和信息传递。在理想条件下,金属引线与基板之间的连接可以达到原子级别的键
2024-12-24 11:32:04 2832
2832
 2832
2832
微流控芯片键合技术
微流控芯片键合技术的重要性 微流控芯片的键合技术是实现其功能的关键步骤之一,特别是在密封技术方面。键合技术的选择直接影响到微流控芯片的整体性能和可靠性。 不同材料的键合方式 玻璃材料:通常通过热键合
2024-12-30 13:56:31 1248
1248
 1248
1248引线键合的基础知识
引线键合 引线键合,又称压焊,是半导体封装工艺中的关键环节,对封装的可靠性和最终产品的测试良率具有决定性影响。 以下是对引线键合的分述: 引线键合概述 引线键合设备 引线键合方法 1 引线键合概述
2025-01-02 10:18:01 2679
2679
 2679
2679
混合键合中的铜连接:或成摩尔定律救星
混合键合3D芯片技术将拯救摩尔定律。 为了继续缩小电路尺寸,芯片制造商正在争夺每一纳米的空间。但在未来5年里,一项涉及几百乃至几千纳米的更大尺度的技术可能同样重要。 这项技术被称为“混合键合”,可以
2025-02-09 09:21:43 1230
1230
 1230
1230
什么是金属共晶键合
金属共晶键合是利用金属间的化学反应,在较低温度下通过低温相变而实现的键合,键合后的金属化合物熔点高于键合温度。该定义更侧重于从材料科学的角度定义。
2025-03-04 14:14:41 1922
1922
 1922
1922
一文详解共晶键合技术
键合技术主要分为直接键合和带有中间层的键合。直接键合如硅硅键合,阳极键合等键合条件高,如高温、高压等。而带有中间层的键合,所需的温度更低,压力也更小。带金属的中间层键合技术主要包括共晶键合、焊料键合、热压键合和反应键合等。本文主要对共晶键合进行介绍。
2025-03-04 17:10:52 2636
2636
 2636
2636
芯片封装键合技术工艺流程以及优缺点介绍
为邦定。 目前主要有四种键合技术:传统而可靠的引线键合(Wire Bonding)、性能优异的倒装芯片(Flip Chip)、自动化程度高的载带自动键合(TAB, Tape Automated Bonding),以及代表未来趋势的混合键合(Hybrid Bonding)技术。本文将简要介绍这四种键合
2025-03-22 09:45:31 5450
5450
 5450
5450
面向临时键合/解键TBDB的ERS光子解键合技术
,半导体制造商倾向于采用厚度小于 100 μm的薄晶圆。然而,晶圆越薄就越容易破损,为此,行业开发了各种临时键合和解键 (TBDB) 技术,利用专用键合胶将器件晶圆临时固定在刚性载板上,以提升制造过程的稳定性和良率。 现有解键方法的局限
2025-03-28 20:13:59 790
790
 790
790芯片封装中的四种键合方式:技术演进与产业应用
自动键合和混合键合四种主流技术,它们在工艺流程、技术特点和应用场景上各具优势。本文将深入剖析这四种键合方式的技术原理、发展现状及未来趋势,为产业界提供技术参考。
2025-04-11 14:02:25 2633
2633
 2633
2633
引线键合替代技术有哪些
电气性能制约随着片外数据传输速率持续提升及键合节距不断缩小,引线键合技术暴露出电感与串扰两大核心问题。高频信号传输时,引线电感产生的感抗会阻碍信号快速通过,而相邻引线间的串扰则造成信号干扰,这些问题严重限制了其在高速电子系统中的应用场景。
2025-04-23 11:48:35 867
867
 867
867
银线二焊键合点剥离失效原因:镀银层结合力差VS银线键合工艺待优化!
银线二焊键合点剥离LED死灯的案子时常发生,大家通常争论是镀银层结合力差的问题,还是键合线工艺问题,而本案例,客户在贴片完后出现死灯,金鉴接到客诉后立即进行了初步分析,死灯现象为支架镀银层脱落导致
2025-06-25 15:43:48 744
744
 744
744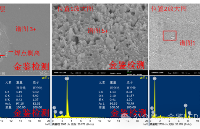
混合键合(Hybrid Bonding)工艺介绍
所谓混合键合(hybrid bonding),指的是将两片以上不相同的Wafer或Die通过金属互连的混合键合工艺,来实现三维集成,在Hybrid Bonding前,2D,2.5D及3D封装都是采用
2025-07-10 11:12:17 2722
2722
 2722
2722
LG电子重兵布局混合键合设备研发,锁定2028年大规模量产目标
近日,LG 电子宣布正式启动混合键合设备的开发项目,目标在 2028 年实现该设备的大规模量产,这一举措标志着 LG 电子在半导体先进封装领域迈出了重要一步。混合键合技术作为半导体制造中的前沿工艺
2025-07-15 17:48:02 530
530
 530
530铝丝键合的具体步骤
铝丝键合常借助超声楔焊技术,通过超声能量实现铝丝与焊盘的直接键合。由于键合所用劈刀工具头为楔形,使得键合点两端同样呈楔形,因而该技术也被叫做楔形压焊。超声焊工艺较为复杂,键合劈刀的运动、线夹动作
2025-07-16 16:58:24 1461
1461
 1461
1461突破堆叠瓶颈:三星电子拟于16层HBM导入混合键合技术
成为了全球存储芯片巨头们角逐的焦点。三星电子作为行业的领军企业,一直致力于推动 HBM 技术的革新。近日有消息传出,三星电子准备从 16 层 HBM 开始引入混合键合技术,这一举措无疑将在存储芯片领域掀起新的波澜。 编辑 编辑 技术背景:HBM 发展的必然趋
2025-07-24 17:31:16 632
632
 632
632
3D集成赛道加速!混合键合技术开启晶体管万亿时代
当传统制程微缩逼近物理极限,芯片巨头们正在另一条赛道加速冲刺——垂直方向。Counterpoint Research最新报告指出,混合键合(Hybrid Bonding) 技术已成为实现“单颗芯片
2025-07-28 16:32:54 384
384
 384
384芯片制造中的键合技术详解
键合技术是通过温度、压力等外部条件调控材料表面分子间作用力或化学键,实现不同材料(如硅-硅、硅-玻璃)原子级结合的核心工艺,起源于MEMS领域并随SOI制造、三维集成需求发展,涵盖直接键合(如SiO
2025-08-01 09:25:59 1772
1772
 1772
1772
白光扫描干涉法在先进半导体封装混合键合表面测量中的应用研究
随着半导体器件特征尺寸不断缩小,三维(3D)封装技术已成为延续摩尔定律的重要途径。铜-介质混合键合(HybridBonding)通过直接连接铜互连与介电层,实现了高密度、低功耗的异质集成。然而
2025-08-05 17:48:53 865
865
 865
865
详解先进封装中的混合键合技术
在先进封装中, Hybrid bonding( 混合键合)不仅可以增加I/O密度,提高信号完整性,还可以实现低功耗、高带宽的异构集成。它是主要3D封装平台(如台积电的SoIC、三星的X-Cube
2025-09-17 16:05:36 1475
1475
 1475
1475
芯片键合工艺技术介绍
在半导体封装工艺中,芯片键合(Die Bonding)是指将晶圆芯片固定到封装基板上的关键步骤。键合工艺可分为传统方法和先进方法:传统方法包括芯片键合(Die Bonding)和引线键合(Wire
2025-10-21 17:36:16 2064
2064
 2064
2064
电子元器件失效分析之金铝键合
电子元器件封装中的引线键合工艺,是实现芯片与外部世界连接的关键技术。其中,金铝键合因其应用广泛、工艺简单和成本低廉等优势,成为集成电路产品中常见的键合形式。金铝键合失效这种现象虽不为人所熟知,却是
2025-10-24 12:20:57 444
444
 444
444
 电子发烧友App
电子发烧友App

















评论