文章来源:芯学知
原文作者:芯启未来
本文介绍带金属的中间键合技术
键合技术主要分为直接键合和带有中间层的键合。直接键合如硅硅键合,阳极键合等键合条件高,如高温、高压等。而带有中间层的键合,所需的温度更低,压力也更小。带金属的中间层键合技术主要包括共晶键合、焊料键合、热压键合和反应键合等。本文主要对共晶键合进行介绍。
共晶键合,又称共晶焊接,指两种或两种以上金属层,在一定的温度下直接从固体转化成液态,通过金属的再结晶在键合面形成共晶相的键合工艺。共晶键合优势是键合过程的温度比直接键合低,也比单层金属的熔点低很多;同时键合过程中出气量很低,可以实现高真空零级封装;另外,由于共晶键合是液相键合,因此对键合面的平整度、划痕和颗粒都不敏感,利于保证键合良率和批量生产。

图 Al-Ge键合示意图
常用的共晶键合材料体系包括Au-Si,Au-Ge,Al-Ge,Au-Sn和Au-In等。Au-Si和Au-Ge体系的键合温度约400°C,Al-Ge 体系的键合温度约420°C,Au-Sn体系的键合温度约300°C, Au-Sn体系的键合温度约180°C。为实现高真空度封装,MEMS陀螺仪多采用Al-Ge、Au-Si的共晶键合技术。为实现低温键合封装,在光学MEMS器件,如MEMS微镜和VCSEL中采用Au-In的共晶键合。
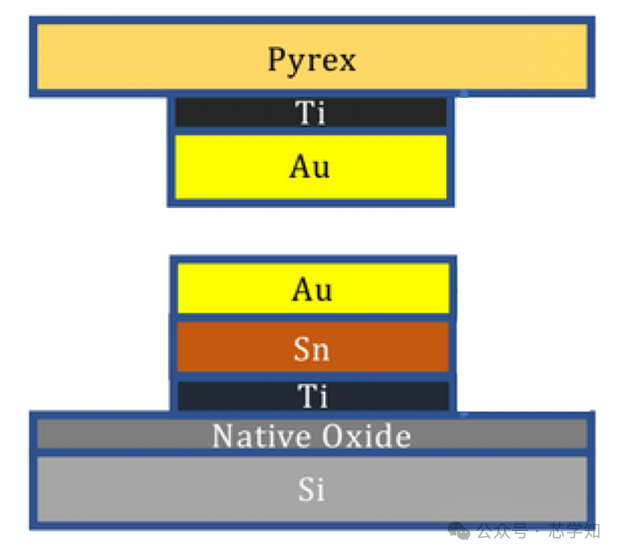
图 Au-Sn键合示意图
共晶键合需要在2片晶圆的键合面制作金属层,制作方法包括溅射和丝印等。Al-Ge键合分别在2个键合面采用磁控溅射镀Al和Ge膜,采用刻蚀或剥离的方法进行键合区域的图形化。根据实际的要求和衬底的情况,决定是否预先制作1μm厚度的UBM(Under Bump Metallization)作为黏附层。Al和Ge膜的厚度通常低于1μm,经过高温,键合界面上的金属形成互溶液相,形成共晶结构,完成键合。
Au-Sn共晶键合通常采用在一片待键合的晶片键合面通过物理气相沉积的方法制备叠层的Au-Sn层,另一片键合的晶片键合面通过物理气相沉积的方法制备Au层,Au和Sn的厚度比例决定了金属间化合物的成分,金属间化合物的特性决定了键合的质量。常用的厚度比例是Au:Sn=8:2。
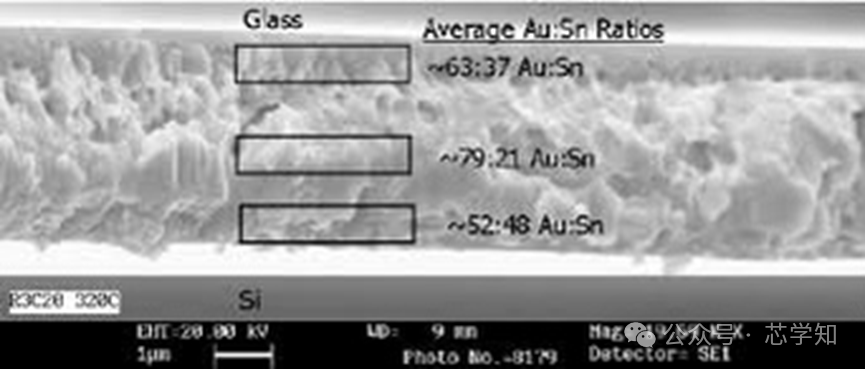
图 键合中间层Au-Sn比例
-
mems
+关注
关注
129文章
4369浏览量
197648 -
工艺
+关注
关注
4文章
708浏览量
30105 -
焊接
+关注
关注
38文章
3507浏览量
62737 -
键合
+关注
关注
0文章
87浏览量
8232
原文标题:带金属的中间键合技术如何实现?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
晶圆键合中使用的主要技术
带你一文了解什么是引线键合(WireBonding)技术?






 一文详解共晶键合技术
一文详解共晶键合技术




















评论