【博主简介】本人“爱在七夕时”,系一名半导体行业质量管理从业者,旨在业余时间不定期的分享半导体行业中的:产品质量、失效分析、可靠性分析和产品基础应用等相关知识。常言:真知不问出处,所分享的内容如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习!
键合工艺发展经历了从引线键合到混合键合的过程。从上世纪70年代起,其发展历程涵盖了引线键合、倒装、热压贴合、扇出型封装和混合键合,连接方式从最初的引线键合到锡球再到铜 - 铜键合,单位面积连接密度提高了超过2000倍。
引线键合(Wire Bonding)是一种常见的封装技术。它通过加热、加压、超声波能量等方式将金属引线与基板焊盘紧密焊合,实现芯片与基板间的电气互连和芯片间的信息互通。

现有的用于引线键合工艺的金属引线主要有金线、铝线和铜线,这几种金属引线各有优劣。比如金线具有导电性好,耐腐蚀能力强等特点,但是金线的成本高。铝线的成本低廉,但是其容易腐蚀,且很容易断裂,所以常用在一些相对低端的封装中。铜线价格也比较便宜,而且现有的芯片金属布线大多采用铜布线,因此采用铜线键合能更好地与芯片工艺兼容。但铜线的硬度太高,键合过程中容易产生裂纹甚至剥落现象。

而随着半导体技术的飞速发展,集成电路封装的高密度、高强度、低成本要求日益增长。在这一背景下,铜丝键合技术因其成本效益和优异的物理性能,逐渐成为金丝键合的有力替代品。铜丝不仅价格低廉,而且具有更高的机械强度、更低的电阻率以及更慢的铜铝金属间化合物(IMC)生长速度,这些特性使得铜丝在高密度封装中展现出独特的优势。
然而,铜丝键合技术在实际应用中也面临着一系列挑战。铜丝易氧化、硬度高,这些特性在键合过程中可能导致芯片损伤、氧化层形成等问题,影响键合的质量和可靠性。此外,铜丝在封装后还可能受到塑封材料中卤化物的腐蚀,进一步增加了失效风险。
所以,根据采用的金属引线的材质不同,键合工艺也有差异。比如金线普遍采用热超声键合,且采用球形键合,即将键合引线垂直插入毛细管劈刀的工具中,引线端部受热熔成球状,在劈刀的引导下接触晶片的键合区,加压后,使金球和焊盘金属焊接在一起,然后劈刀提起,沿着预定的轨道移动,到达第二个键合点时,利用压力和超声能量形成月牙式焊点,劈刀垂直运动截断金属丝的尾部,键合过程完成。铝丝键合则较多地采用楔形引线键合法,将金属丝穿入楔形劈刀背面的一个小孔,通过移动劈刀将金属丝压在焊区表面,采用超声或热声焊实现前一个焊点的键合,随后劈刀上升并移动到第二个键合点时,再次利用压力和超声能量形成第二个键合焊点,劈刀垂直向下运动截断金属丝的尾部,完成键合。
引线键合主要分为两种形式:球形键合(Ball Bonding)和楔形键合(Wedge Bonding)。这两种技术都涉及三个基本步骤:在芯片上形成第一焊点、形成线弧、以及在引线框架或基板上形成第二焊点。它们的主要区别在于第一焊点的形成方式:球形键合在每次焊接开始时会形成一个焊球,然后将其焊接到焊盘上;而楔形键合则是直接将引线焊接到芯片焊盘上。

一、楔形键合(Wedge Bonding)工艺的介绍
楔形键合,英文全称:Wedge Bonding,此工艺其实是半导体超声热压键合的一种基本工艺技术。该技术利用超声波发生器产生的高频振动,使键合设备的铆钉在水平方向上产生弹性振动,同时施加向下的压力。这种振动和压力共同作用,使铆钉带动引线在被焊件金属表面快速摩擦,从而在焊接区造成塑性变形,并去除金属表面的氧化层。引线与键合区因此得以紧密接触,完成焊接。超声波楔键合工艺两端的键合点一般呈楔形,这种形状有助于增强键合的牢固度和稳定性。

二、楔形键合(Wedge Bonding)工艺的原理
楔形键合通过楔形劈刀传递热能、压力和超声能量给金属线,形成焊接。这种焊接过程中不形成焊球。在劈刀压力和超声作用下,金属线与焊盘金属接触形成连接。楔形键合是单向焊接工艺,第二焊点需与第一焊点对齐。旋转式楔形劈刀可适应不同角度的焊线。楔形键合通常用于室温下的铝线超声波键合,成本和温度较低。由于焊点小,适合微波和大功率器件的封装。
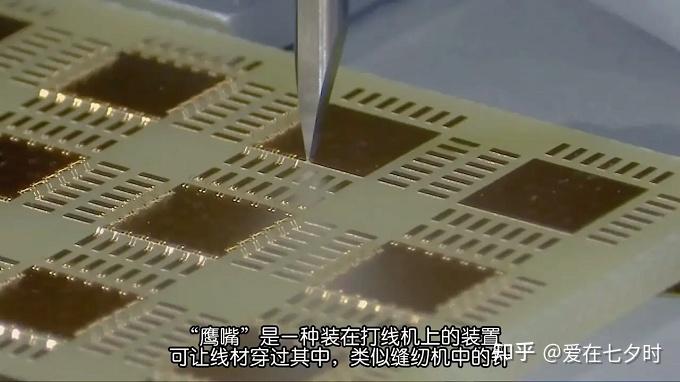
楔形键合是用楔形劈刀将热、压力、超声传给金属线,在一定时间形成焊接,焊接过程中不出现焊球。在劈刀的压力和超声波能量的作用下,金属线和焊盘金属的纯净表面接触并最终形成连接。楔形键合是一种单一方向焊接工艺(即第二焊点必须对准第一焊点的方向)。传统的楔形键合仅仅能在线的平行方向上形成焊点,旋转的楔形劈刀能使楔形键合机适合不同角度的焊线,在完成引线操作后移动到第二焊点之前劈刀旋转到程序规定的角度。常见楔形键合工艺是室温下的铝线超声波键合,其成本和键合温度较低。由于楔形键合形成的焊点小于球形键合,特别适用于微波器件,尤其是大功率器件的封装。
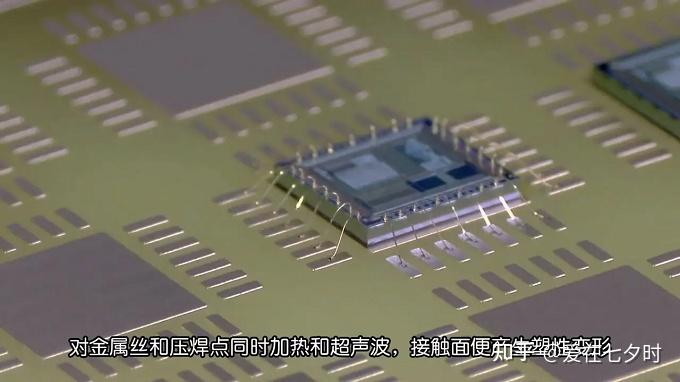
三、楔形键合(Wedge Bonding)工艺流程
因为楔形键合是通过加压和加热的方式,使金属引线与焊区接触面的原子之间达到原子引力范围,从而实现键合。这种方法的具体过程如下:
1、准备金属引线
金属引线的一端成球形,另一端成楔形。
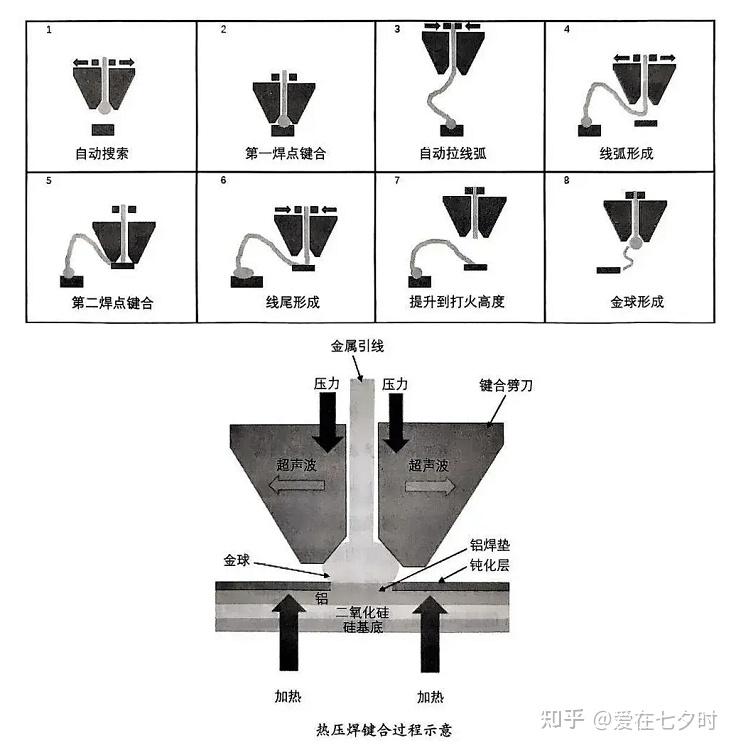
2、键合过程
键合头将金球下压在已预热到150~250℃的第一焊点,进行球形键合。在键合时,金球因受压力而略微变形,以增加键合面积、降低键合面粗糙度对键合的影响,并穿破金属表面氧化层等阻碍键合的因素,形成紧密的键合。

3、焊点形状
热压焊键合完成后,会形成两个焊点,第一焊点呈球形,第二焊点即金属引线键合结束时的焊点,呈楔形。
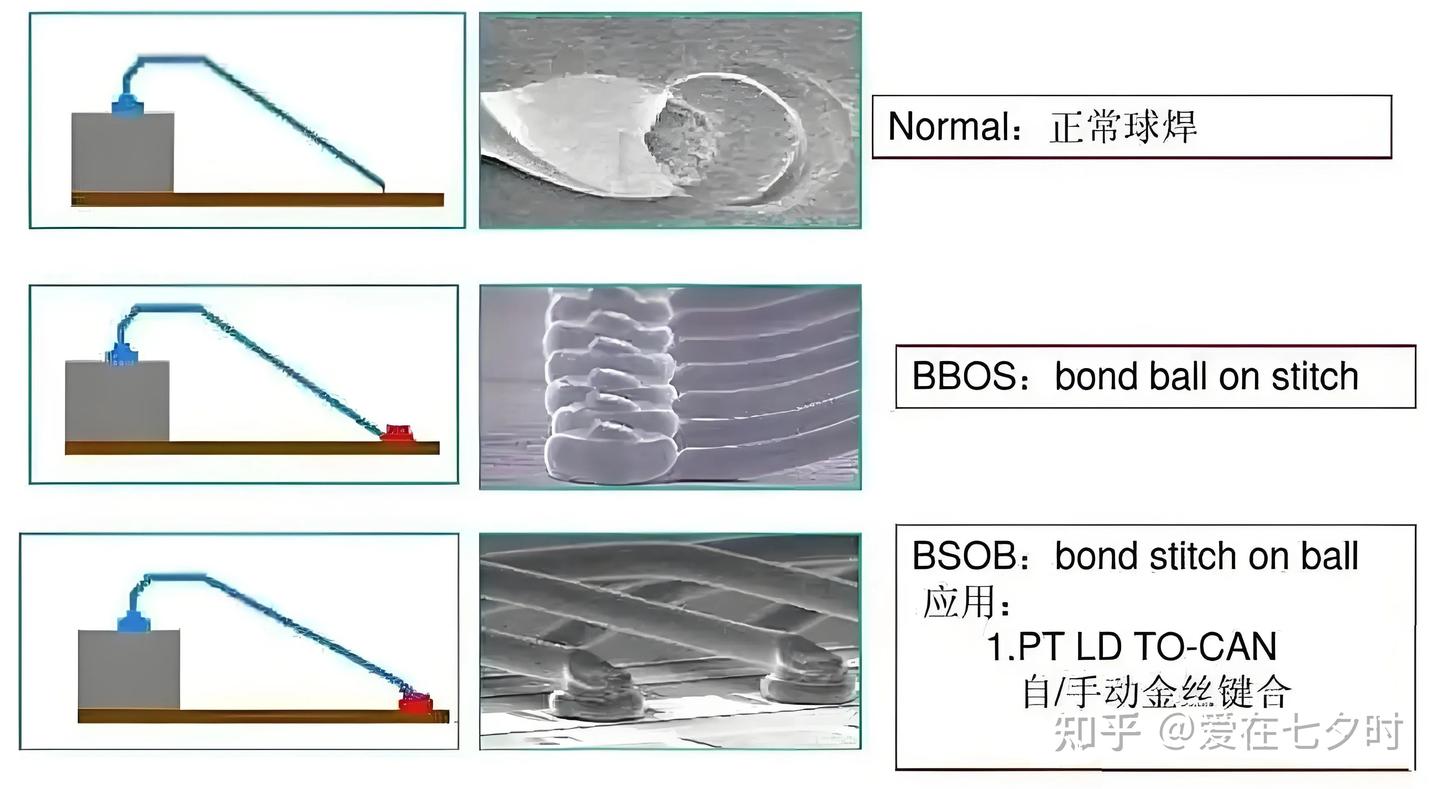
四、楔形键合(Wedge Bonding)工艺技术的重点介绍




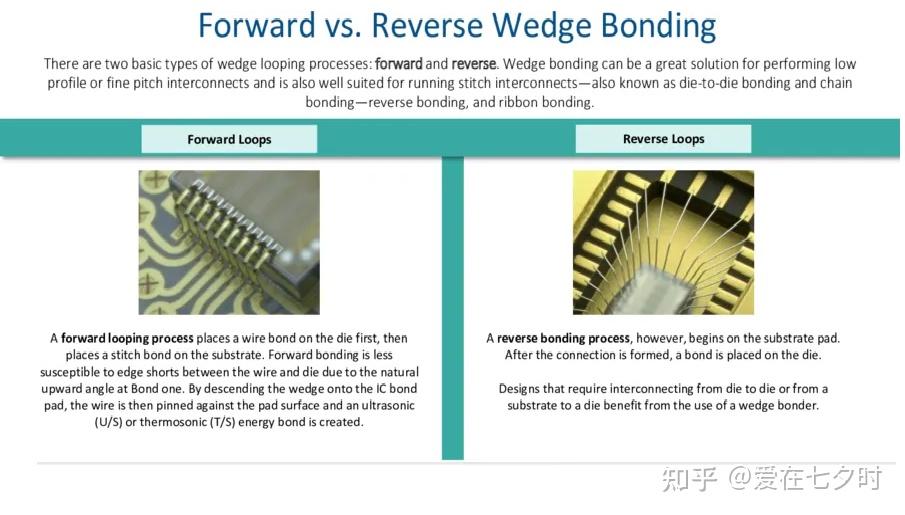
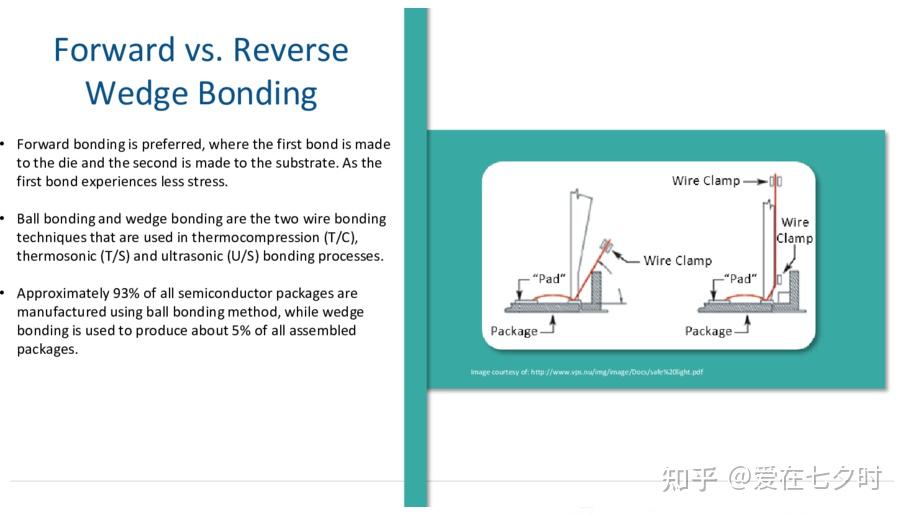
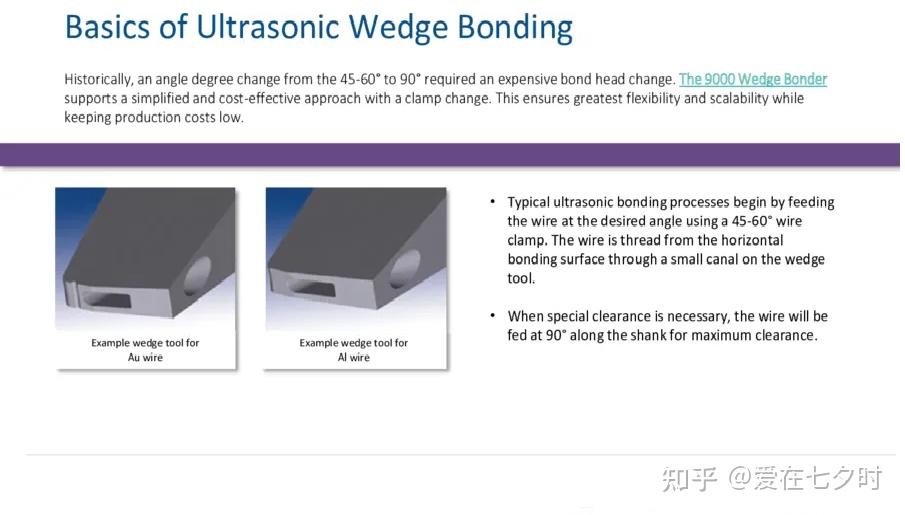

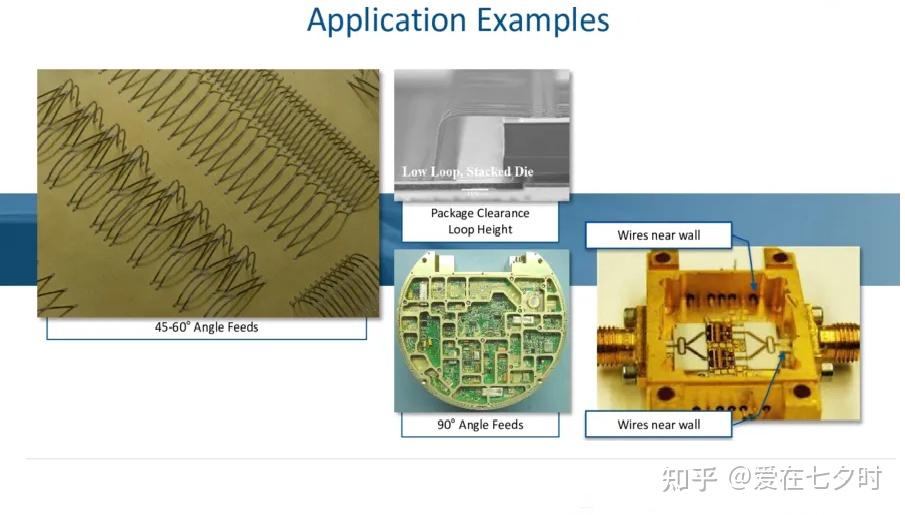
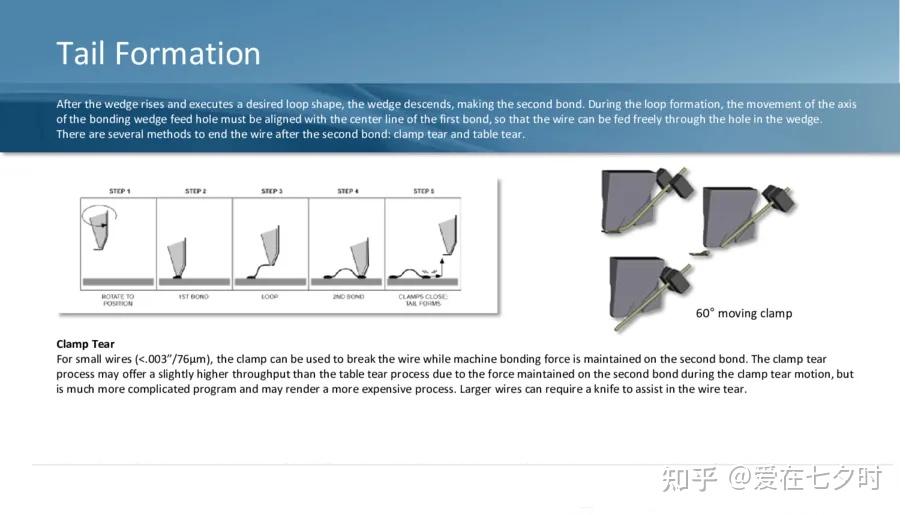
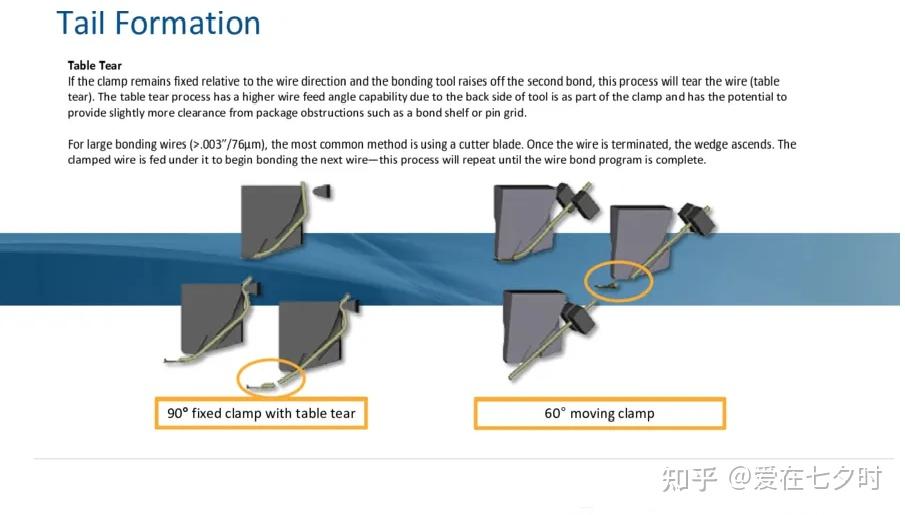
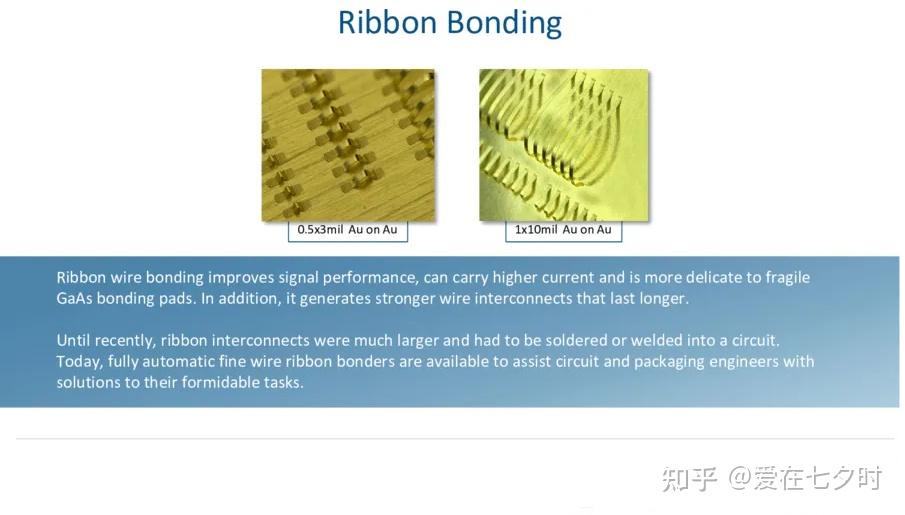



http://weixin.qq.com/r/QhAjO9TE64mUrZBY90VQ (二维码自动识别)
因为本PPT章节太多,剩下部分如有朋友有需要,可加入我“知识星球”免费下载PDF版本。注意:此资料只可供自己学习,不可传阅,平台有下载记录,切记!文末有加入“星球”方式,欢迎加入后一起交流学习。
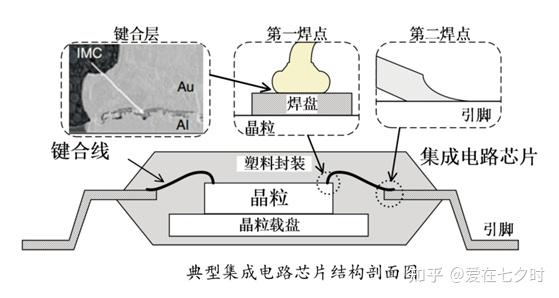
五、键合工艺技术的挑战和发展
随着芯片设计日益复杂,键合工艺也面临着不少挑战。例如,随着芯片上的元件数量的增加,需要更精细、更紧凑的键合技术来满足设计要求。
另外,随着物联网和人工智能的兴起,对高性能和低功耗的需求也在增加。这要求键合技术不仅要有高的信号传输速度,而且要有低的功耗。
为了满足这些挑战,各种键合技术都在持续进行研究和发展,如引入新材料、改进设备和工艺等,以提高性能和降低成本。
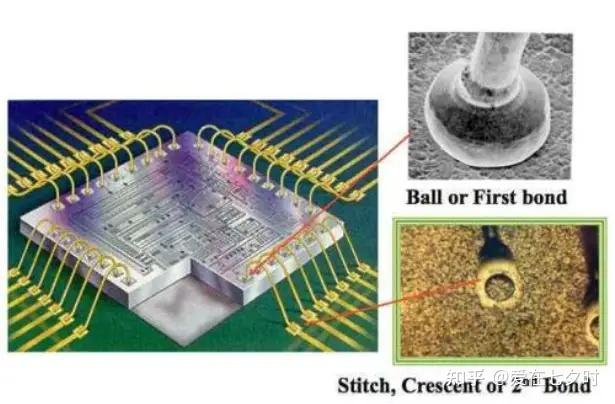
总结一下
在半导体封装领域,键合技术经历了从引线键合、TAB到倒装芯片再到混合键合的演进过程。下表对四种键合方式的特点、优缺点及应用情况做了详细对比:

总的来说:芯片键合工艺是半导体制造中不可或缺的一环。它确保了各种设备的高效、可靠和持久运行。虽然Wedge、Ball和Bump键合各有优势,但选择哪种方法取决于具体的应用、设计和环境要求。随着科技的不断进步,我们可以预期,这些键合技术将更加先进,更加精细,以满足未来更高的技术和性能要求。

免责声明
【我们尊重原创,也注重分享。文中的文字、图片版权归原作者所有,转载目的在于分享更多信息,不代表本号立场,如有侵犯您的权益请及时私信联系,我们将第一时间跟踪核实并作处理,谢谢!】
审核编辑 黄宇
-
芯片
+关注
关注
463文章
54409浏览量
469127 -
半导体
+关注
关注
339文章
31208浏览量
266394
发布评论请先 登录
半导体封装引线键合技术:超声键合步骤、优势与推拉力测试标准

半导体金线键合(Gold Wire Bonding)封装工艺技术简介;

半导体芯片制造技术——“芯片键合”工艺技术的详解;

半导体封装Wire Bonding (引线键合)工艺技术的详解;

半导体封装“焊线键合(Wire Bonding)”线弧相关培训的详解;

半导体“光刻(Photo)”工艺技术的详解;

半导体后道制程“芯片键合(Die Bonding)”工艺技术的详解;




 半导体“楔形键合(Wedge Bonding)”工艺技术的详解;
半导体“楔形键合(Wedge Bonding)”工艺技术的详解;










评论