随着微型机电系统(MEMS)技术的快速发展,其在汽车、医疗、通信、消费电子等领域的应用日益广泛。MEMS器件由于其独特的结构和功能特性,对封装技术提出了极高的要求。其中,气密性封装是MEMS封装中的关键技术之一,它不仅能够保护MEMS器件免受外部环境的影响,还能提高器件的性能和可靠性。Au-Sn共晶键合技术作为一种先进的封装技术,在MEMS气密性封装中展现出了巨大的潜力。
一、MEMS封装概述
MEMS是将微传感器、微执行器、信号处理、电路等元件集成到硅层上的系统。由于MEMS器件具有精密的可动结构,如微型腔体、微梁和薄膜元件等,这些微结构的尺寸很小、强度低,容易因机械接触而损坏,因此封装起来难度极大。MEMS封装不仅需要提供必要的电学和其他物理场的互联,还需对MEMS结构以及电连接等提供支持和保护,使之免受外部环境的干扰或破坏。封装中面临着结构优化、工艺条件的选择、热力学效应和多物理场耦合等问题。研究表明,在MEMS系统中发生的可靠性问题50%来自电子封装过程。
二、Au-Sn共晶键合技术原理
共晶键合,又称共晶焊接,是指两种或两种以上金属层,在一定的温度下直接从固体转化成液态,通过金属再结晶在键合面形成共晶相的键合工艺。Au-Sn共晶键合是其中一种重要的类型,它利用Au和Sn在特定比例下形成的共晶合金,实现低温下的键合。
Au-Sn合金是半导体后道管壳级封装中常用的焊料之一,常用的合金质量分数分别为80%的Au和20%的Sn。这种成分比例的Au-Sn焊料能够在280℃下形成共晶合金,在合金温度点附近,主要包括Au5Sn相和AuSn相。在键合过程中,当温度高于Sn的熔点(231.9℃)时,Sn层开始熔化,在金锡界面形成液相。由于金和锡的反应扩散,在界面快速形成金锡的共晶相。温度降低时,凝固形成稳定的金锡共晶体。
三、Au-Sn共晶键合技术在MEMS封装中的应用优势
- 低温键合
相比于其他封装技术,如硅/玻璃静电键合、硅/硅直接键合等,Au-Sn共晶键合技术具有更低的键合温度。硅/玻璃静电键合需要约1000V的高电压,这对某些MEMS器件的性能产生影响,也不适于在CMOS集成传感器中应用;硅/硅直接键合所需温度高(>1000℃),且无法实现带金属键合,应用面较小。而Au-Sn共晶键合技术的键合温度约为300℃,这一温度远低于上述两种技术,有利于减少封装过程中对MEMS器件的热应力影响,提高器件的可靠性。
- 高气密性
MEMS器件对封装的气密性有着特殊的要求。在真空或充压环境下进行气密封装可以提高多种MEMS器件的性能,如MEMS陀螺仪就必须要求真空封装以提高谐振器的品质因数Q值。Au-Sn共晶键合技术在键合过程中出气量很低,可以实现高真空零级封装,满足MEMS器件对气密性的严格要求。
- 工艺简单,适于批量生产
Au-Sn共晶键合技术对键合面的平整度、划痕和颗粒都不敏感,这降低了对键合前处理工艺的要求,使得键合过程更加简单、易于控制。同时,由于Au-Sn共晶合金具有良好的物理特性、导热性好、强度高、无需助焊剂以及低黏滞性等优点,因此Au-Sn共晶键合技术非常适合于批量的气密封装生产。
四、Au-Sn共晶键合技术在MEMS封装中的应用实例
以某MEMS气密性封装项目为例,该项目采用Au-Sn共晶键合技术实现了MEMS晶圆级气密封装。具体过程如下:
- 键合结构设计
设计了共晶键合多层材料的结构和密封环图形。盖帽层采用Ti/Ni/Au/Sn/Au结构,其中Ti作为金属与硅衬底的黏附层,Ni作为扩散阻挡层和焊料的浸润层。由于Sn在大气环境下容易氧化,在Sn的表面淀积一层Au作为钝化层。器件层采用Ti/Ni/Au结构。Au和Sn的厚度比例严格按照质量分数分别为80%的Au和20%的Sn进行电镀,以保证键合质量。
- 键合前处理
采用氮气与氧气等离子清洗相结合的前处理方法去除无机与有机沾污,得到一个清洁的键合表面。氮气清洗属于物理清洗方法,去除表面吸附的颗粒以及无机物;氧气清洗属于化学清洗方法,采用微波氧气等离子体,通过微波提高氧活性和等离子体密度,与金属表面的有机物迅速反应去除残留的有机沾污。
- 键合过程
两层硅片在氮气气氛中靠静态的压力实现紧密接触。加热的峰值温度为300℃,持续时间为2min。由于Au-Sn合金的共熔温度为280℃,略高于共熔温度是为了保证焊料的充分互熔。在升温的过程中,界面的Sn首先熔化,熔化的Sn溶解了两面接触的Au,实现了金属间的互熔。降温时通入氮气加速冷却,快速降温有利于生成的金属间化合物更小、结构更致密。
- 键合后处理
键合完成后采用应力测试仪测试圆片翘曲,通过翘曲度来评估圆片键合应力的大小。同时,从键合好的圆片上抽取封装好的芯片进行剪切强度测试,以衡量封装质量。
五、Au-Sn共晶键合技术在MEMS封装中的应用前景
随着MEMS技术的不断发展,对封装技术的要求也越来越高。Au-Sn共晶键合技术以其低温键合、高气密性、工艺简单和适于批量生产等优点,在MEMS封装中展现出了广阔的应用前景。特别是在对气密性要求较高的MEMS器件,如MEMS陀螺仪、压力传感器等,Au-Sn共晶键合技术将成为主流的封装技术之一。
此外,随着半导体封装技术的不断进步,Au-Sn共晶键合技术也有望与其他先进封装技术相结合,形成更加完善的MEMS封装解决方案。例如,将Au-Sn共晶键合技术与晶圆级封装(WLP)技术相结合,可以实现更高密度、更高可靠性的MEMS封装。
六、结论
Au-Sn共晶键合技术作为一种先进的封装技术,在MEMS气密性封装中展现出了巨大的潜力。其低温键合、高气密性、工艺简单和适于批量生产等优点,使得它成为MEMS封装中的理想选择。随着MEMS技术的不断发展,Au-Sn共晶键合技术将在MEMS封装领域发挥更加重要的作用,为MEMS器件的性能提升和可靠性保障提供有力支持。同时,随着半导体封装技术的不断进步,Au-Sn共晶键合技术也将不断发展和完善,为MEMS封装带来更多的创新解决方案。
-
键合
+关注
关注
0文章
107浏览量
8307 -
微型机电
+关注
关注
0文章
3浏览量
6475 -
MEMS封装
+关注
关注
0文章
5浏览量
5543
发布评论请先 登录
晶圆键合中使用的主要技术
基于BCB键合的MEMS加速度计圆片级封装工艺

EVG 已在全球范围建立超过 1100 个EVG 晶圆键合室
Plessey购买GEMINI晶圆键合系统 将扩大MicroLED制造
EV集团将在SEMICON CHINA展出用于3D-IC封装的突破性晶圆键合技术
用于MEMS器件的先进晶圆级封装解决方案
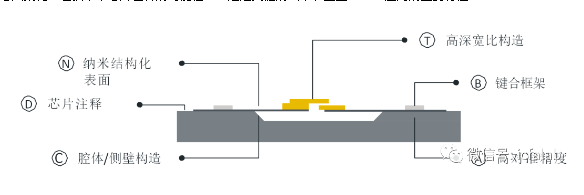



 揭秘Au-Sn共晶键合:MEMS封装的高效解决方案
揭秘Au-Sn共晶键合:MEMS封装的高效解决方案


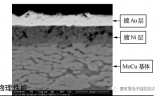









评论