文章来源:Tom聊芯片智造
原文作者:芯片智造
本文介绍了Cu-Cu混合键合主要用在哪方面以及原理是什么。
什么是Cu-Cu混合键合?
Cu-Cu混合键合英文名为Cu-Cu Hybrid Bonding。
传统的锡球倒装键合通常需要金属熔化又凝固的过程,但铜一铜混合键合采用固态接合,在高温下,铜金属的原子在固态下发生扩散,形成牢固的连接,避免了金属熔化带来的“bridging”问题,确保接合的可靠性。
Cu-Cu混合键合原理

1,选择两片均含有SiO₂介质和铜触点的晶圆,铜触点通常略低于SiO₂的厚度。通常会使用等离子体来清洁表面,增强材料之间的粘附力。
2,处理后的两片晶圆将在室温下进行对位接合。由于氧化硅之间的范德华力的作用,两片晶圆已经形成了一定的接合强度。这种接合力虽不高,但足够让两片晶圆保持初步接触。
3,接合后的晶圆在100℃下加热,形成了较强的共价键,共价键的形成使得氧化硅接合面之间的结合更加牢固。
4,接下来,温度升高至300℃至400℃,由于铜的热膨胀系数大于SiO₂,铜的体积会剧烈膨胀,最终使两片晶圆上位置低于氧化硅的铜相互接触,并在高温下扩散进入对方,从而实现铜与铜之间的键合。
Cu-Cu混合键合问题的来源
晶圆的平坦化不足,晶圆表面未清洗干净有粒子残留,对齐误差,Cu金属界面有孔洞等。
wafer to wafer Cu-Cu混合键合用在哪些芯片产品上?
可以用在CIS、3D NAND等产品上。
-
芯片
+关注
关注
463文章
54593浏览量
470595 -
晶圆
+关注
关注
53文章
5475浏览量
132886 -
键合
+关注
关注
0文章
107浏览量
8309
原文标题:Cu-Cu混合键合原理
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
蓝牙音响BP077CU
请教如何查看CU320卡里存贮的CU组态数据?
CU1641-000 CU1641-000 缆到缆接续
CU1647-000 CU1647-000 缆到缆接续
CU1639-000 CU1639-000 缆到缆接续
CU3031-000 CU3031-000 接头
BOE湿蚀对三维集成中铜模式直接键界面特性的影响
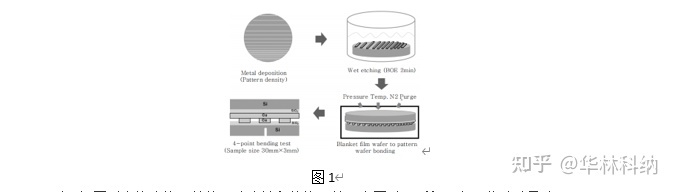
先进封装之热压键合工艺的基本原理

CU4000™和CU4000 LoPro®铜箔Rogers
3D Cu-Cu混合键合技术的优点和未来发展
化解先进半导体封装挑战,有一个工艺不能不说
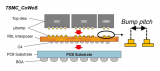
Cu-Cu Hybrid Bonding技术在先进3D集成中的应用




 Cu-Cu混合键合的原理是什么
Cu-Cu混合键合的原理是什么







评论