电子发烧友网报道(文/黄山明)芯片,一直被誉为 人类智慧、工程协作与精密制造的集大成者 ,而制造芯片的重要设备光刻机就是 雕刻这个结晶的 “ 神之手 ”。但仅有光刻机还不够,还需要光刻胶、掩膜版以及
2025-10-28 08:53:35 6234
6234 电子发烧友网综合报道 在芯片制造领域,光刻胶用光引发剂长期被美日韩企业垄断,成为制约我国半导体产业发展的关键“卡脖子”技术。近日,这一局面被打破——湖北兴福电子材料股份有限公司以4626.78万元
2025-12-17 09:16:27 5950
5950 在半导体制造过程中,晶圆去胶工艺之后确实需要进行清洗和干燥步骤。以下是具体介绍:一、清洗的必要性去除残留物光刻胶碎片:尽管去胶工艺旨在完全去除光刻胶,但在实际操作中,可能会有一些微小的光刻胶颗粒残留
2025-12-16 11:22:10 110
110 
SPM(硫酸-过氧化氢混合液)清洗是半导体制造中关键的湿法清洗工艺,主要用于去除晶圆表面的有机物、光刻胶残留及金属污染。以下是SPM清洗的标准化步骤及技术要点:一、溶液配制配比与成分典型体积比
2025-12-15 13:23:26 392
392 
剥离SPM通过高温(120–150℃)下的强氧化反应,将光刻胶分解为可溶性小分子。例如,在5nm以下制程中,SPM结合超声波空化效应,可实现无残留剥离,同时避
2025-12-15 13:20:31 201
201 
在化工、石油等严苛化学腐蚀环境中,如何选择合适的灌封胶?本文聚焦耐化学腐蚀灌封胶的类型对比、核心选型要点及应用建议,帮助您快速掌握专业防护方案。 | 铬锐特实业 三
2025-12-13 00:24:01 201
201 
晶圆清洗是半导体制造中至关重要的环节,直接影响芯片良率和性能。其工艺要点可归纳为以下六个方面:一、污染物分类与针对性处理颗粒污染:硅粉、光刻胶残留等,需通过物理擦洗或兆声波空化效应剥离。有机污染
2025-12-09 10:12:30 236
236 
、有机物及金属离子污染。方法:采用化学溶液(如SPM混合液)结合物理冲洗,通过高温增强化学反应效率,溶解并剥离表面残留的光刻胶等物质。二、核心清洗步骤有机溶剂处理
2025-12-08 11:24:01 236
236 
在芯片制造这场微观世界的雕刻盛宴中,光刻胶(PR)如同一位技艺精湛的工匠手中的隐形画笔,在硅片这片“晶圆画布”上勾勒出亿万个晶体管组成的复杂电路。然而,这支“画笔”却成了中国芯片产业最难突破的瓶颈之一:
2025-11-29 09:31:00 4626
4626 
晶圆边缘曝光(WEE)作为半导体制造关键精密工艺,核心是通过光刻胶光化学反应去除晶圆边缘多余胶层,从源头减少污染、提升产品良率。文章聚焦其四阶段工作流程、核心参数要求及光机电协同等技术难点。友思特
2025-11-27 23:40:39 243
243 
要素的解析: 一、核心化学溶液体系 SPM(硫酸/双氧水混合液) 作用 :通过强氧化性分解有机物(如光刻胶残留),并去除金属杂质。 典型配比 :浓硫酸与双氧水按7:3体积比混合,高温(100~150℃)下反应生成过氧酸,增强氧化能力
2025-11-24 15:07:29 283
283 模块有符合 RoHS 豁免条款的部件,需同步准备豁免证明文件。
REACH 认证REACH 管控欧盟市场上化学物质及其制品,低功耗蓝牙模块的外壳塑料、电路板涂层等含有的化学物质均需符合其要求,流程如下
2025-11-17 15:39:38
显微镜可三维成像表面形貌,通过粗糙度参数评估微观均匀性。有机物与金属污染检测紫外光谱/傅里叶红外光谱:识别有机残留(如光刻胶)。电感耦合等离子体质谱:量化金属杂质含量
2025-11-11 13:25:37 350
350 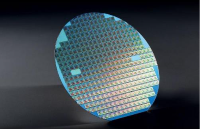
半导体清洗中SPM(硫酸-过氧化氢混合液)的最佳使用温度需根据具体工艺目标、污染物类型及设备条件综合确定,以下是关键分析: 高温场景(120–150℃) 适用场景:主要用于光刻胶剥离、重度有机污染
2025-11-11 10:32:03 253
253 去除表面污染物,保障工艺精度颗粒物清除:在半导体制造过程中,晶圆表面极易附着微小的颗粒杂质。这些颗粒若未被及时清除,可能会在后续的光刻、刻蚀等工序中引发问题。例如,它们可能导致光刻胶涂层不均匀
2025-10-30 10:47:11 354
354 
电子发烧友网综合报道 近日,我国半导体材料领域迎来重大突破。北京大学化学与分子工程学院彭海琳教授团队及合作者通过冷冻电子断层扫描技术,首次在原位状态下解析了光刻胶分子在液相环境中的微观三维结构、界面
2025-10-27 09:13:04 6180
6180 
污染物类型 不同工序产生的残留物差异显著(如光刻胶残余、金属离子沉积、颗粒物或氧化层缺陷)。例如: 前端硅片预处理需去除表面有机物和自然氧化层; CMP抛光后需清理研磨液中的磨料颗粒; 金属互连前的清洗则侧重于消除电
2025-10-22 14:47:39 257
257 颗粒物附着 :空气中悬浮的微尘落在涂覆光刻胶的晶圆表面,形成掩膜图案外的异常散射中心。 有机挥发物(VOCs) :光刻胶溶剂残留或环境中的有机物吸附于晶圆边缘,导致显影不完全或线宽失真。 静电吸附 :干燥环境下积累的静电荷会吸引周围粒子至晶圆表面
2025-10-21 14:28:36 688
688 选择合适的SC1溶液清洗硅片需要综合考虑多个因素,以下是具体的方法和要点:明确污染物类型与污染程度有机物污染为主时:如果硅片表面主要是光刻胶、油脂等有机污染物,应适当增加过氧化氢(H₂O₂)的比例
2025-10-20 11:18:44 460
460 
步骤:炉前清洗:在扩散工艺前对硅片进行彻底清洁,去除可能影响掺杂均匀性的污染物。光刻后清洗:有效去除残留的光刻胶,为后续工序提供洁净的表面条件。氧化前自动清洗:在
2025-10-16 17:42:03 741
741 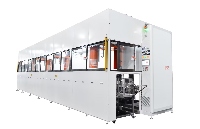
,分解有机污染物(如光刻胶残留物)或金属腐蚀产物(如铜氧化物)。例如,在类似SC2清洗液体系中,它可能替代部分盐酸,通过氧化反应去除金属杂质;缓冲与pH调节:作为缓
2025-10-14 13:08:41 203
203 
本文从焊料应用工程师视角,解析了锡膏与锡胶的核心差异:成分上,锡膏以金属合金粉为核心,助焊剂辅助焊接;锡胶含热固树脂,兼顾焊接与补强。性能上,锡膏导电导热更优,耐受高温;锡胶低温固化,残留物绝缘性好。应用场景上,锡膏适配手机主板、汽车VCU等量产高精度产品;锡胶用于折叠屏、医疗传感器等特种场景。
2025-10-10 11:06:36 585
585 
徘徊在我们的水、血液和环境中,是出了名的难以检测的“永远的化学物质” ,其中一些对人类有毒。 芝加哥大学普利兹克分子工程学院(UChicago PME)和美国阿贡国家实验室(Argonne
2025-10-09 19:47:05 128
128 中产生空化效应,形成微小气泡破裂时释放的能量可剥离晶圆表面的颗粒物和有机膜层。该方法对去除光刻胶残渣尤为有效,且能穿透复杂结构如沟槽和通孔进行深度清洁。高压喷淋冲洗
2025-10-09 13:46:43 472
472 
清洗策略半导体制造过程中产生的污染物可分为四类:颗粒物(灰尘/碎屑)、有机残留(光刻胶/油污)、金属离子污染、氧化层。针对不同类型需采用差异化的解决方案:颗粒物清除
2025-10-09 13:40:46 705
705 
的电子元器件必须符合RoHS要求,以确保产品不会对环境和人类健康造成伤害。
REACH认证 :全称为《化学品注册、评估、授权和限制法规》,要求电子元器件中的化学物质必须注册、评估,并限制或禁止某些高风险
2025-09-29 15:28:50
半导体腐蚀清洗机是集成电路制造过程中不可或缺的关键设备,其作用贯穿晶圆加工的多个核心环节,具体体现在以下几个方面:一、精准去除表面污染物与残留物在半导体工艺中,光刻、刻蚀、离子注入等步骤会留下多种
2025-09-25 13:56:46 497
497 
湿法去胶工艺中出现化学残留的原因复杂多样,涉及化学反应、工艺参数、设备性能及材料特性等多方面因素。以下是具体分析:化学反应不完全或副产物生成溶剂选择不当:若使用的化学试剂与光刻胶成分不匹配(如碱性
2025-09-23 11:10:12 497
497 
、金属屑),优先选择物理作用强的超声波或兆声波模块;针对有机残留(光刻胶、树脂)、油污等,则需化学溶解能力强的喷淋系统配合溶剂(如丙酮、NMP)。对于金属离子污染,
2025-09-22 11:04:05 464
464 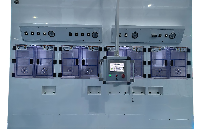
什么是离子污染物离子污染物是指产品表面未被清洗掉的残留物质,这些物质在潮湿环境中会电离为导电离子,例如电镀药水、助焊剂、清洗剂、人工汗液等,很容易在产品上形成离子残留。一旦这些物质在产品表面残留并
2025-09-18 11:38:28 502
502 
光刻胶剥离工艺是半导体制造和微纳加工中的关键步骤,其核心目标是高效、精准地去除光刻胶而不损伤基底材料或已形成的结构。以下是该工艺的主要类型及实施要点:湿法剥离技术有机溶剂溶解法原理:使用丙酮、NMP
2025-09-17 11:01:27 1282
1282 
在半导体制造过程中,若湿法去胶第一次未能完全去除干净,可能引发一系列连锁反应,对后续工艺和产品质量造成显著影响。以下是具体后果及分析:残留物导致后续工艺缺陷薄膜沉积异常:未清除的光刻胶残留会作为异物
2025-09-16 13:42:02 447
447 
薄膜或散射光异常区域,初步区分有机物、无机盐还是金属残留。例如,油性光泽可能指向光刻胶残余,而白色结晶多为铵盐类无机物。仪器验证:借助FTIR光谱分析官能团特征峰识
2025-09-16 13:37:42 580
580 
提高光刻胶残留清洗效率需要结合工艺优化、设备升级和材料创新等多方面策略,以下是具体方法及技术要点:1.工艺参数精准控制动态调整化学配方根据残留类型(正胶/负胶、厚膜/薄膜)实时匹配最佳溶剂组合。例如
2025-09-09 11:29:06 629
629 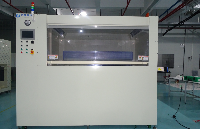
₂)、石墨化残留物及金属杂质,开发多组分混合酸液体系。例如,采用HF/HNO₃/HAc缓冲溶液实现各向同性蚀刻,既能有效去除损伤层又不引入表面粗糙化。通过电化学阻抗谱监测
2025-09-08 13:14:28 621
621 
想到,除了研究大脑的抽象数学模型外,能否抛弃传统的芯片实现方式,以化学物质和生物组件、材料及相关现象来构建人工神经网络或提取其功能来用于AI处理,甚至直接用生物体来实现AI功能,这就是从AI硬件走向AI
2025-09-06 19:12:03
预处理与初步去污将硅片浸入盛有丙酮或异丙醇溶液的容器中超声清洗10–15分钟,利用有机溶剂溶解并去除表面附着的光刻胶、油脂及其他疏水性污染物。此过程通过高频振动加速分子运动,使大块残留物脱离基底进入
2025-09-03 10:05:38 603
603 
引言 晶圆光刻图形是半导体制造中通过光刻工艺形成的微米至纳米级三维结构(如光刻胶线条、接触孔、栅极图形等),其线宽、高度、边缘粗糙度等参数直接决定后续蚀刻、沉积工艺的精度,进而影响器件性能。传统
2025-09-03 09:25:20 650
650 
相似相溶原理快速溶解有机污渍(如油脂、光刻胶残留物),适用于初步去脂或特定聚合物材料的清除。例如,在CCD芯片清洗中,常采用“蒸馏水→异丙醇→纯丙酮”的顺序循环喷淋
2025-09-01 11:21:59 1000
1000 
在芯片制造领域的光刻工艺中,光刻胶旋涂是不可或缺的基石环节,而保障光刻胶旋涂的厚度是电路图案精度的前提。优可测薄膜厚度测量仪AF系列凭借高精度、高速度的特点,为光刻胶厚度监测提供了可靠解决方案。
2025-08-22 17:52:46 1542
1542 
一、工艺参数精细化调控1.化学配方动态适配根据污染物类型(有机物/金属离子/颗粒物)设计阶梯式清洗方案。例如:去除光刻胶残留时采用SC1配方(H₂O₂:NH₄OH=1:1),配合60℃恒温增强氧化
2025-08-20 12:00:26 1247
1247 
这一突破的核心力量。 然而,EUV光刻的广泛应用并非坦途,其光源本身存在反射损耗大、亮度低等固有缺陷,这对配套的光刻胶材料提出了前所未有的严苛要求——不仅需要具备高效的EUV吸收能力,还要在反应机制的稳定性、缺陷控制的精准度等方面实
2025-08-17 00:03:00 4220
4220 电子束光刻(EBL)是一种无需掩模的直接写入式光刻技术,其工作原理是通过聚焦电子束在电子敏感光刻胶表面进行纳米级图案直写。
2025-08-14 10:07:21 2553
2553 
。 从光固化龙头到半导体材料新锐 久日新材的战略转型始于2020年。通过收购大晶信息、大晶新材等企业,强势切入半导体化学材料赛道。2024年11月,久日新材控股公司年产4500吨光刻胶项目进入试生产阶段,其中面板光刻胶4000吨、半导体光刻胶500吨
2025-08-12 16:45:38 1162
1162 的相互作用,而反应速度直接受温度影响。例如:高温加速反应(如硫酸+双氧水混合液在80℃下快速剥离光刻胶);低温导致反应滞后或不彻底,造成残留物污染后续工序。温度波动±1
2025-08-12 11:23:14 660
660 
半导体湿法去胶是一种通过化学溶解与物理辅助相结合的技术,用于高效、可控地去除晶圆表面的光刻胶及其他工艺残留物。以下是其核心原理及关键机制的详细说明:化学溶解作用溶剂选择与反应机制有机溶剂体系:针对正性光刻胶
2025-08-12 11:02:51 1506
1506 
电子发烧友网综合报道 近日,八亿时空宣布其KrF光刻胶万吨级半导体制程高自动化研发/量产双产线顺利建成,标志着我国在中高端光刻胶领域的自主化进程迈出关键一步。 此次建成的KrF光刻胶产线采用
2025-08-10 03:26:00 9092
9092 光刻工艺是芯片制造的关键步骤,其精度直接决定集成电路的性能与良率。随着制程迈向3nm及以下,光刻胶图案三维结构和层间对准精度的控制要求达纳米级,传统检测手段难满足需求。光子湾3D共聚焦显微镜凭借非
2025-08-05 17:46:43 944
944 
浸泡的方式,用去离子水(DIWater)或其他溶剂清除晶圆表面的残留物(如光刻胶碎片、蚀刻剂副产物、颗粒污染物等)。主要作用:确保前一道工序后的有害物质被彻底去除
2025-08-04 14:53:23 1078
1078 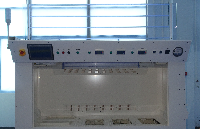
→光阻去除核心目的:清除完成图案转移后剩余的光刻胶层,暴露出需要进一步加工(如蚀刻、离子注入或金属沉积)的芯片区域。承上启下作用:连接前期的光刻图案化与后续的材料
2025-07-30 13:33:02 1121
1121 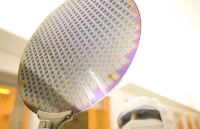
光阻去除工艺(即去胶工艺)是半导体制造中的关键步骤,旨在清除曝光后的光刻胶而不损伤底层材料。以下是主流的技术方案及其特点:一、湿法去胶技术1.有机溶剂溶解法原理:利用丙酮、NMP(N-甲基吡咯烷酮
2025-07-30 13:25:43 916
916 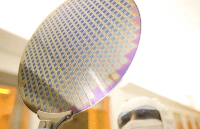
于:光刻工艺后清洗:去除光刻胶残留及显影液副产物。刻蚀后清洁:清除蚀刻副产物及侧壁颗粒。先进封装:TSV(硅通孔)、Bumping(凸点)等3D结构的窄缝污染物清除。
2025-07-23 15:06:54
、氧化物等。表面预处理:为光刻、沉积、刻蚀等工艺提供洁净表面。化学机械抛光(CMP)后清洗:去除磨料残留和表面损伤层。二、突出特点1. 高效批量处理能力多槽联动设计:
2025-07-23 15:01:01
光刻胶残留)发生氧化反应,生成CO₂和H₂O等挥发性物质1。表面活化:增强晶圆表面亲水性,为后续工艺(如CVD)提供更好的附着力3。优势:高效去除有机污染,适用于光
2025-07-23 14:41:42 496
496 
晶圆蚀刻与扩散是半导体制造中两个关键工艺步骤,分别用于图形化蚀刻和杂质掺杂。以下是两者的工艺流程、原理及技术要点的详细介绍:一、晶圆蚀刻工艺流程1.蚀刻的目的图形化转移:将光刻胶图案转移到晶圆表面
2025-07-15 15:00:22 1224
1224 
晶圆蚀刻后的清洗是半导体制造中的关键步骤,旨在去除蚀刻残留物(如光刻胶、蚀刻产物、污染物等),同时避免对晶圆表面或结构造成损伤。以下是常见的清洗方法及其原理:一、湿法清洗1.溶剂清洗目的:去除光刻胶
2025-07-15 14:59:01 1622
1622 
污染物。 方法:湿法化学清洗(如SC-1溶液)或超声波清洗。 硅片抛光后清洗 目的:清除抛光液残留(如氧化层、纳米颗粒),避免影响后续光刻精度。 方法:DHF(氢氟酸)腐蚀+去离子水冲洗。 2. 光刻工序 光刻胶涂覆前清洗 目的:去除硅
2025-07-14 14:10:02 1016
1016 电子发烧友网综合报道 光刻胶作为芯片制造光刻环节的核心耗材,尤其高端材料长期被日美巨头垄断,国外企业对原料和配方高度保密,我国九成以上光刻胶依赖进口。不过近期,国产光刻胶领域捷报频传——从KrF
2025-07-13 07:22:00 6083
6083 光刻胶,又称光致抗蚀剂,是一种关键的耐蚀剂刻薄膜材料。它在紫外光、电子束、离子束、X 射线等的照射或辐射下,溶解度会发生变化,主要应用于显示面板、集成电路和半导体分立器件等细微图形加工作业。由于
2025-07-11 15:53:24 430
430 
的应用。 改善光刻图形线宽变化的方法 优化曝光工艺参数 曝光是决定光刻图形线宽的关键步骤。精确控制曝光剂量,可避免因曝光过度导致光刻胶过度反应,使线宽变宽;或曝光不足造成线宽变窄。采用先进的曝光设备,如极紫外(EUV)光刻机
2025-06-30 15:24:55 740
740 
在半导体芯片制造的精密流程中,晶圆清洗台通风橱扮演着至关重要的角色。晶圆清洗是芯片制造的核心环节之一,旨在去除晶圆表面的杂质、微粒以及前道工序残留的化学物质,确保晶圆表面的洁净度达到极高的标准,为
2025-06-30 13:58:12
深入探讨白光干涉仪在光刻图形测量中的应用。 改善光刻图形垂直度的方法 优化光刻胶性能 光刻胶的特性直接影响图形垂直度。选用高对比度、低膨胀系数的光刻胶,可减少曝光和显影过程中的图形变形。例如,化学增幅型光刻胶具有良
2025-06-30 09:59:13 489
489 
键设备的技术价值与产业意义。一、晶圆湿法清洗:为何不可或缺?晶圆在制造过程中会经历多次光刻、刻蚀、沉积等工艺,表面不可避免地残留光刻胶、金属污染物、氧化物或颗粒。这些污染
2025-06-25 10:26:37
干涉仪在光刻图形测量中的应用。 针对晶圆上芯片工艺的光刻胶剥离方法 湿法剥离 湿法剥离是晶圆芯片工艺中常用的光刻胶去除方式。通过将涂覆光刻胶的晶圆浸入含有特定化学成分的剥离液中,利用剥离液与光刻胶发生化学反应,
2025-06-25 10:19:48 815
815 
物的应用,并探讨白光干涉仪在光刻图形测量中的作用。 金属低蚀刻率光刻胶剥离液组合物 配方组成 金属低蚀刻率光刻胶剥离液组合物主要由有机溶剂、碱性助剂、缓蚀体系和添加剂构成。有机溶剂如 N - 甲基 - 2 - 吡咯烷酮(NMP),
2025-06-24 10:58:22 565
565 
引言 在显示面板制造的 ARRAY 制程工艺中,光刻胶剥离是关键环节。铜布线在制程中广泛应用,但传统光刻胶剥离液易对铜产生腐蚀,影响器件性能。同时,光刻图形的精准测量对确保 ARRAY 制程工艺精度
2025-06-18 09:56:08 693
693 
一、产品概述全自动Mask掩膜板清洗机是半导体光刻工艺中用于清洁光罩(Reticle/Mask)表面的核心设备,主要去除光刻胶残留、颗粒污染、金属有机物沉积及蚀刻副产物。其技术覆盖湿法化学清洗、兆
2025-06-17 11:06:03
测量对工艺优化和产品质量控制至关重要。本文将探讨低含量 NMF 光刻胶剥离液及其制备方法,并介绍白光干涉仪在光刻图形测量中的应用。 低含量 NMF 光刻胶剥离液及制备方法 配方组成 低含量 NMF 光刻胶剥离液主要由低浓度 NMF、助溶剂、碱性物质、缓蚀剂
2025-06-17 10:01:01 678
678 
通过使用光掩膜和光刻胶在基板上复制流体图案的过程。基板将涂覆硅二氧化层绝缘层和光刻胶。光刻胶在被紫外光照射后可以容易地用显影剂溶解,然后在腐蚀后,流体图案将留在基板上。无尘室(Cleanroom)排除掉空间范围内空气中的微
2025-06-16 14:36:25 1070
1070 介绍白光干涉仪在光刻图形测量中的作用。 金属低刻蚀的光刻胶剥离液 配方设计 金属低刻蚀光刻胶剥离液需平衡光刻胶溶解能力与金属保护性能。其核心成分包括有机溶剂、碱性物质和缓蚀剂。有机溶剂(如 N - 甲基吡咯烷酮)负责溶
2025-06-16 09:31:51 586
586 
引言 在半导体制造领域,光刻胶剥离工艺是关键环节,但其可能对器件性能产生负面影响。同时,光刻图形的精确测量对于保证芯片制造质量至关重要。本文将探讨减少光刻胶剥离工艺影响的方法,并介绍白光
2025-06-14 09:42:56 736
736 
全息图样对应的物光源。加密过程中,让两束光干涉叠加得到干涉图样,并用胶片或者光刻胶记录下来,得到一个全息图;解密时,只使用复杂的随机图样照射前面形成的全息图就可以获得物光源信息。
图1是加密过程示意图
2025-06-13 08:42:59
一、光刻工艺概述 光刻工艺是半导体制造的核心技术,通过光刻胶在特殊波长光线或者电子束下发生化学变化,再经过曝光、显影、刻蚀等工艺过程,将设计在掩膜上的图形转移到衬底上,是现代半导体、微电子、信息产业
2025-06-09 15:51:16 2127
2127 如果说最终制造出来的芯片是一道美食,那么光刻胶就是最初的重要原材料之一,而且是那种看起来可能不起眼,但却能决定一道菜味道的关键辅料。 光刻胶(photoresist),在业内又被称为光阻或光阻剂
2025-06-04 13:22:51 992
992 引言 在半导体制造与微纳加工领域,光刻胶剥离液是光刻胶剥离环节的核心材料,其性能优劣直接影响光刻胶去除效果与基片质量。同时,精准测量光刻图形对把控工艺质量意义重大,白光干涉仪为此提供了有力的技术保障
2025-05-29 09:38:53 1108
1108 
优势,为光刻图形测量提供了可靠手段。 Micro OLED 阳极像素定义层制备方法 传统光刻工艺 传统 Micro OLED 阳极像素定义层制备常采用光刻剥离工艺。首先在基板上沉积金属层作为阳极材料,接着旋涂光刻胶,通过掩模版曝光使光刻胶发生光化学反应,随后
2025-05-23 09:39:17 628
628 
,如超声波清洗、高压喷淋、毛刷机械清洗、化学湿法清洗等,可有效去除光罩表面的油污、灰尘、微粒及化学残留物125。部分高端机型支持真空超声清洗和超临界流体清洗,提升
2025-05-12 09:03:45
:去除硅片表面的颗粒、有机物和氧化层,确保光刻胶均匀涂覆。 清洗对象: 颗粒污染:通过物理或化学方法(如SC1槽的碱性清洗)剥离硅片表面的微小颗粒。 有机物残留:清除光刻胶残渣或前道工艺留下的有机污染物(如SC2槽的酸性清洗)
2025-04-30 09:23:27 478
478 光刻胶类型及特性光刻胶(Photoresist),又称光致抗蚀剂,是芯片制造中光刻工艺的核心材料。其性能直接影响芯片制造的精度、效率和可靠性。本文介绍了光刻胶类型和光刻胶特性。
2025-04-29 13:59:33 7833
7833 
及应用的详细介绍: 一、技术原理 化学反应机制 氨水(NH₄OH):提供碱性环境,腐蚀硅片表面的自然氧化层(SiO₂),使附着的颗粒脱离晶圆表面。 过氧化氢(H₂O₂):作为强氧化剂,分解有机物(如光刻胶残留)并氧化硅片表面,形成新的亲水性
2025-04-28 17:22:33 4239
4239 下的潜在影响。 SPM清洗的化学特性 SPM成分:硫酸(H₂SO₄)与过氧化氢(H₂O₂)的混合液,通常比例为2:1至4:1(体积比),温度控制在80-120℃35。 主要作用: 强氧化性:分解有机物(如光刻胶残留)、氧化金属污染物; 表面氧化:在硅表面生成亲水
2025-04-27 11:31:40 866
866 刻蚀工艺的核心机理与重要性 刻蚀工艺是半导体图案化过程中的关键环节,与光刻机和薄膜沉积设备并称为半导体制造的三大核心设备。刻蚀的主要作用是将光刻胶上的图形转移到功能膜层,具体而言,是通过物理及化学
2025-04-27 10:42:45 2200
2200 
第9章 集成电路制造工艺概况 第10章 氧化 第11章 淀积 第12章 金属化 第13章 光刻:气相成底膜到软烘 第14章 光刻:对准和曝光 第15章 光刻:光刻胶显影和先进的光刻技术 第16章
2025-04-15 13:52:11
助焊剂残留物可能导致电路板电化学腐蚀、绝缘下降及可靠性隐患,其危害源于残留物质与环境的化学作用。通过表面绝缘电阻测试、铜镜腐蚀测试等方法可评估风险。科学应对需从材料选型(无卤素助焊剂)、工艺优化
2025-04-14 15:13:37 2234
2234 
的光刻胶,剩下未感光的光刻胶。
最后进行刻蚀,第五步是通过物理和化学手段把SiO2薄层上未被光刻胶保护的SiO2“刻蚀”掉,只保留受光刻胶保护的SiO2;第六步是把SiO2材料上的光刻胶清除掉,这样图形
2025-04-02 15:59:44
工艺:光刻胶除胶,蚀刻未被保护的SiO2,显影,除胶。 材料:晶圆,研磨抛光材料,光按模板材料。光刻胶,电子化学品。工业气体,靶材,封装材料 硅片制造:单晶硅棒拉制,硅棒切片,硅片研磨抛光,硅片氧化
2025-03-27 16:38:20
(或其他感光材料)上时,光子能量被光刻胶分子吸收,使分子内部能量升高并引发化学反应,通常为化学键的断裂或者交联等反应。然后通过显影过程选择性去除特定区域的光刻胶形成期望的图形。不同类型和波长的激光可以
2025-03-25 17:42:21
微流控芯片制造过程中,匀胶是关键步骤之一,而匀胶机转速会在多个方面对微流控芯片的精度产生影响: 对光刻胶厚度的影响 匀胶机转速与光刻胶厚度成反比关系。旋转速度影响匀胶时的离心力,转速越大,角速度越大
2025-03-24 14:57:16 751
751 光刻胶(Photoresist)又称光致抗蚀剂,是指通过紫外光、电子束、离子束、X射线等的照射或辐射,其溶解度发生变化的耐蚀剂刻薄膜材料。由感光树脂、增感剂和溶剂3种主要成分组成的对光敏感的混合液
2025-03-18 13:59:53 3008
3008 
不同材料的刻蚀速率比,达到>5:1甚至更高的选择比标准。 一、核心价值与定义 l精准材料去除 高选择性蚀刻通过调整反应条件,使目标材料(如多晶硅、氮化硅)的刻蚀速率远高于掩膜或底层材料(如氧化硅、光刻胶),实现
2025-03-12 17:02:49 809
809 是一种用于高效、无损地清洗半导体晶圆表面及内部污染物的关键设备。简单来说,这个机器具有以下这些特点: 清洗效果好:能够有效去除晶圆表面的颗粒、有机物、金属杂质、光刻胶残留等各种污染物,满足半导体制造对晶圆清洁度
2025-03-07 09:24:56 1037
1037 所需的厚度。在微流控领域,匀胶机主要用于光刻胶的涂覆,以确保光刻过程的均匀性和质量。 匀胶机的主要组成部分 旋转平台:承载基片的平台,通过高速旋转产生离心力。 滴胶装置:控制胶液的滴落量和位置。 控制系统:调节旋转速
2025-03-06 13:34:21 678
678 蓄电池放电原理主要基于其内部的化学反应,将储存的化学能转化为电能。以下是对蓄电池放电原理的详细解析:
基本原理:当蓄电池处于放电状态时,内部的化学物质发生反应,产生电流。这一过程中,正极和负极上
2025-02-10 16:11:02
机和光刻胶: 光掩膜:如同芯片的蓝图,上面印有每一层结构的图案。 光刻机:像一把精确的画笔,能够引导光线在光刻胶上刻画出图案。 光刻胶:一种特殊的感光材料,通过光刻过程在光刻胶上形成图案,进而构建出三维结构。
2025-01-28 16:36:00 3591
3591 
、化学物质、温度变化等,主要是提供一层保护性涂层,以确保电子元件在不同环境条件下能够稳定、可靠地运行,延长其寿命并提高其性能。PCB元件焊点保护胶种类有哪些?PCB元
2025-01-16 15:17:19 1308
1308 
,作为影响PCB板清洁度的重要因素之一,其控制变得尤为关键。PCB线路板在潮湿环境中运行时,可能会遭遇各种离子污染残留物的问题。这些残留物可能来自助焊剂残留、化学清
2025-01-14 11:58:30 1671
1671 
半导体湿法刻蚀过程中残留物的形成,其背后的机制涵盖了化学反应、表面交互作用以及侧壁防护等多个层面,下面是对这些机制的深入剖析: 化学反应层面 1 刻蚀剂与半导体材料的交互:湿法刻蚀技术依赖于特定
2025-01-08 16:57:45 1468
1468 用先进材料项目等。 恒坤新材成立于2004年12月,是中国境内少数具备12英寸集成电路晶圆制造关键材料研发和量产能力的创新企业之一。据其股东厦门市产业投资基金披露,恒坤新材是国内12英寸晶圆制造先进制程上出货量最大的光刻胶企业。 根据弗若斯特沙利文市
2025-01-07 17:38:55 843
843 光刻胶在这些物理或化学过程中具有更好的工艺稳定性和效果。 增强光刻胶与基片的粘附 烘胶有助于除去显影后残留于胶膜中的溶剂或水分,从而使胶膜与基片紧密粘附,防止胶层脱落。这一过程在微流控芯片的光刻工艺中是重要的一环,保障了
2025-01-07 15:18:06 824
824
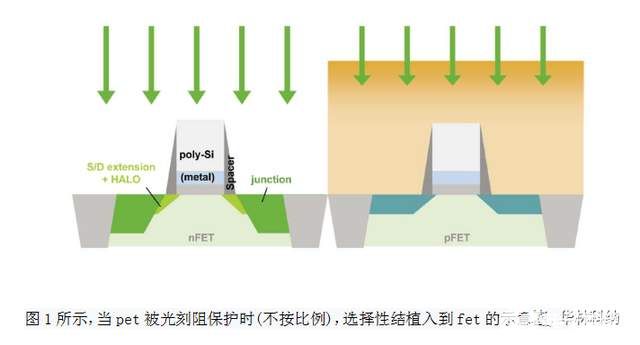
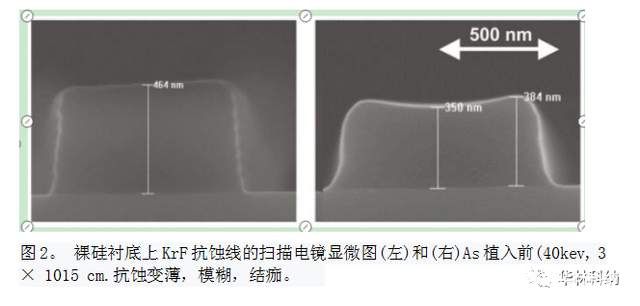

 电子发烧友App
电子发烧友App

















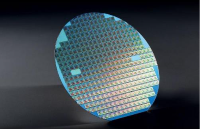



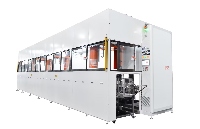





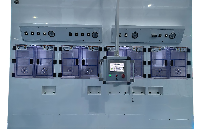



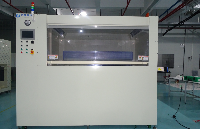









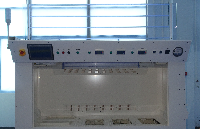
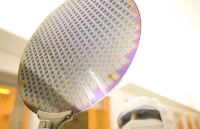
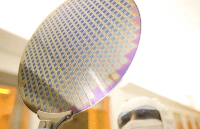















评论