半导体湿法去胶是一种通过化学溶解与物理辅助相结合的技术,用于高效、可控地去除晶圆表面的光刻胶及其他工艺残留物。以下是其核心原理及关键机制的详细说明:
化学溶解作用
溶剂选择与反应机制
有机溶剂体系:针对正性光刻胶(如基于酚醛树脂的材料),常使用TMAH(四甲基氢氧化铵)、NMD-3等碱性溶液进行溶解;对于负性光刻胶,则采用特定溶剂如PGMEA实现剥离。这些溶剂通过破坏高分子链间的交联结构,使胶层逐渐分解为可溶性片段。
无机强氧化性溶液:例如硫酸和双氧水混合液,可将光刻胶中的碳元素氧化为二氧化碳气体逸出,从而去除残留物。但此类方案不适用于含金属层(如Al、Cu)的制程,因强酸可能腐蚀金属部件。
温度与时间调控:通过加热至30–80℃加速化学反应速率,缩短处理周期。精确的温度控制(±0.5℃精度)可避免胶层碳化或基材热损伤,确保均匀剥离且不损害下层材料。
物理增强技术
超声波辅助剥离:低频超声波(20–40kHz)产生的空化效应能分解顽固胶体团块,并清除尺寸≥10nm的亚微米颗粒。该技术尤其适用于复杂拓扑结构的晶圆边缘区域,提升清洁彻底性。
兆声波精准清洗(可选):高频声波(1–3MHz)生成微射流,可定向作用于临时键合界面(如Si-Si直接键合片),实现无损剥离的同时减少基材机械应力损伤。
流体动力学设计:多向喷淋系统与离心旋转(200–500rpm)相结合,确保化学液覆盖整个晶圆表面,包括难以触及的凹槽和高深宽比结构,避免局部残留导致的图形边缘粗糙化(如LER/CD偏差)。
工艺协同优化
多槽串联模块化流程:典型配置包括预洗→主剥→漂洗→干燥等阶段。例如,先以较高浓度的去胶液快速溶解主体胶层,再通过稀释后的溶剂冲洗残余物,最后用去离子水(DIW)恢复表面洁净度。此设计兼顾效率与清洁效果。
循环过滤系统:内置高精度滤芯(≤5μm)实时截留脱落的颗粒杂质,配合在线电导率监测自动补充新鲜药水,既延长了化学液寿命,又防止污染物再沉积造成二次污染。
自动化控制参数适配:根据晶圆尺寸(兼容6/8/12英寸)、胶厚及图案密度动态调整喷淋压力、旋转速度和处理时长,确保不同批次间的工艺一致性。
半导体湿法去胶的核心在于化学溶解主导、物理强化辅助的协同机制,结合精密温控与流体管理,实现从纳米级残留到宏观结构的全尺度清洁。该技术广泛应用于光刻后清洗、3D封装临时键合拆解及刻蚀后处理等场景,是保障半导体制造良率的关键工艺节点。
-
半导体
+关注
关注
336文章
29985浏览量
258273 -
晶圆
+关注
关注
53文章
5344浏览量
131690 -
湿法
+关注
关注
0文章
36浏览量
7218
发布评论请先 登录

半导体及光伏太阳能领域湿法清洗
6英寸半导体工艺代工服务
苏州华林科纳半导体设备
半导体清洗设备
半导体湿法腐蚀设备
超声波清洗机,苏州晶淼半导体设备有限公司
《炬丰科技-半导体工艺》GaN、ZnO和SiC的湿法化学蚀刻
湿法去胶液的种类有哪些?去胶液都有哪些种类?去胶原理是什么?

智程半导体完成股权融资,专注半导体湿法工艺设备研发
半导体湿法刻蚀设备加热器的作用
半导体湿法刻蚀残留物的原理
半导体湿法flush是什么意思
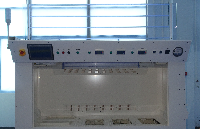
湿法去胶工艺chemical残留原因






 半导体湿法去胶原理
半导体湿法去胶原理

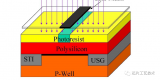










评论