光刻胶(Photoresist)又称光致抗蚀剂,是指通过紫外光、电子束、离子束、X射线等的照射或辐射,其溶解度发生变化的耐蚀剂刻薄膜材料。由感光树脂、增感剂和溶剂3种主要成分组成的对光敏感的混合液体。在光刻工艺过程中,用作抗腐蚀涂层材料。半导体材料在表面加工时,若采用适当的有选择性的光刻胶,可在表面上得到所需的图像。光刻胶按其形成的图像分类有正性、负性两大类。在光刻胶工艺过程中,涂层曝光、显影后,曝光部分被溶解,未曝光部分留下来,该涂层材料为正性光刻胶。如果曝光部分被保留下来,而未曝光被溶解,该涂层材料为负性光刻胶。按曝光光源和辐射源的不同,又分为紫外光刻胶(包括紫外正、负性光刻胶)、深紫外光刻胶、X-射线胶、电子束胶、离子束胶等。光刻胶主要应用于显示面板、集成电路和半导体分立器件等细微图形加工作业。光刻胶生产技术较为复杂,品种规格较多,在电子工业集成电路的制造中,对所使用光刻胶有严格的要求。
一、发展历史
1826年,法国人涅普斯(J. N. Niepce)最先发现了具有感光性的天然沥青,使用低黏度优质沥青涂覆玻璃板,预干后,置于相机暗盒内,开启曝光窗,经光学镜头长时间曝光后,沥青涂层感光逐渐交联固化,形成潜像,再经溶剂松节油清洗定影,获得最早的沥青成像图案。 1832年,德国人舒柯(G. Suckow)发现重铬酸盐在明胶等有机物中具有感光性。1839年,英国人庞顿(S. M. Ponton)首先将重铬酸盐用于照相研究。1850年,英国人塔尔博特(F. Talbot)将重铬酸盐与明胶混合后涂在钢板上制作照相凹版获得了成功。19世纪中叶,德国人格里斯(J. P. Griess)合成出芳香族重氮化合物,并发现重氮化合物不但遇热不稳定,而且对光照也不稳定。1884年,德国人韦斯特(West)首先利用重氮化合物的感光性显示出影像。1890年。德国人格林(Green)和格罗斯(Gross)等人将重氮化的混合物制成感光材料。取得了第一个重氮感光材料的专利。不久,德国的卡勒(Kalle)公司推出了重氮印相纸,从而使重氮感光材料商品化,并逐渐代替了铁印相技术。1921年,美国人毕勃(M. C. Beeb)等人将碘仿与芳香胺混合在一起,用紫外光照射得到染料像,称它为自由基成像体系。1925年,美国柯达(Eastman-Kodak)公司发现了聚乙烯醇和肉桂酸酯在紫外光下有很强的交联反应并且感光度很高,随后用于光学玻璃的光栅蚀刻,成为光刻胶的先驱。
1942年,英国Eisler发明印刷电路板,重铬酸盐感光材料作为光敏抗蚀剂用于制造印刷线路板。重铬酸在紫外光作用下还原成三价铬离子,三价铬离子可和水溶性聚合物中的羰基、胺基、羟基等作用形成不溶的配位络合物。 1943年,美国杜邦公司提交了世界第一份有关光引发剂的发明专利,尽管这种二硫代氨基甲酸酯化合物感光活性较低,后来也未能转化为实际应用,但确实开启了一种全新的聚合物材料加工技术。1948年,美国专利中出现第一个光固化油墨配方和实施技术的专利。
1949年,德国Kalle公司首先开发成功紫外正性光刻胶。1954年,由柯达公司的明斯克(L. M. Minsk)等人研究成功的光敏剂增感的聚乙烯醇肉桂酸酯成为第一个光固化性能的光刻胶,牌号KPR。先用于印刷工业,后用于电子工业。1958年,柯达公司发展出了叠氮-橡胶系的负性光刻胶,牌号为KMER和KTFR。1960年,出现邻重氮萘醌-酚醛树脂紫外正性光刻胶。1968年,美国IBM公司的Haller等人发明聚甲基丙烯酸甲酯电子束光刻胶。1973年,由Bell实验室和Bowden发明聚烯砜类电子束光刻胶。1976年,美国麻省理工学院的H. Smith提出X射线曝光技术。1989年,日本科学家Kinoshita提出极紫外光刻技术(EUVL)。 1990年后,开始出现248 nm化学增幅型光刻胶。
1992年,IBM使用甲基丙烯酸异丁酯的聚合物作为化学增幅的193 nm光刻胶材料。同年Kaimoto等也发现了非芳香性的抗蚀刻剂,而且在193 nm有较好的透光性。20世纪90年代中期,美国明尼苏达大学纳米结构实验室提出了一种叫做“纳米压印成像”(nanoimprint lithography)的新技术。1996年,欧洲主要成立了4个极紫外光刻相关研究项目,约110个研究单位参与,其中比较重要的项目为MEDEA和MORE MOORE。1997年,Intel公司成立了包括AMD、Motorola、Micron、Infineon和IBM的EUV LLC,并与由LBNL、LLNL和SNL组成的国家技术实验室(VNL)签订了极紫外光刻联合研发协议(CRADA)。1998年,日本开始极紫外光刻研究工作,并于2002年6月成立极紫外光刻系统研究协会(EUVA)。1962年,中国北京化工厂接受中国科学院半导体研究所的委托,着手研究光刻胶,以吡啶为原料,采用热法工艺,制成聚乙烯醇肉桂酸酯胶。1967年,中国第一个KPR型负性光刻胶投产。1970年,103B型、106型两种负胶投产,环化橡胶系负胶BN-302、BN-303也相继开发成功。
2018年5月24日,国家科技重大专项(02专项)极紫外光刻胶项目顺利通过国家验收。
2018年5月30日,国家科技重大专项“极大规模集成电路制造装备与成套工艺”专项(02专项)项目“极紫外光刻胶材料与实验室检测技术研究”,经过项目组全体成员的努力攻关,完成了EUV光刻胶关键材料的设计、制备和合成工艺研究、配方组成和光刻胶制备、实验室光刻胶性能的初步评价装备的研发,达到了任务书中规定的材料和装备的考核指标。2019年11月25日,8种“光刻胶及其关键原材料和配套试剂”入选工信部《重点新材料首批次应用示范指导目录(2019年版)》。
二、工作原理(一)光学光刻胶
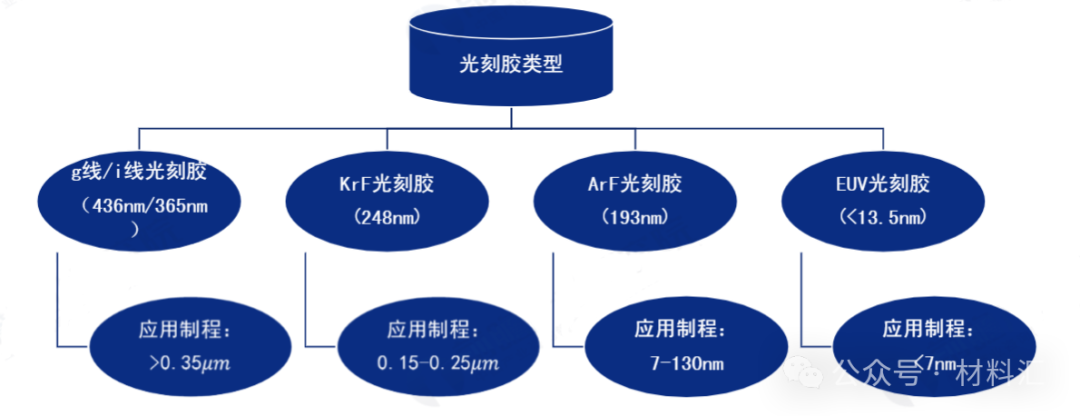
光刻胶类型及应用制程
1、紫外光刻胶紫外光刻胶适用于g线(436 nm)与i线(365 nm)光刻技术。
负性光刻胶
(1)环化橡胶型光刻胶属于聚烃类——双叠氮系光刻胶
。这种胶是将天然橡胶溶解后,用环化剂环化制备而成的。一般来说,橡胶具有较好的耐腐蚀性,但是它的感光活性很差。橡胶的分子量在数十万以上,因此溶解性甚低,无论在光刻胶的配制还是显影过程中都有很大困难。因此无法直接采用橡胶为原料配制光刻胶。这一类光刻胶的重要组成部分为交联剂,又称架桥剂,可以起到光化学固化作用,依赖于带有双感光性官能团的交联剂参加反应,交联剂曝光后产生双自由基,它和聚烃类树脂相作用,在聚合物分子链之间形成桥键,变为三维结构的不溶性物质,这种光化学架桥交联反应可用下式表示:

式中,C为交联剂;P为聚合物。叠氮有机化合物、偶氮盐和偶氮有机化合物都可用作交联剂,它们不仅能够和聚烃类树脂相配合组成负性光刻胶,而且还能和一些线型聚合物,如聚酰胺、聚丙烯酰胺等相配合制成负性光刻胶。在聚烃类光刻胶里添加的交联剂以双叠氮有机化合物较为重要;在和环化橡胶配合使用时,双叠氮型交联剂不带极性基团,并且能够溶解于非极性溶剂,如三氯乙烯和芳香烃等类型的芳香族双叠氮化合物。

四种光刻胶常用双叠氮交联剂的分子结构
这种交联剂包括4,4'-双叠氮二苯基乙烯(A)、4,4'-二叠氮二苯甲酮(B)、2,6-双-(4'-叠氮苄叉)-环己酮(C)、2,6-双-(4'-叠氮苄叉)-4-甲基环己酮(D)等,其结构如图所示。其中D的效果最为突出,感光时在交联剂双叠氮化合物作用下发生交联成为不溶性高聚物。

聚烃类——双叠氮系光刻胶反应式该类型的光刻胶一般为环化橡胶的甲苯溶液,浓度为8%~10%,光敏交联剂加入量为环化橡胶的10%以下,增感剂可以用二苯甲酮或蒽酮等,加入量为5%左右。
(2)肉桂酸酯类的光刻胶

肉桂酸结构式这类光刻胶在紫外光的照射下,肉桂酸上的不饱和键会打开,产生自由基,形成交联结构。主要品种有聚乙烯醇肉桂酸酯光刻胶、聚乙烯氧乙基肉桂酸酯光刻胶和肉桂叉二酯光刻胶等。 第一种胶是最早被用于光刻胶制备的光敏高分子化合物,对二氧化硅、铝、氧化铬等材料都有良好的附着力,耐氢氟酸、磷酸腐蚀;第二种胶在曝光下几乎不受氧的影响,无须氮气保护。分辨率1μm左右,灵敏度较第一种胶高1倍,黏附性好,抗蚀能力强,图形清晰、线条整齐,耐热性好,显影后可在190℃坚膜0.5h不变质。感光范围在250~475nm,特别对436nm十分敏感。属线型高分子聚合物,常用溶剂为丙酮;第三种胶能溶于酮类、烷烃等溶剂,不溶于水、乙醇、乙醚等。有较好的黏附性和感光性,分辨率也很高,感光速度快。

聚乙烯醇肉桂酸酯的光交联

聚乙烯醇肉桂酸酯的增感机理增感剂的作用:少量添加即可使光二聚反应在波长更长的可见光范围内进行。例如聚乙烯醇肉桂酸酯的感光区域原本在240~350nm,加入少量三线态光敏剂5-硝基苊后,感官区域扩展到了240~450nm。光敏剂对聚乙烯醇肉桂酸酯的增感机理与普通光化学的三线态光敏反应完全相同,光敏剂首先吸收光而变为激发单线态(SSn)然后进行系间窜跃成为激发三线态(TS1)。这个三线态的能量转移到邻近的肉桂酰基上,使肉桂酰基成为激发三线态(TC1)最后进行环丁烷化反应而交联。因此一个好的光敏剂的条件如下:①光敏剂与肉桂酰基的能量水准必须满足TS1≥TC1。实验发现二者取接近值时效果最佳。②光敏剂必须比肉桂酰基在更长波长区域内具有有效的吸收。③被吸收的能量易于向三线态进行系间窜跃(系间窜跃的量子收率大)。
聚乙烯醇肉桂酸酯的光敏剂 | |||
光敏剂 | 相对感度 | 吸收峰值/nm | 感光波长边值/nm |
空白 | 2.2 | 320 | 350 |
对硝基联苯 | 180 | 360 | 380 |
对硝基苯胺 | 110 | 370 | 400 |
2,4-二硝基苯胺 | 88 | 360 | 400 |
苦酰胺 | 400 | 450 | 480 |
2-氯-4-硝基苯胺 | 290 | 380 | 410 |
2,5-二硝基-4-硝基苯胺 | 330 | 380 | 410 |
4,4'-四甲基-二胺基苯甲酮 | 640 | 380 | 420 |
1,2-苯并蒽酮 | 510 | 420 | 470 |
蒽酮 | 99 | 320 | 420 |
3-甲基-1,3-二氮杂-1,9-苯并蒽酮 | 1100 | 470 | 490 |
5-硝基苊 | 184 | 400 | 450 |
正性光刻胶在光照的情况下,高分子链主链可能发生断链或降解(聚合的逆反应)。光降解反应使高分子材料老化,机械性能变坏;从而失去使用价值,是高分子材料光老化的主要原因。当然光降解现象的存在也使废弃聚合物被消化,对环境保护具有有利的一面。
一个比较有意义的光分解反应是发生在高分子侧链上的化学反应,与一般有机物的分解反应类似,但由于侧链上基团的分解反应可以使高分子链溶解性质发生明显变化,即可以通过控制曝光区域来实现对高分子的溶解性的控制。正性光刻胶与一般负性光刻胶不同,主要是邻重氮醌化合物。
在曝光过程中,邻重氮醌化合物吸收能量引起光化学分解作用,经过较为复杂的反应过程,转变为可溶于显影液的物质,而未经感光的光刻胶则不溶于这种显影剂。因此曝光显影后,所得图像与掩膜相同,所以称作正性光刻胶。由于未经感光的光致抗蚀剂仍然保持它在紫外线照射下发生光分解反应的活性,故该种类型的光刻胶在光刻工艺过程中,能够多次曝光。邻重氮醌化合物都能溶解在乙二醇单甲醚中。为了改善光刻胶的成膜性和增加涂层的耐磨性,可以掺入线性酚醛树脂、聚酚、聚碳酸酯或乙酸乙烯和顺丁烯二酸酐的共聚物;或者将邻重氮醌-5-磺酰氯和带有羟基的树脂进行缩合,而将感光性官能团引入合成树脂的分子链上去。以酚醛树脂为例,连接有邻重氮萘醌结构的酚醛树脂在紫外光照射时可以发生光分解反应,放出氮气,同时在分子结构上经过重排,产生环的收缩作用,从而形成相应的五元环烯酮化合物,五元环烯酮化合物水解后生成茚基羧酸衍生物。茚基羧酸衍生物遇烯碱性水溶液显影。其分辨率高,线条整齐。

高聚物的光分解反应2、深紫外光刻胶随着集成度的提高,光刻胶的分辨率的要求越来越高,所用的光源波长越来越短。因为光刻胶成像时可分辨线宽与曝光波长成正比,与曝光机透镜开口数成反比,所以缩短曝光波长是提高分辨率的主要途径。光刻工艺经历了从g线、i线光刻的近紫外(NUV),进入到深紫外(DUV)248 nm光刻,以及193 nm光刻的发展历程。值得指出的是:现代曝光技术不仅要求高的分辨率,而且要有工艺宽容度和经济性,显然光源的波长越短,光刻胶的分辨率越高,感光树脂合成的难度也越大。光刻技术由i线转入248 nm时,IBM公司开发出化学增幅光刻胶,在体系中采用聚对羟基苯乙烯树脂解决了透光率的问题,并引入了光致产酸剂(PAG,Photo Acid Generator),在光的照射下PAG生成酸,酸作为催化剂催化树脂的反应,通过化学的方法将光学信号进行了放大,解决了感光速率的问题。化学增幅光刻胶曝光速度非常快,大约是线性酚醛树脂光刻胶的10倍;对短波长光源具有良好的光学敏感性;提供陡直侧墙,具有高的对比度;具有0.25μm及其以下尺寸的高分辨率。  248nm光刻胶脱保护反应机理以KrF激光为光源的248nm光刻,已可以生产256M至1G的随机存储器,其最佳分辨率可达0.15μm,但对于小于0.15μm的更精细图形加工,248nm光刻胶已无能为力了,这时候需要193nm(ArF激光光源)光刻。光刻技术从248nm转变为193nm时,由于以前的i线光刻胶、248nm光刻胶由于含有苯环结构,在193nm吸收太高而无法继续使用,因此要寻求一种在193 nm波长下更透明的材料。193nm光刻胶通常选用丙烯酸类树脂,机理上则沿用248nm光刻胶中的化学放大机理。但是丙烯酸树脂类光刻胶的抗蚀能力较差,光刻胶的抗蚀能力与树脂中的碳氢比有关,碳氢比越高,抗蚀能力越强。传统光刻胶及248nm光刻胶的树脂均是以苯环为主体,具有较高的碳氢比,但是丙烯酸树脂的碳氢比相对较低,在光刻后的刻蚀工艺中无法提供足够的抗蚀能力。因此193nm光刻胶常将金刚烷、多环内酯等基团作为保护基引入丙烯酸酯体系中或将稠环烯作为共聚单元引入高分子链中以提高其抗蚀能力。
248nm光刻胶脱保护反应机理以KrF激光为光源的248nm光刻,已可以生产256M至1G的随机存储器,其最佳分辨率可达0.15μm,但对于小于0.15μm的更精细图形加工,248nm光刻胶已无能为力了,这时候需要193nm(ArF激光光源)光刻。光刻技术从248nm转变为193nm时,由于以前的i线光刻胶、248nm光刻胶由于含有苯环结构,在193nm吸收太高而无法继续使用,因此要寻求一种在193 nm波长下更透明的材料。193nm光刻胶通常选用丙烯酸类树脂,机理上则沿用248nm光刻胶中的化学放大机理。但是丙烯酸树脂类光刻胶的抗蚀能力较差,光刻胶的抗蚀能力与树脂中的碳氢比有关,碳氢比越高,抗蚀能力越强。传统光刻胶及248nm光刻胶的树脂均是以苯环为主体,具有较高的碳氢比,但是丙烯酸树脂的碳氢比相对较低,在光刻后的刻蚀工艺中无法提供足够的抗蚀能力。因此193nm光刻胶常将金刚烷、多环内酯等基团作为保护基引入丙烯酸酯体系中或将稠环烯作为共聚单元引入高分子链中以提高其抗蚀能力。
为了进一步提高193nm光刻胶的分辨率,出现了水浸没式193nm光学光刻(其数值孔径高达1.44),将光学光刻的分辨率延续到50nm以下。配合双重曝光技术可以达到32nm节点,采用四重曝光技术可以达到14nm节点。这一技术的缺点是增加了光刻的难度和步骤,增加了成本,降低了生产能力。157nm F2激发态光刻工艺有可能成为传统光学光刻工艺和下一代细微光刻工艺之间的桥梁,是生产临界线宽小于100nm集成电路的首选工艺。同其他光刻胶一样,157nm单层光刻胶设计所面临的问题仍然是:①光吸收及漂白;②水基碱溶液显影;③抗干法腐蚀。可实际上随着曝光波长的缩短,材料的选择愈加困难。对于157nm光刻胶基本材料的光透过率虽然是充分的,但引入成像官能团后可能会使紫外吸收增加,同时给水基碱溶液显影带来问题。线宽的缩小还会使酸扩散及边缘粗糙度的问题愈加突出。实验发现,在聚乙烯分子链上适当引入吸电子基团,如氧或氟原子可使透过率明显提高。例如:高氟化聚乙烯醇类似物或聚乙烯醇均在157nm有很好的透过率。另外,硅聚合物,如硅氧烷等,在157nm有良好的透过率。实验还发现任何π键体系在157nm均有较强吸收,所以必须设计新的酸性基团,例如采用有推电子效应的共轭基团使负电荷稳定,还有利用诱导效应,如六氟异丙醇中的羟基由于共轭碱的诱导稳定性而具有相当的酸性。原本应用的t-BOC酸酯由于含羧基而不能使用,乙缩醛基可能用于替代。除此之外,仍有许多问题需要解决,需要继续研发才能进入实用领域。
3、极紫外光刻胶极紫外光刻胶又称作软X射线(Soft X-ray),其波长为11-14 nm,常用13.5 nm,单光子的能量为91.48eV。相同体积内,相同功率密度的EUV光源和ArF光源相比,EUV光源的光子数要比ArF光源光子数少十分之一。这就要求主体材料中应尽量减少高吸收元素(如F等),或者提高C/H的比例。由于极紫外光非常容易被吸收,所以光学系统(透镜等)和掩膜板都要采用反射来传递图像信息。极紫外光刻技术利用短波长曝光,可以在很小的数值孔径下获得线宽小于100nm的图像。这种光刻胶的设计思路发生了巨大的变化,不再关注树脂的透光性,取而代之的是感光速度、曝光产气控制及随机过程效应(Stochastic effects),主要分为以下几种:①金属氧化物类型:其特点是金属氧化物的引入可以提高体系的吸光度,进而提高光刻的感光速度,另一方面金属氧化物可以提高体系的抗蚀能力,降低光刻胶的膜厚,进一步提高分辨率。
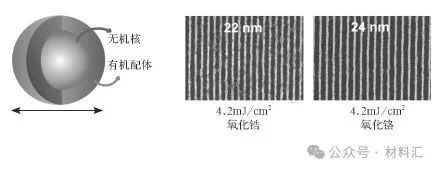
纳米氧化物复合材料光刻胶②化学增幅型光刻胶:即在传统化学增幅型光刻胶的基础上进行性能改进,如采用聚合物键合光致产酸剂(PBP,Polymer Bond PAG)改善线条边缘粗糙度(LER,line edge roughness),在聚合物中加入吸色基团提高对EUV的光子的吸收。
③分子玻璃型光刻胶:将小分子作为光刻胶主体,透过对小分子进行功能化修饰,使其在具备溶解抑制与溶解促进的同时实现优异的涂布性能,小分子为主体可以消除因聚合物分子量分布引起的线条边缘粗糙问题。其核心多为苯环结构,与核心相连的是酸性官能团(如羟基等),有时根据需要可对酸性官能团采取部分保护。此类分子常多为非对称结构,从而避免体系中因π-π堆积而结晶。
④聚对羟基苯乙烯及共聚物:聚对羟基苯乙烯(polyhydroxystyrene, PHS or PHOST)衍生物类体系有两大优点:
(1)不会出现酸扩散现象,所以不会对光刻的分辨率、线边缘粗糙度以及灵敏度产生影响;(2)聚对羟基苯乙烯受EUV辐照后,二次电子产率比其他聚合物都要高,含有多苯环结构能够保证它在图形转移过程中具有较高抗蚀性。所以PHS及其共聚物成为主要研究材料。聚对羟基苯乙烯类光刻胶体系由基质、带有保护基团的聚对羟基苯乙烯衍生物、产酸剂(硫鎓盐等)、酸猝灭剂(三乙胺等)和溶剂(丙二醇甲醚醋酸酯等)组成。例如在低分子量PHS/硫醇/感光剂体系非化学放大负性光刻胶中,光敏剂-羟基环己基苯基甲酮首先受EUV激发产生自由基,从而引发ALOPHS侧链(一般含烯烃或炔烃)与硫醇BPMB发生交联反应,在显影后留在衬底表面。此光刻胶体系在常温真空条件下即可发生光诱导自由基链反应,因此有很高的灵敏性。低分子量PHS增加了光刻胶的分辨率,同普通光刻胶相比,其产气量也有了明显降低。

PHS非化学放大光刻胶体系的反应机理⑤聚碳酸酯类衍生物:又称为断链型光刻胶(Chain-secission Resists)。这种光刻胶的主链上含有易解离的碳酸酯基团,在EUV照射下聚合物分解为CO2和很多低分子量片段,这些片段能够增加在显影液中溶解性能,显影时被除去。这类光刻胶具有很高的分辨率和低的线边缘粗糙度。

聚碳酸酯类化合物的作用机理
(二)辐射线光刻胶以X-射线、电子束或离子束为曝光源的光刻胶,统称为辐射线光刻胶。由于X-射线、电子束或离子束等的波长比深紫外光更短,几乎没有衍射作用,因此在集成电路制作中可获得更高的分辨率。辐射线光刻胶是由线宽小于0.1μm的加工工艺设计的,一般认为,电子束、离子束光刻工艺适用于纳米级线宽。
1、电子束光刻胶电子束辐射刻蚀,就是以高速、高能(通常为10-20 keV)的粒子流与抗蚀剂分子碰撞,利用非弹性碰撞所丧失的能量被分子吸收后,诱发化学反应,抗蚀剂分子、原子吸收这部分能量后,放出二次电子、三次电子,由于激励抗蚀分子等原因而失去能量,渐渐地成为低能电子。组成光刻胶的原子为C、H、O等,这些原子的电离势大约为几十至几百eV。因此,当这些电子(包括二次、三次电子)的能量低至几十电子伏特时,将强烈地诱导化学反应。此外,在电子束电子失去能量的过程中,还会产生多种离子和原子团(化学自由基),它们都有强烈的反应性能,也会引起多种化学反应。引起抗蚀剂分子交联(负性光刻胶)或断裂降解(正性光刻胶),利用曝光后曝光区与非曝光区在溶剂中溶解性以及溶解速率的差异,经显影后得到图像。电子束光刻要求抗蚀剂具有高的灵敏度、对比度以及抗干法蚀刻选择性,由于电子束光刻不存在紫外吸收问题,因而对材料的选择比较广泛。可分为以下几种:
①聚(甲基)丙烯酸甲酯(PMMA)及其衍生物体系:这是最早开发的一种电子束光刻胶体系,此类光刻胶具有优异的分辨率、稳定性和低成本。它是由单体(MMA)聚合而成,MMA单体的分子量为100,组成聚合物分子链的单体数量可达到数千个,分子量为100000量级。PMMA聚合体的物理化学特性在很大程度上取决于分子量。形成PMMA聚合体的原子间共价键可以被高能辐射打破。因此PMMA对波长λ为1nm或更短的射线以及20keV或更高能量的电子辐射敏感,表现为光敏特性。在电子束曝光条件下,PMMA主链发生断裂形成低分子量聚合物片段,作为正性光刻胶使用,但主链断裂需要的曝光能量较高,因此它的感光度比较低。当曝光能量足够高时,PMMA发生交联形成负性光刻胶,最高分辨率可达到10nm。
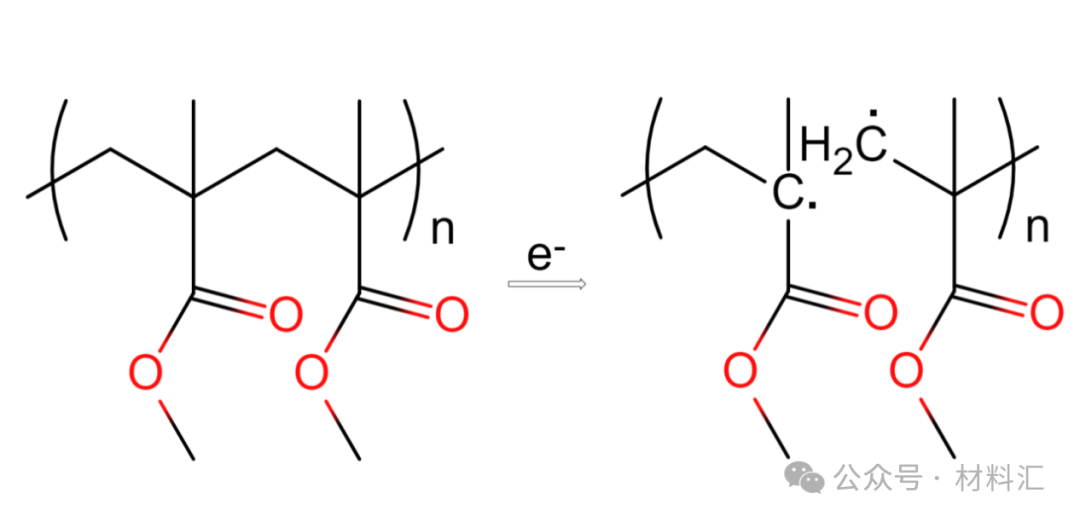 PMMA电子束光刻胶成像机理示意图PMMA的灵敏度在15 kV时为5×10-5C/cm2,比较低,为了提高PMMA的灵敏度,采用了各种方法,除采用与传统光刻胶相似的方法,如增加分子量、使分子量分布高、窄,与某些单体共聚在取代基中引入氯或氟等元素、改进显影液、添加增感剂、改造为化学增幅型光刻胶以外,还采用了预聚合和双层光刻胶等方法:
PMMA电子束光刻胶成像机理示意图PMMA的灵敏度在15 kV时为5×10-5C/cm2,比较低,为了提高PMMA的灵敏度,采用了各种方法,除采用与传统光刻胶相似的方法,如增加分子量、使分子量分布高、窄,与某些单体共聚在取代基中引入氯或氟等元素、改进显影液、添加增感剂、改造为化学增幅型光刻胶以外,还采用了预聚合和双层光刻胶等方法:
——预聚合方法:预先在PMMA中形成一定量的交联结构,例如将聚甲基丙烯酰氯与PMMA反应,在电子束曝光之前加热使PMMA分子间形成一定量的交联结构。若将聚合体通式表示为

:当结构中的R1或R2有一个或两个都是氢原子时,就会发生交联反应。在α位上的氢被脱掉而成为比较稳定的游离基,然后与另外的游离基偶合而交联反应;当R1和R2为氢原子以外的基团(如甲基、卤原子等)时,就会发生降解反应。由于次甲基游离基的不稳定而转位,发生主链的断裂而降解反应。 ——双层光刻胶工艺:底层用甲基丙烯酸甲酯和甲基丙烯酸的共聚物,以乙基纤维素醋酸乙醇为显影剂;表层为PMMA,以甲基异丁酮为显影剂。这样,经强迫显影后,虽然表层的PMMA膜层减薄了很多,但剩下的厚度对底层的抗蚀膜仍能起到保护作用,底层的抗蚀膜厚度没有损失,这种方法可达到2×10-6C/cm2的灵敏度。其中强迫显影指使用光刻胶的良溶剂作为显影剂使用,能使显影速度加快,从而提高灵敏度,但良溶剂显影对未曝光区域也会溶解,只是比较慢,所以经强迫显影后,曝光区域的抗蚀膜可以完全去掉,未曝光区域的抗蚀膜也相应的要去掉一些,从而引起图形畸变,光刻胶膜溶胀,尺寸不易控制等问题。
②聚(烯烃-砜)体系:聚(烯烃-砜)是一类高敏感度,高分辨率的用于电子束正性光刻胶成膜树脂,其中主链中的C-S键键能比较弱,为259.59 kJ/mol,所以在电子束曝光下易发生断裂,引起聚(烯烃-砜)主链的分解,使得分子量变小,选择适当的显影液,被曝光的低分子量部分溶解掉,未曝光的高分子量部分得以保留,形成正性图形。

最常见的聚烯砜(PBS)的结构聚(烯烃一砜)相比于PMMA具有更高的感光度和分辨率。PBS的灵敏度可达8×10-7C/cm2,但也受显影剂的影响。若只用甲基异丁酮显影时,灵敏度只为(2~4)×10-6C/cm2。为了加强甲基异丁酮的显影性能,可以添加少量的四氯乙烷等良溶剂。最佳的显影液是良溶剂和不良溶剂的混合液,例如由四氯乙烷和二异丁酮组成的混合液。用这种显影液,显影时间小于45s,可得到8×10-7C/cm2的灵敏度。PBS也可用作自显影光刻胶,在用高剂量照射时,它可完全气化蒸发,而无需用溶剂显影。③不饱和体系:若聚合物中含有双键,很容易在电子束照射下发生交联反应,因此常用的负性光刻胶如聚乙烯醇肉桂酸酯和叠氮-橡胶系光刻胶都可用来做负性电子束光刻胶,但灵敏度较低。烷基乙烯基醚和顺丁烯二酸酐共聚体的烯丙酯是一个灵敏度较高的负性电子束光刻胶(灵敏度可达4×10-8C/cm2),而且稳定性好。另一种常用的负性胶是氯甲基苯乙烯的聚合物或它和苯乙烯的共聚物(PCMS),它们的灵敏度可达4×10-7C/cm2,分辨率也好,且可耐干法腐蚀,具有较好的综合性能。在乙烯基的α-位置上具有甲基或其他原子团的聚合物都具有正性电子束光刻胶的性能,但性能一般不优于PMMA。典型的例子是聚α-甲基苯乙烯、聚异丁烯、聚甲基乙丙烯基酮、聚甲基丙烯酰胺(PMAA)、聚α-氰基丙烯酸乙酯(PCEA)等。其中,PMAA的灵敏度较高,在20 kV时可达到4×10-7C/cm2,并能用水或弱碱溶液显影;PCEA的灵敏度也较高,在15 kV时可达到3×10-7C/cm2,为了减弱溶胀和畸变,在显影时将PCEA的良溶剂(如乙酸乙酯,环乙酮等)和不良溶剂(如甲基异丁酮)混合使用,例如以2:1的混合液作显影液。
不饱和电子束光刻胶类型 | |
电子束光刻胶类型 | 聚合物名称 |
交联型(负性) | 聚乙烯 |
聚丙烯 | |
聚苯乙烯 | |
聚丙烯酸 | |
聚丙烯酸甲酯 | |
聚丙烯酰胺 | |
聚乙烯基烷基醚 | |
聚乙烯基甲基醚 | |
降解型(正性) | 聚异丁烯 |
聚α-甲基苯乙烯 | |
聚甲基丙烯酸甲酯 | |
聚甲基丙烯酰胺 | |
聚甲基异丙烯基酮 | |
④环氧体系:环氧基树脂由于分子链含有环氧活性基团,因此很容易通过环氧阳离子开环聚合反应产生交联,形成三维网状结构,曝光区域在显影液中不溶,从而形成负性光刻胶,这类型负胶又称为环氧基负胶。在受电子束曝光时产生活性氧中心,此中心再攻击相邻环氧基团,形成共价键产生交联,环氧基开环率较高,灵敏度也较高。其中最重要的品种是甲基丙烯酸环氧丙酯与丙烯酸乙酯的共聚体(COP),这种负性胶的灵敏度变动范围宽,可由分子量和环氧含量调节,其缺点是显影时易溶胀,剖面轮廓粗糙,从而使分辨率受到影响。
⑤树枝状聚合物体系:由树枝状聚合物和PAG组成,其聚合物是基于三苯基的骨架通过化学键连接其他苯基的树枝状物质,当电子束曝光时,产酸剂产酸,经后烘脱去保护基团,在碱溶液显影中形成正型图形,但T型(T-top)现象严重,在有机溶剂中显影可以成为负型图形,此种类型的光刻胶最小可以获得100nm的线条分辨率。
⑥分子玻璃体系:分子玻璃为无定形的有机小分子化合物,具有明确的分子结构,较小的分子尺寸和单一的分子量分布。早期的分子玻璃抗蚀剂是基于树枝状的联苯体系,因为联苯体系分子玻璃材料是热稳定性好的非平面、刚性较强的分子,具有较高的抗蚀刻性,因此成为分子玻璃光刻胶材料的首选,如1,3,5-(α-萘)苯、1,3,5-三烷基-2-吡唑啉等。由叔丁氧基羰基(t-BOC)保护的分子玻璃,在产酸剂存在的条件下,通过电子束成像形成图像,通过运用化学增幅技术,分子玻璃抗蚀剂具有较高的感光度可与高聚物抗蚀剂相媲美。
⑦有机硅及碳材料体系:在聚合物结构中引入具有低吸收的元素,如硅、硼等,得到有机-无机杂化聚合物光致抗蚀剂,不仅可以减少高吸收的氧元素的含量以提高透明性,而且还可增强体系的抗蚀刻性。例如在光刻胶中掺杂富勒烯可以提高光刻胶的抗蚀性;聚氢硅烷体系的光刻胶经电子束曝光后,体系中Si-H键断裂,形成自由基,因此,曝光区的聚氢硅烷会交联形成三维的网状结构,在显影液中不溶,常用作负性光刻胶;聚乙烯基硅氧烷(PVS)的灵敏度为5×10-6C/cm2,但具有高的分辨率。有机硅树脂加热或在O2活性离子束腐蚀(O2RIE)作用下可转变为SiO2。利用这一特点,可将有机硅光刻胶作为双层光刻胶系统的上层,经曝光显影后,残留的胶膜可在O2RIE作用下形成SiO2薄层,从而保护下层胶不受O2RIE的作用;有一种有机硅烷醇低聚物和硫鎓盐混合可得一负性光刻胶,在电子束作用下,鎓盐分解产生强酸,产生的强酸在烘烤时催化有机硅烷醇低聚物缩合成不溶物。
⑧酚醛树脂体系:线性酚醛树脂最早是应用在近紫外曝光中,但由于具有较好的耐热性和抗干法刻蚀,也成为优良的电子束光刻材料。其中正性光刻胶矩阵聚合物主要有酚醛树脂、部分被保护的对羟基苯乙烯和对羟基苯乙烯的共聚物,以及乙烯基醚共聚物。在电子束照射下,感光剂产酸使阻溶剂发生化学变化由阻溶变为可溶或促溶,或者光产酸剂发生的酸直接催化矩阵树脂发生降解而使曝光区变得在碱溶液中可溶,从而制得负性和正性图形。⑨聚碳酸酯体系:聚碳酸酯类非化学增幅正型光刻胶,又被称为断链型光刻胶(Chain—secission Resist),这种光刻胶的主链上含有易解离的碳酸酯基团,在电子束曝光下聚合物分解成CO2和很多低分子量片段,能够增加在显影液中溶解性能,显影时被除去。
2、X射线光刻胶X射线对物质的化学作用类似电子束,X射线曝光时,X射线本身并不能直接引起光刻胶的反应,它的能量是消耗的光电子放射过程而产生低能电子束上。正是这些低能电子使光刻胶的分子离化,并激励产生化学反应,使光刻胶分子间的结合键解离,或键合成高分子,在某些显影液中变成易溶或不溶。X射线光刻胶和电子束光刻胶没有本质的区别,因此所有的电子束胶都可以与X射线光刻胶混用,一部分248nm光学光刻胶亦可用作X射线光刻胶,X射线光刻胶的分辨率十分高,例如早期正性的光刻胶有用含氟的聚甲基丙烯酸酯,负胶有用甲基丙烯酸缩水甘油酯-丙烯酸乙酯共聚体和聚丙烯酸-2,3-二氯-1-丙酯。3、离子束光刻胶离子束光刻技术可分为聚焦离子束光刻、离子束投影式光刻。聚焦离子束光刻用途广泛,常以镓离子修补传统及相位转移掩膜板;离子束投影式光刻主要使用150keV的H+、H2+、H3+、He+,以镂空式模板,缩小投影(4~5倍)。离子束光刻与电子束直写光刻技术类似,不需要掩膜板,应用高能离子束直写。离子束的散射没有电子束那么强,因此具有更好的分辨率。液态金属离子源为最简单的曝光源:在钨针或钼针的顶端附上镓或金硅合金,加热融化后经由外层为液态金属表面产生的场使离子发射,其发射面积很小(<10 nm),因此利用离子光学系统可较容易地将发射的离子聚焦成细微离子束,从而进行高分辨率的离子束曝光。
(三)纳米压印技术

热压印与紫外压印原理示意图纳米压印技术是通过压模来制作微纳特征的一种图形转移技术,其最明显的优势是高产能、高分辨率、低成本,主要工艺流程:模板制作、硅衬底滴胶、压印、曝光、脱模、离子刻蚀,图像精度可以达到5nm。使用的光刻胶种类主要分为两种:①热压印光刻胶:把光刻胶加热到玻璃化转变温度以上,将预先制作好的带有微图形特征的硬模版压入光刻胶中,待光刻胶冷却后抬起模板,从而将模板上的微特征转移到光刻胶上。光刻胶材料主要有:聚甲基丙烯酸酯体系、烯丙基酯接枝低聚物、Hybrane体系、聚二甲基硅烷体系等。 ②紫外压印光刻胶:使用透明的模板,将预先制作好的带有微图形特征的硬模版压入常温下液态光刻胶中,用紫外光将光刻胶固化后抬起模板,从而将模板上的微特征转移到光刻胶上。按照光引发反应机理,可分为自由基聚合和阳离子聚合两大体系。光刻胶材料主要有甲基丙烯酸酯体系、有机硅改性的丙烯酸或甲基丙烯酸酯体系、乙烯基醚体系、环氧树脂体系等。采取接触式方法的压印光刻技术最关键的问题是脱模,光刻胶具有良好的脱模性能才能保证纳米结构的高精度复制以及预防模板沾污。
三、性能指标
1、灵敏度灵敏度(Sensitivity)即光刻胶上产生一个良好的图形所需一定波长光的最小能量值(或最小曝光量)。单位:毫焦/平方厘米或mJ/cm2。光刻胶的敏感性对于波长更短的深紫外光(DUV)、极深紫外光(EUV)等尤为重要。负胶通常需5~15s时间曝光,正胶较慢,其曝光时间为负胶的3~4倍。灵敏度反映了光刻胶材料对某种波长的光的反应程度。不同的光刻胶对于不同的波长的光是有选择性的,比如248nm波长光刻胶的成膜树脂中存在苯环结构,对193nm波长的光具有很强的吸收作用,即对193nm波长的光是不透明的,因此193nm光刻胶必须改变树脂主体。同时,高的产出要求短的曝光时间,对光刻胶的灵敏度要求也越来越高。通常以曝光剂量作为衡量光刻胶灵敏度的指标,曝光剂量值越小,代表光刻胶的灵敏度越高。i线光刻胶材料曝光剂量在数百mJ/cm2左右,而KrF和ArF的光刻胶材料,其曝光剂量则在30和20mJ/cm2左右。灵敏度可以体现于光刻胶的对比度曲线上。 2、对比度对比度(Contrast)指光刻胶材料曝光前后化学物质(如溶解度)改变的速率。对比度的定义如下:

式中,DL为所有光刻胶被去掉所需的最低能量剂量,即灵敏度(也称为曝光阈值);D0为光刻胶开始进行光化学反应作用的最低能量。对比度可以被认为是光刻胶区分掩膜版上亮区和暗区能力的衡量标准,且辐照强度在光刻胶线条和间距的边缘附近平滑变化。光刻胶的对比度越大,线条边缘越陡,典型的光刻胶对比度为2~4。对于理想光刻胶来说,如果受到该阈值以上的曝光剂量,则光刻胶完全感光;反之,则完全不感光。实际上,光刻胶的曝光阈值存在一个分布,该分布范围越窄,光刻胶的性能越好。通常它是由如下方法测定的:将一已知厚度的光刻胶薄膜旋转涂布于硅晶片之上,再软烤除去多余的溶剂;然后,将此薄膜在不同能量的光源下曝光,再按一般程序显影。测量不同曝光能量的光刻胶薄膜厚度,再对曝光能量作图,即可由曲线线性部分的斜率求得对比度。如图所示,γp和γn分别为正光刻胶和负光刻胶材料的对比度。同时,也可以得到该光刻胶的灵敏度(图中的DL为灵敏度)。
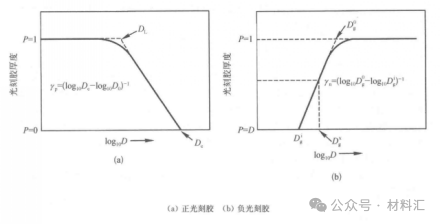
显影薄膜的厚度与曝光能量的关系3、分辨率分辨率(resolution,R)即光刻工艺中所能形成最小尺寸的有用图像。是区别硅片表面相邻图形特征的能力。一般用关键尺寸(CD,Critical Dimension)来衡量分辨率。形成的关键尺寸越小,光刻胶的分辨率越好。此性质深受光刻胶材质本身物理化学性质的影响,必须避免光刻胶材料在显影过程中收缩或在硬烤中流动。因此,若要使光刻材料拥有良好的分辨能力,需谨慎选择高分子基材及所用的显影剂。对于分辨率有:


式中,R为分辨率,DOF为焦深,λ为波长,NA为光学系统的数值孔径。分辨率和焦深都是光刻中图像质量的关键因素。在光刻中既要获得更好的分辨率来形成关键尺寸图形,又要保持合适的焦深是非常矛盾的。虽然分辨率非常依赖于曝光设备,但是高性能的曝光工具需要与之相配套的高性能的光刻胶才能真正获得高分辨率的加工能力。
4、抗蚀性抗蚀性(Anti-etching;Etching resistance)即光刻胶材料在刻蚀过程中的抵抗力。在图形从光刻胶转移到晶片的过程中,光刻胶材料必须能够抵抗高能和高温(>150℃)而不改变其原有特性。在后续的刻蚀工序中保护衬底表面。耐热稳定性、抗刻蚀能力和抗离子轰击能力。在湿法刻蚀中,印有电路图形的光刻胶需要连同硅片一同置入化学刻蚀液中,进行很多次的湿法腐蚀。只有光刻胶具有很强的抗蚀性,才能保证刻蚀液按照所希望的选择比刻蚀出曝光所得图形,更好体现器件性能。在干法刻蚀中,例如集成电路工艺中在进行阱区和源漏区离子注入时,需要有较好的保护电路图形的能力,否则光刻胶会因为在注入环境中挥发而影响到注入腔的真空度。此时注入的离子将不会起到其在电路制造工艺中应起到的作用,器件的电路性能受阻。
5、纯度纯度(Purity)指光刻胶必须在微粒含量、钠和微量金属杂质及水含量方面达到严格的标准要求。集成电路工艺对光刻胶的纯度要求是非常严格的,尤其是金属离子的含量。如由g线光刻胶发展到i线光刻胶材料时,金属Na、Fe和K离子的含量由10-7降低到了10-8。
6、黏附性黏附性(Adherence)是表征光刻胶黏着于衬底的强度。主要衡量光刻胶抗湿法腐蚀能力。它不仅与光刻胶本身的性质有关,而且与衬底的性质和其表面情况等有密切关系。作为刻蚀阻挡层,光刻胶层必须和晶圆表面黏结得很好,才能够忠实地把光刻层图形转移到晶圆表面层,光刻胶的黏附性不足会导致硅片表面的图形变形。光刻胶的黏附性必须经受住后续工艺(刻蚀、离子注入等)。通常负胶比正胶有更强的黏结能力。
7、黏度黏滞性/黏度(Viscosity)是衡量光刻胶流动特性的参数。黏滞性随着光刻胶中的溶剂的减少而增加;高的黏滞性会产生厚的光刻胶;越小的黏滞性,就有越均匀的光刻胶厚度。光刻胶的比重(SG,Specific Gravity)是衡量光刻胶的密度的指标,它与光刻胶中的固体含量有关。较大的比重意味着光刻胶中含有更多的固体,黏滞性更高、流动性更差。黏度的单位:泊(P,1 P=10-1Pa·s),光刻胶一般用厘泊(cP,1 cP=10-2P)来度量。百分泊即厘泊为绝对黏滞率;运动黏滞率定义为:运动黏滞率=绝对黏滞率/比重。单位:百分斯托克斯(cst)=1 mm2/s。大多数光刻胶生产商用在光刻胶中转动风向标的方法测量黏度。8、表面张力表面张力(surface tension)指液体中将表面分子拉向液体主体内的分子间吸引力。光刻胶应该具有比较小的表面张力,使光刻胶具有良好的流动性和覆盖。
9、针孔针孔是光刻胶层尺寸非常小的空穴。针孔是有害的,因为它可以允许刻蚀剂渗过光刻胶层进而在晶圆表面层刻蚀出小孔,针孔是在涂胶工艺中有环境中的微粒污染物造成的,或者由光刻胶层结构上的空穴造成的。光刻胶层越厚,针孔越少,但它却降低了分辨力,光刻胶厚度选择过程中需权衡这两个因素的影响。正胶的纵横比更高,所以正胶可以用更厚的光刻胶膜达到想要的图形尺寸,而且针孔更少。10、热流程光刻工艺过程中有两个加热的过程:软烘焙和硬烘焙。工艺师通过高温烘焙,尽可能使光刻胶黏结能力达到最大化。但光刻胶作为像塑料一样的物质,加热会变软和流动,对最终的图形尺寸有重要影响,在工艺设计中必须考虑到热流程带来的尺寸变化。热流程越稳定,对工艺流程越有利。
11、其他在实际的工艺中光刻胶的选择还必须考虑硅片表面的薄膜种类与性质(反射率、亲水性或疏水性)和产品图形所需的解析度。
四、制备方法
(一)紫外负性胶1、环化聚异戊二烯橡胶将高纯度异戊二烯单体在催化剂存在下进行聚合,再将聚异戊二烯橡胶在二甲苯中溶解,以对甲苯磺酸为催化剂进行环化,所得环化产物经精制、过滤,再与溶剂、交联剂等其余组分配胶,即得成品。

环化聚异戊二烯橡胶光刻胶合成反应方程式(1)生产工艺

环化聚异戊二烯橡胶光刻胶工艺流程①环化橡胶的制备:在聚合反应釜中加入高纯度的异戊二烯单体和溶剂无水二甲苯,加入催化剂后进行离子聚合反应,制得聚戊二烯。将所得聚异戊二烯加入不锈钢的环化反应釜中,再加入溶剂无水二甲苯,再通入氮气的条件下加入环化催化剂对甲苯磺酸进行环化反应,反应达一定程度后测定反应物环化率,通过环化率的测定,确定反应重点,重点确定后,向反应体系中加入终止剂终止环化反应,即得环化聚异戊二烯橡胶。 用醋酸水溶液洗涤环化橡胶,除去未参加反应的聚合物,采用离心分离法精制。
②浓缩:精制后的胶液中含有微量水分,微量水分的存在对胶性能的影响很大,采用浓缩法使微量水分随二甲苯共沸蒸出。
③调胶:将所制得的环化橡胶液计量后加入不锈钢调胶釜中,再加入定量的交联剂、添加剂搅拌混合,并按所需浓度加入溶胶溶剂无水二甲苯,稀释到一定黏度,保证其固体分含量为12%~26%。④过滤:在特别的不锈钢过滤器中,采用聚四氟乙烯超滤过滤膜。在氮气保护和加压下将光刻胶过滤2~3次,第一次除去1μm以上的粒子,第二次除去0.1μm以上的粒子,即制得环化聚异戊二烯橡胶负性光刻胶。⑤包装:采用玻璃瓶作容器,先用超声波清洗玻璃瓶,经超净干燥处理,然后在100级净化室内包装。用氮气加压贮罐中的胶液,进行灌装,计量后密封,外加遮光袋,置入纸盒中。
(2)产品性能淡黄至琥珀色黏性、清亮透明液体。受光、受热会发生聚合反应,易受氧影响,易燃,闪点31℃,易溶于苯、酮等溶剂。对二氧化硅、晶硅及金属有良好的黏附性,对醛、碱有很好的抗蚀性能。
(3)产品标准
产品标准 | |
指标名称 | 指标 |
外观 | 浅黄至琥珀色透明液体 |
固体含量 | 12%~26% |
黏度(30℃) | 30、45、60、100、150、300、350、550MPa·s |
膜厚 | 4.05~6.00μm |
分辨率 | 2.5~20.0μm |
针孔密度 | ≤8个/cm3 |
水分 | ≤0.02~0.03% |
灰分 | <3% |
金属杂质 | ≤1×10-8 |
(4)主要原料高聚物:环化聚异戊二烯橡胶。交联剂:2,6-双(4'-叠氮亚苄基)-4-甲基环己酮。溶剂:甲苯等芳香烃。 添加剂:根据需要使用,包括少许增黏剂和防光晕染料。
2、聚乙烯醇肉桂酸酯将精制的聚乙烯醇放入吡啶中溶胀,滴加由肉桂酸与二氯亚砜反应制得的肉桂酰氯进行酯化反应。经洗涤、过滤、干燥后,与配胶组成中的其余组分混合,即得光刻胶成品。

聚乙烯醇肉桂酸酯光刻胶合成反应方程式(1)生产工艺

聚乙烯醇肉桂酸酯光刻胶工艺流程①肉桂酰氯的制备:先将肉桂酸加入酰氯化反应器中,然后加入SOCl2[m(肉桂酸):m(二氯亚砜)=1.0:4.2],迅速反应,加热升温至回流,维持温度100~110℃,反应至计泡器中无气泡析出为止。酰氯化反应时间3~4 h。反应完成后得棕黄色液体,先于50℃下用水力真空泵抽去未反应的SOCl2,全部抽净后用机械真空泵减压蒸馏,收集122~123℃、1067 Pa馏分,冷却后得浅黄色固体,即得肉桂酰氯。
②聚乙烯醇肉桂酸酯的制备:先将精制的聚乙烯醇与50%的无水吡啶混合均匀,将此混合液加入酯化反应釜中,于100℃下保温溶胀12 h,待温度降至50~55℃后,加入剩余的50%的无水吡啶,于搅拌下缓慢滴加肉桂酰氯,温度控制在50~55℃,滴加完毕,于50~60℃条件下继续反应4 h,反应液逐渐变成黏稠体,同时有晶体析出。加入丙酮稀释、过滤,然后将滤液缓慢倒入蒸馏水中,聚乙烯醇肉桂酸酯呈纤维状沉淀析出,过滤后用水洗至无氯负离子,最后于暗处在50~60℃下干燥至恒重。
③光刻胶的配制:其配胶组成高聚物(聚乙烯醇肉桂酸酯)、增感剂【5-硝基苊(加入量一般不大于聚乙烯醇肉桂酸酯质量的10%)】、溶剂(环己酮)及所需的添加剂混合,待聚乙烯醇肉桂酸酯溶解完成全后,充分搅拌,将各组分混合均匀,即得聚乙烯醇肉桂酸酯光刻胶。
(2)产品标准
产品标准 | ||
指标名称 | 指标 | |
外观 | 浅黄色液体 | |
固体含量 | 9%~10% | |
黏度(30℃) | 65±5 MPa·s | |
分辨率 | 2~4 μm | |
针孔密度 | 膜厚0.4~0.6μm | ≤4.5个/cm3 |
膜厚1μm | ≤0.5个/cm3 | |
水分 | ≤0.15% | |
金属杂质 | ≤1×10-8 | |
3、聚乙烯氧乙基肉桂酸酯由氯乙醇分子间脱水制得二氯二乙基醚,然后在碱性条件下二氯二乙基醚脱一分子氯化氢,得到2-氯乙基乙烯基醚,2-氯乙基乙烯基醚再与肉桂酸钠发生酯化,得到聚合单体,最后单体聚合得成品。
(1)生产工艺

聚乙烯氧乙基肉桂酸酯合成工艺流程氯乙醇及硫酸在反应釜中经脱水反应生成二氯二乙基醚,二氯二乙基醚再在氢氧化钠作用下,加热至200~220℃发生消去反应制得2-氯乙基乙烯基醚,2-氯乙基乙烯基醚与由氢氧化钠和肉桂酸作用生成乙烯氧乙醇肉桂酸酯单体。单体经精制,在三氟化硼乙醚催化剂作用下在聚合釜内于低温进行阳离子聚合得成品。(3)产品标准
产品标准 | |
指标名称 | 指标 |
外观 | 淡黄色透明液体 |
固体含量 | 10%~15% |
黏度(25℃) | 0.030~0.045 Pa·s |
感光性 | 感光范围250~475nm,特别对436nm敏感 |
分辨率 | 1μm |
水分 | <0.2% |
灰分 | <3% |
金属杂质(Na、K、Mn、Fe、Al) | <1×10-8 |
4、聚酯型光刻胶(1)生产方法——直接缩聚法:以对甲苯磺酸为缩聚催化剂,由肉桂叉丙二酸和乙二醇直接缩合制得聚肉桂叉丙二酸乙二醇酯。
直接缩聚合成聚肉桂叉丙二酸乙二醇酯——酯交换法:由肉桂叉丙二酸二乙酯和乙二醇进行酯交换反应生成聚酯。反应分两步进行。  酯交换法合成聚肉桂叉丙二酸乙二醇酯
酯交换法合成聚肉桂叉丙二酸乙二醇酯
(2)生产工艺——直接缩聚法:在缩合反应釜中按缩聚催化剂n(甲苯磺酸):n(肉桂叉丙二酸):n(乙二醇)=1400的比例加入缩聚反应原料,在避光并由氮气保护的条件下进行缩聚反应,氮气还能带走反应放出的水分;反应开始时,将物料升温至170℃,保温反应2.5~3.0 h;再将物料升温至200℃,同时抽真空(真空度为400~667 Pa)继续反应。待缩聚反应完成后,将物料稍降温,并再氮气保护下趁热放料,物料冷却后固化,将固体粉碎即制得聚亚肉桂基丙二酸乙二醇酯。——酯交换法:在不锈钢反应釜中,加入70份肉桂叉丙二酸二乙酯、35份乙二醇,将通氮管插入液面下,通氮赶出釜内空气,于搅拌下加入0.044份乙酸锌,在氮气保护下加热升温进行反应,当釜内温度升至150℃左右时,开始有乙醇蒸出,随着反应温度的升高,乙醇流出速度加快,将物料温度升至160℃,保温反应5~6 h,再将温度升至170℃,保温反应5~6 h,在此期间蒸出乙醇的量应达蒸出乙醇投料量的85%以上,然后升温至180℃,保温反应2~3 h,再升温至190℃,保温反应1~2 h,这时乙醇蒸出速度已很慢,停止加热,继续搅拌和通氮,待内温降至150℃以下时,取出通氮管,加入0.02份乙酸锌、0.036份三氧化二锑,开始抽真空(真空度133~267 Pa),加热升至220℃。抽真空开始时,有大量的液体流出,主要是未蒸出的乙醇和过量的乙二醇,很快就没有馏出物馏出,再过十几分钟后又有馏出物滴出这是缩聚反应放出的乙二醇,开始是无色透明的液体,后来有淡黄色油状物馏出,抽真空反应6 h后,反应液显著变黏稠,达反应终点时,先停止抽真空,压氮气出料。冷却后变成又硬又脆的固体,粉碎后即制得聚肉桂叉丙二酸乙二醇酯。 ——配制光刻胶:聚酯型光刻胶由高聚物(聚亚肉桂基丙二酸乙二醇酯)、溶剂(环己酮)和增感剂(5-硝基苊)及所需的添加剂配制而成。一般配比m(高聚物):m(溶剂):m(增感剂)=15.00.3。根据不同的光刻对象,可调节胶的浓度。配制时,将各组分混合,充分搅拌至高聚物全部溶解(有时有少量不溶物)后,用漏斗或不锈钢过滤器过滤,即得聚酯型光刻胶。
产品标准 | |
指标名称 | 指标 |
外观 | 浅黄色透明液体 |
固体含量 | 12±1% |
感光性 | 最大紫外光吸收340~400 nm,感光波长至500 nm |
水分 | ≤0.08% |
金属杂质 | (1~2)×10-8 |
相对密度(d254) | 0.9640~0.9740 |
折射指数(25℃) | 4.4670~4.4740 |
分辨率 | 1~2 μm |
运动黏度 | 8~25 mm/s |
5、紫外正性胶(1)生产方法由混合甲酚与甲醛缩聚制得酚醛树脂。以β-萘胺经重氮化、氧化生成邻重氮萘醌,再与磺酰氯反应生成2-重氮-1-萘醌-5-磺酰氯(215磺酰氯),然后2-重氮-1-萘醌-5-磺酰氯与三羟基二苯甲酮发生酯化,得到感光剂。将甲酚醛树脂、树脂、感光剂、添加剂和溶剂按一定比例混合配胶,制得紫外正性光刻胶。  701正性光刻胶合成反应方程式
701正性光刻胶合成反应方程式
生产配方 | |
原料名称 | 用量/份(质量) |
215磺酰氯(≥98%) | 70~80 |
丙酮 | 700~800 |
混甲酚(有效酚≥95%) | 350 |
甲醛(36~37%) | 200 |
三羟基二苯甲酮 | 45~50 |
乙二醇单乙醚乙酸酯(添加剂) | 650~700 |
(2)生产工艺
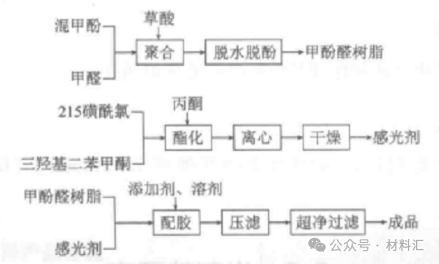
正性光刻胶工艺流程合成甲酚醛树脂:将原料混甲酚和甲醛送入不锈钢釜,加入适量草酸为催化剂,加热回流反应5~6 h,然后减压蒸馏去除水及未反应的单体酚,得到甲酚醛树脂。合成感光剂:在装有搅拌器的夹套反应罐中,先将三羟基二苯甲酮和215磺酰氯加至丙酮中搅拌下溶解,待完全溶解后,滴加有机碱溶液作催化剂,控制反应温度30~35℃,滴加完毕后,继续反应1 h。将反应液冲至水中,感光剂析出,离心分离,干燥。配胶:先将合成的树脂、感光剂与溶剂及添加剂按一定比例混合配胶,然后调整胶的各项指标使之达到要求,最后过滤分装。过滤分装:光刻胶经过板框式过滤器粗滤后,转入超净间(100级)进行超净过滤,滤膜孔径0.2 μm;经超净过滤的胶液分装即得成品。(3)产品性能 遇热分解,于0~25℃下保存。
产品标准 | |
指标名称 | 指标 |
外观 | 琥珀色或紫红色透明液体 |
感光性 | 最大紫外光吸收340~400 nm,感光波长至500 nm |
水分 | <0.5% |
灰分 | <30×10-6 |
金属杂质 | <1×10-8 |
(4)主要原料
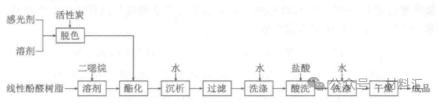
701正性光刻胶工艺流程感光剂:2-重氮-1,2-萘醌-5-磺酰氯。成膜剂:成膜剂是正胶的基本成分,它对光刻胶的黏附性、抗蚀性、成膜性及显影性均有影响,常用的为酚醛树脂,一般为了获得线型酚醛树脂,采用酚量多于醛量,以草酸作催化剂进行缩聚,反应后用水蒸气蒸馏脱酚,经热水水洗、冷却后即得线性酚醛树脂。 添加剂:正胶中加入少量硫脲或脂肪酸如癸酸,有稳定作用,用羟基亚苄基丙酮可以增加胶的稳定性和批与批之间的重复性,加入表面活性剂可以改善胶的涂布性能。
其他生产配方 | ||
配方 | 原料名称 | 用量/份(质量) |
一 | 聚乙烯醇肉桂酸酯(干燥的) | 10.0 |
5-硝基苊 | 1.0 | |
环己酮 | 94.8 | |
为负型光刻胶,在制造微型电路时,将光刻胶涂在半导体或其他金属上,经感光后,光刻胶照射部分硬化,成为抗腐蚀的坚硬薄膜层。将未感光部分经清洗或化学腐蚀法处理,得微型电路。 | ||
二 | 聚乙烯醇肉桂酸酯 | 16.84 |
线性酚醛树脂 | 4.30 | |
噻唑啉系光敏剂 | 0.16 | |
对苯二酚 | 0.08 | |
氯苯 | 143.30 | |
环己酮 | 38.32 | |
为柯达公司配方,为负型光刻胶。涂布在线路板、半导体基片或其他基材的表面,经光照后,用化学腐蚀或其他方法制成线路图板。 | ||
三 | 间甲酚甲醛树脂 | 45 |
光敏剂 | 15 | |
结晶紫 | 1 | |
苦味酸 | 1 | |
氨丙基三乙氧基硅烷(增黏剂) | 2 | |
硬脂酸 | 0.66 | |
甲基溶纤剂乙酸酯 | 135.34 | |
该配方为奥林公司的光刻胶配方。 | ||
四 | 重氮萘醌磺酸酯 | 20 |
酚醛树脂 | 40 | |
环氧树脂 | 2 | |
乙醇/乙醚 | 320 | |
为正型光刻胶。可见光也极易使其感光。 | ||
6、深紫外光刻胶(1)生产方法193 nm光刻胶的主体树脂是以降冰片烯-5-羧酸-(8-乙基三癸基)酯为单体合成的。单体的合成以三环癸烷-8-酮为起始原料,与乙基格氏试剂反应后水解得对应的醇,再与丙烯酰氯发生酯化,最后与环戊二烯发生Diels-Alder[4+2]环加成反应,得单体。单体与引发剂发生共聚反应得共聚物,共聚物再与PAG、添加剂、溶剂配胶,经粗滤、精滤后,得成品。

193 nm光刻胶合成反应方程式(2)生产工艺单体合成所用玻璃仪器都要经100℃烘干并趁热搭起来,整个反应全过程要在氮气保护下完成。
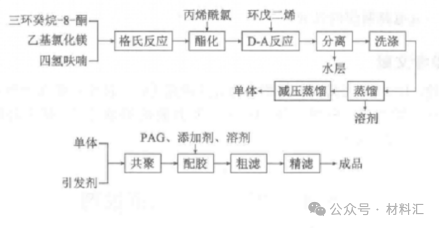
193 nm光刻胶工艺流程 在2L的四口烧瓶上安装氮导管、温度计、搅拌、橡胶隔片,通过双针头管向瓶内压入400 g含25%乙基氯化镁(EtMgCl)的四氢呋喃(THF)溶液,用干冰冷却至-30~-25℃。在另一三口反应烧瓶上安装N2导入管、玻璃塞子、橡胶隔片,通过双针头管向瓶内压入153.6 g三环癸烷-8-8酮(TCD)和480 g无水THF。当上述乙基氯化镁溶液冷至-30~-25℃时,用N2向内压入TCD溶液,压入所用时间约2 h,压完后移去冷槽,再搅拌反应2 h。然后把反应液再次冷却至-30~-25℃,用125 mL的恒压漏斗向反应液中滴加108 g丙烯酰氯,滴加时间为1.0~4.5 h,滴完后移去冷槽,升温至室温搅拌过夜,从琥珀色透明溶液中会出现白色沉淀。过夜后,用125 mL的恒压漏斗向反应液中滴加75 g新裂解的环戊二烯,滴完后,加去离子水至所有的盐均溶解并分成两层,上层有机层用1×500 mL饱和Na2CO3洗,再用2×500 mL去离子水洗后,用无水硫酸镁干燥,过滤后旋转蒸发除去THF,得橙色油300 g,减压蒸馏收集158℃、666 Pa馏分,得189 g纯的单体降冰片烯5-羧酸-(8-乙基三环癸基)酯。将上述制备的高纯度单体按一定比例投料,加四氢呋喃溶解,充氮气赶走反应瓶内的空气,加热回流下滴加AIBN,滴完后,在N2保护下回流过夜。反应液加入正己烷中,析出聚合物粉末,粉末再用THF溶解后,重新用正己烷析出,再次得到的聚合物粉末,经真空干燥,烘干得主体树脂。将主体树脂、光致产酸剂、添加剂按比例依次加入溶剂中,配成一定溶度(含量10%~20%)的溶液,搅拌使各组分完全溶解后,先进行粗级过滤,粗滤后再经0.2 μm滤膜精细过滤,得193 nm光刻胶装入超净瓶中。 产品标准:该光刻胶最佳分辨率为0.1 μm,最小曝光量为26 mJ/cm3。
7、辐射线光刻胶(1)正性电子束光刻胶(positive electron beam photoresist)生产方法:——将MMA精制、聚合、提纯、干燥、配胶、过滤,制得成品。配胶组成:高聚物(成膜剂)为聚甲基丙烯酸甲酯,溶剂为乙二醇甲醚醋酸酯、氯苯,添加剂为高氯酸四丁基铵。——将甲基丙烯酸与甲基丙烯酸酯共聚、精制,后道工序同上。配胶组成:高聚物为甲基丙烯酸与甲基丙烯酸酯的共聚体,溶剂为二乙二醇二甲醚,添加剂为三缩三乙二醇二甲基丙烯酸酯。——将甲基丙烯酸、三氯乙酯和甲基丙烯酸酯共聚、精制,后道工序同上。配胶组成:高聚物为2-甲基丙烯酸、2,2,2-三氯乙酯和甲基丙烯酸酯的共聚体,溶剂为环己酮、乙二醇甲醚醋酸酯。——将甲基丙烯酸、1-甲基丙烯酸酯、2-甲基丙烯酸酯共聚、精制,后道工序同上。配胶组成:高聚物为甲基丙烯酸甲酯、甲基丙烯酸和甲基丙烯酸叔丁酯的三元共聚物,溶剂为二乙二醇二甲醚、乙二醇甲醚醋酸酯,添加剂为二缩三丙二醇二丙烯酸酯等。

(2)负性电子束光刻胶(negative electron-beam photoresist)

负性电子束光刻胶XH-REN-2结构式生产方法:将4-氯甲基苯乙烯聚合、提纯、干燥、配胶、过滤,制得产品。配胶组成:高聚物为聚4-氯甲基苯乙烯,溶剂为二甲苯等。
质量标准 | |
牌号 | XH-REN-2 |
金属杂质 | 0.5×10-6 |
分辨率 | 0.5 μm |
黏度 | 6~8 mPa·s |
灵敏度 | (1~7)×10-6C/cm2 |
(3)辐射线光刻胶性能比较

-
半导体材料
+关注
关注
11文章
579浏览量
30909 -
电子束
+关注
关注
2文章
135浏览量
14077 -
光刻胶
+关注
关注
10文章
357浏览量
31859
发布评论请先 登录
半导体光刻胶企业营收靓丽!打造光刻胶全产业链 博康欲成国产光刻胶的中流砥柱
Futurrex高端光刻胶
光刻胶
光刻胶在集成电路制造中的应用
半导体材料市场构成分析
《炬丰科技-半导体工艺》光刻前 GaAs 表面处理以改善湿化学蚀刻过程中的光刻胶附着力和改善湿蚀刻轮廓
光刻胶成为半导体产业的关键材料
减少光刻胶剥离工艺对器件性能影响的方法及白光干涉仪在光刻图形的测量




 半导体材料介绍 | 光刻胶及生产工艺重点企业
半导体材料介绍 | 光刻胶及生产工艺重点企业


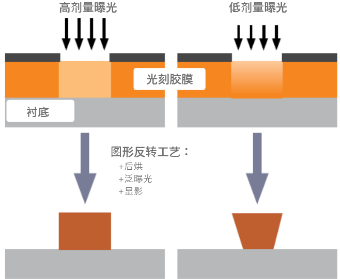





评论