摘要
几个旨在补救的实验结果在喷湿化学品时,光刻胶粘附失效报道了InGaP/GaAs NPN hbt的刻蚀。 几个确定了影响黏附和黏附的因素采用实验设计(DOE)方法研究选定因素的影响和相互作用。 最显著的附着力改善确定是在蚀刻之前加入天然氧化物光阻剂的外套。 除提高附着力外,这种预涂处理也改变了湿蚀刻轮廓(100)砷化镓使蚀刻反应受限较多与未经过表面处理的晶圆片相比各向同性;轮廓在[011']和都有一个积极的锥度[011]但锥角并不相同。改变的侧写让我们可以预测出结果完全可探测的HBTs与5×5µm发射器使用5200 Å未平整的蒸发金属。
介绍
光刻胶的附着力能起到至关重要的作用湿法蚀刻的结果和随后产生的电流和光学设备。 有很多因素可以有助于光刻胶在半导体上的粘附衬底。 然而,具体的信息很少砷化镓在开放文献和 硅常用的方法,如六甲基二硅氮烷(HMDS)预处理对GaAs[1]可能无效。 此外,GaAs的表面难以控制能对看似微小的工艺条件十分敏感。
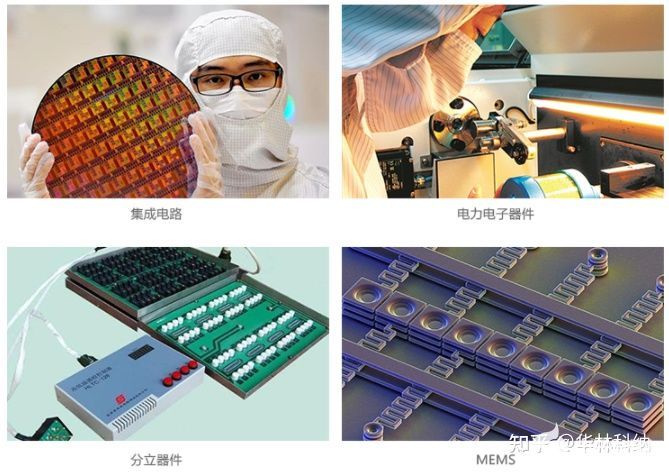
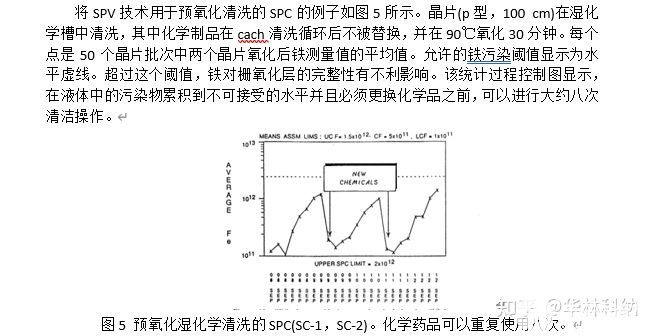
审核编辑:符乾江
 电子发烧友App
电子发烧友App




















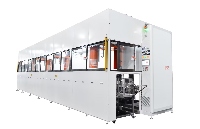







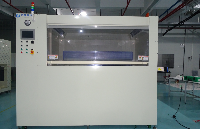










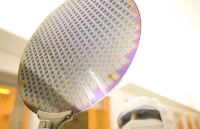
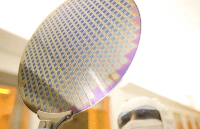





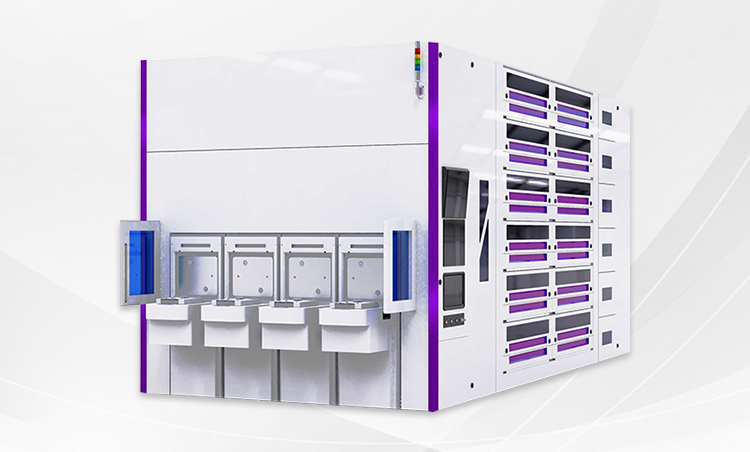


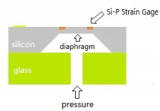







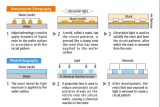

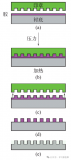





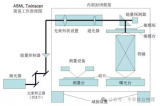



评论