文章来源:老虎说芯
原文作者:老虎说芯
本文介绍了光刻胶、曝光方式和光刻的主要步骤。
光刻工艺贯穿整个芯片制造流程的多次重复转印环节,对于集成电路的微缩化和高性能起着决定性作用。随着半导体制造工艺演进,对光刻分辨率、套准精度和可靠性的要求持续攀升,光刻技术也将不断演化,支持更为先进的制程与更复杂的器件设计。
一、光刻在集成电路制造中的地位
在制造集成电路时,常需反复多次“转印”设计图形到硅衬底(硅片)上,而光刻正是承担转印这一核心任务的关键步骤。通过光刻工艺,我们能够将掩模版(亦称掩膜版、光罩)上的线路图形,借助光敏材料(光刻胶)和光照,精准地“曝光-显影”到硅片表面所涂覆的光刻胶层中,并通过后续刻蚀等工序将该图形最终“雕刻”到硅衬底或金属层上。
由于光刻工艺区采用对光刻胶不敏感的黄色照明光源,因此光刻区域亦被称为“黄光区”。这不仅能防止杂散光对光刻胶造成非预期曝光,还使得工程人员可以在相对安全的环境中操作,而不必在完全黑暗中进行。
二、光刻胶与曝光方式
1. 光刻胶的种类
正胶(Positive Photoresist)
暴露在光(或特定波长)照射下的区域会变得更易溶于显影液,曝光区域会被显影剂“冲洗”掉,而未曝光区域则保留下来。
优点:能够实现纳米级线宽的高分辨率,因而在先进制程中普遍使用。
典型应用:0.35 µm、0.25 µm 乃至 14 nm、7 nm 及以下节点。
负胶(Negative Photoresist)
暴露在光照下的区域会发生交联反应,变得更加难溶于显影液,最终保留在硅片表面,而未曝光区域则被冲洗掉。
优点:在某些大面积图形或特定工艺中有稳定的加工特性和较高的抗刻蚀能力。
局限:由于分辨率不如正胶,更多应用在对线宽要求不极端苛刻的领域。
2. 光刻胶对波长的敏感性
光刻胶的配方设计高度依赖所用光源的波长,比如:
i线(365nm)光刻胶通常采用重氮萘醌 (DNQ) 线性酚醛树脂体系;
193nm(ArF)光刻胶需使用与该波段相匹配的新型聚合物及光敏成分,i线胶配方已不再适用;
先进制程工艺(例如 EUV 13.5nm)更需专门的抗蚀剂材料方案。
3. 先进制程中的“正胶负显影”技术
对于 16nm/14nm 及以下节点,在通孔和金属层可使用“正胶负显影”(PTD,Positive Tone Resist with Negative Development)工艺:
正胶正常情况下是“曝光后部分被显影冲洗掉”,但通过采用负显影液,将“未曝光”的部分清洗掉,留下的反而是“曝光区”。
优势:能进一步提升细小沟槽图形的成像对比度,对某些关键层(如高深宽比通孔)有显著好处。
三、光刻工艺的主要流程
1、底膜准备
清洗与脱水
要彻底去除颗粒、金属离子等污染物,以及衬底表面的水分。
提升衬底表面与光刻胶之间的黏附力,从而减少后续光刻中因胶层脱落造成的缺陷或图形变形。
2、涂光刻胶与软烘
旋涂光刻胶
将硅片置于旋涂设备(涂胶机)中,通过高速旋转使液态光刻胶均匀铺展;
旋转速度、胶液黏度和旋涂时间共同决定光刻胶膜厚度和均匀度。
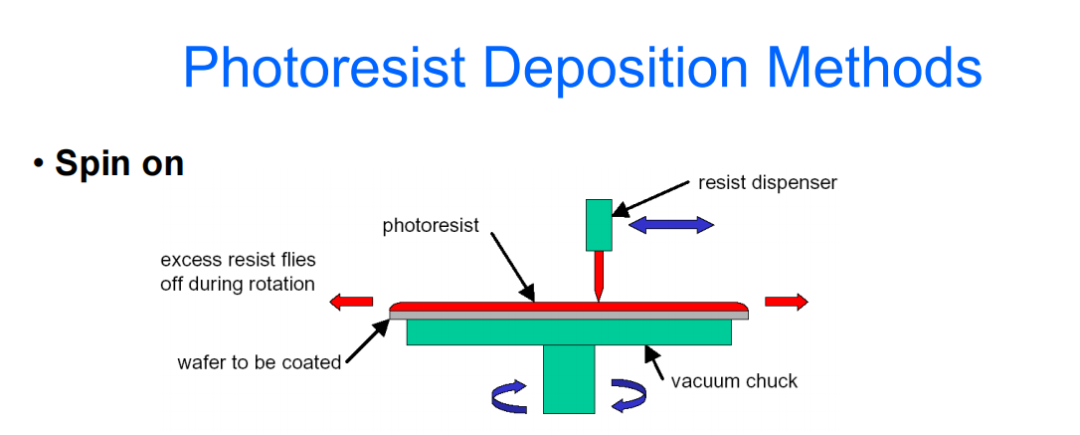
软烘(Soft Bake)
通过低温烘烤(一般 90~120°C 左右,具体视胶种而定),驱除光刻胶中的溶剂;
增强胶层与衬底的黏附性,提高厚度均匀性,为后续曝光显影奠定基础。
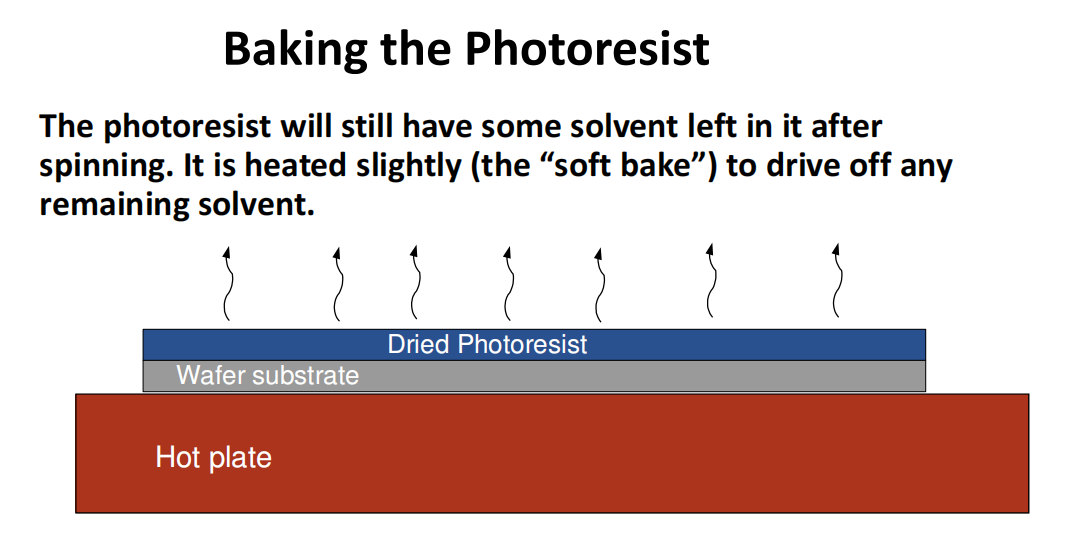
3、对准、曝光与曝光后烘
对准(Alignment):
将光刻机中的掩模版图形与硅片上已形成的前层图形进行精确对准,确保层与层之间的电路通路和垂直位置吻合。
对准精度是衡量光刻工艺质量的重要指标之一,也决定最终器件能否达成期望的尺寸与性能。
曝光(Exposure):
使用特定波长的光源照射光刻胶,令光刻胶发生光化学反应;
193nm 的 ArF、365nm 的 i线等光刻工艺各具优势和局限,需要配合不同的设备与胶种。
光刻机是整条产线中最昂贵、最关键的装备,其技术水平往往代表了一条生产线能否冲击更先进制程节点。
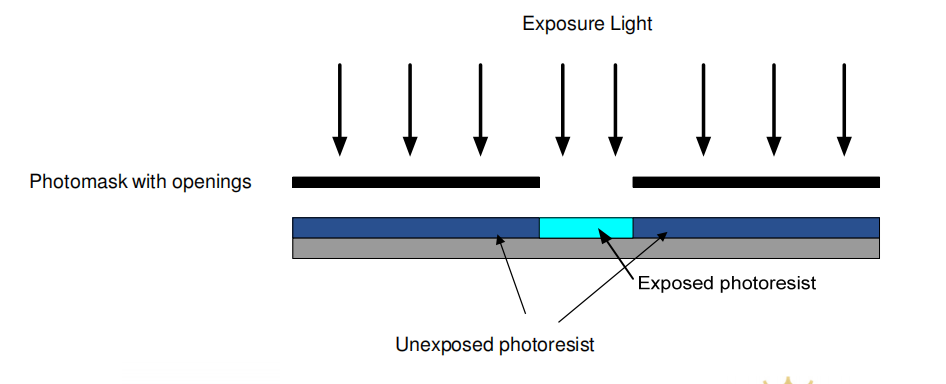
曝光后烘(Post-Exposure Bake, PEB):
对于深紫外 (DUV) 光刻胶,PEB 有助于去除保护基团,从而使胶层能更好地溶解于显影液;
对于传统 i线光刻胶,PEB 可以减弱胶层中的驻波现象,提升图形侧壁的平滑度和形貌稳定性。
4、显影与坚膜
显影:
利用显影液将曝光后(对正胶而言)可溶解的区域去除,将掩模版的图形“显”出来;
显影温度、时间、显影液浓度与清洗流程等都是影响线宽控制和图形完整度的重要因素。
坚膜(Hard Bake):
又称“坚膜烘焙”,将显影后光刻胶的残余溶剂和水分进一步去除,使得胶层更加坚硬;
提高了光刻胶在后续刻蚀工序中对等离子体等恶劣环境的耐受力。
5、显影检测
通过自动光学检查(或图像识别系统)对显影后图形进行缺陷检测;
若缺陷量超出可接受范围,则判定为不良品,通常采取报废或返工处理(光刻是少数可以“返工”的工艺之一,能够通过去胶重新涂胶、再曝光来弥补错误,减少废片损失)。
四、光刻工艺关键指标
分辨率 (Resolution)
能够清晰分辨并成像的最小线宽/空间尺寸,是判断光刻工艺极限能力的重要指标。短波长(如 193nm、13.5nm)并结合高数值孔径(NA)镜头能实现更高分辨率。
灵敏度 (Sensitivity)
指光刻胶能在多大光剂量下充分发生化学变化。灵敏度过低意味着需要较长曝光时间或更高剂量,易增加发热、材料损伤或产能损失;灵敏度过高则可能因工艺窗口过小而造成稳定性下降。
套准精度 (Alignment Accuracy)
反映不同层图形之间的重合偏差;随着制程线宽愈来愈小,套准误差若过大将导致器件性能变差甚至失效。
缺陷率 (Defect Rate)
表征在曝光/显影环节中是否产生不良孔洞、污点、图形畸变等,缺陷率直接关系到最终良品率和成本。
五、类比与直观理解
“胶片摄影”类比:可以将光刻理解为给“涂有感光材料的胶片”曝光并冲洗显影的过程。掩模版好比底片,硅片表面的光刻胶好比胶片乳剂,曝光时将图形“拍摄”下来,显影时则冲洗出图形。不同之处在于半导体工业对尺寸和精度的要求极高,且种种化学及物理条件须精确控制。
“冲洗返工”优势:在大多数半导体工艺步骤中,一旦发生错误往往难以挽回,而光刻能够通过再次“冲洗”掉光刻胶,重新涂胶与曝光来挽救某些失误,这也是光刻工艺相对独特之处。
六、总结与展望
总结:光刻是将设计电路转移到硅片表面的核心步骤,从衬底清洗、光刻胶涂布、对准与曝光、显影到坚膜与检测,每一环节都有其严格的参数控制与质量要求。光刻胶的选择与光源波长匹配、曝光机性能与套准精度等都深刻影响最终制程的线宽与良率。
展望:随着制程不断迈向 7nm、5nm、3nm 乃至更小线宽,传统 DUV (ArF) 光刻逐渐由多重曝光或混合工艺与 EUV 光刻共同支撑。下一代光刻技术不仅在波长上更短(EUV 13.5nm),设备与材料体系也变得更复杂昂贵。如何提高光刻胶抗蚀刻能力、解决 EUV 的掩模缺陷与光源效率问题等,仍是行业重点攻关的关键课题。
-
集成电路
+关注
关注
5469文章
12744浏览量
376260 -
半导体
+关注
关注
339文章
31494浏览量
267694 -
制造工艺
+关注
关注
2文章
217浏览量
21323 -
光刻工艺
+关注
关注
1文章
39浏览量
2133
原文标题:光刻工艺:光刻胶、曝光方式、光刻主要步骤
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
光刻工艺的基本步骤
示波器的关键指标
功率半导体分立器件工艺流程
什么是光刻工艺?光刻的基本原理

光刻工艺的基本知识

简述光刻工艺的三个主要步骤
光刻工艺中的显影技术
MEMS制造领域中光刻Overlay的概念
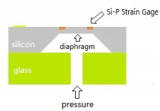
3D 共聚焦显微镜 | 芯片制造光刻工艺的表征应用

【新启航】玻璃晶圆 TTV 厚度在光刻工艺中的反馈控制优化研究




 光刻工艺的主要流程和关键指标
光刻工艺的主要流程和关键指标

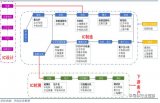




评论