文章来源:芯学知
原文作者:芯启未来
本文介绍了MEMS制造领域中光刻Overlay的概念,以及控制优化的方法。
在MEMS(微机电系统)制造领域,光刻工艺是决定版图中的图案能否精确 “印刷” 到硅片上的核心环节。光刻Overlay(套刻精度),则是衡量光刻机将不同层设计图案对准精度的关键指标。光刻Overlay指的是芯片制造过程中,前后两次光刻工艺形成的电路图案之间的对准精度。
对于MEMS器件而言,Overlay的精准度至关重要。以压力芯片为例,需要进行正反套刻,精确的对准是保证压力敏感元件与振动膜片相对位置正确的基础,任何Overlay误差都可能导致压力感知偏差,影响芯片对压力变化的精确测量。陀螺仪芯片中,Overlay精度决定了微机械振动结构与检测电极的相对位置关系,若出现较大误差,会使陀螺仪的灵敏度和稳定性大幅下降,无法为惯性导航等应用提供可靠的角度测量数据。
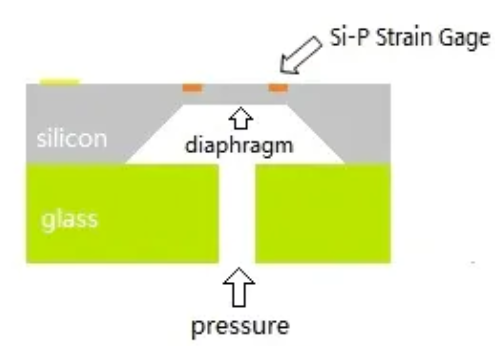
压力传感器压阻与膜片相对位置Overlay
Overlay误差来源于光刻对准误差,曝光时,光刻机需要对准前一层的对准标记,但由于光学系统的误差,可能导致轻微偏移。例如,光学元件的制造精度限制以及长时间使用后的磨损,都可能使对准过程中出现偏差,使得当前光刻层的图案与前一层不能精确重合。
除了光刻对准误差,MEMS工艺误差也会引起Overlay。沉积SiO₂、Si₃N₄或金属层时,材料的应力可能导致晶圆局部变形。不同材料在沉积过程中会产生不同程度的内应力,当这些应力积累到一定程度,就会使晶圆发生弯曲或翘曲,使得后续光刻层在对准和图案转移时出现偏差。高温工艺(如氧化、退火)可能导致晶圆膨胀或翘曲。在高温环境下,晶圆材料的热膨胀系数不同,会使得晶圆内部产生热应力,从而发生形变。这种形变会影响后续光刻层的对准精度,导致图案错位。
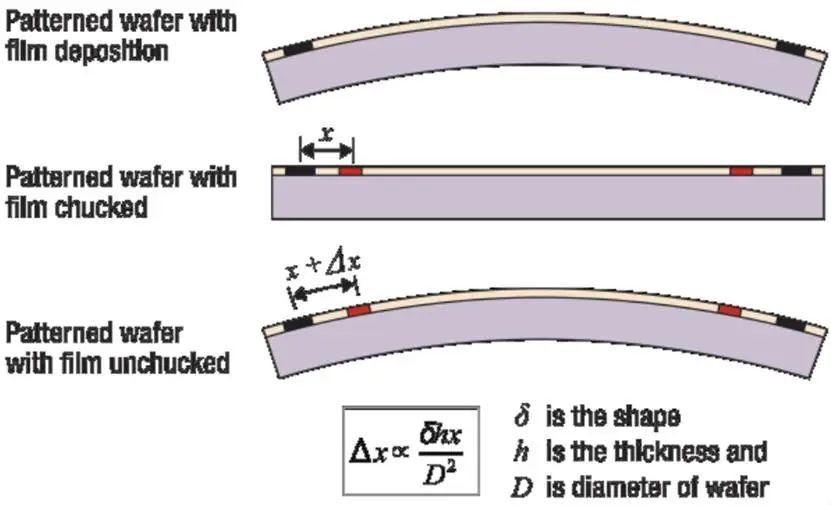
MEMS工艺中翘曲对Overlay的影响图示
如何进行Overlay误差的控制和优化呢?在IC工艺中,光学邻近效应修正(Optical Proximity Correction,OPC)就是使用计算方法对掩模版上的图形做修正,使得投影到光刻胶上的图形尽量符合设计要求,从而对Overlay误差进行控制。在MEMS工艺中,很少用到OPC,MEMS器件都是微米或者亚微米的线宽,光学补偿使用较少。在MEMS工艺中,主要还是通过高精度光刻机提升Overlay精度的。在工艺层面,选用热膨胀系数相近的材料,能够有效降低温度变化引起的层间错位。例如,在沉积SiO₂、Si₃N₄或金属层时,合理搭配材料,减少因材料热膨胀差异产生的内应力,进而降低晶圆的形变程度,提高Overlay精度。
-
芯片
+关注
关注
462文章
53528浏览量
458824 -
mems
+关注
关注
129文章
4370浏览量
197648 -
光刻工艺
+关注
关注
1文章
37浏览量
2067
原文标题:什么是MEMS中的Overlay?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
光刻图形转化软件免费试用
MEMS传感器是什么?mems的工艺是什么?
光刻胶在集成电路制造中的应用
MEMS传感器四大应用领域详解
关于MEMS的技术简介
MEMS制造技术
通信领域中的MEMS器件及发展动态
为什么需要Overlay网络?Overlay网络是如何形成的?Overlay网络的应用有哪些?

半导体制造领域光刻胶的作用和意义






 MEMS制造领域中光刻Overlay的概念
MEMS制造领域中光刻Overlay的概念













评论