在半导体制造的精密流程中,晶圆清洗机湿法制程设备扮演着至关重要的角色。以下是关于晶圆清洗机湿法制程设备的介绍:分类单片清洗机:采用兆声波、高压喷淋或旋转刷洗技术,针对纳米级颗粒物进行去除。批量式清洗
2025-12-29 13:27:19 204
204 
UV三防漆固化后附着力强,难以直接去除,需根据基材类型、漆层面积及操作环境选择科学方法。常见去除方式主要有化学法、加热法与微研磨技术,操作时应以安全为首要原则,并尽量避免损伤基材与周边元器件。电子三
2025-12-27 15:17:19 165
165 
晶圆去胶后的清洗与干燥工艺是半导体制造中保障良率和可靠性的核心环节,需结合化学、物理及先进材料技术实现纳米级洁净度。以下是当前主流的工艺流程:一、清洗工艺多阶段化学清洗SC-1溶液(NH₄OH+H
2025-12-23 10:22:11 134
134 
一、行业背景:半导体设备从“能运行”走向“长期稳定运行”对于半导体设备制造商(EquipmentMaker)而言,刻蚀、薄膜沉积、离子注入、化学机械抛光(CMP)等核心设备的竞争力,早已不再停留在
2025-12-19 17:10:21 5866
5866 
在半导体制造过程中,晶圆去胶工艺之后确实需要进行清洗和干燥步骤。以下是具体介绍:一、清洗的必要性去除残留物光刻胶碎片:尽管去胶工艺旨在完全去除光刻胶,但在实际操作中,可能会有一些微小的光刻胶颗粒残留
2025-12-16 11:22:10 110
110 
衬底清洗是半导体制造、LED外延生长等工艺中的关键步骤,其目的是去除衬底表面的污染物(如颗粒、有机物、金属离子、氧化层等),确保后续薄膜沉积或器件加工的质量。以下是常见的衬底清洗方法及适用场景:一
2025-12-10 13:45:30 323
323 
湿法清洗机是半导体制造中用于清洁晶圆表面的关键设备,其核心原理是通过化学溶液与物理作用的协同效应去除污染物。以下是其工作原理的详细说明:一、化学溶解与反应机制酸碱中和/氧化还原:利用酸性(如HF
2025-12-09 14:35:19 387
387 
研磨液供液系统是半导体制造中化学机械抛光(CMP)工艺的核心支持系统,其工作原理涉及流体力学、自动化控制及材料科学等多学科技术融合。以下是系统的工作流程与关键技术解析:一、核心组件与驱动方式动力驱动
2025-12-08 11:28:18 182
182 
外延片氧化清洗流程是半导体制造中的关键环节,旨在去除表面污染物并为后续工艺(如氧化层生长)提供洁净基底。以下是基于行业实践和技术资料的流程解析:一、预处理阶段初步清洗目的:去除外延片表面的大颗粒尘埃
2025-12-08 11:24:01 236
236 
氩离子抛光技术通过电场加速产生的高能氩离子束,在真空环境下对样品表面进行可控的物理溅射剥离。与传统机械制样方法相比,其核心优势在于:完全避免机械应力导致的样品损伤,能够保持材料的原始微观结构,实现
2025-11-25 17:14:14 456
456 
晶圆清洗的核心原理是通过 物理作用、化学反应及表面调控的协同效应 ,去除晶圆表面的颗粒、有机物、金属离子及氧化物等污染物,同时确保表面无损伤。以下是具体分析: 一、物理作用机制 超声波与兆声波清洗
2025-11-18 11:06:19 200
200 如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习! 20 世纪 80 年代初,IBM 公司在制造DRAM的过程中,为了达到圆片表面金属间介电质层(IMD)的全局平坦,建立起了硅氧化物(SiO2)的 CMP 工艺
2025-11-13 11:04:37 1382
1382 
检测晶圆清洗后的质量需结合多种技术手段,以下是关键检测方法及实施要点:一、表面洁净度检测颗粒残留分析使用光学显微镜或激光粒子计数器检测≥0.3μm的颗粒数量,要求每片晶圆≤50颗。共聚焦激光扫描
2025-11-11 13:25:37 350
350 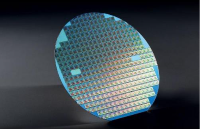
兆声波清洗通过高频振动(通常0.8–1MHz)在清洗液中产生均匀空化效应,对晶圆表面颗粒具有高效去除能力。然而,其潜在损伤风险需结合工艺参数与材料特性综合评估:表面微结构机械损伤纳米级划痕与凹坑:兆
2025-11-04 16:13:22 248
248 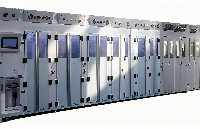
封装清洗工序主要包括以下步骤: 预冲洗:使用去离子水或超纯水对封装后的器件进行初步冲洗,去除表面的大部分灰尘、杂质和可溶性污染物。这一步骤有助于减少后续清洗过程中化学试剂的消耗和污染。 化学清洗
2025-11-03 10:56:20 146
146 清洗晶圆以去除金属薄膜需要根据金属类型、薄膜厚度和工艺要求选择合适的方法与化学品组合。以下是详细的技术方案及实施要点:一、化学湿法蚀刻(主流方案)酸性溶液体系稀盐酸(HCl)或硫酸(H₂SO₄)基
2025-10-28 11:52:04 363
363 
污染物类型 不同工序产生的残留物差异显著(如光刻胶残余、金属离子沉积、颗粒物或氧化层缺陷)。例如: 前端硅片预处理需去除表面有机物和自然氧化层; CMP抛光后需清理研磨液中的磨料颗粒; 金属互连前的清洗则侧重于消除电
2025-10-22 14:47:39 257
257 )、高压喷淋(360°表面冲洗)及化学试剂反应(如RCA标准溶液、稀氢氟酸或硫酸双氧水),实现对不同类型污染物的针对性去除。例如,兆声波清洗可处理亚微米级颗粒,而化学液则分解金属离子或氧化层; 双流体旋转喷射:采用气体
2025-10-14 11:50:19 230
230 晶圆去除污染物的措施是一个多步骤、多技术的系统工程,旨在确保半导体制造过程中晶圆表面的洁净度达到原子级水平。以下是详细的解决方案:物理清除技术超声波辅助清洗利用高频声波(通常为兆赫兹范围)在清洗
2025-10-09 13:46:43 472
472 
半导体器件清洗工艺是确保芯片制造良率和可靠性的关键基础,其核心在于通过精确控制的物理化学过程去除各类污染物,同时避免对材料造成损伤。以下是该工艺的主要技术要点及实现路径的详细阐述:污染物分类与对应
2025-10-09 13:40:46 705
705 
半导体腐蚀清洗机是集成电路制造过程中不可或缺的关键设备,其作用贯穿晶圆加工的多个核心环节,具体体现在以下几个方面:一、精准去除表面污染物与残留物在半导体工艺中,光刻、刻蚀、离子注入等步骤会留下多种
2025-09-25 13:56:46 497
497 
;设备管道内的积垢脱落进入清洗槽;气液界面扰动时空气中的微粒被带入溶液。这些因素均可能造成颗粒附着于硅片表面。此外,若清洗后的冲洗不彻底或干燥阶段水流速度过快产生
2025-09-22 11:09:21 508
508 
选择合适的半导体芯片清洗模块需要综合考虑工艺需求、设备性能、兼容性及成本效益等多方面因素。以下是关键决策点的详细分析:1.明确清洗目标与污染物类型污染物特性决定清洗策略:若主要去除颗粒物(如硅微粉
2025-09-22 11:04:05 464
464 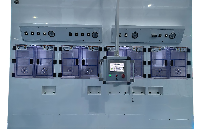
精密零件清洗后仍存在残留颗粒是一个复杂问题,通常由多环节因素叠加导致。以下是系统性分析及潜在原因:1.清洗工艺设计缺陷参数设置不合理超声波频率过低无法有效剥离顽固附着的颗粒(如烧结形成的氧化物结块
2025-09-15 13:26:02 363
363 
一、引言
化学机械抛光(CMP)工艺是实现碳化硅(SiC)衬底全局平坦化的关键技术,对提升衬底质量、保障后续器件性能至关重要。总厚度偏差(TTV)作为衡量碳化硅衬底质量的核心指标之一,其精确控制
2025-09-11 11:56:41 619
619 
半导体RCA清洗工艺中使用的主要药液包括以下几种,每种均针对特定类型的污染物设计,并通过化学反应实现高效清洁:SC-1(碱性清洗液)成分组成:由氢氧化铵(NH₄OH)、过氧化氢(H₂O₂)和去离子水
2025-09-11 11:19:13 1329
1329 
,衬底是技术发展的基石与核心材料。蓝宝石(α-Al₂O₃)凭借其卓越的物理、化学和光学特性,成为常用的衬底和窗口材料,如在LED衬底和红外窗口中广泛应用。为提升蓝宝石加工质量,科研人员将超声振动引入CMP,开发出蓝宝石超声振动辅助
2025-09-04 11:37:58 449
449 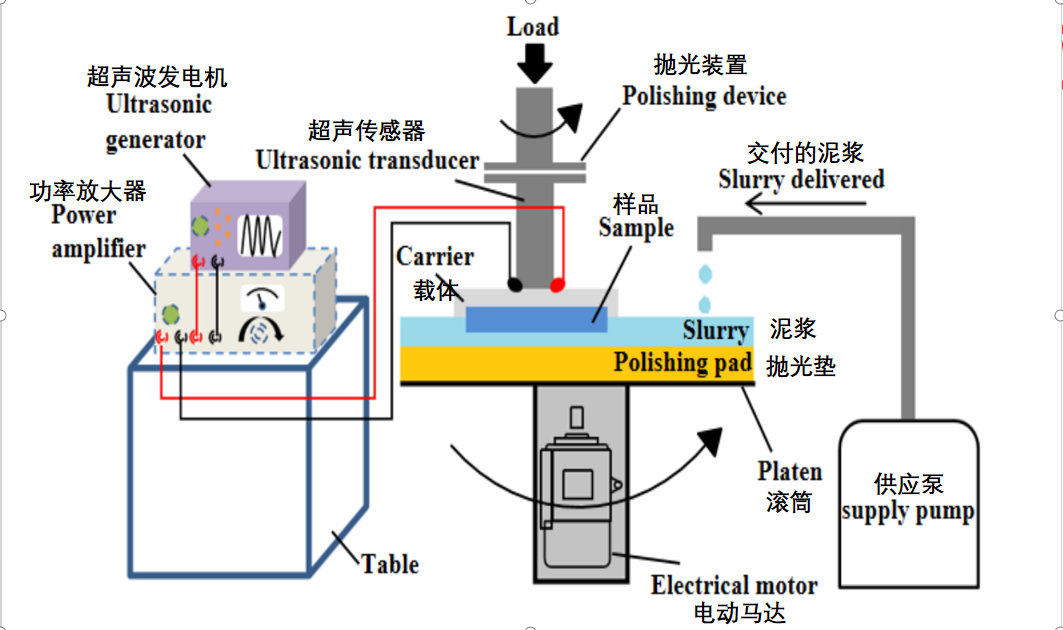
湿法清洗中的“尾片效应”是指在批量处理晶圆时,最后一片(即尾片)因工艺条件变化导致清洗效果与前面片子出现差异的现象。其原理主要涉及以下几个方面:化学试剂浓度衰减:随着清洗过程的进行,槽体内化学溶液
2025-09-01 11:30:07 316
316 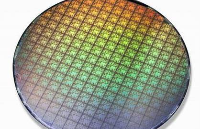
标准清洗液SC-1是半导体制造中常用的湿法清洗试剂,其核心成分包括以下三种化学物质:氨水(NH₄OH):作为碱性溶液提供氢氧根离子(OH⁻),使清洗液呈弱碱性环境。它能够轻微腐蚀硅片表面的氧化层,并
2025-08-26 13:34:36 1156
1156 
氧化层)选择对应的清洗方式。例如,RCA法中的SC-1溶液擅长去除颗粒和有机残留,而稀HF则用于精确蚀刻二氧化硅层。对于顽固碳沉积物,可能需要采用高温Piranha
2025-08-25 16:43:38 449
449 
一、工艺参数精细化调控1.化学配方动态适配根据污染物类型(有机物/金属离子/颗粒物)设计阶梯式清洗方案。例如:去除光刻胶残留时采用SC1配方(H₂O₂:NH₄OH=1:1),配合60℃恒温增强氧化
2025-08-20 12:00:26 1247
1247 
在半导体行业中,清洗芯片晶圆、陶瓷片和硅片是确保器件性能与良率的关键步骤。以下是常用的清洗方法及其技术要点:物理清洗法超声波清洗:利用高频声波在液体中产生的空化效应破坏颗粒与表面的结合力,使污染物
2025-08-19 11:40:06 1351
1351 
在工业生产和日常生活中,油污的清洗一直是个难题。尤其是在机械零件、厨房器具和电子设备等场合,油污不仅影响美观,更可能影响设备的正常运转。如何有效地去除油污成为许多用户所关注的问题。而超声波清洗机作为
2025-08-18 16:31:14 773
773 
半导体封装过程中的清洗工艺是确保器件可靠性和性能的关键环节,主要涉及去除污染物、改善表面状态及为后续工艺做准备。以下是主流的清洗技术及其应用场景:一、按清洗介质分类湿法清洗
2025-08-13 10:51:34 1916
1916 
在半导体材料领域,碳化硅(SiC)因其卓越的电导性、热稳定性和化学稳定性而成为制作高功率和高频电子器件的理想材料。然而,为了实现这些器件的高性能,必须对SiC进行精细的表面处理。化学机械抛光(CMP
2025-08-05 17:55:36 985
985 
,化学机械抛光(CMP)工艺引入的纳米级表面形貌变化(如铜凹陷/凸起)会显著影响键合质量。传统测量方法如原子力显微镜(AFM)虽然具有埃级分辨率,但其接触式测量方式存在
2025-08-05 17:48:53 864
864 
芯片清洗过程中用水量并非固定值,而是根据工艺步骤、设备类型、污染物种类及生产规模等因素动态调整。以下是关键影响因素和典型范围:✅1.主要影响因素(1)清洗阶段不同预冲洗/粗洗:快速去除大块颗粒或松散
2025-08-05 11:55:14 773
773 
中通入微量阴离子表面活性剂,利用同种电荷相斥原理阻止带电颗粒重返表面。此方法对去除碱性环境中的金属氢氧化物特别有效。3.溶解度梯度管理采用阶梯式浓度递减的多级漂洗
2025-08-05 11:47:20 694
694 
相较于传统CMOS工艺,TSV需应对高深宽比结构带来的技术挑战,从激光或深层离子反应刻蚀形成盲孔开始,经等离子体化学气相沉积绝缘层、金属黏附/阻挡/种子层的多层沉积,到铜电镀填充及改进型化学机械抛光(CMP)处理厚铜层,每一步均需对既有设备与材料进行适应性革新,最终构成三维集成的主要工艺成本来源。
2025-08-01 09:13:51 1975
1975 于:光刻工艺后清洗:去除光刻胶残留及显影液副产物。刻蚀后清洁:清除蚀刻副产物及侧壁颗粒。先进封装:TSV(硅通孔)、Bumping(凸点)等3D结构的窄缝污染物清除。
2025-07-23 15:06:54
、氧化物等。表面预处理:为光刻、沉积、刻蚀等工艺提供洁净表面。化学机械抛光(CMP)后清洗:去除磨料残留和表面损伤层。二、突出特点1. 高效批量处理能力多槽联动设计:
2025-07-23 15:01:01
晶圆清洗工艺是半导体制造中的关键步骤,用于去除晶圆表面的污染物(如颗粒、有机物、金属离子和氧化物),确保后续工艺(如光刻、沉积、刻蚀)的良率和器件性能。根据清洗介质、工艺原理和设备类型的不同,晶圆
2025-07-23 14:32:16 1368
1368 
晶圆清洗后表面外延颗粒的要求是半导体制造中的关键质量控制指标,直接影响后续工艺(如外延生长、光刻、金属化等)的良率和器件性能。以下是不同维度的具体要求和技术要点:一、颗粒污染的核心要求颗粒尺寸与数量
2025-07-22 16:54:43 1540
1540 
CMP是半导体制造中关键的平坦化工艺,它通过机械磨削和化学腐蚀相结合的方式,去除材料以实现平坦化。然而,由于其复杂性,CMP工艺中可能会出现多种缺陷。这些缺陷通常可以分为机械、化学和表面特性相关的类别。
2025-07-18 15:14:33 2299
2299 清洗、超声波/兆声波清洗、多级漂洗及真空干燥等技术,能够高效去除石英、硅片、金属部件等表面的颗粒、有机物、氧化物及金属污染,同时避免二次损伤,确保器件表面洁净度与
2025-07-15 15:25:50
一、产品概述卧式石英管舟清洗机是一款专为半导体、光伏、光学玻璃等行业设计的高效清洗设备,主要用于去除石英管舟、载具、硅片承载器等石英制品表面的污垢、残留颗粒、有机物及氧化层。该设备采用卧式结构设计
2025-07-15 15:14:37
晶圆蚀刻后的清洗是半导体制造中的关键步骤,旨在去除蚀刻残留物(如光刻胶、蚀刻产物、污染物等),同时避免对晶圆表面或结构造成损伤。以下是常见的清洗方法及其原理:一、湿法清洗1.溶剂清洗目的:去除光刻胶
2025-07-15 14:59:01 1622
1622 
污染物。 方法:湿法化学清洗(如SC-1溶液)或超声波清洗。 硅片抛光后清洗 目的:清除抛光液残留(如氧化层、纳米颗粒),避免影响后续光刻精度。 方法:DHF(氢氟酸)腐蚀+去离子水冲洗。 2. 光刻工序 光刻胶涂覆前清洗 目的:去除硅
2025-07-14 14:10:02 1016
1016 的背面减薄,通过研磨盘实现厚度均匀性控制(如减薄至50-300μm),同时保证表面粗糙度Ra≤0.1μm。 在化学机械抛光(CMP)工艺中,研磨盘配合抛光液对晶圆表面进行全局平坦化,满足集成电路对层间平整度的要求。 芯片封装前处理 对切
2025-07-12 10:13:41 893
893 一、CMP工艺与抛光材料的核心价值化学机械抛光(ChemicalMechanicalPlanarization,CMP)是半导体制造中实现晶圆表面全局平坦化的关键工艺,通过“化学腐蚀+机械研磨
2025-07-05 06:22:08 7015
7015 
化学机械抛光(Chemical Mechanical Polishing, 简称 CMP)技术是一种依靠化学和机械的协同作用实现工件表面材料去除的超精密加工技术。下图是一个典型的 CMP 系统示意图:
2025-07-03 15:12:55 2215
2215 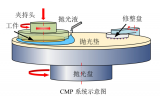
微小毛刺的存在会对产品品质、安全造成隐患,因此对于一些行业而言,去除毛刺是特别重要的工序。传统的清洗方法可能无法彻底解决毛刺问题,但是超声波清洗机能够有效地去除微小毛刺,提高产品质量和安全性。本文将
2025-07-02 16:22:27 493
493 
(CMP)DSTlslurry断供:物管通知受台湾出口管制限制,Fab1DSTSlury(料号:M2701505,AGC-TW)暂停供货,存货仅剩5个月用量(267桶)。DSTlslurry是一种用于半导体制造过程中的抛光液,主要用于化学机械抛光(CMP)工艺。这种抛光液在制造过程中起着
2025-07-02 06:38:10 4461
4461 
采用喷淋清洗,利用高压喷头将清洗液高速喷射到物体表面,靠液体冲击力去除颗粒、有机物等污染物;还会用到超声清洗,借助超声波在清洗液中产生的空化效应,使微小气泡瞬间破裂
2025-06-30 13:52:37
很多人接触过,或者是存在好奇与疑问,很想知道的是单晶硅清洗废液处理方法有哪些?那今天就来给大家解密一下,主流的单晶硅清洗废液处理方法详情。物理法过滤:可去除废液中的大颗粒悬浮物、固体杂质等,常采用砂
2025-06-30 13:45:47 494
494 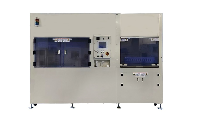
在半导体制造的精密链条中,半导体清洗机设备是确保芯片良率与性能的关键环节。它通过化学或物理手段去除晶圆表面的污染物(如颗粒、有机物、金属离子等),为后续制程提供洁净的基底。本文将从设备定义、核心特点
2025-06-25 10:31:51
半导体湿法清洗是芯片制造过程中的关键工序,用于去除晶圆表面的污染物(如颗粒、有机物、金属离子、氧化物等),确保后续工艺的良率与稳定性。随着芯片制程向更小尺寸(如28nm以下)发展,湿法清洗设备
2025-06-25 10:21:37
一、产品概述全自动Mask掩膜板清洗机是半导体光刻工艺中用于清洁光罩(Reticle/Mask)表面的核心设备,主要去除光刻胶残留、颗粒污染、金属有机物沉积及蚀刻副产物。其技术覆盖湿法化学清洗、兆
2025-06-17 11:06:03
化学机械抛光设备(CMP)、量测设备与减薄机的关键工位,为芯片良率与生产效率提供底层支撑。从纳米级的精度控制,到全流程的质量守护,本文将通过15大经典应用场景,揭示明治
2025-06-17 07:33:23 1019
1019 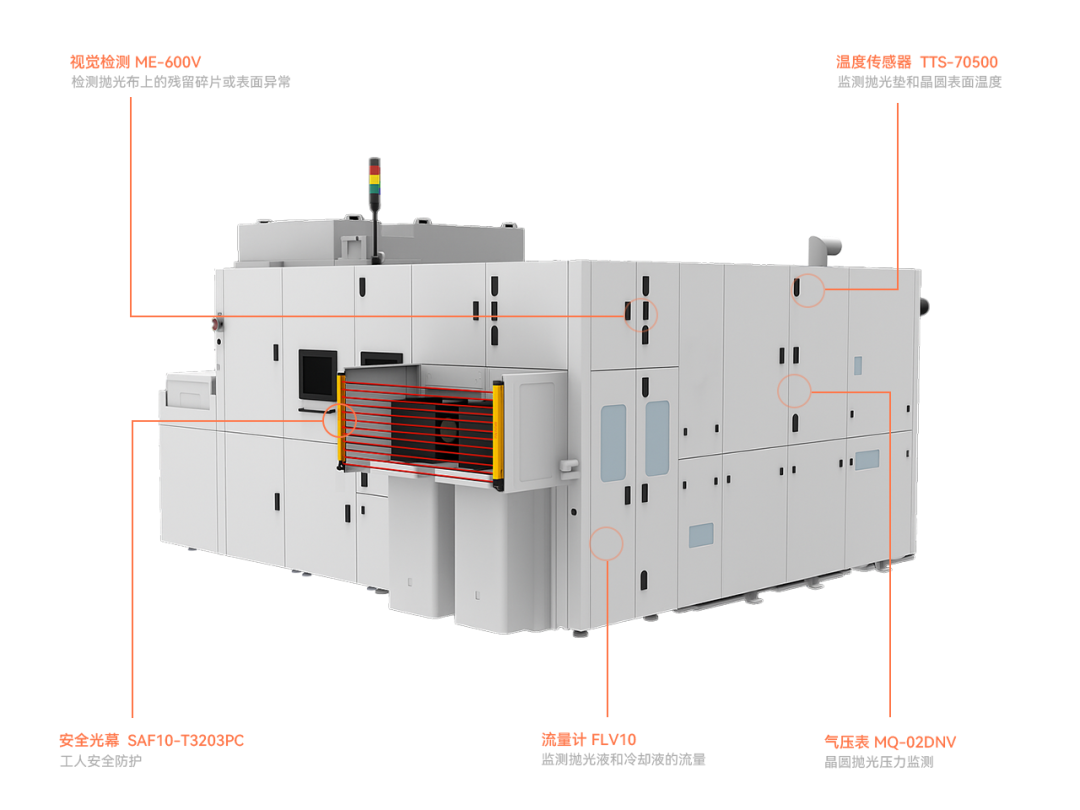
铜互连工艺是一种在集成电路制造中用于连接不同层电路的金属互连技术,其核心在于通过“大马士革”(Damascene)工艺实现铜的嵌入式填充。该工艺的基本原理是:在绝缘层上先蚀刻出沟槽或通孔,然后在沟槽或通孔中沉积铜,并通过化学机械抛光(CMP)去除多余的铜,从而形成嵌入式的金属线。
2025-06-16 16:02:02 3559
3559 
在日常生活或工作环境中,尤其是工业与家庭领域,顽固污渍总是令人困扰。无论是车库的油渍、户外家具的霉点,还是地面上的顽固污垢,传统的清洗方法常常难以奏效。此时,高压清洗机便成为了我们清洁工作中
2025-06-11 16:44:12 636
636 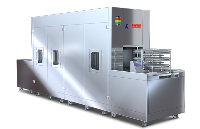
在半导体制造领域,化学机械抛光(CMP)是实现晶圆表面全局平坦化的关键技术,而CMP保持环(固定环)则是这一工艺中不可或缺的核心组件。CMP保持环的主要作用是固定晶圆位置,均匀分布抛光压力,防止晶圆
2025-06-11 13:18:20 1293
1293 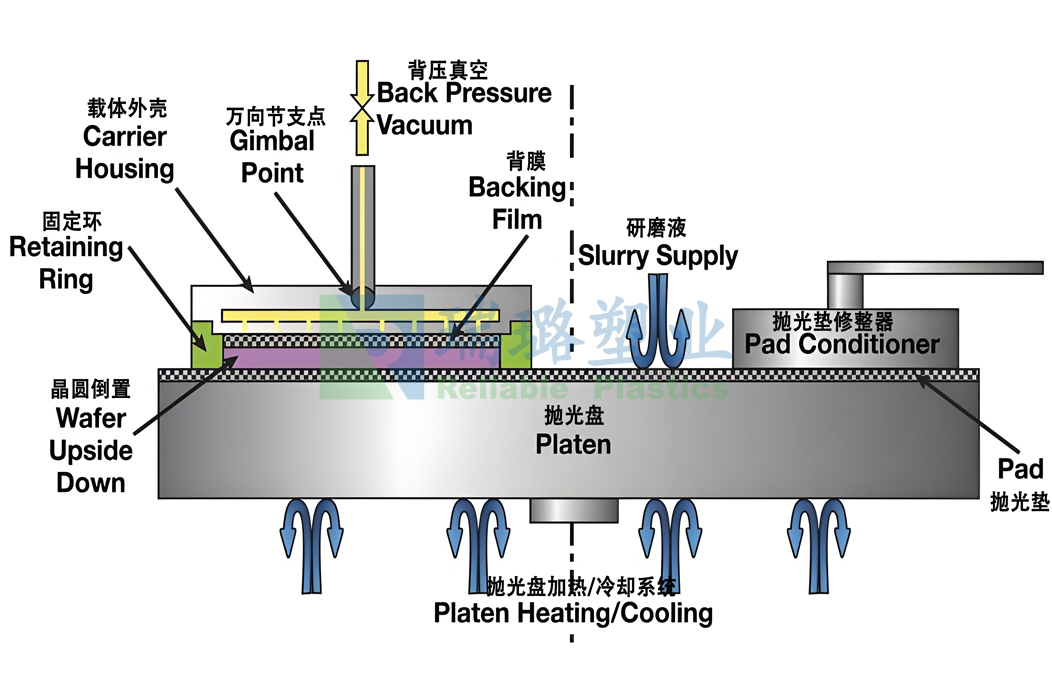
SPM清洗设备(硫酸-过氧化氢混合液清洗系统)是半导体制造中关键的湿法清洗设备,专为去除晶圆表面的有机物、金属污染及残留物而设计。其核心优势在于强氧化性、高效清洁与工艺兼容性,广泛应用于先进制程(如
2025-06-06 15:04:41
从技术原理、核心功能、行业优势及应用案例等方面,全面解析这一设备的核心竞争力。一、技术原理与核心功能清洗原理单片清洗机通过化学腐蚀和物理冲洗结合的方式,去除晶圆表
2025-06-06 14:51:57
不同芯片的“个性”问题,如污染物类型和材质特性,精准匹配或组合清洗工艺,确保芯片表面洁净无瑕。超声波清洗以高频振动的空化效应,高效清除微小颗粒;化学湿法清洗则凭借精确的化学反应,实现分子级清洁,且严格把
2025-06-05 15:31:42
),避免引入二次污染。 适用场景:用于RCA标准清洗(SC1/SC2配方)、去除硅片表面金属离子和颗粒。 典型应用: SC1溶液(H₂SO₄/H₂O₂):去除有机物和金属污染; SC2溶液(HCl/H₂O₂):去除重金属残留。 技术限制: 传统SPM(硫酸+过氧化氢)清洗中,过氧
2025-06-04 15:15:41 1056
1056 在芯片制程进入纳米时代后,一个看似矛盾的难题浮出水面:如何在不损伤脆弱纳米结构的前提下,彻底清除深孔、沟槽中的残留物?传统水基清洗和等离子清洗由于液体的表面张力会损坏高升宽比结构中,而超临界二氧化碳(sCO₂)清洗技术,凭借其独特的物理特性,正在改写半导体清洗的规则。
2025-06-03 10:46:07 1933
1933 
在现代制造业中,表面质量对产品的性能和外观至关重要。超声波清洗机作为一种高效的清洗工具,在去除表面污垢和缺陷方面发挥着关键作用。本文将介绍超声波清洗机的作用,以及它是否能够有效去除毛刺。超声波清洗
2025-05-29 16:17:33 874
874 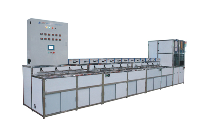
样品切割和抛光配温控液氮冷却台,去除热效应对样品的损伤,有助于避免抛光过程中产生的热量而导致的样品融化或者结构变化,氩离子切割制样原理氩离子切割制样是利用氩离子束(〜1mm)来切割样品,以获得相比
2025-05-26 15:15:22 478
478 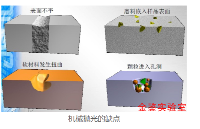
设备抛光机上的经典应用案例。企业背景与痛点广东一半导体制造公司专注于高端芯片生产,其先进的 12 英寸晶圆生产线采用了前沿的化学机械抛光(CMP)技术,旨在实现晶圆
2025-05-22 14:58:29
”
在指纹模组中,信号的快速、准确传输是实现高灵敏度指纹识别的关键,而低温纳米烧结银浆在这方面发挥着至关重要的作用。银浆中的纳米银颗粒在低温烧结后,能够形成高度致密的结构,宛如一条条畅通无阻的高速公路,为
2025-05-22 10:26:27
超声波清洗机主要应用于机械、电子、光学、医药、电镀、涂装及真空镀膜前处理等行业。(1)机械行业:防锈油脂的去除;量具的清洗;机械部件的除油除锈;发动机、化油器及汽车件的清洗;过滤器、滤网的疏通清洗等
2025-05-20 16:39:23 704
704 
化学机械抛光液是化学机械抛光(CMP)工艺中关键的功能性耗材,其本质是一个多组分的液体复合体系,在抛光过程中同时起到化学反应与机械研磨的双重作用,目的是实现晶圆表面多材料的平整化处理。
2025-05-14 17:05:54 1224
1224 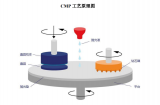
在半导体制造流程中,单片晶圆清洗机是确保芯片良率与性能的关键环节。随着制程节点迈向纳米级(如3nm及以下),清洗工艺的精度、纯净度与效率面临更高挑战。本文将从技术原理、核心功能、设备分类及应用场景等
2025-05-12 09:29:48
,如超声波清洗、高压喷淋、毛刷机械清洗、化学湿法清洗等,可有效去除光罩表面的油污、灰尘、微粒及化学残留物125。部分高端机型支持真空超声清洗和超临界流体清洗,提升
2025-05-12 09:03:45
), 360种不同的光学制造技术中的每一种都有自己特定的程序和技巧。以下,将报告其中两个专业的PanDao数字化流程:(a)非球面抛光和(b) Pea Puffer抛光程序。
3.非球面抛光
非球面抛光
2025-05-09 08:48:08
芯片清洗机(如硅片清洗设备)是半导体制造中的关键设备,主要用于去除硅片表面的颗粒、有机物、金属污染物和氧化层等,以确保芯片制造的良率和性能。以下是其在不同工艺环节的应用: 1. 光刻前清洗 目的
2025-04-30 09:23:27 478
478 半导体清洗SC1是一种基于氨水(NH₄OH)、过氧化氢(H₂O₂)和去离子水(H₂O)的化学清洗工艺,主要用于去除硅片表面的有机物、颗粒污染物及部分金属杂质。以下是其技术原理、配方配比、工艺特点
2025-04-28 17:22:33 4239
4239 在半导体制造工艺中,化学机械抛光(CMP)是实现晶圆表面全局平坦化的关键技术,而CMP固定环(保持环)作为抛光头的核心易耗部件,其性能影响着晶圆加工的良率和生产效率。随着半导体技术向更小制程节点
2025-04-28 08:08:48 1204
1204 
很多行业的人都在好奇一个问题,就是spm清洗会把氮化硅去除吗?为此,我们根据实践与理论,给大家找到一个结果,感兴趣的话可以来看看吧。 SPM清洗通常不会去除氮化硅(Si₃N₄),但需注意特定条件
2025-04-27 11:31:40 866
866 晶圆扩散前的清洗是半导体制造中的关键步骤,旨在去除表面污染物(如颗粒、有机物、金属离子等),确保扩散工艺的均匀性和器件性能。以下是晶圆扩散清洗的主要方法及工艺要点: 一、RCA清洗工艺(标准清洗
2025-04-22 09:01:40 1289
1289 半导体单片清洗机是芯片制造中的关键设备,用于去除晶圆表面的颗粒、有机物、金属污染和氧化物。其结构设计需满足高精度、高均匀性、低损伤等要求,以下是其核心组成部分的详细介绍: 一、主要结构组成 清洗槽
2025-04-21 10:51:31 1617
1617 ,对于亚微米甚至纳米级别的污染物,如何有效去除且不损伤芯片表面是一大挑战。国产清洗机在清洗的均匀性、选择性以及对微小颗粒和金属离子的去除工艺上,与国际先进水平仍有差距。 影响:清洗精度不足可能导致芯片上的残留污
2025-04-18 15:02:42 692
692 晶圆浸泡式清洗方法是半导体制造过程中的一种重要清洗技术,它旨在通过将晶圆浸泡在特定的化学溶液中,去除晶圆表面的杂质、颗粒和污染物,以确保晶圆的清洁度和后续加工的质量。以下是对晶圆浸泡式清洗方法的详细
2025-04-14 15:18:54 766
766 在半导体制造过程中,SPM(Sulfuric Peroxide Mixture,硫酸过氧化氢混合液)清洗和HF(Hydrofluoric Acid,氢氟酸)清洗都是重要的湿法清洗步骤。但是很多人有点
2025-04-07 09:47:10 1341
1341 氩离子抛光技术的核心氩离子抛光技术的核心在于利用高能氩离子束对样品表面进行精确的物理蚀刻。在抛光过程中,氩离子束与样品表面的原子发生弹性碰撞,使表面原子或分子被溅射出来。这种溅射作用能够在不引
2025-03-19 11:47:26 626
626 
(Czochralski)生长为圆柱形硅锭。切割与抛光:硅锭切割成0.5-1mm厚的晶圆(常见尺寸12英寸/300mm),经化学机械抛光(CMP)达到纳米级平整度。2.氧
2025-03-14 07:20:00 1443
1443 
,适用于多种微观分析技术。怎样利用氩离子抛光技术氩离子抛光技术利用氩离子束对样品表面进行轰击,氩离子与样品表面原子发生弹性碰撞,使表面原子逐渐被移除。与传统的机械抛光
2025-03-10 10:17:50 943
943 
EBSD样品制备EBSD样品的制备过程对实验结果的准确性和可靠性有着极为重要的影响。目前,常用的EBSD样品制备方法包括机械抛光、电解抛光和聚焦离子束(FIB)等,但这些方法各有其局限性。1.
2025-03-03 15:48:01 692
692 
引言
碳化硅(SiC)作为新一代半导体材料,因其出色的物理和化学特性,在功率电子、高频通信、高温及辐射环境等领域展现出巨大的应用潜力。然而,在SiC外延片的制备过程中,揭膜后的脏污问题一直是影响外延
2025-02-24 14:23:16 260
260 
影响半导体器件的成品率和可靠性。 晶圆表面污染物种类繁多,大致可分为颗粒污染、金属污染、化学污染(包括有机和无机化合物)以及天然氧化物四大类。 图1:硅晶圆表面可能存在的污染物 01 颗粒污染 颗粒污染主要来源于空气中的粉
2025-02-20 10:13:13 4063
4063 
半导体制造是典型的“精度至上”领域,尤其在前道晶圆加工和后道封装环节中,研磨(Grinding)与抛光(Polishing)技术直接决定了器件的性能和良率。以下从技术原理、工艺难点及行业趋势三方面
2025-02-14 11:06:33 2769
2769 外延片的质量和性能。因此,采用高效的化学机械清洗方法,以彻底去除SiC外延片表面的污染物,成为保证外延片质量的关键步骤。本文将详细介绍SiC外延片的化学机械清洗方法
2025-02-11 14:39:46 414
414 
利用氩离子束对样品表面进行物理溅射,从而达到抛光的效果。在这个过程中,氩气作为惰性气体,不会与样品发生化学反应,保证了样品的原始性质不被破坏。通过精确控制离子束的
2025-02-10 11:45:38 924
924 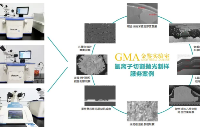
实现表面的精细抛光。氩离子抛光的优势在于氩气的惰性特性。氩气不会与样品发生化学反应,因此在抛光过程中,样品的化学性质得以保持,为研究者提供了一种理想的表面处理方法。
2025-02-07 14:03:34 867
867 
引言
碳化硅(SiC)外延晶片因其卓越的物理和化学特性,在功率电子、高频通信、高温传感等领域具有广泛应用。在SiC外延晶片的制备过程中,硅面贴膜是一道关键步骤,用于保护外延层免受机械损伤和污染。然而
2025-02-07 09:55:37 317
317 
但随着技术迭代,晶体管尺寸持续缩减,电阻电容(RC)延迟已成为制约集成电路性能的关键因素。在90纳米及以下工艺节点,铜开始作为金属互联材料取代铝,同时采用低介电常数材料作为介质层,这一转变主要依赖于铜大马士革工艺(包括单镶嵌与双镶嵌)与化学机械抛光(CMP)技术的结合。
2025-02-07 09:39:38 5480
5480 
氩离子抛光技术氩离子抛光技术凭借其独特的原理和显著的优势,在精密样品制备领域占据着重要地位。该技术以氩气为介质,在真空环境下,通过电离氩气产生氩离子束,对样品表面进行精准轰击,实现物理蚀刻,从而去除
2025-01-16 23:03:28 586
586 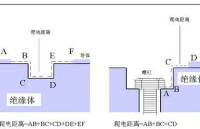
。这一精密而复杂的流程主要包括以下几个工艺过程:晶圆制造工艺、热工艺、光刻工艺、刻蚀工艺、离子注入工艺、薄膜淀积工艺、化学机械抛光工艺。 晶圆制造工艺 晶圆制造工艺包括单晶生长、晶片切割和晶圆清洗。 半导
2025-01-08 11:48:34 4047
4047 
可能来源于前道工序或环境。通常采用超声波清洗、机械刷洗等物理方法,结合化学溶液(如酸性过氧化氢溶液)进行清洗。 刻蚀后清洗 目的与方法:在晶圆经过刻蚀工艺后,表面会残留刻蚀剂和其他杂质,需要通过清洗去除。此步骤通常
2025-01-07 16:12:00 813
813
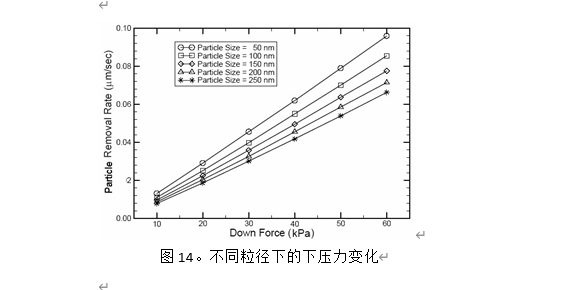

 电子发烧友App
电子发烧友App



















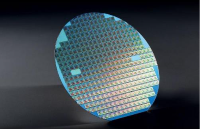
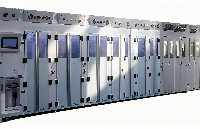




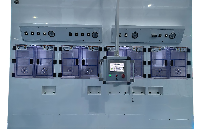



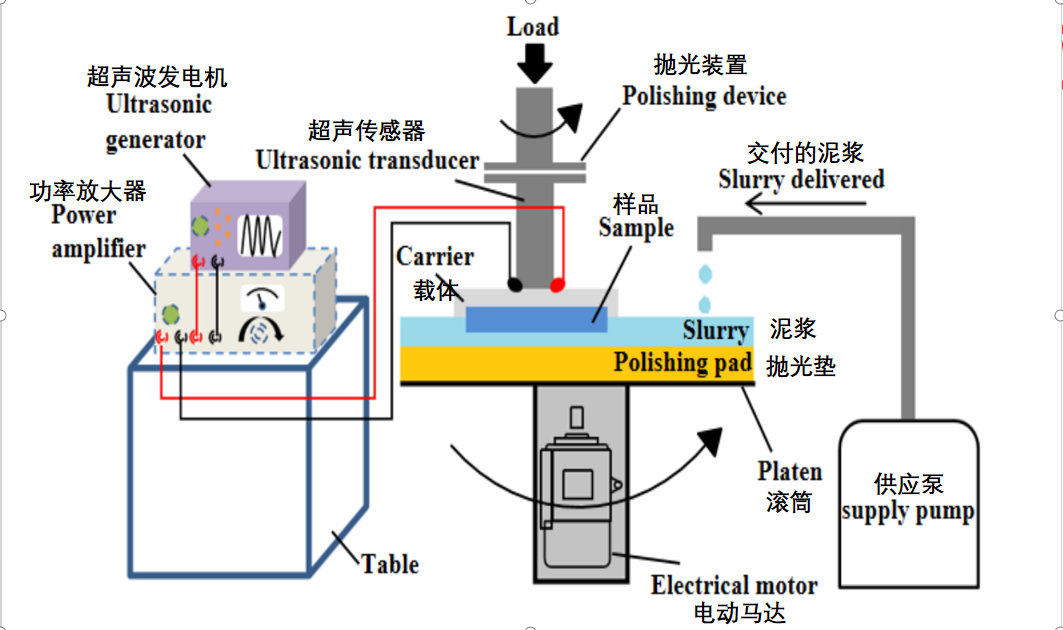
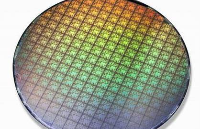











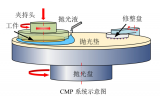

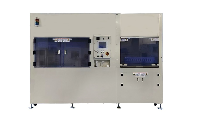
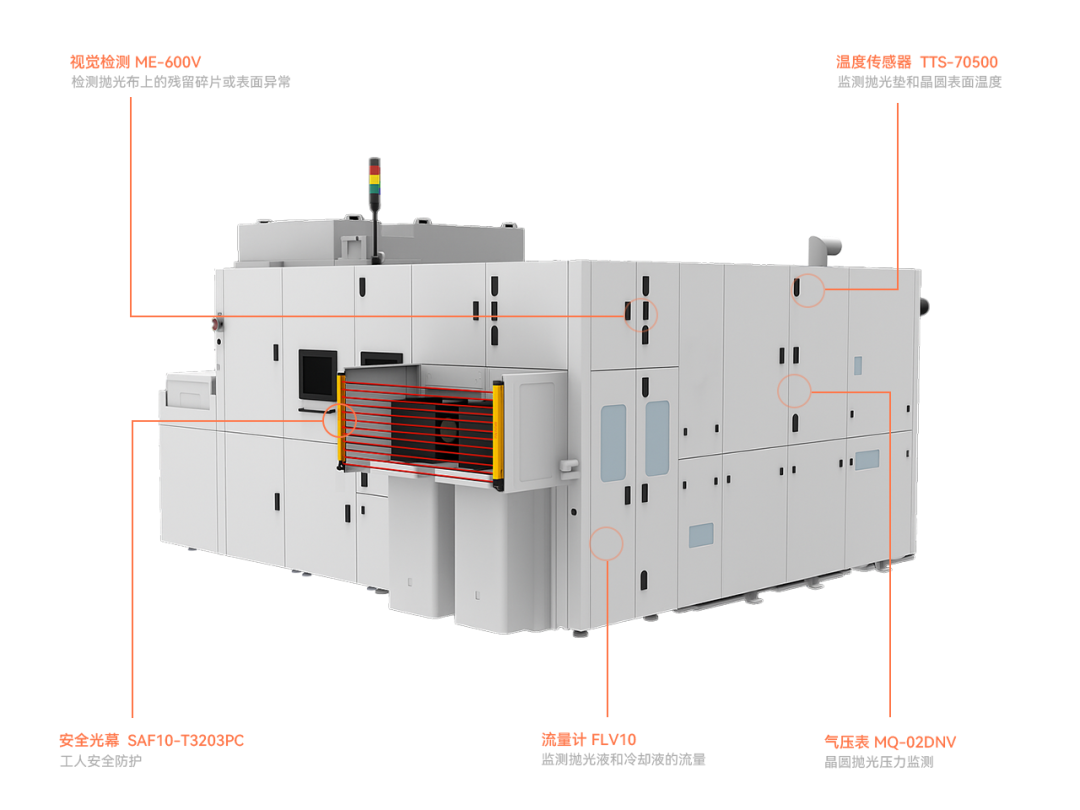

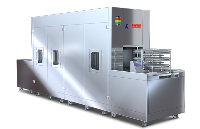
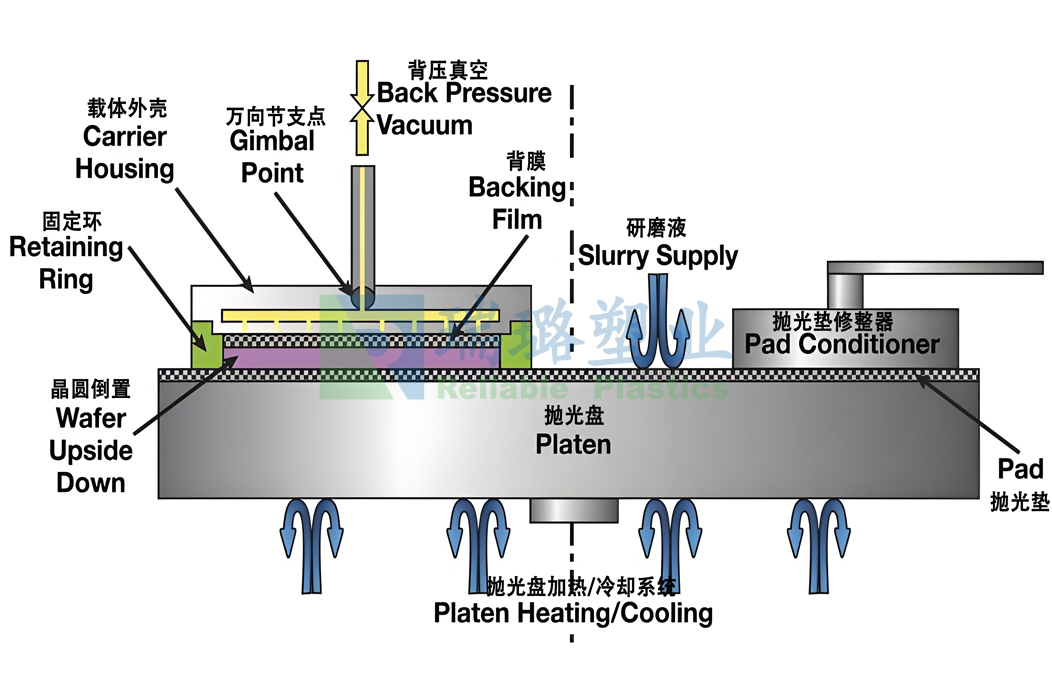

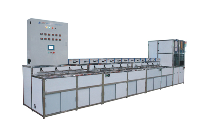
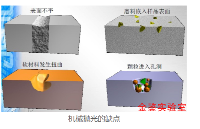

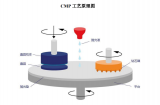







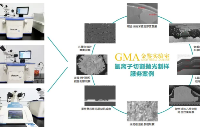


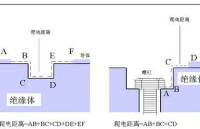




评论