文章来源:半导体全解
原文作者:圆圆De圆
本文主要讲述芯片化学机械抛光(CMP)技术。
一、化学机械抛光(CMP)简介
化学机械抛光(Chemical Mechanical Polishing,简称CMP)技术是一种依靠化学和机械的协同作用实现工件表面材料去除的超精密加工技术。下图是一个典型的CMP系统示意图:
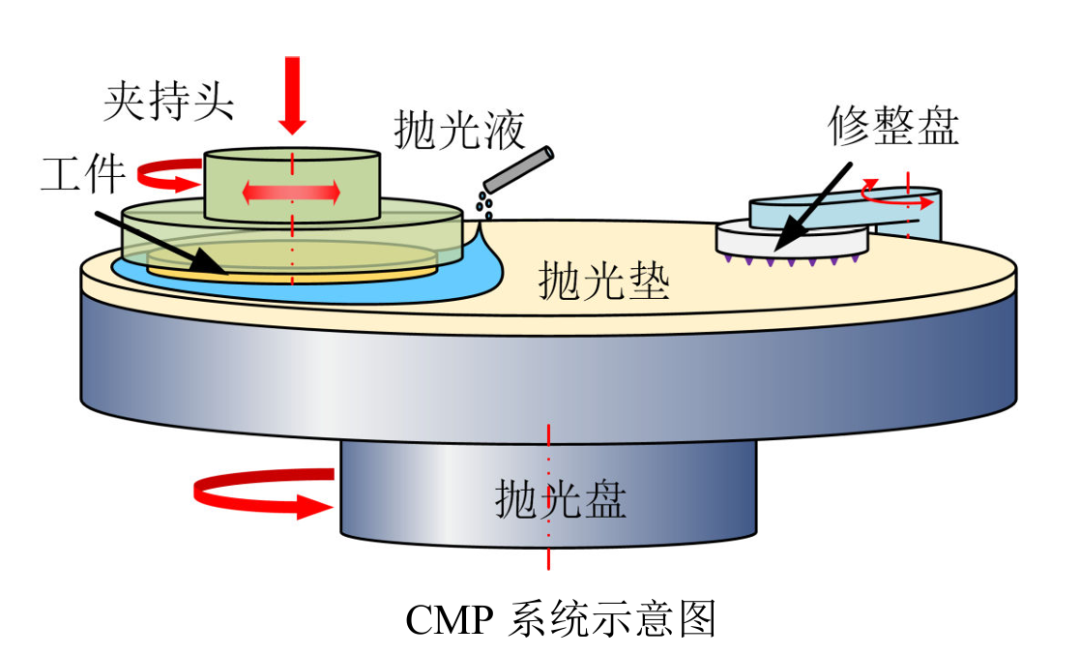
主要包括:夹持工件的抛光头、承载抛光垫的抛光盘、修整抛光垫表面的修整器和抛光液供给系统四大部分。
在抛光过程中,工件通过抛光头,按照给定压力作用在贴有抛光垫的旋转抛光盘上,同时相对自身轴线做旋转运动以及相对抛光盘做往复摆动运动。抛光液输送在工件和抛光垫之间的接触界面内,不断和工件表面发生化学反应,通过磨粒的机械作用以及抛光液的化学作用,实现表面材料的去除。
二、化学机械抛光(CMP)发展历程
CMP技术起源于古典抛光技术,在早期主要用于玻璃的抛光。在当时的工艺条件下,复杂的影响因素导致抛光结果不稳定和不可控。在很长一段时间内,抛光工艺都被当作是一种艺术,而不是一种科学看待。
直到上个世纪八十年代初期,美国IBM公司率先开发出应用于半导体晶圆抛光的CMP技术。
CMP在去除上道工序引起的损伤和缺陷的同时,能够兼顾全局和局部平坦化要求,这使得半导体晶圆表面平坦化程度获得大幅提高,克服了当时遇到的“深亚微米壁垒”。
进入二十一世纪以来,集成电路 (Integrated Circuit,简称IC)制造在“摩尔定律”的指引以及资本的推动下飞速发展, 已经深入到计算机,通信,电子,军事等各个领域。如今,IC制造俨然成为现代高科技的核心与先导,成为大国之间博弈的重要筹码。
CMP作为公认的能够为晶圆表面提供优异局部和全局平坦化的唯一技术,在IC制造对人类制造极限的一次次冲击中获得了极大的发展。
目前,CMP技术远远超越了早先在IBM试验室达到的水平,尤其是在IC制造领域,CMP技术已经能够实现原子水平上的材料去除。
CMP技术多样化挑战IC制造领域对于CMP技术的推动和开发,也促进了CMP技术在其他制造领域的应用,如光学玻璃加工,强激光元件制造等领域。
三、化学机械抛光(CMP)原理
CMP原子级材料去除过程是在抛光液的化学作用下,抛光垫/磨粒/工件三者之间原子级的摩擦磨损过程是CMP技术最底层的材料去除过程。
Preston作为抛光技术的先驱者,在1926年关于玻璃抛光的文献中就提出以下论述:不同于研磨这种依靠机械磨损导致玻璃表面破碎的材料去除方式,玻璃的抛光更像是一种连续的,在“分子或近似分子”量级的材料去除。
然而,在过去的很长一段时间内,由于难以确定CMP过程中的化学作用机理,相关理论研究更多的注重于CMP过程中机械作用,并将材料去除归因于磨粒和工件之间的“固固”磨损。其中最具代表性的为1991年Kaufman等人的研究,他们提出CMP的材料去除过程是一种化学辅助的机械划擦过程,具体过程如图所示:
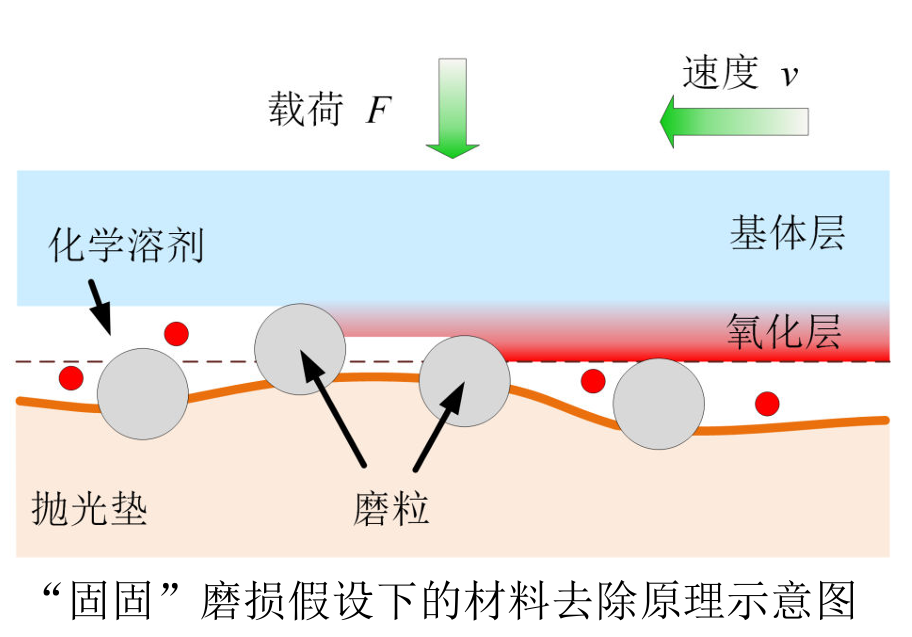
首先,抛光液中的化学溶剂和工件表面发生化学反应,在工件表面生成一种软质的反应层。磨粒在抛光垫的挤压下划擦表面反应层,产生材料去除。反应层被去除之后,底层的新鲜表面重新裸露在抛光液中并生成新的反应层,之后再被磨粒去除,如此循环往复。
当机械去除和化学反应两种过程处于平衡时,材料去除效率将达到最佳,并且任何影响这两个过程的参数都将对最终的材料去除率以及表面质量产生影响。
然而,这种基于机械划擦理论的材料去除机理的认知在如今面临很大的局限性。首先,目前CMP技术可以实现超光滑表面的加工,在抛光GaN,蓝宝石等晶体材料时会观测到原子台阶现象。
原子台阶是由于晶向偏角或者晶格缺陷的存在,导致表面裸露的晶格结构呈现稳定的周期性台阶,是表面加工所能达到的理论光滑极限。
显然,基于磨粒压入-塑性耕犁的材料去除模式无法解释CMP这种原子级的极限加工能力。另外,在典型的CMP工况下,抛光液中的纳米磨粒压入工件表面的深度甚至小于一个原子直径,在这种原子级别的压入深度下,基于连续介质理论的压入-耕犁去除模式将不再适用于CMP原子级材料去除机理的解释。
分子动力学(Molecular Dynamics,简称MD)由于可在原子尺度展示所研究系统的动态运动过程,目前已经成为研究CMP在原子尺度上的化学机械协同作用以及材料去除过程的主要途径之一。
基于抛光过程的MD仿真模型主要包括磨粒磨损模型和磨粒冲击模型。两者均利用MD来模拟磨粒对工件表面的材料去除机制和损伤机理,而前者主要基于纳米切削或者纳米压痕过程的仿真。
然而,传统MD方法基于牛顿力学运动方程,无法考虑化学作用的影响,因此,模拟结果具有很大的局限性。 基于反应力场的分子动力学(Reactive Force Field-Molecular Dynamics,简称ReaxFF MD)方法是MD方法的一种延伸,其突破了MD基于传统的牛顿运动定律的力场体系,而采用第一性原理的计算方法计算原子级别的动态过程。另外,通过建立势能函数和键级的关系,ReaxFF-MD可以进一步用来描述体系中原子尺度的化学反应。
下图展示了SiO2磨粒在阈值压力下划擦Si表面发生的单层原子去除过程。
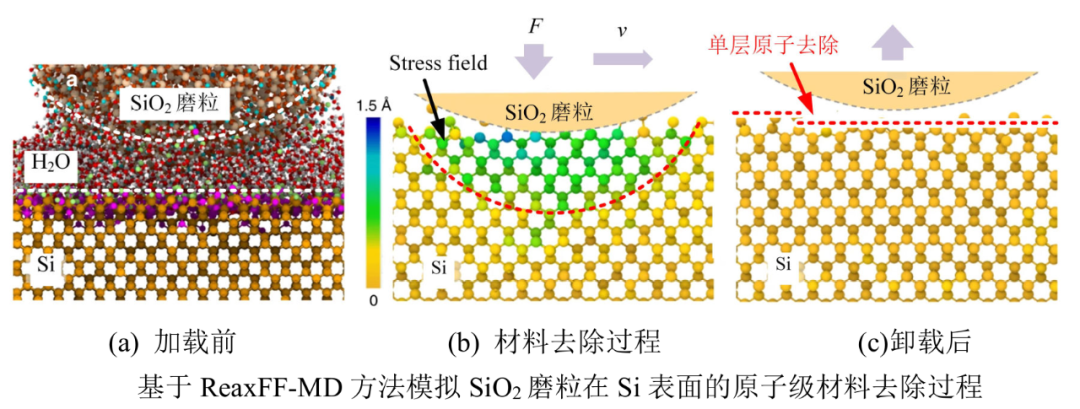
在初始阶段,如图(a)所示,Si工件和SiO2磨粒表面分别和H2O发生化学反应,生成Si–H和Si– OH官能团。接着,Si和SiO2磨粒在载荷的作用下发生接触,表面官能团重组形成Si– O–Si界面桥键,如图(b)所示,其中颜色云图表示Si原子在载荷作用下的Z向位移。 在滑动过程中,界面Si–O–Si键将拉应力传递给Si基体,促进Si基体中Si–Si键的断 裂,并发生表面单层Si原子的去除,如图(c)所示。
基于原子力显微镜(Atomic Force Microscope,简称AFM)技术的AFM探针试验,是研究原子尺度上材料去除过程的重要试验方法。
研究发现,金刚石针尖在划擦Si表面时,只有在大载荷条件下才会造成材料去除,而SiO2针尖却可以在更小的载荷条件下产生更大的材料去除,并且SiO2针尖的材料去除率和环境湿度密切相关。将这种现象归因于SiO2和Si在H2O环境中的表面羟基化。当外载荷作用时,SiO2和Si表面的羟基脱水缩合形成Si–O–Si界面桥键。
这种原子尺度的机械化学反应,降低了材料去除的能量阈值,使得SiO2针尖可以在更小的载荷下去除材料,并进一步建立了单颗磨粒的材料去除率和最大接触压力Pmax以及相对划擦速度v之间的关系。
基于上述原子尺度的机械化学反应,科研人员利用直径为250 μm的SiO2探针,在单晶硅Si(100)面上实现了Si原子的单层去除,并通过高分辨透射电镜(High Resolution Transmission Electron Microscope,简称HRTEM),证实了Si原子的单层去除现象。
尽管上述研究取得了一系列的成果,然而,真实CMP过程中的抛光环境更加复杂,涉及各类参数,各类材料在抛光过程中的动态变化等等。
以目前的数值模拟技术和试验技术,要准确建立真实CMP过程中的原子级材料去除模型仍旧存在困难。
四、CMP纳/微/宏跨尺度材料去除
化学机械协同作用下的原子级材料去除过程是CMP技术最底层的物理过程。然而,这种从原子级的材料去除过程到宏观材料去除过程的映射,是一个复杂的动态跨尺度问题。如下图(a)所示,抛光过程中,工件以给定载荷作用在抛光垫表面并发生相对运动。与此同时,抛光液在离心力的作用下,流入工件和抛光垫之间的接触界面,提供供材料去除的纳米磨粒以及化学溶剂环境。
抛光垫作为一种抛光工具,其表面存在大量的微观粗糙结构,因此,粗糙的抛光垫表面只有一些局部高点才会和工件发生真实接触,如图(b)所示。
在CMP过程中,纳米磨粒嵌入在一个个接触点内,并跟随抛光垫一起,相对工件表面运动,如图(c)所示。
最后,在机械载荷以及抛光液的化学作用下,磨粒和工件之间发生原子级的材料去除,如图(d)所示。
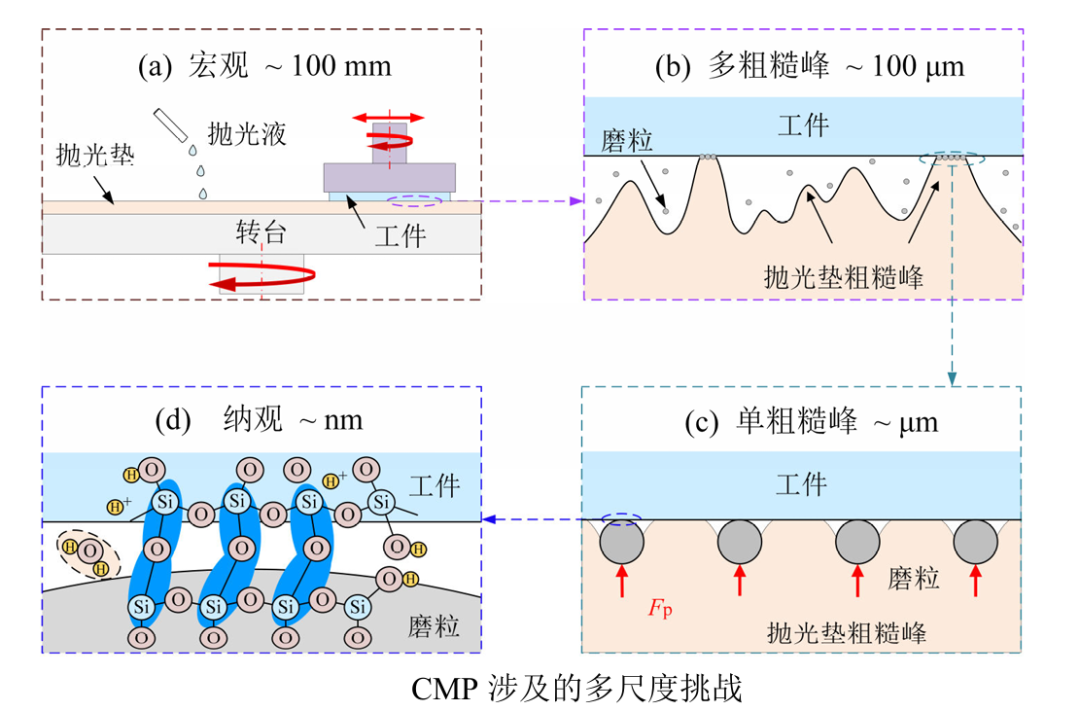
五、抛光垫作用及分类
抛光垫的微观接触状态,指的是抛光垫粗糙表面的高点和工件表面形成的接触区域。
一般来说,抛光垫/工件之间接触点尺寸在1~100 μm范围内。抛光垫的微观接触状态是抛光垫力学特性和表面微观形貌的综合体现。
抛光过程中,任何导致抛光垫表面力学特性以及微观形貌变化的的因素都会对抛光垫的微观接触状态产生影响。
以下是抛光垫微观接触状态的影响因素的详细讨论:
(1)微观接触状态主要取决于抛光垫的材料力学特性和结构特点
抛光垫一般是由聚氨酯材料制作而成,具有优良的机械性能,耐磨损性,以及良好的化学稳定性。另外,聚氨酯材料具有很好的可设计性和可加工性,可以满足不同的工艺需求。这种设计和制造工艺的不同,导致不同抛光垫之间的力学特性和结构特点差异明显。基于抛光垫的结构特点,将主流的商用抛光垫分为以下四类,如表所示。
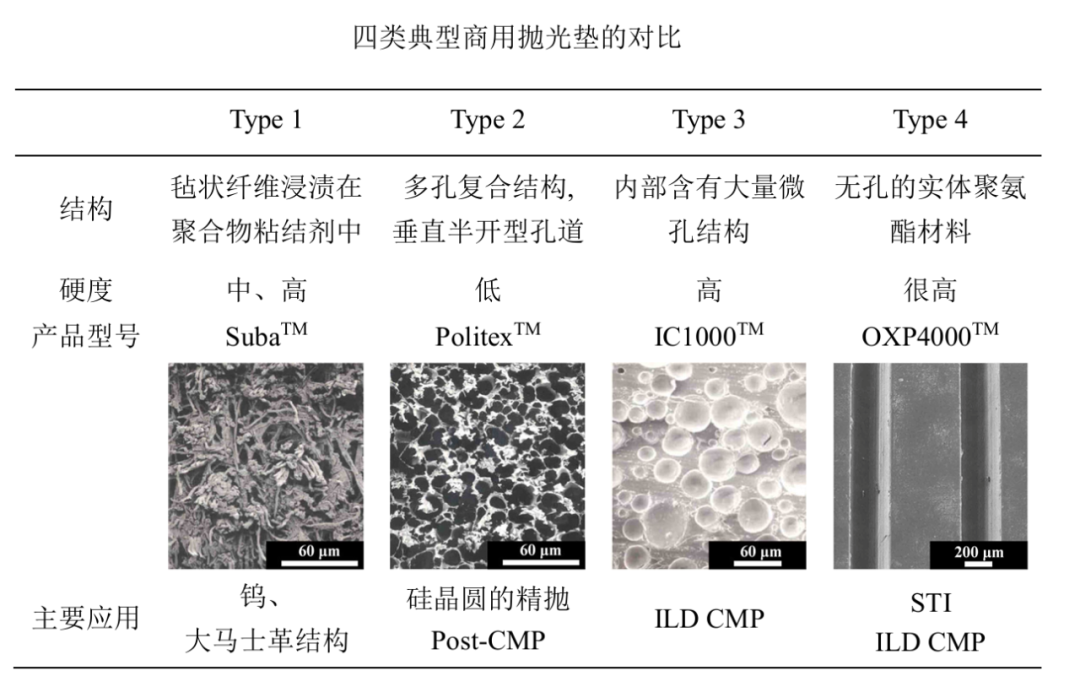
可见,每种类型的抛光垫都有独特的表面微观结构,表面微观结构决定了抛光垫的真实接触状态,决定了磨粒在接触界面内的承载状态以及工件表面的化学反应时间,从而对最终的材料去除率产生影响。
另外,抛光垫的力学特性表现出明显的非线性特点,首先,为了保证抛光液在接触界面的存储和运输,大部分抛光垫都含有微孔或者间隙结构。
以IC1000系列抛光垫为例,其在制备过程中会填充一定比例的空心聚合物微球,混合固化后在内部形成大量半径10~50 μm的封闭微孔,这种多孔结构导致抛光垫表现出明显的材料非线性特点。并且,由于抛光机械载荷的作用以及化学溶剂带来的聚氨酯水解现象,抛光垫表层的力学特性和基体层也将存在很大差异,同样会带来显著的非线性问题。复杂的力学特性导致抛光垫的微观接触状态变得更加复杂。
(2)微观接触状态很容易受到抛光过程和修整过程的影响
一方面,CMP的运动特征导致抛光垫粗糙峰不断经历抛光载荷以及剪切力的循环作用,从而诱发粗糙峰发生塑性流动并趋于平面化,这种抛光垫表面平面化的现象也被称为釉化现象,如图(b)所示。
另一方面,抛光液中的磨粒很容易积累在表面微孔结构中,并导致材料去除效率的恶化以及划痕的产生。因此,实际的CMP过程中大多会引入修整工艺来保证加工质量以及加工过程的稳定性。
修整是对抛光垫表面进行机械加工的过程,如图(c)所示。
嵌有金刚石颗粒的修整盘在一定的修整载荷下划擦抛光垫表面,通过金刚石颗粒的切割作用,重新生成具有一定粗糙度的表面,如图(d)所示。修整过程直接决定抛光垫表面的微观形貌,从而影响抛光垫/工件之间的微观接触状态。然而修整过程是一种随机过程,如何表征随机修整过程中的微观接触特征,是导致抛光垫微观接触状态研究复杂的另外一个重要因素。
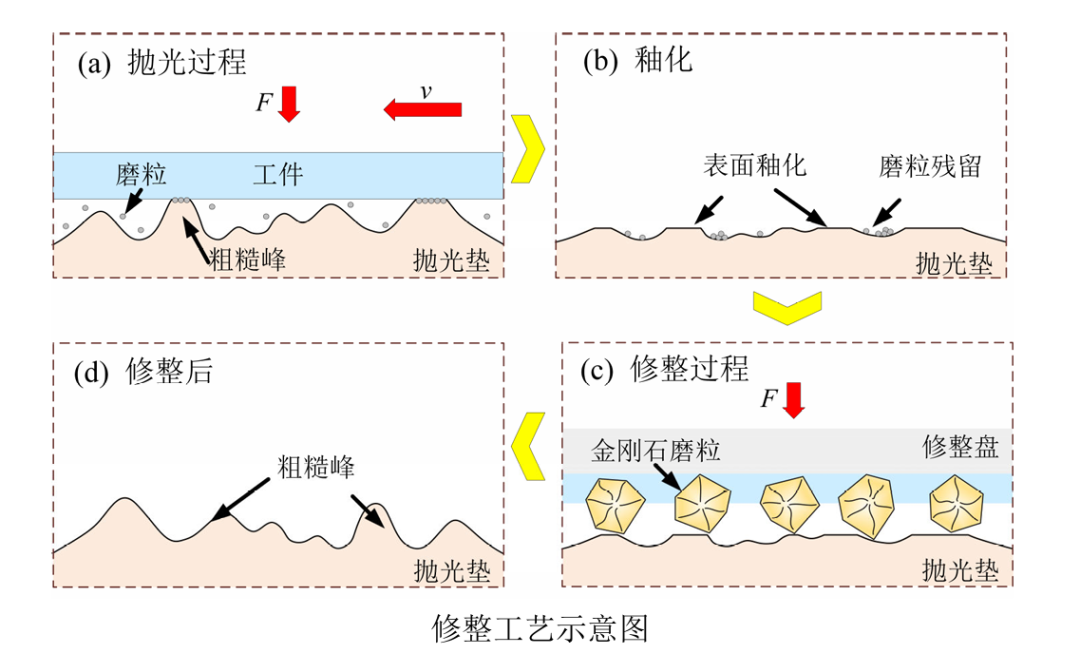
六、CMP面临的挑战
多行业的应用导致CMP技术面临多样化的材料以及加工工艺需求。CMP技术所面临的多样化挑战包括以下几部分:
(1)材料多样化挑战
CMP工艺所涉及的材料越来越多,包括玻璃、单晶硅、砷化镓、碳化硅、氮化硅、氮化镓、硅锗化合物、铜、铝、钨、金、蓝宝石、金刚石和各种陶瓷等。
根据易磨损(Easy to Abrade,简称ETA),难磨损(Difficult to Abrade,简称DTA)两类机械特性和易反应(Easy to React,简称ETR),难反应(Difficult to React,简称DTR)两类化学特性,将材料分为以下四个大类:
(a)ETA–ETR材料,Cu,Al这种质软、化学特性活泼的金属材料一般属于这一类,其在CMP过程中很容易产生划痕以及化学腐蚀现象。
(b)DTA–ETR材料,SiO2等氧化物阻挡层一般属于这一类,虽然表面很难被划擦,但是比较容易发生化学反应。
(c)ETA–DTR材料,IC领域中的Low k材料和MEMS领域中SU-8光刻胶就属于这一类。
(d)DTA–DTR材料,一些新型的宽禁带半导体材料如SiC和GaN一般属于这一类,材料本身比较硬且有具有很强的化学反应惰性。
可见,不同的材料具有不同的物理化学特性,而CMP技术本身又是一种依靠化学和机械协同作用实现材料去除的加工方式,材料多样化的挑战对CMP过程中化学和机械协同作用的理解和控制提出新的要求。
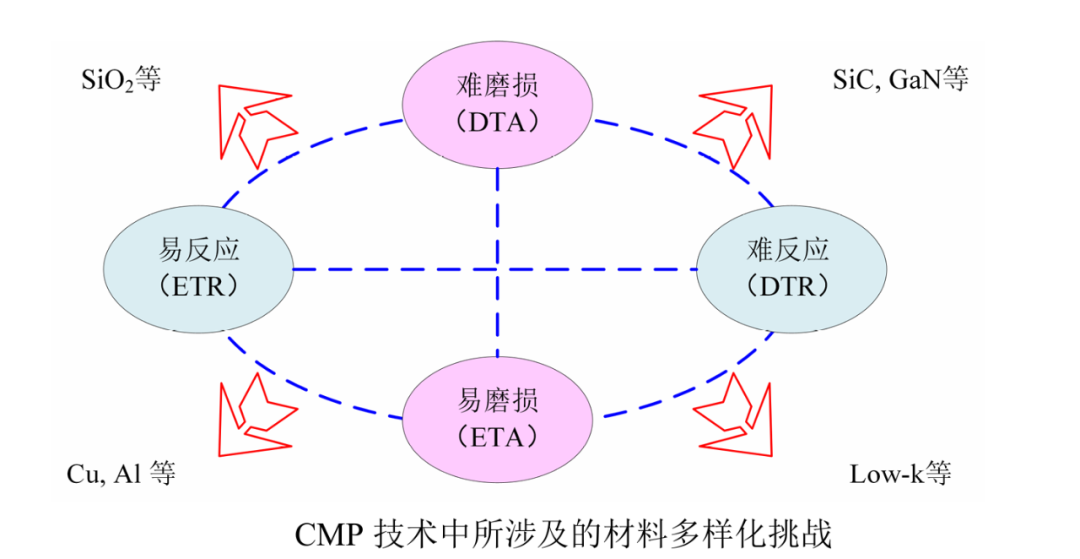
(2)加工技术指标的多样化挑战
不同领域对CMP的加工要求和精度指标有所差异,即使是相同领域,不同工艺路线和流程下的加工指标也有所不同。多样化的加工技术指标是CMP技术面临的另一个挑战。以IC制造为例,鳍式场效应晶体管(Fin Field-effect Transistor,简称FinFET)是7nm制程下广泛使用的工艺设计。FinFET制造中对CMP技术提出的技术指标是在SiN和SiO2层上实现Poly-Si层的选择性去除,即要求CMP在平坦化过程中具有较高的选择性去除能力,满足Poly-Si的高去除率又保证作为衬底材料的SiN,SiO2不被去除。
而3D-NAND是一种将存储单元在垂直方向进行堆叠从而提高芯片存储容量的技术。为了满足存储单元在垂直方向堆叠,就需要一些大的沟道结构,导致阻挡层和隔离层材料如SiN,SiO2以及poly-Si在沉积时,出现明显的高度差,如下图(a)所示。
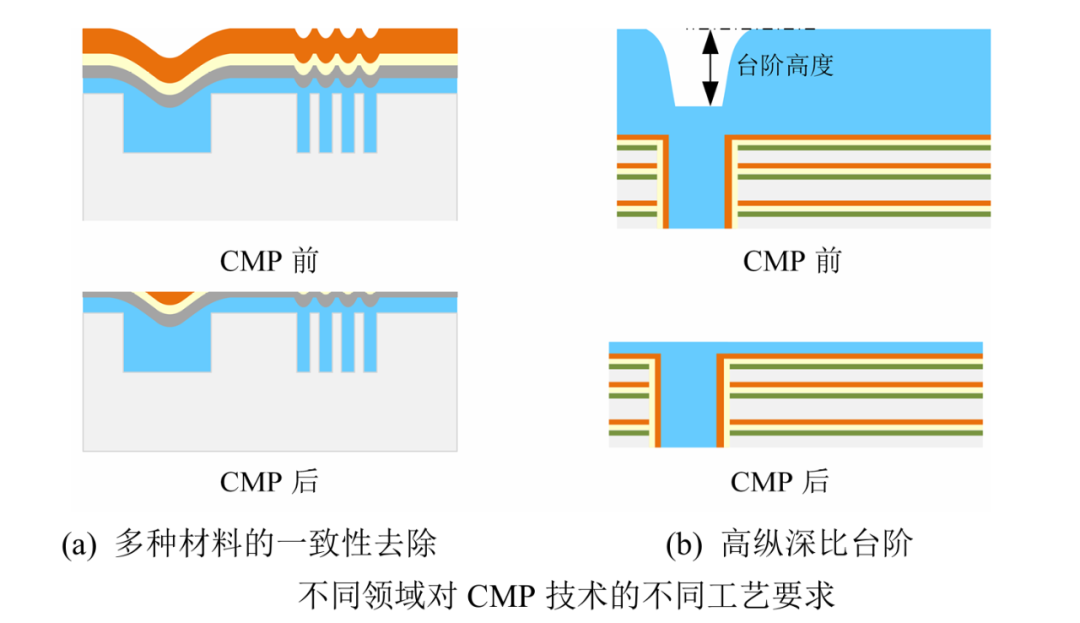
为了保证全局和局部的平坦化的要求,就要在一次CMP过程中实现SiN,SiO2以及Poly Si这几种不同材料的同时去除,这提出了和FinFET制造中不同的工艺需求。
另外,半导体制造流程在前段制程(Front End of Line)以及后段制程(Back End of Line)中经常遇到一些高纵深比的三维结构。这些高纵深比的三维结构在填充后,很容易产生一些大的台阶高度,如上图(b)所示,这些高纵深比结构的存在,则对CMP的去除效率提出新的要求。
(3)各产业未来发展的挑战
随着各领域的发展,各种新型材料会被不断的开发出来,一些传统材料也在新的背景需求下得到新的应用。
同时,各个领域的不断的发展又会不断提出新的加工工艺指标和技术要求,这就需要CMP技术具有很强的适应能力和调控能力,能够快速满足产业化需求。如何快速开发针对特定材料和加工性能要求的CMP工艺,是决定未来市场竞争力和产业化速度的关键问题之一,同样也是CMP技术面临的新的挑战。
以IC领域为例,集成电路正继续遵循摩尔定律向着更小线宽、更多互连层数、更大晶圆尺寸的方向发展,对晶圆平坦化工艺的平整度和缺陷控制的要求越来越苛刻,可以预见,CMP技术将成为未来IC制造的瓶颈之一。
下表列举了IC领域中新的发展趋势对于CMP技术的影响。
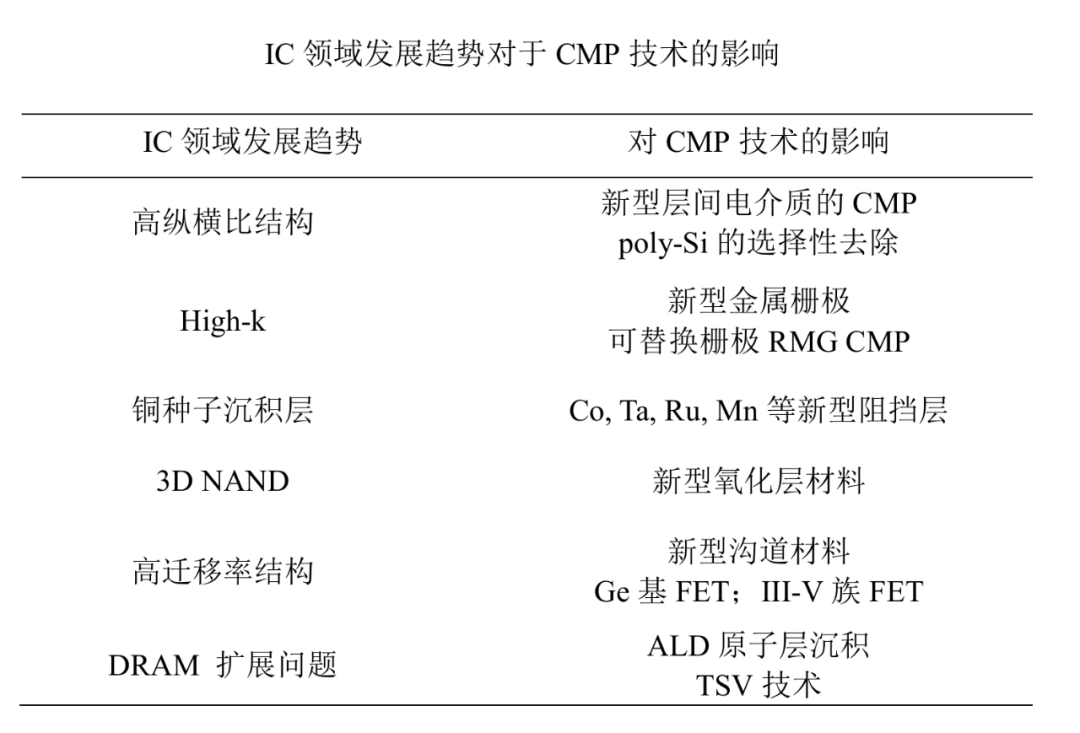
对于晶体管来说,为了提高晶体管栅极结构的电子迁移率,提出利用Ge、III-V族半导体和石墨烯以及碳纳米管等碳类材料作为沟道材料的MOSFET结构。
这种新型三维结构和栅极材料的使用,导致CMP技术的开发难度急剧增加。对于互连来说, 随着互连线宽缩小,互连沟槽深宽比增大,传统的钽基阻挡层无法实现均匀沉积,容易出现缩口现象。因此,提出新的铜/钌(钴)亚10nm结构来替代传统的铜/钽结构。
然而,铜、钌之间的电化学性能差异极大,如果机械力和化学的耦合作用控制不当,极易导致界面电偶腐蚀,造成芯片断路。因此,这种新型结构的使用对CMP过程中机械和化学作用的调控提出了更严格的要求。
七、总结
可以预见,在未来几年,随着不同物理化学响应的抛光材料的增加,再加上面形精度、表面粗糙度、材料去除均匀性、材料选择去除性等不同加工结果的要求,CMP技术面临越来越多样化的挑战。然而,由于影响CMP加工质量和效率的因素众多,且各因素的影响间存在复杂的耦合关系,人们依旧需要提高对CMP技术机理的认知。
-
芯片
+关注
关注
463文章
54441浏览量
469421 -
半导体
+关注
关注
339文章
31248浏览量
266601 -
晶圆
+关注
关注
53文章
5450浏览量
132763 -
机械抛光
+关注
关注
0文章
7浏览量
1967
原文标题:一文了解芯片化学机械抛光(CMP)技术
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
碳化硅晶片的化学机械抛光技术研究

新型铜互连方法—电化学机械抛光技术研究进展
化学机械抛光技术的研究进展
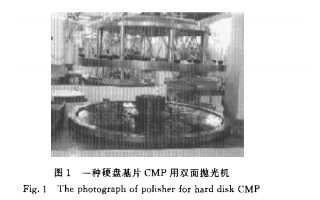
化学机械抛光CMP技术的发展应用及存在问题
化学机械抛光(CMP)技术的发展、应用及存在问题
多晶硅薄膜后化学机械抛光的新型清洗解决方案

CMP后化学机械抛光清洗中的纳米颗粒去除报告
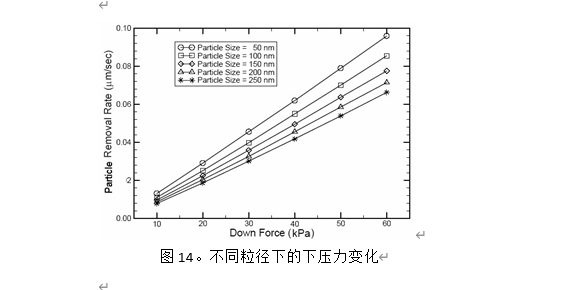
化学机械抛光(CMP)的现状和未来
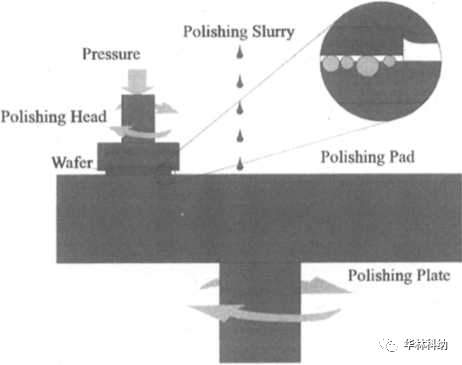
半导体行业中的化学机械抛光(CMP)技术详解
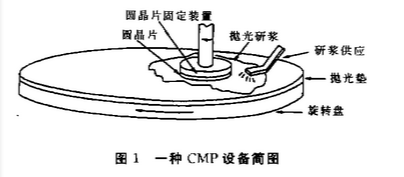
日本研发电化学机械抛光(ECMP)技术
化学机械抛光技术(CMP)的深度探索
半导体国产替代材料 | CMP化学机械抛光(Chemical Mechanical Planarization)




 深度解析芯片化学机械抛光技术
深度解析芯片化学机械抛光技术


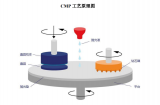



评论