半导体湿法清洗工艺
随着半导体器件尺寸的不断缩小和精度要求的不断提高,晶圆清洗工艺的技术要求也日益严苛。晶圆表面任何微小的颗粒、有机物、金属离子或氧化物残留都可能对器件性能产生重大影响,进而影响半导体器件的成品率和可靠性。
晶圆表面污染物种类繁多,大致可分为颗粒污染、金属污染、化学污染(包括有机和无机化合物)以及天然氧化物四大类。
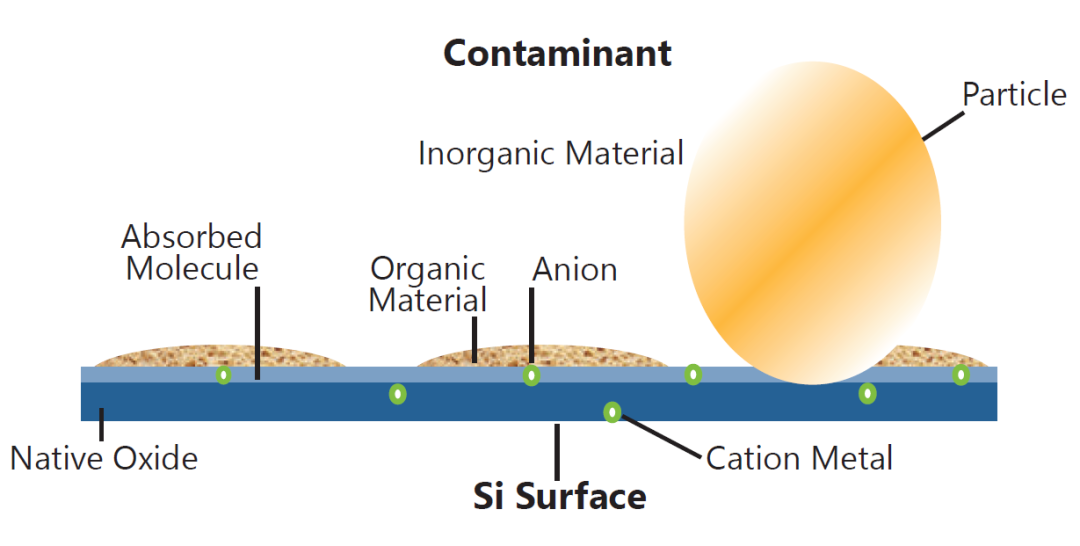
图1:硅晶圆表面可能存在的污染物
01
颗粒污染
颗粒污染主要来源于空气中的粉尘、生产设备磨损、工艺化学品残留等。这些微小颗粒可能遮挡关键特征的形成,或在绝缘薄膜中产生局部电弱点,导致器件性能下降甚至失效。针对颗粒污染的清洗策略包括使用强氧化剂如piranha溶液(硫酸与过氧化氢的混合物)进行总颗粒物清洗,以及利用SC-1溶液(氨水、过氧化氢和水的混合物)去除强粘附的小颗粒。SC-1通过诱导晶圆表面与颗粒相同的zeta电位,有效防止颗粒再吸附。
02
金属污染
金属污染物如金、铜等,在硅晶格中具有高度流动性,易从表面迁移到体硅中,导致漏电流增大、击穿电压降低等严重后果。酸性清洗剂如SC-2(盐酸、过氧化氢和水的混合物)、SPM(硫酸与过氧化氢的混合物)等能有效去除金属污染物,形成可溶的离子化金属盐并被冲洗掉。
03
化学污染
有机污染物主要来源于光刻胶残留、挥发性有机溶剂及空气污染。这些污染物在高温工艺中会形成碳残留物,影响良率。SC-1和SPM等清洗液通过氧化及溶剂化作用去除有机污染物。
无机污染物包括硼、磷等掺杂元素及酸碱性化合物。这些污染物会改变电阻率、影响光刻胶性能并产生颗粒和雾霾。通过SC-1和SC-2的联合作用可有效去除。
04
天然氧化物
硅表面自然形成的氧化物层会影响热氧化物厚度形成及栅极绝缘体电特性。稀氢氟酸(DHF)、氟化铵或BOE(抛光氧化物刻蚀液)能完全去除天然氧化物,留下氢终端的硅表面。

图2:天然氧化物的去除和氢终端硅表面特性
湿法清洗是指利用化学反应或物理作用将半导体表面的杂质、氧化物和有机物等污染物去除的方法。清洗的目的是为了提高半导体表面的洁净度,减少杂质对器件性能的影响。在湿法清洗中,常用的化学反应有酸碱中和反应、氧化还原反应等。物理作用包括溶解扩散、吸附等。
常用的湿法清洗有:RCA清洗、臭氧清洗、超声波清洗和兆声波清洗等方法。
1
RCA清洗
RCA清洗工艺是半导体行业中最经典的晶圆预清洗方法,由Werner Kern及其同事在RCA公司开发。该工艺结合了SC-1和SC-2溶液,并辅以稀HF或BOE去除天然氧化物。RCA清洗凭借其高效性和可靠性,至今仍被广泛应用于前道工序(FEOL)的晶圆清洗中。SC-1清洗液由 NH4OH、H2O2和H2O 组成,由于H2O2的作用,硅片表面有一层自然氧化膜(SiO2),呈亲水性, 硅片表面和粒子之间可用清洗液浸透。SC-2 清洗液由 HCl、H2O2 、和H2O组成,主要用于对硅片表面金属沾污的清洗。
硅片表面金属的存在形式是多种多样的,它们可以以原子、氧化物、金属复合物、硅化物等形式存在于自然氧化膜表面、自然氧化膜内部、硅与氧化物的界面或硅内部。金属在溶液中的附着特性与 pH 值、金属诱生氧化物作用、氧化还原电位、负电性、金属致氧化物形成焓以及化学试剂的氧化性等有关。在3
在SC-1和SC-2溶液清洗后,利用DHF去除晶圆表面的氧化层。DHF(HF/H2O 20-25℃)是一种由氢氟酸和去离子水组成的混合溶液。由于DHF可以去除硅片表面的自然氧化膜,因此附着在自然氧化膜上的金属将被溶解到清洗液中,同时 DHF 抑制了氧化膜的形成。因此可以很容易的去除硅片表面的 AL、 Fe、 Zn、 Ni等金属,DHF也可以去除附着在自然氧化膜上的金属氢氧化物。随着自然氧化膜溶解到清洗液中 Cu 等贵金属(氧化还原电位比 H 高),会附着在裸硅表面即:
01
如果硅片最外层的硅都以H为终端,硅表面在化学上将是稳定的。即使清洗液中存在贵金属离子,也很难发生于 Si的电子交换,因此这些金属不会附着在硅片的表面;
01
02
如果清洗液中存在Cl等阴离子,就会附着在硅表面H终端不完整的地方,附着的阴离子将会辅助Cu离子与 Si 的电子交换,使Cu离子成为Cu附着在硅片表面。用 DHF 清洗时将会把硅片表面的自然氧化膜腐蚀掉,而Si几乎不被腐蚀。用DHF 清洗后,硅片最外端的Si几乎都以H为终端, 故硅片呈疏水性。
SPM(H2SO4/H2O2100-130℃)是一种由硫酸和过氧化氢组成的混合溶液。这是一种去除有机污染物的常用清洗液。由于工艺上的不同,DHF或被用于SPM后、或SC-1后、或SC-2后,甚至多道DHF被引入RCA清洗中。大部分公司将RCA清洗中的DHF设置于SPM后。标准的RCA清洗流程如图3所示。
图3:标准的RCA清洗流程
02
2
臭氧清洗
臭氧清洗技术主要利用其极强的氧化性。该氧化性可以破坏和去除晶圆表面的有机和无机污染物,它也常用于对表面进行氧化处理。向超纯水中加入臭氧可以有效去除Cu,Ag等金属,甚至一些轻有机物,是其他晶圆清洗手段的一种辅助。这种方法不需要使用昂贵的化学试剂,并且对环境污染较小,因此逐渐成为晶圆清洗领域的一种新兴技术。
图4:臭氧清洗原理示意图
3
超声波清洗
超声波清洗是在超声波作用下,机械振动传到液体中时,迫使液体内部产生疏密相间的振动,液体不断被拉伸和压缩。疏的区域形成微小的空穴气泡,密的区域受到压缩,在不断拉伸和压缩的环境下,空穴气泡不断破裂,对晶片表面的颗粒连续施加短暂且强烈的作用力,迫使颗粒从晶片表面脱落,从而达到清洗效果。一般用于大于0.5微米的颗粒清洗。
4
兆声波清洗
在兆声波清洗中,很少形成超声波那样的气泡,主要以高速的流体冲击晶片表面,强制除去细小的污染物,使之进入到清洗液中。一般可以去除0.1-0.3微米的颗粒清洗。
图5:兆声波清洗示意图
晶圆清洗技术作为半导体制造中的关键环节,其重要性不言而喻。通过多种清洗方法的组合使用,能够有效去除晶圆表面的各种污染物,为后续工艺提供洁净的基底表面。随着技术的不断进步,清洗工艺也在不断优化,以适应更高精度、更低缺陷率的半导体制造需求。
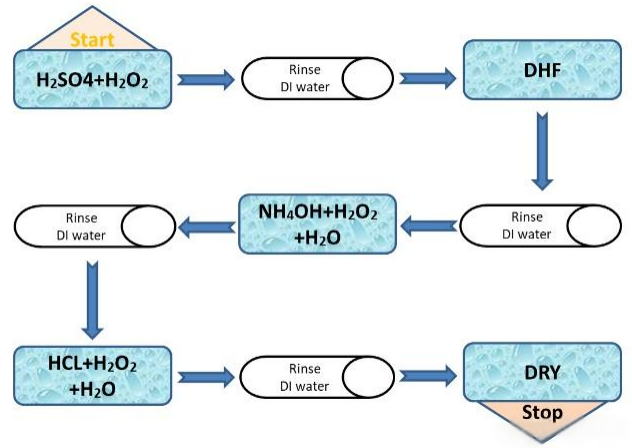

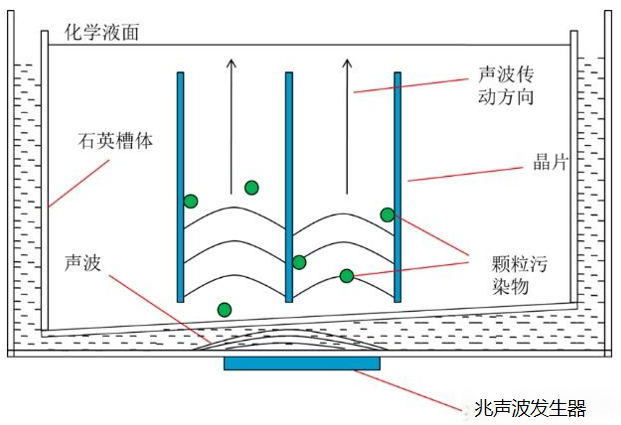
-
湿法
+关注
关注
0文章
41浏览量
7279 -
半导体制造
+关注
关注
8文章
529浏览量
26347
原文标题:半导体湿法清洗工艺
文章出处:【微信号:wc_ysj,微信公众号:旺材芯片】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测
半导体制造的难点汇总
《炬丰科技-半导体工艺》DI-O3水在晶圆表面制备中的应用
半导体制造CMP工艺后的清洗技术
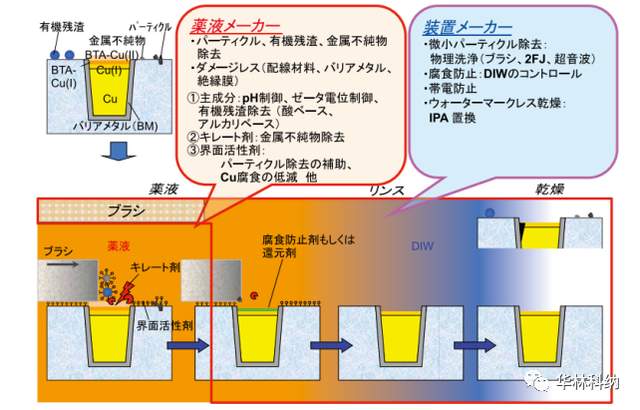
半导体制造中有效的湿法清洗工艺
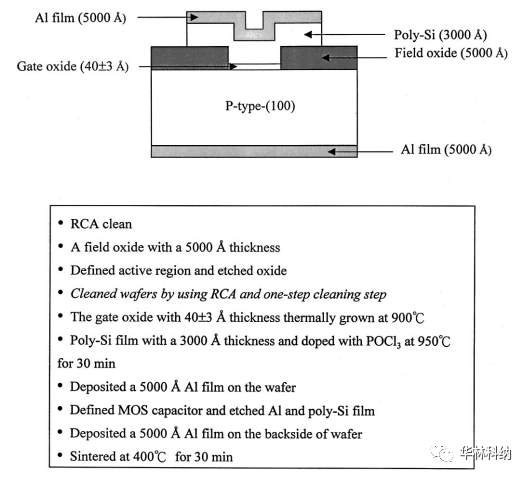
探秘半导体制造中单片式清洗设备
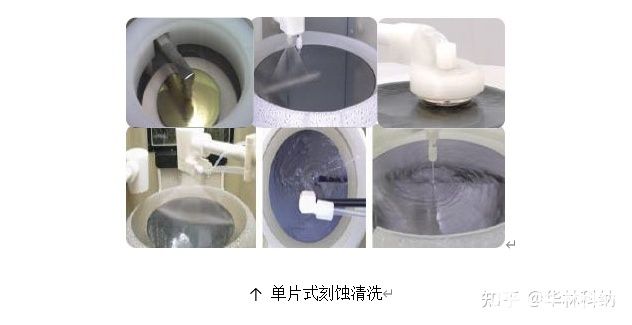
衬底清洗全攻略:从湿法到干法,解锁半导体制造的“洁净密码”




 半导体制造中的湿法清洗工艺解析
半导体制造中的湿法清洗工艺解析

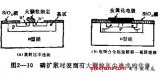






评论