了解封装设备的原理,有助于设备的选型及灌胶工艺的深入了解,中汇翰骑小编给大家简单介绍下透明屏的封装工艺;
SMD表贴工艺技术
SMD:它是Surface Mounted Devices的缩写,意为:表面贴装器件。采用SMD(表贴技术)封装的LED产品,是将灯杯、支架、晶元、引线、环氧树脂等材料封装成不同规格的灯珠。用高速贴片机,以高温回流焊将灯珠焊在电路板上,制成不同间距的显示单元。
SMD小间距一般是把LED灯珠裸露在外,或采用面罩的方式。由于技术成熟稳定、制造成本低、散热效果好、维修方便等特点,故在LED应用市场也占据了较大份额。但由于存在严重的缺陷,已是无法满足现在市场的需求。
1、防护等级低:时常会出现灯珠不亮,列亮,死灯,掉灯,怕冷风,怕水汽,怕灰尘,怕刮蹭等居多问题,不具备防潮、防水、防尘、防震、防撞。在潮湿的气候下,容易出现大批次的死灯、坏灯现象。在运输的过程中容易出现掉灯,坏灯的现象。也容易受到静电的影响,造成死灯现象。
2、 对眼睛伤害大:长时间观看会出现刺眼、疲劳,不能保护眼睛。此外,有些劣质产品还存在“蓝害”影响,因蓝色LED波长短,频率高,人眼直接地、长期地接受蓝光影响,容易引起视网膜病变。
目前市面上能够有效解决以上问题的工艺主要有COB、GOB、VOB封装。
COB封装工艺
COB :chip on board 发光芯片在基板上封装;
COB指的是在基底表面用导热环氧树脂覆盖硅片安放点,然后将硅片直接安放在基底表面,热处理至硅片牢固地固定在基底为止,随后再用丝焊的方法在硅片和基底之间直接建立电气连接。裸芯片技术主要有两种形式:一种是COB技术,另一种是倒装片技术(Flip Chip)。板上芯片封装(COB),半导体芯片交接贴装在印刷线路板上,芯片与基板的电气连接用引线缝合方法实现,并用树脂复盖以确保可靠性。虽然COB是简单的裸芯片贴装技术,但它的封装密度远不倒片焊技术。
COB相对于SMD的工艺的优势:
1、防磕碰、防撞击;
2、防氧化、防静电;
3、防潮、防尘、正面防水、易清洗;
4、点光源到面光源,无像素颗粒感,画面柔和,不易产生视觉疲劳;
5、有效抑制摩尔纹,减少光线折射,显示画面更优质;
6、减少制作工艺步骤,提高品质控制,可靠性高,COB产品失效率低;
7、间距更小:采用COB封装没有贴片、SMT等步骤,可以完成更小间距的实现,单位内显示像素越多,画面自然清晰;
COB正装与倒装技术的区别?
倒装LED芯片相对于正装芯片来说,是电极芯片的布局和实现电气功能的方式不同。倒装芯片的电极是朝下的,而且不需要正装芯片的键合焊接工艺,这样可以大大提高生产效率。
COB倒装技术优势:
1、有源层更贴近基板,缩短了热源到基板的热流路径,具有较低的热阻。
2、适合大电流驱动,光效更高。
3、优越的可靠性,可提高产品寿命,降低产品维护成本。
4、尺寸可以做到更小,光学更容易匹配。
GOB工艺
GOB是Glue on board的缩写,是为了解决LED灯防护问题的一种技术,是采用了一种先进的新型透明材料对基板及其LED封装单元进行封装,形成有效的保护。该材料不仅具备超高的透明性能,同时还拥有超强的导热性。使GOB小间距可适应任何恶劣的环境,相比传统SMD其特点是,具有高防护性:防潮、防水、防尘、防撞击、防磕碰、防静电、防盐雾、防氧化、防蓝光、防震动,可以应用于更多恶劣的环境,避免大面积死灯、掉灯等现象发生。
LED透明屏VOB工艺
VOB是市面上GOB工艺上的一种升级工艺,采用的进口VOB纳米胶涂敷,通过纳米级的涂敷机控制涂层更薄,平整性更高,且LED防护性更强、故障率更低、黑屏一致性更高、画面更加柔和,极大地提升了屏幕的观看显示效果。
VOB的优势:
1、防护性更强:
防潮、防水、防尘、防撞击、防磕碰、防静电、防盐雾、防氧化、防蓝光、防震动;这样可以解决安装过程中的磕碰,甚至焊盘脱落导致的PCB报废。
2、故障率低,可靠性高:
整体的将灯珠不良降低到5PPM以下,这样客户不用担心交付验收,用户不用担心使用。
3、易维修:
继承了SMD简易单灯维修等优点,在VOB车间经过我司培训合格的工程师, 便可进行维修,重新安装后不会存在颜色差异。
4、画面柔和,不易产生视觉疲劳:
VOB工艺将LED灯由点发光源变成面发光源,观看起来画面柔和,无像素颗粒感,同时可以减轻摩尔纹效果。
5、黑屏一致性提高,对比度增高:
VOB工艺涂覆层厚度,颜色可控,有效解决了PCB 墨色不一致的问题,可以提高屏幕底色黑度,增加对比度,而且不损失视角。
VOB系列产品质量控制生产步骤大概分3步:
1. 首先选取最优质的材料、灯珠、业内超高刷IC方案、高品质LED晶片;
2. 产品装配好后,通过纳米级涂敷机灌胶前,老化72小时,对灯进行检测;
3. 灌胶后,再老化24小时,再次确认产品质量。
审核编辑:ymf
 电子发烧友App
电子发烧友App























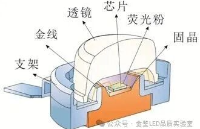


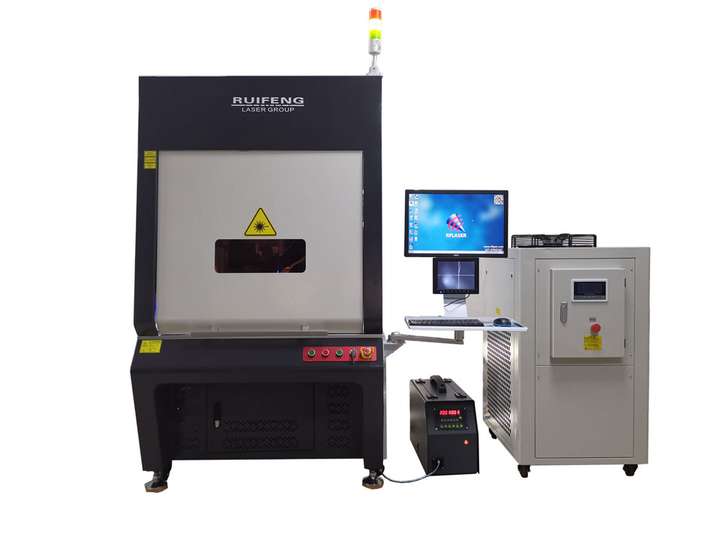








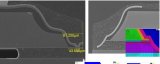

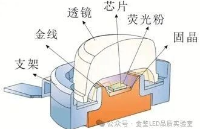





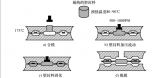
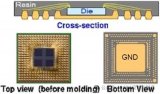










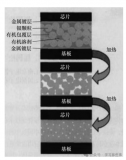
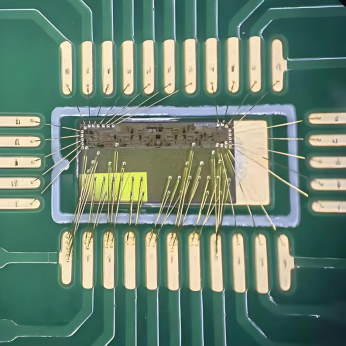



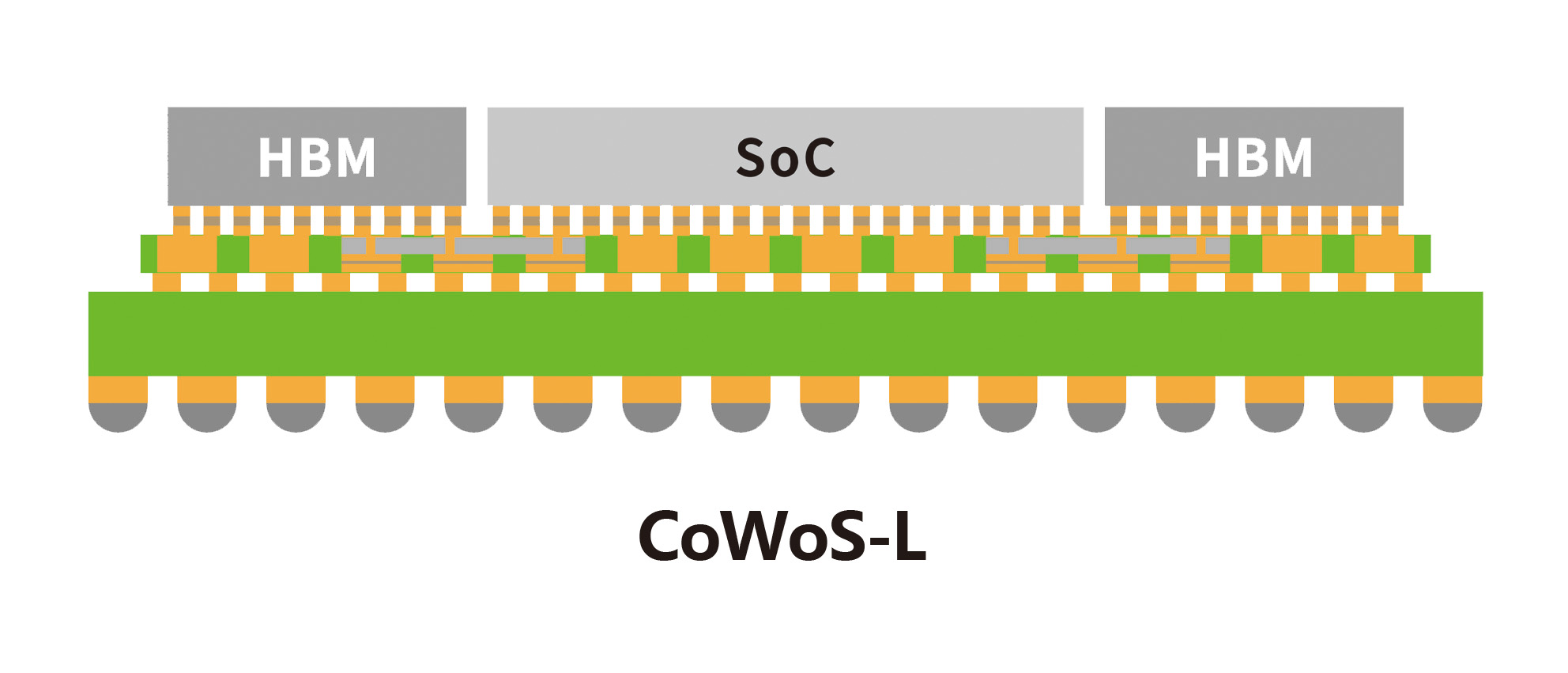














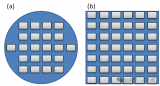



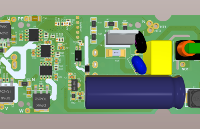





评论