封装工艺正从传统保护功能向系统级集成演进,其核心在于平衡电气性能、散热效率与制造成本。
一、封装工艺的基本概念
芯片封装是将半导体芯片通过特定工艺封装于保护性外壳中的技术,主要功能包括:
物理保护:防止芯片受机械损伤、湿气、灰尘等外界环境影响;
电气连接:通过引脚或焊料凸点实现芯片与外部电路的稳定信号传输;
散热管理:优化封装材料与结构设计,提升芯片散热效率;
机械支撑:增强芯片结构强度以应对振动、冲击等物理应力。
二、封装工艺的主要分类
【传统封装技术】
通孔插装技术(1980年前):以DIP(双列直插封装)为代表,引脚数≤64,安装密度约10引脚/cm²;
表面贴装技术(1980-1990年):采用SOP(小外形封装)和QFP(四边引脚扁平封装),引脚数扩展至3-300条,安装密度达10-50引脚/cm²。
【先进封装技术】
系统级封装(SiP):集成处理器、存储器等多功能芯片于单一封装内,支持2D、堆叠及3D结构,显著缩短开发周期并降低成本;
倒装封装(Flip Chip):芯片倒置并通过焊球直接连接基板,缩短信号传输路径,提升I/O密度与高频性能;
多芯片封装(MCP):基于2.5D/3D堆叠技术,采用硅中介层或有机基板实现高密度互连,适用于移动设备与高算力服务器。
三、封装工艺流程
封装等级划分
0级封装:晶圆切割为独立芯片;
1级封装:芯片级封装(如倒装焊、引线键合);
2级封装:封装芯片安装至模块或电路卡;
3级封装:系统级集成,完成电路卡到主板的安装。
关键制造步骤
凸点制作:在芯片I/O焊盘沉积金属凸点,结合UBM层增强导电性与附着力;
芯片贴装:高精度对准基板焊盘,通过加热或加压实现焊球连接;
底部填充:注入环氧树脂材料固化,吸收热应力并提升机械稳定性;
塑封成型:采用环氧模塑料包裹芯片,形成最终保护壳体。
四、技术发展趋势
高密度集成:3D堆叠与Chiplet技术突破物理限制,实现超薄、异构芯片集成;
智能散热方案:集成热界面材料(TIM)与液冷技术,应对200-400W高功耗场景;
国产化突破:国产封装设备逐步替代进口,兼容信创生态与边缘计算需求。
审核编辑 黄宇
-
芯片封装
+关注
关注
14文章
627浏览量
32442
发布评论请先 登录
CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图及国产替代进展

85页PPT,看懂芯片半导体的封装工艺!

热压键合工艺的技术原理和流程详解

解析LGA与BGA芯片封装技术的区别

SK海力士HBS存储技术,基于垂直导线扇出VFO封装工艺

传统封装与晶圆级封装的区别
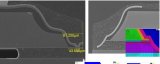
详解CSP封装的类型与工艺




 芯片封装工艺详解
芯片封装工艺详解












评论