一、引言
随着电子产品的日益小型化、多功能化,对半导体封装技术提出了更高要求。PoP(Package on Package,叠层封装)作为一种先进的封装技术,在智能手机、数码相机、便携式穿戴设备等消费类电子产品中得到了广泛应用。本文将详细探讨PoP叠层封装工艺的原理、特点、结构类型、关键技术、应用以及未来发展趋势。
二、PoP叠层封装工艺原理与特点
PoP叠层封装工艺是在一个具有高集成度的逻辑封装件上再叠加另一个与之相匹配的大容量存储器封装件,形成一个新的封装整体。这种封装形式主要具有以下几个特点:
- 高度集成:PoP封装将逻辑器件和存储器件进行垂直堆叠,大大提高了系统封装密度,节省了占板面积。这对于空间有限的便携式电子设备来说尤为重要。
- 灵活性高:存储器件和逻辑器件可以自由组合,并可单独进行测试或替换,这不仅提高了成品率,还为终端用户提供了自由选择器件组合的可能。
- 性能优越:由于堆叠器件垂直互连取代了传统二维封装互连,可以实现逻辑器件和存储器件之间更快的数据传输,减少了信号延迟,提高了系统性能。
三、PoP叠层封装结构类型
随着技术的不断发展,PoP叠层封装工艺出现了多种结构类型,以满足不同产品的需求。
- 锡球连接PoP:在这种结构中,逻辑芯片通常采用倒装互连(Flip Chip,FC)技术进行封装,并作为底部组件。底部芯片采用毛细管底部填充工艺(Capillary Under Fill,CUF)。锡球连接PoP结构紧凑,适用于对性能要求较高的应用场景。
- MLP(MoldimgLaser Package)连接PoP:为了发展较薄的PoP封装结构,成型激光封装技术应运而生,市场上也称之为穿塑孔(Through Mold Via,TMV)技术。其方法是先在底部芯片四周焊接锡球并直接塑封,然后采用激光穿孔方式使锡球露出,以便后续与上层元器件连接。这种结构在减小封装厚度的同时,保持了良好的电性能。
- 柔性电路板连接PoP:为了满足PoP产品尺寸薄、功能强、I/O数多等需求,采用柔性电路板连接各种封装组件并进行折叠形成PoP结构。这种结构在可穿戴设备等对柔性要求较高的应用场景中具有优势。
- BVA(Bond Via Array)连接PoP:BVA技术通过提高产品性能、缩小引脚间距,进一步提升了PoP封装的集成度和性能。
四、PoP叠层封装关键技术
PoP叠层封装工艺涉及多项关键技术,这些技术对于保证封装质量和性能至关重要。
- 减薄工艺:PoP作为高度集成的3D封装体,对封装及圆片的厚度有着更高的要求(低于100um)。因此,需严格控制减薄工艺,避免出现圆片破裂和芯片裂纹等问题。同时,在切割厚度薄于100um的圆片时,易造成芯片剥离蓝膜,这也需要采取相应的措施进行解决。
- 植球工艺:由于封装集成度高,信号端口之间的间距更小(小于0.3mom),所以对植球工艺提出了更高的要求。需要更高精度的植球机,严格控制植球工艺精度,以保证电气连接的可靠性和稳定性。
- 塑封材料与工艺:PoP对于成品的厚度要求较高,需要将塑封控制在较薄的厚度范围内。因此,需通过实验选择最佳的塑封材料,以及塑封和固化参数,以避免发生不完全塑封、塑封体内的孔洞,以及塑封材料与圆片及基板之间分层等问题。特别是对于MLP-POP结构,塑封后的激光钻孔尤为重要,需要控制好激光脉冲的能量、脉冲宽度、重复频率、对位等参数,从而控制好钻孔的尺寸、形状、位置等,更好地实现上、下封装体的叠封。
- 翘曲控制:PoP作为高度集成的两个封装体的叠加,对于上、下封装体的翘曲有着较高的要求。应尽量使上、下封装体具有相同的翘曲方向,从而实现叠加上的一致性。对于封装体翘曲过大的情况,需要更好地控制封装时的锡膏量。进行新产品评估时,也需要专门评估分析上、下封装体的翘曲数据。
五、PoP叠层封装工艺应用
PoP叠层封装工艺在消费类电子产品中具有广泛的应用前景。特别是在智能手机领域,随着智能手机性能不断提高、功能不断增多,其内部空间不断缩小,PoP封装应用比例不断提升。PoP封装不仅满足了智能手机对高性能、小尺寸的需求,还通过提供灵活的器件组合选择,降低了生产成本,提高了市场竞争力。
此外,PoP封装还逐渐扩展到其他消费类电子产品中,如数码相机、便携式穿戴设备等。这些产品对小型化、多功能化同样有着较高的要求,而PoP封装正好能够满足这些需求。
六、PoP叠层封装工艺未来发展趋势
- 技术不断创新:随着半导体技术的不断发展,PoP叠层封装工艺将不断创新。例如,通过引入新型材料、优化工艺流程等手段,进一步提高封装密度、降低封装厚度、提高性能稳定性等。
- 应用领域不断拓展:除了消费类电子产品外,PoP叠层封装工艺还将拓展到更多领域。例如,在汽车电子、工业控制、医疗电子等领域,PoP封装也将发挥重要作用。
- 标准化与规范化:随着PoP封装技术的广泛应用,标准化与规范化将成为未来发展的重要趋势。通过建立统一的标准和规范,可以提高生产效率、降低生产成本、促进技术交流与合作。
七、案例分析
以某智能手机厂商为例,该厂商在智能手机设计中广泛采用了PoP叠层封装工艺。通过采用PoP封装,该厂商成功地将高性能的处理器和大容量的存储器集成到有限的空间内,实现了智能手机的轻薄化、高性能化。同时,由于PoP封装提供了灵活的器件组合选择,该厂商还可以根据市场需求快速调整产品配置,提高了市场响应速度。
在具体实施过程中,该厂商与半导体封装厂商紧密合作,共同攻克了减薄工艺、植球工艺、塑封材料与工艺、翘曲控制等关键技术难题。通过不断优化工艺流程和参数设置,该厂商成功地将PoP封装应用于大规模生产中,并取得了良好的市场效果。
八、总结
PoP叠层封装工艺作为一种先进的封装技术,在消费类电子产品中具有广泛的应用前景。通过高度集成、灵活性高、性能优越等特点,PoP封装满足了电子产品对小型化、多功能化、高性能化的需求。同时,随着技术的不断创新和应用领域的不断拓展,PoP封装将在未来发挥更加重要的作用。然而,PoP封装也面临着一些挑战,如减薄工艺难度大、植球工艺精度要求高、塑封材料与工艺复杂等。因此,需要半导体封装厂商、手机厂商等各方共同努力,不断攻克技术难题,推动PoP封装技术的持续发展和应用。
-
电子产品
+关注
关注
6文章
1308浏览量
61209 -
芯片封装
+关注
关注
14文章
623浏览量
32397 -
POP封装
+关注
关注
0文章
7浏览量
5287
发布评论请先 登录
电子产品EMC整改:从源头到终端的系统化技术路径
乐鑫科技即将亮相2026国际消费电子产品展览会
普强亮相2025全球智能机械与电子产品博览会
谷东智能亮相2025全球智能机械与电子产品博览会
电子产品生产中的电路板布线设计与激光焊锡的关系

为什么电子产品必须采用RoHS无铅工艺?

瀚思通亮相2025香港秋季电子产品展
电子产品是做GB4943标准测试吗?

电子产品都要做ROHS测试吗?

电子产品环境可靠性试验介绍




 揭秘PoP封装技术,如何引领电子产品的未来?
揭秘PoP封装技术,如何引领电子产品的未来?



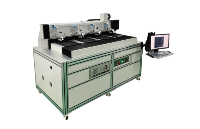




评论