来源:内容由半导体芯闻(ID:MooreNEWS)
先进半导体封装的凸块技术已取得显着发展,以应对缩小接触间距和传统倒装芯片焊接相关限制带来的挑战。该领域的一项突出进步是 3D Cu-Cu 混合键合技术,它提供了一种变革性的解决方案。
随着焊料凸点间距缩小,会出现一些问题。凸块高度和接合表面积的降低使得建立可靠的电气连接变得越来越困难,因此需要精确的制造工艺来避免错误。关键的共面性和表面粗糙度变得至关重要,因为即使是微小的不规则性也会影响成功的粘合。
制造面临一些障碍,例如由于铜柱和凸块直径较小而导致蚀刻困难,从而更有可能发生底切。随着有效确保均匀性和控制共面性变得更加困难,电化学沉积 (ECD) 电镀变得更加复杂。此外,随着凸块尺寸不断缩小,接合质量对凸块共面性、表面粗糙度和硬度等因素的敏感性使得对温度、时间和压力等参数的调整变得复杂。
传统的倒装芯片接合方法仅限于 50μm 或 40μm 的间距,由于热膨胀不匹配导致翘曲和芯片移位,因此会遇到可靠性问题。为了应对这些挑战,半导体行业正在转向热压接合 (TCB),以实现先进的细间距接合应用,包括小至 10μm 的间距。TCB 为实现不断发展的半导体封装领域所需的精度和可靠性提供了一条有前途的途径,从而突破了电子设备小型化和性能的界限。
然而,当接触间距减小到 10 微米左右时,出现了一些问题。焊球尺寸的减小会增加金属间化合物 (IMC) 形成的风险,从而降低导电性和机械性能。此外,在回流焊过程中,焊球接触并导致桥接故障的可能性可能会导致芯片故障。这些限制在高性能组件封装场景中变得越来越成问题。
为了克服这些问题,铜-铜混合键合技术成为了游戏规则的改变者。这项创新技术涉及在介电材料之间嵌入金属触点,并使用热处理来实现铜原子的固态扩散,从而消除与焊接相关的桥接问题。
混合键合相对于倒装焊接的优点是显而易见的。
首先,它实现了超细间距和小触点尺寸,有利于高 I/O 数量。这对于现代半导体封装至关重要,因为设备需要越来越多的连接来满足性能需求。
其次,与通常依赖底部填充材料的倒装焊接不同,铜-铜混合键合不需要底部填充,从而减少了寄生电容、电阻和电感以及热阻。
最后,铜-铜混合键合中键合连接的厚度减小,几乎消除了倒装芯片技术中 10-30 微米厚度的焊球,为更紧凑、更高效的半导体封装开辟了新的可能性。
铜-铜混合键合技术为先进半导体封装带来了巨大的前景,但它也带来了一系列挑战,需要创新的解决方案来实现未来的发展。
目前Cu-Cu混合键合有三种方式。晶圆到晶圆(W2W)工艺是最常用的,而芯片到晶圆(D2W)或芯片到晶圆(C2W)工艺正在深入研究开发中,因为它可以满足更多需要集成不同尺寸的应用。
对于所有这三种方式,制造中的一个关键方面是键合环境,其中通过化学机械抛光 (CMP) 优化实现平坦且清洁的电介质表面至关重要。此外,开发能够承受较低退火温度和较短持续时间的介电材料对于最大限度地减少键合过程中晶圆变形和翘曲的可能性至关重要。优化的铜溶液电化学沉积 (ECD) 还可以减少退火时间并降低退火温度,从而提高效率。
就 D2W/C2W 工艺而言,解决与芯片分割和边缘效应相关的挑战以及最大限度地减少芯片和晶圆上的污染将是关键。需要高精度贴片机来确保精确的芯片贴装,并将公差缩小至低至 0.2μm。为了适应潜在的放置错误,必须使用更大的铜焊盘。此外,先进的薄晶圆处理技术将在确保铜-铜混合键合的成功实施方面发挥重要作用。
铜-铜混合键合的未来发展可能会集中在改进和优化工艺的这些关键方面。这包括 CMP、介电材料、ECD 解决方案和拾放机械方面的进步,以及处理薄晶圆方面的创新。克服这些挑战将为先进半导体封装中更广泛采用铜-铜混合键合铺平道路,从而能够创建更小、更强大且节能的电子设备。
审核编辑:汤梓红
-
半导体
+关注
关注
336文章
29980浏览量
258256 -
3D
+关注
关注
9文章
2990浏览量
113831 -
封装
+关注
关注
128文章
9140浏览量
147893 -
焊接
+关注
关注
38文章
3507浏览量
62757
原文标题:3D cu-cu键合,封装新革命?
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
从微米到纳米,铜-铜混合键合重塑3D封装技术格局
3D显示技术的发展现状及未来趋势
研发的铜混合键合工艺正推动下一代2.5D和3D封装技术

BOE湿蚀对三维集成中铜模式直接键界面特性的影响
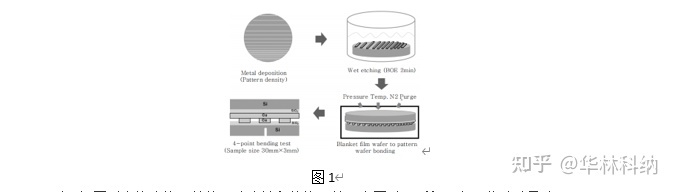
先进封装中铜-铜低温键合技术研究进展






 3D Cu-Cu混合键合技术的优点和未来发展
3D Cu-Cu混合键合技术的优点和未来发展





















评论