在半导体技术日新月异的今天,SK海力士再次站在了行业创新的前沿。据最新消息,该公司计划于2026年在其高性能内存(High Bandwidth Memory, HBM)的生产过程中引入混合键合技术,这一举措不仅标志着SK海力士在封装技术上的重大突破,也预示着全球半导体行业将迎来新一轮的技术革新。
为了实现这一目标,SK海力士已与领先的半导体封装解决方案提供商Genesem紧密合作。目前,Genesem已向SK海力士的试验工厂交付了两台先进的下一代混合键合设备,用于全面测试和优化该工艺。这一合作不仅体现了双方在技术创新上的共同追求,也展示了SK海力士对于提升产品竞争力、加速技术迭代的坚定决心。
混合键合技术相较于传统封装方式具有显著优势。它摒弃了铜焊盘之间常用的凸块和铜柱结构,转而采用直接键合焊盘的方式,极大地简化了封装流程,并显著提升了封装密度。这一变革意味着,在相同的封装尺寸下,SK海力士能够装入更多的芯片进行堆叠,从而在不增加功耗的前提下,大幅提升内存的带宽和容量。这对于追求极致性能的数据中心、高性能计算以及人工智能等领域来说,无疑是一个巨大的福音。
随着SK海力士混合键合技术的逐步成熟和商业化应用,我们有理由相信,这一创新将引领全球半导体封装技术的新一轮变革。它不仅将推动HBM等高性能内存产品的性能极限不断突破,也将为整个半导体行业带来更多可能性,助力全球数字化转型的加速推进。
-
半导体
+关注
关注
339文章
31238浏览量
266571 -
SK海力士
+关注
关注
0文章
1011浏览量
41909 -
HBM
+关注
关注
2文章
433浏览量
15884
发布评论请先 登录
SK海力士投资19万亿韩元在韩国建设先进封装厂
SK海力士发布未来存储路线图
SK海力士ZUFS 4.1闪存,手机端AI运行时间缩短47%!
全球首款HBM4量产:2.5TB/s带宽超越JEDEC标准,AI存储迈入新纪元
SK海力士宣布量产HBM4芯片,引领AI存储新变革
突破堆叠瓶颈:三星电子拟于16层HBM导入混合键合技术




 SK海力士将在HBM生产中采用混合键合技术
SK海力士将在HBM生产中采用混合键合技术

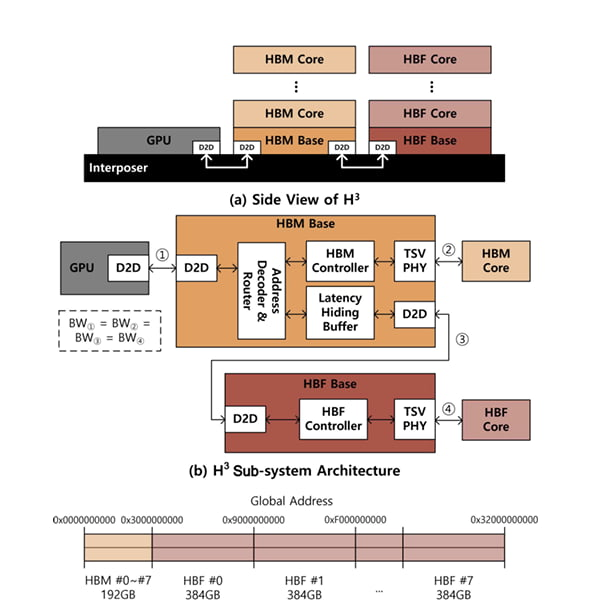





评论