全球晶圆代工龙头台积电次代先进封装布局可望再进一步,持续替摩尔定律延寿。日前苗栗县政府已经表示,台积电竹南之先进封测厂建厂计划已经展开环评,而熟悉半导体先进封装业者表示,台积电近期陆续研发并推动植
2018-10-06 06:19:21 5269
5269 半导体设备、封测厂今年将扩大高阶覆晶封装(Flip Chip)研发支出。随着半导体开始迈入3D IC架构,晶片封装技术也面临重大挑战,因此一线半导体设备厂、封测业者皆积极布局高阶覆晶封装
2013-03-13 09:13:10 1589
1589 2.5D及3D IC制程解决方案已经逐渐成熟,产业界目前面临最大的挑战是量产能力如何提升,业界预估明后年3D IC可望正式进入量产。
2013-07-23 11:24:32 1279
1279 在这篇文章中,笔者将介绍各种不同型态的 3D IC 技术,由最简易的开始到目前最先进的解决方案。不过当我们开始探讨3D IC,第一件事情就是要先问自己:「我们是想要透过3D达成什么目的?」这个问题并不无厘头,因为3D对不同的人来说可能代表的东西也不同。
2013-12-02 09:14:38 8503
8503 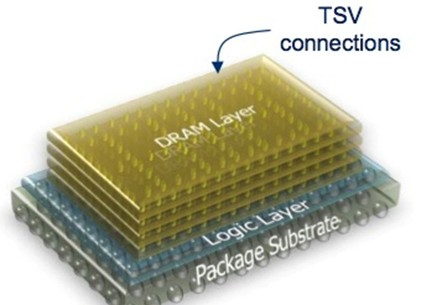
3D IC测试的两个主要目标是提高预封装测试质量,以及在堆栈芯片之间建立新的测试。业界如今已能有效测试堆栈在逻辑模块上的内存,但logic-on-logic堆栈的3D测试仍处于起步阶段…
2017-02-15 10:52:49 4373
4373 
晶圆龙头台积电订本周四举行供应链管理论坛。 据了解,将由共同执行长刘德音亲自主持,并要求供应链配合台积电全力冲刺7纳米产能,以及后续的5纳米试产,以利早日超越英特尔,成为全球半导体业新霸主。
2017-02-20 09:29:11 929
929 
据台湾媒体报道,东芝(Toshiba)出售NAND Flash事业群的竞标案炒得热闹,近期台湾经济部工业局也找台湾多家存储器相关业者密谈应对之策,将再找晶圆代工业者作第二轮商议,业界透露,台积电有意
2017-03-02 07:51:24 844
844 台积电(中国)有限公司技术总监陈敏表示,TSMC 3D Fabric先进封装技术涵盖 2.5D 和垂直芯片堆叠产,是台积电过去10年以来对于3D IC的不断完善和开发。客户采用台积3D Fabric所生产的产品取得的整个系统效能的提升,都有非常良好的表现。
2022-09-20 10:35:47 2930
2930 
几周前三星展示了公司的3D晶圆封装技术。如今,有业界专家指出,三星电子正在加速这项技术的部署,因为该公司期望能在明年开始与台积电在先进芯片封装领域展开竞争。
2020-08-25 09:47:42 3182
3182 台积电传出正在跟美国科技巨擘合作,共同开发系统整合芯片(SoIC)创新封装科技,利用 3D 芯片间堆栈技术,让半导体功能更强大。
2020-11-20 10:03:06 3583
3583 据中国台湾媒体报道,台积电将在日本投资设立一座先进封测厂。合作架构预计为中国台湾与日方各出一半投资,这将是台积电第一座在中国台湾之外的封测厂。
2021-01-06 04:39:00 3312
3312 电子发烧友网报道(文/李弯弯)3月3日,Graphcore发布最新一代IPU,性能比上一代提升40%,电源效率提升16%,这是全球首款基于台积电3D Wafer-on-Wafer的处理器。从上
2022-03-03 18:39:29 7259
7259 ~2年内有机会独吞苹果A7处理器的订单。据悉,台积电明年第1季S3C6410开始试产A7,顺利的话,后年上半年将进入量产阶段。 苹果iPhone 5上市后,受销量徒增的影响,导致A6处理器供货紧张
2012-09-27 16:48:11
应用处理器代工市场已是毫无敌手,可望直取英特尔SoFIA、苹果A9大单。 台积电今年全力冲刺20纳米系统单芯片制程(20SoC)产能,由于已抢下苹果A8处理器及高通、英特尔、NVIDIA等大单,不仅第
2014-05-07 15:30:16
据外媒报道,预计台积电将获得高通新一代电源管理芯片(PWM IC)70%至80%的订单。高通前一代电源管理芯片是由中芯国际(SMIC)生产的,后者在其8英寸晶圆厂使用0.18至0.153微米工艺来生
2017-09-27 09:13:24
发展3D封装业务。据相关报道显示,2019年4月,台积电完成全球首颗3D IC封装技术,预计2021年量产。业界认为,台积电正式揭露3D IC封装迈入量产时程,意味全球芯片后段封装进入真正的3D新纪元
2020-03-19 14:04:57
台积电强攻LED产业矽晶制程
台积电的LED照明技术研发暨量产厂房正式动土,宣告台积电正式跨足LED产业分食大饼。进军LED产业,聚焦新一代固态照
2010-04-21 11:54:18 703
703 台积电(TSMC)与中国台湾的国立台湾大学日前共同发表产学合作成果,成功研发出全球第一颗以40纳米制程生产之自由视角(any-angle)3D电视机顶盒芯片,可望较现行技术提供更精致、多元的视频影像体验。此项成果为视频处理及半导体制程技术在3D领域的重大突破
2011-02-23 09:26:54 1052
1052 据台湾对外贸易发展协会(TAITRA)透露,芯片代工巨头台积电(TSMC)有望超过intel,在2011年底推出业内首款采用3-D芯片堆叠技术的半导体芯片产品。
2011-07-07 09:19:07 1168
1168 台积电将尝试在未来独力为客户提供整合3D晶片堆叠技术。这种做法对台积而言相当合理,但部份无晶圆晶片设计厂商表示,这种方法缺乏技术优势,而且会限制他们的选择。
2011-12-16 08:57:59 1004
1004 台积电技术长孙元成20日指出,摩尔定律未必走不下去,只要与3D IC技术相辅相成,未来10年内持续微缩至7奈米、甚至是5奈米都不成问题。
2012-03-21 09:13:27 811
811 因应台积电明年积极布建?? 20nm制程产能并跨及3DIC封测,国内封测双雄日月光、矽品及记忆体封测龙头力成,下半年起也积极抢进3DIC封测,布建3DIC封测产能。
2012-07-30 09:08:04 1368
1368 本文核心思想: 台积电从个测试业挖角,成立400人封测部队,向3D IC高阶封测市场全力挥军,力争拓宽版图。 晶圆代工龙头台积电大动作启动人员扩编,为应对苹果订单落袋、主力客户
2012-08-15 09:26:02 1126
1126 半导体产业迈入20nm以下制程后,不但封测技术愈加困难、投资门坎也愈来愈高,IC封测龙头厂日月光(2311)营运长吴田玉表示,台积电(2330)本身就是看到这一点,才积极投入2.5D及
2012-09-04 11:24:43 1907
1907 
联电矽穿孔(TSV)制程将于2013年出炉。为争食2.5D/三维晶片(3D IC)商机大饼,联电加紧研发逻辑与记忆体晶片立体堆叠技术,将采Via-Middle方式,在晶圆完成后旋即穿孔,再交由封测厂
2012-09-12 09:41:32 1034
1034 台积电2013年大举跨入高阶封测领域,封测双雄日月光和矽品均进入备战状况,加大力度建置产能,可预期高阶封测将成为封测业今年主战场。
2013-01-06 09:00:19 974
974 9月25日——全球电子设计创新领先企业Cadence设计系统公司(NASDAQ:CDNS)今天宣布,台积电与Cadence合作开发出了3D-IC参考流程,该流程带有创新的真正3D堆叠。该流程通过
2013-09-26 09:49:20 1717
1717 系列产品全线量产。赛灵思这些采用台积公司的CoWoS(Chip-on-Wafer-on-Substrate)技术开发而成的28nm 3D IC产品,通过在同一系统上集成多个芯片,从而带来明显的芯片尺寸缩小以及功耗和性能的优势。
2013-10-22 10:13:18 1554
1554 近日消息,高通日前表示,正与其生态系统合作伙伴开发3D深度传感技术,并在明年初应用到已骁龙移动芯片为基础的Android手机上。高通台积电开发3D深度传感技术高通表示,3D深度传感设备的目标市场将拓展至汽车、无人机。
2018-06-17 11:28:00 2400
2400 台积电创始人兼董事长张忠谋在近日的一次公司会议上披露,台积电将在2020年开工建设3nm工艺晶圆厂,但不会去美国设厂,而是坚持留在台湾本土,确切地说是在南部科技园区。张忠谋提出,台积电相信当地政府会解决好3nm工厂建设所需水电土地问题,并提供全力协助。
2017-11-07 13:32:32 1035
1035 台积公司透过遍及全球的营运据点服务全世界半导体市场。台积公司立基台湾,目前拥有三座最先进的十二吋晶圆厂、五座八吋晶圆厂以及一座六吋晶圆厂。本文介绍了台积电股票代码、台积电是一家怎样的公司以及台积电核心价值。
2018-01-08 09:23:25 78185
78185 义隆(2458)强攻当红的3D人脸辨识与无人车最关键的先进驾驶辅助系统(ADAS)。其中,3D人脸辨识方案锁定非苹手机品牌,ADAS则挥军日系车款,新产品效应预计在第2季末、第3季初陆续发酵。 义隆
2018-01-11 06:21:09 841
841 全球晶圆代工龙头台积电次代先进封装布局可望再进一步,持续替摩尔定律延寿。日前苗栗县政府已经表示,台积电竹南之先进封测厂建厂计画已经展开环评,而熟悉半导体先进封装业者表示,台积电近期陆续研发并推动植
2018-09-25 13:56:20 5019
5019 台积电此次揭露 3D IC 封装技术成功,正揭开半导体制程的新世代。目前业界认为,此技术主要为是为了应用在 5 纳米以下先进制程,并为客制化异质芯片铺路,当然也更加巩固苹果订单。
2019-04-22 17:09:08 3026
3026 台积电一条龙布局再突破,完成全球首颗3D IC封装技术,预计2021年量产。
2019-04-23 08:56:38 3342
3342 台积电一条龙布局再突破,完成全球首颗3D IC封装技术,预计2021年量产。
2019-05-04 09:12:00 2846
2846 台积电完成全球首颗 3D IC 封装,预计将于 2021 年量产。
2019-04-24 10:55:20 3083
3083 台积电此次揭露 3D IC 封装技术成功,正揭开半导体工艺的新世代。目前业界认为,此技术主要为是为了应用在5纳米以下先进工艺,并为客制化异质芯片铺路,当然也更加巩固苹果订单
2019-04-25 14:20:28 4993
4993 日前在台积电说法会上,联席CEO魏哲家又透露了台积电已经完成了全球首个3D IC封装,预计在2021年量产,据悉该技术主要面向未来的5nm工艺,最可能首发3D封装技术的还是其最大客户苹果公司。
2019-04-25 15:15:10 3734
3734 新思科技宣布新思科技设计平台(Synopsys Design Platform)已通过台积电最新系统整合芯片3D芯片堆栈(chip stacking)技术的认证,其全平台的实现能力,辅以具备高弹性
2019-05-07 16:20:35 3668
3668 台积电完成全球首颗 3D IC 封装,预计将于 2021 年量产。
2019-05-27 15:30:48 3395
3395 另外,我们也看到,除了传统的晶圆代工以外,台积电的2.5D和InFO“后端”封装产品都在不断发展,重点是推出SoIC拓扑结构的紧密间距Cu压接全3D堆叠芯片。可用的电路密度(mm ^3)将非常吸引人。然而,利用这项技术的挑战相当大,从系统架构分区到堆叠芯片接口的复杂电气/热/机械分析,全都包括在内。
2019-08-28 10:45:59 6186
6186 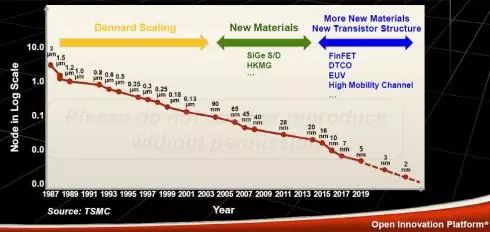
根据台积电在第二十四届年度技术研讨会中的说明,SoIC是一种创新的多芯片堆叠技术,是一种晶圆对晶圆(Wafer-on-wafer)的键合(Bonding)技术,这是一种3D IC制程技术,可以让台积电具备直接为客户生产3D IC的能力。
2019-08-14 11:21:06 4993
4993 
依现行3D封装技术,由于必须垂直叠合HPC芯片内的处理器及存储器,因此就开发成本而言,比其他两者封装技术(FOWLP、2.5D封装)高出许多,制程难度上也更复杂、成品良率较低。
2019-08-15 14:52:14 3391
3391 外电报导,美国计划将「源自美国技术标准」从25%比重调降至10%,以全力阻断台积电等非美企业供货给华为。 根据外电报导,台积电内部评估,7 纳米源自美国技术比率不到10%,仍可继续供货,但14纳米将受到限制。
2019-12-24 09:50:51 4046
4046 张忠谋称,三星电子是很厉害的对手,目前台积电暂时占优势,但台积电跟三星的战争绝对还没结束,台积电还没有赢。
2020-01-03 11:08:24 3234
3234 台积电从原来的晶圆制造代工角色,逐步跨界至封测代工领域(InFO、CoWoS及SoIC等封装技术),试图完整实体半导体的制作流程。
2020-02-25 17:18:14 4256
4256 
前有台积电的 CoWoS,Intel 的 Foveros,现在三星也公布了自家的 3D 封装技术 X-Cube。显而易见的是,未来我们买到的电子产品中,使用 3D 封装技术的芯片比例会越来越高。
2020-08-24 14:39:25 3046
3046 近日,中国台湾工业技术研究院研究总监Yang Rui预测,台积电将在芯片制造业再占主导地位五年,此后3D封装将成为主要工艺挑战。
2020-09-09 16:57:46 1592
1592 三星计划明年开始与台积电在封装先进芯片方面展开竞争,因而三星正在加速部署3D芯片封装技术。
2020-09-20 12:09:16 3742
3742 台积电官网的信息显示,他们目前有 4 座先进的芯片封测工厂,新投产两座之后,就将增加到 6 座。 据国外媒体报道,台积电计划在明后两年投产的两座芯片封装工厂,将采用 3D Fabric 先进封装技术
2020-09-25 17:06:45 840
840 他们未来的3nm工厂,预计2022年下半年台积电3nm工艺就会投产。 当然随着半导体工艺的逐渐发展,工艺的升级也逐渐困难,所需的投入也越来越大,报团合作也越来越多,台积电拉了Google和AMD过来合作。 台积电正在和Google合作,以推动3D芯片制
2020-11-30 15:50:10 1146
1146 在Intel、台积电各自推出自家的3D芯片封装技术之后,三星也宣布新一代3D芯片技术——X-Cube,基于TSV硅穿孔技术,可以将不同芯片搭积木一样堆叠起来,目前已经可以用于7nm及5nm工艺。
2020-10-10 15:22:58 2004
2004 10月份刚结束,市场上就传来一个好消息,有消息称台积电可以继续给华为供芯片了。综合现阶段各方报道,目前市场上有5家公司可以为华为供应芯片,分别是索尼、豪威科技、AMD、英特尔和台积电。 回归到芯片
2020-11-04 14:16:57 2837
2837 【TechWeb】1据台湾媒体报道,台积电赴美建5nm厂一事有了新进展,台积电正在美国大举招募人才。 台积电在职场社交网站LinkedIn放出许多职位,工作地点位于美国亚利桑那州凤凰城,包括3D
2020-11-06 11:29:30 1690
1690 11月10日消息,据国外媒体报道,台积电、三星等主要芯片代工商,都在加快部署3D封装技术,以求尽快投产,台积电计划明后两年投产的两座芯片封装工厂,都将采用3D Fabric封装技术。 在台积电、三星
2020-11-10 18:20:41 2583
2583 11月19日消息,据报道,台积电与Google等美国客户正在一同测试,合作开发先进3D堆栈晶圆级封装产品,并计划2022年进入量产。台积电将此3D堆栈技术命名为“SoIC封装”,可以垂直与水平的进行芯片链接及堆栈封装。
2020-11-20 10:56:30 2854
2854 11月23日消息,据国外媒体报道,谷歌和AMD,正在帮助台积电测试和验证3D堆栈封装技术,将成为台积电这一芯片封装技术的首批客户。 外媒是援引消息人士的透露,报道谷歌和AMD正在帮助台积电测试3D
2020-11-23 12:01:58 2191
2191 近日,据外国媒体报道谷歌和AMD,正在帮助台积电测试和验证3D堆栈封装技术,将成为台积电这一芯片封装技术的首批客户。报道中提到,台积电正在打造支持3D堆栈封装技术建设的工厂,预计明年建成。
2020-11-23 16:21:06 2515
2515 如今的高端半导体芯片越来越复杂,传统的封装技术已经无法满足,Intel、台积电、三星等纷纷研发了各种2.5D、3D封装技术,将不同IP模块以不同方式,整合封装在一颗芯片内,从而减低制造难度和成本
2020-11-26 17:59:48 1778
1778 如今的高端半导体芯片越来越复杂,传统的封装技术已经无法满足,Intel、台积电、三星等纷纷研发了各种2.5D、3D封装技术,将不同IP模块以不同方式,整合封装在一颗芯片内,从而减低制造难度和成本。
2020-11-27 09:09:09 1805
1805 如今的高端半导体芯片越来越复杂,传统的封装技术已经无法满足,Intel、台积电、三星等纷纷研发了各种2.5D、3D封装技术,将不同IP模块以不同方式,整合封装在一颗芯片内,从而减低制造难度和成本。
2020-11-27 10:38:38 1667
1667 芯片设计领域,而台积电、中芯国际等,则专注于芯片制造领域,日月光、通富微电等则专注于芯片封测,当然也有像Intel、三星这样IDM芯片巨头,自己可以实现芯片的设计、制造、封测三个重要环节,而我们都知道
2020-11-30 11:30:53 1832
1832 一直以来,台积电以其强大的半导体制造能力称霸半导体领域。就在近日,有消息传出台积电方面意图全面进军芯片封测领域。 众所周知,台积电在30多年来一直专注于半导体制造环节,其市场规模甚至超过了50
2020-12-01 16:13:08 2329
2329 众所周知,台积电是张忠谋在1987年成立,成立之后专注于半导体制造,目前国际上不少芯片都由台积电生产,因此台积电的市值也一度暴涨。据了解,目前台积电的最新市值为5370.70亿美元(美股)。
2020-12-15 15:48:16 17995
17995 台积电是目前少数几家能生产5nm制程的半导体公司。根据此前的消息,除了5nm制程,台积电还在研发最新的3nm工艺,而且研发工作已经接近尾声。近日,有知情人士透露,苹果公司已预订了台积电3nm的产能,将来用于生产A系列芯片和M系列自研芯片。另外,还有传言称台积电3nm工艺将用于制造A16芯片。
2020-12-23 10:41:42 2609
2609 据国外媒体报道,此前,外媒报道称,苹果预订了台积电明年80%的5nm产能。如今,业内消息人士称,该公司也已预订台积电的3nm产能。 外媒报道称,在芯片代工商台积电全力推进3nm制程部署时,苹果公司
2020-12-28 11:51:32 2376
2376 据日经亚洲评论报道,台积电正与谷歌等美国科技巨头合作,开发新的芯片封装技术。新3D SoIC 封装技术。 随着摩尔定律放缓,缩小晶体管之间的空间变得越来越困难,封装技术的创新变得尤为重要。 台积电
2020-12-30 15:17:15 3236
3236 作为全世界最大的半导体芯片代工厂,台积电的一举一动总会吸引无数人关注。前段时间,台积电在招聘网站领英发出数十项招聘信息,工作地点位于美国亚利桑那州凤凰城,职位包括3D IC封装研发工程师、制造主管
2021-01-04 10:21:32 3229
3229 台积电和三星于先进封装的战火再起。2020年,三星推出3D封装技术品牌X-Cube,宣称在7纳米芯片可直接堆上SRAM内存,企图在先进封装拉近与台积电的距离。几天之后,台积电总裁魏哲家现身,宣布推出自有先进封装品牌3D Fabric,台积电最新的SoIC(系统集成芯片)备受瞩目。
2021-01-04 10:37:09 1760
1760 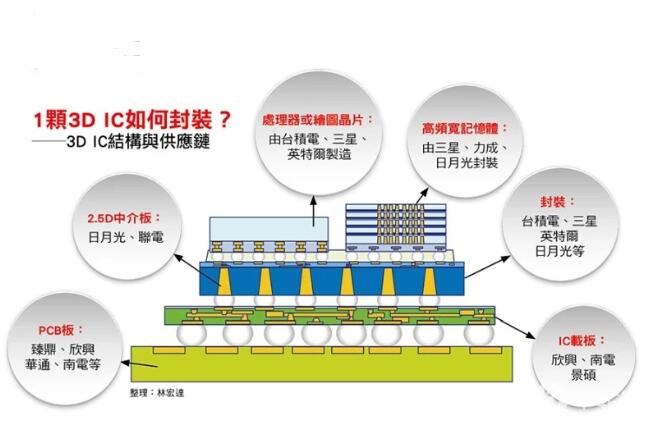
对于芯片代工龙头,台积电正在加大自己的研发费用,从而获得更领先的优势。
2021-01-04 16:51:45 1683
1683 据中国台湾媒体报道,台积电将在日本投资设立一座先进封测厂。合作架构预计为中国台湾与日方各出一半投资,这将是台积电第一座在中国台湾之外的封测厂。 资料显示,在台积电赴美投资晶圆厂后,日本经济产业省感到
2021-01-05 11:41:28 2995
2995 据台湾媒体爆料称,在日本经济产业省极力的邀请下,台积电计划将在日本东京设立先进封测厂。
2021-01-06 09:51:57 2162
2162 有关赴日设立先进封测厂的计划,台积电没有透露任何细节。但《联合报》报道称,台积电在新年度对封测事业组织做了调整。原全力推动台积电3D先进封测的研发副总余振华,转任台积电卓越院士兼研发副总经理,原职务转由主管研发的资深副总经理米玉杰负责。
2021-01-06 15:27:08 2878
2878 据消息人士透露,在日本政府的极力邀请下,台积电将与日本经济产业省成立合资公司,双方将以各出资一半的合作架构,在东京设立一座先进封测厂。据悉,若消息属实,这将成为台积电在海外设立的第一座封测厂。
2021-01-06 15:33:39 2470
2470 据台湾媒体爆料称,在日本经济产业省极力的邀请下,台积电计划将在日本东京设立先进封测厂。
2021-01-06 16:30:59 2327
2327 台积电给委婉拒绝了。
但没有想到的是,关于台积电的新消息传来,美国之后,这次是日本,因为台积电也要在日本建厂了。
不同的是,台积电在美国建设的是晶圆代工厂,在日本建设的是先进封测厂
2021-01-08 11:32:14 2228
2228 圆代工的优惠政策,这对于台积电来说,是比较罕见的决定。以往,对于该代工龙头的主要客户,台积电一般会给出3%-5%的优惠,以回报大客户对其先进制程的支持。
2021-01-12 14:55:48 2719
2719 在台积电昨日最新举办的法人说明会上,多位台积电高管分享台积电2021年资本支出计划,透露台积电N3、3D封装等先进工艺研发情况,并公布台积电2020年第四季度营收情况。
2021-01-15 10:33:39 2814
2814 日前,台积电计划通过在日本建立一家研究机构来开发3D SoIC封装材料,从而与多家公司建立协同效应。台积电强调3D SoIC将成为2022年起的主要增长引擎之一。
2021-02-19 15:54:16 2605
2605 两个芯片。这种方案很便宜,但没有太大的带宽。在这个简单的实现之上,还有多种方法可以将多个小芯片连接在一起,而台积电拥有许多这样的技术。为了统一其2.5D和3D封装变体的所有不同名称,TSMC在早前的技术大会上推出了其新的首要品牌:3DFabric。
2021-03-08 14:55:39 2512
2512 最近,台积电总裁魏哲佳出席2022台积电技术论坛,他表示台积电的3纳米工艺技术即将量产,2纳米工艺保证在2025年量产。
2022-08-31 16:40:44 4127
4127 多年来,3D IC技术已从初始阶段发展成为一种成熟的主流制造技术。EDA行业引入了许多工具和技术来帮助设计采用3D IC路径的产品。最近,复杂的SoC实现开始利用3D IC技术来平衡性能和成本目标。
2022-09-16 10:06:41 1879
1879 台积电今(27)日宣布,成立开放创新平台(OIP)3D Fabric联盟以推动3D半导体发展,目前已有美光、SK海力士、日月光、ARM、新思科技等19个合作伙伴同意加入。 据悉,3DFabric联盟
2022-10-27 10:27:55 2039
2039 包含在台积电3Dblox Reference Flow中的RedHawk-SC和RedHawk-SC Electrothermal,能够使用台积电3DFabric技术实现电源完整性和热可靠性设计签核
2022-11-02 14:19:48 1146
1146 半导体行业中的第一个联盟,它与合作伙伴联手加速3D IC生态系统的创新和准备,为半导体设计、内存模块、衬底技术、测试、制造和封装提供全方位的最佳解决方案和服务。这一联盟将帮助客户快速实现硅和系统级的创新,并利用台积电的3DFabric技术(一个全面的3D硅堆叠
2022-12-19 17:57:02 1443
1443 台积电与联电皆致力于异质整合布局。台积电2022年6月启用日本筑波3D IC研发中心,专注研究下世代3D IC与先进封装技术的材料。台积电也积极扩充3D Fabric先进封装产能,预计至2025年
2023-06-20 11:22:34 1431
1431 
前段时间,台积电晶圆以及先进工艺芯片代工价的表单也在推特上曝光。从图片上可以看到台积电近年来的价格走势,整体价格也基本在IC设计业者提到的范围区间,不过,因为两张图片相同产品的报价也有差异,价格也仅做参考。
2023-07-18 13:01:13 1123
1123 
随着芯片制造持续往更小的制程节点迈进,晶圆代工厂利用先进封装技术直接封装晶片的模式乃应运而生。不过,此模式也意味著晶圆代工厂将攫取传统封测厂的部分业务,所以自从台积电于 2011 年宣布进军先进封装领域之后,其对于传统封测厂的“威胁论”就不曾间断,那么此说法是否属实呢?
2023-08-23 16:33:57 1531
1531 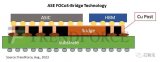
半导体公司在2022年提出了3dblox开放型标准,以简化半导体产业的3d芯片设计和模式化。台积电表示,在大规模生态系统的支持下,3dblox成为未来3d芯片开发的核心设计动力。
2023-09-28 10:51:07 1479
1479 介绍做电柜3D布局需要满足的先提条件。 电气部件要关联有相应的3D宏 使用stp格式文件,制作成3D宏,在部件中需要关联。
2023-10-19 10:47:28 854
854 
在上次降价3年后,ic制造企业表示,此次台积电将在2024年之前将部分成熟工程的价格下调约2%。另一家ic企业表示:“确实正在与台积电就明年的价格打折问题进行协商。”另外,ic设计工厂表示,台积电提供的优惠方式是在第一季度胶卷投入结束后进行结算,因此换算成下季度的光罩费用。
2023-11-27 11:39:00 1377
1377 今年6月,台积电宣布启动先进封测六厂的运作,宣示3DFabric系统整合技术扩产的标志性成果。这座位于竹南科技园区的新工厂占地14.3公顷,堪称台积电当前最大的封装测试厂,其洁净室总面积远超台积电其他先进封测晶圆厂之和。
2023-12-20 14:09:22 1087
1087 谈到台积电在这一领域的长期发展,魏哲家表示,他们已经进行了十余年的深入研究和开发,预计诸如CoWoS、3D IC和SoIC等先进封装技术的年均增长率未来几年内将保持在50%以上。
2024-01-19 09:36:39 1271
1271 2.5/3D-IC封装是一种用于半导体封装的先进芯片堆叠技术,它能够把逻辑、存储、模拟、射频和微机电系统 (MEMS)集成到一起
2024-03-06 11:46:05 3931
3931 
先进封装解决方案的激增需求,台积电正全力加速扩充其CoWoS(Chip-on-Wafer-on-Substrate)封装产能。
2024-09-06 17:20:10 1356
1356 台积电近期迎来3nm制程技术的出货高潮,预示着其在半导体制造领域的领先地位进一步巩固。随着苹果iPhone 16系列新机发布,预计搭载的A18系列处理器将采用台积电3nm工艺,这一消息直接推动了台积电3nm制程的订单量激增,为台积电带来了新一轮的出货热潮。
2024-09-10 16:56:38 1271
1271 高度差异化的终端产品。 台积电生态系统与联盟管理负责人Dan Kochpatcharin表示: 与西门子这样的开放创新平台(OIP)生态伙伴持续合作,能够帮助台积电在加速3D IC设计和AI创新方面始终处于前沿。我们与西门子的长期合作使双方共同客
2024-11-27 11:20:32 658
658 进步,先进封装行业的未来非常活跃。简要回顾一下,目前有四大类先进封装。 3D = 有源硅堆叠在有源硅上——最著名的形式是利用台积电的 SoIC CoW 的 AMD 3D V-Cache和利用台积电的 SoIC
2024-12-21 15:33:52 4573
4573 
西门子和台积电在现有 N3P 设计解决方案的基础上,进一步推进针对台积电 N3C 技术的工具认证。双方同时就台积电新的 A14 技术的设计支持展开合作,为下一代设计奠定基础。
2025-05-07 11:37:06 1415
1415
 电子发烧友App
电子发烧友App









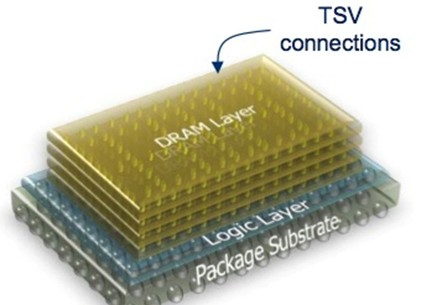




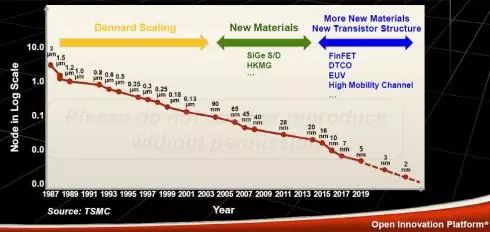


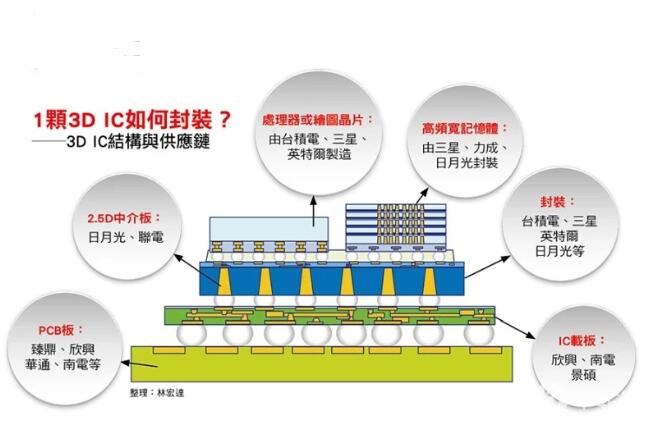


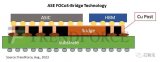






评论