11月10日消息,据国外媒体报道,台积电、三星等主要芯片代工商,都在加快部署3D封装技术,以求尽快投产,台积电计划明后两年投产的两座芯片封装工厂,都将采用3D Fabric封装技术。
在台积电、三星这两大主要的芯片代工商加快部署3D封装技术的背景下,外界也担心以芯片封测为主要业务的厂商会受到影响,封装业务可能就会大幅减少。
但产业链方面的人士透露,目前主要芯片代工商与专业封测厂商之间的合作,依旧紧密。
透露这一消息的,是芯片封装和测试服务商Amkor的一名高管,这一高管透露,虽然主要的芯片代工商加快部署3D封装,但目前他们与专业芯片封测厂商依旧是合作伙伴,并非竞争对手。
不过,从此前外媒的报道来看,主要芯片代工商与专业芯片封测厂商在封装领域依旧是合作伙伴的日子,可能并不会持续很久。在8月下旬的报道中,外媒称三星正在加快部署3D封装技术,希望在明年同台积电展开竞争。三星加快部署,其竞争对手台积电,可能也会加快3D封装技术的部署进度,以求早日大规模投产。
责任编辑:PSY
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
463文章
54739浏览量
471704 -
芯片代工
+关注
关注
0文章
102浏览量
18600 -
封测
+关注
关注
4文章
392浏览量
36154
发布评论请先 登录
相关推荐
热点推荐
评估一家封测代工厂需要重点关注哪些指标
在元器件封测代工市场,找一家靠谱的合作伙伴,远比单纯比较价格重要。交期延误、批次一致性差、沟通成本高……这些都是客户在代工合作中经常遇到的痛
显示驱动芯片封测行业迎涨价潮:结构性缺芯与贵金属通胀双重驱动
显示驱动芯片封测产业链正遭遇成本风暴。受8英寸晶圆产能结构性紧缺及国际金价飙升影响,DDIC封测上下游价格全面上涨。本文深度解析原材料成本激增与工艺双重挤压下的涨价传导机制。
长电科技汽车电子(上海)有限公司正式启用 打造面向车规级与机器人芯片封测新标杆
3月10日,长电科技旗下面向汽车电子与机器人应用的芯片封测工厂——长电科技汽车电子(上海)有限公司(JSAC)在中国(上海)自由贸易试验区临港新片区举行启用仪式,标志着公司正式投产。该项目也成为临港

长电科技汽车电子(上海)有限公司正式启用,打造面向车规级与机器人芯片封测新标杆
3月10日,长电科技旗下面向汽车电子与机器人应用的芯片封测工厂——长电科技汽车电子(上海)有限公司(JSAC)在中国(上海)自由贸易试验区临港新片区举行启用仪式,标志着公司正式投产。该项目也成为临港
发表于 03-10 18:49
•916次阅读

Meta与NVIDIA达成多年战略合作伙伴关系
NVIDIA 今天宣布与 Meta 达成一项多年期、跨多代产品的战略合作伙伴关系,涵盖本地部署、云计算和 AI 基础设施。
2D、2.5D与3D封装技术的区别与应用解析
半导体封装技术的发展始终遵循着摩尔定律的延伸与超越。当制程工艺逼近物理极限,先进封装技术成为延续芯片性能提升的关键路径。本文将从技术原理、典型结构和应用场景三个维度,系统剖析2D、2.

长电科技车规级芯片封测工厂顺利通线
2025年12月31日,长电科技(600584.SH)宣布公司旗下车规级芯片封测工厂“长电科技汽车电子(上海)有限公司(JSAC)”于本月如期实现通线。当前,多家国内外车载芯片客户的生产项目正在JSAC加速推进产品认证与量产导入工作,涵盖智能驾驶、电源管理等关键车控领域。
亚马逊云科技中国12家合作伙伴获得2025年度合作伙伴奖项
旨在嘉奖那些通过深度融合亚马逊云科技技术与服务,在全球范围内赋能客户实现创新突破和构建前瞻性解决方案方面做出杰出贡献的优秀合作伙伴。这些获奖企业充分彰显了他们在商业模式创新、业务持续增长以及最终帮助客户实现深远价值方面的专业实力、创新理念和协
2025格科全球合作伙伴大会圆满落幕
2025年10月31日,格科全球合作伙伴大会在浙江嘉善圆满落幕。来自政府的领导、国内外知名品牌终端、代理商、模组厂、平台合作伙伴等核心客户,以及国内外的晶圆制造、镀膜、封测、半导体设备、材料、软硬件服务等
SILEX希来科与QUALCOMM高通公司长达15年的战略合作伙伴关系 高通认证开发合作伙伴~高通官网能找到silex希来科
支撑起来的专业团队的知识和以与高通创锐讯之间战略合作伙伴关系为基础,为以工业、医疗、显示为代表的行业提供具有可靠连接性能的设备、为系统制造商提供作为一家领先供应商才能提供的硬件和软件的解决方案
发表于 08-28 23:33
如何提高3D成像设备的部署和设计优势
3D视觉技术正快速普及,其增长得益于成本下降和软件优化,应用场景从高端工业扩展到制造、物流等领域。该技术通过1-2台3D相机替代多台2D设备,显著提升效率并降低成本。目前主流3D成像技

Chiplet与3D封装技术:后摩尔时代的芯片革命与屹立芯创的良率保障
在摩尔定律逐渐放缓的背景下,Chiplet(小芯片)技术和3D封装成为半导体行业突破性能与集成度瓶颈的关键路径。然而,随着芯片集成度的提高,气泡缺陷成为影响




 芯片代工商加快部署3D封装 但与专业芯片封测厂商依旧是合作伙伴
芯片代工商加快部署3D封装 但与专业芯片封测厂商依旧是合作伙伴


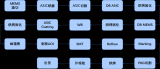



评论