作者:李晓延

(集微网报道)有着年复合增长率30%的扇出型板级封装,将在2025年实现4亿美元的市场规模。这个封装技术的后起之秀,因为更适合大型封装的批量生产,被业内人士一致看好。特别是5G、AIoT和HPC应用不断崛起,给了这项技术更大的发展空间。而作为实现扇出型板级封装的核心技术,RDL(Redistribution Layer,重布线层)更是为实现芯片的异构集成奠定了坚实的基础。
为了更好理清RDL在面板级封装中的重要性,RDL技术的发展状况和怎样的的解决方案能帮助厂商应对这些挑战,本期集微连线“未来封装趋势与杀手级应用市场——你所不知道的RDL整合技术大揭秘”中, 厦门云天半导体科技有限公司董事长于大全、深圳中科四合科技有限公司 CTO丁鲲鹏、Manz亚智科技股份有限公司技术处长李裕正围绕扇出型板级封装和RDL技术的技术发展,如何更全面地立即和掌握RDL解决方案进行了全面的解读和展望。
扇出型板级封装潜力无穷
扇出型板级封装(以下简称板级封装)与扇出型晶圆级封装几乎同时出现,以不同的路线来实现同样的目标。两者相比较的话,于大全认为扇出型板级封装有更大的尺寸,封装的单个成本更低,引发了行业极大的关注度。
李裕正也持相同的观点,“扇出型板级封装的先进程度、解析度都非常好,但是成本目前还是较高。”他也指出了扇出型板级封装的三个挑战:一是基板增大带来的重量增加,二是基板增大带来的均匀性问题,三是铜导线制程在生产中的问题。
于大全认为扇出型板级封装的实现包含了非常多的装备工艺难点,后续也将面临精度、效率、速度等一系列挑战。
据他介绍,当前扇出型板级封装有两条技术路线,一是像三星电机为三星公司的AP处理器采用该技术,这需要非常强有力的客户来做支撑;二是原来做QFN的MOSFET等产品,用基板类的工艺路径来实现板级封装,这条路线更为合理。
板级封装已经在业界逐渐开始流行。据丁鲲鹏介绍,国际一流的封装厂,如长电、日月光、矽品都在做板级封装,大陆地区的合肥矽迈、中科四合、重庆矽磐微也都实现了批量出货。
对于该技术的发展前景,于大全认为:“扇出型板级封装有非常多的挑战,目前所适应的产品类型还不够丰富,但随着工艺的进一步成熟,成本进一步降低,还有市场进一步扩大,将是非常有发展潜力的一个封装技术。”
RDL是重要的连接点
如何将尺寸极小但功能强大的芯片放到印刷电路板上做成一个系统,就需要封装技术进一步发展。要让封装技术进一步发展,就必要依赖互联技术的微缩化。“板级封装的重点就是互联技术的微缩,进而促进器件的微缩。”李裕正表示。
RDL可以把不同的芯片连接在一起,所以是一个非常重要的互联技术。于大全表示:“实现扇出型封装的一种重要方法就是RDL first,需要在晶圆和面板上做高精的布线。”
异构集成通过再布线来进行I/O的变换,就需要以RDL来实现多芯片的堆叠。于大全指出RDL的作用越来越重要,在封装中的成本占比日益增加。
他同时指出,随着技术进一步的精细化,铜互联要实现微纳或者纳米级别的组织调控,采用自由取向的再布线技术,实际上对RDL的研发也提出了很苛刻的要求。
从工艺细节的演进上来看,RDL的出现也是一个必然现象。丁鲲鹏表示:“晶圆上的焊盘大部分是铝焊盘,无论是做晶圆级封装还是板级封装,因为铝金属不易做后续处理,都需要用另外的金属来覆盖铝,RDL就应运而生。”
除了异构集成,李裕正认为RDL的应用空间非常宽广,“无源器件从原本的SMT慢慢进展到集成式,将进一步把RDL整合到工艺中,形成一个系统电路。”
同时,现在封装载板处于缺货的状态,如果将RDL技术应用到mini LED或者是Micro LED的组装上,就可以解决这个问题。
以完整解决方案来应对RDL的挑战
随着封装厂对RDL的使用增多,挑战也在不断增加。“在RDL制程中,会遇到加工尺寸中的开窗大小,对金属层厚度的掌控,铜导线跟铝焊盘结合的可靠性等一系列问题。”丁鲲鹏希望RDL工艺设备的兼容性更好,给封装厂提供更多助力。
李裕正表示,RDL解决方案提供商正在从多方面来满足封装厂的需求,像亚智科技就可以提供完整的板级RDL制程规划,覆盖了生产制造的全过程。
在很多工艺细节的处理上,亚智科技做了很多精细的设计。李裕正表示:“亚智科技提供了特殊的设计来处理沉重的基板,对材料的翘曲也做了专门的应对措施。”
另外,在容易与基板接触的部分,亚智科技也会做特殊的处理,在短时间内可以完成显影、剥膜及蚀刻的部分,使均匀性达到90%以上。
李裕正指出,板级封装非常重要的一点,就是让铜的电镀膜能够均匀成长在大基板上。“考虑到基板已经很重,亚智科技专门开发了无治具的模组,可以让基板直接密合到反应槽上,而不需要另外承载的治具,大幅缩减了系统的重量。”
李裕正强调:“在生产制造方面,亚智科技也有自己的专利,可以让垂直电镀在反应完成之后,快速地净空圈子,使电镀均匀性大于90%。此外,在细线路制作上面,我们也可以提供给客户一些特殊需求的设计制作。”
李裕正最后指出,“对RDL解决方案提供商最为重要的就是,给客户提供一个能够指导生产制造的规划,避免生产中的波动造成制程上的变异。”
编辑:fqj
 电子发烧友App
电子发烧友App












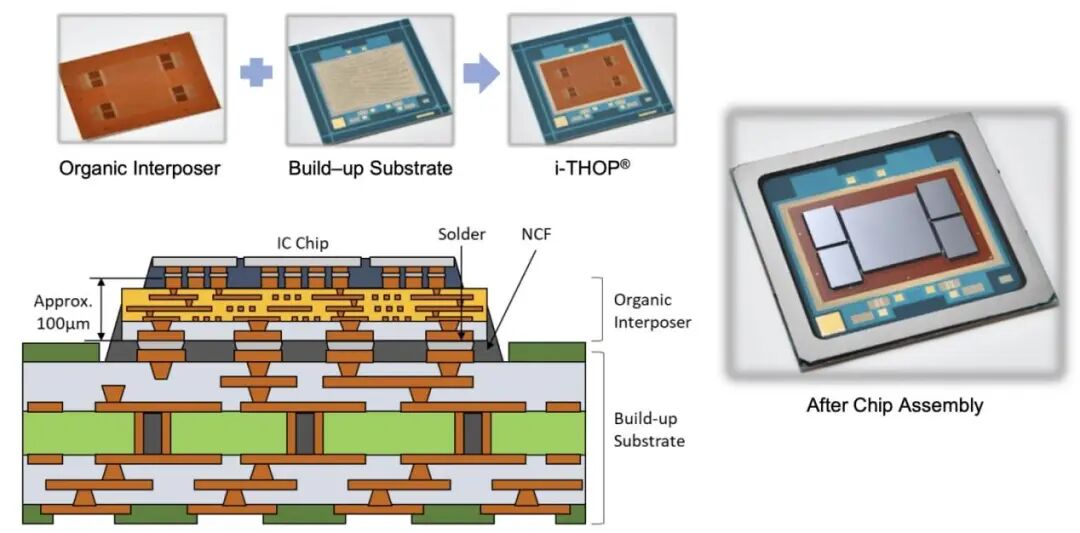



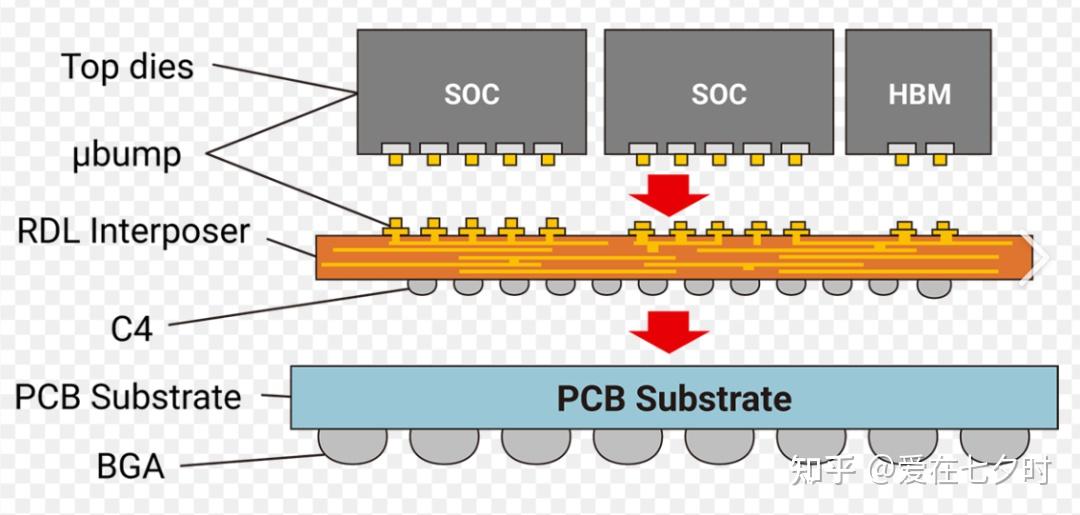













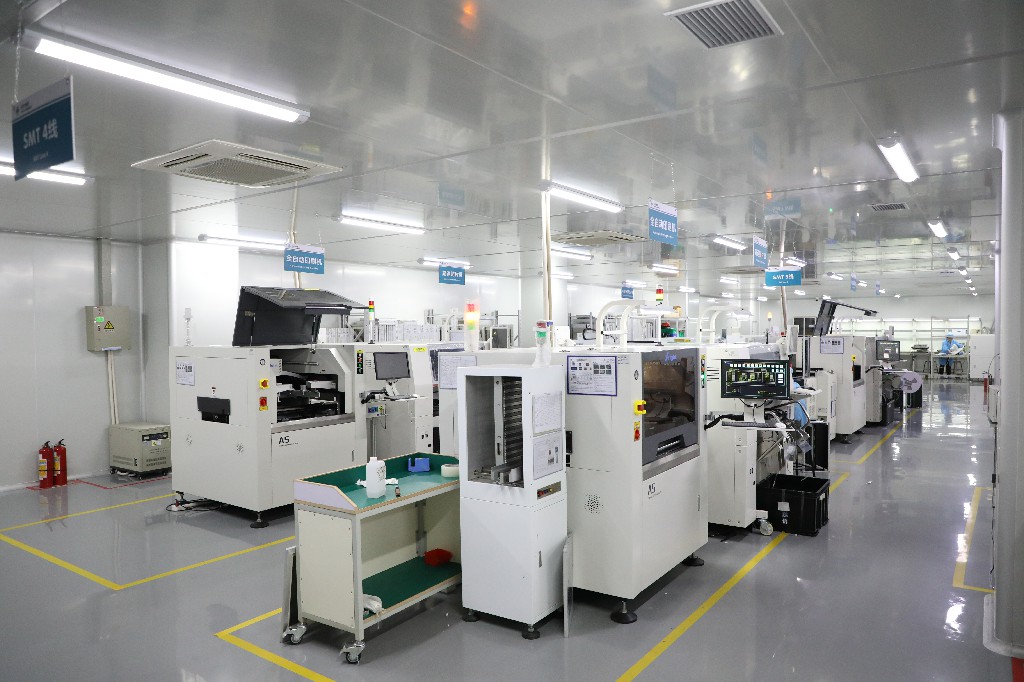

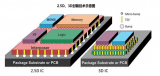

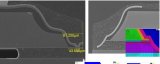





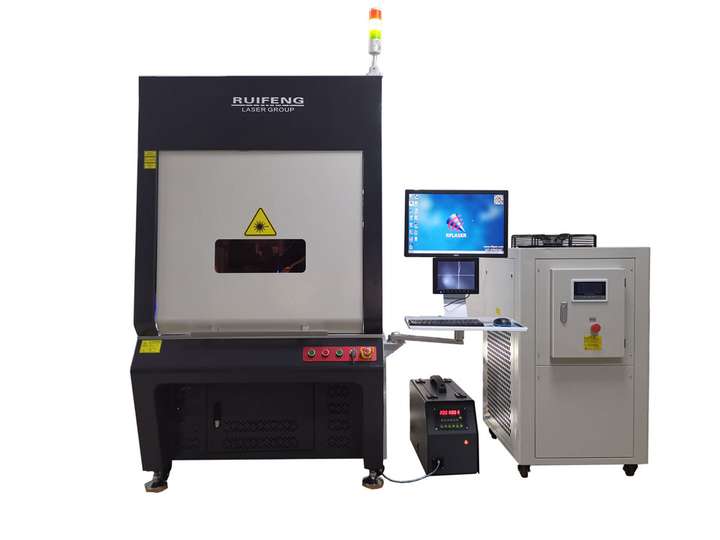




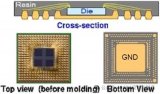










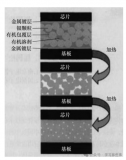





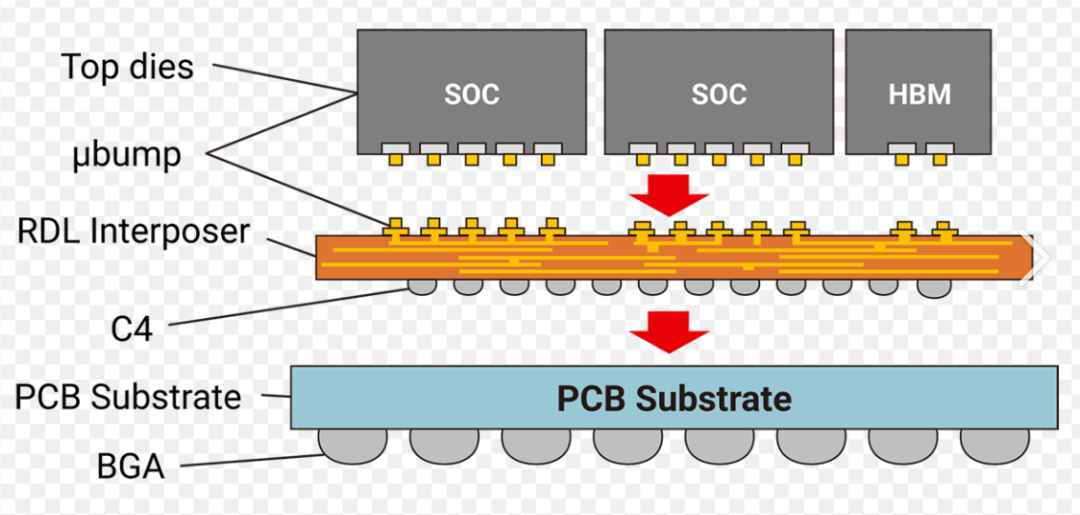
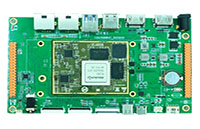


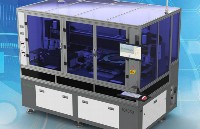







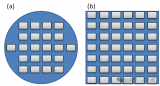

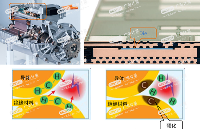
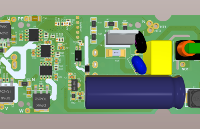




评论