汉思新材料(深圳市汉思新材料科技有限公司)于2023年公开了一项针对系统级封装(SiP)的专用封装胶及其制备方法的专利(申请号:202310155819.4),该技术旨在解决多芯片异构集成中的热膨胀系数失配、界面应力开裂及高温可靠性等核心问题。
以下从技术背景、配方设计、工艺创新、性能优势及产业化应用等角度综合分析:

一、专利背景与技术挑战
系统级封装需集成不同材质芯片(如逻辑芯片、存储器、射频模块等),传统固态环氧塑封料因高温高压工艺易损伤焊点,而液体封装胶则存在热膨胀系数(CTE)高、玻璃化转变温度(Tg)低、吸水率大等问题。例如,现有技术中环氧封装胶的CTE普遍>20 ppm/℃,吸水率>0.7%,导致湿热环境下分层失效风险高。汉思此专利通过材料组分创新与工艺优化,实现了低CTE(15 ppm/℃)、高Tg(180℃)和超低吸水率(0.32%)的协同突破。
二、核心配方组成
专利配方采用高比例无机填料+树脂基体优化设计,具体组分如下:
1.有机树脂(3wt%~10wt%)
可选双酚A/F型环氧树脂、脂环族环氧树脂(如3,4-环氧环己基甲酸酯)、氰酸酯树脂(如双酚A型氰酸酯)等,通过多树脂复配提升耐热性与界面附着力。
2.增韧剂(0.05wt%~5wt%)
有机硅杂化环氧树脂或环氧基低聚倍半硅氧烷,增强抗冲击性并降低内应力。
3.固化剂(3wt%~10wt%)
酸酐类(如甲基六氢苯酐、改性偏苯三酸酐),确保低温固化活性与高交联密度。
4.固化促进剂(0.05wt%~2wt%)
咪唑衍生物(如2-乙基-4-甲基咪唑)或双环脒类(如1,8-二氮杂二环十一碳-7-烯),精准调控固化速度。
5.无机填料(75wt%~90wt%)
球形氧化铝(粒径0.5–20μm)或二氧化硅(0.1–10μm),高填充量显著降低CTE并提升导热性;粒径梯度设计优化颗粒堆叠密度。
6.偶联剂(0.05wt%~2wt%)
环氧基硅烷(如3-缩水甘油醚氧丙基三甲氧基硅烷),强化填料-树脂界面结合。
三、制备工艺创新
专利采用分步混合+均质化研磨工艺,解决高填料比例下的分散难题:
1.树脂-填料预混:将有机树脂与部分无机填料(如片状SiO₂)初步混合,研磨至细度<15μm,形成高分散性基料。
2.梯度添加剩余组分:依次加入固化剂、增韧剂、球形填料及偶联剂,低速搅拌避免气泡生成。
3.三辊研磨脱泡:过三辊机研磨3遍,真空脱泡后过滤出料,确保粘度稳定在80 Pa·s以下,适配点胶工艺。
此工艺避免填料沉降,提升批次一致性,且单组份设计支持自动化产线快速点胶。
四、性能突破与应用价值
1.关键性能参数
低热膨胀系数:CTE降至15 ppm/℃(较传统产品降低50%),匹配硅芯片与陶瓷基板,抑制热应力翘曲。
高耐热性:Tg达180℃,适用于汽车电子(-40℃~150℃工作环境)。
环境稳定性:吸水率0.32%,盐雾测试>2000小时,失效率<0.02ppm。
力学性能:抗弯强度>120 MPa,冲击韧性提升3倍。
2.应用场景
高密度SiP模块:5G射频前端、AI加速卡(如Chiplet异构集成)。
车规级电子:ECU控制板、传感器(通过AEC-Q200认证)。
消费电子:屏下指纹模组(如HS700系列底部填充胶)、可穿戴设备微型封装。
五、产业化与市场前景
国产替代价值:突破美日企业(如Henkel、Namics)在高阶封装胶的技术垄断,已导入华为、三星供应链,替代进口产品。
环保兼容性:符合RoHS 2.0及Reach标准,VOC趋零排放,环保性能超行业均值50%。
产学研协同:与复旦大学合作开发3DIC封装适配材料,规划科创板上市加速产业化。
总结:
汉思此项专利通过高填料改性+分步工艺,攻克了SiP中多材质界面失效的行业痛点,其低CTE、高Tg、低吸水的特性为先进封装(如Chiplet、3DIC)提供了底层材料支撑。技术已应用于智能汽车、AI硬件等高端场景,推动国产封装胶从“依赖进口”向“全球输出”转型。进一步技术细节可查阅专利原文(CN202310155819.4)或汉思胶水官网案例。
-
SiP
+关注
关注
6文章
544浏览量
108100 -
材料
+关注
关注
3文章
1634浏览量
28721 -
芯片封装
+关注
关注
14文章
627浏览量
32446
发布评论请先 登录
汉思新材料:MiniLED金线包封胶及其制备方法专利解析

汉思新材料:电路板IC加固环氧胶选择与应用

汉思新材料:PCB器件点胶加固操作指南
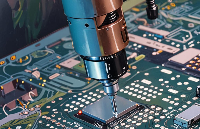



 汉思新材料取得一种系统级封装用封装胶及其制备方法的专利
汉思新材料取得一种系统级封装用封装胶及其制备方法的专利













评论