电子发烧友综合报道 面板级封装(Panel-Level Packaging,PLP)已经存在一段时间,但未被大规模应用。Yole Group近期预测,2024年,PLP市场总收入达到约1.6亿美元,全球产量接近8万片(约33万片等效300毫米晶圆)。到2030年,这一市场可能达到超过6.5亿美元,产量约为2.2万片。2024到2030年期间的复合年均增长率高达27%,未来市场空间巨大。
那么面板级封装PLP是什么?
与传统晶圆级封装(Wafer-Level Packaging, WLP)相比,其核心区别在于使用更大面积的面板作为基板(例如玻璃、硅或有机材料面板),而非传统的圆形晶圆。在面板上可集成多个芯片、无源元件及互连结构,显著提升封装效率。相较于晶圆级封装,PLP封装基板一般是正方形或矩形,其面积利用率更高,且单次处理芯片数量更多,尤其适合大规模生产。
在基板尺寸上,传统晶圆直径为8-12英寸,即200-300mm;而面板尺寸可达500mm×500mm甚至更大。更大的面积意味着允许在同一批次中封装更多芯片,提升单位产能。
从材料和成本的角度看,因为PLP采用的基板材料价格更低,且基板矩形避免了圆形晶圆的边缘浪费,利用率更高,在大规模生产中有显著的成本效益。
技术上,PLP封装也支持多芯片、异构集成,通过先进布线技术实现复杂互连。同时可以封装不同尺寸、工艺节点的芯片,尤其适合扇出型封装、2.5D/3D集成等先进技术。
既然有这么多好处,为什么PLP封装还未能广泛应用?
工艺上,PLP由于面板面积大,面板应力和温度均匀性控制难度较高,需要解决翘曲控制的难题。高密度互连需要微米级以下的线路和精准对位,依赖高精度对位、光刻及清洗设备,加上传统晶圆设备适应圆形的基板,需要改造设备以适应PLP基板尺寸。
而目前市场上针对这种新型格式的光刻、电镀和层压等关键工艺设备还未成熟,以及玻璃基板材料的热翘曲难以解决,产业链还需要从材料、设备方面入手。相比WLP,PLP前期投入巨大,还需要时间推进工艺的成熟,因此这也影响了PLP的推广。
目前PLP主要被应用在小封装应用,包括三星、日月光、矽磐微电子、意法半导体等将PLP应用在MCU、PMIC、RF等,另外三星将PLP用于可穿戴设备SoC上。
三星在2019年在Galaxy Watch芯片上首次用上PLP技术,在最新的芯片中,三星利用FOPLP结合PoP封装将CPU、PMIC、DRAM集成到一个封装中。
PLP需整合半导体、面板、PCB等多行业资源,但材料供应商、设备商和封测厂协同研发进展缓慢。例如,玻璃基板生产涉及三星、台积电等巨头,但其技术封闭性限制了生态扩展。
尽管挑战重重,PLP的规模化应用前景仍可期。通过材料创新,如抗翘曲的玻璃基板,以及工艺优化、设备低成本及标准化推进,PLP有望在2026年后随AI/HPC需求爆发实现突破。
PLP面板级封装,静待爆发
- 面板(54310)
相关推荐
On-Cell触控面板技术市场爆发难
On-Cell触摸显示屏市场并没有如面板厂的意愿爆发,终端客户开方案的多,量产的却并不多。On-Cell触摸显示屏在终端市场的不景气,让其价格也快速松动,反而沦为客户跟传统GFF 、OGS触摸屏的砍价陪衬。
2014-05-21 09:22:03 2176
2176
 2176
2176解析静噪元件的直流重叠特性
在电子设备中,为防止噪声使用静噪滤波器,选择要使用的静噪滤波器时,必须注意滤波器不仅要适当地除去噪声,同时还不能引起信号质量的降低,导致设备误操作。在此介绍关于使用静噪对策时应该注意的滤波器的性能,以及改善这些性能的静噪滤波器。
2016-07-04 15:03:14 1945
1945
 1945
1945晶圆级封装的基本流程
介绍了晶圆级封装的基本流程。本篇文章将侧重介绍不同晶圆级封装方法所涉及的各项工艺。晶圆级封装可分为扇入型晶圆级芯片封装(Fan-In WLCSP)、扇出型晶圆级芯片封装(Fan-Out WLCSP
2023-11-08 09:20:19 10257
10257
 10257
10257
HRP晶圆级先进封装替代传统封装技术研究(HRP晶圆级先进封装芯片)
随着晶圆级封装技术的不断提升,众多芯片设计及封测公司开始思考并尝试采用晶圆级封装技术替代传统封装。其中HRP(Heat Re-distribution Packaging)晶圆级先进封装
2023-11-30 09:23:24 2501
2501
 2501
2501
AR崛起:光学方案“神仙打架”,内容端静待游戏厂商
的崛起”。产业链上下游玩家能更加直接地感受到AR设备带来的机会,持续投入并静待花开。 光学显示方案的升级,成为
2024-03-31 13:26:35 3872
3872
 3872
3872
台积电开始探索面板级封装,但三星更早?
方案,据传台积电也开始探索更激进的封装方案,比如面板级封装FO-PLP。 面板级封装FO-PLP,AI芯片加倍产能的捷径? 在先进封装市场占比10%的扇出封装中,主要技术路线分为FOPLP(扇出面板级封装)和FOWLP(扇出晶圆级封装)两种。相较FOWLP,FOPLP可采
2024-06-28 00:19:00 4264
4264
 4264
4264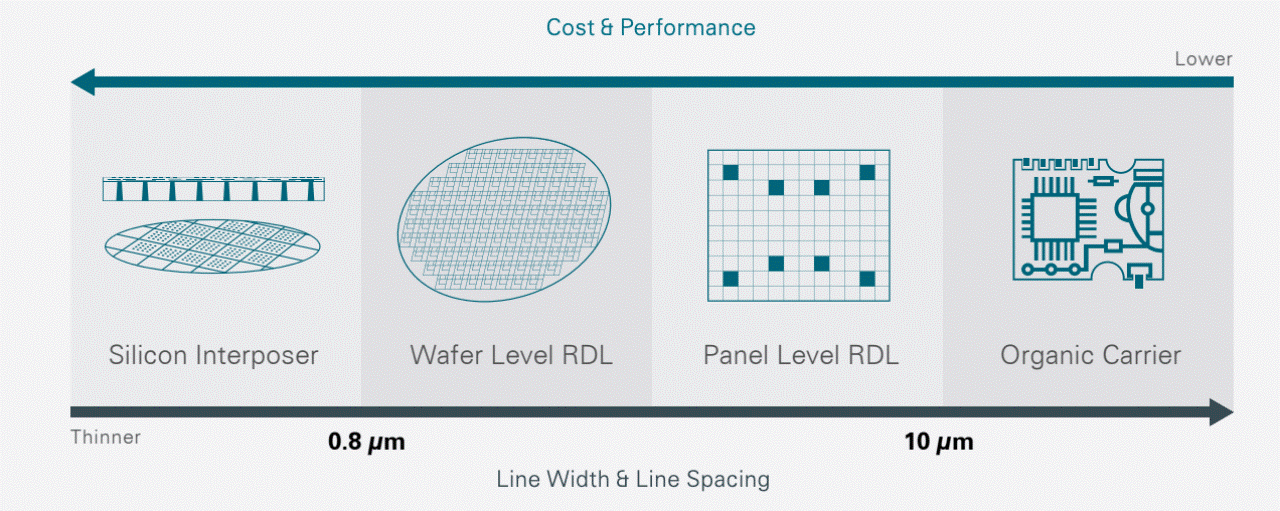
PLP-10
PLP-10 - HIGH-REPETITION PICOSECOND LIGHT PULSER Model PLP-10 - Hamamatsu Corporation
2022-11-04 17:22:44
PLP10-044C
PLP10-044C - HIGH-REPETITION PICOSECOND LIGHT PULSER Model PLP-10 - Hamamatsu Corporation
2022-11-04 17:22:44
PLP10-067
PLP10-067 - HIGH-REPETITION PICOSECOND LIGHT PULSER Model PLP-10 - Hamamatsu Corporation
2022-11-04 17:22:44
PLP10-078C
PLP10-078C - HIGH-REPETITION PICOSECOND LIGHT PULSER Model PLP-10 - Hamamatsu Corporation
2022-11-04 17:22:44
PLP10-085C
PLP10-085C - HIGH-REPETITION PICOSECOND LIGHT PULSER Model PLP-10 - Hamamatsu Corporation
2022-11-04 17:22:44
PLP10-130
PLP10-130 - HIGH-REPETITION PICOSECOND LIGHT PULSER Model PLP-10 - Hamamatsu Corporation
2022-11-04 17:22:44
PLP10-130C
PLP10-130C - HIGH-REPETITION PICOSECOND LIGHT PULSER Model PLP-10 - Hamamatsu Corporation
2022-11-04 17:22:44
PLP1001A
PLP1001A - THSHIBA PHOTOINTERRUPTER INFRARED LEDPHOTO IC - Toshiba Semiconductor
2022-11-04 17:22:44
封装级微调与其它失调校正法的比较
作者:Art Kay德州仪器
封装级微调是一种半导体制造方法,可实现高度精确的放大器及其它线性电路。放大器精确度的主要测量指标是其输入失调电压。输入失调电压是以微伏为单位的放大器输入端误差电压。该
2018-09-18 07:56:15
静磁栅位移传感器在电梯控制系统中的应用
”用内藏嵌入式微处理器系统的特制高强度铝合金管材封装,使用开关型霍尔传感器件组成霍尔编码阵列,铝合金管材外部使用防氧化镀塑处理。“静磁栅源”沿“静磁栅尺”轴线作无接触(相对间隙宽容度和相对姿态宽容度达
2011-08-01 11:28:22
EMI静噪滤波器有什么用途?
利用村田制作所的陶瓷工艺技术和独创材料,可以提供各种静噪产品和EMI静噪滤波器。村田制作所基于在静噪领域的多年经验,同时提供技术支持和指南。我公司的技术支持包括设计辅助工具、应用手册和一整套软件工具,以便虚拟仿真任何电路条件。
2019-10-21 09:02:13
Endicott Interconnect投放系统级封装设计
由Endicott Interconnect(EI)科技提供的系统级封装(SiP)设计缩小了尺寸、减轻了重量,并将一块印刷线路板(PWB)上的多重封装整合至一个系统级封装内,以提高电力性能,从而
2018-08-27 15:24:28
MEMS器件的封装级设计
了所有物料和组装成本的20%~40%。由于生产因素的影响,使得封装之后的测试成本比器件级的测试成本更高,这就使MEMS产品的封装选择和设计更加重要。MEMS器件设计团队在开始每项设计前,以及贯穿在整个
2010-12-29 15:44:12
什么是晶圆级封装?
`晶圆级封装(WLP)就是在其上已经有某些电路微结构(好比古董)的晶片(好比座垫)与另一块经腐蚀带有空腔的晶片(好比玻璃罩)用化学键结合在一起。在这些电路微结构体的上面就形成了一个带有密闭空腔的保护
2011-12-01 13:58:36
倒装芯片和晶片级封装技术及其应用
发展趋势的推动下,制造商开发出更小的封装类型。最小的封装当然是芯片本身,图1描述了IC从晶片到单个芯片的实现过程,图2为一个实际的晶片级封装(CSP)。 晶片级封装的概念起源于1990年,在1998年
2018-08-27 15:45:31
定制开关柜静触头
`铜铝导电连接件供应商,可根据客户要求定向开发、个性定制;采用不等长下料技术生产软连接厂家,可根据客户要求提供设计方案,10余年焊接经验客户广泛赞誉。静触头连接结构及具有该结构的开关柜。其中静触头
2019-03-11 16:08:11
晶圆级封装的方法是什么?
晶圆级封装技术源自于倒装芯片。晶圆级封装的开发主要是由集成器件制造厂家(IBM)率先启动。1964年,美国IBM公司在其M360计算器中最先采用了FCOB焊料凸点倒装芯片器件。
2020-03-06 09:02:23
测试爆发点的仪器-智能发火点化验仪
` 测试爆发点的仪器-智能发火点化验仪,测试爆发点的仪器-智能发火点化验仪由【鹤壁爆发点检测仪】提供的爆发点分析仪,检测仪:186.3920.3323爆发点检测仪,微机爆发点检测仪器,微机爆发
2020-12-17 16:33:19
镀银静触头和动触头
`用家用插座来比喻:插座是静触头,插头是动触头。在高压开关中,装在手车上的将开关接入系统的两臂即是动触头,固定不动的和静锄头配合使用的就是静触头。触头金属表面日久或表面产生积垢,从而造成接触。时,应先拆开观察,若银触头,可不用处理,因为银不影响其导电率;`
2019-03-12 10:21:05
PLP-2.5+插入式50Ω低通滤波器
微型电路PLP-2.5+插入式50Ω低通滤波器PLP-2.5+插入式50Ω低通滤波器 特点坚固、密封焊接的外壳50Ω阻抗0.5W最大射频功率输入DC至2.5MHz范围-55°C至+100
2024-03-02 10:38:45
晶圆级封装产业(WLP),晶圆级封装产业(WLP)是什么意思
晶圆级封装产业(WLP),晶圆级封装产业(WLP)是什么意思
一、晶圆级封装(Wafer Level Packaging)简介 晶圆级封装(WLP,Wafer Level Package) 的一般定
2010-03-04 11:35:01 45963
45963
 45963
45963什么是静液压传动_静液压传动与动液压传动有什么区别
本文介绍了什么是静液式传动、其次介绍了 静液式传动分类的分类以及静液式传动的优缺点,最后介绍了静液压传动动作迟缓的原因及改进措施和静液压传动与动液压传动它们两者之间的区别。
2018-01-04 14:33:36 47835
47835
 47835
47835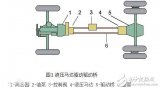
液晶销量下降,小尺寸OLED面板呈爆发式增长
OLED面板在小尺寸以及大尺寸领域不断突破。目前,三星在小尺寸OLED面板占据绝对优势,控制了95%的市场。传未来LG可能为苹果提供小尺寸OLED面板。由此来看,韩系厂商在小尺寸OLED面板市场的绝对霸主仍然难以撼动。
2018-07-13 18:00:00 489
489
 489
489板级封装产业技术及市场趋势报告
OSAT一直在推动半导体产业开发创新解决方案,一种方案便是通过从晶圆和条带级向更大尺寸的面板级转换,充分利用规模经济和效率的优势。而且板级制造可以利用晶圆级封装(WLP)和PCB 平板显示 光伏产业的专业知识和基础设施。
2018-06-11 09:59:00 7868
7868
 7868
7868
Manz亚智科技推出面板级扇出型封装
作为世界领先的湿制程生产设备商之一,Manz亚智科技宣布推出面板级扇出型封装(FOPLP;Fan-out Panel Level Packaging)湿制程解决方案,透过独家的专利技术,克服翘曲
2018-09-01 08:56:16 5719
5719
 5719
5719力成全球首座面板级封装制程量产基地预计2020年上半年完工 总投资达新台币500亿元
存储器封测厂力成今(25)日举行竹科三厂动土典礼,规划作为全球首座面板级扇出型封装(FOPLP)制程的量产基地,总投资金额达新台币500亿元,预计2020年上半年完工、同年下半年装机量产,将可创造约3000个优质工作机会。
2018-09-26 15:44:00 3002
3002
 3002
3002三星扇出型面板级封装FOPLP战略性技术选择
面板级封装(PLP)就是一种从晶圆和条带级向更大尺寸面板级转换的方案。由于其潜在的成本效益和更高的制造效率,吸引了市场的广泛关注。由于面板的大尺寸和更高的载具使用率(95%),它还带来了远高于晶圆级尺寸扇出型晶圆级封装(FOWLP)的规模经济效益,并且能够实现大型封装的批量生产。
2018-12-30 10:24:00 11378
11378
 11378
11378三星电子将收购三星电机半导体封装PLP事业 或重新争取苹果代工订单
期望能重新抢下苹果 A 系列处理器订单,韩国媒体表示,三星电子将收购子公司三星电机的半导体封装 PLP 事业,发展半导体封装业务。而且,根据相关知情人士指出,双方已经完成收购 PLP 业务的协议,将在 30 日的理事会进行讨论,并在月底或下个月初公布。
2019-04-23 16:24:42 4088
4088
 4088
4088Manz 亚智科技面板级湿法工艺导入集成电路封装工艺量产线 助力产业“共融˙共荣”
携30年以上印刷电路板及面板湿法工艺设备制造经验,为集成电路封装市场提供面板级工艺专业设备.
2019-04-30 16:54:16 2523
2523
 2523
2523威刚发布新款定位工业级领域的SSD 可在各种恶劣环境下正常工作且功耗只有2.3W
威刚今天发布了一款定位工业级领域的SSD ISSS333 PLP,特别支持掉电保护,而且相当的皮实、长寿。
2020-02-21 14:55:49 2315
2315
 2315
2315Dialog汽车级PMIC产品组合
Dialog深刻理解汽车客户对延长产品生命周期的要求,并推出了Product Longevity Program(PLP)以提供产品供应保证。Dialog的汽车级产品亦包含在PLP计划中,确保产品推出后至少保持供应15年。
2020-04-27 10:03:37 4130
4130
 4130
4130京东方面板产能即将迎来爆发
显示面板是科技领域的重要战略物资,这是显而易见的事实,几乎所有带有视觉反馈的设备,都需要显示面板的硬性支撑,所以更加高级的显示面板生产线,就当下科技世代的“兵家必争之地”。
2020-06-11 15:53:33 899
899
 899
899明年即将爆发Mini LED背光源搭配LCD面板的显示应用热潮
建立在微缩LED芯片的次世代显示技术中,Micro LED依然卡在制程良率跟成本的难关,但以MiniLED作为背光源搭配LCD面板的显示应用,则已经正式迈入商转阶段,预期相关应用将在明年爆发。
2020-08-07 11:36:49 1342
1342
 1342
1342消息称恩智浦将导入面板级封装
面板级扇出封装(FOPLP)以往颇有叫好不叫座疑虑,不过供应链传出,车用电子芯片龙头之一的恩智浦(NXP),因应未来5~10年车用芯片的发展与生产,传出酝酿考虑部分车用周边IC的后段封测,拟采用面板级封装。
2021-01-20 12:11:10 2001
2001
 2001
2001多家面板企业迎来业绩爆发
随着面板企业纷纷交出2020年成绩单,多家面板企业迎来业绩爆发。机构表示,在行业供不应求局面持续下,一季度面板价格上涨趋势仍将继续强化,行业景气度将继续上行。2月2日,同花顺显示器件板块微跌0.13%,个股涨多跌少。
2021-02-03 14:50:17 1909
1909
 1909
1909集微连线:板级封装潜力无穷 RDL工艺勇挑大梁
、AIoT和HPC应用不断崛起,给了这项技术更大的发展空间。而作为实现扇出型板级封装的核心技术,RDL(Redistribution Layer,重布线层)更是为实现芯片的异构集成奠定了坚实的基础。 为了更好理清RDL在面板级封装中的重要性,RDL技术的发展状况和怎样的的解决
2021-11-02 14:10:00 2719
2719
 2719
2719
什么是晶圆级封装
在传统晶圆封装中,是将成品晶圆切割成单个芯片,然后再进行黏合封装。不同于传统封装工艺,晶圆级封装是在芯片还在晶圆上的时候就对芯片进行封装,保护层可以黏接在晶圆的顶部或底部,然后连接电路,再将晶圆切成单个芯片。
2022-04-06 15:24:19 11122
11122
 11122
11122国产射频前端静待春天 主要射频厂商营收对比
中国射频前端产业在2022年经历了需求不振、上市破发、专利纷扰等诸多困境,从烈火烹油到寒气阵阵,2023年的他们或许还需静待市场春天的到来。
2023-01-30 09:27:03 2021
2021
 2021
2021华封科技助力“玻璃面板级封装”新领域
据Digitimes报道,群创光电总裁James Yang介绍,该公司将改造一家3.5G LCD面板工厂,以容纳一条IC封装生产线,生产将于2023年下半年开始。 从产品市场前景来看,玻璃Panel
2023-03-03 11:15:02 854
854
 854
854异构集成推动面板制程设备(驱动器)的改变
FO-PLP) l需求趋同使得面板级制程系统的研发成本得以共享 l 晶体管微缩成本的不断提升,促使行业寻找创新方法,更新迭代提升芯片和系统的性能。正因此,异构集成已成为封装技术最新的转折点。 异构集成将单独制造的部件集成一个更高级别的组合,该组合总体上具有更强的功能
2023-04-11 17:46:27 623
623
 623
623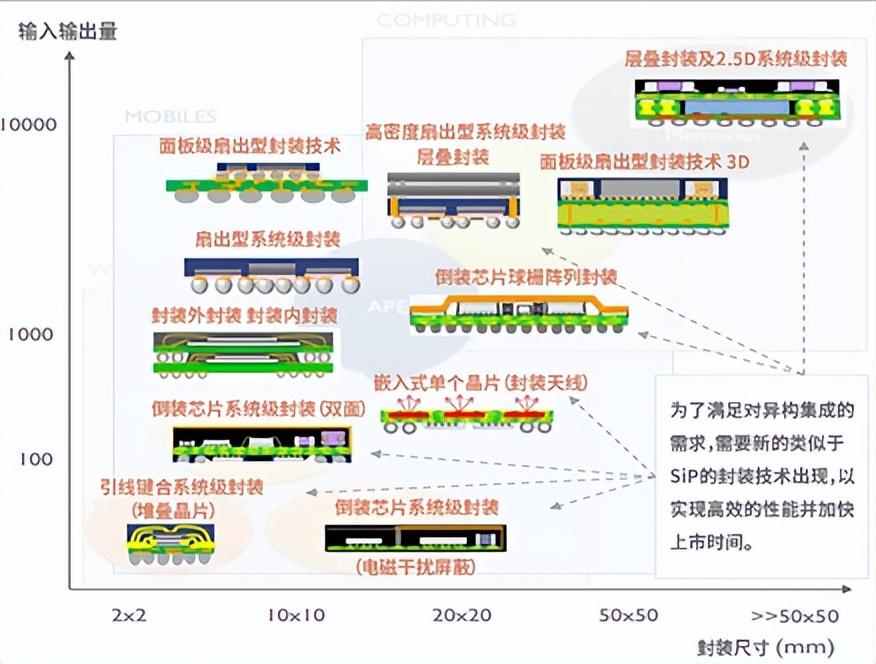
先进封装之面板芯片级封装(PLCSP)简介
今天我们来介绍PLCSP(Panel Level Chip Scale Packaging)。同理,PLCSP是一种将面板级封装(PLP)和芯片尺寸封装(CSP)合为一体的封装技术。芯片尺寸封装(CSP)是指整个package的面积相比于silicon总面积不超过120%的封装技术。
2023-06-19 11:31:46 1814
1814
 1814
1814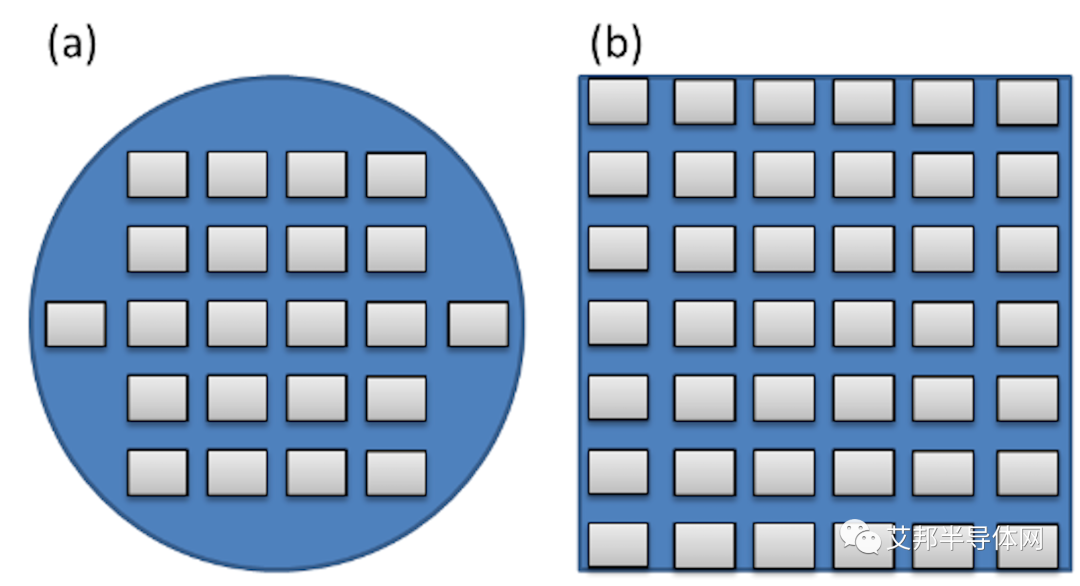
打破传统技术,普莱信发布面板级封装巨量转移设备P-XBonder
随着摩尔定律的逐步失效,芯片行业的发展更多的将目光放到先进封装,在众多先进封装技术中,晶圆级封装和面板级封装是两大主流技术路线,迄今为止,面板级封装由于工艺成熟度较低,设备、材料等供应较为短缺,导致
2023-08-22 09:33:30 662
662
 662
662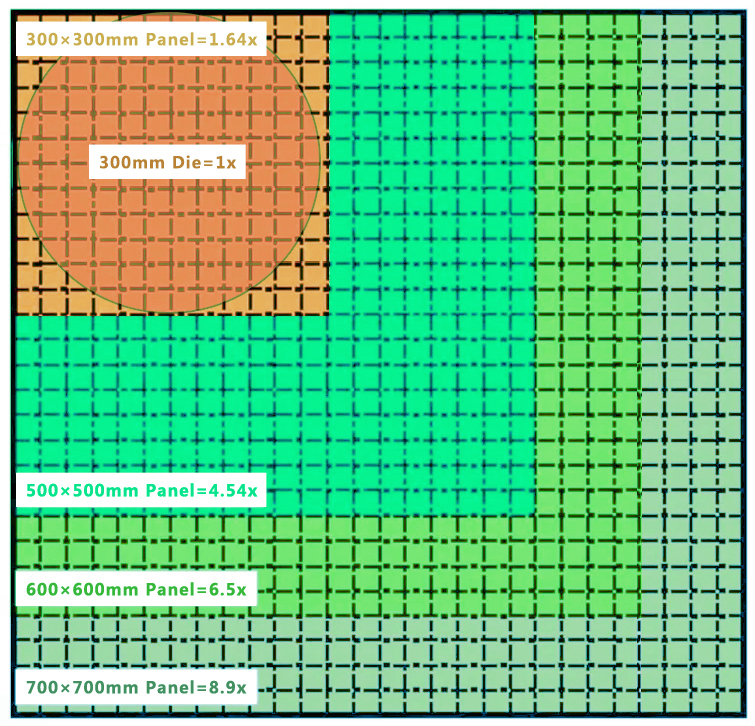
晶圆级芯片封装技术上市公司有哪些 晶圆级封装与普通封装区别在哪
晶圆级封装是在整个晶圆(wafer)的级别上进行封装,而普通封装是在单个芯片级别上进行封装。晶圆级封装通常在晶圆制造完成后,将多个芯片同时封装在同一个晶圆上,形成多个封装单元。相比之下,普通封装将单个芯片分别封装在独立的封装器件上。
2023-08-30 16:44:57 4456
4456
 4456
4456群创等面板厂转型,涉足半导体封装技术
睿生光电与半导体测试系统制造商z智诚实业合作,展示了axi系统的应用程序和x-ray数字平面显示器系列。该公司使用的pact检测设备使用了特殊光学引擎,用于面板级封装(plp)检测和化合物硅电石第三代检测。
2023-09-07 14:31:40 1022
1022
 1022
1022群创3.5 代线转为面板级封装,明年底量产
电视面板价格自今年2月起,已连续多月上涨,市场普遍认为面板价格涨幅将在9月告一段落,外界好奇面板价格第四季是否有跌价压力;对此,杨柱祥表示,只要刚性需求持续存在,产业秩序经过沉淀之后,大家会做出对产业发展有利的决策。
2023-09-18 15:59:28 909
909
 909
909倒装芯片和芯片级封装的由来
在更小、更轻、更薄的消费产品趋势的推动下,越来越小的封装类型已经开发出来。事实上,封装已经成为在新设计中使用或放弃设备的关键决定因素。本文首先定义了“倒装芯片”和“芯片级封装”这两个术语,并阐述了晶
2023-10-16 15:02:47 1191
1191
 1191
1191消息称群创拿下恩智浦面板级扇出型封装大单
据最新消息,全球显示领导厂商群创光电近日成功拿下欧洲半导体大厂恩智浦的面板级扇出型封装(FOPLP)大单。恩智浦几乎包下了群创所有相关的产能,并计划在今年下半年开始量产出货。
2024-01-30 10:44:56 985
985
 985
985一文看懂晶圆级封装
共读好书 在本文中,我们将重点介绍半导体封装的另一种主要方法——晶圆级封装(WLP)。本文将探讨晶圆级封装的五项基本工艺,包括:光刻(Photolithography)工艺、溅射
2024-03-05 08:42:13 2003
2003
 2003
2003
英伟达AI芯片2026年将应用面板级扇出型封装,推动市场供应
业内人士普遍认为,英伟达的倡导将为台湾封测行业带来更多订单机会。同时,英特尔、AMD等半导体巨头也纷纷涉足面板级扇出型封装,预计将使AI芯片供应更为流畅,推动AI技术的多元化发展。
2024-04-15 09:48:51 1215
1215
 1215
1215消息称英伟达计划将GB200提早导入面板级扇出型封装
为解决CoWoS先进封装产能紧张的问题,英伟达正计划将其GB200产品提前导入扇出面板级封装(FOPLP)技术,原计划2026年的部署现提前至2025年。
2024-05-22 11:40:32 1597
1597
 1597
1597新一代封装技术,即将崛起了
扇出型面板级封装(Fan-out Panel Level Package,简称FOPLP)是近年来在半导体封装领域兴起的一种先进技术。它结合了扇出型封装和面板级封装的优点,为高性能、高集成度的半导体芯片提供了一种高效且成本较低的封装解决方案。
2024-05-28 09:47:55 2364
2364
 2364
2364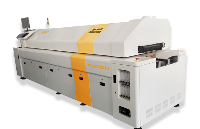
台积电研发芯片封装新技术:从晶圆级到面板级的革新
在半导体制造领域,台积电一直是技术革新的引领者。近日,有知情人士透露,这家全球知名的芯片制造商正在积极探索一种全新的芯片封装技术,即从传统的晶圆级封装转向面板级封装,这将可能带来封装效率的显著提升和成本的降低。
2024-06-22 14:31:54 1663
1663
 1663
1663三星电子领先台积电进军面板级封装
在全球半导体封装行业中,三星电子已经取得了令人瞩目的重大进展,特别是在面板级封装(PLP)领域,其技术实力已领先业界巨头台积电。这一领先地位的取得,离不开三星电子在2019年的一项重要战略决策——以
2024-06-26 10:19:50 964
964
 964
964日月光FOPLP扇出型面板级封装将于2025年二季度小规模出货
(Fan-Out Panel-Level Packaging,扇出型面板级封装)技术,预计将于2025年第二季度正式开启小规模出货阶段,标志着日月光在先进封装领域的又一重大突破。
2024-07-27 14:40:32 1213
1213
 1213
1213盛美上海推出Ultra C vac-p面板级先进封装负压清洗设备
盛美半导体设备(上海)股份有限公司,作为半导体工艺解决方案领域的佼佼者,近日宣布了一项重大技术突破——成功推出Ultra C vac-p面板级先进封装负压清洗设备。这款设备的问世,不仅彰显了盛美上海
2024-08-01 17:11:40 767
767
 767
767盛美上海推出新型面板级电镀设备
盛美半导体设备(上海)股份有限公司,业界知名的半导体前道及先进晶圆级封装工艺解决方案提供商,近日成功推出了针对扇出型面板级封装(FOPLP)领域的创新力作——Ultra ECP app面板级电镀设备
2024-08-09 10:40:23 657
657
 657
657Manz亚智科技RDL设备切入五家大厂
近日,设备制造业的佼佼者Manz亚智科技宣布了在人工智能芯片与半导体先进封装领域的重大突破。该公司已成功将近10条先进的重布线层(RDL)生产线交付至全球五大顶尖大厂,这些生产线专为面板级封装(PLP)技术量身打造,标志着Manz亚智科技在封装技术前沿的领先地位。
2024-08-28 15:40:28 624
624
 624
624整合为王,先进封装「面板化」!台积电、日月光、群创抢攻FOPLP,如何重塑封装新格局?
2024 年 Semicon Taiwan 国际半导体展完美落幕,先进封装成为突破摩尔定律的关键,尤其以面板级扇出型封装(FOPLP)成为备受关注的下一代技术,同时也是封测厂、面板厂极力布局的方向。
2024-09-21 11:01:17 730
730
 730
730
群创面板级扇出封装助力AI高效能运算
群创光电近日分享了其对面板产业的见解与未来规划。总经理杨柱祥透露,尽管未来两年内公司没有新增的电视面板产能计划,但产品平均尺寸的增长将加速去产能化进程。他强调,旧世代产线的逐步淘汰将有助于维持面板市场供需的紧张平衡状态。
2024-09-30 16:23:14 1127
1127
 1127
1127盘古多芯片高密度板级扇出项目喜封金顶 年产板级封装产品8.64万板
,华天科技FOPLP产品处于通线打样阶段,已完成第一批dummy样品及电信测试,目前处于小批量样品制作中。其PLP平台进展特点如下: 通过AI算法优化封装流程,显著提高了研发效率和产品良率; 允许在更大的面板上进行芯片布局,利用率及生产效率大大提升; 基于RDL工艺
2024-10-28 13:48:49 512
512
 512
512
封装工艺简介及元器件级封装设备有哪些
本文介绍了封装工艺简介及元器件级封装设备有哪些。 概述 电子产品制造流程涵盖半导体元件制造及整机系统集成,以晶圆切割成芯片为分界,大致分为前期工序与后期工序,如图所示。后期工序主要包含芯片封装
2025-01-17 10:43:06 648
648
 648
648
日月光斥资2亿美元投建面板级扇出型封装量产线
日月光集团营运长吴田玉宣布,集团历经十年研发,决定正式迈向面板级扇出型封装(FOPLP)量产阶段。为此,集团将斥资2亿美元(约新台币64亿元),在高雄设立专门的量产线。
2025-02-18 15:21:02 376
376
 376
376签约顶级封装厂,普莱信巨量转移技术掀起晶圆级封装和板级封装的技术革命
经过半年的测试,普莱信智能和某顶级封装厂就其巨量转移式板级封装设备(FOPLP)设备XBonder Pro达成战略合作协议,这将是巨量转移技术在IC封装领域第一次规模化的应用,将掀起晶圆级封装和板级
2025-03-04 11:28:05 456
456
 456
456
 电子发烧友App
电子发烧友App













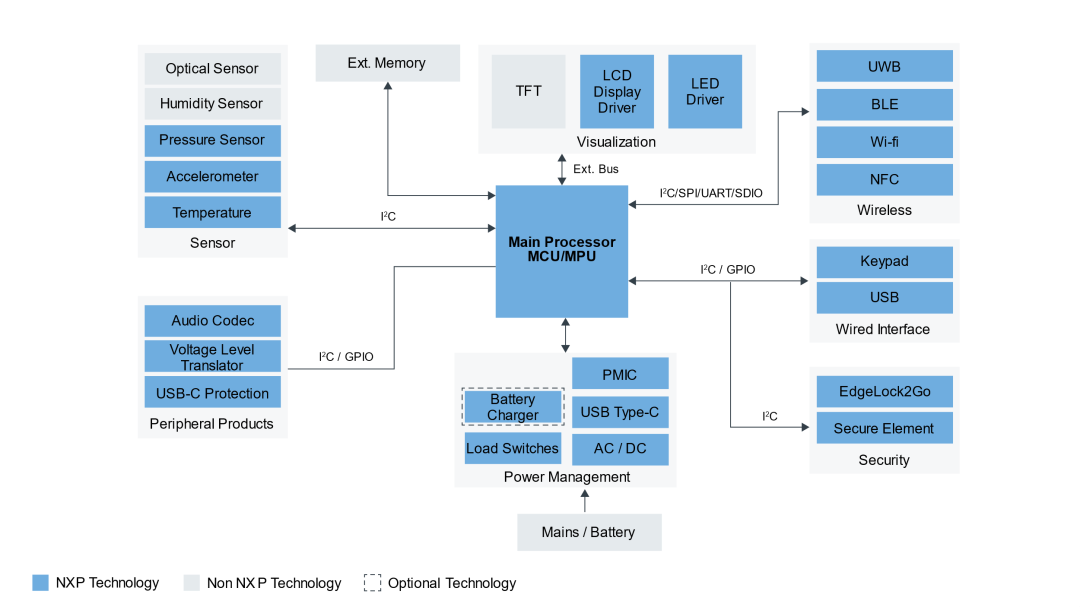











评论