文章来源:学习那些事
原文作者:小陈婆婆
本文介绍了功率半导体晶圆级封装的发展。
在功率半导体封装领域,晶圆级芯片规模封装技术正引领着分立功率器件向更高集成度、更低损耗及更优热性能方向演进。
本文分述如下:
晶圆级MOSFET封装革命
晶圆级封装发展趋势
1. 晶圆级MOSFET封装革命
相较于传统分立功率封装,晶圆级MOSFET通过封装形态的革新实现了体积占比的根本性转变——从早期DPAK封装中约75%的环氧模塑化合物(EMC)占比,逐步演进至WLCSP中EMC完全消失、硅及互连金属占比超80%的极致紧凑结构。这一转变不仅体现在体积指标上,更深刻影响了器件的电气性能与可靠性设计。
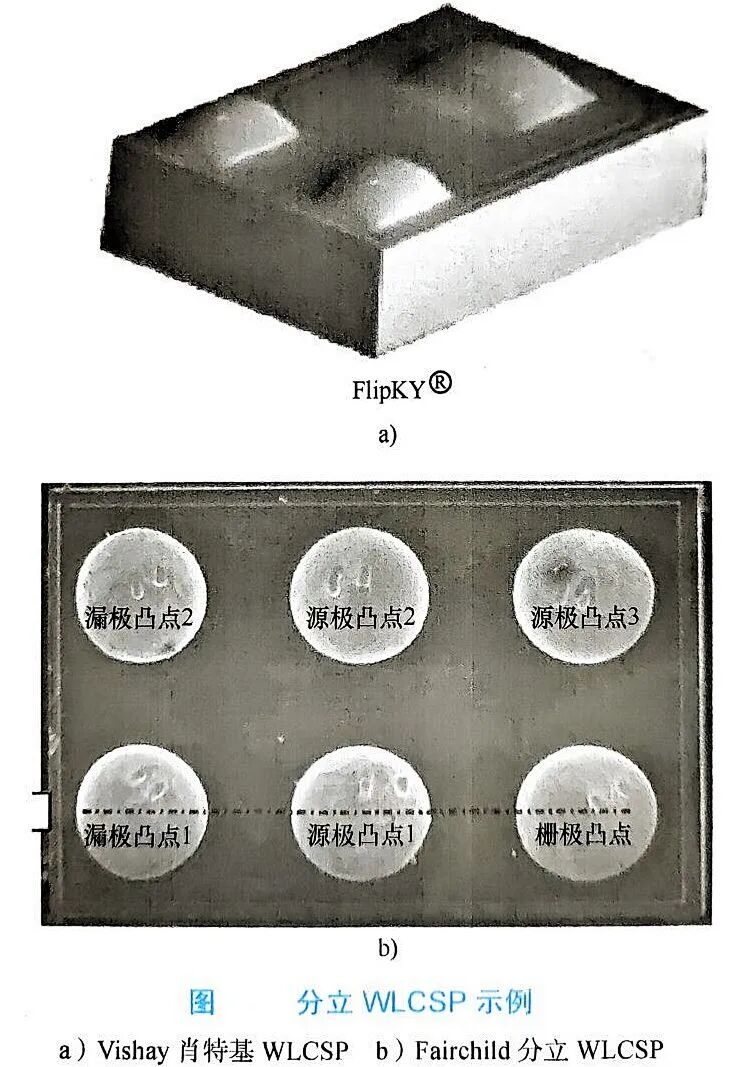
例如,Vishay与Fairchild推出的晶圆级肖特基二极管及垂直MOSFET产品,通过扇入型布局实现了芯片级封装,而EMC在扇出型封装中则转型为重布线层(RDL)基底材料,通过晶圆级环氧树脂成型技术构建出具备更大间距的收缩芯片封装结构,既保留了EMC对器件机械鲁棒性的增强作用,又适配了多样化取放设备的安装需求。
面对高电流能力需求与芯片收缩趋势的双重挑战,晶圆级功率封装的载流能力提升策略呈现出多维度创新特征。在热管理层面,行业形成了PCB级强化散热与封装级多方向散热的协同路径。以金属框架集成工艺为例,Fairchild的MOSFET BGA与Vishay的PolarPAK通过预刻蚀腔金属晶圆与芯片的键合,实现了热扩散路径的立体化重构,有效提升了器件在复杂热环境下的稳定性。这种设计思路在最新研究中进一步延伸至复合金属基板与纳米导热材料的融合应用,通过微通道散热结构的精准构建,将热阻降低至传统方案的30%以下。
在电气性能优化方面,垂直金属氧化物晶圆级MOSFET通过超薄硅基板(如7μm级)与厚铜漏极(50μm级)的工艺组合,实现了Rds(on)电阻的显著降低与热性能的同步提升。
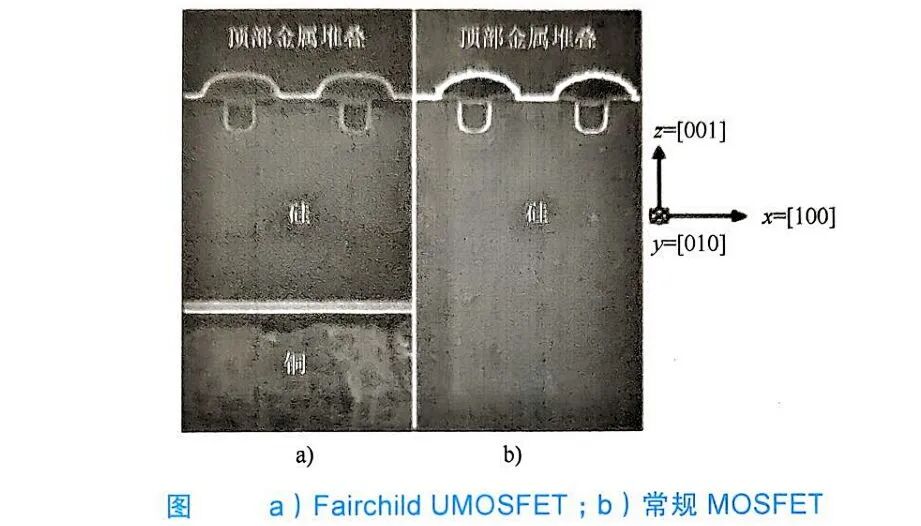
Fairchild的晶圆级UMOSFET结构便是典型代表,其通过硅基板减薄与铜镀层工艺的协同,在保证机械强度的同时,将漏极电阻压缩至传统结构的1/5。值得关注的是,行业正探索漏极位置重构的新路径——将漏极、源极、栅极集成于芯片同侧的横向布局,虽在高压应用中存在局限,但在低功率场景下展现出表面安装兼容性与电气性能的双重优势。
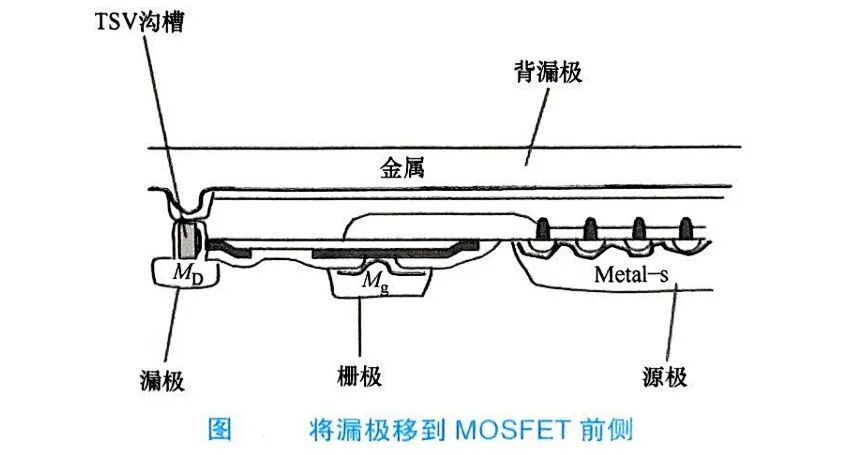
对于VDMOS WLCSP,沟槽区域TSV直连技术的突破,实现了背漏极至前侧的直接电气连接,在保持低Rds(on)特性的同时,进一步简化了封装工艺流程。
当前,该领域的前沿探索正聚焦于三维集成技术与新型材料的深度融合。例如,基于硅通孔(TSV)的3D WLCSP结构已实现多芯片垂直互连,在功率模块中展现出更高的功率密度与热管理效率;而碳纳米管、石墨烯等新型导热材料的引入,则为封装级散热设计提供了更优的解决方案。
2. 晶圆级封装发展趋势
功率IC封装的发展趋势
在功率IC封装领域,5~100V电压范围的解决方案正通过单片集成技术实现电感负载范围的拓展与功能集成度的跃升,典型如晶圆级片上电源系统将高压侧/低压侧电源开关与IC驱动器集成,配合无传感器定位、自适应运动控制等数字功能,形成高集成度的电源转换架构。对于100~700V高压场景,下一代LDMOS结构已突破硅基几何极限,通过优化掺杂分布与场板设计提升击穿电压,推动AC-DC单片功率变换能力升级,同时多晶粒集成极限持续突破,支撑高功率密度模块开发。
随着芯片尺寸向亚毫米级收缩,封装占用面积虽呈下降趋势,但热管理挑战愈发凸显——WLCSP与PCB级散热器的机械兼容性问题导致板级封装可靠性降低,传统空气冷却已难以满足高功率密度需求。

当前前沿探索聚焦于晶圆级微通道冷却技术,通过在芯片有源侧/背面构建微米级流道,配合高导热流体实现高效热扩散,可完全替代散热器并消除风扇噪声,该方案在数据中心电源模块中已实现热阻降低40%的实测效果。
晶圆级无源器件的发展趋势
晶圆级无源器件的发展正突破低功率限制,通过新型材料与工艺创新向中高功率延伸。例如,采用氮化铝基板的晶圆级电感器在MHz级高频下可承载数安培电流,其自谐振频率可达100MHz以上,远超传统封装级电感器性能;而集成电阻器与电容器的BCDMOS工艺已实现寄生参数压缩至传统方案的1/3,在降压转换器中显著降低开关损耗。
晶圆级堆叠/3D功率芯片SiP
三维集成与堆叠技术成为功率SiP的核心演进方向。晶圆对晶圆键合配合TSV互连可实现双晶圆堆叠,如将MOSFET与驱动IC垂直集成于无源晶圆上方,通过TSV连接公共源极/漏极,使高边/低边芯片间距缩短至50μm以内,寄生电阻降低60%以上。

该结构在LCD背光逆变器中已验证,半桥拓扑的开关延迟压缩至2ns以下。当前研究正探索混合键合与硅通孔微凸点技术,以实现更高密度的3D堆叠,同时解决热应力匹配问题。
综上,功率晶圆级封装正沿着高集成度、高频化、三维化的路径演进。扇入型WLCSP仍是主流,但扇出型技术通过RDL重布线与EMC成型工艺逐步成熟,在汽车功率模块中已实现批量应用。VDMOSFET漏极前移技术持续普及,配合TSV直连与复合金属基板,推动全表面贴装兼容性提升。未来,随着碳化硅、氮化镓等宽禁带材料与晶圆级封装的深度融合,以及AI驱动的热管理算法优化,功率器件将向更高功率密度、更低损耗的智能集成方向加速突破,在新能源汽车、智能电网等领域发挥关键作用。
-
MOSFET
+关注
关注
151文章
10873浏览量
235302 -
封装
+关注
关注
128文章
9365浏览量
149149 -
功率半导体
+关注
关注
23文章
1581浏览量
45302
原文标题:功率晶圆级芯片尺寸封装开发
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
MEMS的发展趋势怎么样?
5G创新,半导体在未来的发展趋势将会如何?
陆芯半导体精密晶圆切割机领域发展趋势及方向




 功率半导体晶圆级封装的发展趋势
功率半导体晶圆级封装的发展趋势








评论