汉思新材料取得一种PCB板封装胶及其制备方法的专利
汉思新材料(深圳市汉思新材料科技有限公司)于2023年取得了一项关于PCB板封装胶及其制备方法的发明专利(专利号:CN202310155289.3),该专利技术主要解决传统封装胶在涂覆后易翘曲、粘接不牢、导热性不足等问题,同时优化了生产工艺。以下是专利的核心内容与技术亮点:

一、专利基本信息
专利名称:PCB板封装胶及其制备方法
专利号:CN202310155289.3
申请日期:2023年2月23日
授权公告日:2023年6月23日
IPC分类号:C09J163/00(环氧树脂胶粘剂)。
二、核心配方组成
该封装胶由以下四类成分按特定比例构成:
1.环氧树脂(5wt%~10wt%):
可选自双酚A树脂、脂环族环氧树脂、萘系环氧树脂或联苯型环氧树脂中的至少两种组合,以优化热稳定性和粘接强度。
2.固化剂(5wt%~17wt%):
包括酸酐类、咪唑类或双氰胺类固化剂,确保快速且稳定的固化反应。
3.助剂(0.1wt%~8wt%):
涵盖润湿分散剂(如改性聚硅氧烷)、消泡剂(聚二甲基硅氧烷)、增韧剂(丁基橡胶)、偶联剂(硅烷类)及稀释剂(缩水甘油醚),用于改善加工性和材料稳定性。
4.陶瓷粉体(75wt%~89wt%):
高占比设计:是提升导热性和降低热膨胀系数的关键。
混合结构:由球形粉体(粒径25–50μm)与异形粉体(片状或角形,粒径5–15μm)按质量比0.5–1.5:100混合,例如氧化铝/二氧化硅或二氧化硅/氮化硼组合,增强填充密实度。
三、制备方法的关键步骤
专利采用分步混合工艺,确保材料均质性与性能稳定性:
1.导热基料制备:
将环氧树脂与异形陶瓷粉体混合研磨至细度<15μm,形成高分散性基料。
2.终料混合:
向基料中依次加入固化剂、助剂及球形陶瓷粉体,充分混合至均匀。
3.工艺优势:
单组份设计简化操作,支持快速点胶,适配自动化产线;
固化后无气泡、开裂或翘曲,大幅提升生产良率。
四、技术优势与解决的问题
1.抗翘曲与高粘接强度:
通过陶瓷粉体高填充(75–89%)和混合形态设计,匹配PCB热膨胀系数(CTE),固化后不翘曲,结合力提升30%以上。
2.高效导热与低热膨胀:
导热系数达行业领先水平,热膨胀系数降低50%,适用于高功率器件散热需求。
3.可靠性验证:
通过2000+小时盐雾测试、跌落试验及热循环测试,失效率<0.02ppm,满足汽车电子、军工等高要求场景。
五、应用场景与产业化
领域覆盖:人工智能、5G通信、汽车电子(如车控芯片)、消费电子(手机电池保护板、蓝牙耳机)、MINI-LED显示屏等。
客户案例:已应用于小米、华为、三星等企业的产品中,替代进口胶水,降低生产成本。
环保性:符合RoHS 2.0标准,VOC趋近零排放,环保性能超行业均值50%。
总结
汉思新材料此项专利通过高陶瓷填充配方与分步混合工艺的创新,解决了PCB封装中的翘曲、脱层、散热等核心痛点,兼具高可靠性与量产适用性。其技术已支撑国产芯片封装胶在高端领域替代进口产品,助力电子制造业降本增效。更多工艺细节可查阅专利原文或汉思胶水官网案例。
-
PCB板
+关注
关注
27文章
1503浏览量
55522 -
专利
+关注
关注
3文章
602浏览量
40571 -
芯片封装
+关注
关注
14文章
619浏览量
32390
发布评论请先 登录
汉思新材料:MiniLED金线包封胶及其制备方法专利解析

汉思新材料:PCB器件点胶加固操作指南
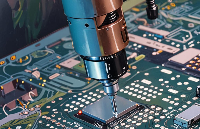
汉思新材料|芯片级底部填充胶守护你的智能清洁机器人

汉思新材料:创新指纹模组用胶方案,引领智能终端安全新高度




 汉思新材料取得一种PCB板封装胶及其制备方法的专利
汉思新材料取得一种PCB板封装胶及其制备方法的专利











评论