经过半年的测试,普莱信智能和某顶级封装厂就其巨量转移式板级封装设备(FOPLP)设备XBonder Pro达成战略合作协议,这将是巨量转移技术在IC封装领域第一次规模化的应用,将掀起晶圆级封装和板级封装领域的一次技术革命。普莱信同时在和某全球最领先的封装厂,某全球领先的功率器件公司就XBonder Pro在晶圆级封装的应用开展合作。
芯片的转移是晶圆级封装和板级封装的核心工序,由于高端的板级封装和晶圆级封装需要在贴片完成后,进行RDL等工艺,所以对贴片精度要求极高,一般精度要求不低于±7微米,甚至要达到±3微米,而传统的高精度贴固晶机(贴片机),速度较低,各个设备厂家只能通过增加邦头和吸嘴的数量来提升单机的UPH,这就导致机器复杂,成本高昂,吸嘴的不稳定导致稼动率和良率极低,而且随着IC设计的发展,芯片集成度越来越高,小芯片的数量越来越多,导致传统吸嘴式的贴片设备难以支持产业的发展。下图展示了普莱信巨量转移设备相对传统设备的巨大优势。

普莱信的巨量转移技术采用了完全不同于传统固晶设备的工艺,从而将整个固晶效率提升了十倍,将固晶,或者装片的成本也降低了数倍。刺晶式固晶机是如何做到速度的数量级提升的呢。在传统的IC封装工艺中,固晶,或者叫装片,贴片,是整个生产工艺的关键环节,传统的固晶机,装片机,无一列外采用的都是Pick & Place的工艺。
1.通过顶针,将芯片从下向上在蓝膜上顶起;
2.吸嘴过来,通过视觉定位后,将芯片吸取;
3.吸住芯片后,移动到目标位置,通过多次视觉定位后,将芯片贴合到目标位置。
这种Pick&Place工艺非常成熟,市场上的各种固晶机,从贴装精度三微米以下的高精度固晶机到贴装精度几十微米的LED固晶机,无一列外都是这种工艺模式,Pick & Place模式下,对精度要求越高,每小时产出(UPH)就会越低,比如贴装精度3微米的高精度固晶机,UPH只有几百个每小时。
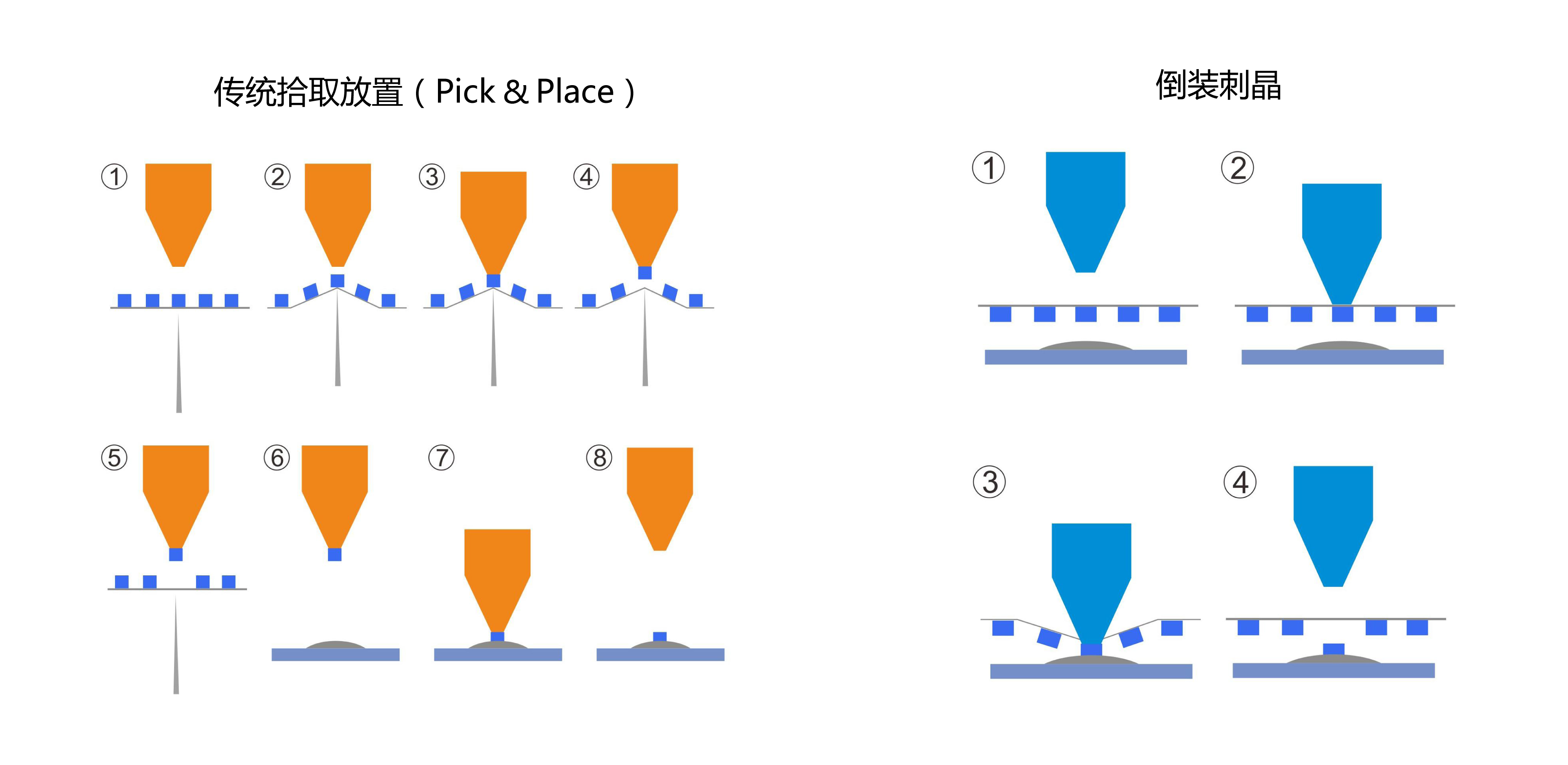
刺晶式巨量转移设备,采用了更简化的工艺,将芯片翻转,基板置于其下,针,晶圆同时移动相对基板进行定位,用针刺的方式把芯片刺到基板,这样大幅度减少了动作,提高了效率,普莱信的刺晶式固晶机,在MiniLED领域,其UPH可以超过300K。普莱信在其MiniLED巨量转移设备的基础上,结合板级封装和晶圆级封装的要求,设计了专为高精度IC封装的XBonder Pro系列产品,高精度下UPH可以达到30K左右,因为没有吸嘴的损耗或者多吸嘴的不一致问题,刺晶的稼动率远高于传统的高精度多头设备。真正帮FOPLP和晶圆级封装降低生产成本,让其做到贴片成本可以低于传统封装。
同时,相对传统的封装设备,刺晶效率高,耗电耗气大幅度降低,极大的降低了设备投入成本和运营成本,相信巨量转移式设备在IC封装领域的成熟,将会引起IC封装行业的一次新技术变革。
3月26-28日,SEMICON China展会期间,普莱信(展位号:N1-1285)将携巨量转移式板级封装设备XBonder Pro、TCB热压键合机Loong(国产唯一HBM/CoWoS键合设备)、高速夹焊系统Clip Bonder、多功能超高精度机DA403等亮相。
审核编辑 黄宇
-
封装
+关注
关注
128文章
9398浏览量
149260 -
晶圆级
+关注
关注
0文章
39浏览量
10223
发布评论请先 登录
华为自研DoB封装技术破局,122TB企业级SSD正式亮相
基于板级封装的异构集成详解

什么是晶圆级扇入封装技术




 签约顶级封装厂,普莱信巨量转移技术掀起晶圆级封装和板级封装的技术革命
签约顶级封装厂,普莱信巨量转移技术掀起晶圆级封装和板级封装的技术革命










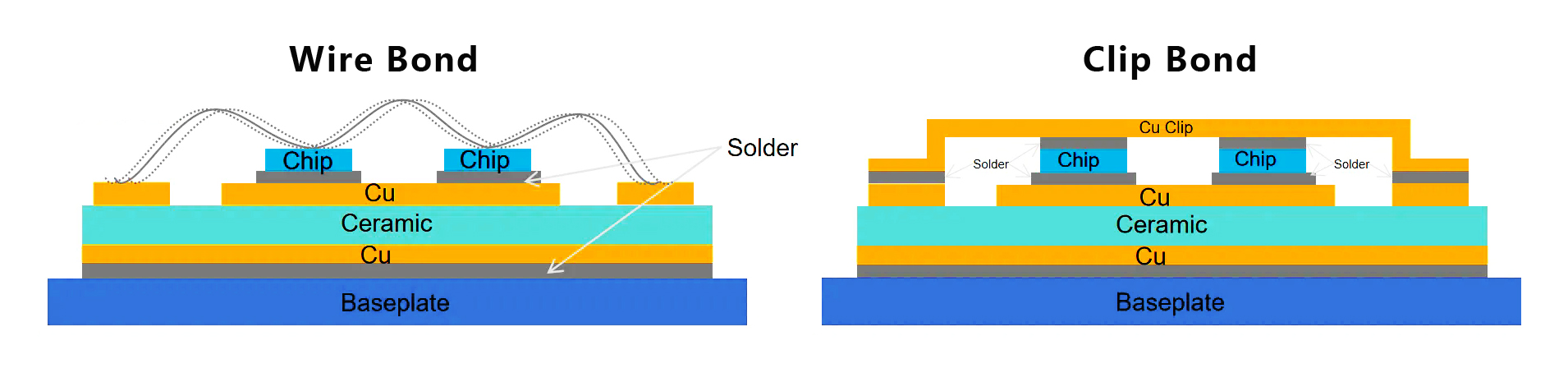




评论