引言
我们介绍了在氢氧化钾溶液中蚀刻的车轮图案和宽分离的V形槽的硅蚀刻速率测量。数据表明,当使用货车轮图案时,存在反应物耗尽效应,这掩盖了真实的表面反应速率限制的蚀刻速率。与以前的报道相反,从受反应物传输影响较小的宽间隔V形槽获得的蚀刻速率表明{ 111}蚀刻的活化能小于{ 100}蚀刻的活化能。我们的实验得到{ 111}面的激活能为0.53 eV,而{ 100}面的激活能为0.62 eV。表观活化能对{ 111}的微小角度偏差高度敏感。
介绍
氢氧化钾和其它溶液中硅的各向异性腐蚀已广泛用于我们的实验室和其它地方,以制造用于光电子器件的V形槽,包括硅晶片板、OLED 1×N光纤分路器、1×N光开关和2×2光折射板开关。了解{ 111}面和{ 111}面附近的各向异性腐蚀行为对于V形槽腐蚀的精细设计和精确控制是必要的。 (111}硅平面的蚀刻速率远低于{ 111 }硅平面的蚀刻速率其他晶面是各向异性蚀刻的基本性质。正是由于这种行为,深V形槽可以用精确定义的。顶角。尽管这一事实很重要,但晶体蚀刻速率各向异性的基本机制仍有争议。
在这项工作中,除了用车轮掩模获得的蚀刻速率之外,我们还研究了广泛分离的V形槽蚀刻速率。我们发现,紧密间隔的V形槽始终以比宽间隔的V形槽更低的速率蚀刻,这意味着反应速率受到反应物和/或产物种类扩散的影响。为了获得真实的反应速率限制的蚀刻速率的精确估计,这些扩散效应必须被最小化。此外,我们发现由晶片平面的轻微错位引起的误差也必须考虑在内。进行这些修正后,我们的结果表明{ 111}硅腐蚀的活化能小于{ 100}硅腐蚀的活化能。本文描述了我们的实验,并讨论了我们的结果和以前估计的{ 111}腐蚀速率激活能之间的差异。
讨论
图1显示了在同一晶圆上测得的两组横向欠蚀刻数据。该实验清楚地表明,宽间隔V形槽的{ 111}蚀刻速率大于紧密间隔的车轮图案的蚀刻速率。这个结果可以解释如下。在化学蚀刻过程中,反应物质在表面不断被消耗。结果,建立了从反应表面到溶液主体的浓度梯度;这种浓度梯度是通过扩散将反应物种推向表面的力。蚀刻的整体动力学将由反应和扩散两个过程中较慢的一个来决定。有一个通用的标准来区分水化学过程的动力学:表观活性
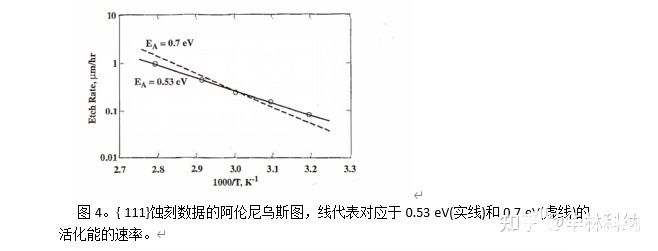

对于扩散限制过程,其能量约为0.13-0.26eV,而对于反应限制过程,其能量约为0.43-0.86eV。我们在实验中发现的{111}蚀刻的活化能为0.53eV,在表面反应限制过程的范围内。在使用马车轮模式或紧密间隔的v型凹槽的实验中,附近模式的存在导致了对可用反应物物种的竞争。这种竞争导致反应物的局部耗尽,驱动反应的速度比大间隔的模式更慢。
所有观察到的蚀刻轮廓,其中蚀刻图案中心的蚀刻深度比边缘更浅。这种效应可以用靠近掩模边缘和蚀刻图案中心的反应物的扩散限制传输之间的差异来解释。还报道了“一些损耗效应是可观察到的”的氢氧化钾蚀刻。
由于我们的样品都有广泛间隔的v型凹槽和紧密间隔的瓦轮模式,我们可以将观察到的蚀刻行为与两种掩模模式进行比较。由于马车轮图案的角增量较粗糙,我们不能从紧密间隔的图案中引用{111}蚀刻的活化能的定量值。然而,对于{111}和{100}蚀刻的相对活化能,我们可以做出一个强有力的定性陈述。图5显示了在两次蚀刻温度下进行蚀刻后的马车-车轮模式。虚线圈表示平面的横向切割程度;这些圆的半径成正比。
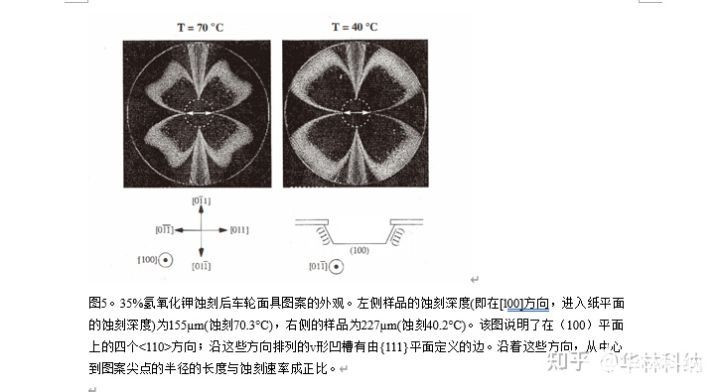
结论
通过比较从马车轮和分离的v槽模式测量的反应速率,我们得出结论,由于反应物运输的影响减少,从分离的v槽模式测量的{111}平面附近的反应速率提供了更准确的估计,即表面反应速率有限的活化能。我们在35%的氢氧化钾中进行了各向异性硅蚀刻实验,结果是{100}平面的活化能为0.62eV,{111}平面的活化能为0.53eV。车轮模式的定性结果显示,{111}上的活化能高于{100}上,与以前报道的结果一致。
 电子发烧友App
电子发烧友App










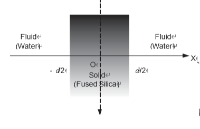



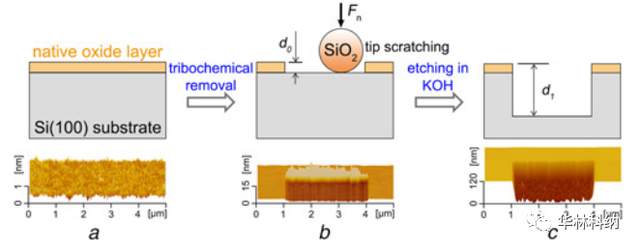
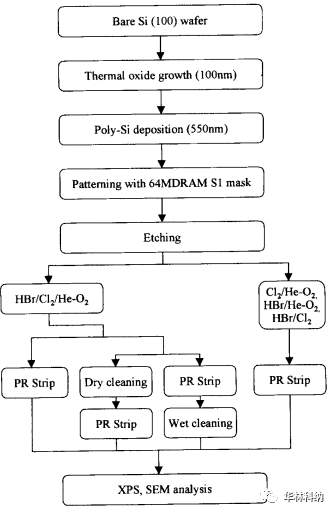

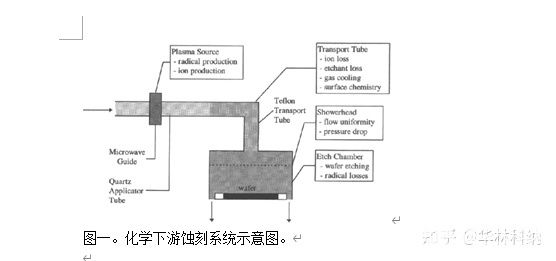

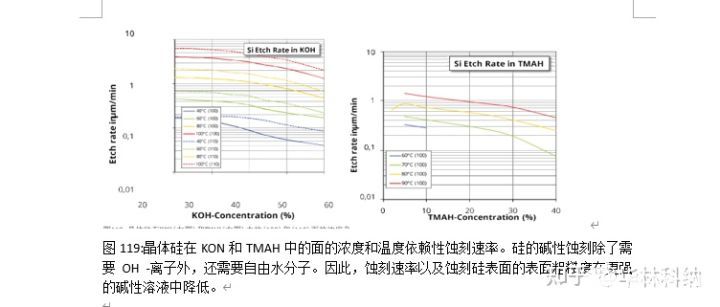


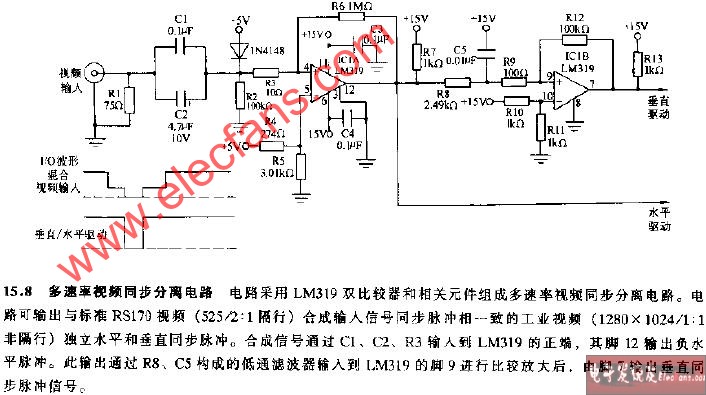
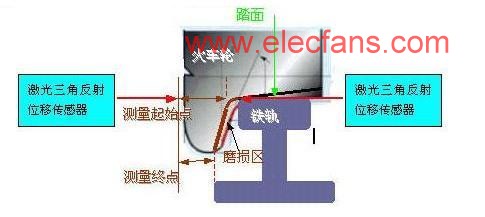


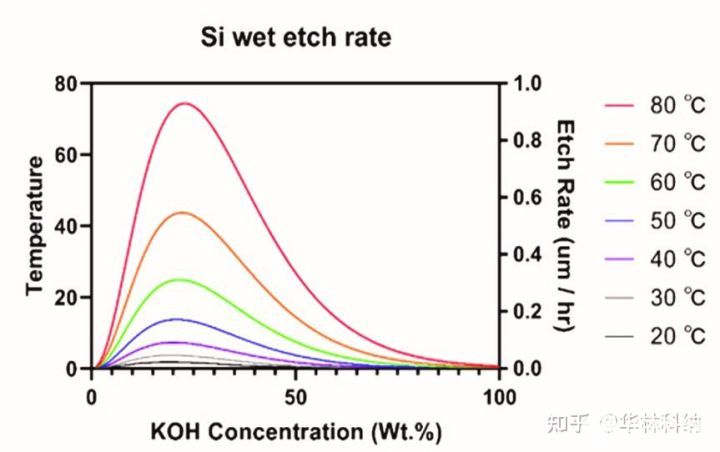
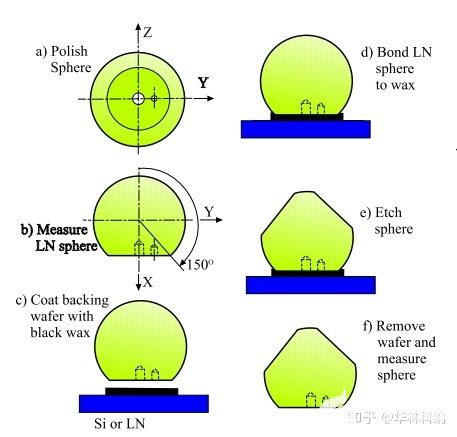
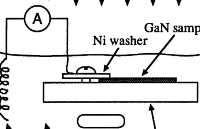

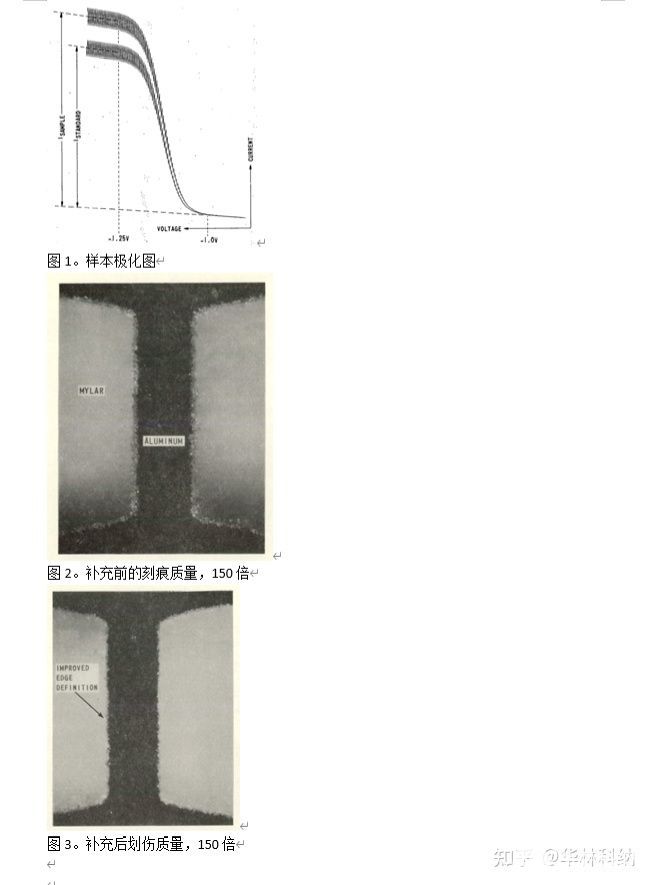

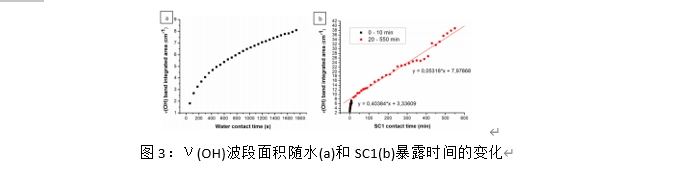
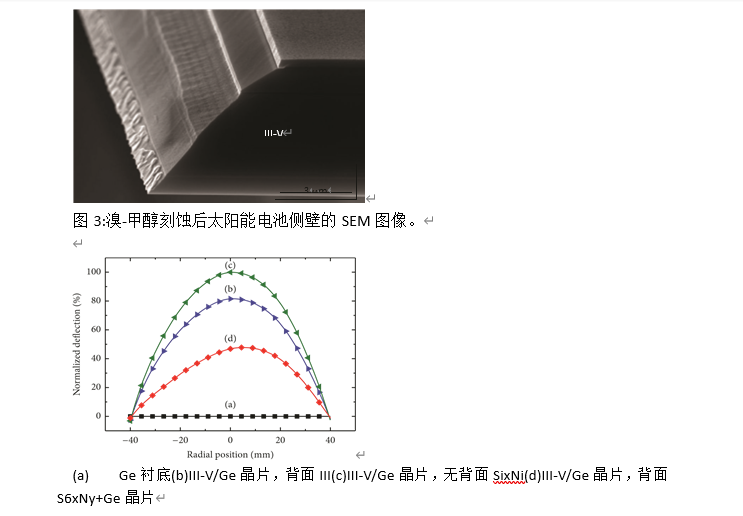






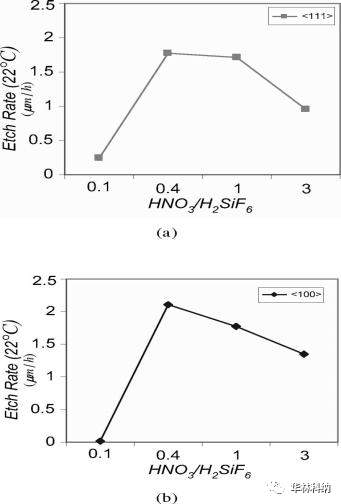
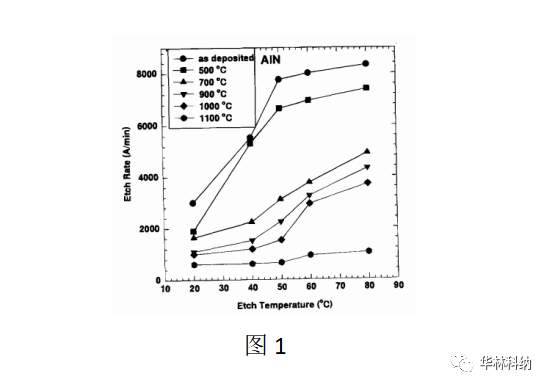
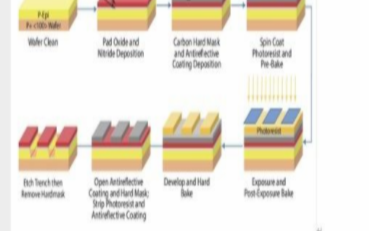
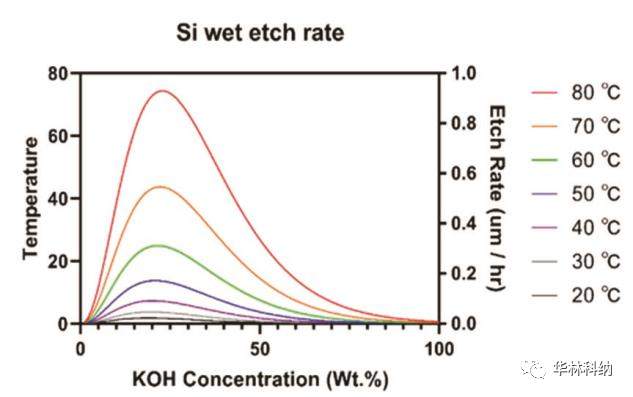

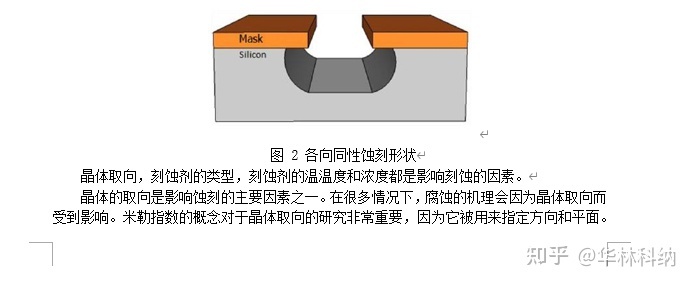

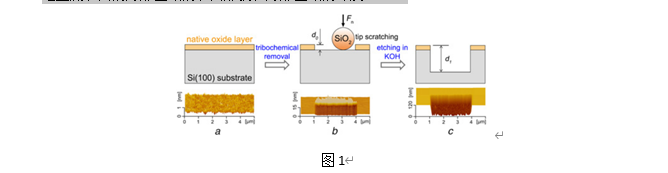

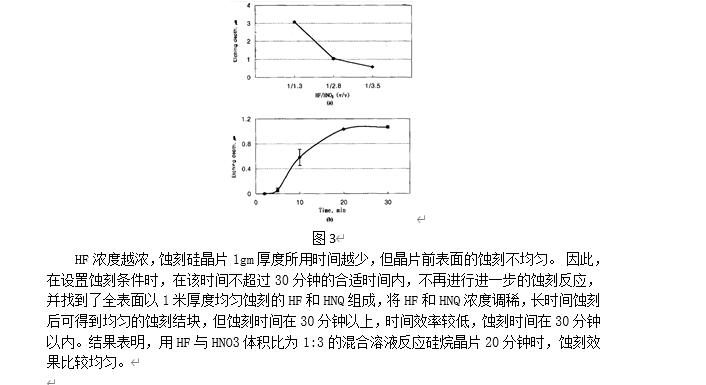
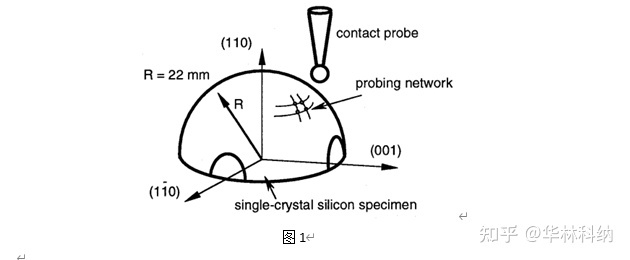

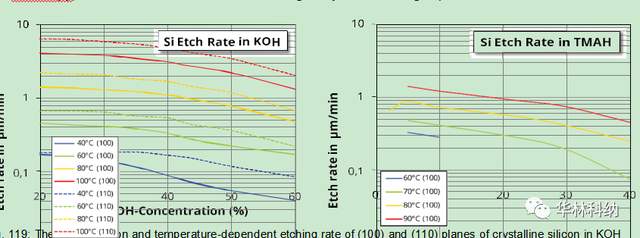
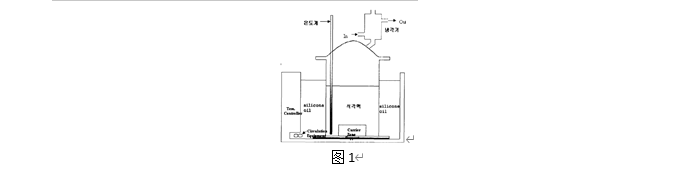


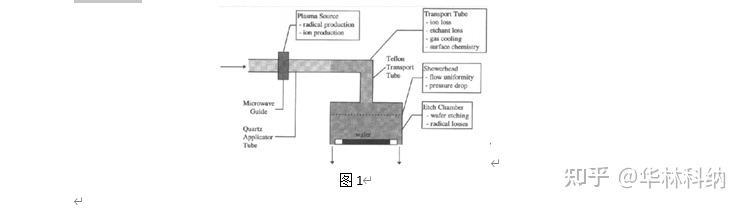

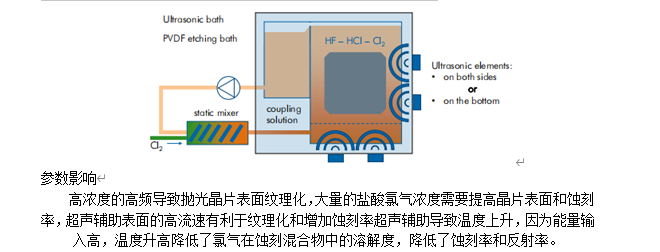
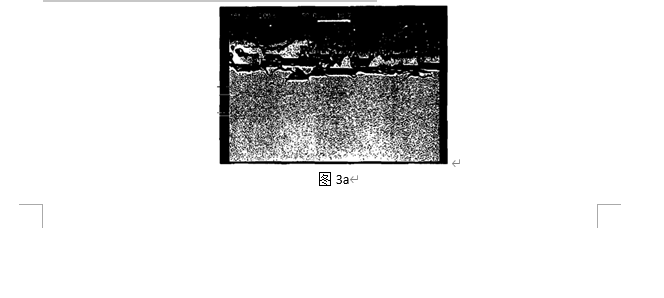

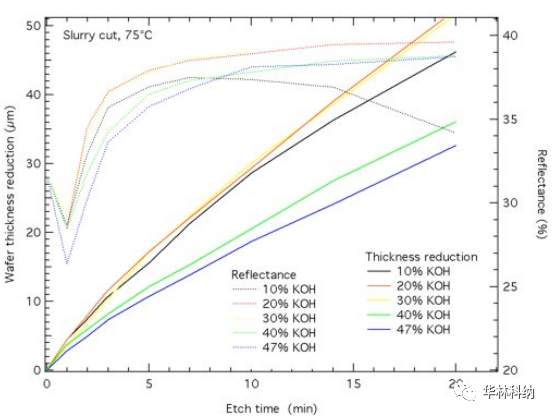
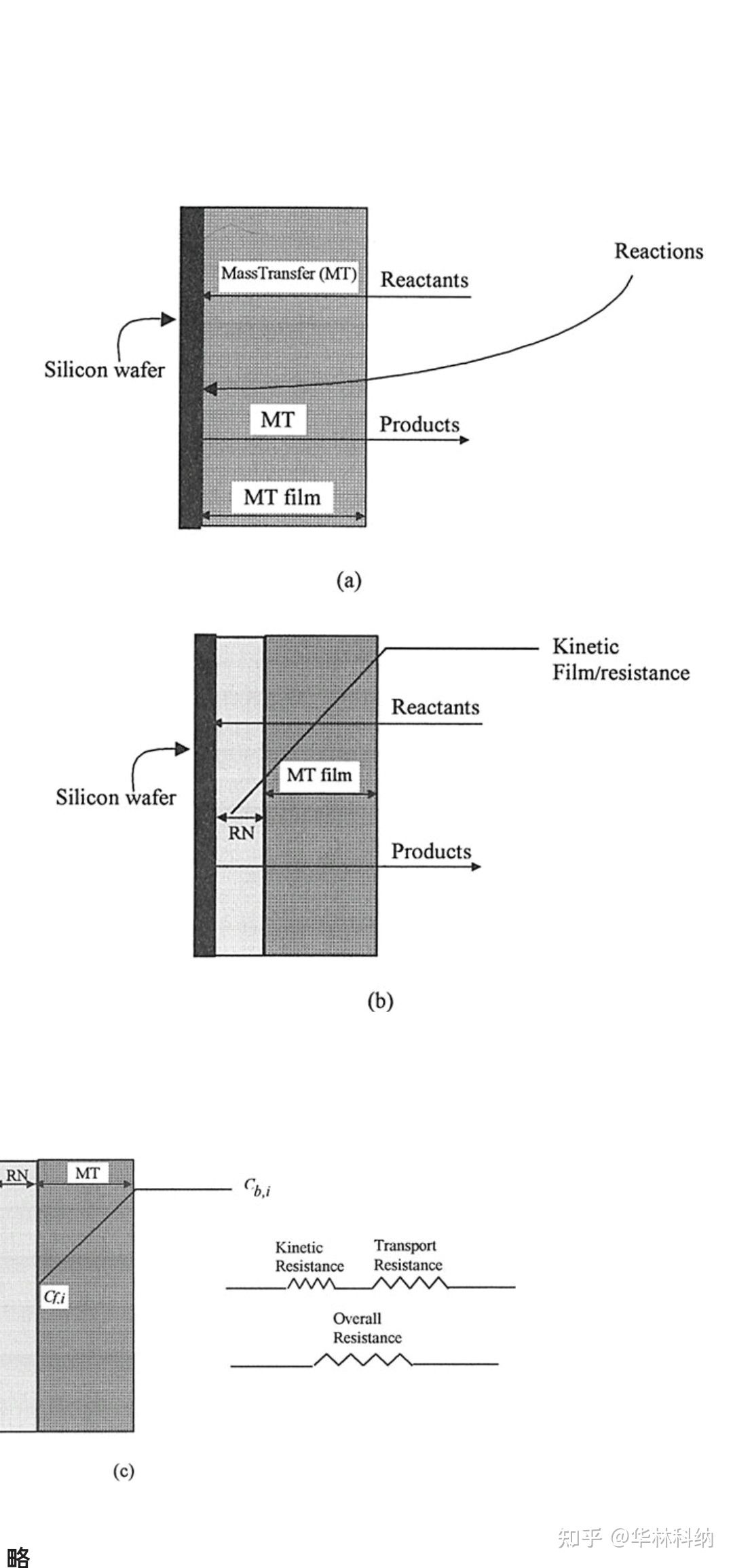
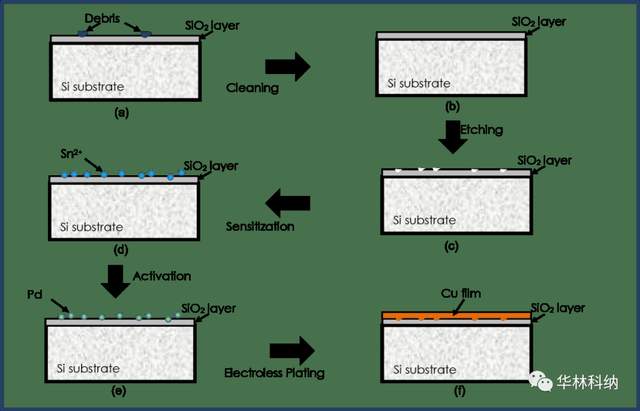
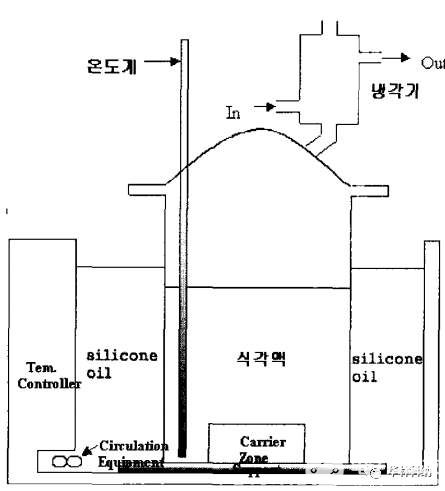

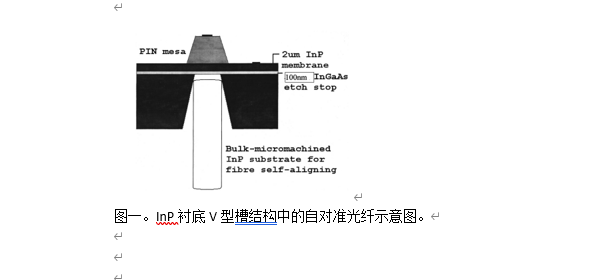
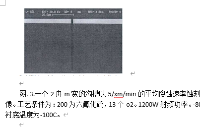
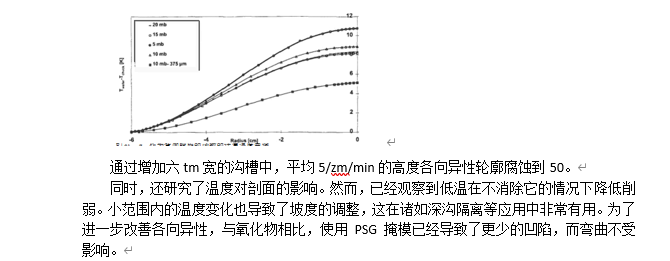

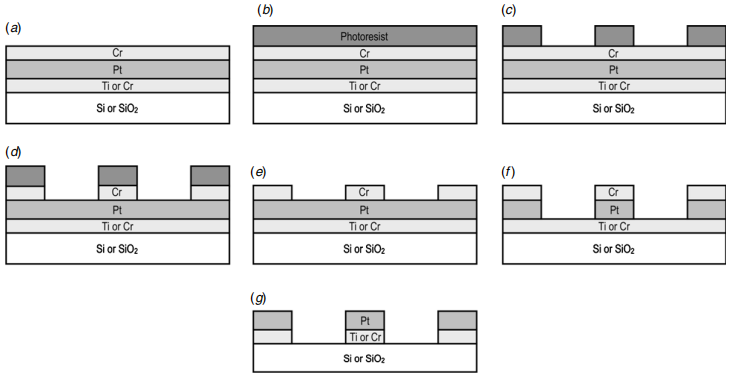




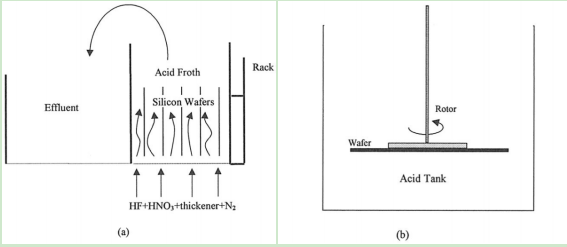



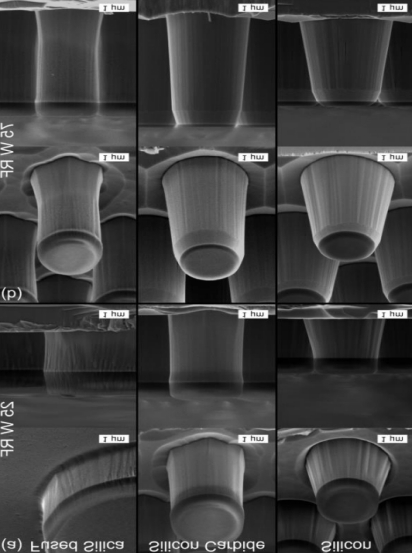
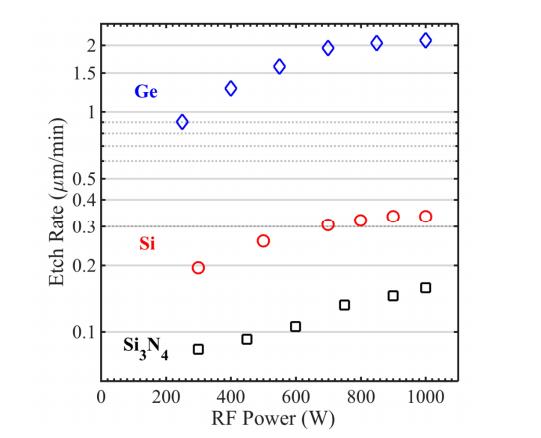







评论