InGaN量子阱方面优势显著。然而,半极性薄膜在异质外延中面临晶体质量差、应力各向异性等挑战。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广
2025-12-31 18:04:27 3563
3563 
测量膜厚是现代工业和科研中的一项关键质量控制手段,它通过精确监控涂层或薄膜的厚度,直接确保产品在光学、电学、机械防护等方面的预期性能(如手机屏幕透光性、芯片运行稳定性、汽车漆面防腐性),同时能有
2025-12-27 10:42:39 72
72 
接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。本文基于光谱椭偏技术,结合X射线衍射、拉曼光谱等方法,系统研究了c面蓝宝石衬底上
2025-12-26 18:02:20 1016
1016 
在现代高科技产业如半导体和新能源领域,厚度低于一微米的薄膜被广泛应用,其厚度精确测量是确保器件性能和质量控制的核心挑战。面对超薄、多层、高精度和非破坏性的测量需求,传统的接触式或破坏性方法已难以胜任
2025-12-22 18:04:28 1088
1088 
,Xfilm埃利将系统阐述四探针法的基本原理,重点分析其在薄膜电阻率测量中的核心优势,并结合典型应用说明其重要价值。四探针法的基本原理/Xfilm四探针法的原理四探针法的理
2025-12-18 18:06:01 154
154 
传统椭偏测量在同时确定薄膜光学常数(复折射率n,k)与厚度d时,通常要求薄膜厚度大于10nm,这限制了其在二维材料等超薄膜体系中的应用。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率
2025-12-08 18:01:31 237
237 
涂层作为抑制此类光学干扰的关键技术,其性能评估至关重要。下文,紫创测控luminbox将系统阐述基于太阳光模拟器的HUD纳米涂层多角度杂散光测量,为汽车HUD用涂层
2025-12-01 18:05:47 295
295 
随着半导体芯片制造精度进入纳米尺度,薄膜厚度的精确测量已成为保障器件性能与良率的关键环节。光谱椭偏仪虽能实现埃米级精度的非接触测量,但传统设备依赖宽带光源与光谱分光系统,存在测量效率低、系统复杂且易
2025-11-03 18:04:06 220
220 
在微电子与MEMS领域,薄膜厚度测量对薄膜沉积、产品测试及失效分析至关重要,有机半导体因低成本、室温常压易加工及“湿法”制备优势,在OLED等器件中潜力大,但其一存在膜层柔软、附着力差等
2025-10-22 18:03:55 2111
2111 
薄膜厚度测量仪,其原理是通过将已知的薄膜材料电阻率除以方阻来确定厚度,并使用XFilm平板显示在线方阻测试仪作为对薄膜在线方阻实时检测,以提供数据支撑。旨在实现非破
2025-09-29 13:43:36 642
642 
法开展表面电阻测量研究。Xfilm埃利四探针方阻仪凭借高精度检测能力,可为此类薄膜电学性能测量提供可靠技术保障。下文将重点分析四探针法的测量原理、实验方法与结果,
2025-09-29 13:43:26 654
654 
一、引言
玻璃晶圆总厚度偏差(TTV)测量数据的准确性,对半导体器件、微流控芯片等产品的质量把控至关重要 。在实际测量过程中,数据异常情况时有发生,不仅影响生产进度,还可能导致产品质量隐患 。因此
2025-09-29 13:32:12 460
460 
我将从超薄玻璃晶圆 TTV 厚度测量面临的问题出发,结合其自身特性与测量要求,分析材料、设备和环境等方面的技术瓶颈,并针对性提出突破方向和措施。
超薄玻璃晶圆(
2025-09-28 14:33:22 338
338 
一、引言
碳化硅(SiC)作为宽禁带半导体材料的代表,在功率器件、射频器件等领域发挥着关键作用。总厚度偏差(TTV)是衡量碳化硅衬底及外延片质量的重要指标,其精确测量对保障碳化硅器件性能至关重要
2025-09-22 09:53:36 1555
1555 
一、引言
碳化硅(SiC)凭借优异的物理化学性能,成为功率半导体器件的核心材料。总厚度偏差(TTV)作为衡量 SiC 衬底质量的关键指标,其精确测量对器件性能和可靠性至关重要。然而,碳化硅独特
2025-09-16 13:33:13 1573
1573 
WD4000晶圆三维形貌膜厚测量系统通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW、WARP、在高效测量测同时有效防止晶圆产生划痕缺陷。WD4000晶圆
2025-09-11 16:41:24
一、引言
碳化硅(SiC)作为宽禁带半导体材料,在功率器件、射频器件等领域应用广泛。总厚度偏差(TTV)是衡量碳化硅衬底质量的关键指标,准确测量 TTV 对保障器件性能至关重要。目前,探针式和非接触
2025-09-10 10:26:37 1011
1011 
薄膜厚度的测量在芯片制造和集成电路等领域中发挥着重要作用。椭偏法具备高测量精度的优点,利用宽谱测量方式可得到全光谱的椭偏参数,实现纳米级薄膜的厚度测量。Flexfilm全光谱椭偏仪可以非接触对薄膜
2025-09-08 18:02:42 1463
1463 
固态薄膜因独特的物理化学性质与功能在诸多领域受重视,其厚度作为关键工艺参数,准确测量对真空镀膜工艺控制意义重大,台阶仪法因其能同时测量膜厚与表面粗糙度而被广泛应用于航空航天、半导体等领域。费曼仪器
2025-09-05 18:03:23 631
631 
在锂电池产业高速发展的背景下,薄膜类关键材料(如极片涂层、隔离膜)的力学性能直接决定电池的循环寿命、安全性能与能量密度。当前,锂电池薄膜材料测试设备作为研发创新与质量管控的核心工具,需求持续增长,但
2025-08-30 14:16:41
在现代工业与科研中,薄膜厚度是决定材料腐蚀性能、半导体器件特性以及光学与电学性质的关键参数。精准测量此参数对于工艺优化、功能材料理解及反向工程都至关重要。其中,台阶仪通过直接测量薄膜与暴露基底之间
2025-08-29 18:01:43 2656
2656 
摘要
本文聚焦碳化硅衬底 TTV 厚度不均匀性测量需求,分析常规采样策略的局限性,从不均匀性特征分析、采样点布局优化、采样频率确定等方面提出特殊采样策略,旨在提升测量效率与准确性,为碳化硅衬底
2025-08-28 14:03:25 545
545 
椭偏仪是一种基于椭圆偏振分析的光学测量仪器,通过探测偏振光与样品相互作用后偏振态的变化,获取材料的光学常数和结构信息。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用
2025-08-27 18:04:52 1416
1416 
摘要
本文聚焦碳化硅衬底 TTV 厚度不均匀性测量需求,分析常规采样策略的局限性,从不均匀性特征分析、采样点布局优化、采样频率确定等方面提出特殊采样策略,旨在提升测量效率与准确性,为碳化硅衬底
2025-08-27 14:28:52 995
995 
摘要
本文针对碳化硅衬底 TTV 厚度测量中存在的边缘效应问题,深入分析其产生原因,从样品处理、测量技术改进及数据处理等多维度研究抑制方法,旨在提高 TTV 测量准确性,为碳化硅半导体制造提供可靠
2025-08-26 16:52:10 1092
1092 
智造提供提供精准测量解决方案,Flexfilm探针式台阶仪可以精确多种薄膜样品的薄膜厚度。然而,刻蚀过程中若边界处理不佳,会导致台阶不平行、测量误差大、重现性差等
2025-08-25 18:05:42 1084
1084 
摘要
本文聚焦碳化硅衬底 TTV 厚度测量数据处理环节,针对传统方法的局限性,探讨 AI 算法在数据降噪、误差校正、特征提取等方面的应用,为提升数据处理效率与测量准确性提供新的技术思路。
引言
在
2025-08-25 14:06:16 545
545 
WD4000晶圆厚度翘曲度测量系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV
2025-08-25 11:29:30
本文围绕探针式碳化硅衬底 TTV 厚度测量仪,系统阐述其操作规范与实用技巧,通过规范测量流程、分享操作要点,旨在提高测量准确性与效率,为半导体制造过程中碳化硅衬底 TTV 测量提供标准化操作指导
2025-08-23 16:22:40 1082
1082 
在OLED显示器中的多层超薄膜叠加结构的椭偏测量应用中,需要同时提取多层超薄膜堆栈各层薄膜厚度值,而膜层与膜层间的厚度也会有强耦合性会导致测量的不确定性增加。某些膜层对总体测量数据的灵敏度也极低
2025-08-22 18:09:58 838
838 
在芯片制造领域的光刻工艺中,光刻胶旋涂是不可或缺的基石环节,而保障光刻胶旋涂的厚度是电路图案精度的前提。优可测薄膜厚度测量仪AF系列凭借高精度、高速度的特点,为光刻胶厚度监测提供了可靠解决方案。
2025-08-22 17:52:46 1542
1542 
摘要
本文围绕探针式碳化硅衬底 TTV 厚度测量仪,系统阐述其操作规范与实用技巧,通过规范测量流程、分享操作要点,旨在提高测量准确性与效率,为半导体制造过程中碳化硅衬底 TTV 测量提供标准化操作
2025-08-20 12:01:02 551
551 
WD4000晶圆显微形貌测量系统通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW、WARP、在高效测量测同时有效防止晶圆产生划痕缺陷。WD4000晶圆显微
2025-08-20 11:26:59
摘要
本文聚焦碳化硅衬底 TTV 厚度测量过程,深入探究表面粗糙度对测量结果的影响机制,通过理论分析与实验验证,揭示表面粗糙度与测量误差的关联,为优化碳化硅衬底 TTV 测量方法、提升测量准确性提供
2025-08-18 14:33:59 454
454 
椭偏技术是一种非接触式、高精度、多参数等光学测量技术,是薄膜检测的最好手段。本文以椭圆偏振基本原理为基础,重点介绍了光学模型建立和仿真,为椭偏仪薄膜测量及误差修正提供一定的理论基础。费曼仪器作为国内
2025-08-15 18:01:29 3970
3970 
本文通过对比国产与进口碳化硅衬底 TTV 厚度测量仪在性能、价格、维护成本等方面的差异,深入分析两者的性价比,旨在为半导体制造企业及科研机构选购测量设备提供科学依据,助力优化资源配置。
引言
在
2025-08-15 11:55:31 707
707 
摘要
本文针对碳化硅衬底 TTV 厚度测量中出现的数据异常问题,系统分析异常类型与成因,构建科学高效的快速诊断流程,并提出针对性处理方法,旨在提升数据异常处理效率,保障碳化硅衬底 TTV 测量准确性
2025-08-14 13:29:38 1027
1027 
WD4000晶圆膜厚测量系统通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW、WARP、在高效测量测同时有效防止晶圆产生划痕缺陷。WD4000晶圆膜厚测量
2025-08-12 15:47:19
摘要
本文针对激光干涉法在碳化硅衬底 TTV 厚度测量中存在的精度问题,深入分析影响测量精度的因素,从设备优化、环境控制、数据处理等多个维度提出精度提升策略,旨在为提高碳化硅衬底 TTV 测量准确性
2025-08-12 13:20:16 778
778 
高对比度图像指导测量位置,结合改进的椭偏分析模型,实现对图案化SAM薄膜厚度与折射率的高精度无损表征。费曼仪器薄膜厚度测量技术贯穿于材料研发、生产监控到终端应用的全流程
2025-08-11 18:02:58 699
699 
摘要
本文针对碳化硅衬底 TTV 厚度测量设备,详细探讨其日常维护要点与故障排查方法,旨在通过科学的维护管理和高效的故障处理,保障测量设备的稳定性与测量结果的准确性,降低设备故障率,延长设备使用寿命
2025-08-11 11:23:01 555
555 
摘要
本文对碳化硅衬底 TTV 厚度测量的多种方法进行系统性研究,深入对比分析原子力显微镜测量法、光学测量法、X 射线衍射测量法等在测量精度、效率、成本等方面的优势与劣势,为不同应用场景下选择合适
2025-08-09 11:16:56 898
898 
摘要
本文针对碳化硅衬底 TTV 厚度测量中各向异性带来的干扰问题展开研究,深入分析干扰产生的机理,提出多种解决策略,旨在提高碳化硅衬底 TTV 厚度测量的准确性与可靠性,为碳化硅半导体制造工艺提供
2025-08-08 11:38:30 657
657 
很难在不引入额外损伤的情况下快速获得其厚度分布的相关信息。本文提出了一种非接触式无损检测量子点薄膜厚度的方法。在高电场作用下,量子点薄膜会发生光致发光猝灭现象,这与量子点薄膜的厚度以及施加的电压大小有关。
2025-08-07 11:33:07 396
396 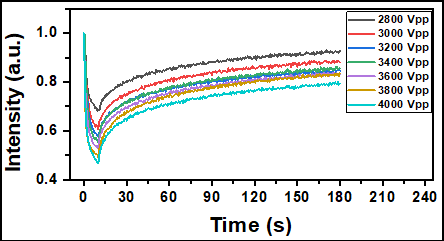
,通过菲涅尔公式得到薄膜参数与偏振态的关系,计算薄膜的折射率和厚度。Flexfilm费曼仪器作为薄膜测量技术革新者,致力于为全球工业智造提供精准测量解决方案,公司自主
2025-07-30 18:03:24 1129
1129 
表面增强拉曼散射SERS技术在痕量检测中具有独特优势,但其性能依赖于活性基底的形貌精度。ZnO作为一种新型半导体薄膜材料,因其本征微米级表面粗糙度通过在其表面覆盖一层贵金属Au,能够大大地提升
2025-07-28 18:04:53 702
702 
WD4000晶圆THK膜厚厚度测量系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它采用白光光谱共焦多传感器和白光干涉显微测量双向扫描技术,完成非接触式扫描并建立表面3D
2025-07-25 10:53:07
在半导体制造中,薄膜的沉积和生长是关键步骤。薄膜的厚度需要精确控制,因为厚度偏差会导致不同的电气特性。传统的厚度测量依赖于模拟预测或后处理设备,无法实时监测沉积过程中的厚度变化,可能导致工艺偏差和良
2025-07-22 09:54:56 1646
1646 
类金刚石碳(DLC)薄膜因高硬度、耐磨损特性,广泛应用于刀具、模具等工业领域,其传统颜色为黑色或灰色。近期,日本研究团队通过等离子体化学气相沉积(CVD)技术,将DLC薄膜厚度控制在20-80纳米
2025-07-22 09:54:36 1176
1176 
在半导体、光学镀膜及新能源材料等领域,精确测量薄膜厚度和光学常数是材料表征的关键步骤。Flexfilm光谱椭偏仪(SpectroscopicEllipsometry,SE)作为一种非接触、非破坏性
2025-07-22 09:54:27 1743
1743 
在半导体芯片制造中,薄膜厚度的精确测量是确保器件性能的关键环节。随着工艺节点进入纳米级,单颗芯片上可能需要堆叠上百层薄膜,且每层厚度仅几纳米至几十纳米。光谱椭偏仪因其非接触、高精度和快速测量的特性
2025-07-22 09:54:19 881
881 
薄膜在半导体、显示和二次电池等高科技产业中被广泛使用,其厚度通常小于一微米。对于这些薄膜厚度的精确测量对于质量控制至关重要。然而,能够测量薄膜厚度的技术非常有限,而光学方法因其非接触和非破坏性特点而
2025-07-22 09:54:08 2166
2166 
透明薄膜在生物医学、半导体及光学器件等领域中具有重要应用,其厚度与光学特性直接影响器件性能。传统接触式测量方法(如触针轮廓仪)易损伤样品,而非接触式光学方法中,像散光学轮廓仪(基于DVD激光头
2025-07-22 09:53:59 606
606 
生物聚合物薄膜(如纤维素、甲壳素、木质素)因其可调控的吸水性、结晶度和光学特性,在涂层、传感器和生物界面模型等领域应用广泛。薄膜厚度是决定其性能的关键参数,例如溶胀行为、分子吸附和光学响应。然而
2025-07-22 09:53:40 608
608 
薄膜结构在半导体制造中扮演着至关重要的角色,广泛应用于微电子器件、光学涂层、传感器等领域。随着半导体技术的不断进步,对薄膜结构的检测精度和效率提出了更高的要求。传统的检测方法,如椭圆偏振法、反射
2025-07-22 09:53:30 1528
1528 
在半导体和显示器件制造中,薄膜与基底的厚度精度直接影响器件性能。现有的测量技术包括光谱椭偏仪(SE)和光谱反射仪(SR)用于薄膜厚度的测量,以及低相干干涉法(LCI)、彩色共焦显微镜(CCM)和光谱
2025-07-22 09:53:09 1468
1468 
系统探讨四探针法的测量原理、优化策略及其在新型导电薄膜研究中的应用,并结合FlexFilm在半导体量测装备及光伏电池电阻检测系统的技术积累,为薄膜电学性能的精确测
2025-07-22 09:52:04 1006
1006 
费曼仪器作为国内领先的薄膜材料检测解决方案提供商,致力于为全球工业智造提供精准测量解决方案。其中全光谱椭偏仪可以精确量化薄膜的折射率、消光系数及厚度参数,揭示基底
2025-07-22 09:51:09 1317
1317 
透明薄膜在光学器件、微电子封装及光电子领域中具有关键作用,其厚度均匀性直接影响产品性能。然而,工业级微米级薄膜的快速测量面临挑战:传统干涉法设备庞大、成本高,分光光度法易受噪声干扰且依赖校准样品
2025-07-21 18:17:57 1456
1456 
在先进光学、微电子和材料科学等领域,透明薄膜作为关键工业组件,其亚微米级厚度的快速稳定测量至关重要。芯片制造中,薄膜衬底的厚度直接影响芯片的性能、可靠性及功能实现,而传统红外干涉测量方法受机械振动
2025-07-21 18:17:35 2706
2706 
薄膜厚度和复折射率的测定通常通过椭圆偏振术或分光光度法实现。本研究采用Flexfilm大样品仓紫外可见近红外分光光度计精确测量薄膜的反射率(R)和透射率(T)光谱,为反演光学参数提供高精度实验数据
2025-07-21 18:17:12 581
581 
。
Molex薄膜电池的技术原理:
Molex薄膜电池的技术原理主要基于其独特的结构和材料组成,以下是关于Molex薄膜电池技术原理的详细解释:
(1)材料组成:Molex薄膜电池主要由锌
2025-07-15 17:53:47
光刻胶生产技术复杂、品种规格多样,在电子工业集成电路制造中,对其有着极为严格的要求,而保证光刻胶产品的厚度便是其中至关重要的一环。 项目需求 本次项目旨在测量光刻胶厚度,光刻胶本身厚度处于 30μm-35μm 范围,测量精度要
2025-07-11 15:53:24 430
430 
WD4000晶圆厚度THK几何量测系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV
2025-07-10 13:42:33
一种重要的光学检测工具——光纤光谱仪。 光纤光谱仪以其结构紧凑、响应快速、操作灵活等优势,已广泛应用于薄膜厚度、光学常数、均匀性等参数的测量中,是当前实现非接触、非破坏性测量的重要手段之一。本文将围绕光纤光谱
2025-07-08 10:29:37 406
406 WD4000全自动晶圆厚度测量设备兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它采用白光光谱共焦多传感器和白光干涉显微测量双向扫描技术,完成非接触式扫描并建立表面3D
2025-06-27 11:43:16
WD4000晶圆厚度测量设备兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW
2025-06-18 15:40:06
引言
在碳化硅衬底厚度测量中,探头温漂是影响测量精度的关键因素。传统测量探头受环境温度变化干扰大,导致测量数据偏差。光纤传感技术凭借独特的物理特性,为探头温漂抑制提供了新方向,对提升碳化硅衬底厚度
2025-06-05 09:43:15 463
463 
基本理论和典型应用\",并研究该方法对轻微变化的涂层厚度有多敏感。
任务描述
镀膜样品
椭圆偏振分析仪
总结 - 组件 ...
椭圆偏振系数测量
椭圆偏振分析仪测量反射系数(s-和p-
2025-06-05 08:46:36
引言
碳化硅衬底 TTV(总厚度变化)厚度是衡量其质量的关键指标,直接影响半导体器件性能。合理选择测量仪器对准确获取 TTV 数据至关重要,不同应用场景对测量仪器的要求存在差异,深入分析选型要点
2025-06-03 13:48:50 1453
1453 
测量。
(2)系统覆盖衬底切磨抛,光刻/蚀刻后翘曲度检测,背面减薄厚度监测等关键工艺环节。
晶圆作为半导体工业的“地基”,其高纯度、单晶结构和大尺寸等特点,支撑了芯片的高性能与低成本制造。其战略价值不仅
2025-05-28 16:12:46
在先进制程中,厚度(THK)翘曲度(Warp)弯曲度(Bow)三者共同决定了晶圆的几何完整性,是良率提升和成本控制的核心参数。通过WD4000晶圆几何形貌测量系统在线检测,可减少其对芯片性能的影响。
2025-05-28 11:28:46 2
2 WD4000系列Wafer晶圆厚度量测系统采用白光光谱共焦多传感器和白光干涉显微测量双向扫描技术,完成非接触式扫描并建立表面3D层析图像,实现Wafer厚度、翘曲度、平面度、线粗糙度、总体厚度变化
2025-05-27 13:54:33
在先进制程中,厚度(THK)翘曲度(Warp)弯曲度(Bow)三者共同决定了晶圆的几何完整性,是良率提升和成本控制的核心参数。通过WD4000晶圆几何形貌测量系统在线检测,可减少其对芯片性能的影响。
2025-05-23 14:27:49 1203
1203 
WD4000晶圆制造翘曲度厚度测量设备通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW、WARP、在高效测量测同时有效防止晶圆产生划痕缺陷。自动测量
2025-05-13 16:05:20
随着光学技术的飞速发展,镜片作为光学系统的核心元件,其制造精度直接影响到光学系统的性能。在镜片生产过程中,厚度是一个关键参数,需进行高精度、高效率的测量。传统测量方法如千分尺、游标卡尺等,是接触式
2025-05-06 07:33:24 822
822 
精确无损测量薄膜厚度对光伏太阳能电池等电子器件很关键。在高效硅异质结(SHJ)太阳能电池中,叉指背接触(IBC)设计可减少光反射和改善光捕获,但其制备需精确图案化和控制薄膜厚度。利用光致发光成像技术
2025-04-21 09:02:50 974
974 
本文介绍了用抗反射涂层来保证光刻精度的原理。
2025-04-19 15:49:28 2560
2560 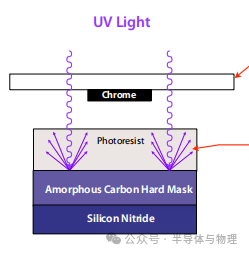
ITO薄膜的表面粗糙度与厚度影响着其产品性能与成本控制。优可测亚纳米级检测ITO薄膜黄金参数,帮助厂家优化产品性能,实现降本增效。
2025-04-16 12:03:19 824
824 
中图仪器NS系列探针式薄膜厚度台阶仪是一款为高精度微观形貌测量设计的超精密接触式仪器,广泛应用于半导体、光伏、MEMS、光学加工等领域。通过2μm金刚石探针与LVDC传感器的协同工作,结合亚埃级
2025-04-15 10:47:00
锂电池作为电动汽车、储能系统等领域的核心部件,其生产质量和效率日益受到重视。特别是在锂电池的生产过程中,极片厚度的精准控制成为了影响电池性能稳定性的关键因素。那么,如何在保证高效生产的同时,实现微米
2025-04-01 07:34:03 783
783 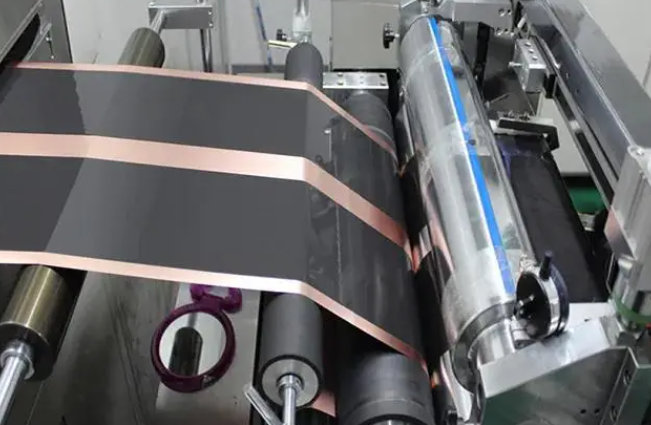
本文介绍了利用X射线衍射方法测量薄膜晶体沿衬底生长的错配角,可以推广测量单晶体的晶带轴与单晶体表面之间的夹角,为单晶体沿某晶带轴切割提供依据。
2025-03-20 09:29:10 848
848 
本文论述了芯片制造中薄膜厚度量测的重要性,介绍了量测纳米级薄膜的原理,并介绍了如何在制造过程中融入薄膜量测技术。
2025-02-26 17:30:09 2660
2660 
的分布情况,帮助用户了解足部受力状态,从而为步态分析、疾病诊断、运动优化和鞋类设计提供科学依据。 薄膜压力分布测量系统概述: 薄膜压力分布测量系统主要由薄膜传感器、数据采集仪和软件组成。薄膜由压敏电阻组成,能够
2025-02-24 16:24:36 968
968 
NS系列膜层厚度台阶高度测量仪主要用于台阶高、膜层厚度、表面粗糙度等微观形貌参数的测量。测量时通过使用2μm半径的金刚石针尖在超精密位移台移动样品时扫描其表面,测针的垂直位移距离被转换为与特征尺寸
2025-02-21 14:05:13
引言: 轮胎压力分布测试是评估轮胎性能的重要手段,直接影响车辆的操控性、舒适性和安全性。薄膜压力分布测量系统作为一种高精度的测量工具,能够实时捕捉轮胎与地面接触时的压力分布情况,为轮胎设计和优化提供
2025-02-14 15:52:16 917
917 
前言非接触式激光厚度测量仪支持多种激光型号,并对应有不同的测量模式,比其他类似软件更合理,更加容易上手。下面我们用 CMS 激光下的厚度模式与平面模式进行操作。一、产品描述1.产品特性非接触式激光
2025-02-13 09:37:19
前言利用光学+激光制造技术新的创新,武汉易之测仪器可以制造各种高质量标准或定制设计的各种石英晶圆玻璃激光厚度测量仪定制,以满足许多客户应用的需求。一、产品描述1.产品特性以下原材料可以用于石英晶圆
2025-02-13 09:32:35
WD4000高精度晶圆厚度几何量测系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV
2025-02-11 14:01:06
产品概述: 薄膜压力传感器是一种电阻式传感器,输出电阻随施加在传感器表面压力的增大而减小,数据通过采集器上传云端可以测得压力大小以及压力分布云图。福普生是一家专注于压力分布测量技术的公司,凭借创新
2025-02-10 15:26:35 1071
1071 
白光干涉仪的膜厚测量模式原理主要基于光的干涉原理,通过测量反射光波的相位差或干涉条纹的变化来精确计算薄膜的厚度。以下是该原理的详细解释:
一、基本原理
当光线照射到薄膜表面时,部分光线会在薄膜表面
2025-02-08 14:24:34 508
508 
基本理论和典型应用\",并研究该方法对轻微变化的涂层厚度有多敏感。
任务描述
镀膜样品
椭圆偏振分析仪
总结 - 组件 ...
椭圆偏振系数测量
椭圆偏振分析仪测量反射系数(s-和p-
2025-02-05 09:35:38
在半导体产业这片高精尖的领域中,氮化镓(GaN)衬底作为新一代芯片制造的核心支撑材料,正驱动着光电器件、功率器件等诸多领域迈向新的高峰。然而,氮化镓衬底厚度测量的精准度却时刻面临着一个来自暗处的挑战
2025-01-22 09:43:37 449
449 
在半导体制造这一微观且精密的领域里,氮化镓(GaN)衬底作为高端芯片的关键基石,正支撑着光电器件、功率器件等众多前沿应用蓬勃发展。然而,氮化镓衬底厚度测量的准确性却常常受到一个隐匿 “敌手” 的威胁
2025-01-20 09:36:50 404
404 
在半导体制造这一高精尖领域,碳化硅衬底作为支撑新一代芯片性能飞跃的关键基础材料,其厚度测量的准确性如同精密机械运转的核心齿轮,容不得丝毫差错。然而,测量探头的 “温漂” 问题却如隐匿在暗处的 “幽灵
2025-01-15 09:36:13 386
386 
在半导体制造的微观世界里,碳化硅衬底作为新一代芯片的关键基石,其厚度测量的精准性如同精密建筑的根基,不容有丝毫偏差。然而,测量探头的 “温漂” 问题却如同一股暗流,悄然冲击着这一精准测量的防线,给
2025-01-14 14:40:26 447
447 
CHY-CU接触式离型膜厚度测试仪采用机械接触式测量方法,严格符合标准要求,专业适用于量程范围内的塑料薄膜、薄片、隔膜、纸张、箔片、硅片等各种材料厚度的精确测量。测试原理机械接触式测试原理,裁取一定
2025-01-13 15:57:29
热障涂层的厚度研究了热障涂层对叶片换热的影响规律。研究发现:涂有热障涂层后,叶片温度下降明显,越靠近前缘温度降低幅度越大,压力侧与吸力侧相比温度降幅更大;厚度为0.05~0.2 mm 的热障涂层可使叶片金属表面平均温度降低
2025-01-13 09:07:35 1359
1359 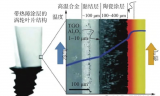
CHY-CU离型膜厚度测试仪采用机械接触式测量方法,严格符合标准要求,专业适用于量程范围内的塑料薄膜、薄片、隔膜、纸张、箔片、硅片等各种材料厚度的精确测量。测试原理机械接触式测试原理,裁取一定尺寸
2025-01-09 15:44:50
 电子发烧友App
电子发烧友App


















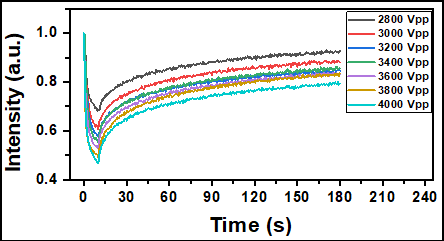





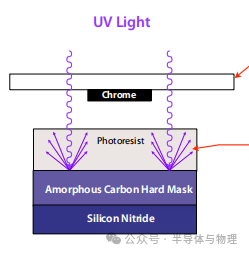

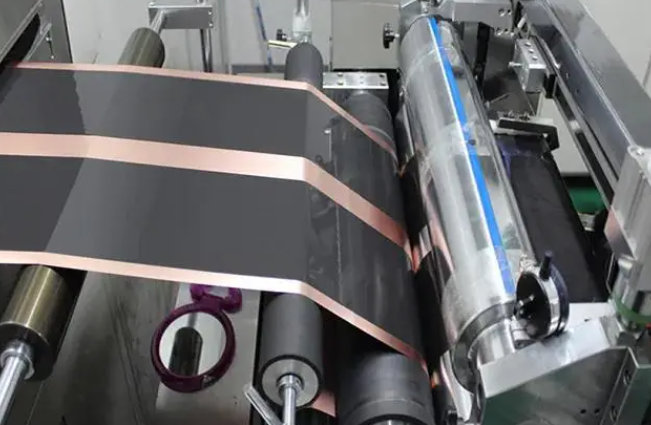







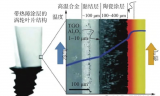



评论