传统椭偏测量在同时确定薄膜光学常数(复折射率n,k)与厚度d时,通常要求薄膜厚度大于10 nm,这限制了其在二维材料等超薄膜体系中的应用。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
本研究提出一种新方法:利用各向异性衬底打破椭偏分析中 n,k,d的参数耦合。模拟结果表明,该方法可在单次测量中以高精度同步测定厚度低于1 nm的超薄膜的光学常数与厚度。这一突破对二维材料、量子器件、等离子体激元等前沿领域的超薄层表征具有重要意义。
1
椭偏测量基本原理
flexfilm

本文所用坐标系方向与样品结构示意图,环境介质为周围介质
椭偏测量的核心是探测电磁波从样品表面反射时偏振态的变化。对于各向同性非退偏样品,这种变化可通过p偏振和s偏振态的复反射系数(rpp、rss)描述,其复比值ρ的振幅和相位传统上用椭偏角Δ和Ψ表示:

对于分层介质,Δ 和 Ψ由样品特性(材料光学常数、层厚、表面粗糙度)、入射角(AOI)和探测波长 λ 共同决定。椭偏数据分析的本质是通过计算建模解决逆问题:从测量结果反推样品特性,其样品模型通常由环境介质、薄膜层和半无限大衬底组成,材料光学参数由复折射率N=n+ik描述(其中 n 为折射率,k 为消光系数),且满足N2=ε(ε为复介电函数)。
2
超薄膜测量的核心挑战
flexfilm
当模型参数间存在强数值相关性时,逆问题的解会变得模糊。对于厚度 d≲10 nm的超薄膜,Ψ 几乎不包含薄膜的有效信息,而 Δ 仅能提供 “光学厚度”Nlayer⋅d的耦合信息,即使采用多入射角、多波长测量(变角光谱椭偏仪,VASE),这种耦合依然难以消除。
3
各向异性衬底解耦方案
flexfilm
本研究通过数值模拟验证该方法的有效性:采用Berreman 4×4 矩阵法计算各向异性衬底上超薄膜的穆勒-琼斯矩阵,并添加噪声模拟实际测量数据。通过非线性拟合反演薄膜参数,以厚度相对不确定度σrel=σd/d作为解耦效果的量化指标。
4
hBN在金红石衬底上的验证
flexfilm
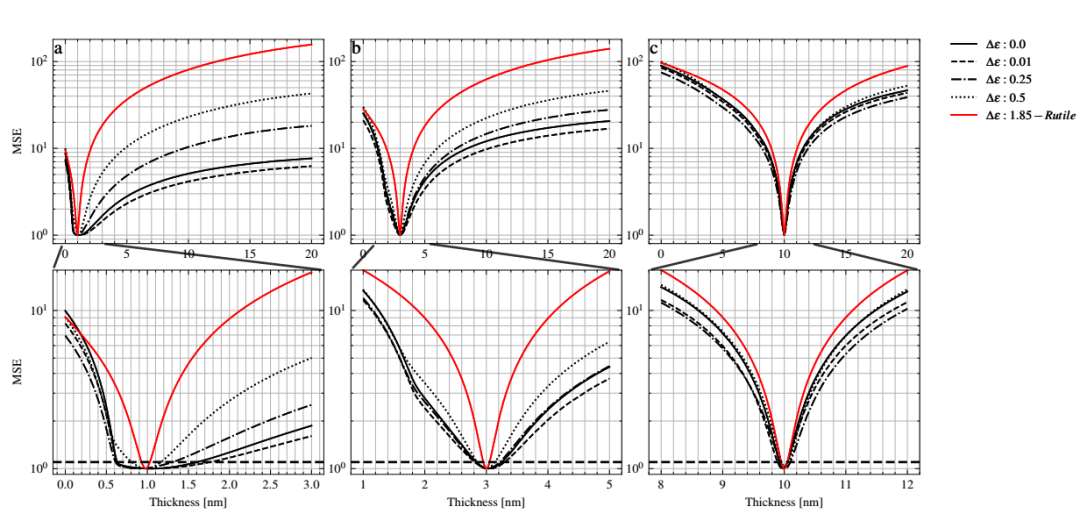
在入射角 50°、波长 500 nm 条件下,1 nm(左)、3 nm(中)和 10 nm(右)hBN 层在透明衬底上的唯一性拟合结果

不同 Δϵ下 10 nm、3 nm 与 1 nm hBN层在金红石衬底上的相对厚度不确定度 σrel
以500 nm波长、50°入射角模拟hBN薄膜(介电常数 ϵ=5.0)沉积于金红石衬底(ϵo=7.4,Δϵ=1.85)的情况。结果表明:
即使对于1 nm超薄膜,使用高双折射衬底可大幅降低厚度不确定度:σrel从各向同性衬底的48.4%降至4.9%(绝对不确定度约0.02 nm)。
衬底双折射越大,解耦效果越显著。
5
多种材料组合的系统研究
flexfilm

薄层在单轴衬底上的相对层厚不确定度 σrelσrel 模拟结果,对应以下六种情况:(a) hBN–金红石(b) MoS₂–金红石(c) hBN–石英(d) hBN–硅(e) MoS₂–硅(f) 石墨烯–硅

用于模拟案例 I–VI 的介电值(λ=500 nm)

在 σrel=2% 条件下,各向同性衬底与Δϵ=0.6衬底对应的厚度 ds
模拟涵盖了六类典型材料体系,包括透明/吸收层与透明/吸收衬底的组合。主要发现如下:
当薄膜介电常数低于衬底时,衬底双折射的增大会显著提升厚度提取精度(例如hBN/金红石)。
对于透明层/吸收衬底体系(如hBN/Si),各向异性带来的改善相对有限。
在所有案例中,衬底面内各向异性的引入均不同程度降低了参数耦合。
本研究通过系统模拟证明,利用光学各向异性衬底可有效解耦椭偏测量中超薄膜的光学常数与厚度信息。该方法具有普适性,尤其适用于二维材料等超薄层的高精度无损表征。实际应用中,可采用天然各向异性晶体(如金红石、石英)作为衬底,或设计人工超材料衬底以优化双折射性能。结合多角度、光谱椭偏测量,可进一步提升表征精度与可靠性。该方法为二维材料、量子器件、超薄功能薄膜等前沿领域提供了一种强大的光学表征新工具。
Flexfilm全光谱椭偏仪
flexfilm

全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
- 先进的旋转补偿器测量技术:无测量死角问题。
- 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
- 秒级的全光谱测量速度:全光谱测量典型5-10秒。
- 原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《Unambiguous determination of optical constants and thickness of ultrathin films by using optical anisotropic substrates》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
光学
+关注
关注
4文章
884浏览量
38242 -
测量
+关注
关注
10文章
5719浏览量
116968
发布评论请先 登录
VirtualLab Fusion应用:各向异性方解石晶体的双折射效应
[VirtualLab] 各向异性方解石晶体的双折射效应
各向异性衬底上的高温超导( HTS)微带天线
【新启航】如何解决碳化硅衬底 TTV 厚度测量中的各向异性干扰问题

椭偏仪的原理和应用 | 薄膜材料或块体材料光学参数和厚度的测量

椭偏仪微区成像光谱测量:精准表征二维ReS₂/ReSe₂面内双折射率Δn≈0.22

椭偏仪在半导体的应用|不同厚度m-AlN与GaN薄膜的结构与光学性质




 椭偏术精准测量超薄膜n,k值及厚度:利用光学各向异性衬底
椭偏术精准测量超薄膜n,k值及厚度:利用光学各向异性衬底





评论