在半导体芯片制造中,薄膜厚度的精确测量是确保器件性能的关键环节。随着工艺节点进入纳米级,单颗芯片上可能需要堆叠上百层薄膜,且每层厚度仅几纳米至几十纳米。光谱椭偏仪因其非接触、高精度和快速测量的特性,成为半导体工业中膜厚监测的核心设备。
1
宽光谱椭偏仪工作原理
flexfilm
宽光谱椭偏仪通过分析偏振光与样品相互作用后的偏振态变化,测量薄膜的厚度与光学性质。其核心流程如下:
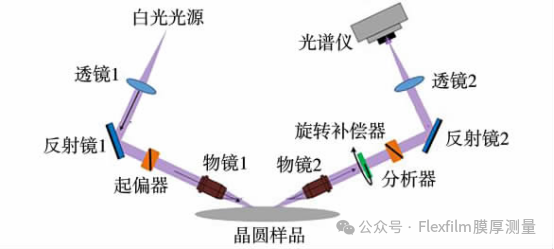
光谱椭偏仪结构简化示意图
1.偏振态调制:光源发出的宽谱光经起偏器形成特定偏振态,入射至样品表面后发生反射或透射,偏振态因薄膜的光学特性(如折射率、厚度、粗糙度)发生改变。
2.信号采集:反射光通过补偿器与分析器后,由探测器接收。光强随光学元件(如旋转补偿器)的周期性运动而变化,通过傅里叶分析提取与样品相关的傅里叶系数。
3.参数反演:实验测得的系数转化为偏振态参数ψ(振幅衰减比)和Δ(相位差),其数学表达为:

4.模型拟合:将ψ和Δ的实验值与基于Maxwell方程的理论模型(如多层膜光学模型)进行拟合,通过优化算法调整膜厚和材料光学参数(如复折射率),直至理论值与实验数据最佳匹配,最终输出精确的膜厚及光学常数。
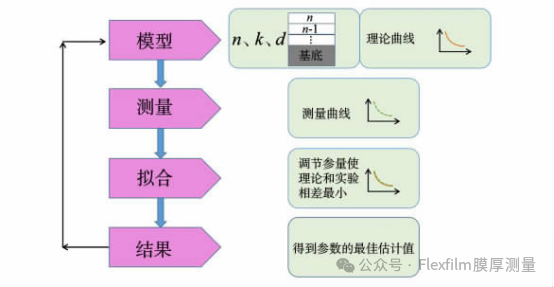
光谱椭偏仪拟合一般流程
2
实验设计:聚焦位置影响膜厚的测量结果
flexfilm

不同聚焦位置实验设计示意图
光谱椭偏仪需将入射光聚焦至样品表面形成微小光斑(通常几十微米),以匹配芯片切割道内的监测区域。实验表明,当聚焦位置偏离最佳焦点(±5 μm范围)时,膜厚测量值会呈现线性变化:
3 nm薄膜:离焦距离每增加1 μm,膜厚测量值增加约0.0056 nm,相当于0.19%/μm的百分比变化。
900 nm厚膜:离焦距离每增加1 μm,膜厚测量值仅增加0.01 nm,对应0.001%/μm的变化率。

薄膜样品在聚焦位置±5 μm范围内的膜厚静态重复性和拟合值

厚膜样品在聚焦位置±5 μm范围内的膜厚静态重复性和拟合值
原因分析:离焦时,光斑在探测器上的位置和大小发生偏移,导致采集的光谱信号与理论模型产生偏差。对于薄膜而言,其光谱特征较为平滑,微小信号差异即可引发较大的拟合误差;而厚膜因具有丰富的波长依赖峰谷特征,对光谱变化的容忍度更高。
3
实验结果
flexfilm
实验发现,尽管离焦会显著改变膜厚拟合值,但多次测量的静态重复性(以三次标准差衡量)对聚焦位置变化并不敏感。例如:
- 3 nm薄膜的聚焦重复性为1.3 μm时,膜厚测量的重复精度可达0.01 nm
- 900 nm厚膜在1.5 μm聚焦重复性下,重复精度为0.012 nm

两种样品在焦和离焦5 μm 时的光谱差异
这表明,仪器算法在离焦状态下仍能稳定拟合数据,但单次聚焦的位置偏差会直接影响最终结果的准确性。
4
结论:
聚焦重复性是提升测量膜厚精度的关键
flexfilm
根据实验结论,膜厚测量的重复精度极限主要由聚焦系统的稳定性决定。以当前工业设备的聚焦重复性(1.3~1.5 μm)为例,3 nm薄膜的测量误差已被限制在0.01~0.012 nm水平。若要进一步提升精度,需从以下方向改进:
1.优化自动聚焦算法:提高焦点定位的重复性,减少机械振动或环境扰动的影响。
2.增强光学系统设计:采用高数值孔径物镜或自适应光学元件,降低离焦敏感度。
3.改进拟合模型:针对离焦状态的光谱特征优化算法,减少拟合误差。
Flexfilm全光谱椭偏仪
flexfilm

全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
1.先进的旋转补偿器测量技术:无测量死角问题。
2.粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
3.秒级的全光谱测量速度:全光谱测量典型5-10秒。
4.原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪始终关注聚焦的位置偏差,为薄膜厚度的精确测量提供了高效解决方案。随着聚焦重复性的引入,椭偏仪的数据分析过程逐渐自动化,降低了用户门槛。未来,该技术有望在柔性电子、光伏器件等新兴领域发挥更大作用,推动材料科学的精细化发展。
本文出处:《聚焦位置对光谱椭偏仪膜厚测量的影响》
-
测量
+关注
关注
10文章
5786浏览量
117115 -
光谱
+关注
关注
4文章
1072浏览量
37466
发布评论请先 登录
VirtualLab Fusion应用:氧化硅膜层的可变角椭圆偏振光谱(VASE)分析
VirtualLab Fusion应用:氧化硅膜层的可变角椭圆偏振光谱(VASE)分析
基于均匀样品的薄膜厚度测量:椭偏仪vs.反射仪

椭偏仪在光学薄膜中的应用 | Al₂O₃膜厚、色差与耐腐蚀性解析




 聚焦位置对光谱椭偏仪膜厚测量精度的影响
聚焦位置对光谱椭偏仪膜厚测量精度的影响






评论