在本文中,我们详细研究了AlGaN的湿法刻蚀特性。特别地,我们研究了m面刻面形成和AlN摩尔分数对蚀刻速率的依赖关系。我们还研究了氮化铝摩尔分数差异较大的紫外发光二极管结构的湿法刻蚀特性。
2021-12-13 14:58:12 2236
2236 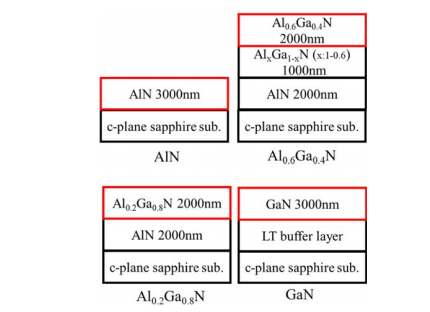
引言 椭偏光谱(SE)、原子力显微镜(AFM)、X射线光电子能谱(XPS)、润湿性和光致发光(PL)测量研究了HF水 溶液中化学清洗的GaP(OOl)表面。SE数据清楚地表明,溶液在浸入样品后(W1
2021-12-22 17:30:40 2639
2639 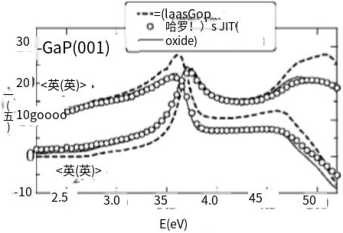
引言 用多能氩离子辐照x射线切割铌酸锂单晶,产生厚度为400纳米的均匀损伤表面层,研究其在HF水溶液中的腐蚀行为。使用不同的酸温度和浓度,表明可以通过将温度从24℃提高到55℃来提高蚀刻速率,同时
2021-12-23 16:36:59 2054
2054 引言 化学蚀刻是通过与强化学溶液接触来控制工件材料的溶解。该过程可以应用于任何材料。铜是利用化学腐蚀工艺制造微电子元件、微工程结构和精密零件中广泛使用的工程材料之一。在这项研究中,铜在50℃用两种
2021-12-29 13:21:46 3441
3441 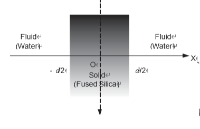
摘要 在印刷和蚀刻生产厚金属膜中的精密图案时,需要对化学蚀刻剂有基本的了解,以实现工艺优化和工艺控制。 为了蚀刻纯铝电路,研究了正磷酸、多磷酸和氯化铁的配方。 研究的目的是确定蚀刻速率和图案定义对正
2022-01-07 15:07:48 1640
1640 
摘要 我们华林科纳研究了正磷酸、聚磷酸、和铁(III)氯化物蚀刻剂对工艺条件变化的敏感性,以确定该蚀刻剂系统在纯铝电路光刻制造中的潜在生产应用。温度变化、正磷酸浓度、多磷酸浓度的影响。检测了酸浓度
2022-01-07 15:40:12 1922
1922 
划分为与晶体表面的不同状态和各种蚀刻机制相对应的部分。蚀刻后的晶体表面的形状与同一溶液中沿同一方向蚀刻的凹槽的轮廓密切相关。 介绍 本文研究(100)砷化镓在硫酸、过氧化氢和水溶液中的化学蚀刻具有重要的技术和科学意义。该解决方案通常用于
2022-01-25 10:32:24 3235
3235 
晶格中唯一光滑的面,其他面可能只是因为表面重建而是光滑的。通过这种方式,我们解释了在001方向上KOH:H20中的最小值。实验对HF:HN03溶液中接近001的最小蚀刻率的形状和从各向同异性向各向异性蚀刻的过渡进行了两个关键预测。
2022-01-25 13:51:11 2855
2855 
硅的各向异性蚀刻是指定向依赖的蚀刻,通常通过碱性蚀刻剂如水溶液氢氧化钾,TMAH和其他羟化物如氢氧化钠。由于蚀刻速率对晶体取向、蚀刻剂浓度和温度的强烈依赖性,可以以高度可控和可重复的方式制备多种硅
2022-03-08 14:07:25 2479
2479 
在本研究中,我们设计了一个150mm晶片的湿蚀刻槽来防止硅片的背面蚀刻,并演示了优化的工艺配方,使各向异性湿蚀刻的背面没有任何损伤,我们还提出了300mm晶圆处理用湿浴槽的设计,作为一种很有前途的工艺发展。
2022-03-28 11:01:49 3096
3096 
本文研究了氢氧化钾、TMAH(C6H4(OH)2)溶液中氢氧化铵(四甲基铵)和EDP(乙烯二胺(NH2(CH2)2NH2)的浓度和温度对硅表面的影响,制作了光滑的垂直墙和悬吊梳式结构。
2022-04-26 14:08:17 5087
5087 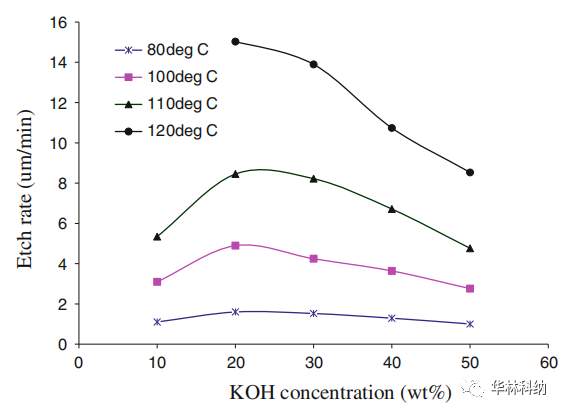
形成非球面表面。 我们使用 100 525 μm的硅晶片,在正面上具有1 μm的SiO2掩模,在背面上具有保护性的氮化物层。用于整个过程的蚀刻剂是85℃的33重量%的KOH:H2O溶液。 我们设计了许多
2022-05-11 14:49:58 1342
1342 
项工作中,使用光刻和蚀刻技术将晶体硅(c- Si)晶片深度蚀刻至厚度小于20 μm。使用SPR 220-7.0和SU-8光刻胶,使用四甲基氢氧化铵(TMAH)湿法各向异性蚀刻和基于等离子体的反应离子蚀刻(RIE)。二氧化硅用作TMAH蚀刻的制造层。4英寸c-Si晶片的TMAH蚀刻在80℃的温度
2022-06-10 17:22:58 9764
9764 
。二氧化硅通过分别用于微米和纳米鳍的光和电子束光刻形成图案,随后在氢氟酸中进行湿法蚀刻。使用用异丙醇(IPA)稀释的四甲基氢氧化铵(TMAH)以及具有表面活性剂(Triton-X-100)的硅掺杂TMAH
2022-07-08 15:46:16 2154
2154 
蚀刻机理 诸如KOH-、NaOH-或TMAH-溶液的强含水碱性介质蚀刻晶体硅通孔 硅+ 2 OH- + 2 H O 硅(OH) + H 二氧化硅(OH) 2- + 2 H 因为不同晶面的Si原子
2022-07-11 16:07:22 2920
2920 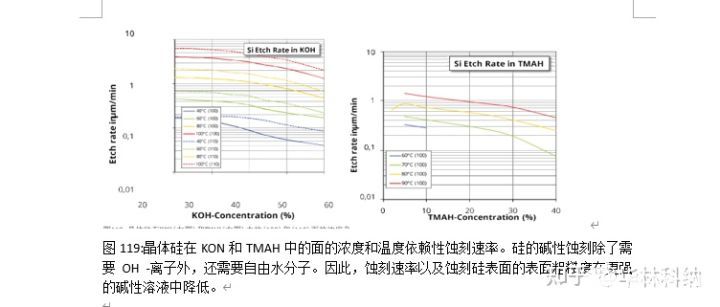
他方向上的蚀刻速度快,而各向同性蚀刻(如HF)会向所有方向侵蚀。使用KOH工艺是因为其在制造中的可重复性和均匀性,同时保持了较低的生产成本。异丙醇(IPA)经常添加到溶液中,以改变从{110}壁到{100}壁的选择性,并提高表面光滑度。 氧化物和氮化物
2022-07-14 16:06:06 5995
5995 
为了在基板上形成功能性的MEMS结构,必须蚀刻先前沉积的薄膜和/或基板本身。通常,蚀刻过程分为两类:浸入化学溶液后材料溶解的湿法蚀刻干蚀刻,其中使用反应性离子或气相蚀刻剂溅射或溶解材料在下文中,我们将简要讨论最流行的湿法和干法蚀刻技术。
2021-01-09 10:17:20
PCB制作工艺中的碱性氯化铜蚀刻液1.特性1)适用于图形电镀金属抗蚀层,如镀覆金、镍、锡铅合金,锡镍合金及锡的印制板的蚀刻。 2)蚀刻速率快,侧蚀小,溶铜能力高,蚀刻速率容易控制。 3)蚀刻液可以
2018-02-09 09:26:59
蚀问题,蚀刻后的导线侧壁接近垂直。 3)温度:温度对蚀刻液特性的影响比较大,通常在化学反应过程中,温度对加速溶液的流动性和减小蚀刻液的粘度,提高蚀刻速率起着很重要的作用。但温度过高,也容易引起蚀刻液
2018-09-11 15:19:38
化学反应过程中,温度对加速溶液的流动性和减小蚀刻液的粘度,提高蚀刻速率起着很重要的作用。但温度过高,也容易引起蚀刻液中一些化学成份挥发,造成蚀刻液中化学组份比例失调,同时温度过高,可能会造成高聚物抗
2013-10-31 10:52:34
PCB印制电路中影响蚀刻液特性的因素有哪些
2021-04-25 06:45:00
给定值时,溶液便会自动进行添加。 在与此相关的化学蚀刻(亦称之为光化学蚀刻或PCH)领域中,研究工作已经开始,并达到了蚀刻机结构设计的阶段。在这种方法中,所使用的溶液为二价铜,不是氨-铜蚀刻。它将
2018-11-26 16:58:50
计控制系统。当自动测得的PH结果低于给定值时,溶液便会自动进行添加。 在与此相关的化学蚀刻(亦称之为光化学蚀刻或PCH)领域中,研究工作已经开始,并达到了蚀刻机结构设计的阶段。在这种方法中,所
2018-09-13 15:46:18
重要材料的湿法腐蚀,即氧化锌、氮化镓和碳化硅。虽然氧化锌很容易在许多酸溶液中蚀刻,包括硝酸/盐酸和氢氟酸/硝酸,在非酸性乙酰丙酮中,第三族氮化物和碳化硅很难湿法蚀刻,通常使用干法蚀刻。已经研究了用于氮化
2021-10-14 11:48:31
晶体学和湿蚀刻的性质• 湿的在基于KOH的化学中,GaN 的化学蚀刻具有高度的各向异性,能够形成垂直和光滑的多面纳米结构。文章全部详情,请加V获取:hlknch / xzl1019• 我们 可以
2021-07-08 13:09:52
常见的加工方法进行。对于我们的第一步,我们使用了几种不同的处理方法,包括氯基等离子体中的反应离子蚀刻、KOH 溶液中的 PEC 蚀刻和切割。第二步是通过浸入能够在晶体学上蚀刻 GaN 的化学品中完成
2021-07-07 10:24:07
发射极感兴趣,这可以避免AlGaAs 的氧化和深能级问题。用于器件制造的关键技术操作之一是湿化学蚀刻。在我们之前的论文中,我们介绍了一组在 HC1:C H3COOH:H2O2(所谓的 KKI)溶液中
2021-07-09 10:23:37
问题,因为涉及的损害很低。此外,它们比干法蚀刻方法更便宜且不复杂。另一个重要的优点是湿法蚀刻可以选择性地去除不同的材料。本文介绍了n型氮化镓在几种电解质水溶液中(光)电化学行为的基础研究结果,以及在
2021-10-13 14:43:35
损伤并平滑垂直侧壁。图中。 在 TMAH 溶液中化学抛光不同时间后的 GaN m 面和 a 面侧壁的 SEM 图像。(a) 六方纤锌矿结构的晶胞示意图。(b) 鸟瞰图(倾斜于20°) ICP 干法蚀刻
2021-07-09 10:21:36
μm 的 3''、4'' 和 6''硅晶片进行了 KOH 和 TMAH 溶液的蚀刻实验分别是纳米制造中心。3''晶片被双面抛光并在热氧化层上分别在60/40nm的两侧具有氮化层以获得掩模窗口。4 英寸
2021-07-19 11:03:23
测得的PH结果低于给定值时,溶液便会自动进行添加。在与此相关的化学蚀刻(亦称之为光化学蚀刻或PCH)领域中,研究工作已经开始,并达到了蚀刻机结构设计的阶段。在这种方法中,所使用的溶液为二价铜,不是氨-铜
2018-04-05 19:27:39
摘要:在印制电路制作过程中,蚀刻是决定电路板最终性能的最重要步骤之一。所以,研究印制电路的蚀刻过程具有很强的指导意义,特别是对于精细线路。本文将在一定假设的基础上建立模型,并以流体力学为理论基础
2018-09-10 15:56:56
蚀刻 浸入蚀刻是一种半桨技术,它只需一个装满蚀刻洛液的槽,把板子整个浸入到溶液中,如图1所示。板子需要保持浸入直至蚀刻完成,这就需要很长的蚀刻时间,且蚀刻速度非常缓慢。可以通过加热蚀刻溶液的方法来
2018-09-11 15:27:47
﹐就是尽速让金属表面不断地接触新鲜的蚀刻液。 在氨性蚀刻中﹐假定所有参数不变﹐那么蚀刻的速率将主要由蚀刻液中的氨(NH3)来决定。因此, 使用新鲜溶液与蚀刻表面相互作用﹐其主要目的有两个﹕冲掉刚产生的铜
2017-06-23 16:01:38
湿法蚀刻工艺的原理是使用化学溶液将固体材料转化为液体化合物。选择性非常高,因为所用化学药品可以非常精确地适应各个薄膜。对于大多数解决方案,选择性大于100:1。
2021-01-08 10:12:57
我司是做湿法蚀刻药水的,所以在湿法这块有很多年的研究。所以有遇到湿法蚀刻问题欢迎提问,很愿意为大家解答。谢谢!QQ:278116740
2017-05-08 09:58:09
用交替微波加热法快速制备CeO2/C复合材料,进而制备Pt-CeO2/C。用电化学方法研究了甲醇、乙醇、甘油和乙二醇在KOH溶液中在Pt/C或Pt-CeO2/C电极上的电化学氧化性能。结果显示负载在
2011-03-11 12:31:25
适当的清洁或对溶液进行补加。 蚀刻过程中应注意的问题 减少侧蚀和突沿﹐提高蚀刻系数 侧蚀会产生突沿。通常印制板在蚀刻液中的时间越长,侧蚀的情况越严重。侧蚀将严重影响印制导线的精度,严重的侧蚀将不
2017-06-24 11:56:41
的PH结果低于给定值时,溶液便会自动进行添加。 在与此相关的化学蚀刻(亦称之为光化学蚀刻或PCH)领域中,研究工作已经开始,并达到了蚀刻机结构设计的阶段。在这种方法中,所使用的溶液为二价铜,不是氨-铜
2018-09-19 15:39:21
,不再呈光亮银白的金属色。采用循环伏安法研究镍在碱性溶液中的电化学活性。研究发现:镍片的电化学性能受到溶液浓度、电势扫描范围、扫描速度等因素的影响,并且具有较强的规律性。电磁干扰测试仪器:http://www.hyxyyq.com/wz/news/xpxx/90.html系统集成:http://www.oitek.com.cn
2017-09-15 10:09:37
通常所指蚀刻也称腐蚀或光化学蚀刻(photochemicaletching),指通过曝光制版、显影后,将要蚀刻区域的保护膜去除,在蚀刻时接触化学溶液,达到溶解腐蚀的作用,形成凹凸或者镂空成型的效果。
2019-04-25 15:41:36 17776
17776 我们华林科纳研究了不同醇类添加剂对氢氧化钾溶液的影响。据说醇导致硅蚀刻各向异性的改变。具有一个羟基的醇表现出与异丙醇相似的效果。它们导致(hh 1)型平面的蚀刻速率大大降低,通常在蚀刻凸形图形的侧壁处发展。这就是凸角根切减少的原因。具有一个以上羟基的醇不影响蚀刻各向异性,并导致表面光洁度变差。
2021-12-17 15:27:53 1194
1194 )、(TMAH)、NaOH等,但KOH与TMAH相比,平整度更好,并且只对硅的 100 表面做出反应,因此Fig。如1所示,具有54.74的各向异性蚀刻特性,毒性小。使用KOH的硅各向异性湿式蚀刻在压力传感器、加速度计、光学传感器等整体MEMS装置结构形成等中使用。 实验 KOH硅湿法蚀刻工艺 工艺
2021-12-23 09:55:35 1043
1043 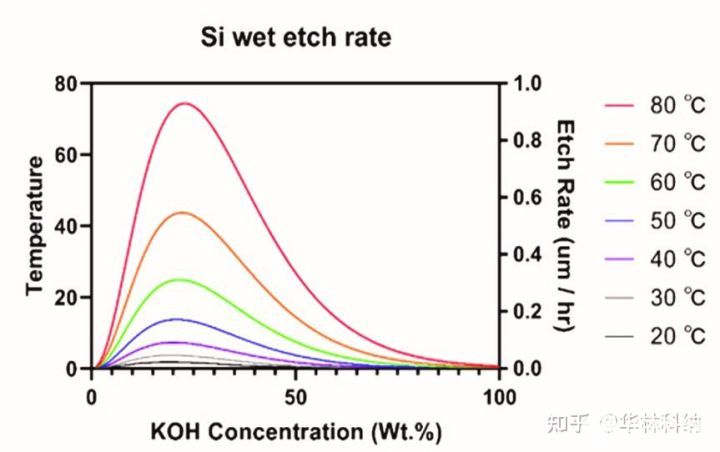
。在碱性溶液中,TMAH和KOH最广泛地用于湿法各向异性蚀刻。当考虑到互补金属氧化物半导体的兼容性,并且热氧化物被用作掩模层时,使用解决方案。为了获得和氢氧化钾之间的高蚀刻选择性。 即R和Si的显著蚀刻速率,氢氧化钾优于
2021-12-28 16:36:40 2146
2146 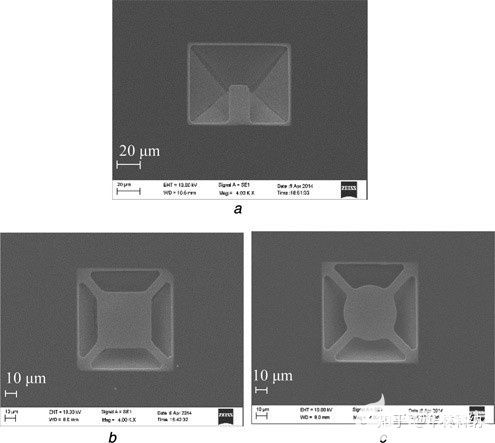
引言 到目前为止,GaAs晶片的直接再利用受到晶片表面上的残留物的限制,这些残留物不能利用一般的清洗方法方式去除。因此,用显微技术、轮廓术和x光电子能谱研究了氢氟酸对GaAs晶片的腐蚀。发现在蚀刻
2021-12-28 16:34:37 1396
1396 
介绍 于大多数半导体而言,阳极氧化需要价带空穴。因此,人们期望该反应发生在黑暗中的p型半导体和仅在(超)带隙光照射下的n型半导体。 氢氧化钾溶液中硅的化学蚀刻包括两个主要步骤:氢氧化物催化的硅-氢
2021-12-31 15:23:35 906
906 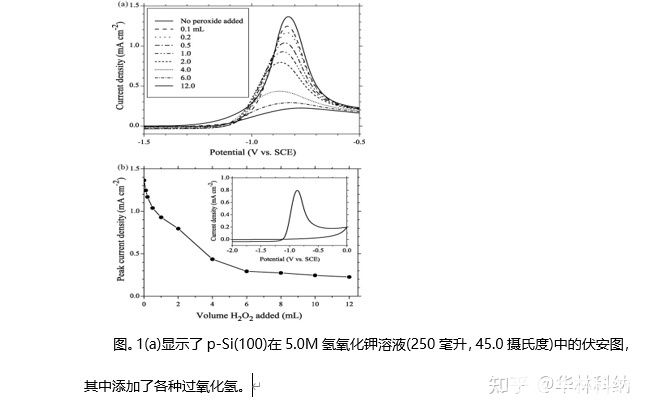
摘要 本文对本克斯使用的铝蚀刻剂进行调查,以长期提高蚀刻部件的质量。非常薄的铝箔图案在磷酸、氯化铁和水锈溶液中精确蚀刻的铝箔图案符合尺寸和一致性标准。蚀刻剂的主要问题是,由蒸发和耗尽引起的成分变化
2022-01-07 16:47:46 1281
1281 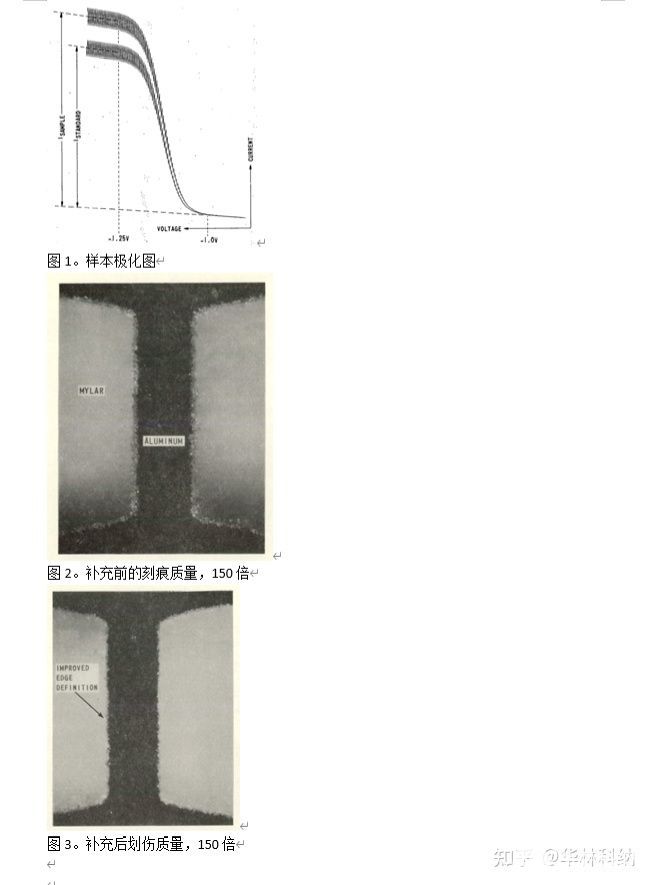
高,而各向同性蚀刻(如高频)会在所有方向上进行。使用氢氧化钾工艺是因为它在制造中的可重复性和均匀性,同时保持低生产成本。异丙醇(IPA)经常被添加到溶液中,以改变从{110}壁到{100}壁的选择性,并提高表面光滑度。 使用氢氧化钾蚀
2022-01-11 11:50:33 3264
3264 
引言 本文介绍了表面纹理对硅晶圆光学和光捕获特性影响。表面纹理由氢氧化钾(KOH)和异丙醇(IPA)溶液的各向异性蚀刻来控制。(001)晶硅晶片的各向异性蚀刻导致晶片表面形成金字塔面。利用轮廓测量法
2022-01-11 14:41:58 1824
1824 
上降低了(100)和(h11)面的蚀刻速率。 为了在低氢氧化钾浓度下获得低粗糙度的(100)表面,蚀刻溶液必须含有饱和水平的异丙醇。在我们的研究中,我们研究了异丙醇浓度对具有不同晶体取向的硅衬底的蚀刻速率和表面形态的影响。还研究了氢氧化钾浓度对(
2022-01-13 13:47:26 2752
2752 
引言 湿化学蚀刻是制造硅太阳能电池的关键工艺步骤。为了蚀刻单晶硅,氢氧化钾溶液被广泛使用,因为它们可以形成具有随机金字塔的表面纹理,从而增强单晶硅晶片的光吸收。对于多晶硅晶片,表面纹理化通常通过在含
2022-01-13 14:47:19 1346
1346 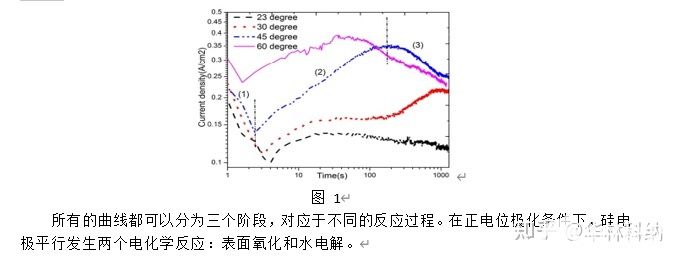
引言 我们华林科纳研究了KOH基溶液中AIN的湿式化学蚀刻与蚀刻温度和材料质量的关系。这两种材料的蚀刻速率都随着蚀刻温度的增加而增加,从20~80°C不等。通过在1100°C下快速热退火,提高了反应
2022-01-17 16:21:48 754
754 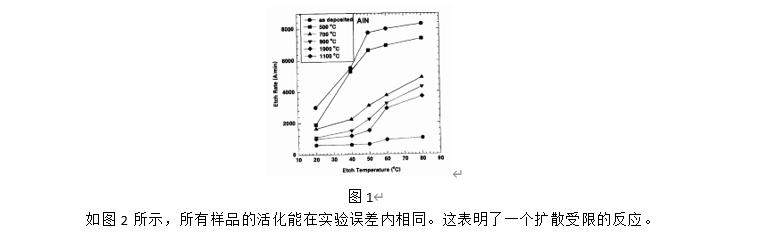
摘要 我们江苏华林科纳讲述了倒置有机太阳能电池(IOSCs)的光伏(PV)性能。氧化锌薄膜采用简单的水溶液路线沉积在ITO/玻璃溶液上。氧化锌薄膜通过湿化学蚀刻得到氧化锌纳米结构。与使用氧化锌薄膜
2022-01-20 11:27:38 660
660 
湿法蚀刻工艺已经广泛用于生产各种应用的微元件。这些过程简单易操作。选择合适的化学溶液(即蚀刻剂)是湿法蚀刻工艺中最重要的因素。它影响蚀刻速率和表面光洁度。铜及其合金是各种工业,特别是电子工业的重要
2022-01-20 16:02:24 3288
3288 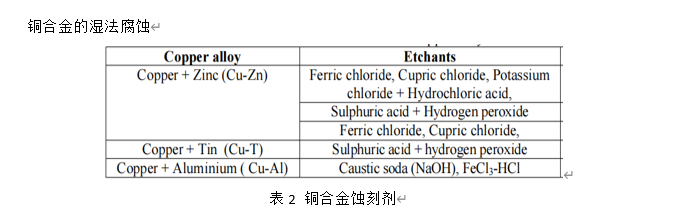
介绍 在本文中,我们首次报道了实现硅111和100晶片的晶体蚀刻的酸性溶液。通过使用六氟硅酸(也称为氟硅酸)和硝酸的混合物,获得暴露出各种面外111平面的硅111的晶体蚀刻。本文描述了用于该研究
2022-01-20 16:46:48 1197
1197 
,表面的Ga-As键断裂,元素砷留在砷化镓表面。此外,用盐酸+2-丙醇溶液蚀刻时可以观察到吸附的2-丙醇分子,但用氨水溶液蚀刻时没有检测到吸附的水分子。 介绍 湿式化学蚀刻工艺在器件制造中已被广泛应用。半导体/电解质界面上发生的过程
2022-01-24 15:07:30 2419
2419 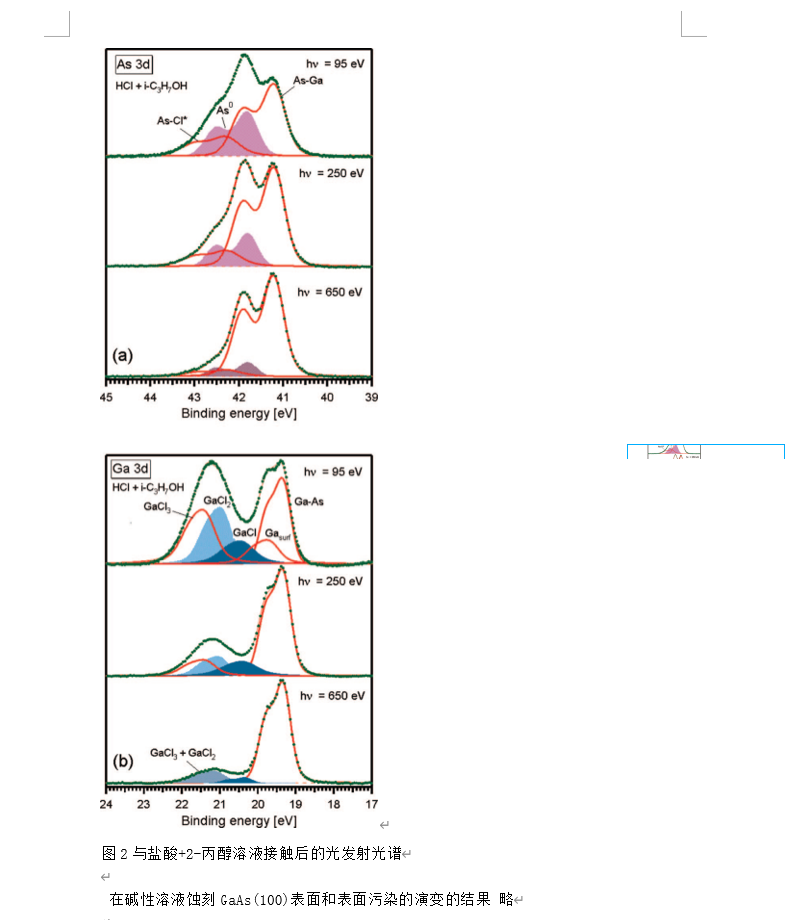
介绍 本文通过详细的动力学研究,阐明了在富含HF的高频/HNO3混合物中对硅的湿式化学蚀刻的机理。蚀刻实验后,我们进行进行了化学分析并研究了蚀刻速率与温度、蚀刻剂的硅含量利用率和搅拌速度的函数关系
2022-01-24 15:41:13 2458
2458 
的磷酸和氢氧化钾溶液中,氮化镓上可以观察到氧化镓的形成。这归因于两步反应过程并且在此过程中,紫外线照射可以增强氮化镓的氧化溶解。 实验中,我们使用深紫外紫外光照射来研究不同酸碱度电解质中的湿法蚀刻过程。因此,我们能够首次在PEC蚀
2022-01-24 16:30:31 1662
1662 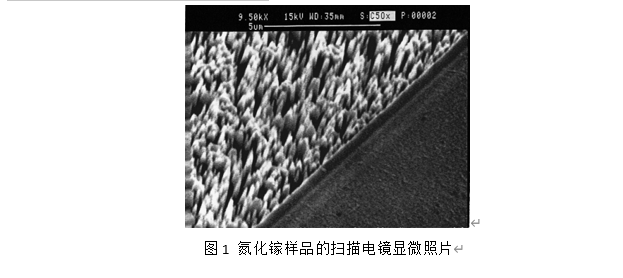
基于HC1的蚀刻剂被广泛应用于InP半导体器件,HC1溶液中其他酸的存在对蚀刻速率有显著影响,然而,InP并不溶在涉及简单氧化剂的传统蚀刻剂中,为了解决溶解机理的问题,我们江苏华林科纳研究了p-InP在不同HC1溶液中的刻蚀作用和电化学反应。
2022-02-09 10:54:58 1600
1600 
我们华林科纳使用K2S2O8作为氧化剂来表征基于KOH的紫外(UV)光辅助湿法蚀刻技术。该解决方案提供了良好控制的蚀刻速率,并产生了光滑的高质量蚀刻表面,同时通过原子力显微镜测量的表面粗糙度降低最小
2022-02-14 16:14:55 1186
1186 
引言 抛光液中的污染物和表面划痕、挖掘和亚表面损伤(固态硬盘)等缺陷是激光损伤的主要前兆。我们提出了在抛光后使用HF/HNO3或KOH溶液进行深度湿法蚀刻,以提高熔融石英光学器件在351 nm波长下
2022-02-24 16:26:03 4173
4173 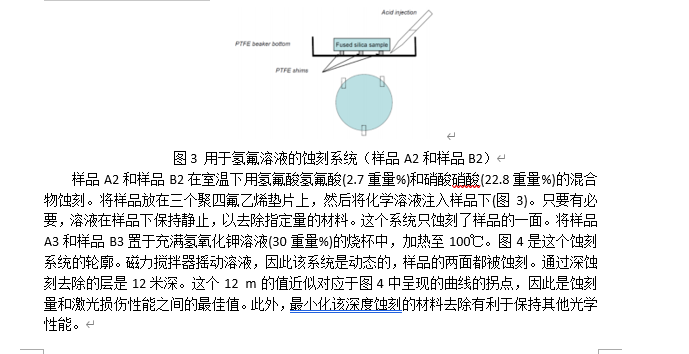
在 KOH 水溶液中进行湿法化学蚀刻期间,硅 (1 1 1) 的绝对蚀刻速率已通过光学干涉测量法使用掩膜样品进行了研究。蚀刻速率恒定为0.62 ± 0.07 µm/h 且与 60 时 1–5 M
2022-03-04 15:07:09 1824
1824 
各向异性蚀刻剂通过掩模中的矩形幵口在(100)硅晶片上产生由( 100)和(111)平面组成的孔。在这种情况下,孔的上角是尖的。如果通过无掩模湿法各向异性蚀刻工艺蚀刻整个表面,则上部拐角变圆。例如
2022-03-07 15:26:14 966
966 
在本文中,我们首次报道了实现硅111和100晶片的晶体蚀刻的酸性溶液。通过使用六氟硅酸(也称为氟硅酸)和硝酸的混合物,获得暴露出各种面外111平面的硅111的晶体蚀刻。本文描述了用于该研究的溶液的化学组成,随后是使用电子和光学显微镜获得的结果。蚀刻的机理,虽然没有完全理解,将在下面的章节中讨论。
2022-03-09 14:35:42 1074
1074 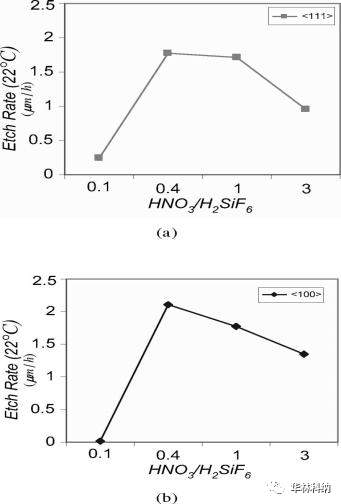
本文研究了KOH基溶液中AIN的湿式化学蚀刻与蚀刻温度和材料质量的关系。这两种材料的蚀刻速率都随着蚀刻温度的增加而增加,从20~80°C不等。通过在1100°C下快速热退火,提高了反应性溅射制备
2022-03-09 14:37:47 815
815 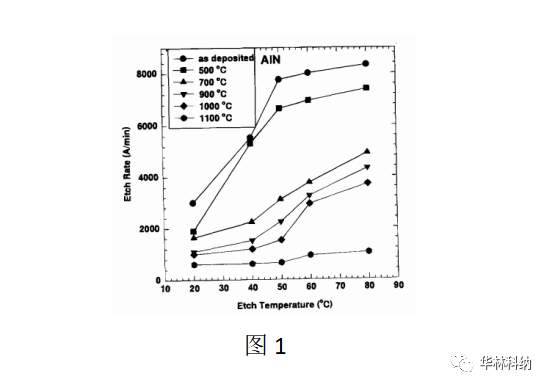
高度光滑表面光洁度的45个反射镜。在这项工作中,我们使用了一种CMOS兼容的各向异性蚀刻剂,含有四甲基氢氧化铵(TMAH)和少量(0.1% v/v)的非离子表面活性剂(NC-200),含有100%的聚氧
2022-03-14 10:51:42 1371
1371 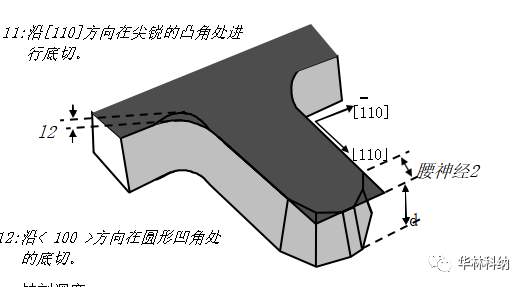
本文研究了用金刚石线锯切和标准浆料锯切制成的180微米厚5英寸半宽直拉单晶硅片与蚀刻时间的关系,目的是确定FAS晶片损伤蚀刻期间蚀刻速率降低的根本原因,无论是与表面结构相关,缺陷相关,由于表面存在的氧化层,还是由于有机残差。
2022-03-16 13:08:09 1159
1159 
实验研究了预清洗对KOH/IPA溶液中单晶硅表面纹理化的影响。如果没有适当的预清洗,表面污染会形成比未污染区域尺寸小的金字塔,导致晶片表面纹理特征不均匀,晶片表面反射率不均匀。根据供应商的不同,晶片的表面质量和污染水平可能会有所不同,预清洗条件可能需要定制,以达到一致和期望的纹理化结果。
2022-03-17 15:23:08 999
999 本文我们华林科纳半导体有限公司研究了类似的现象是否发生在氢氧化钾溶液中添加的其他醇,详细研究了丁基醇浓度对(100)和(110)Si平面表面形貌和蚀刻速率的影响,并给出了异丙醇对氢氧化钾溶液的蚀刻结果,为了研究醇分子在蚀刻溶液中的行为机理,我们还对溶液的表面张力进行了测量。
2022-03-18 13:53:01 769
769 
使用酸性或氟化物溶液对硅表面进行湿蚀刻具有重大意义,这将用于生产微电子包装所需厚度的可靠硅芯片。本文研究了湿蚀刻对浸入48%高频/水溶液中的硅片厚度耗散、减重、蚀刻速率、表面形貌和结晶性
2022-03-18 16:43:11 1211
1211 
在本研究中,我们研究了碱性后刻蚀表面形貌对p型单晶硅片少子寿命的影响,在恒温下分别使用30%和23%的氢氧化钠和氢氧化钾溶液,表面状态通过计算算术平均粗糙度(Ra)和U-V-可见光-近红外光学反射率
2022-03-21 13:16:47 1326
1326 
通过电位学和电位步测量,研究了氢氧化钾溶液中(100)和(111)电极的电化学氧化和钝化过程。在不同的表面之间观察到显著的差异,对n型和p型电极的结果进行比较,得出碱性溶液中硅的电化学氧化必须
2022-03-22 15:36:40 1282
1282 
在本文章中,研究了球形试样的尺寸参数,以确定哪种尺寸允许可靠地测量各向异性蚀刻中的方向依赖性,然后进行了一系列的实验,测量了所有方向的蚀刻速率。这导致建立了一个涵盖广泛的氢氧化钾蚀刻条件范围的蚀刻
2022-03-22 16:15:00 966
966 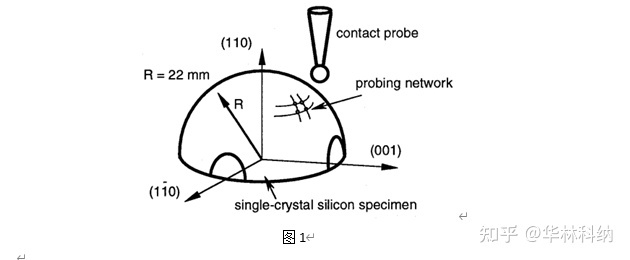
为了形成膜结构,单晶硅片已经用氢氧化钾和氢氧化钾-异丙醇溶液进行了各向异性蚀刻,观察到蚀刻速率强烈依赖于蚀刻剂温度和浓度,用于蚀刻实验的掩模图案在硅晶片的主平面上倾斜45°。根据图案方向和蚀刻剂浓度
2022-03-25 13:26:34 4201
4201 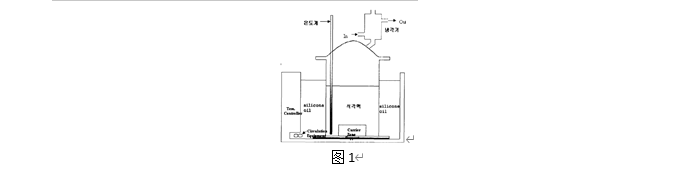
(AFM)。通过与粉末状氧化物(Ga2O3、As2O3 和 As2O5)相比,振动和 XPS 光谱中存在的表面氧化物导致的不同特征的分配。这里描述的蚀刻程序,即,使用低浓度 HF 溶液的那些,大大减少了砷氧化物 (100) 表面中存在的砷氧化物和脂肪族污染物的数量,并完全去除了氧化镓。
2022-03-31 14:57:03 1412
1412 
本研究根据蚀刻条件的变化,对蚀刻特性——蚀刻率和蚀刻系数进行了球面分析,并使用速度、液滴大小、冲击力(PDA)系统分析了喷嘴、喷射压力、线短距离、工质物性值变化时的喷雾特性,并考察了与蚀刻特性的相互关系。
2022-04-07 16:16:39 907
907 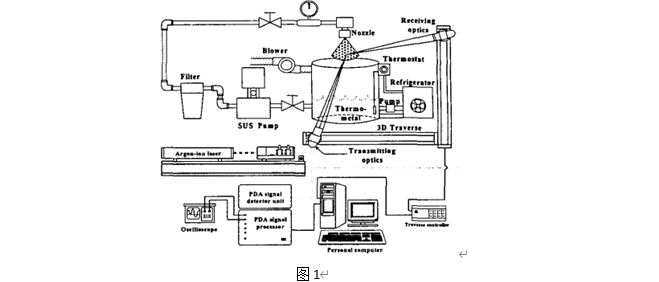
共有旋转轴的多片晶片在蚀刻溶液中旋转,通过化学反应进行蚀刻的表面处理。在化学处理之后,晶片的平坦度,因此为了控制作为旋转圆板的晶圆周边的蚀刻溶液的流动,实际上进行了各种改进。例如图1所示的同轴旋转的多个圆板
2022-04-08 17:02:10 2777
2777 
旋转轴的多片晶片在蚀刻溶液中旋转,通过化学反应进行蚀刻的表面处理。在化学处理之后,晶片的平坦度,因此为了控制作为旋转圆板的晶圆周边的蚀刻溶液的流动,实际上进行了各种改进。例如图1所示的同轴旋转的多个圆板的配置为基础,旋转圆板和静止圆板交替配置等。
2022-04-12 15:28:16 1531
1531 
本研究根据蚀刻条件的变化,对蚀刻特性——蚀刻率和蚀刻系数进行了球面分析,并使用速度、液滴大小、冲击力(PDA)系统分析了喷嘴、喷射压力、线短距离、工质物性值变化时的喷雾特性,并考察了与蚀刻特性的相互关系。
2022-04-14 14:02:00 877
877 
浓度观察到不同的蚀刻特性,当氢氧化钾浓度固定为20wt%时,在80℃以上的蚀刻温度下观察到U形槽的蚀刻形状,在80℃以下观察到V形槽的蚀刻形状,蚀刻硅表面产生的小丘随着蚀刻剂温度和浓度的增加而减少。 为了了解单晶硅的KOH溶液和K
2022-05-05 16:37:36 4132
4132 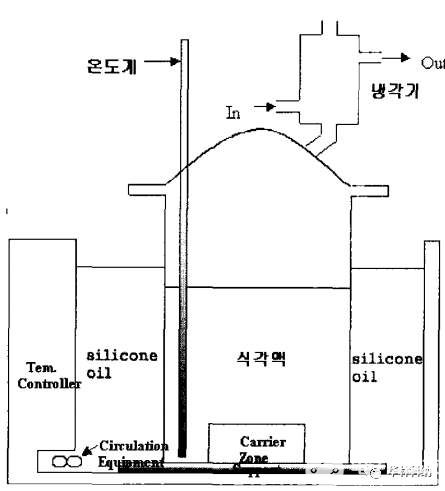
本文提出了一种将垂直氮化镓鳍式场效应晶体管中的鳍式沟道设计成直而光滑的沟道侧壁的新技术。因此,详细描述了在TMAH溶液中的氮化镓湿法蚀刻;我们发现m-GaN平面比包括a-GaN平面在内的其他取向
2022-05-05 16:38:03 2538
2538 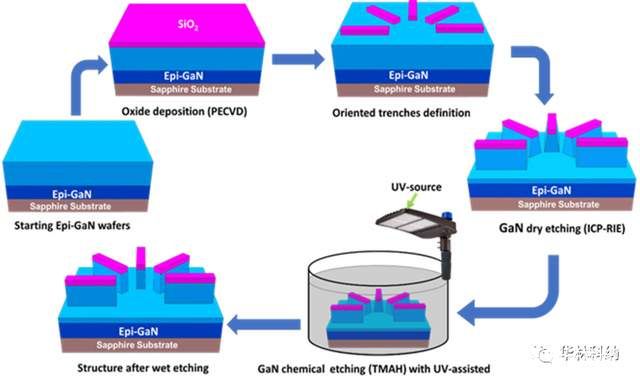
速度快,而各向同性蚀刻(如HF)会向所有方向侵蚀。使用KOH工艺是因为其在制造中的可重复性和均匀性,同时保持了较低的生产成本。异丙醇(IPA)经常添加到溶液中,以改变从{110}壁到{100}壁的选择性,并提高表面光滑度。
2022-05-09 15:09:20 2627
2627 在本研究中,通过对目标区域的低破坏性扫描和在KOH溶液中的后蚀刻,发展了一种在石英表面产生三维纳米结构的新型纳米加工方法。这种纳米制造方法的能力通过各种纳米结构来展示,包括斜坡、分级阶段和棋盘状图案。在不同温度下测试扫描区域的蚀刻速率。为了制造更深层次的结构,人们尝试在现有的纳米结构上重新制作。
2022-05-13 13:51:35 849
849 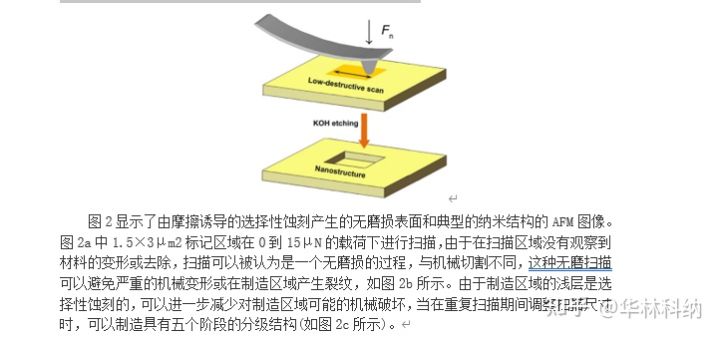
我们华林科纳研究探索了一种新的湿法腐蚀方法和减薄厚度在100 µm以下玻璃的解决方案,为了用低氢氟酸制备蚀刻溶液,使用NH4F或nh4hf 2作为主要成分并加入硫酸或硝酸是有效的,研究了混合酸溶液
2022-05-20 16:20:24 5686
5686 我们华林科纳研究了TMAH溶液中摩擦诱导选择性蚀刻的性能受蚀刻温度、刻蚀时间和刮刻载荷的影响,通过对比试验,评价了硅摩擦诱导的选择性蚀刻的机理,各种表面图案的制造被证明与控制尖端痕迹划伤。 蚀刻时间
2022-05-20 16:37:45 3558
3558 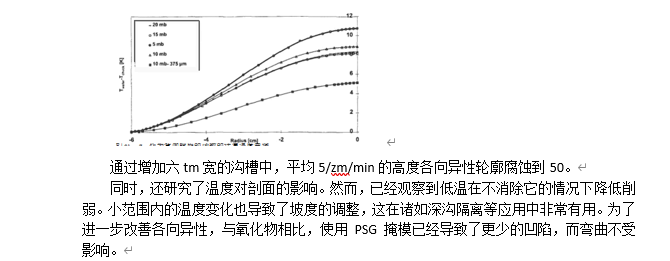
本文讲述了我们华林科纳研究了M111N蚀刻速率最小值的高度,以及决定它的蚀刻机制,在涉及掩模的情况下,M111N最小值的高度可以受到硅/掩模结处的成核的影响,以这种方式影响蚀刻或生长速率的结可以被
2022-05-20 17:12:59 1881
1881 
密度通常随着温度的升高、浓度的降低或通过在小分子大小的弱酸中蚀刻而增加。观察到的多晶ZnO:Al膜的腐蚀趋势在ZnO单晶上得到证实。我们从蚀刻速率和凹坑形成的角度详细讨论了蚀刻过程。根据最近提出的ZnO腐蚀模型解释了结果,并给出了可能的物理解释。
2022-05-23 16:51:23 4747
4747 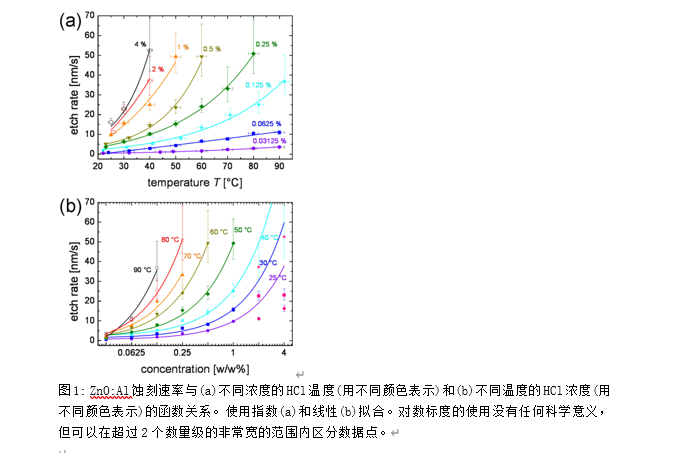
,对于大于1小时的蚀刻时间,处理方案变得复杂和昂贵。我们在此提出蚀刻到超过600微米深的熔融石英中,同时保持衬底没有凹坑并保持适合于生物成像的抛光蚀刻表面。我们使用耐HF的光敏抗蚀剂(HFPR ),它在49%的HF溶液中不会被侵蚀。比较了仅用
2022-05-23 17:22:14 2377
2377 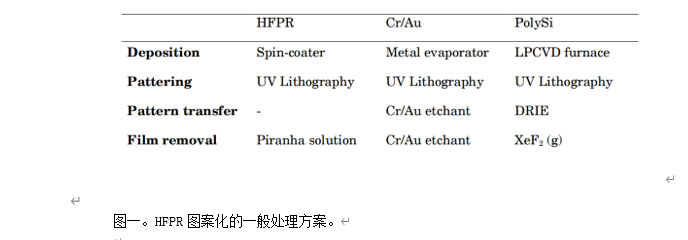
本文介绍了我们华林科纳采用混合酸溶液(H3PO4 : H2SO4 = 1 : 3)和熔融KOH作为湿法腐蚀介质,盐酸作为阳极腐蚀介质,用扫描电镜和透射电镜分别观察了蚀坑和T-Ds。
2022-05-27 16:56:03 1164
1164 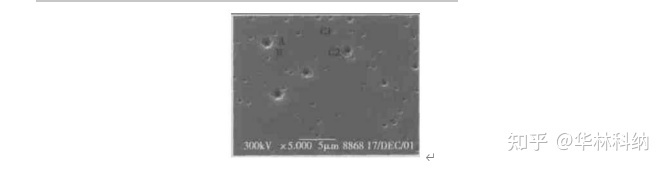
引用 本文介绍了我们华林科纳半导体研究了取向硅在氢氧化钾水溶液中的各向异性腐蚀特性和凸角底切机理。首先,确定控制底切的蚀刻前沿的晶面,并测量它们的蚀刻速率。然后,基于测量数据,检验了凸角补偿技术
2022-06-10 17:03:48 2252
2252 
在本研究中,我们华林科纳研究了在液晶显示(LCD)技术中常用的蚀刻剂中相同的ITO薄膜的蚀刻速率,保持浴液温度恒定,并比较了含有相同浓度的酸的溶液,对ITO在最有趣的解决方案中的行为进行了更详细的研究,试图阐明这些浴液中的溶解机制。
2022-07-04 15:59:58 2966
2966 
在半导体湿法蚀刻中, 热磷酸广泛地用于对氮化硅的去除工艺, 实践中发现温下磷酸对氮化硅蚀刻率很难控制。 从热磷酸在氮化硅湿法蚀刻中的蚀刻原理出发, 我们华林科纳分析了影响蚀刻率的各个因素, 并通过
2022-08-30 16:41:59 7112
7112 
过去利用碱氢氧化物水溶液研究了硅的取向依赖蚀刻,这是制造硅中微结构的一种非常有用的技术。以10M氢氧化钾(KOH)为蚀刻剂,研究了单晶硅球和晶片的各向异性蚀刻过程,测量了沿多个矢量方向的蚀刻速率,用单晶球发现了最慢的蚀刻面。英思特利用这些数据,提出了一种预测不同方向表面的倾角的方法
2023-05-29 09:42:40 3202
3202 
,虽然已经发现KOH基溶液可以蚀刻AlN和InAlN,但是之前还没有发现能够蚀刻高质量GaN的酸或碱溶液。在本文中,英思特通过使用乙二醇而不是水作为KOH和NaOH的溶剂,开发了一种将晶体表面蚀刻为III族氮化物的两步法。
2023-11-24 14:10:30 2150
2150 
由于其独特的材料特性,III族氮化物半导体广泛应用于电力、高频电子和固态照明等领域。加热的四甲基氢氧化铵(TMAH)和KOH3处理的取向相关蚀刻已经被用于去除III族氮化物材料中干法蚀刻引起的损伤,并缩小垂直结构。
2023-11-30 09:01:58 1043
1043 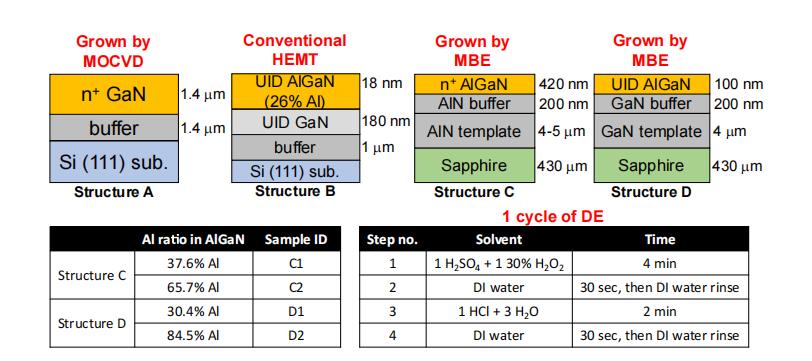
芯片湿法蚀刻工艺是一种在半导体制造中使用的关键技术,主要用于通过化学溶液去除硅片上不需要的材料。 基本概念 湿法蚀刻是一种将硅片浸入特定的化学溶液中以去除不需要材料的工艺,广泛应用于半导体器件如芯片
2024-12-27 11:12:40 1538
1538 (如HF、H₂SO₄)或碱性蚀刻液(KOH、TMAH)作为腐蚀介质,通过电化学作用溶解目标金属材料。例如,在铝互连工艺中,磷酸基蚀刻液能选择性去除铝层而保持下层介
2025-09-25 13:59:25 951
951 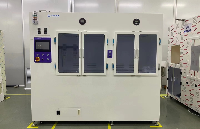
晶圆蚀刻过程中确实可能用到硝酸钠溶液,但其应用场景较为特定且需严格控制条件。以下是具体分析:潜在作用机制氧化性辅助清洁:在酸性环境中(如与氢氟酸或硫酸混合),硝酸钠释放的NO₃⁻离子可作为强氧化剂
2025-10-14 13:08:41 203
203 
(0.1 μm) 单片设备:适用于高精度需求(如FinFET结构),避免批次间污染,但产能较低 环保与安全注意事项 废液处理: KOH废液需中和至pH 6-9后排放,避免碱性污染。 防护措施:操作时需穿戴防化服、护目镜,防止KOH溶液灼伤皮肤。 四、案例参考: 某
2025-12-23 16:21:59 46
46 
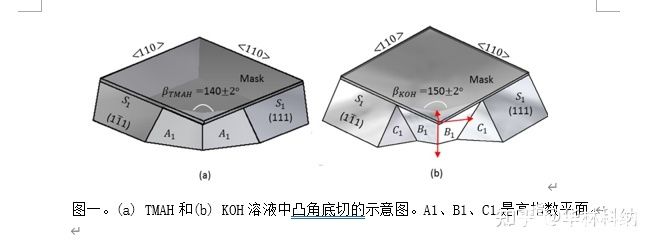



 电子发烧友App
电子发烧友App









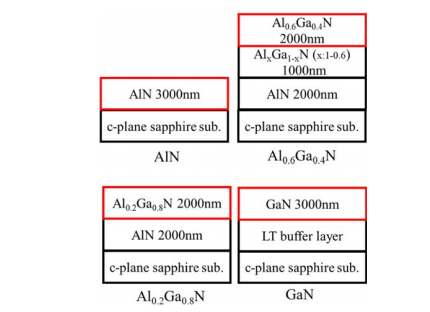
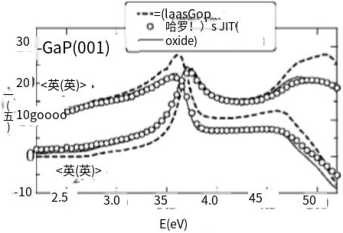
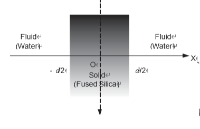






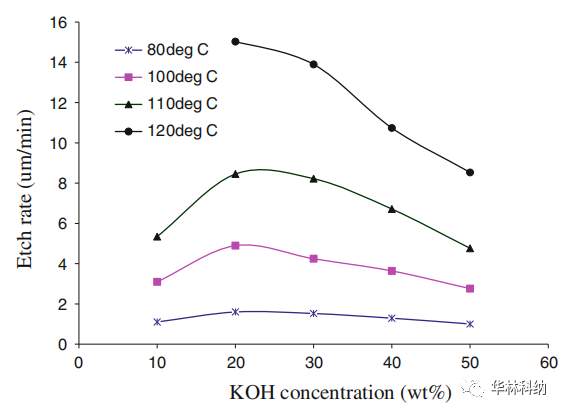



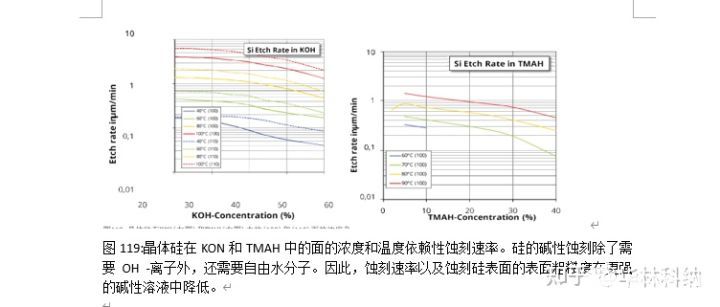

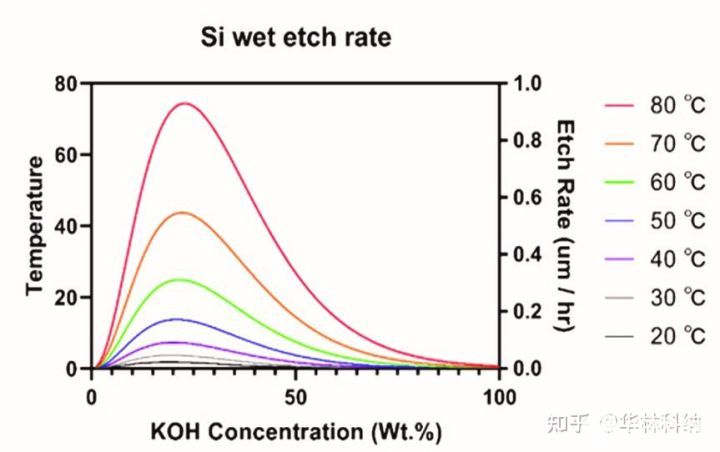
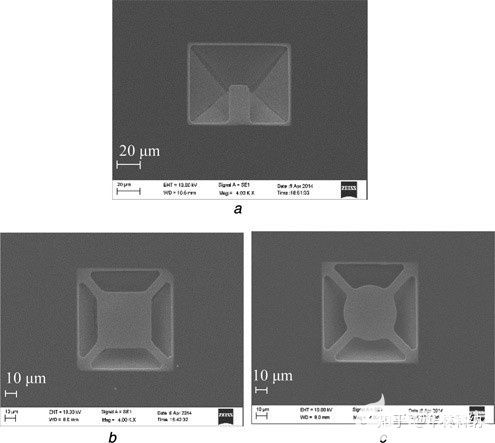

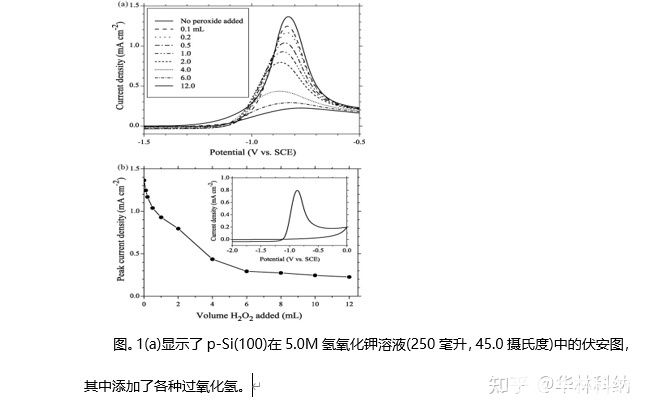
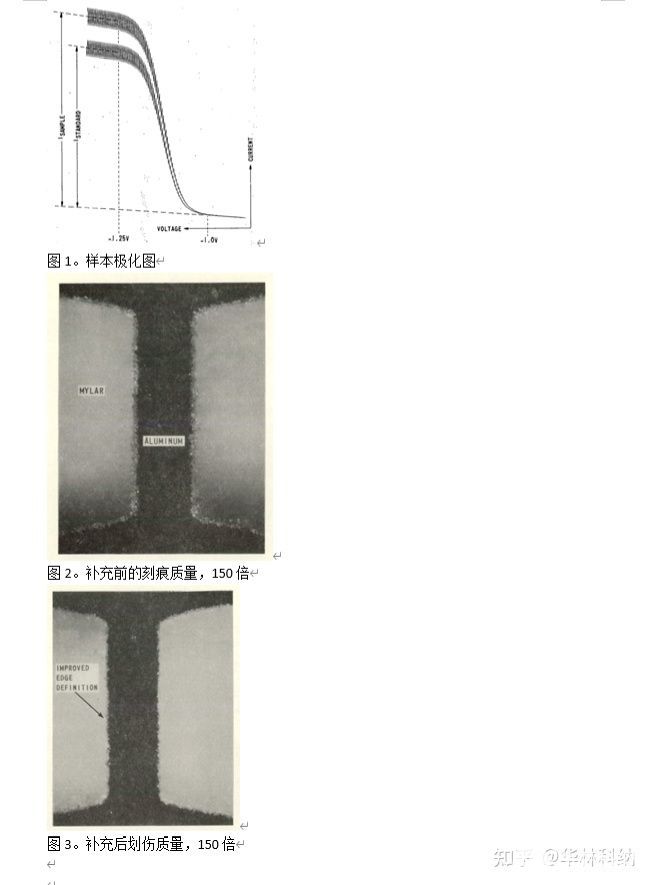



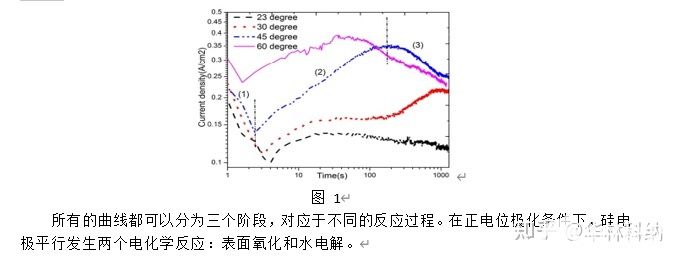
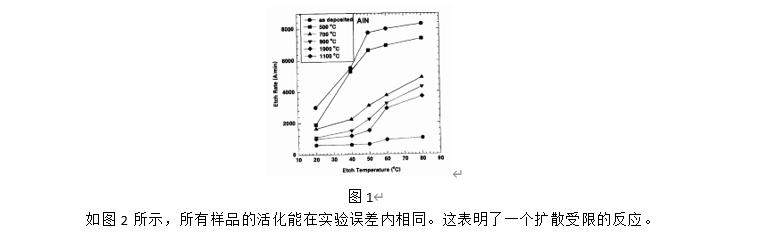

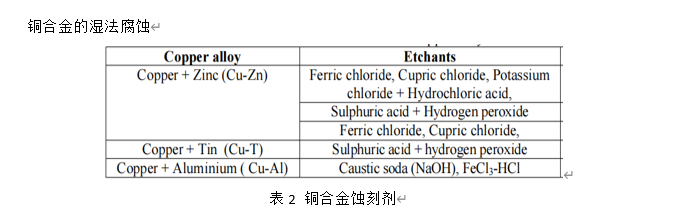

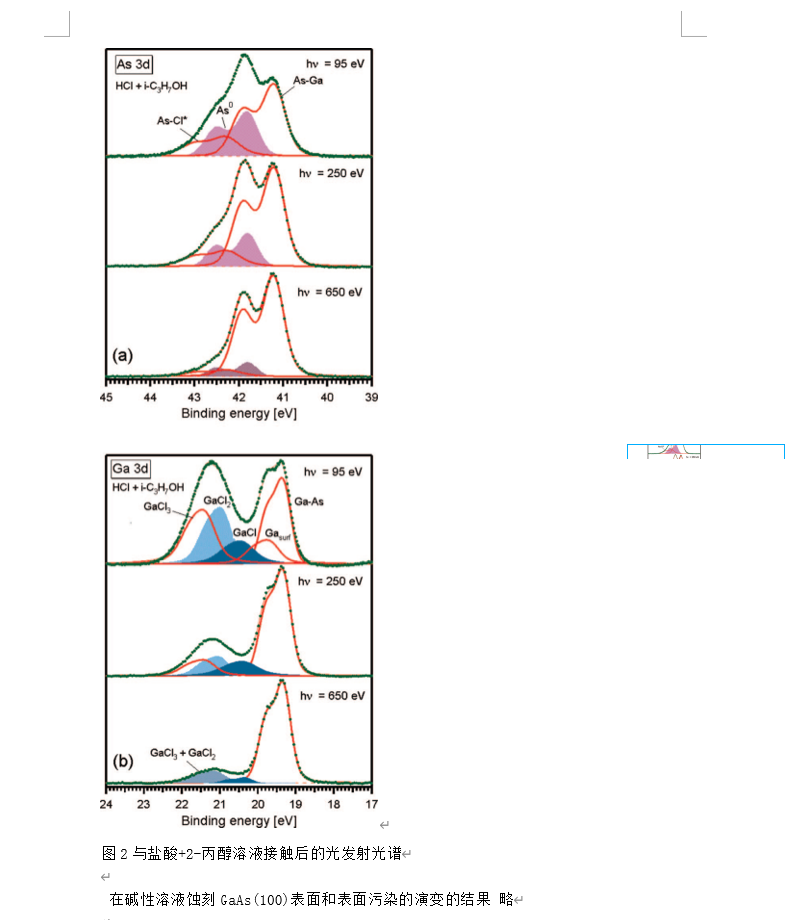

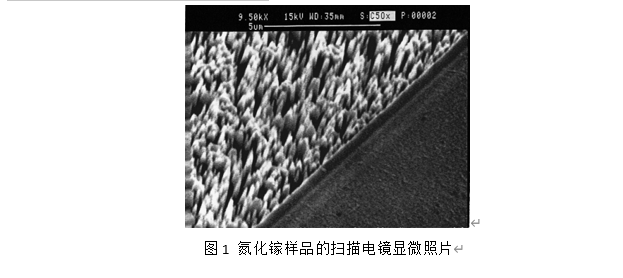


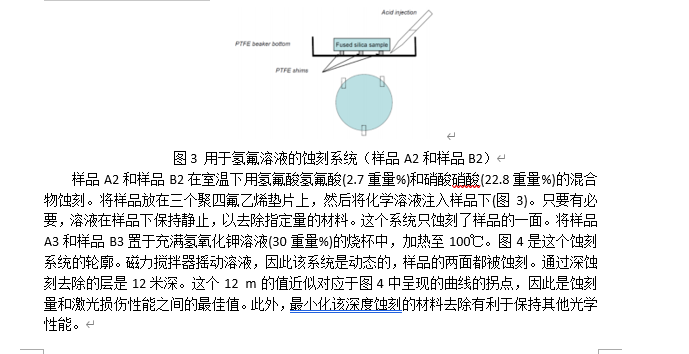


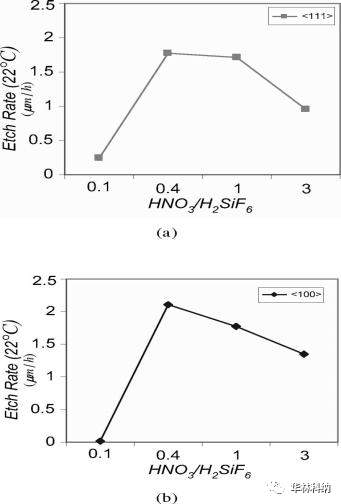
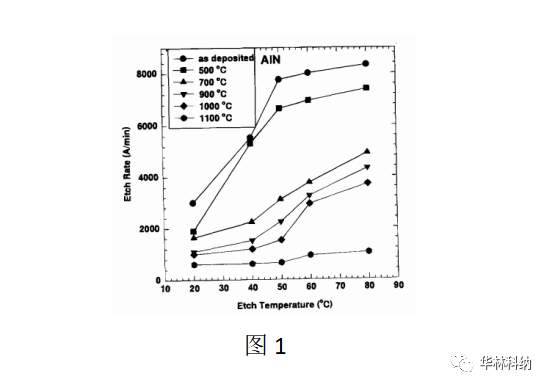
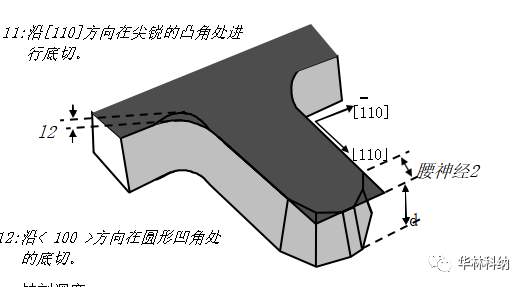





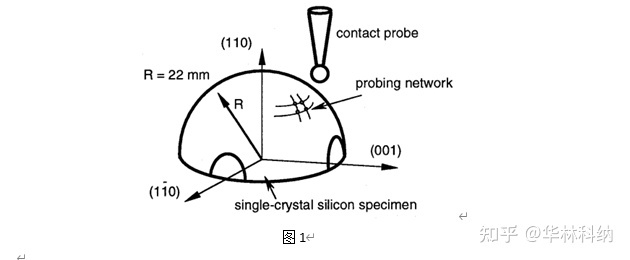
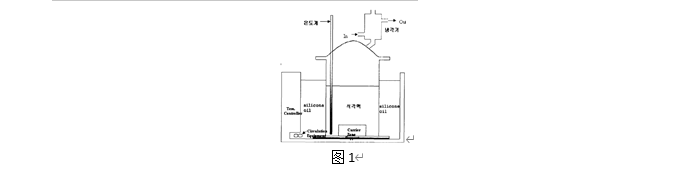

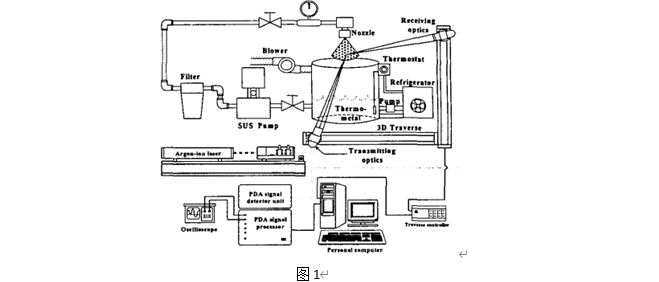



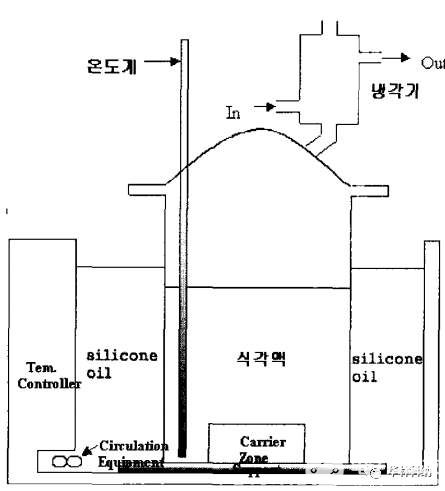
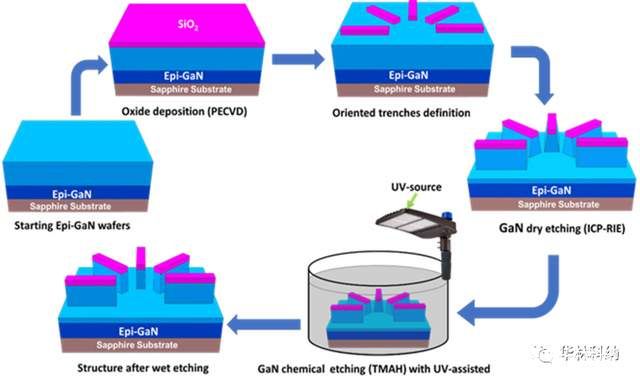
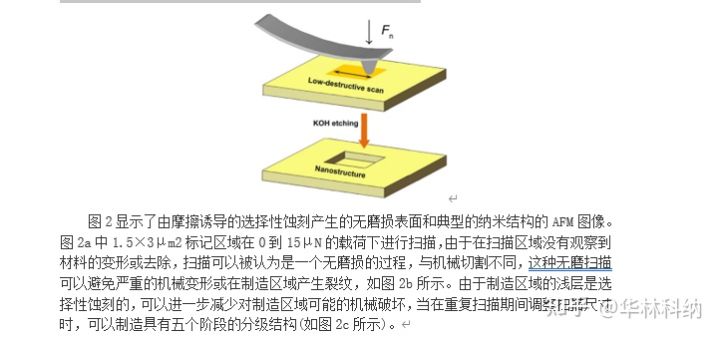
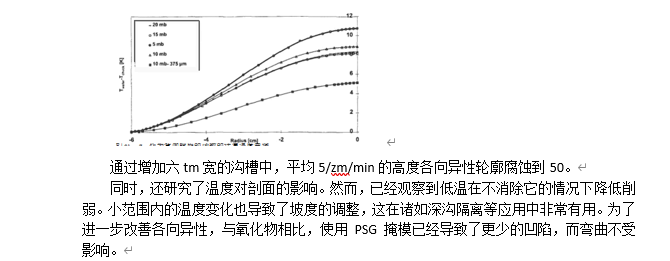

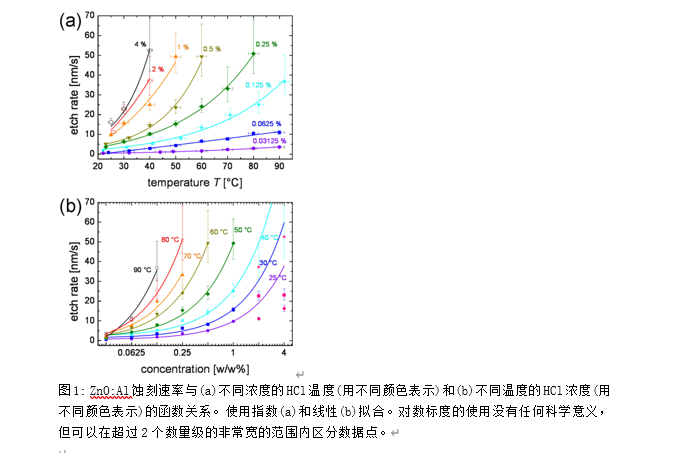
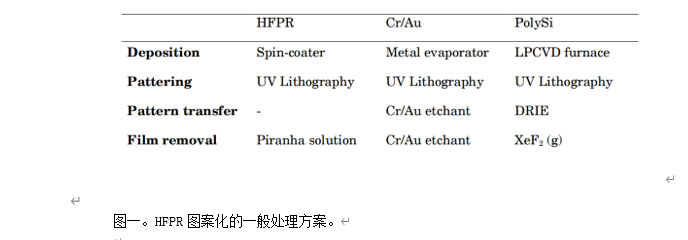
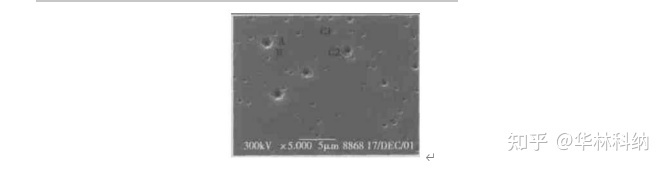





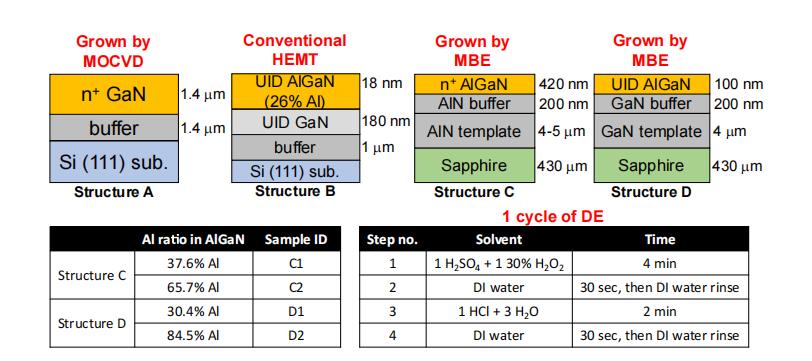
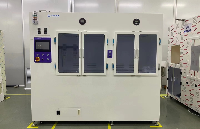





评论