引言 椭偏光谱(SE)、原子力显微镜(AFM)、X射线光电子能谱(XPS)、润湿性和光致发光(PL)测量研究了HF水 溶液中化学清洗的GaP(OOl)表面。SE数据清楚地表明,溶液在浸入样品后(W1
2021-12-22 17:30:40 2639
2639 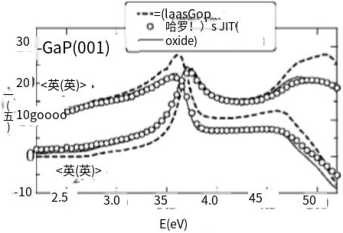
陶瓷在内的大量固体废物的排放,自然资源和填埋场的枯竭正成为一个严重的问题。为了解决这些问题,有必要为这些陶瓷开发一个回收系统。然而,精细陶瓷回收的研究和开发还没有进行。 实验 si3n 4陶瓷的水热处理使用在JFCC,通过添
2021-12-23 16:39:45 2262
2262 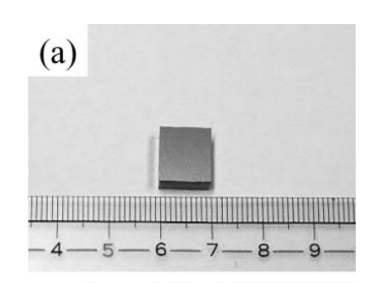
集成电路制造的一个基本步骤。Mat和Looney~研究了二氧化硅在高频溶液中的蚀刻速率作为浓度、温度、氧化物生长过程和溶液搅拌的函数。 介绍 稀释度高频解中的平衡点 在稀高频溶液中,高频=H++F([3]HF+F-=;对于平衡常数(反应r~和r2的1和K2,其值分别为6.8510 4 工具
2021-12-31 11:08:01 5943
5943 
划分为与晶体表面的不同状态和各种蚀刻机制相对应的部分。蚀刻后的晶体表面的形状与同一溶液中沿同一方向蚀刻的凹槽的轮廓密切相关。 介绍 本文研究(100)砷化镓在硫酸、过氧化氢和水溶液中的化学蚀刻具有重要的技术和科学意义。该解决方案通常用于
2022-01-25 10:32:24 3235
3235 
硅的各向异性蚀刻是指定向依赖的蚀刻,通常通过碱性蚀刻剂如水溶液氢氧化钾,TMAH和其他羟化物如氢氧化钠。由于蚀刻速率对晶体取向、蚀刻剂浓度和温度的强烈依赖性,可以以高度可控和可重复的方式制备多种硅
2022-03-08 14:07:25 2479
2479 
本文研究了硅的氧化物和氮化物的气相氟化氢蚀刻作用,新的氧化物选择性模式,概述了通过将无水高频与控制量的水蒸汽混合而产生高频蒸汽蚀刻剂的实现方法,描述了一种通过将氮气通过高频水溶液而引入高频蒸汽的系统。
2022-04-11 16:41:19 1960
1960 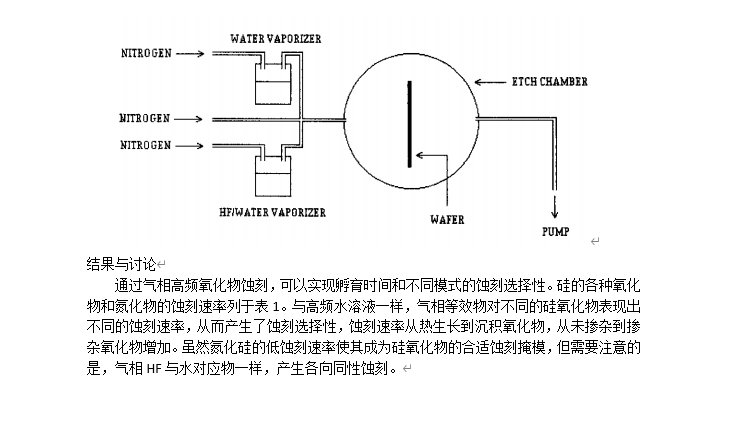
在湿法各向异性蚀刻中,底切凸角的蚀刻轮廓取决于蚀刻剂的类型。已经进行了大量的研究来解释这种凸角底切并确定底切平面的方向。然而,还不清楚为什么不同蚀刻剂会出现不同形状的底切前沿。
2022-05-24 14:27:26 3001
3001 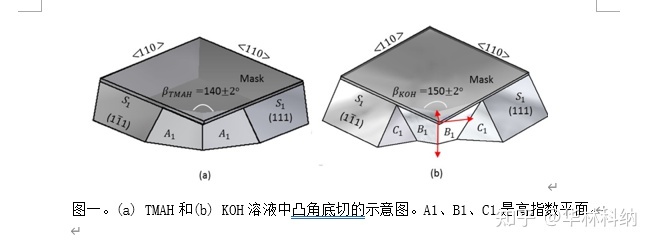
本文描述了我们华林科纳用于III族氮化物半导体的选择性侧壁外延的具有平面侧壁刻面的硅微米和纳米鳍的形成。通过湿法蚀刻取向的硅晶片生产鳍片。使用等离子体增强化学气相沉积来沉积二氧化硅,以产生硬掩模
2022-07-08 15:46:16 2154
2154 
反应离子蚀刻 (RIE)是一种干法蚀刻工艺,与半导体工业中使用的互补金属氧化物半导体(CMOS)方法兼容。
2023-04-14 14:26:16 2584
2584 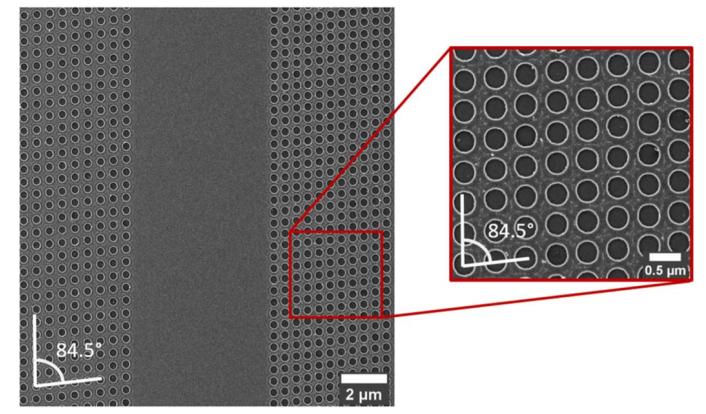
需要全部蚀刻,而留下的另一层就是电路。蚀刻的方法,我们主要讨论化学方法,主要分为浸渍蚀刻、搅拌蚀刻以及喷射蚀刻。浸渍蚀刻就是把线路板进入容器中,容器中盛有蚀刻药液。这种蚀刻方法比较慢,而且会存在凹陷
2017-02-21 17:44:26
为了在基板上形成功能性的MEMS结构,必须蚀刻先前沉积的薄膜和/或基板本身。通常,蚀刻过程分为两类:浸入化学溶液后材料溶解的湿法蚀刻干蚀刻,其中使用反应性离子或气相蚀刻剂溅射或溶解材料在下文中,我们将简要讨论最流行的湿法和干法蚀刻技术。
2021-01-09 10:17:20
连续再生循环使用,成本低。 2.蚀刻过程中的主要化学反应在氯化铜溶液中加入氨水,发生络合反应:CuCl2+4NH3 →Cu(NH3)4Cl2在蚀刻过程中,板面上的铜被[Cu(NH3)4]2+络离子氧化
2018-02-09 09:26:59
蚀问题,蚀刻后的导线侧壁接近垂直。 3)温度:温度对蚀刻液特性的影响比较大,通常在化学反应过程中,温度对加速溶液的流动性和减小蚀刻液的粘度,提高蚀刻速率起着很重要的作用。但温度过高,也容易引起蚀刻液
2018-09-11 15:19:38
中的氨(NH3)来决定。因此用新鲜溶液与蚀刻表面作用,其目的主要有两个:一是冲掉刚刚产生的铜离子;二是不断提供进行反应所需要的氨(NH3)。 在印制电路工业的传统知识里,特别是印制电路原料的供应商
2018-11-26 16:58:50
的规定或适当降低抽风量执行。 (3)按工艺要求排放出部分比重高的溶液经分析后补加氯化铵和氨的水溶液,使蚀刻液的比重调整到工艺充许的范围。 3.问题:印制电路中金属抗蚀镀层被浸蚀 原因: (1
2018-09-19 16:00:15
所有其它参数不变,那么蚀刻速率主要由蚀刻液中的氨(NH3)来决定。因此用新鲜溶液与蚀刻表面作用,其目的主要有两个:一是冲掉刚刚产生的铜离子;二是不断提供进行反应所需要的氨(NH3)。 在印制电路工业
2018-09-13 15:46:18
重要材料的湿法腐蚀,即氧化锌、氮化镓和碳化硅。虽然氧化锌很容易在许多酸溶液中蚀刻,包括硝酸/盐酸和氢氟酸/硝酸,在非酸性乙酰丙酮中,第三族氮化物和碳化硅很难湿法蚀刻,通常使用干法蚀刻。已经研究了用于氮化
2021-10-14 11:48:31
常见的加工方法进行。对于我们的第一步,我们使用了几种不同的处理方法,包括氯基等离子体中的反应离子蚀刻、KOH 溶液中的 PEC 蚀刻和切割。第二步是通过浸入能够在晶体学上蚀刻 GaN 的化学品中完成
2021-07-07 10:24:07
过程具有反应受限的性质。HClH3PO4:H2O2 蚀刻剂是 HCl 和 H2O2 在 H3PO4 中的非水溶液溶剂。作为氧化剂的H2O2起着非常重要的作用。单独的盐酸,不含 H2O2,不会侵蚀 GaAs
2021-07-09 10:23:37
问题,因为涉及的损害很低。此外,它们比干法蚀刻方法更便宜且不复杂。另一个重要的优点是湿法蚀刻可以选择性地去除不同的材料。本文介绍了n型氮化镓在几种电解质水溶液中(光)电化学行为的基础研究结果,以及在
2021-10-13 14:43:35
氟化氢 (HF))的混合溶液中,使用贵金属(例如 Au、Ag 或 Pt)蚀刻其下方的硅。1,3图1描绘了MacEtch过程的示意图。图 2 显示了 MacEtch 工艺流程。从图 1 中可以看出,通过
2021-07-06 09:33:58
,那么蚀刻速率主要由蚀刻液中的氨(NH3)来决定。因此用新鲜溶液与蚀刻表面作用,其目的主要有两个:一是冲掉刚刚产生的铜离子;二是不断提供进行反应所需要的氨(NH3)。在印制电路工业的传统知识里,特别是
2018-04-05 19:27:39
典型的硅刻蚀是用含氮的物质与氢氟酸的混合水溶液。这一配比规则在控制刻蚀中成为一个重要的因素。在一些比率上,刻蚀硅会有放热反应。加热反应所产生的热可加速刻蚀反应,接下来又产生更多的热,这样进行下去会
2018-12-21 13:49:20
的关系 在蚀刻过程中,蚀刻液中的反应离子是通过流体运动,扩散运动达到露铜箔的表面并与铜发生化学反应的。流体运动的速度与扩散层的厚度决定着反应的速率。在流体运动时,其受到铜箔表面流体的阻力f作用。根据
2018-09-10 15:56:56
x500) mm 的板子。在印制电路板制作中,在第二个蚀刻周期前放置板子的架子可以旋转180° ,此外还提供了一个刷洗槽以冲洗蚀刻后的板子。这套设备蚀刻的极子走线分辨率可达小于(大于?)0. 1mm ,而且在新的FeCI3蚀刻溶液中其蚀刻速度只能达到90s 。
2018-09-11 15:27:47
P FIB 与DB FIB师出同源,最大差异在离子源与蚀刻效率。DB FIB的离子源Ga+容易附着在样品表面,P FIB使用Xe可减少样品Ga污染问题。P FIB可大范围面积快速执行,蚀刻速率提升20倍。
2019-08-15 15:57:55
﹐就是尽速让金属表面不断地接触新鲜的蚀刻液。 在氨性蚀刻中﹐假定所有参数不变﹐那么蚀刻的速率将主要由蚀刻液中的氨(NH3)来决定。因此, 使用新鲜溶液与蚀刻表面相互作用﹐其主要目的有两个﹕冲掉刚产生的铜
2017-06-23 16:01:38
怎么用LABVIEW索引出对应温度(列)和体积浓度(行,百分比)下的乙二醇水溶液的密度(中间的数值)
2017-08-12 20:41:36
,LiNbO3材料,频谱仪,线圈等。实验内容:提出了一款工作在45kHz的压电天线。分析压电天线的远场磁感应强度和辐射效率的理论计算公式,并通过在COMSOL中仿真不同压电材料,不同圆柱体尺寸、不同镀金厚度
2021-11-10 08:00:00
适当的清洁或对溶液进行补加。 蚀刻过程中应注意的问题 减少侧蚀和突沿﹐提高蚀刻系数 侧蚀会产生突沿。通常印制板在蚀刻液中的时间越长,侧蚀的情况越严重。侧蚀将严重影响印制导线的精度,严重的侧蚀将不
2017-06-24 11:56:41
。2.克升浓度计算: 定义:一升溶液里所含溶质的克数。 举例:100克硫酸铜溶于水溶液10升,问一升浓度是多少? 100/10=10克/升3.重量百分比浓度计算 (1)定义:用溶质的重量占全部溶液
2018-08-29 10:20:51
速率主要由蚀刻液中的氨(NH3)来决定。因此用新鲜溶液与蚀刻表面作用,其目的主要有两个:一是冲掉刚刚产生的铜离子;二是不断提供进行反应所需要的氨(NH3)。 在印制电路工业的传统知识里,特别是
2018-09-19 15:39:21
锌铜电池通常包含两个烧杯、锌片、铜片、盐桥和导线。装置如下图。锌片放出电子变成锌离子,进入溶液中。电子经由外电路到达铜片。铜片的作用只是传递电子给水溶液中的铜离子。
2019-09-10 10:42:39
超声波辐照水溶液时,空化泡在声波的作用下形成、振荡、生长、收缩至崩溃。空化泡崩溃时在空化泡周围的极小空间内可以产生5000K以上的高温和高达5 X 107Pa的高压等极端物理条件
2008-11-24 21:51:53 12
12 分析了厚电极厚缓冲层的共面波导Mach-Zehnder行波电极LiNbO3光调制器,讨论了电极厚度和缓冲层厚度对调制器特性参数的影响,得到了调制器的有效折射率、特征阻抗、半波电压及
2009-02-28 10:36:10 33
33 因产品配置不同, 价格货期需要电议, 图片仅供参考, 一切以实际成交合同为准伯东公司日本原装设计制造离子蚀刻机 IBE. 提供微米级刻蚀, 均匀性: ≤±5%, 满足
2022-11-07 16:27:40
因产品配置不同, 价格货期需要电议, 图片仅供参考, 一切以实际成交合同为准离子蚀刻机 4 IBE伯东公司日本原装进口小型离子蚀刻机, 适用于科研院所
2022-11-07 16:30:42
因产品配置不同, 价格货期需要电议, 图片仅供参考, 一切以实际成交合同为准伯东公司日本原装进口小型离子蚀刻机, 适用于科研院所, 实验室研究, 干式制程的微细加工
2022-11-07 16:38:17
斜辐照激光等离子体辐射X光子特性:在神光Ⅱ高功率激光装置上,实验研究了激光斜辐照形成的激光等离子体辐射X射线光子的特性及真空喷射热等离子体流的方向。采用
2009-10-29 14:11:39 15
15 Eu3 + 掺杂LiNbO3 晶体的变温发射光谱特征
在488 nm 波长光的激发下, 研究了用坩埚下降法生长的掺杂Eu3 + 离子的下部与上部LiNbO3 晶体从77 到600 K的变温发射光谱特征。实
2010-02-22 11:53:54 10
10 摘要 分析了在垂直LiNbO3晶体光轴方向加电压,光沿近光轴方向传播时,入射光偏振方向对电光调制器的影响.通过计算加电场后双折射光程差的变化和偏光振动方向的转动,画出在正交
2010-11-30 13:12:35 23
23 1. 克升浓度计算:
定义:一升溶液里所含溶质的克数。
举例:100克硫酸铜溶于水溶液10升,问一升浓度是多少?
10
2010-10-26 17:33:24 2514
2514 对于我们常用的不可充电的原电池,国际标准IEC 60086-5“原电池—-第5部分:水溶液电解质电池的安全”中就对其安全使用提出了诸多建议。
2012-05-30 15:39:24 1618
1618 铝离子是在化学反应中,铝原子失去电子,从而使参加反应的铝原子带上3个正电荷。带电荷的铝原子叫做铝离子。在弱酸性溶液(加入pH5.0~6.0的缓冲溶液)中,铝离子与过量的EDTA络合,用氯化锌标准溶液滴定过量的EDTA。
2018-02-27 14:41:54 11587
11587 本文主要介绍了配比盐雾试验所用盐水溶液的三种方法。
2018-06-21 12:00:00 0
0 通常所指蚀刻也称腐蚀或光化学蚀刻(photochemicaletching),指通过曝光制版、显影后,将要蚀刻区域的保护膜去除,在蚀刻时接触化学溶液,达到溶解腐蚀的作用,形成凹凸或者镂空成型的效果。
2019-04-25 15:41:36 17776
17776 按工艺要求排放出部分比重高的溶液经分析后补加氯化铵和氨的水溶液,使蚀刻液的比重调整到工艺充许的范围。
2019-06-10 16:31:11 2693
2693 如今,锂离子电池充电越来越快且性能也越来越高,但也越来越昂贵且越来越易燃。
2019-12-21 10:42:55 859
859 内部,正极和负极两个电极浸在液体电解质中。电池充放电时,液体电解质就会传导离子。水溶液电解质因不可燃性而备受关注。而且,在制造过程中,与非水电解质不同,水溶液电解质不易受水分影响,更方便操作,成本更低。对于这种材料来说,最大的挑战在于如何保持性能。
2020-10-29 22:27:00 1472
1472 在压电天线的谐振频率的实测中,利用函数信号发生器发送45 kHz的正弦波,再利用ATA- -2161电压放大器将正弦波的电压幅度放大,将放大的电压输入到LiNbO3晶体两端,再利用接收线圈接收
2021-11-05 16:51:50 3584
3584 我们华林科纳研究了不同醇类添加剂对氢氧化钾溶液的影响。据说醇导致硅蚀刻各向异性的改变。具有一个羟基的醇表现出与异丙醇相似的效果。它们导致(hh 1)型平面的蚀刻速率大大降低,通常在蚀刻凸形图形的侧壁处发展。这就是凸角根切减少的原因。具有一个以上羟基的醇不影响蚀刻各向异性,并导致表面光洁度变差。
2021-12-17 15:27:53 1194
1194 引言 铌酸锂是一种广泛应用于光学和声表面波器件的铁电材料。铌酸锂通常不用于微机电系统(MEMS)应用,部分原因是铌酸锂的体微加工不如与其他材料的加工那样好理解。已经公布了硅和石英对晶体取向的完全蚀刻
2021-12-24 15:43:43 1504
1504 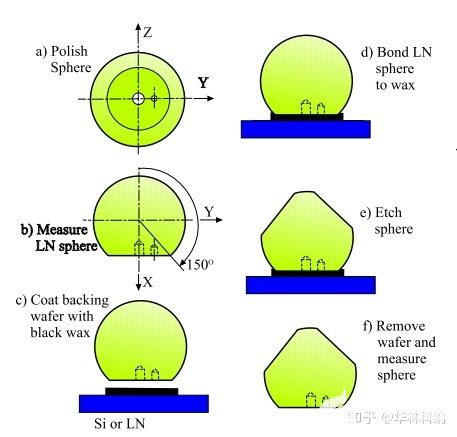
方法。本文结合理论模拟和实验,综合分析了所提出的旋转交换湿蚀刻法的蚀刻结果。发现质子交换层可以很容易地使用氢氟酸/硝酸混合酸蚀刻阻挡层,从而改善提取率和表面形貌。最佳波导的最低粗糙度被测量为0.81毫米,这有利于基
2021-12-24 16:24:52 1107
1107 
引言 我们研究了四种硅在高频水溶液中的阳极电流-电势特性。根据不同电位阳极氧化的样品的表面条件,电流-电位曲线上通常有三个区域:电流随电位指数变化区域的多孔硅形成,恒流区域的硅的电泳抛光,以及
2021-12-28 16:40:16 1563
1563 
引言 到目前为止,GaAs晶片的直接再利用受到晶片表面上的残留物的限制,这些残留物不能利用一般的清洗方法方式去除。因此,用显微技术、轮廓术和x光电子能谱研究了氢氟酸对GaAs晶片的腐蚀。发现在蚀刻
2021-12-28 16:34:37 1396
1396 
上降低了(100)和(h11)面的蚀刻速率。 为了在低氢氧化钾浓度下获得低粗糙度的(100)表面,蚀刻溶液必须含有饱和水平的异丙醇。在我们的研究中,我们研究了异丙醇浓度对具有不同晶体取向的硅衬底的蚀刻速率和表面形态的影响。还研究了氢氧化钾浓度对(
2022-01-13 13:47:26 2752
2752 
HF/HNO 3的溶液中进行酸性蚀刻来实现。酸性溶液各向同性地蚀刻多晶硅晶片,即在所有晶体取向上产生圆形纹理。然而,酸性蚀刻工艺难以控制,并且化学废物的处理昂贵。 为了克服这种对环境有害的酸性蚀刻工艺,同时保持mc-Si晶片
2022-01-13 14:47:19 1346
1346 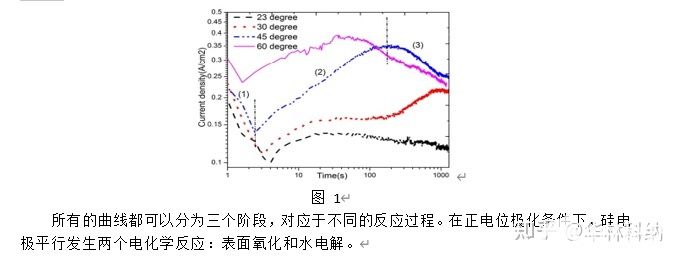
引言 我们华林科纳研究了KOH基溶液中AIN的湿式化学蚀刻与蚀刻温度和材料质量的关系。这两种材料的蚀刻速率都随着蚀刻温度的增加而增加,从20~80°C不等。通过在1100°C下快速热退火,提高了反应
2022-01-17 16:21:48 754
754 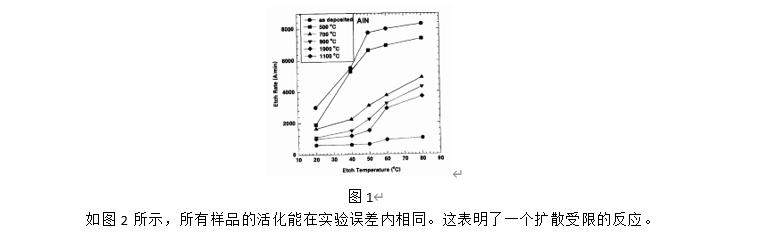
的溶液的化学组成,随后是使用电子和光学显微镜获得的结果。蚀刻的机理,虽然没有完全理解,将在下面的章节中讨论。 氢氟硅酸H2SiF6用于沉积二氧化硅,在二氧化硅中发现其蒸汽含有过量的四氟化钠,四氟化钠与水结合会产生二氧化硅。在更具体的应用中
2022-01-20 16:46:48 1197
1197 
,表面的Ga-As键断裂,元素砷留在砷化镓表面。此外,用盐酸+2-丙醇溶液蚀刻时可以观察到吸附的2-丙醇分子,但用氨水溶液蚀刻时没有检测到吸附的水分子。 介绍 湿式化学蚀刻工艺在器件制造中已被广泛应用。半导体/电解质界面上发生的过程
2022-01-24 15:07:30 2419
2419 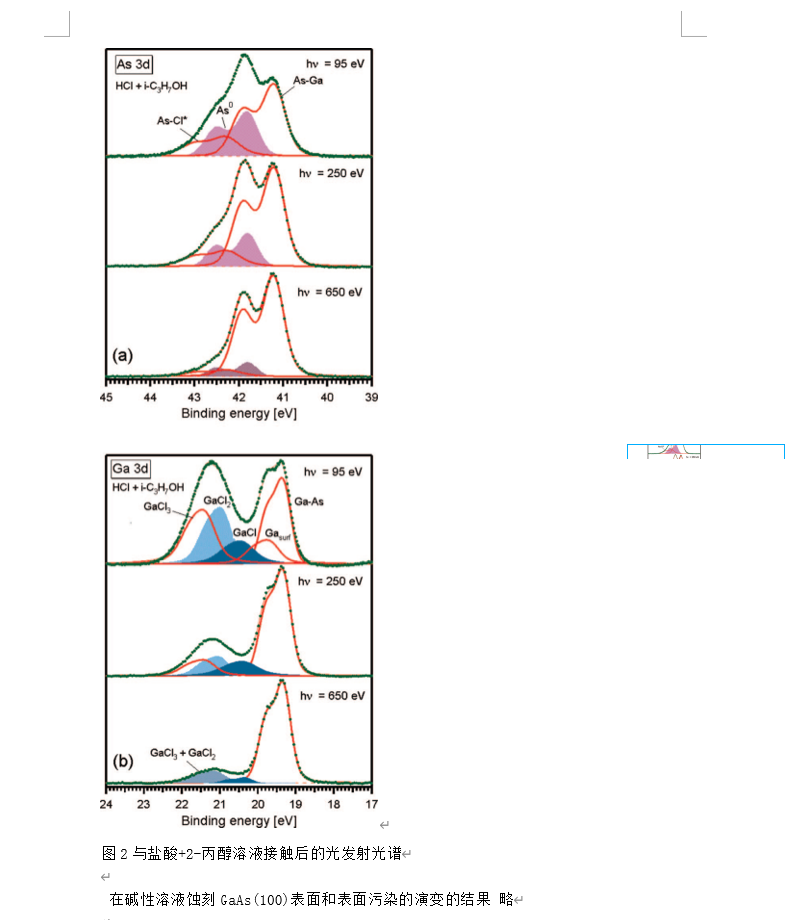
。此外,用离子色谱法测定稀释蚀刻剂溶液中亚硝酸盐离子浓度作为浓缩蚀刻剂中活性NIII的参数,确定了两种不同的蚀刻机制。在亚硝酸盐浓度高的区域,蚀刻速率明显与亚硝酸盐浓度无关。在较低的亚硝酸盐浓度下,蚀刻速率随亚硝酸盐c呈线性
2022-01-24 15:41:13 2458
2458 
本文探讨了紫外辐照对生长在蓝宝石衬底上的非有意掺杂n型氮化镓(GaN)层的湿法化学刻蚀的影响。实验过程中,我们发现氮化镓的蚀刻发生在pH值分别为2-1和11-15的磷酸水溶液和氢氧化钾溶液中。在稀释
2022-01-24 16:30:31 1662
1662 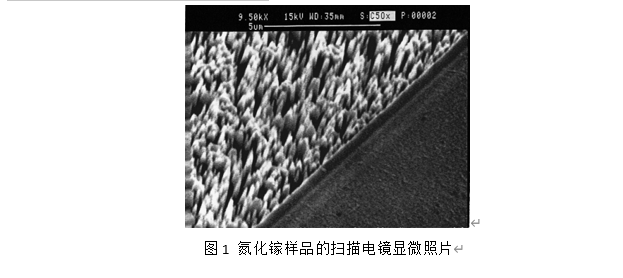
刻蚀电介质(二氧化硅、氮化硅)和晶体硅。论文的第二部分致力于蚀刻ⅲ-ⅴ族化合物半导体,其中基于氮化镓材料的反应离子刻蚀结果,揭示了一种简单实用的热力学方法,解释了选择蚀刻特定材料的最佳化学物质的标准,并解释了氮化镓蚀刻
2022-02-07 14:39:36 2711
2711 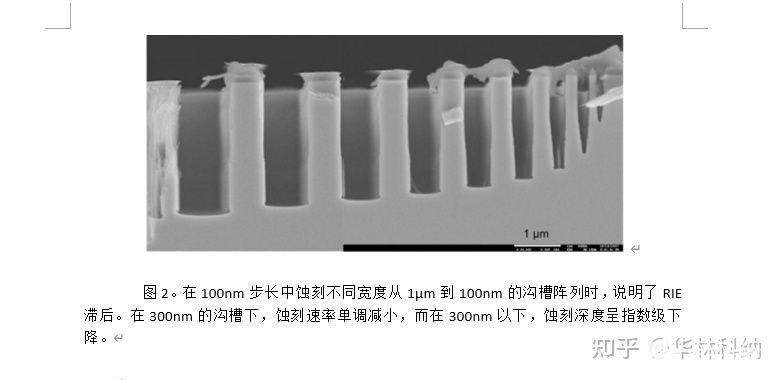
基于HC1的蚀刻剂被广泛应用于InP半导体器件,HC1溶液中其他酸的存在对蚀刻速率有显著影响,然而,InP并不溶在涉及简单氧化剂的传统蚀刻剂中,为了解决溶解机理的问题,我们江苏华林科纳研究了p-InP在不同HC1溶液中的刻蚀作用和电化学反应。
2022-02-09 10:54:58 1600
1600 
引言 抛光液中的污染物和表面划痕、挖掘和亚表面损伤(固态硬盘)等缺陷是激光损伤的主要前兆。我们提出了在抛光后使用HF/HNO3或KOH溶液进行深度湿法蚀刻,以提高熔融石英光学器件在351 nm波长下
2022-02-24 16:26:03 4173
4173 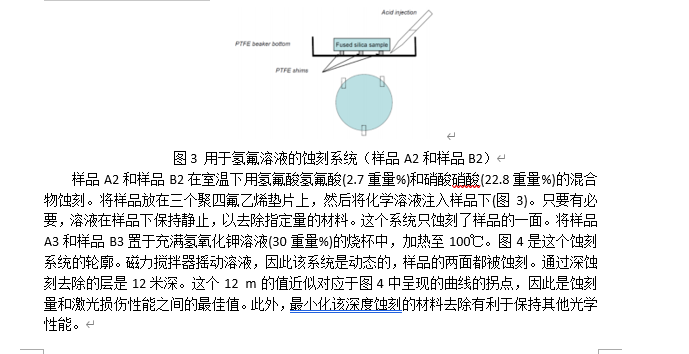
在 KOH 水溶液中进行湿法化学蚀刻期间,硅 (1 1 1) 的绝对蚀刻速率已通过光学干涉测量法使用掩膜样品进行了研究。蚀刻速率恒定为0.62 ± 0.07 µm/h 且与 60 时 1–5 M
2022-03-04 15:07:09 1824
1824 
在高频水溶液中,SiO的蚀刻可以通过电场的应用而被阻碍或停止。在CMOS制造中,非常低水平的光可以导致这种影响。对溶解过程提出了平行反应路径,并加上电场在中间步骤中停止或重定向反应的能力。
2022-03-07 15:28:24 2561
2561 
HF对基片进行了研究,主要分为随机蚀刻和周期性蚀刻。 我们讨论了蚀刻的问题机理、蚀刻速率、硬掩膜材料、周期性光俘获结构。
2022-03-08 11:52:41 1825
1825 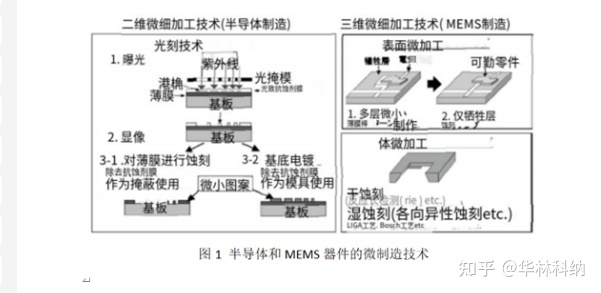
在本文中,我们首次报道了实现硅111和100晶片的晶体蚀刻的酸性溶液。通过使用六氟硅酸(也称为氟硅酸)和硝酸的混合物,获得暴露出各种面外111平面的硅111的晶体蚀刻。本文描述了用于该研究的溶液的化学组成,随后是使用电子和光学显微镜获得的结果。蚀刻的机理,虽然没有完全理解,将在下面的章节中讨论。
2022-03-09 14:35:42 1073
1073 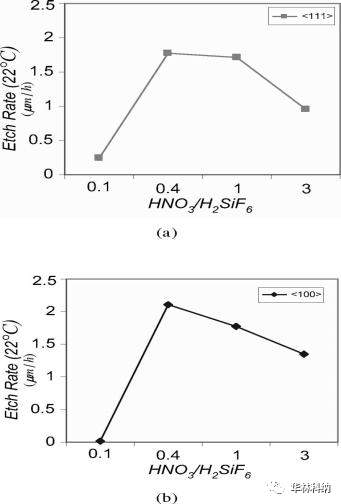
本文研究了KOH基溶液中AIN的湿式化学蚀刻与蚀刻温度和材料质量的关系。这两种材料的蚀刻速率都随着蚀刻温度的增加而增加,从20~80°C不等。通过在1100°C下快速热退火,提高了反应性溅射制备
2022-03-09 14:37:47 815
815 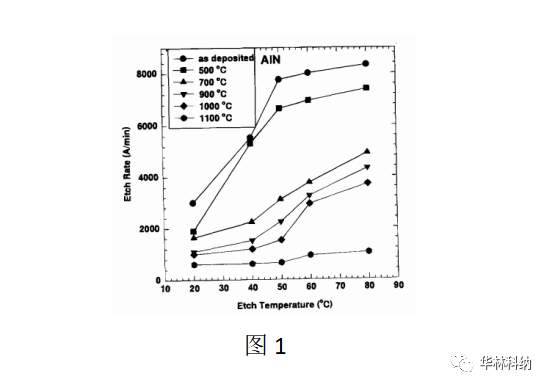
本文研究了用金刚石线锯切和标准浆料锯切制成的180微米厚5英寸半宽直拉单晶硅片与蚀刻时间的关系,目的是确定FAS晶片损伤蚀刻期间蚀刻速率降低的根本原因,无论是与表面结构相关,缺陷相关,由于表面存在的氧化层,还是由于有机残差。
2022-03-16 13:08:09 1159
1159 
本文根据测量的OCP和平带电压,构建了氢氧化钾水溶液中n-St的定量能带图,建立了同一电解质中p-St的能带图,进行了输入电压特性的测量来验证这些能带图,硅在阳极偏置下的钝化作用归因于氧化物膜的形成
2022-03-17 17:00:08 2042
2042 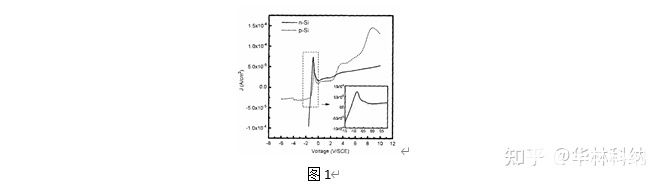
本文我们华林科纳半导体有限公司研究了类似的现象是否发生在氢氧化钾溶液中添加的其他醇,详细研究了丁基醇浓度对(100)和(110)Si平面表面形貌和蚀刻速率的影响,并给出了异丙醇对氢氧化钾溶液的蚀刻结果,为了研究醇分子在蚀刻溶液中的行为机理,我们还对溶液的表面张力进行了测量。
2022-03-18 13:53:01 769
769 
使用酸性或氟化物溶液对硅表面进行湿蚀刻具有重大意义,这将用于生产微电子包装所需厚度的可靠硅芯片。本文研究了湿蚀刻对浸入48%高频/水溶液中的硅片厚度耗散、减重、蚀刻速率、表面形貌和结晶性
2022-03-18 16:43:11 1211
1211 
薄晶片已成为各种新型微电子产品的基本需求。 需要更薄的模具来适应更薄的包装。 使用最后的湿蚀刻工艺在背面变薄的晶圆与标准的机械背面磨削相比,应力更小。 硅的各向同性湿蚀刻通常是用硝酸和氢氟酸的混合物
2022-04-07 14:46:33 1278
1278 
在集成电路的许多生产步骤中,晶片被一层材料(如二氧化硅或某种金属)完全覆盖。通过对掩模的蚀刻有选择性地除去不需要的材料,从而创建电路模板、电互连以及必须扩散的或者金属沉积的区域。等离子蚀刻工序在这
2022-04-25 16:14:11 564
564 
金属涂层,如铜膜,可以很容易地沉积在半导体材料上,如硅晶片,而无需使无电镀工艺进行预先的表面预处理。然而,铜膜的粘附性可能非常弱,并且容易剥离。在本研究中,研究了在氢氟酸溶液中蚀刻作为硅晶片化学镀前
2022-04-29 15:09:06 1103
1103 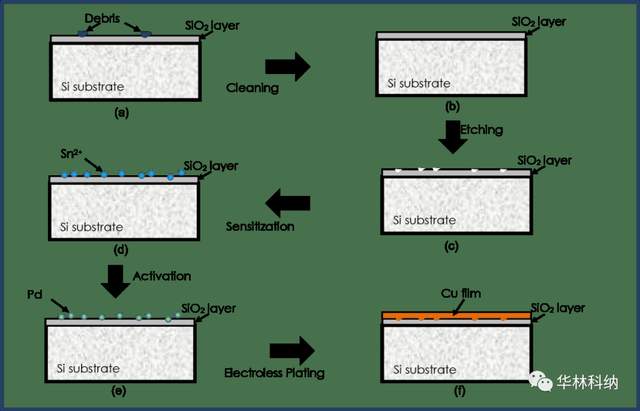
我们华林科纳研究探索了一种新的湿法腐蚀方法和减薄厚度在100 µm以下玻璃的解决方案,为了用低氢氟酸制备蚀刻溶液,使用NH4F或nh4hf 2作为主要成分并加入硫酸或硝酸是有效的,研究了混合酸溶液
2022-05-20 16:20:24 5686
5686 认为是一个速度源,这是我们提出的一个数学概念,也适用于位错和晶界,速度源的活动取决于相关的M111N平面与掩模之间的夹角,因此在微观机械结构中蚀刻的薄壁相对的M111N侧可以有不同的值。 在图1a中,示出了S 100T单晶硅炉和部分覆盖它的惰性掩
2022-05-20 17:12:59 1881
1881 
摘要 微流体和光学传感平台通常由玻璃和熔融石英(石英)制成,因为它们具有光学透明性和化学惰性。氢氟酸(HF)溶液是用于深度蚀刻二氧化硅衬底的选择的蚀刻介质,但是由于HF迁移穿过大多数掩模材料的侵蚀性
2022-05-23 17:22:14 2377
2377 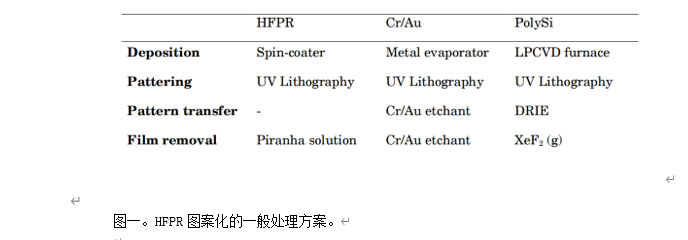
本文介绍了我们华林科纳采用混合酸溶液(H3PO4 : H2SO4 = 1 : 3)和熔融KOH作为湿法腐蚀介质,盐酸作为阳极腐蚀介质,用扫描电镜和透射电镜分别观察了蚀坑和T-Ds。
2022-05-27 16:56:03 1164
1164 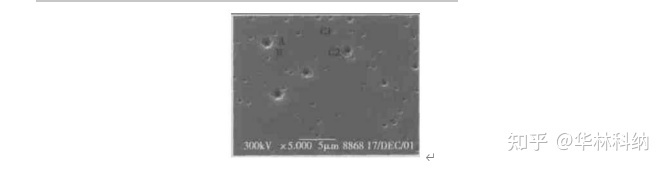
引用 本文介绍了我们华林科纳半导体研究了取向硅在氢氧化钾水溶液中的各向异性腐蚀特性和凸角底切机理。首先,确定控制底切的蚀刻前沿的晶面,并测量它们的蚀刻速率。然后,基于测量数据,检验了凸角补偿技术
2022-06-10 17:03:48 2252
2252 
的蚀刻去除了金属污染物。用氰化氢HCN水溶液清洗被金属污染的碳化硅,然后进行RCA清洗,反之亦然,可以完全去除它们。结果表明,强吸附金属和粗糙碳化硅表面底部区域的金属不能分别用RCA法和HCN法去除。由于
2022-09-08 17:25:46 3011
3011 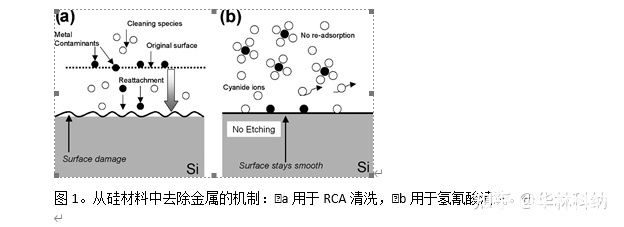
反应性离子蚀刻综合了离子蚀刻和等离子蚀刻的效果:其具有一定的各向异性,而且未与自由基发生化学反应的材料会被蚀刻。首先,蚀刻速率显著增加。通过离子轰击,基材分子会进入激发态,从而更加易于发生反应。
2022-09-19 15:17:55 6526
6526 在湿蚀刻的情况下,随着SiNx/SiOy层的厚度减小,剩余的SiOy层由于表面张力而坍塌,蚀刻溶液对孔的渗透变得更具挑战性。
2023-03-27 10:17:49 1539
1539 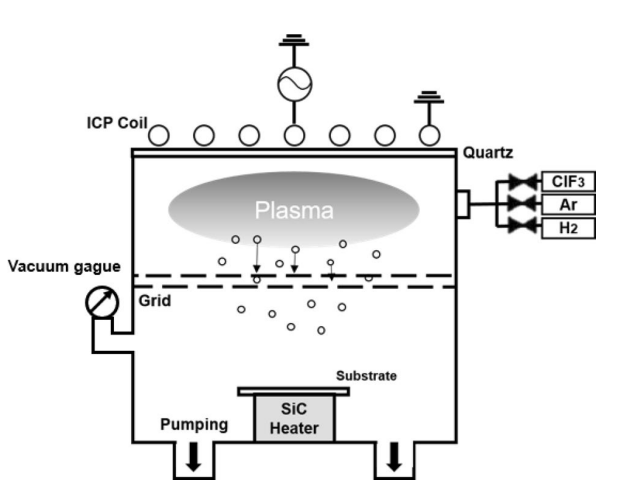
过去利用碱氢氧化物水溶液研究了硅的取向依赖蚀刻,这是制造硅中微结构的一种非常有用的技术。以10M氢氧化钾(KOH)为蚀刻剂,研究了单晶硅球和晶片的各向异性蚀刻过程,测量了沿多个矢量方向的蚀刻速率,用单晶球发现了最慢的蚀刻面。英思特利用这些数据,提出了一种预测不同方向表面的倾角的方法
2023-05-29 09:42:40 3202
3202 
随着集成电路互连线的宽度和间距接近3pm,铝和铝合金的等离子体蚀刻变得更有必要。为了防止蚀刻掩模下的横向蚀刻,我们需要一个侧壁钝化机制。尽管AlCl和AlBr都具有可观的蒸气压,但大多数铝蚀刻的研究
2023-06-27 13:24:11 1278
1278 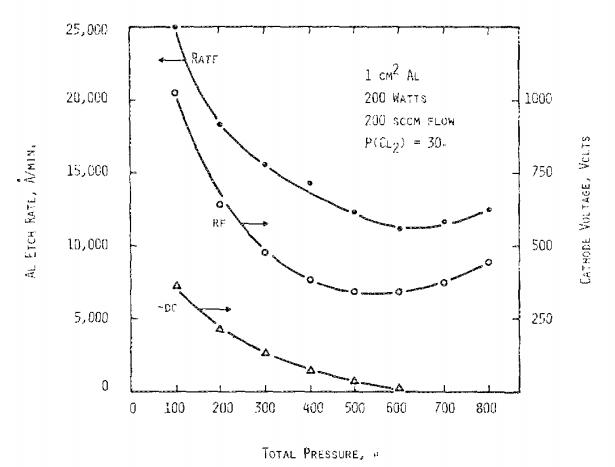
硅在暴露在空气中时会形成一层氧化硅(SiO2)层。在许多制程步骤中,如在热处理过程之前,需要移除这层氧化硅。氢氟酸是唯一能够有效清洗硅片表面氧化硅的化学品。氢氟酸能够与SiO2发生反应,生成挥发性的氟硅酸,从而清除硅片表面的氧化物层。
2023-08-02 10:40:25 2711
2711 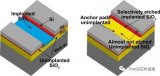
目前,大多数III族氮化物的加工都是通过干法等离子体蚀刻完成的。干法蚀刻有几个缺点,包括产生离子诱导损伤和难以获得激光器所需的光滑蚀刻侧壁。干法蚀刻产生的侧壁典型均方根(rms)粗糙度约为50纳米
2023-11-24 14:10:30 2150
2150 
按工艺要求排放出部分比重高的溶液经分析后补加氯化铵和氨的水溶液,使蚀刻液的比重调整到工艺充许的范围。
2023-12-06 15:01:46 5138
5138 氨水溶液换热器作为一种重要的化工设备,广泛应用于化工、制冷等领域。在壳程为循环水、管程介质为氨水溶液的工况下,列管换热器管板腐蚀问题成为影响设备安全运行的关键因素。因此,研究有效的防腐技术对于延长设备寿命、保障生产安全具有重要意义。
2024-06-21 16:08:59 1323
1323 
钛酸铅 PZT , 铌酸锂 LiNbO3 和 氮化铝钪 AlScN, 或用于 MRAM 和 STT-MRAM 的材料(如
2024-11-27 10:06:34 1179
1179 
芯片湿法蚀刻工艺是一种在半导体制造中使用的关键技术,主要用于通过化学溶液去除硅片上不需要的材料。 基本概念 湿法蚀刻是一种将硅片浸入特定的化学溶液中以去除不需要材料的工艺,广泛应用于半导体器件如芯片
2024-12-27 11:12:40 1538
1538 什么是离子色谱离子色谱(IonChromatography,IC)是高效液相色谱(HPLC)家族中的专门分支,其核心任务是对水溶液中呈离子态的化合物进行分离与定量。仪器通过高压输液泵将流动相(淋洗
2025-08-08 11:41:05 859
859 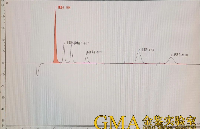
晶圆蚀刻过程中确实可能用到硝酸钠溶液,但其应用场景较为特定且需严格控制条件。以下是具体分析:潜在作用机制氧化性辅助清洁:在酸性环境中(如与氢氟酸或硫酸混合),硝酸钠释放的NO₃⁻离子可作为强氧化剂
2025-10-14 13:08:41 203
203 
湿法蚀刻的最佳刻蚀条件需综合溶液体系、温度控制、时间管理及材料特性等因素,具体如下: 溶液体系与浓度 氢氟酸缓冲体系(BOE):采用HF:NH₄F:H₂O=6:1:1的体积比配置,pH值控制在3
2025-11-11 10:28:48 269
269 成特定的图形才能用于芯片, 因 LiNbO3 惰性特性, 使用 ICP 或 RIE 工艺无法完成刻蚀, 上海伯东 IBE 离子束刻蚀机为铌酸锂 LiNbO3 薄膜
2024-09-13 10:59:11
 电子发烧友App
电子发烧友App









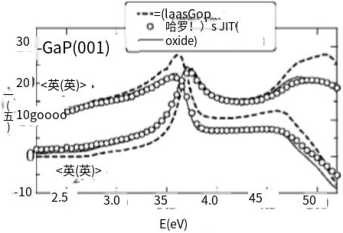
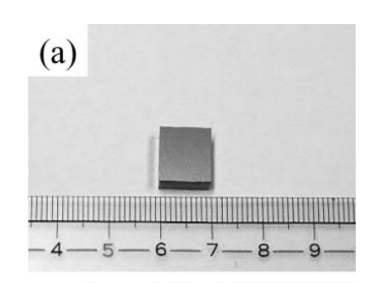



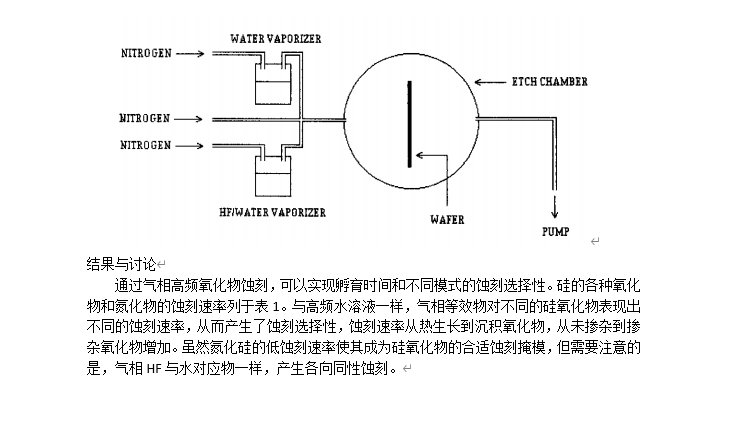
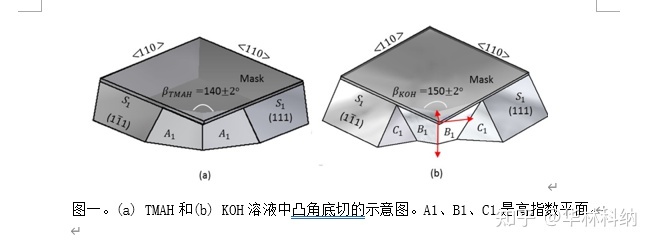

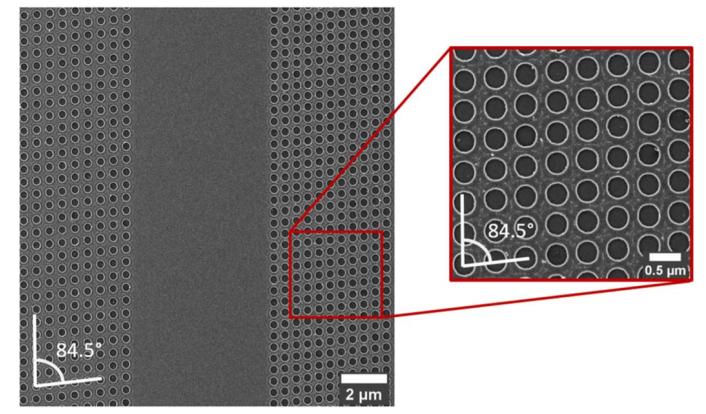

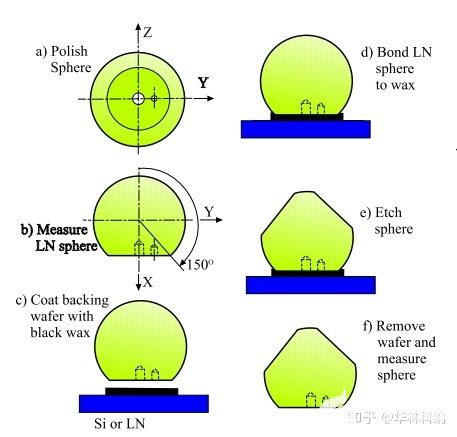




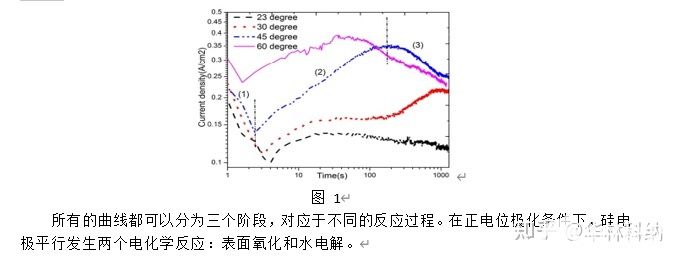
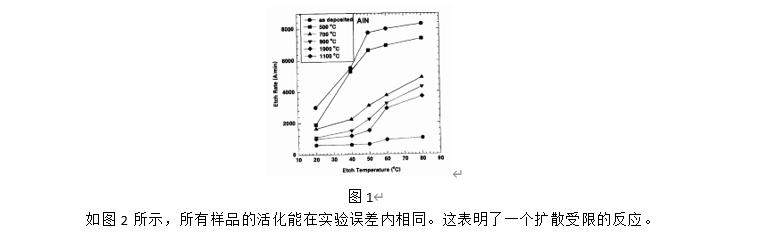

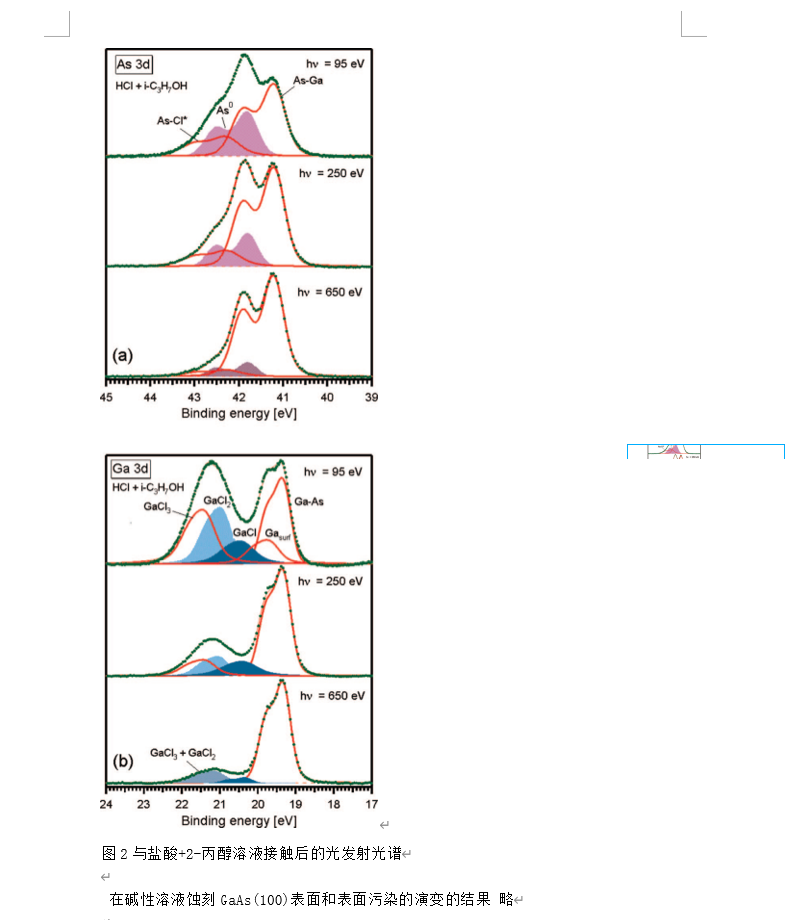

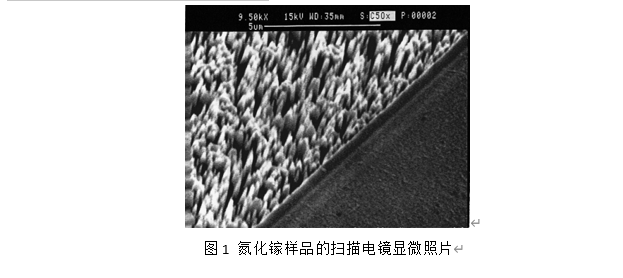
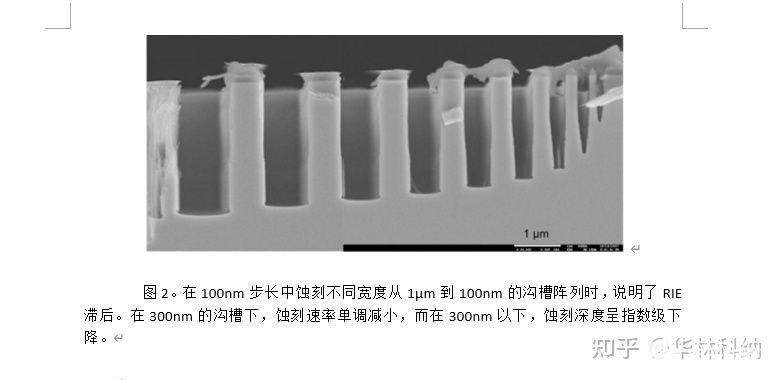

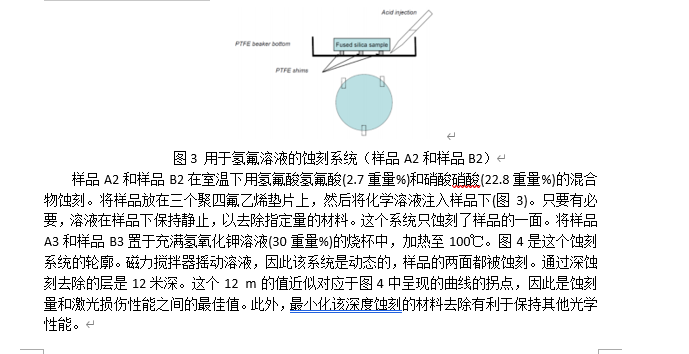


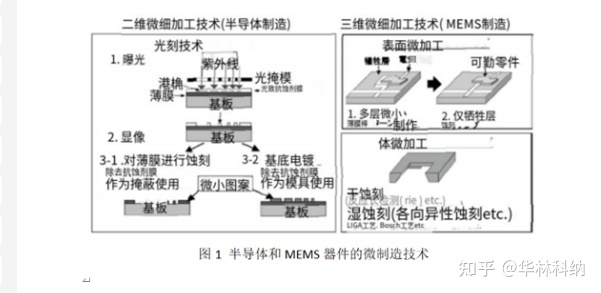
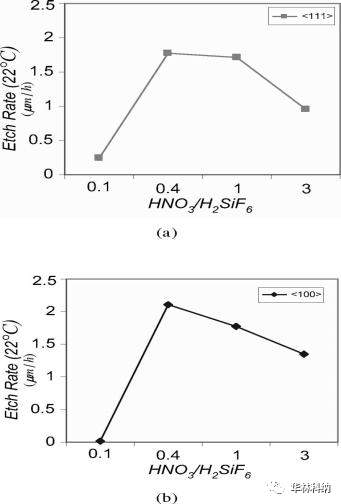
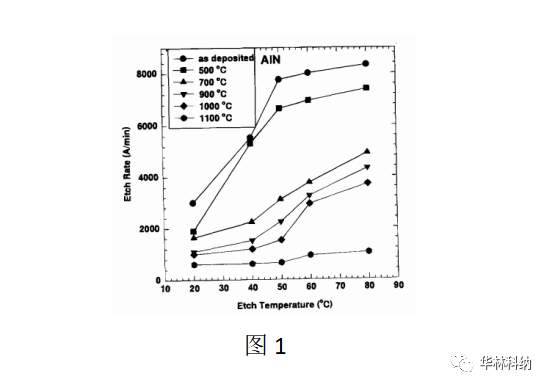

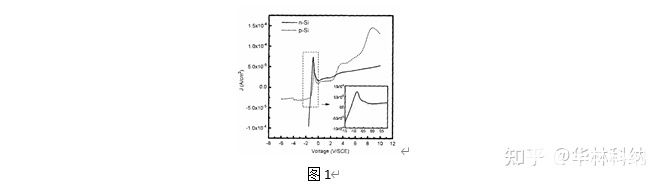




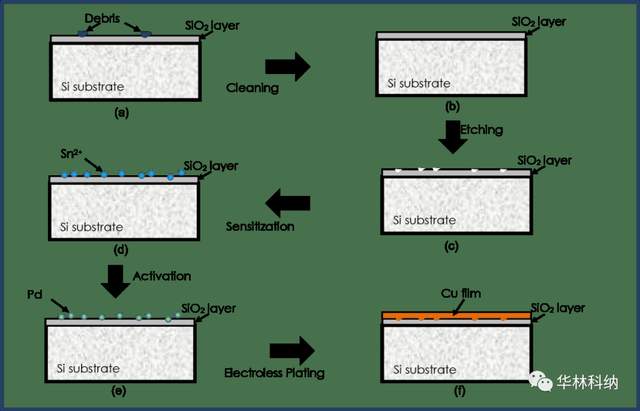

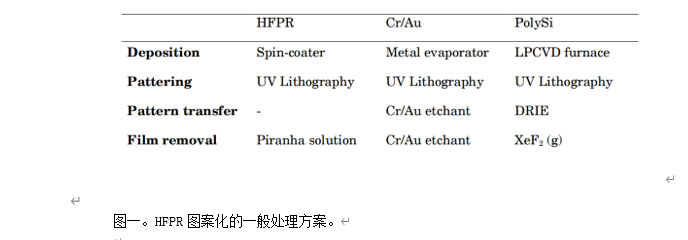
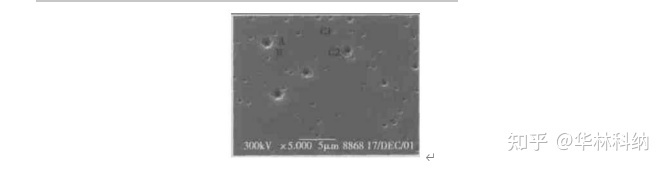

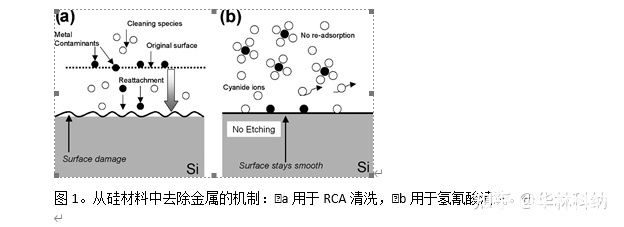

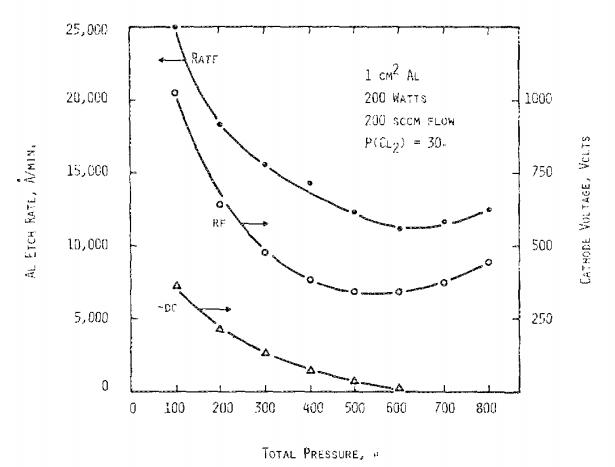
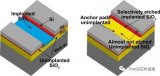



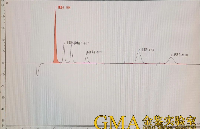




评论