在半导体制造过程中,晶圆去胶工艺之后确实需要进行清洗和干燥步骤。以下是具体介绍:一、清洗的必要性去除残留物光刻胶碎片:尽管去胶工艺旨在完全去除光刻胶,但在实际操作中,可能会有一些微小的光刻胶颗粒残留
2025-12-16 11:22:10 110
110 
晶圆边缘曝光(WEE)作为半导体制造关键精密工艺,核心是通过光刻胶光化学反应去除晶圆边缘多余胶层,从源头减少污染、提升产品良率。文章聚焦其四阶段工作流程、核心参数要求及光机电协同等技术难点。友思特
2025-11-27 23:40:39 243
243 
在半导体制造领域,晶圆清洗是保障芯片性能与良率的核心环节之一。随着制程技术向纳米级演进,污染物对器件功能的影响愈发显著,而清洗材料的选择直接决定了清洁效率、工艺兼容性及环境可持续性。以下是关键清洁
2025-11-24 15:07:29 283
283 12寸晶圆(直径300mm)的制造工艺是一个高度复杂且精密的过程,涉及材料科学、半导体物理和先进设备技术的结合。以下是其核心工艺流程及关键技术要点: 一、单晶硅生长与晶圆成型 高纯度多晶硅提纯 原料
2025-11-17 11:50:20 329
329 晶圆卡盘的正确清洗是确保半导体制造过程中晶圆处理质量的重要环节。以下是一些关键的清洗步骤和注意事项: 准备工作 个人防护:穿戴好防护服、手套、护目镜等,防止清洗剂或其他化学物质对身体造成伤害。 工具
2025-11-05 09:36:10 254
254 一、引言
玻璃晶圆在半导体制造、微流控芯片等领域应用广泛,光刻工艺作为决定器件图案精度与性能的关键环节,对玻璃晶圆的质量要求极为严苛 。总厚度偏差(TTV)是衡量玻璃晶圆质量的重要指标,其厚度
2025-10-09 16:29:24 576
576 
再生晶圆与普通晶圆在半导体产业链中扮演着不同角色,二者的核心区别体现在来源、制造工艺、性能指标及应用场景等方面。以下是具体分析:定义与来源差异普通晶圆:指全新生产的硅基材料,由高纯度多晶硅经拉单晶
2025-09-23 11:14:55 774
774 
WD4000晶圆BOW值弯曲度测量系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV
2025-09-18 14:03:57
WD4000晶圆三维显微形貌测量设备通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW、WARP、在高效测量测同时有效防止晶圆产生划痕缺陷。自动测量
2025-09-17 16:05:18
晶圆清洗后的干燥是半导体制造过程中至关重要的环节,其核心目标是在不引入二次污染、不损伤表面的前提下实现快速且均匀的脱水。以下是几种主流的干燥技术及其原理、特点和应用场景的详细介绍:1.旋转甩干
2025-09-15 13:28:49 543
543 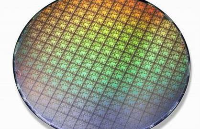
WD4000晶圆三维形貌膜厚测量系统通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW、WARP、在高效测量测同时有效防止晶圆产生划痕缺陷。WD4000晶圆
2025-09-11 16:41:24
MEMS晶圆级电镀是一种在微机电系统制造过程中,整个硅晶圆表面通过电化学方法选择性沉积金属微结构的关键工艺。该技术的核心在于其晶圆级和图形化特性:它能在同一时间对晶圆上的成千上万个器件结构进行批量加工,极大地提高了生产效率和一致性,是实现MEMS器件低成本、批量化制造的核心技术之一。
2025-09-01 16:07:28 2076
2076 
WD4000晶圆厚度翘曲度测量系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV
2025-08-25 11:29:30
WD4000晶圆显微形貌测量系统通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW、WARP、在高效测量测同时有效防止晶圆产生划痕缺陷。WD4000晶圆显微
2025-08-20 11:26:59
晶圆部件清洗工艺是半导体制造中确保表面洁净度的关键环节,其核心在于通过多步骤、多技术的协同作用去除各类污染物。以下是该工艺的主要流程与技术要点:预处理阶段首先进行初步除尘,利用压缩空气或软毛刷清除
2025-08-18 16:37:35 1038
1038 
本文主要讲述TSV工艺中的硅晶圆减薄与铜平坦化。 硅晶圆减薄与铜平坦化作为 TSV 三维集成技术的核心环节,主要应用于含铜 TSV 互连的减薄芯片制造流程,为该技术实现短互连长度、小尺寸、高集成度等特性提供了重要支撑。
2025-08-12 10:35:00 1545
1545 
在半导体制造的精密世界里,每一个微小的改进都可能引发效率的飞跃。今天,美能光子湾科技将带您一探晶圆背面磨削工艺中的关键技术——总厚度变化(TTV)控制的奥秘。随着三维集成电路3DIC制造技术
2025-08-05 17:55:08 3372
3372 
晶圆切割,作为半导体工艺流程中至关重要的一环,不仅决定了芯片的物理形态,更是影响其性能和可靠性的关键因素。传统的切割工艺已逐渐无法满足日益严苛的工艺要求,而新兴的激光切割技术以其卓越的精度和效率,为
2025-08-05 17:53:44 765
765 
摘要
本文围绕半导体晶圆研磨工艺,深入剖析聚氨酯研磨垫磨损状态与晶圆 TTV 均匀性的退化关系,探究其退化机理,并提出相应的预警方法,为保障晶圆研磨质量、优化研磨工艺提供理论与技术支持。
引言
在
2025-08-05 10:16:02 685
685 
WD4000晶圆三维显微形貌测量系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它采用白光光谱共焦多传感器和白光干涉显微测量双向扫描技术,完成非接触式扫描并建立表面3D
2025-08-04 13:59:53
退火工艺是晶圆制造中的关键步骤,通过控制加热和冷却过程,退火能够缓解应力、修复晶格缺陷、激活掺杂原子,并改善材料的电学和机械性质。这些改进对于确保晶圆在后续加工和最终应用中的性能和可靠性至关重要。退火工艺在晶圆制造过程中扮演着至关重要的角色。
2025-08-01 09:35:23 2027
2027 
WD4000晶圆THK测量设备兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW
2025-07-28 15:38:44
切割工艺参数以实现晶圆 TTV 均匀性有效控制,为晶圆切割工艺改进提供新的思路与方法。
一、引言
在半导体晶圆切割工艺中,晶圆 TTV 均匀性是影响芯片制造质量与良
2025-07-25 10:12:24 420
420 
晶圆清洗工艺是半导体制造中的关键步骤,用于去除晶圆表面的污染物(如颗粒、有机物、金属离子和氧化物),确保后续工艺(如光刻、沉积、刻蚀)的良率和器件性能。根据清洗介质、工艺原理和设备类型的不同,晶圆
2025-07-23 14:32:16 1368
1368 
晶圆清洗机中的晶圆夹持是确保晶圆在清洗过程中保持稳定、避免污染或损伤的关键环节。以下是晶圆夹持的设计原理、技术要点及实现方式: 1. 夹持方式分类 根据晶圆尺寸(如2英寸到12英寸)和工艺需求,夹持
2025-07-23 14:25:43 929
929 不同晶圆尺寸的清洗工艺存在显著差异,主要源于其表面积、厚度、机械强度、污染特性及应用场景的不同。以下是针对不同晶圆尺寸(如2英寸、4英寸、6英寸、8英寸、12英寸等)的清洗区别及关键要点:一、晶圆
2025-07-22 16:51:19 1332
1332 
Wafer Acceptance Test (WAT) 是晶圆制造中确保产品质量和可靠性的关键步骤。它通过对晶圆上关键参数的测量和分析,帮助识别工艺中的问题,并为良率提升提供数据支持。在芯片项目的量产管理中,WAT是您保持产线稳定性和产品质量的重要工具。
2025-07-17 11:43:31 2778
2778 晶圆蚀刻与扩散是半导体制造中两个关键工艺步骤,分别用于图形化蚀刻和杂质掺杂。以下是两者的工艺流程、原理及技术要点的详细介绍:一、晶圆蚀刻工艺流程1.蚀刻的目的图形化转移:将光刻胶图案转移到晶圆表面
2025-07-15 15:00:22 1224
1224 
一、引言
在半导体制造中,晶圆总厚度变化(TTV)均匀性是决定芯片性能与良品率的关键因素,而切割过程产生的应力会导致晶圆变形,进一步恶化 TTV 均匀性。浅切多道工艺作为一种先进的晶圆切割技术,在
2025-07-14 13:57:45 465
465 
一、引言
在半导体晶圆制造领域,晶圆总厚度变化(TTV)是衡量晶圆质量的关键指标,直接影响芯片制造的良品率与性能。浅切多道工艺通过分层切削降低单次切削力,有效改善晶圆切割质量,但该工艺过程中
2025-07-12 10:01:07 437
437 
TTV 厚度均匀性欠佳。浅切多道切割工艺作为一种创新加工方式,为提升晶圆 TTV 厚度均匀性提供了新方向,深入探究其提升机制与参数优化方法具有重要的现实意义。
二
2025-07-11 09:59:15 471
471 
楷登电子(美国 Cadence 公司,NASDAQ:CDNS)近日宣布扩大与三星晶圆代工厂的合作,包括签署一项新的多年期 IP 协议,在三星晶圆代工厂的 SF4X、SF5A 和 SF2P 先进节点
2025-07-10 16:44:04 918
918 WD4000晶圆厚度THK几何量测系统兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV
2025-07-10 13:42:33
On Wafer WLS无线晶圆测温系统通过自主研发的核心技术将传感器嵌入晶圆集成,实时监控和记录晶圆在制程过程中的温度变化数据,为半导体制造过程提供一种高效可靠的方式来监测和优化关键
2025-06-27 10:37:30
TC Wafer 晶圆测温系统通过利用自主研发的核心技术将耐高温的热电偶传感器镶嵌在晶圆表面,实时监控和记录晶圆在制程过程中的温度变化数据,为半导体制造过程提供一种高效可靠的方式来监测和优化关键
2025-06-27 10:16:41
RTD Wafer 晶圆测温系统利用自主研发的核心技术将 RTD 传感器集成到晶圆表面,实时监控和记录晶圆在制程过程中的温度变化数据,为半导体 制造过程提供一种高效可靠的方式来监测和优化关键的工艺
2025-06-27 10:08:43
TCWafer晶圆测温系统是一种革命性的温度监测解决方案,专为半导体制造工艺中晶圆温度的精确测量而设计。该系统通过将微型热电偶传感器(Thermocouple)直接镶嵌于晶圆表面,实现了对晶圆温度
2025-06-27 10:03:14 1396
1396 
在半导体制造的精密流程中,晶圆载具清洗机是确保芯片良率与性能的关键设备。它专门用于清洁承载晶圆的载具(如载具、花篮、托盘等),避免污染物通过载具转移至晶圆表面,从而保障芯片制造的洁净度与稳定性。本文
2025-06-25 10:47:33
键设备的技术价值与产业意义。一、晶圆湿法清洗:为何不可或缺?晶圆在制造过程中会经历多次光刻、刻蚀、沉积等工艺,表面不可避免地残留光刻胶、金属污染物、氧化物或颗粒。这些污染
2025-06-25 10:26:37
引言 在晶圆上芯片制造工艺中,光刻胶剥离是承上启下的关键环节,其效果直接影响芯片性能与良率。同时,光刻图形的精确测量是保障工艺精度的重要手段。本文将介绍适用于晶圆芯片工艺的光刻胶剥离方法,并探讨白光
2025-06-25 10:19:48 815
815 
WD4000晶圆厚度测量设备兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW
2025-06-18 15:40:06
摘要:本文探讨晶圆边缘 TTV 测量在半导体制造中的重要意义,分析其对芯片制造工艺、器件性能和生产良品率的影响,同时研究测量方法、测量设备精度等因素对测量结果的作用,为提升半导体制造质量提供理论依据
2025-06-14 09:42:58 552
552 
贴膜是指将一片经过减薄处理的晶圆(Wafer)固定在一层特殊的胶膜上,这层膜通常为蓝色,业内常称为“ 蓝膜 ”。贴膜的目的是为后续的晶圆切割(划片)工艺做准备。
2025-06-03 18:20:59 1180
1180 
“减薄”,也叫 Back Grinding(BG),是将晶圆(Wafer)背面研磨至目标厚度的工艺步骤。这个过程通常发生在芯片完成前端电路制造、被切割前(即晶圆仍然整体时),是连接芯片制造和封装之间的桥梁。
2025-05-30 10:38:52 1658
1658 引言 在 MICRO OLED 的制造进程中,金属阳极像素制作工艺举足轻重,其对晶圆总厚度偏差(TTV)厚度存在着复杂的影响机制。晶圆 TTV 厚度指标直接关乎 MICRO OLED 器件的性能
2025-05-29 09:43:43 589
589 
在生产环境中,为了确保数据库系统的连续可用性、降低故障恢复时间以及实现业务的无缝切换,高可用(High Availability, HA)方案至关重要。本文将详细介绍三种常见的 MySQL 高可用
2025-05-28 17:16:57 1071
1071 通过退火优化和应力平衡技术控制。
3、弯曲度(Bow) 源于材料与工艺的对称性缺陷,对多层堆叠和封装尤为敏感,需在晶体生长和镀膜工艺中严格调控。
在先进制程中,三者共同决定了晶圆的几何完整性,是良率提升
2025-05-28 16:12:46
关键词:键合晶圆;TTV 质量;晶圆预处理;键合工艺;检测机制 一、引言 在半导体制造领域,键合晶圆技术广泛应用于三维集成、传感器制造等领域。然而,键合过程中诸多因素会导致晶圆总厚度偏差(TTV
2025-05-26 09:24:36 854
854 
摘要:本文针对湿法腐蚀工艺后晶圆总厚度偏差(TTV)的管控问题,探讨从工艺参数优化、设备改进及检测反馈机制完善等方面入手,提出一系列优化方法,以有效降低湿法腐蚀后晶圆 TTV,提升晶圆制造质量
2025-05-22 10:05:57 511
511 
摘要:本文聚焦于降低晶圆 TTV(总厚度偏差)的磨片加工方法,通过对磨片设备、工艺参数的优化以及研磨抛光流程的改进,有效控制晶圆 TTV 值,提升晶圆质量,为半导体制造提供实用技术参考。 关键词:晶
2025-05-20 17:51:39 1028
1028 
前言在半导体制造的前段制程中,晶圆需要具备足够的厚度,以确保其在流片过程中的结构稳定性。尽管芯片功能层的制备仅涉及晶圆表面几微米范围,但完整厚度的晶圆更有利于保障复杂工艺的顺利进行,直至芯片前制程
2025-05-16 16:58:44 1110
1110 
我们看下一个先进封装的关键概念——晶圆级封装(Wafer Level Package,WLP)。
2025-05-14 10:32:30 1533
1533 
TCWafer晶圆测温系统是一种专为半导体制造工艺设计的温度测量设备,通过利用自主研发的核心技术将高精度耐高温的热电偶传感器嵌入晶圆表面,实现对晶圆特定位置及整体温度分布的实时监测,记录晶圆在制程
2025-05-12 22:23:35 785
785 
在半导体制造流程中,晶圆在前端工艺阶段需保持一定厚度,以确保其在流片过程中的结构稳定性,避免弯曲变形,并为芯片制造工艺提供操作便利。不同规格晶圆的原始厚度存在差异:4英寸晶圆厚度约为520微米,6
2025-05-09 13:55:51 1976
1976 圆片级封装(WLP),也称为晶圆级封装,是一种直接在晶圆上完成大部分或全部封装测试程序,再进行切割制成单颗组件的先进封装技术 。WLP自2000年左右问世以来,已逐渐成为半导体封装领域的主流技术,深刻改变了传统封装的流程与模式。
2025-05-08 15:09:36 2068
2068 
随着半导体工艺复杂度提升,可靠性要求与测试成本及时间之间的矛盾日益凸显。晶圆级可靠性(Wafer Level Reliability, WLR)技术通过直接在未封装晶圆上施加加速应力,实现快速
2025-05-07 20:34:21
晶圆制备是材料科学、热力学与精密控制的综合体现,每一环节均凝聚着工程技术的极致追求。而晶圆清洗本质是半导体工业与污染物持续博弈的缩影,每一次工艺革新都在突破物理极限。
2025-05-07 15:12:30 2192
2192 
On Wafer WLS-WET无线晶圆测温系统是半导体先进制程监控领域的重要创新成果。该系统通过自主研发的核心技术,将温度传感器嵌入晶圆集成,实现了晶圆本体与传感单元的无缝融合。传感器采用IC传感器,具备±0.1℃的测量精度和10ms级快速响应特性,可实时捕捉湿法工艺中瞬态温度场分布。
2025-04-22 11:34:40 670
670 
晶圆扩散前的清洗是半导体制造中的关键步骤,旨在去除表面污染物(如颗粒、有机物、金属离子等),确保扩散工艺的均匀性和器件性能。以下是晶圆扩散清洗的主要方法及工艺要点: 一、RCA清洗工艺(标准清洗
2025-04-22 09:01:40 1289
1289 本文介绍了半导体集成电路制造中的晶圆制备、晶圆制造和晶圆测试三个关键环节。
2025-04-15 17:14:37 2160
2160 
晶圆高温清洗蚀刻工艺是半导体制造过程中的关键环节,对于确保芯片的性能和质量至关重要。为此,在目前市场需求的增长情况下,我们来给大家介绍一下详情。 一、工艺原理 清洗原理 高温清洗利用物理和化学的作用
2025-04-15 10:01:33 1097
1097 晶圆浸泡式清洗方法是半导体制造过程中的一种重要清洗技术,它旨在通过将晶圆浸泡在特定的化学溶液中,去除晶圆表面的杂质、颗粒和污染物,以确保晶圆的清洁度和后续加工的质量。以下是对晶圆浸泡式清洗方法的详细
2025-04-14 15:18:54 766
766 工作台工艺流程介绍 一、预清洗阶段 初步冲洗 将晶圆放置在工作台的支架上,使用去离子水(DI Water)进行初步冲洗。这一步骤的目的是去除晶圆表面的一些较大颗粒杂质和可溶性污染物。去离子水以一定的流量和压力喷淋在晶圆表
2025-04-01 11:16:27 1009
1009 在我用photodiode工具选型I/V放大电路的时候,系统给我推荐了AD8655用于I/V,此芯片为CMOS工艺
但是查阅资料很多都是用FET工艺的芯片,所以请教下用于光电信号放大转换(主要考虑信噪比和带宽)一般我们用哪种工艺的芯片,
CMOS,Bipolar,FET这三种工艺的优缺点是什么?
2025-03-25 06:23:13
电子发烧友网综合报道 据多方消息来源推测,三星电子可能取消原计划于 2027 年量产的 1.4nm(FS1.4)晶圆代工工艺。三星在 “Samsung Foundry Forum 2022” 上首
2025-03-23 11:17:40 1827
1827 电子发烧友网综合报道 据多方消息来源推测,三星电子可能取消原计划于 2027 年量产的 1.4nm(FS1.4)晶圆代工工艺。三星在 “Samsung Foundry Forum 2022” 上首
2025-03-22 00:02:00 2462
2462 加工的PEEK晶圆夹的耐磨性和低排气性能使其成为晶圆制造的理想工具,确保了晶圆表面的清洁和完整性。 PEEK晶圆夹——提升晶圆制造效率与良率 1.PEEK晶圆夹能够在260℃的高温环境下长期使用,且保持高强度、尺寸稳定和较小的线胀系数
2025-03-20 10:23:42 802
802 
本文介绍了晶圆清洗的污染源来源、清洗技术和优化。
2025-03-18 16:43:05 1686
1686 
圆不仅是芯片制造的基础材料,更是连接设计与现实的桥梁。在这张画布上,光刻、刻蚀、沉积等工艺如同精妙的画笔,将虚拟的电路图案转化为现实的功能芯片。 晶圆:从砂砾到硅片 晶圆的起点是普通的砂砾,其主要成分是二氧化硅(SiO₂
2025-03-10 17:04:25 1544
1544 红外探测器作为红外热像仪的核心部件,广泛应用于工业、安防、医疗等多个领域。随着技术的不断进步,红外探测器的封装形式也在不断发展和完善。其中,晶圆级、陶瓷级和金属级封装是三种最常见的封装形式,它们各自具有独特的特点和优势,适用于不同的场景。
2025-03-05 16:43:22 1115
1115 
随着半导体技术的飞速发展,晶圆级封装(WLP)作为先进封装技术的重要组成部分,正逐渐成为集成电路封装的主流趋势。在晶圆级封装过程中,Bump工艺扮演着至关重要的角色。Bump,即凸块,是晶圆级封装中
2025-03-04 10:52:57 4980
4980 
既然说到了半导体晶圆电镀工艺,那么大家就知道这又是一个复杂的过程。那么涉及了什么工艺,都有哪些内容呢?下面就来给大家接下一下! 半导体晶圆电镀工艺要求是什么 一、环境要求 超净环境 颗粒控制:晶圆
2025-03-03 14:46:35 1736
1736 在新能源时代,锂电池作为核心动力与储能单元,其重要性不言而喻。而在锂电池的诸多特性中,封装形状这一外在表现形式,实则蕴含着复杂的技术考量与工艺逻辑。方形、圆柱、软包三种主流封装形状,各自对应着独特
2025-02-17 10:10:38 2226
2226 
Dicing 是指将制造完成的晶圆(Wafer)切割成单个 Die 的工艺步骤,是从晶圆到独立芯片生产的重要环节之一。每个 Die 都是一个功能单元,Dicing 的精准性直接影响芯片的良率和性能。
2025-02-11 14:28:49 2947
2947 在半导体制造的复杂流程中,晶圆历经前道工序完成芯片制备后,划片工艺成为将芯片从晶圆上分离的关键环节,为后续封装奠定基础。由于不同厚度的晶圆具有各异的物理特性,因此需匹配不同的切割工艺,以确保切割效果与芯片质量。
2025-02-07 09:41:00 3050
3050 
今天我们再详细看看Underfill工艺中所用到的四种填充胶:CUF,NUF,WLUF和MUF。 倒装芯片的底部填充工艺一般分为三种:毛细填充(流动型)、无流动填充和模压填充,如下图所示, 目前看来
2025-01-28 15:41:00 3970
3970 
近日,据最新报道,三星计划在2025年大幅削减其晶圆代工部门的投资规模,设备投资预算将从2024年的10万亿韩元锐减至5万亿韩元,削减幅度高达50%。 此次投资削减主要集中在韩国的两大工厂:平泽P2
2025-01-23 11:32:15 1081
1081 扇出型晶圆级中介层封装( FOWLP)以及封装堆叠(Package-on-Package, PoP)设计在移动应用中具有许多优势,例如低功耗、短信号路径、小外形尺寸以及多功能的异构集成。此外,它还
2025-01-22 14:57:52 4507
4507 
着晶圆 BOW 的测量精度与可靠性,对整个半导体工艺链的稳定性起着不可忽视的作用。
一、真空吸附方式剖析
真空吸附方式长期以来在晶圆测量领域占据主导地位。它借助布
2025-01-21 09:36:24 520
520 
本文主要介绍功率器件晶圆测试及封装成品测试。 晶圆测试(CP) 如图所示为典型的碳化硅晶圆和分立器件电学测试的系统,主要由三部分组成,左边为电学检测探针台阿波罗
2025-01-14 09:29:13 2359
2359 
晶圆是集成电路、功率器件及半导体分立器件的核心原材料,超过90%的集成电路均在高纯度、高品质的晶圆上制造而成。晶圆的质量及其产业链供应能力,直接关乎集成电路的整体性能和竞争力。今天我们将详细介绍
2025-01-09 09:59:26 2100
2100 
8寸晶圆的清洗工艺是半导体制造过程中至关重要的环节,它直接关系到芯片的良率和性能。那么直接揭晓关于8寸晶圆的清洗工艺介绍吧! 颗粒去除清洗 目的与方法:此步骤旨在去除晶圆表面的微小颗粒物,这些颗粒
2025-01-07 16:12:00 813
813 随着半导体技术的飞速发展,晶圆级封装(Wafer Level Packaging, WLP)作为一种先进的封装技术,正逐渐在集成电路封装领域占据主导地位。晶圆级封装技术以其高密度、高可靠性、小尺寸
2025-01-07 11:21:59 3190
3190 
WD4000半导体晶圆几何表面形貌检测设备兼容不同材质不同粗糙度、可测量大翘曲wafer、测量晶圆双面数据更准确。它通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度
2025-01-06 14:34:08
 电子发烧友App
电子发烧友App





















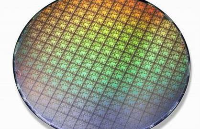








































评论