随着5G毫米波通信、车载雷达(77 GHz/79 GHz)、6G太赫兹通信以及高速互连等应用的迅猛发....

射频(Radio Frequency,RF),本质是可辐射到自由空间的、具有交流变化特性的电磁波,是....

在高速信道中,尤其是当使用低损耗层压材料时,导体损耗主导着介电损耗。因此,信道性能的准确预测依赖于导....

本文以五阶盲孔印制电路板为研究对象,围绕逐次增层法制备流程,系统阐述微孔激光成形、超高厚径比盲孔电镀....

塑封器件在尺寸微型化、重量轻量化、成本效益和电气性能方面较陶瓷封装与金属封装具有显著优势,成为消费电....

在后摩尔时代,扇出型晶圆级封装(FOWLP) 已成为实现异构集成、提升I/O密度和缩小封装尺寸的关键....

半导体产业正面临传统芯片缩放方法遭遇基本限制的关键时刻。随着人工智能和高性能计算应用对计算能力的需求....

先进材料与三维集成技术的结合为边缘计算应用带来了新的可能性。本文探讨研究人员如何通过单片3D集成方式....

在封装基板发展的早期阶段,广泛采用一种称为减成法的印制电路板制造技术,亦称蚀刻铜箔技术。该技术的基本....
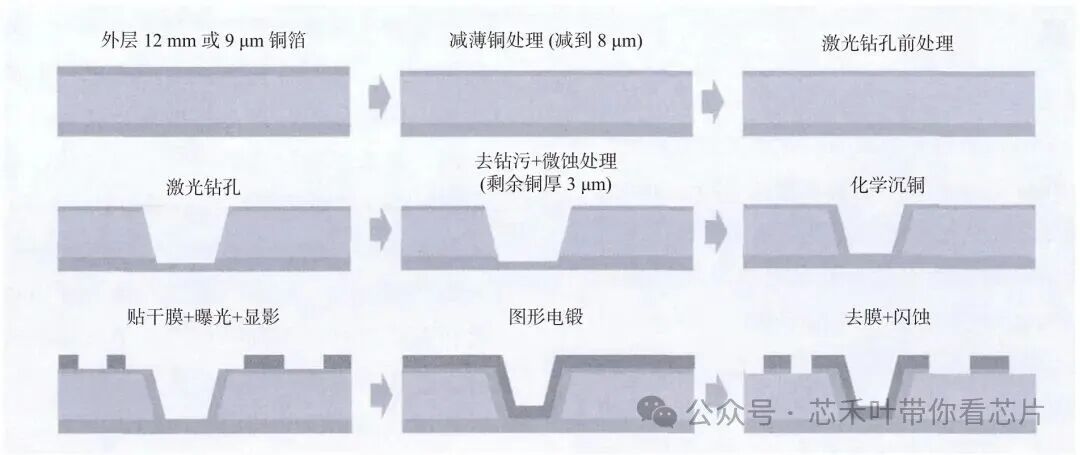
集成电路湿法工艺是指在集成电路制造过程中,通过化学药液对硅片表面进行处理的一类关键技术,主要包括湿法....

硅基光电子技术的发展催生了可编程光电子集成芯片的诞生,这类芯片可以通过软件重新配置来实现多种应用功能....
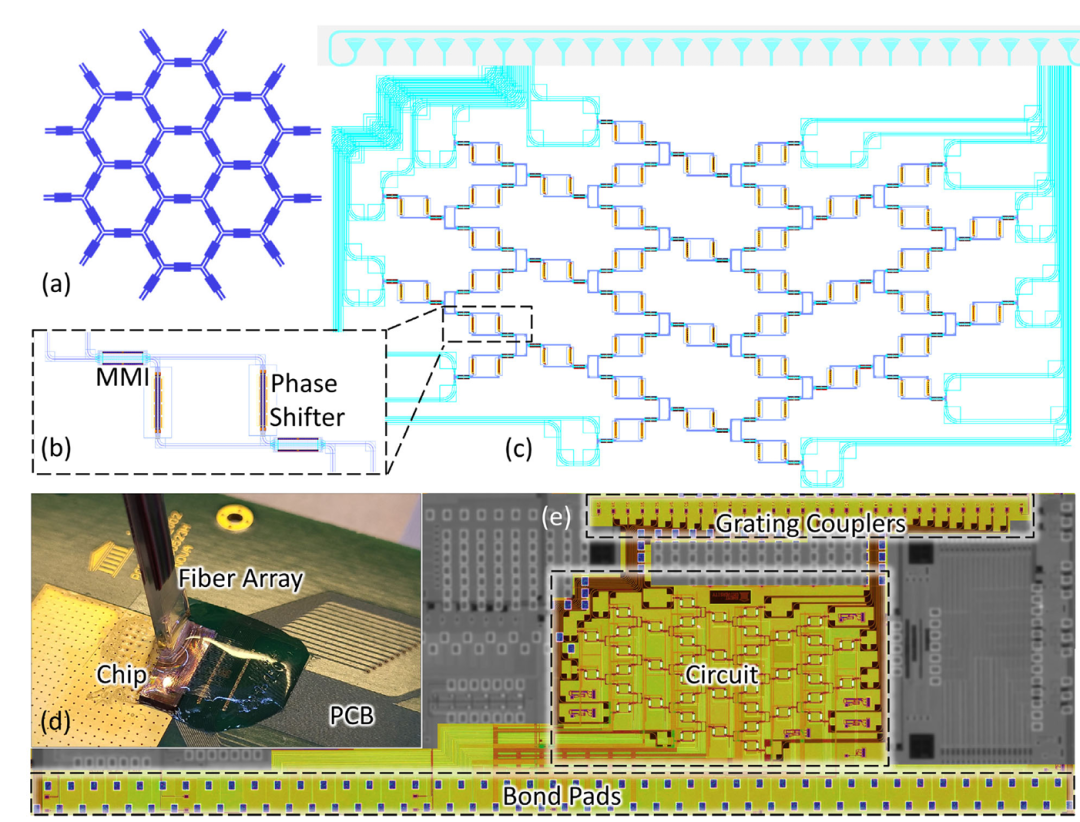
氮化镓(GaN)作为一种第三代宽禁带半导体材料,凭借其高电子迁移率和高击穿电场等优异特性,已在5G通....

扫描电镜(SEM)的分辨率是指其能够分辨样品表面两点之间的最小距离,是衡量其成像能力的关键指标。

在半导体材料与器件的表征中,薄层电阻是一个至关重要的参数,直接关系到导电薄膜、掺杂层以及外延层的电学....
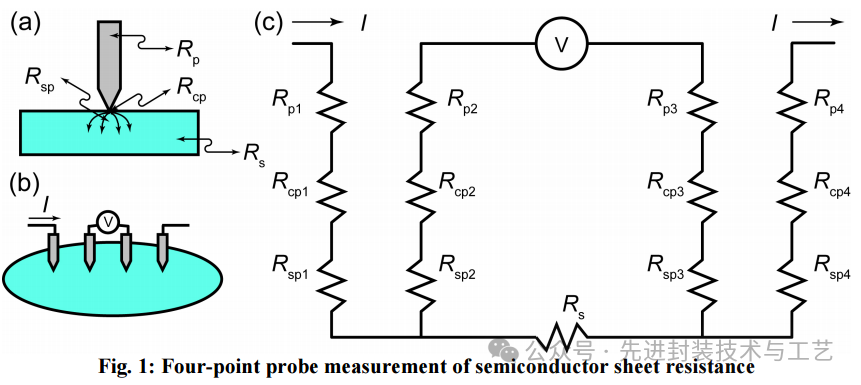
人工智能、云计算和高性能计算的快速发展对现代数据中心的数据传输带宽和能源效率提出了更高的要求。传统的....
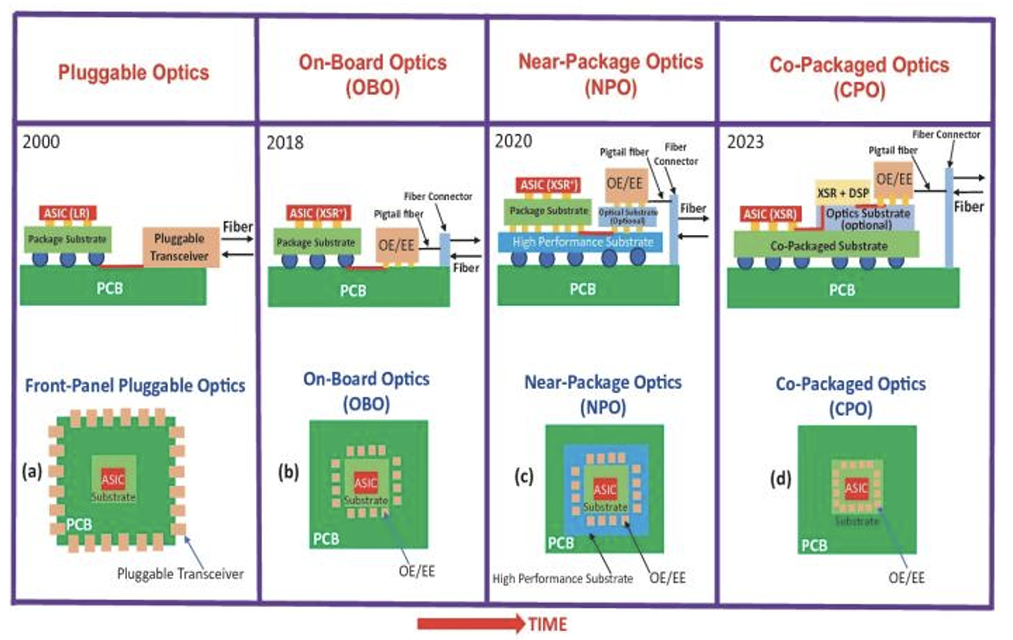
扇出型晶圆级封装(FOWLP)的概念最早由德国英飞凌提出,自2016 年以来,业界一直致力于FOWL....

为了实现更紧凑和集成的封装,封装工艺中正在积极开发先进的芯片设计、材料和制造技术。随着具有不同材料特....

到目前为止,我们已经了解了如何将芯片翻转焊接到具有 FR4 核心和有机介电薄膜的封装基板上,也看过基....
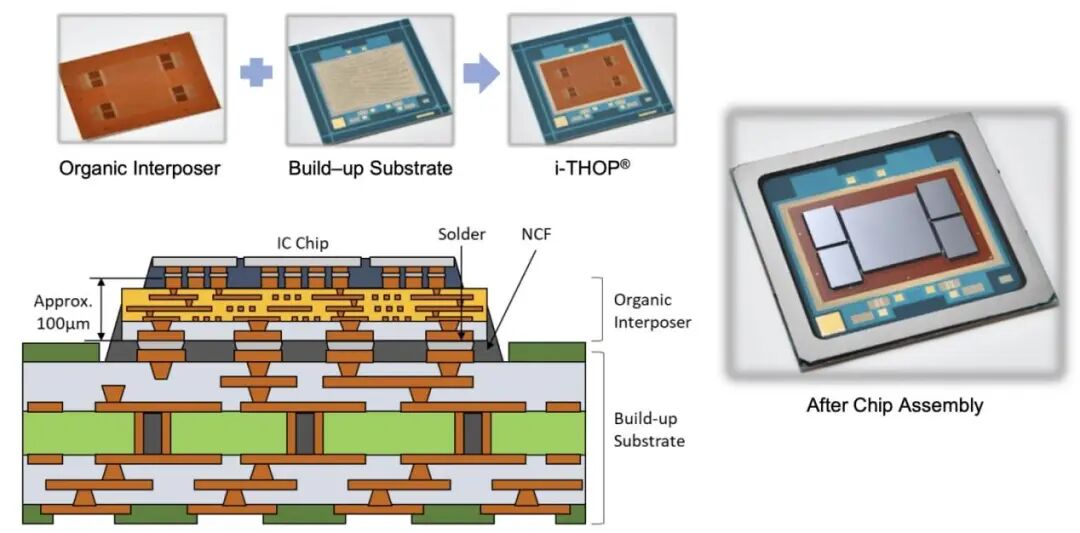
这是一份涉及芯片封装几乎所有关键概念的终极指南,它可以帮助您全面了解芯片的封装方式以及未来互连技术的....

热阻(Thermal Resistance)表示热量在传递过程中所受到的阻力,为传热路径上的温差与热....
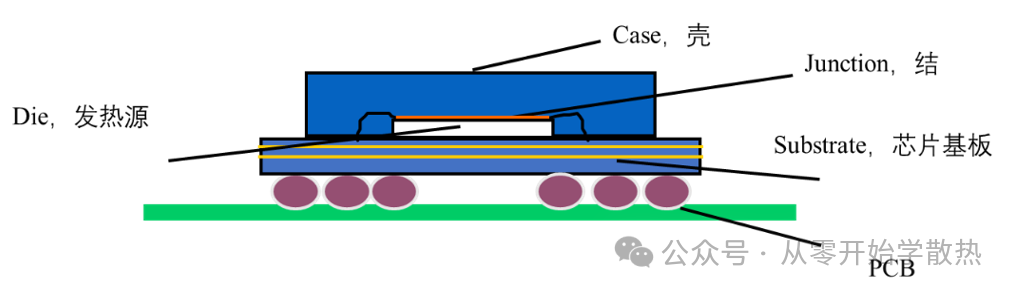
人工智能和机器学习应用的爆炸式增长已经将高性能计算系统推向极限。在训练日益复杂的AI模型时,计算需求....
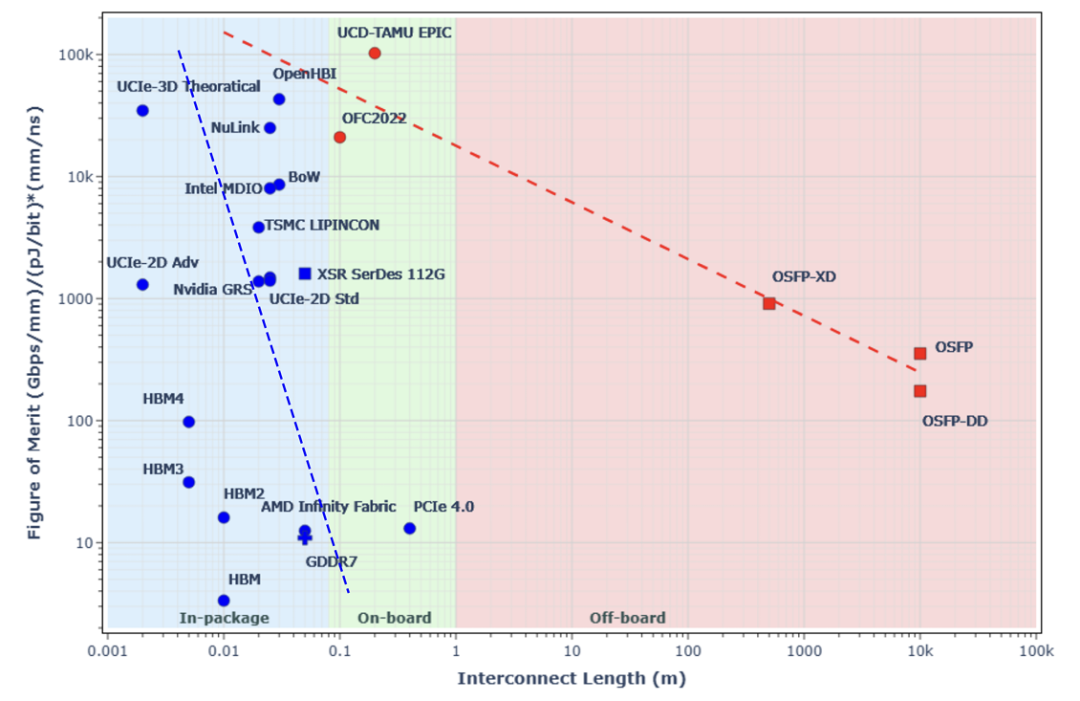
随着高性能计算(HPC)、人工智能(AI)和大数据分析的快速发展,诸如CoWoS(芯片-晶圆-基板)....

台积电在先进封装技术,特别是CoWoS(Chip on Wafer on Substrate)平台上....

半导体产业正处在传统封装边界逐步消解的转型节点,新的集成范式正在涌现。理解从分立元件到复杂异构集成的....

玻璃基板正在改变半导体封装产业,通过提供优异的电气和机械性能来满足人工智能和高性能计算应用不断增长的....

半导体行业持续推进性能和集成度的边界,Chiplet技术作为克服传统单片设计局限性的解决方案正在兴起....
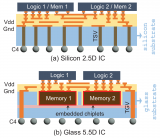
半导体行业正面临传统封装方法的性能极限,特别是在满足AI计算需求的爆炸性增长方面。CoWoP(芯片晶....
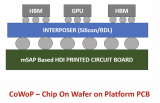
在先进封装中, Hybrid bonding( 混合键合)不仅可以增加I/O密度,提高信号完整性,还....

半导体行业正在经历向更紧凑、更高效封装解决方案的转型。随着移动设备和物联网(IoT)应用对更小、更薄....

毫米波(mmWave)严格意义上是指波长在1到10毫米之间、频率范围是30GHz-300GHz的电磁....