传统封装方法已无法满足人工智能、高性能计算和下一代通信技术的需求。晶体管尺寸已缩小至个位数纳米量级,....
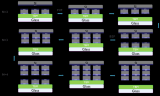
光电共封装(Co-Packaged Optics,CPO)代表了光互连技术的新发展方向,这种技术将光....

FOPLP 技术目前仍面临诸多挑战,包括:芯片偏移、面板翘曲、RDL工艺能力、配套设备和材料、市场应....

在异构集成组件中,互连结构通常是薄弱处,在经过温度循环、振动等载荷后,互连结构因热、机械疲劳而断裂是....

基于板级封装的异构集成作为弥合微电子与应用差距的关键方法,结合“延续摩尔”与“超越摩尔”理念,通过S....

提高激光强度(激光功率密度)可以有效提高微孔的加工速 率。然而,过高的激光强度在加工过程中也会造成过....

前面分享了先进封装的四要素一分钟让你明白什么是先进封装,今天分享一下先进封装中先进性最高的TSV。

半导体中电子和空穴运动方式有很多种,比如热运动引起的布朗运动、电场作用下的漂移运动和由浓度梯度引起的....

铜互连工艺是一种在集成电路制造中用于连接不同层电路的金属互连技术,其核心在于通过“大马士革”(Dam....

面向高性能计算机、人工智能、无人系统对电子芯片高性能、高集成度的需求,以 2.5D、3D 集成技术为....

TGV(Through Glass Via)和TSV(Through Silicon Via)是两种....

氧化镓(Ga2O3 )是性能优异的超宽禁带半导体材料,不仅临界击穿场强大、饱和速度高,而且具有极高的....

印刷电路板(PCB)在电子设备和其他相关应用中无处不在。一般来说,PCB是由多层层压材料和多层树脂粘....

aQFN作为一种新型封装以其低成本、高密度I/O、优良的电气和散热性能,开始被应用于电子产品中。本文....
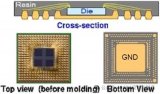
芯片制造中大量使用物理气相沉积、化学气相沉积、电镀、热压键合等技术来实现芯片导电互连。
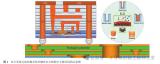
玻璃基板是一种由高度纯净的玻璃材料制成的关键组件,常见的材料包括硅酸盐玻璃、石英玻璃和硼硅酸盐玻璃等....

所谓混合键合(hybrid bonding),指的是将两片以上不相同的Wafer或Die通过金属互连....

TGV技术是近年来在先进封装(如2.5D/3D IC、射频器件、MEMS、光电子集成等)领域备受关注....
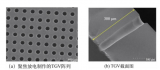
随着台积电在 2011年推出第一版 2.5D 封装平台 CoWoS、海力士在 2014 年与 AMD....

随着集成电路高集成度、高性能的发展,对半导体制造技术提出更高要求。超短脉冲激光加工作为一种精密制造技....

通信、雷达和微波测量等领域电子信息装备迅速发展, 对射频系统提出了微型化、集成化和多样化等迫切需求。....
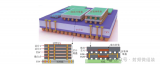
对于传统的MOSFET器件,虽然因为栅极绝缘层的采用大大抑制了栅极漏流,但是硅沟道较低的电子迁移率也....

常规IC封装需经过将晶圆与IC封装基板焊接,再将IC基板焊接至普通PCB的复杂过程。与之不同,WLP....

翘曲(Warpage)是结构固有的缺陷之一。晶圆级扇出封装(FOWLP)工艺过程中,由于硅芯片需通过....

产品集成11颗芯片,58个无源元件,采用双面陶瓷管壳作为载体,进行双层芯片叠装和组装,实现高密度集成....

多芯片封装在现代半导体领域至关重要,主要分为平面多芯片封装和多芯片堆叠封装。多芯片堆叠封装又细分为多....

CSP的概念最早于1993年由Fuiitsu公司的Junichi Kasai和Hitachi Cab....
自集成电路诞生以来,摩尔定律一直是其发展的核心驱动力。根据摩尔定律,集成电路单位面积上的晶体管数量每....
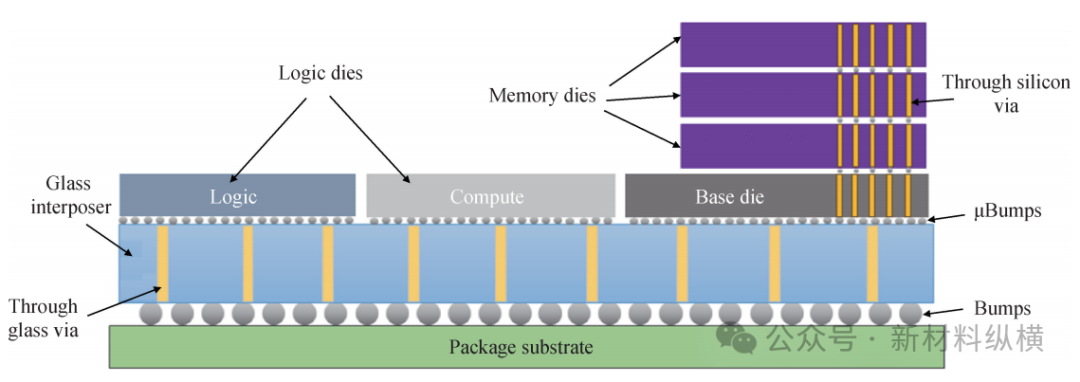
电气性能制约随着片外数据传输速率持续提升及键合节距不断缩小,引线键合技术暴露出电感与串扰两大核心问题....

在芯片制造这一复杂且精妙的领域中,氮化硅(SiNx)占据着极为重要的地位,绝大多数芯片的生产都离不开....