在本文中,我们详细研究了AlGaN的湿法刻蚀特性。特别地,我们研究了m面刻面形成和AlN摩尔分数对蚀刻速率的依赖关系。我们还研究了氮化铝摩尔分数差异较大的紫外发光二极管结构的湿法刻蚀特性。
2021-12-13 14:58:12 1270
1270 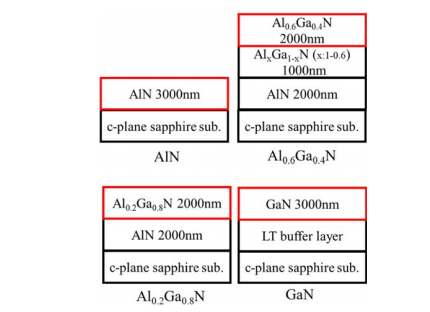
这本文中,我们提出了一种精确的,低损伤的循环刻蚀AlGaN/GaN的新方法,用于精确的势垒凹陷应用,使用ICP-RIE氧化和湿法刻蚀。设备功率设置的优化允许获得宽范围的蚀刻速率~0.6至~11纳米/周期,而相对于未蚀刻的表面,表面粗糙度没有任何可观察到的增加。
2021-12-13 16:07:58 2195
2195 
不同的蚀刻剂(氯化铁和氯化铜)进行化学蚀刻。研究了选择的蚀刻剂和加工条件对蚀刻深度和表面粗糙度的影响。实验研究表明,氯化铁产生的化学腐蚀速率最快,但氯化铜产生的化学腐蚀速率最快最光滑的表面质量。 关键词:化学蚀刻;铜
2021-12-29 13:21:46 2087
2087 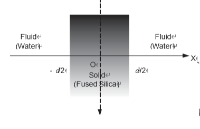
,硫可以用来钝化III-V表面。本研究通过SRPES研究了湿化学处理后的一个(nh4)2s钝化步骤的影响。此外,我们还分别用接触角(CA)、扫描隧道显微镜(STM)和电感耦合等离子体质谱(ICP-MS)对各种处理后的表面润湿性能、形态和蚀刻速率进行了研究。 实
2022-01-12 16:27:33 1604
1604 
摘要 我们华林科纳对h2so4-h202-h20体系中(100)砷化镓的蚀刻情况进行了详细的研究。研究了特定蚀刻剂成分的浓度对蚀刻速率和晶体表面形状的影响。从这些结果中,蚀刻浴组成的吉布斯三角形
2022-01-25 10:32:24 2215
2215 
的全面的物理和化学模型尚未建立。随着MEMS应用程序的不断增加,近年来人们对用来预测蚀刻表面剖面的过程建模、仿真和软件工具的兴趣越来越大。
2022-03-08 14:07:25 1768
1768 
在本研究中,我们设计了一个150mm晶片的湿蚀刻槽来防止硅片的背面蚀刻,并演示了优化的工艺配方,使各向异性湿蚀刻的背面没有任何损伤,我们还提出了300mm晶圆处理用湿浴槽的设计,作为一种很有前途的工艺发展。
2022-03-28 11:01:49 1943
1943 
为了阐明蚀刻残留物的形成机理,研究了氯/氦-氧、溴化氢/氦-氧和溴化氢/氯等不同气体混合物的影响,我们发现在氧的存在下,蚀刻残留物形成良好,这表明蚀刻残留物是由氧和非挥发性乳化硅化合物的反应
2022-05-06 15:49:50 1012
1012 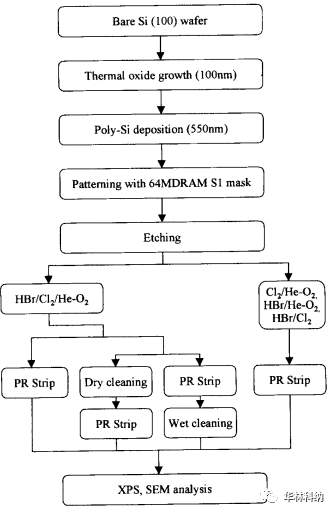
的电子和光电子器件的制造中对高选择性湿法化学蚀刻剂的额外需求,还进行了广泛的研究以检验多种蚀刻溶液。列出了这些蚀刻剂的蚀刻速率、选择性和表面粗糙度,以验证它们对预期应用的适用性。尽管频繁使用GaSb
2022-05-11 14:00:42 1024
1024 
在湿法各向异性蚀刻中,底切凸角的蚀刻轮廓取决于蚀刻剂的类型。已经进行了大量的研究来解释这种凸角底切并确定底切平面的方向。然而,还不清楚为什么不同蚀刻剂会出现不同形状的底切前沿。
2022-05-24 14:27:26 1571
1571 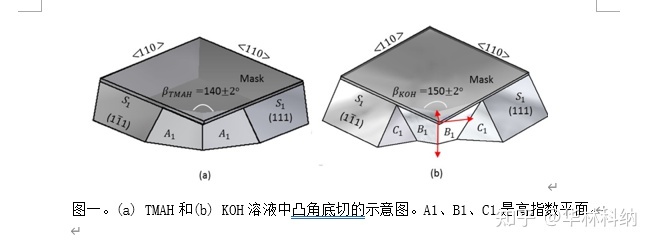
。二氧化硅通过分别用于微米和纳米鳍的光和电子束光刻形成图案,随后在氢氟酸中进行湿法蚀刻。使用用异丙醇(IPA)稀释的四甲基氢氧化铵(TMAH)以及具有表面活性剂(Triton-X-100)的硅掺杂TMAH
2022-07-08 15:46:16 1092
1092 
本文主要阐述我们华林科纳在补救InGaP/GaAs NPN HBT的喷雾湿法化学腐蚀过程中光刻胶粘附失效的几个实验的结果。确定了可能影响粘附力的几个因素,并使用实验设计(DOE)方法来研究所选因素
2022-07-12 14:01:13 1364
1364 
本次在补救InGaP/GaAs NPN HBT的喷雾湿法化学腐蚀过程中光刻胶粘附失效的几个实验的结果。确定了可能影响粘附力的几个因素,并使用实验设计(DOE)方法来研究所选因素的影响和相互作用。确定
2022-07-13 16:55:04 2263
2263 
引言 氢氧化钾(KOH)是一种用于各向异性湿法蚀刻技术的碱金属氢氧化物,是用于硅晶片微加工的最常用的硅蚀刻化学物质之一。各向异性蚀刻优先侵蚀衬底。也就是说,它们在某些方向上的蚀刻速度比在其
2022-07-14 16:06:06 2774
2774 
湿法蚀刻工艺的原理是利用化学溶液将固体材料转化为liquid化合物。由于采用了高选择性化学物质可以非常精确地适用于每一部电影。对于大多数解决方案选择性大于100:1。
2022-07-27 15:50:25 2109
2109 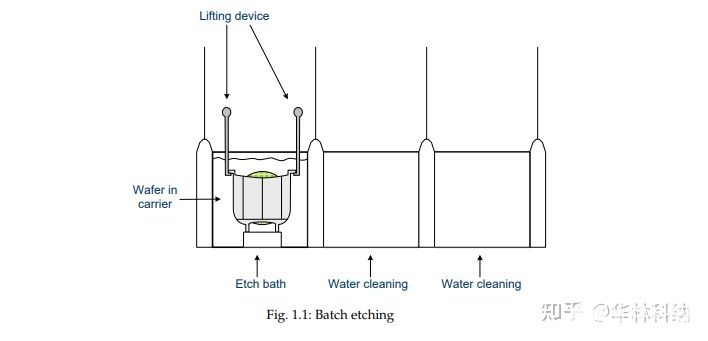
湿法蚀刻工艺的原理是使用化学溶液将固体材料转化为液体化合物。选择性非常高,因为所用化学药品可以非常精确地适应各个薄膜。对于大多数解决方案,选择性大于100:1。
2021-01-08 10:12:57
我司是做湿法蚀刻药水的,所以在湿法这块有很多年的研究。所以有遇到湿法蚀刻问题欢迎提问,很愿意为大家解答。谢谢!QQ:278116740
2017-05-08 09:58:09
、氢氟酸系、硫酸盐系、硫酸系、碱性氯化铜和酸性氯化铜系。蚀刻开始时,金属板表面被图形保护,其余金属面均和蚀刻液接触,此时蚀刻垂直向深度进行。当金属表面被蚀刻到一定深度后,裸露的两侧出现新的金属面,这时蚀刻液
2017-02-21 17:44:26
为了在基板上形成功能性的MEMS结构,必须蚀刻先前沉积的薄膜和/或基板本身。通常,蚀刻过程分为两类:浸入化学溶液后材料溶解的湿法蚀刻干蚀刻,其中使用反应性离子或气相蚀刻剂溅射或溶解材料在下文中,我们将简要讨论最流行的湿法和干法蚀刻技术。
2021-01-09 10:17:20
的距离的同时,还必须同喷淋的压力结合在一起进行研究和设计,即要达到蚀刻的高质量还必须符合经济性、适应性、可制造性、可维修性和可更换性。 4 压力:在设计时要考虑到压力对蚀刻液喷淋效果,对基板表面能否形成
2018-09-11 15:19:38
在一起进行研究和设计,即要达到蚀刻的高质量还必须符合经济性、适应性、可制造性、可维修性和可更换性。 4 压力:在设计时要考虑到压力对蚀刻液喷淋效果,对基板表面能否形成均匀的蚀刻液流动和蚀刻液的流动量的均衡性
2013-10-31 10:52:34
有效地将蚀刻表面上的旧溶液冲掉而保持新溶液与其接触。在喷淋面的边缘处,这种情况尤其突出。其喷射力比垂直方向的要小得多。 这项研究发现,最新的设计参数是65磅/平方英寸(即4+Bar)。每个蚀刻过程和每种
2018-11-26 16:58:50
/index.html 摘要:在 GaAs 传感梁表面的适当位置通过空气桥技术形成薄膜,它们本身固定在端部的刚性框架上,如图 1 所示。当外部加速度施加到加速度计时,地震块将发生位移由于惯性力。地震质量的这种运动
2021-07-07 10:22:15
使用化学溶液去除材料。在 CMOS 制造中,湿法工艺用于清洁晶片和去除薄膜。湿法清洁过程在整个工艺流程中重复多次。一些清洁过程旨在去除微粒,而另一些则是去除有机和/或无机表面污染物。湿蚀刻剂可以是各向同性
2021-07-06 09:32:40
、CMP、ICP 干蚀刻、亚表面损伤、等离子体诱导损伤 直接比较了 GaN 衬底的表面处理方法,即使用胶体二氧化硅浆料的化学机械抛光 (CMP) 和使用 SiCl4 气体的电感耦合等离子体 (ICP) 干
2021-07-07 10:26:01
重要材料的湿法腐蚀,即氧化锌、氮化镓和碳化硅。虽然氧化锌很容易在许多酸溶液中蚀刻,包括硝酸/盐酸和氢氟酸/硝酸,在非酸性乙酰丙酮中,第三族氮化物和碳化硅很难湿法蚀刻,通常使用干法蚀刻。已经研究了用于氮化
2021-10-14 11:48:31
已经报道了具有低至 4±6 nm 的 rms 粗糙度的表面。湿法蚀刻也已被证明用于蚀刻氮化镓,蚀刻具有设备成本相对较低、表面损伤小等优点,但目前还没有找到生产光滑垂直侧壁的方法。还报道了 GaN 的解理
2021-07-07 10:24:07
湿法蚀刻 InGaP 和 GaAs 的结果。以前,发现这些蚀刻剂产生令人满意的效果。 然而,这些解决方案的一个严重缺点是它们会侵蚀金,金随后可能会重新沉积在 MESA 结构的斜面和蚀刻表面本身上。因此
2021-07-09 10:23:37
://www.wetsemi.com/index.html 关键词:光刻胶附着力,砷化镓,湿蚀刻,表面处理,轮廓 概要报告了几个旨在修复 InGaP/GaAs NPN HBT 喷雾湿法化学蚀刻期间光刻胶粘附失效
2021-07-06 09:39:22
,干法蚀刻制备的氮化镓(GaN)侧壁通常具有较大的粗糙度和蚀刻损伤,这会导致由于表面非辐射复合导致的光学散射和载流子注入损失引起的镜面损失。详细研究了干法蚀刻形成的GaN侧壁面的湿化学抛光工艺,以去除蚀刻
2021-07-09 10:21:36
摘要:在印制电路制作过程中,蚀刻是决定电路板最终性能的最重要步骤之一。所以,研究印制电路的蚀刻过程具有很强的指导意义,特别是对于精细线路。本文将在一定假设的基础上建立模型,并以流体力学为理论基础
2018-09-10 15:56:56
分的喷射力就会降低而不能有效地将蚀刻表面上的旧溶液冲掉使新溶液与其接触。在喷淋面的边缘处,这种情况尤为突出,其喷射力比垂直喷射要小得多。这项研究发现﹐最新的设计参数是65磅/平方英寸(即4+Bar
2017-06-23 16:01:38
湿蚀刻是光刻之后的微细加工过程,该过程中使用化学物质去除晶圆层。晶圆,也称为基板,通常是平面表面,其中添加了薄薄的材料层,以用作电子和微流体设备的基础;最常见的晶圆是由硅或玻璃制成的。湿法刻蚀
2021-01-08 10:15:01
其中国市场的开发、推广。公司自有产品包括半导体前段、后段、太阳能、平板显示FPD、LED、MEMS应用中的各种湿制程设备,例如硅片湿法清洗、蚀刻,硅芯硅棒湿法化学处理,液晶基板清洗,LED基片显影脱膜等
2015-04-02 17:23:36
书籍:《炬丰科技-半导体工艺》 文章:单晶的湿法蚀刻和红外吸收 编号:JFKJ-21-206 作者:炬丰科技 摘要 采用湿法腐蚀、x射线衍射和红外吸收等方法研究了物理气相色谱法生长AlN单晶的缺陷
2023-04-23 11:15:00 118
118 低损耗硅波导和有效的光栅耦合器来将光耦合到其中。通过使用各向异性湿法蚀刻技术,我们将侧壁粗糙度降低到1.2纳米。波导沿[112]方向在绝缘体上硅衬底上形成图案。
2021-12-22 10:17:21 712
712 )、(TMAH)、NaOH等,但KOH与TMAH相比,平整度更好,并且只对硅的 100 表面做出反应,因此Fig。如1所示,具有54.74的各向异性蚀刻特性,毒性小。使用KOH的硅各向异性湿式蚀刻在压力传感器、加速度计、光学传感器等整体MEMS装置结构形成等中使用。 实验 KOH硅湿法蚀刻工艺 工艺
2021-12-23 09:55:35 484
484 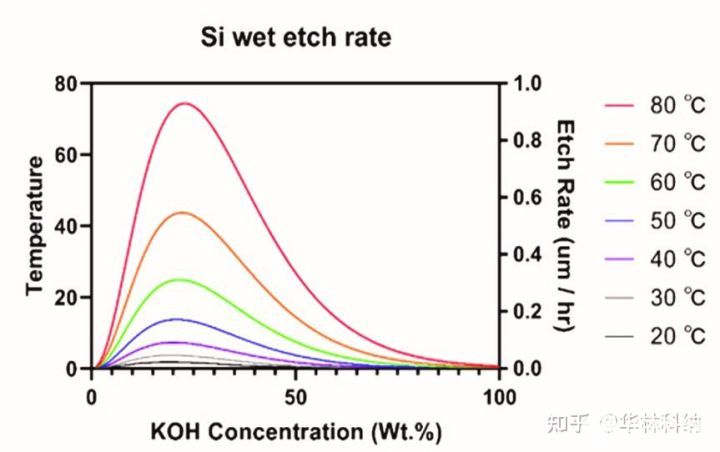
引言 到目前为止,GaAs晶片的直接再利用受到晶片表面上的残留物的限制,这些残留物不能利用一般的清洗方法方式去除。因此,用显微技术、轮廓术和x光电子能谱研究了氢氟酸对GaAs晶片的腐蚀。发现在蚀刻
2021-12-28 16:34:37 627
627 
引言 我们华林科纳研究了溶剂和清洗剂的湿法清洗工艺对沉积氧化镁(001)衬底表面化学性质的影响。比较了使用溶剂和洗涤剂的六种不同的湿法清洗工艺。通过示例系统ScN研究了对薄膜生长的影响。用X射线
2022-01-04 17:12:21 517
517 
的光学特性。样品的全反射系数低于未经处理的硅太阳能电池。硅太阳能电池的整体效率取决于所选的银离子浓度制备条件和湿法蚀刻时间。太阳能电池的纹理化表面显示出效率的提高,电路光电流高于没有纹理化的参考硅太阳能电池。给出了
2022-01-04 17:15:35 629
629 
不可预测地改变了蚀刻剂的质量。 为了解决成分变化的问题,研究开始了确定一种可靠的分析蚀刻剂的方法。当分析程序最终确定时,将建立一个控制程序,其中蚀刻剂成分将保持尽可能接近一个固定的值。经过尝试的各种分析技术,
2022-01-07 16:47:46 840
840 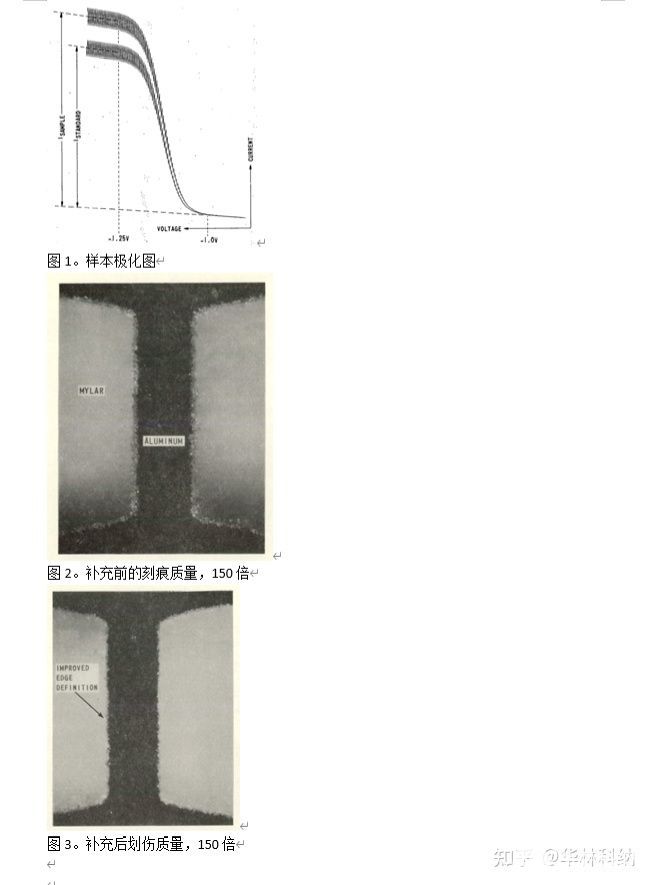
方法来解释在(NH4)2cr 2o 7–HBr–EG蚀刻溶液中InAs、InSb和GaAs、GaSb半导体溶解过程的特征。蚀刻动力学数据表明,晶体溶解具有扩散决定的性质。溶剂浓度从80体积降低到0体积。根据溶液的组成,我们研究了两种类型的晶体表面形态,抛光和钝化的薄膜
2022-01-11 16:17:33 689
689 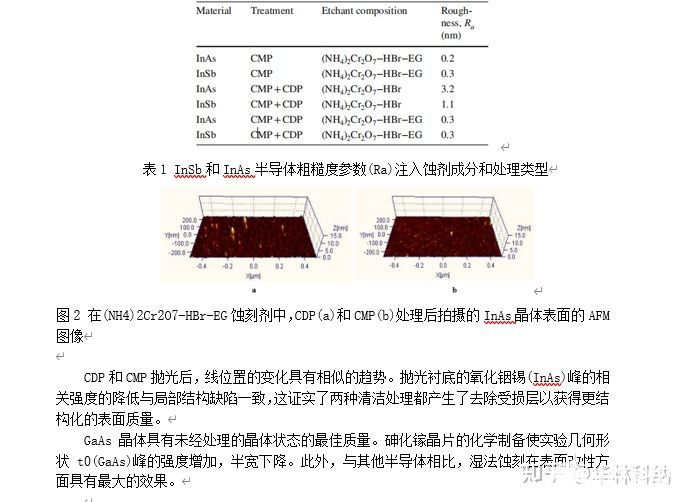
上降低了(100)和(h11)面的蚀刻速率。 为了在低氢氧化钾浓度下获得低粗糙度的(100)表面,蚀刻溶液必须含有饱和水平的异丙醇。在我们的研究中,我们研究了异丙醇浓度对具有不同晶体取向的硅衬底的蚀刻速率和表面形态的影响。还研究了氢氧化钾浓度对(
2022-01-13 13:47:26 1156
1156 
蚀刻的湿法蚀刻技术的方法。本文分析了玻璃湿法刻蚀工艺的基本要素,如:玻璃成分的影响、刻蚀速率、掩膜层残余应力的影响、主要掩膜材料的表征、湿法刻蚀工艺产生的表面质量。通过分析的结果,提出了一种改进的玻璃深度湿
2022-01-19 16:13:40 1873
1873 
湿法蚀刻工艺已经广泛用于生产各种应用的微元件。这些过程简单易操作。选择合适的化学溶液(即蚀刻剂)是湿法蚀刻工艺中最重要的因素。它影响蚀刻速率和表面光洁度。铜及其合金是各种工业,特别是电子工业的重要
2022-01-20 16:02:24 1860
1860 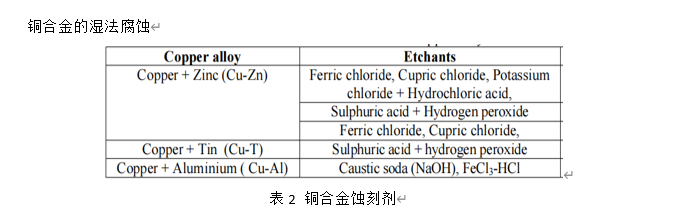
摘要 我们华林科纳用同步光电发射光谱法研究了无氧化物砷化镓表面与酸性(盐酸+2-丙醇)和碱性(氨水)溶液的相互作用。结果表明,两种溶液主要处理表面镓原子,分别形成弱可溶性氯化镓和可溶性氢化镓。因此
2022-01-24 15:07:30 1071
1071 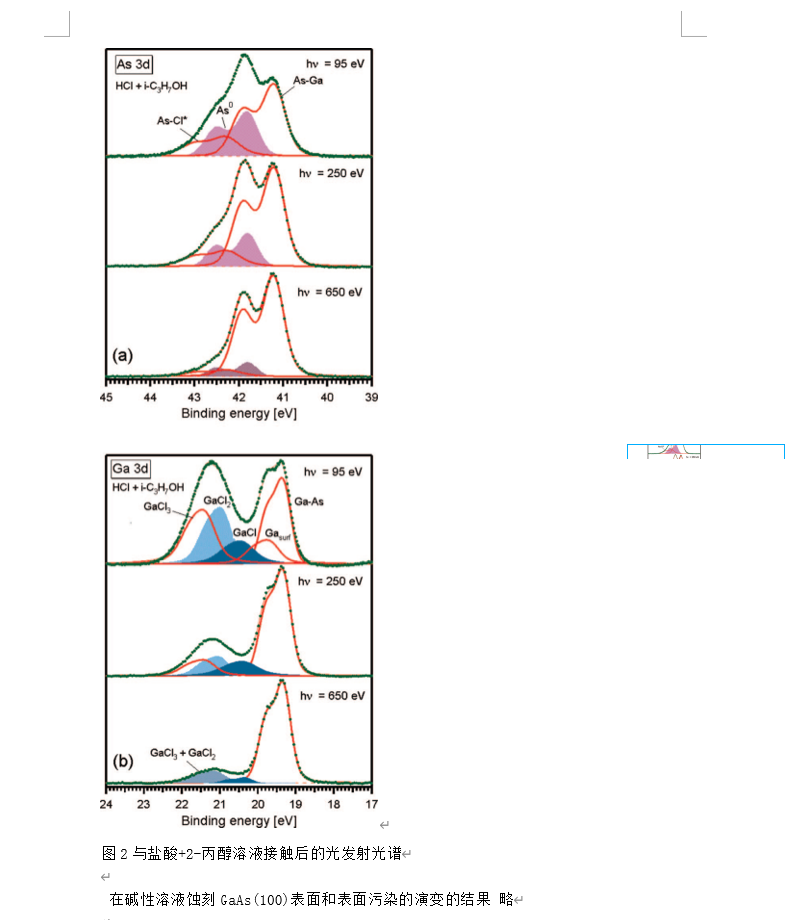
的磷酸和氢氧化钾溶液中,氮化镓上可以观察到氧化镓的形成。这归因于两步反应过程并且在此过程中,紫外线照射可以增强氮化镓的氧化溶解。 实验中,我们使用深紫外紫外光照射来研究不同酸碱度电解质中的湿法蚀刻过程。因此,我们能够首次在PEC蚀
2022-01-24 16:30:31 948
948 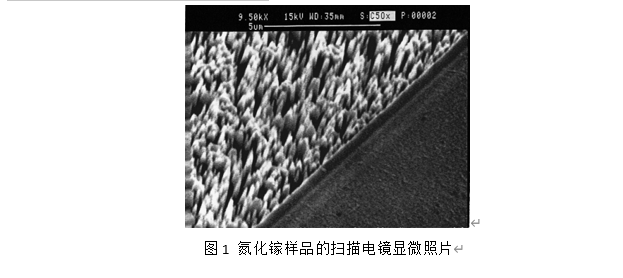
摘要 FeCl3·6h2o用于单晶氧化锌薄膜的湿法蚀刻。该方法对抑制用酸蚀刻氧化锌薄膜时通常观察到的“W”形蚀刻轮廓有很大的影响。通过触控笔轮廓仪和扫描电子显微镜证实,在广泛的蚀刻速率下获得了
2022-01-26 14:46:48 307
307 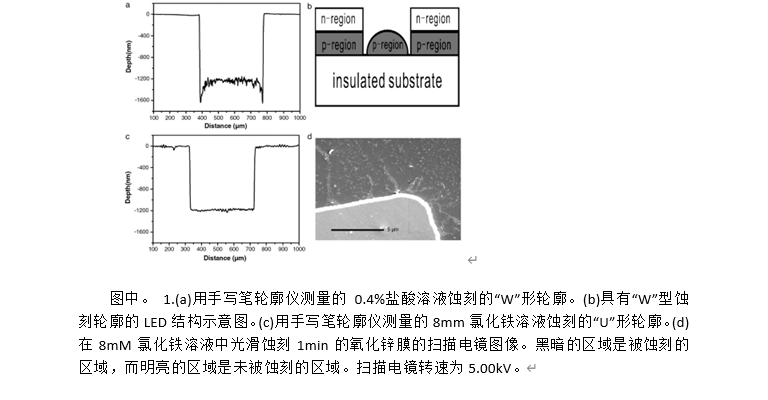
化学蚀刻是一种技术,其中材料中电子和空穴的光生增强了材料的化学蚀刻。本文已经对各种半导体材料进行了湿法PEC蚀刻研究,结果表明,湿法PEC蚀刻可以产生高蚀刻速率、良好的各向异性,以及不同掺杂和带隙材料之间的高选择性 。明斯基等
2022-02-07 14:35:42 1479
1479 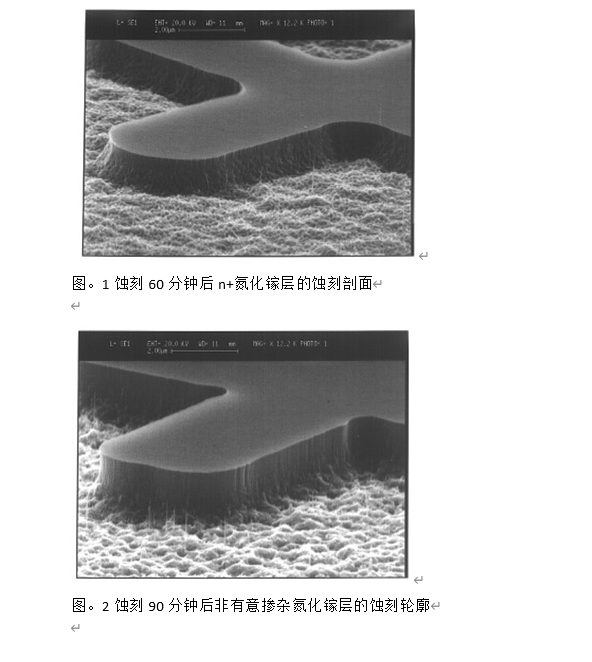
蚀刻或离子注入,会导致高达10i2-1013 atom/em2的金属污染。湿法工艺对于去除干法加工过程中引入的这些:金属杂质变得越来越重要。
2022-02-10 15:49:18 537
537 
我们华林科纳使用K2S2O8作为氧化剂来表征基于KOH的紫外(UV)光辅助湿法蚀刻技术。该解决方案提供了良好控制的蚀刻速率,并产生了光滑的高质量蚀刻表面,同时通过原子力显微镜测量的表面粗糙度降低最小
2022-02-14 16:14:55 716
716 
的组成,我们研究了两种类型的晶体表面形态,抛光和钝化的薄膜,形成后的化学动态(CDP)和/或化学机械抛光(化学机械抛光)在溶液中,饱和的溶剂和氧化剂,结果发现,在抛光蚀刻剂中,CDP和CMP工艺均能形成
2022-02-14 16:47:05 447
447 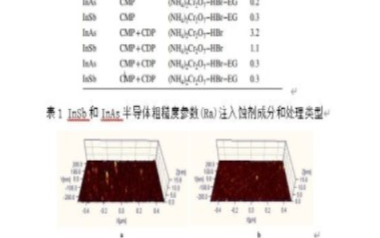
为了能够使用基于 GaAs 的器件作为化学传感器,它们的表面必须进行化学改性。GaAs 表面上液相中分子的可重复吸附需要受控的蚀刻程序。应用了几种分析方法,包括衰减全反射和多重内反射模式 (ATR
2022-02-17 16:41:52 1351
1351 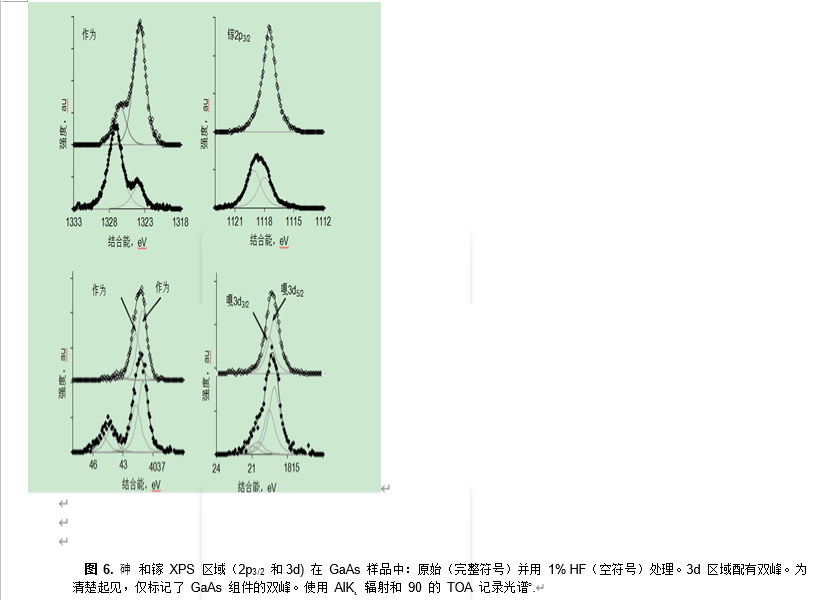
电感耦合等离子体反应离子蚀刻获得的高蚀刻速率和高度各向异性的轮廓。光增强湿法蚀刻提供了一种获得高蚀刻速率而没有离子诱导损伤的替代途径。该方法适用于器件制造以及n-氮化镓中位错密度的估算。这有可能发展成为一种快速评估材料的方法。
2022-02-23 16:20:24 2208
2208 
引言 抛光液中的污染物和表面划痕、挖掘和亚表面损伤(固态硬盘)等缺陷是激光损伤的主要前兆。我们提出了在抛光后使用HF/HNO3或KOH溶液进行深度湿法蚀刻,以提高熔融石英光学器件在351 nm波长
2022-02-24 16:26:03 2429
2429 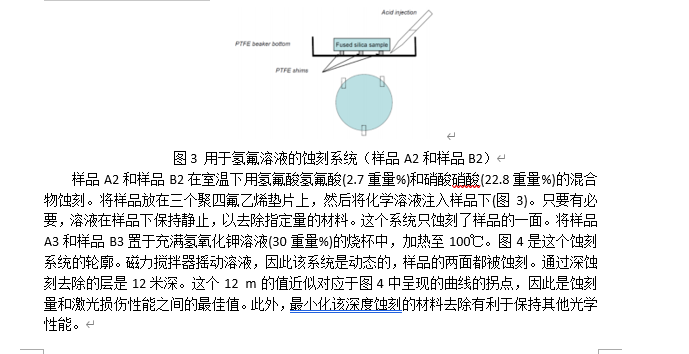
性,单片湿法刻蚀法是一种有用的技术。其进一步推进应得到理论计算的支持。 因此,在我们之前的研究中开发了使用单晶片湿法蚀刻机进行二氧化硅膜蚀刻的数值计算模型。首先,通过水流可视化获得旋转晶片上的整个水运动,并进行评估
2022-03-02 13:58:36 750
750 
在 KOH 水溶液中进行湿法化学蚀刻期间,硅 (1 1 1) 的绝对蚀刻速率已通过光学干涉测量法使用掩膜样品进行了研究。蚀刻速率恒定为0.62 ± 0.07 µm/h 且与 60
2022-03-04 15:07:09 845
845 
各向异性蚀刻剂通过掩模中的矩形幵口在(100)硅晶片上产生由( 100)和(111)平面组成的孔。在这种情况下,孔的上角是尖的。如果通过无掩模湿法各向异性蚀刻工艺蚀刻整个表面,则上部拐角变圆。例如
2022-03-07 15:26:14 372
372 
摘要 几个旨在补救的实验结果在喷湿化学品时,光刻胶粘附失效报道了InGaP/GaAs NPN hbt的刻蚀。 几个确定了影响黏附和黏附的因素采用实验设计(DOE)方法研究选定因素的影响和相互作用
2022-03-07 16:28:03 984
984 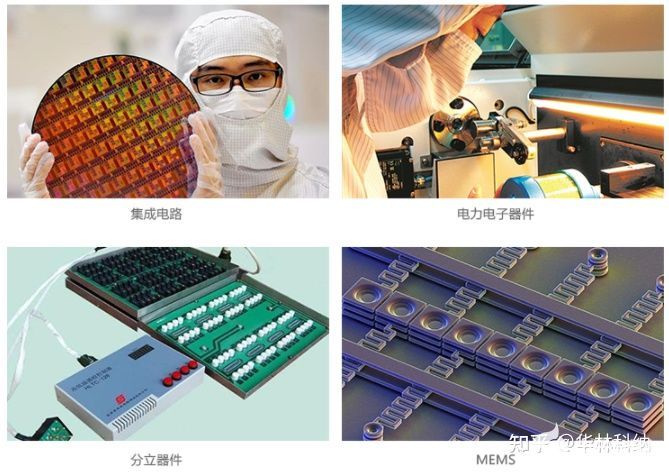
高效薄膜太阳能电池需要具有高吸收、低缺陷、透明导电的吸收层 氧化物(TCO)薄膜,透过率超过80%,导电率高。 此外,光可以通过玻璃捕获并送至光吸收层以提高效率。 本文研究了玻璃表面形貌的形式利用
2022-03-08 11:52:41 1213
1213 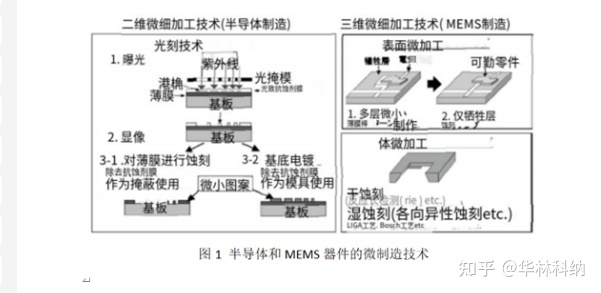
提高10倍的吞吐量。 虽然大多数公司使用干式蚀刻工艺来创建图案表面,但干式蚀刻的缺点并不小,包括加工设备的成本高,吞吐量低,扩展性差等等。 这种不利因素促使许多人重新燃起对湿法蚀刻的兴趣。历史上,标准
2022-03-08 13:34:36 528
528 我们在蚀刻的硅(110)表面上实验观察到的梯形小丘的形成,描述它们的一般几何形状并分析关键表面位置的相对稳定性和(或)反应性。在我们的模型中,小丘被蚀刻剂中的铜杂质稳定,铜杂质吸附在表面上并作
2022-03-10 16:15:56 228
228 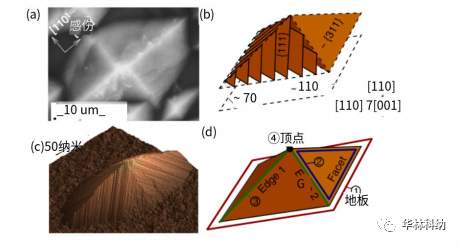
我们开发了一种改进的各向异性湿法蚀刻工艺,通过在晶片上使用单个蚀刻掩模来制造各种硅微结构,这些微结构具有圆形凹角和尖锐凸角、用于芯片隔离的凹槽、蜿蜒的微流体通道、具有弯曲V形凹槽的台面结构以及具有
2022-03-14 10:51:42 581
581 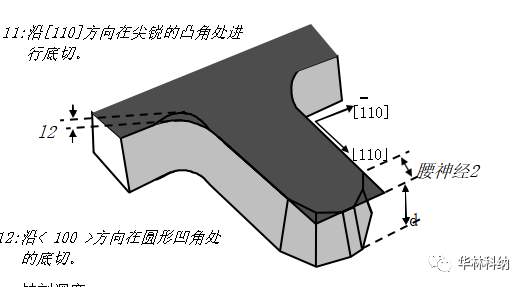
摘要 采用湿法腐蚀、x射线衍射(XRD)和红外吸收等方法研究了物理气相色谱法(PVT)生长AlN(0001)单晶的缺陷和晶格完善性。 一个正六边形的蚀刻坑密度(EPD)约为4000厘米在AlN
2022-03-14 14:40:34 286
286 
微加工过程中有很多加工步骤。蚀刻是微制造过程中的一个重要步骤。术语蚀刻指的是在制造时从晶片表面去除层。这是一个非常重要的过程,每个晶片都要经历许多蚀刻过程。用于保护晶片免受蚀刻剂影响的材料被称为掩模
2022-03-16 16:31:58 1134
1134 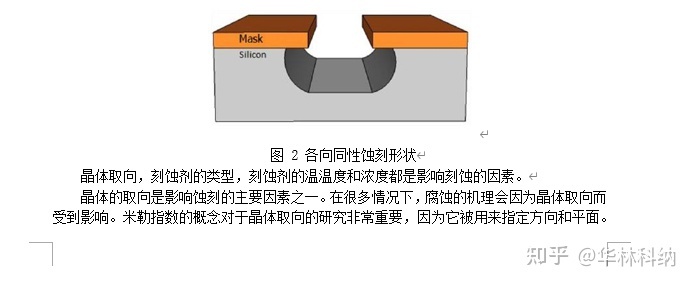
本文我们华林科纳半导体有限公司研究了类似的现象是否发生在氢氧化钾溶液中添加的其他醇,详细研究了丁基醇浓度对(100)和(110)Si平面表面形貌和蚀刻速率的影响,并给出了异丙醇对氢氧化钾溶液的蚀刻结果,为了研究醇分子在蚀刻溶液中的行为机理,我们还对溶液的表面张力进行了测量。
2022-03-18 13:53:01 288
288 
本研究为了将硅晶片中设备激活区的金属杂质分析为ICP-MS或GE\AS,利用HF和HNQ混酸对硅晶片进行不同厚度的重复蚀刻,在晶片内表面附近,研究了定量分析特定区域中金属杂质的方法。
2022-03-21 16:15:07 338
338 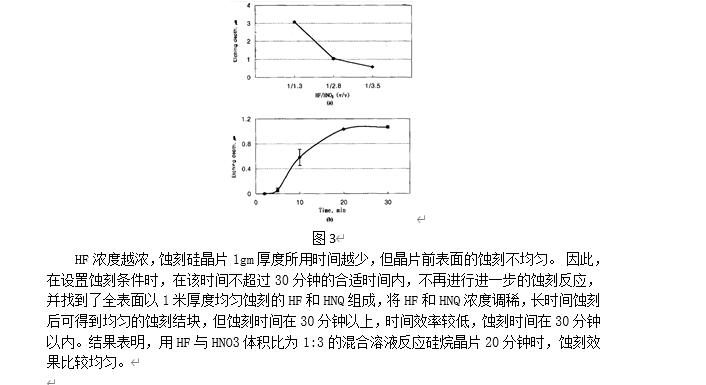
本文章将对表面组织工艺优化进行研究,多晶硅晶片表面组织化工艺主要分为干法和湿法,其中利用酸或碱性溶液的湿法蚀刻工艺在时间和成本上都比较优秀,主要适用于太阳能电池量产工艺。本研究在多晶晶片表面组织化
2022-03-25 16:33:49 516
516 
本文研究了通过光敏抗蚀剂的湿蚀刻剂渗透。后者能够非常快速地响应选择湿蚀刻剂/聚合物的兼容性,以保护下面的膜不被降解。如今,大多数材料图案化是用等离子蚀刻而不是湿法蚀刻来进行的。事实上,与通常
2022-04-06 13:29:19 666
666 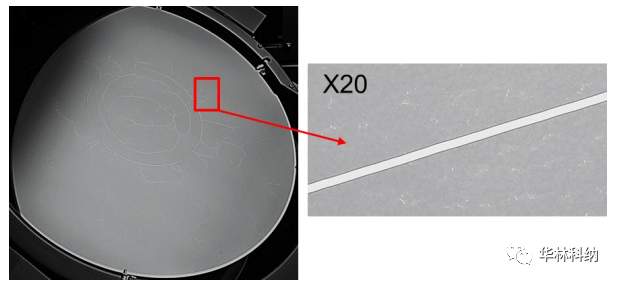
关于在进行这种湿法或干法蚀刻过程中重要的表面反应机制,以Si为例,以基础现象为中心进行解说。蚀刻不仅是在基板上形成的薄膜材料的微细加工、厚膜材料的三维加工和基板贯通加工,而且是通过研磨和研磨等机械
2022-04-06 13:31:25 4183
4183 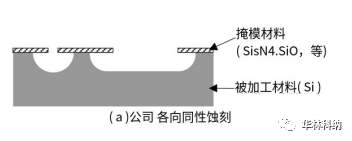
,并添加化学物质来调整粘度和单晶圆旋转加工的表面润湿性。 当硅被蚀刻并并入蚀刻溶液时,蚀刻速率将随时间而降低。 这种变化已经建模。 这些模型可以延长时间,补充化学物质,或者两者兼而有之。
2022-04-07 14:46:33 751
751 
本文研究了用金刚石线锯切和标准浆料锯切制成的180微米厚5英寸半宽直拉单晶硅片与蚀刻时间的关系,目的是确定FAS晶片损伤蚀刻期间蚀刻速率降低的根本原因,无论是与表面结构相关,缺陷相关,由于表面存在的氧化层,还是由于有机残差。
2022-04-18 16:36:05 406
406 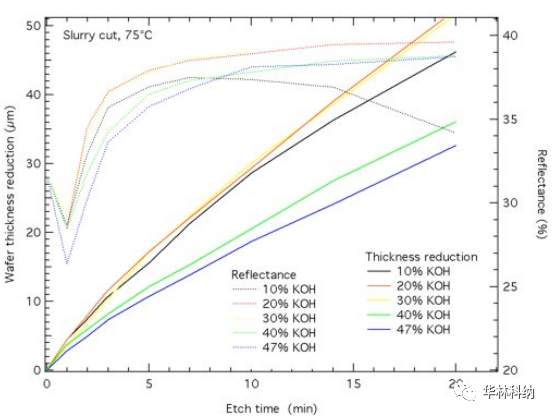
的大规模集成电路密度,已经研究了颗粒和微污染对晶片的影响,以提高封装产量。湿法清洗/蚀刻工艺的湿法站配置有晶片装载器/卸载器、化学槽、溢流冲洗槽和干燥器。
2022-04-21 12:27:43 589
589 
本文研究了通过光敏抗蚀剂的湿蚀刻剂渗透。后者能够非常快速地响应选择湿蚀刻剂/聚合物的兼容性,以保护下面的膜不被降解。如今,大多数材料图案化是用等离子蚀刻而不是湿法蚀刻来进行的。事实上,与通常
2022-04-22 14:04:19 591
591 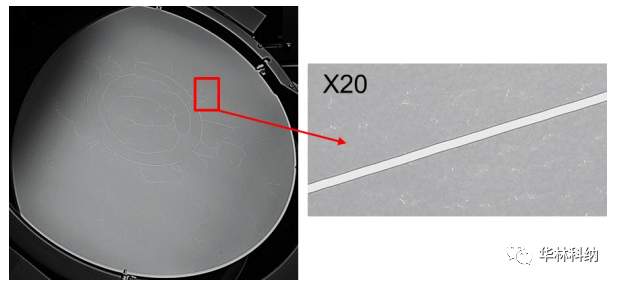
为了将硅晶片中设备激活区的金属杂质分析为ICP-MS或GE\AS,利用HF和HNQ混酸对硅晶片进行不同厚度的重复蚀刻,在晶片内表面附近,研究了定量分析特定区域中消除金属杂质的方法。
2022-04-24 14:59:23 497
497 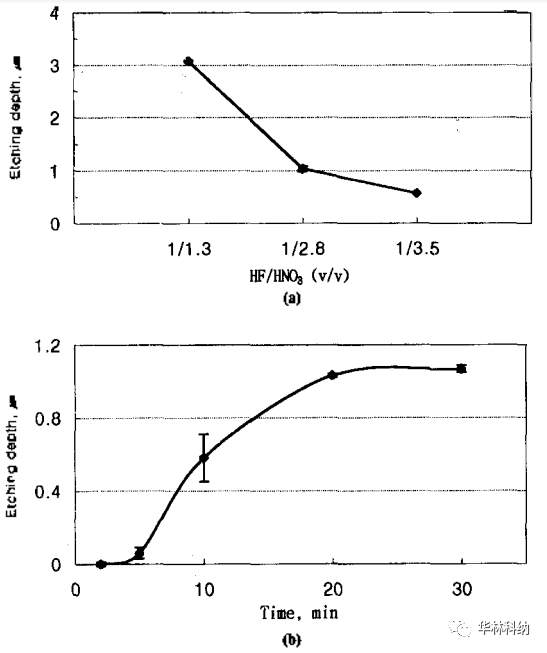
金属涂层,如铜膜,可以很容易地沉积在半导体材料上,如硅晶片,而无需使无电镀工艺进行预先的表面预处理。然而,铜膜的粘附性可能非常弱,并且容易剥离。在本研究中,研究了在氢氟酸溶液中蚀刻作为硅晶片化学镀
2022-04-29 15:09:06 464
464 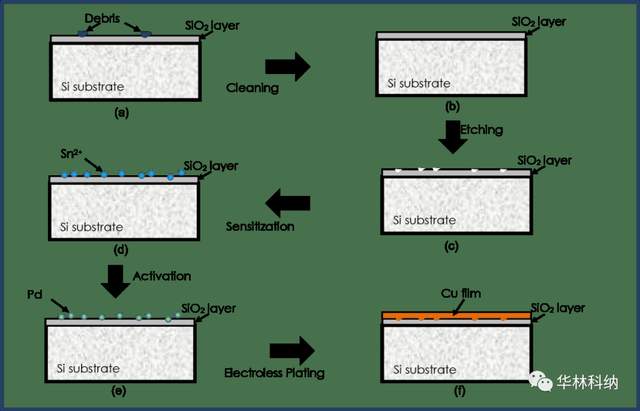
的晶面具有更低的表面粗糙度。还研究了沟道底部的沟槽和斜面(长方体),搅动长方体的去除或晶面刻蚀速率的提高。最后,研究了有无紫外光照射下,紫外光对三甲基氯化铵中m和a-GaN晶面刻蚀速率的影响。因此,发现用紫外光将m-GaN平面蚀刻速率从0.69纳米
2022-05-05 16:38:03 1394
1394 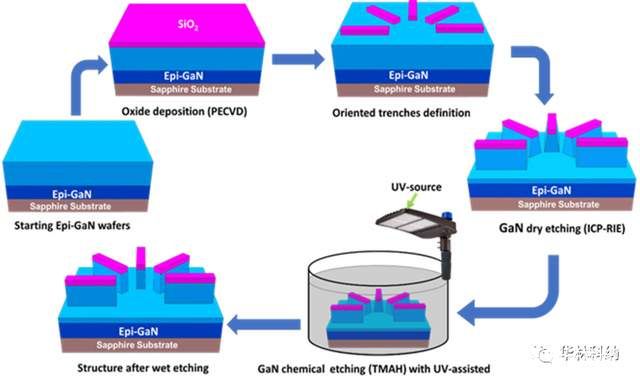
氢氧化钾(KOH)是一种用于各向异性湿法蚀刻技术的碱金属氢氧化物,是用于硅晶片微加工最常用的硅蚀刻化学物质之一。各向异性蚀刻优先侵蚀衬底。也就是说,它们在某些方向上的蚀刻速度比在其他方向上的蚀刻
2022-05-09 15:09:20 1419
1419 本次在补救InGaP/GaAs NPN HBT的喷雾湿法化学腐蚀过程中光刻胶粘附失效的几个实验的结果。确定了可能影响粘附力的几个因素,并使用实验设计(DOE)方法来研究所选因素的影响和相互作用。确定
2022-05-10 15:58:32 504
504 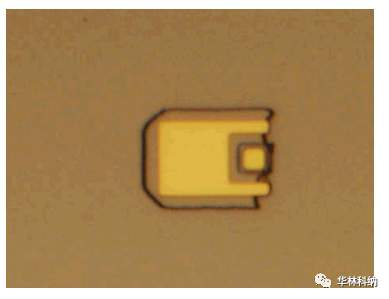
在使用低温卡盘的低压高密度等离子体反应器中研究了硅结构的深且窄的各向异性蚀刻。我们华林科纳以前已经证明了这种技术在这种结构上的可行性。已经研究了蚀刻速率和轮廓的改进,并且新的结果显示
2022-05-11 15:46:19 730
730 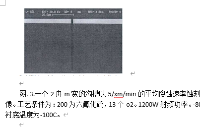
我们华林科纳研究探索了一种新的湿法腐蚀方法和减薄厚度在100 µm以下玻璃的解决方案,为了用低氢氟酸制备蚀刻溶液,使用NH4F或nh4hf 2作为主要成分并加入硫酸或硝酸是有效的,研究了混合酸溶液
2022-05-20 16:20:24 3160
3160 本文提出了基于溅射Ti/Pt/Cr和Cr/Pt/Cr金属多层膜在热王水中湿法腐蚀Pt薄膜的简单制备方案,铬(Cr)或钛(Ti)用作铂的粘附层,Cr在Pt蚀刻过程中被用作硬掩模层,因为它可以容易
2022-05-30 15:29:15 2171
2171 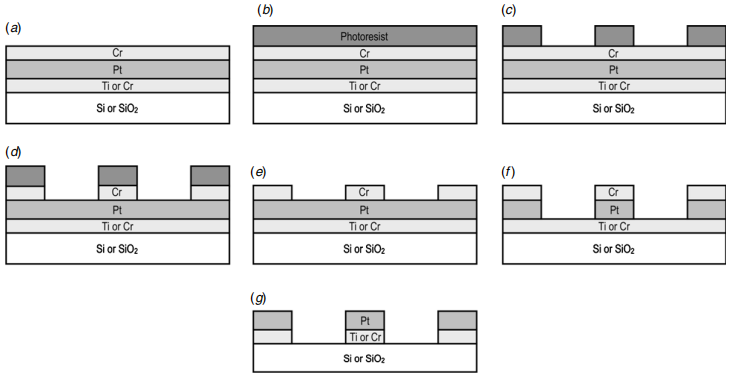
引用 本文介绍了我们华林科纳半导体研究了取向硅在氢氧化钾水溶液中的各向异性腐蚀特性和凸角底切机理。首先,确定控制底切的蚀刻前沿的晶面,并测量它们的蚀刻速率。然后,基于测量数据,检验了凸角补偿技术
2022-06-10 17:03:48 1113
1113 
引言 我们华林科纳描述了一种与去离子水中铜的蚀刻相关的新的成品率损失机制。在预金属化湿法清洗过程中,含有高浓度溶解氧的水会蚀刻通孔底部的铜。蚀刻在金属化后残留的Cu中产生空隙,导致受影响的阵列电路
2022-06-16 16:51:10 1801
1801 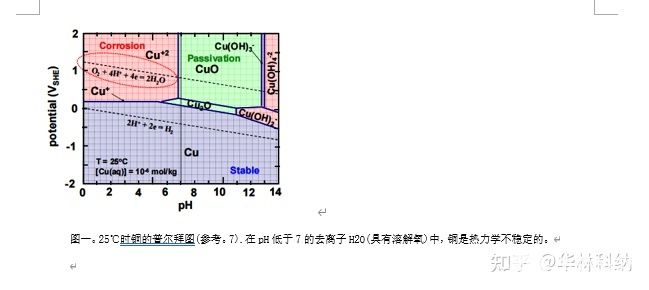
引言 我们华林科纳提出了一种新的GaAs表面湿法清洗工艺。它的设计是为了技术的简单性和在GaAs表面产生的最小损害。它将GaAs清洗与三个条件结合起来,这三个条件包括(1)去除热力学不稳定的物质
2022-06-16 17:24:02 793
793 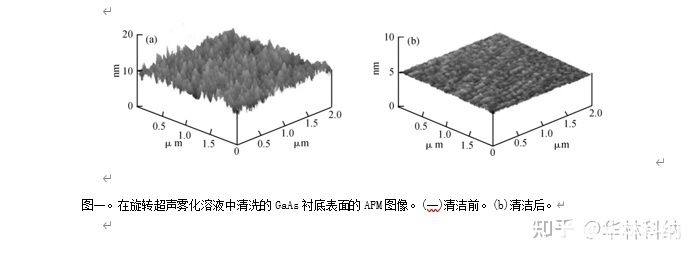
的逐层秘密。随着制造工艺的变化和半导体结构的变化,这些技术需要在时间和程序上不断调整。虽然有许多工具有助于这些分析,如RIE(反应离子蚀刻-一种干法蚀刻技术)、离子铣削和微切割,但钨的湿法化学蚀刻有时比RIE技术更具重现性。
2022-06-20 16:38:20 5220
5220 
本文报道了InGaP/GaAsNPNHBTs在喷雾湿化学蚀刻过程中修复光刻胶粘附失败的实验结果。我们确定了几个可能影响粘附性的因素,并采用实验设计(DOE)方法研究了所选因素的影响和相互作用。最显著
2022-06-29 11:34:59 0
0 本文描述了我们华林科纳一种新的和简单的方法,通过监测腐蚀过程中薄膜的电阻来研究湿法腐蚀ITO薄膜的动力学,该方法能够研究0.1至150纳米/分钟之间的蚀刻速率。通常可以区分三种不同的状态:(1)缓慢
2022-07-01 14:39:13 2242
2242 
本文研究了室温下盐酸和王水溶剂对ITO膜腐蚀行为的影响,在王水中比在盐酸中获得更高的蚀刻速率,然而,通过XPS分析,发现在王水蚀刻剂中比在HCl中有更多的表面残留副产物,在王水和HCl中的表面
2022-07-01 16:50:56 1350
1350 
在本研究中,我们华林科纳研究了在液晶显示(LCD)技术中常用的蚀刻剂中相同的ITO薄膜的蚀刻速率,保持浴液温度恒定,并比较了含有相同浓度的酸的溶液,对ITO在最有趣的解决方案中的行为进行了更详细的研究,试图阐明这些浴液中的溶解机制。
2022-07-04 15:59:58 1434
1434 
中以及在非酸性乙酰丙酮中容易被蚀刻,但是III族氮化物和SiC非常难以湿法蚀刻,并且通常使用干法蚀刻。已经研究了用于GaN和SiC的各种蚀刻剂,包括含水无机酸和碱溶液,以及熔融盐。湿法蚀刻对宽带隙半导体技术具有多种应用,包括缺陷装饰、通过产生特征凹坑或小丘来识
2022-07-06 16:00:21 1642
1642 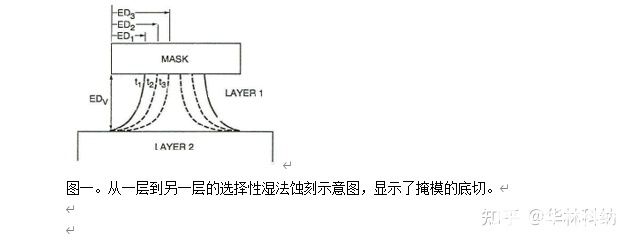
本文介绍了我们华林科纳在半导体制造过程中进行的湿法蚀刻过程和使用的药液,在晶圆表面,为了形成LSI布线,现在几乎所有的半导体器件都使用干蚀刻方式,这是因为干法蚀刻与湿法蚀刻相比,各向异性较好,对于形成细微的布线是有利的。
2022-07-06 16:50:32 1538
1538 
薄晶片已成为各种新型微电子产品的基本需求。更薄的模具需要装进更薄的包装中。与标准的机械背磨相比,在背面使用最终的湿法蚀刻工艺而变薄的晶片的应力更小。
2022-08-26 09:21:36 2363
2363 
在半导体湿法蚀刻中, 热磷酸广泛地用于对氮化硅的去除工艺, 实践中发现温下磷酸对氮化硅蚀刻率很难控制。 从热磷酸在氮化硅湿法蚀刻中的蚀刻原理出发, 我们华林科纳分析了影响蚀刻率的各个因素, 并通过
2022-08-30 16:41:59 2993
2993 
蚀刻不是像沉积或键合那样的“加”过程,而是“减”过程。另外,根据刮削方式的不同,分为两大类,分别称为“湿法蚀刻”和“干法蚀刻”。简单来说,前者是熔法,后者是挖法。
2023-01-29 09:39:00 3850
3850 干法蚀刻与湿法蚀刻之间的争论是微电子制造商在项目开始时必须解决的首要问题之一。必须考虑许多因素来决定应在晶圆上使用哪种类型的蚀刻剂来制作电子芯片,是液体(湿法蚀刻)还是气体(干法蚀刻)
2023-04-12 14:54:33 1004
1004 蚀刻是微结构制造中采用的主要工艺之一。它分为两类:湿法蚀刻和干法蚀刻,湿法蚀刻进一步细分为两部分,即各向异性和各向同性蚀刻。硅湿法各向异性蚀刻广泛用于制造微机电系统(MEMS)的硅体微加工和太阳能电池应用的表面纹理化。
2023-05-18 09:13:12 700
700 
等离子体蚀刻是氮化镓器件制造的一个必要步骤,然而,载体材料的选择可能会实质上改变蚀刻特性。在小型单个芯片上制造氮化镓(GaN)设备,通常会导致晶圆的成本上升。在本研究中,英思特通过铝基和硅基载流子来研究蚀刻过程中蚀刻速率、选择性、形貌和表面钝化的影响。
2023-05-30 15:19:54 452
452 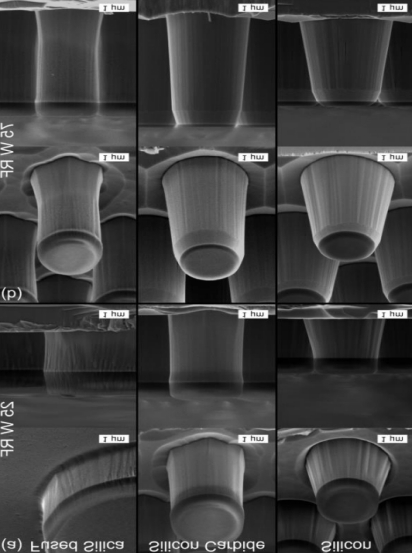
GaN及相关合金可用于制造蓝色/绿色/紫外线发射器以及高温、高功率电子器件。由于 III 族氮化物的湿法化学蚀刻结果有限,因此人们投入了大量精力来开发干法蚀刻工艺。干法蚀刻开发一开始集中于台面结构,其中需要高蚀刻速率、各向异性轮廓、光滑侧壁和不同材料的同等蚀刻。
2023-10-07 15:43:56 319
319 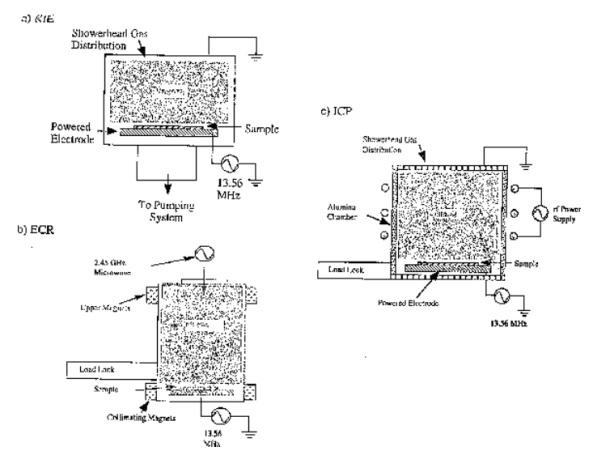



 电子发烧友App
电子发烧友App









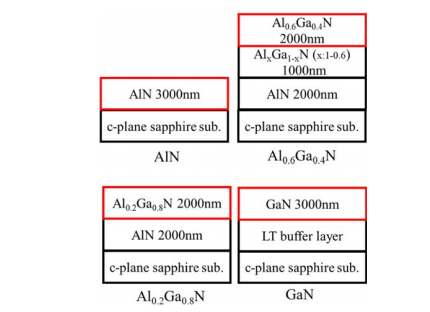

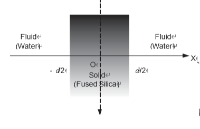




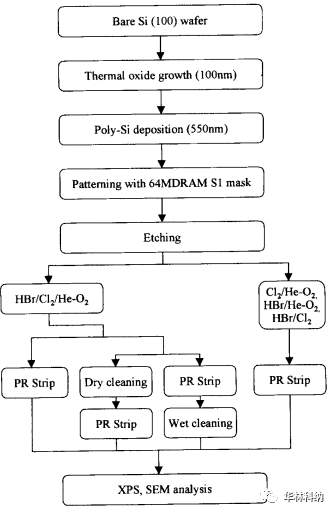

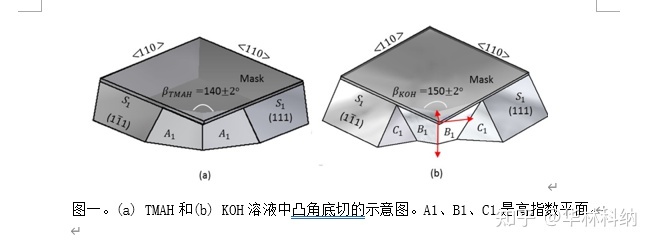




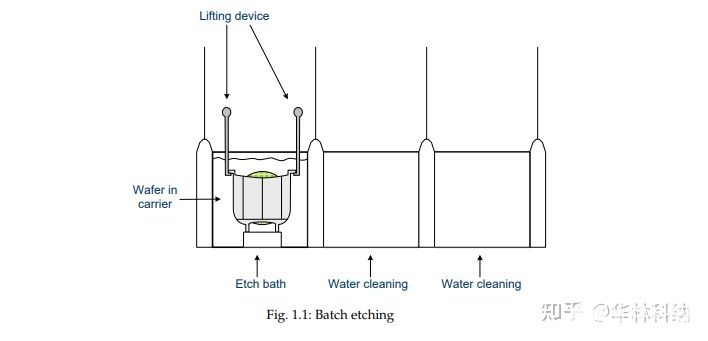
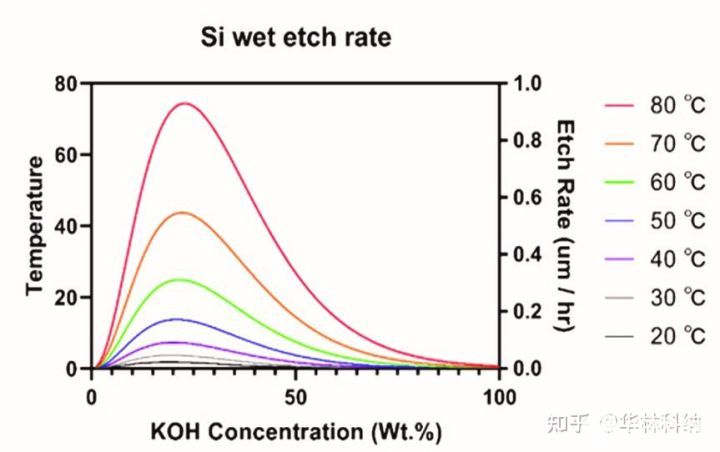



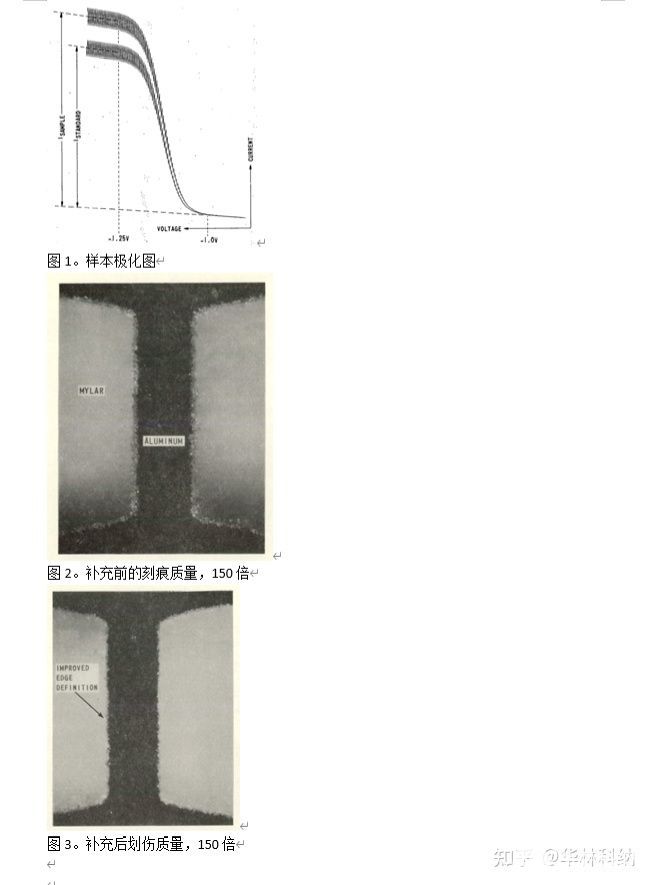
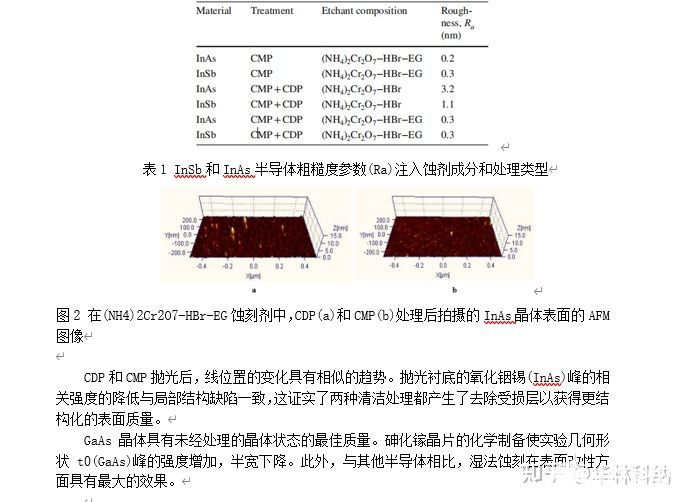


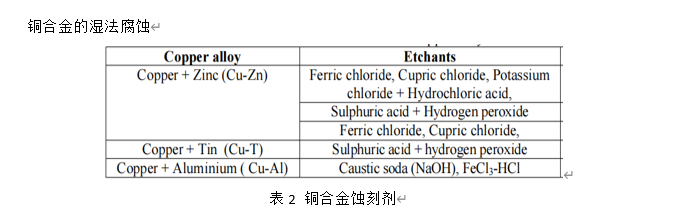
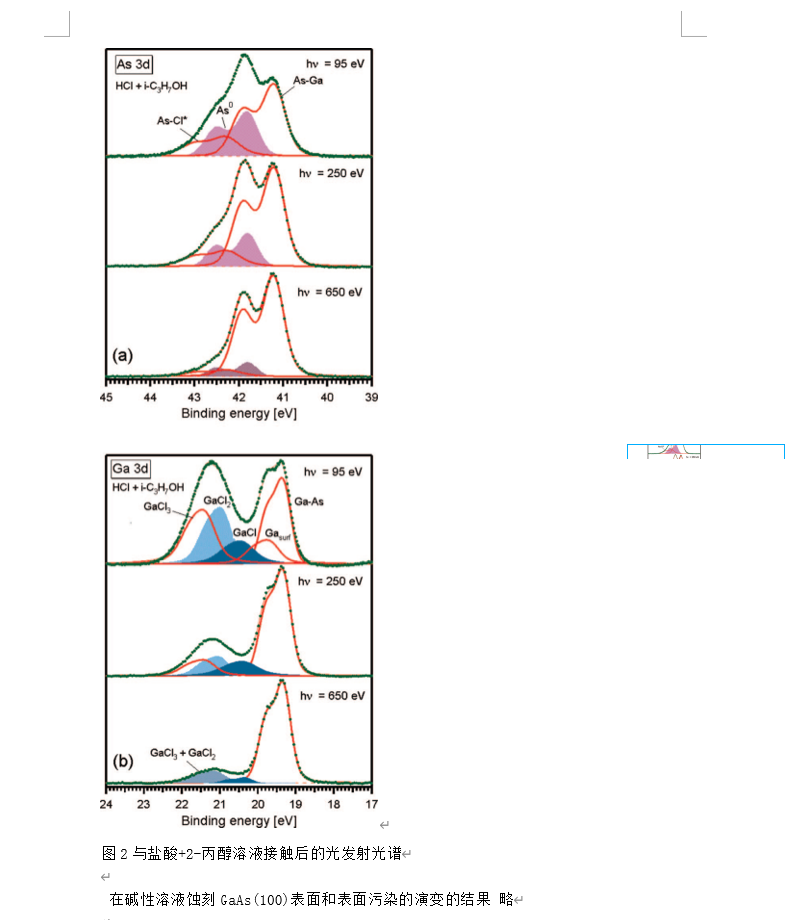
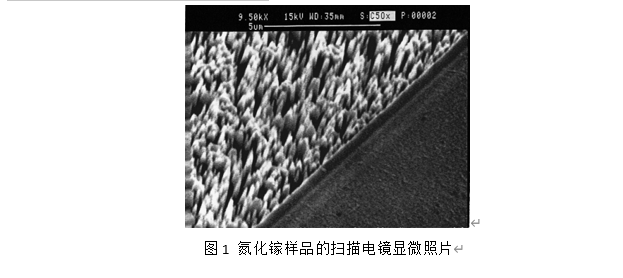
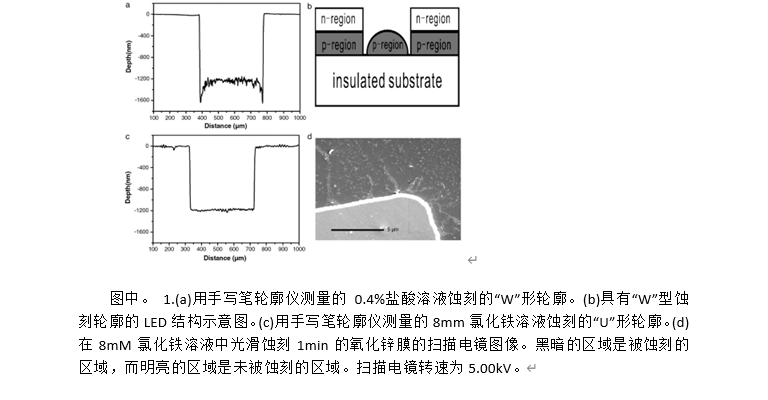
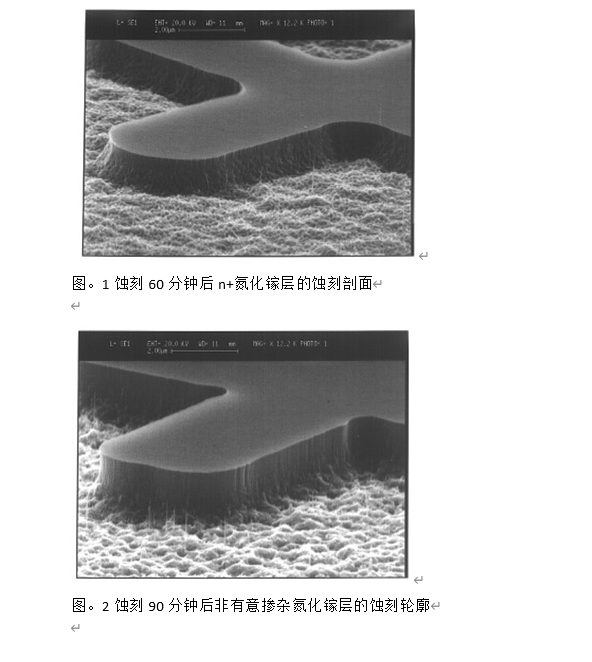


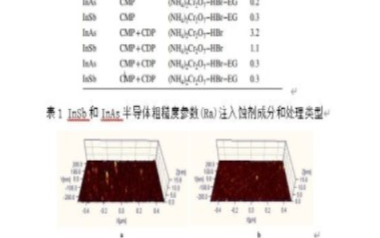
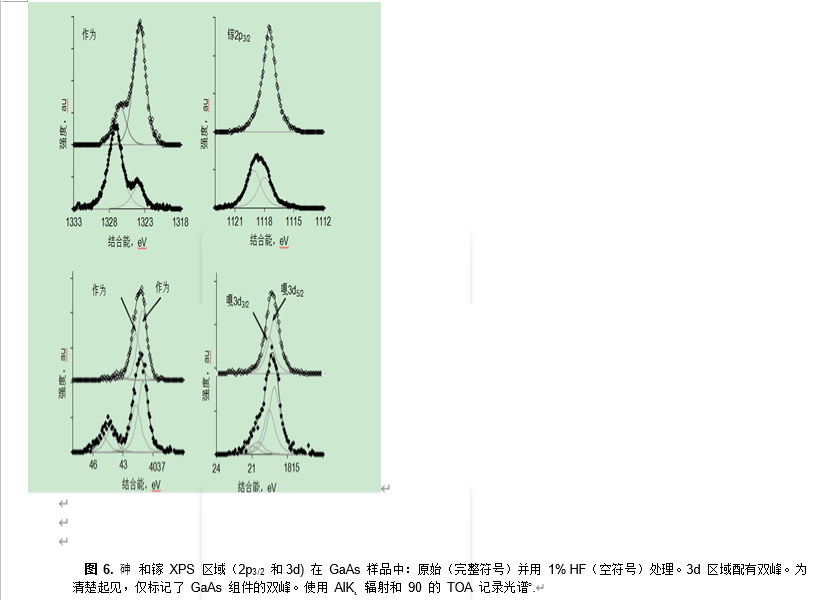

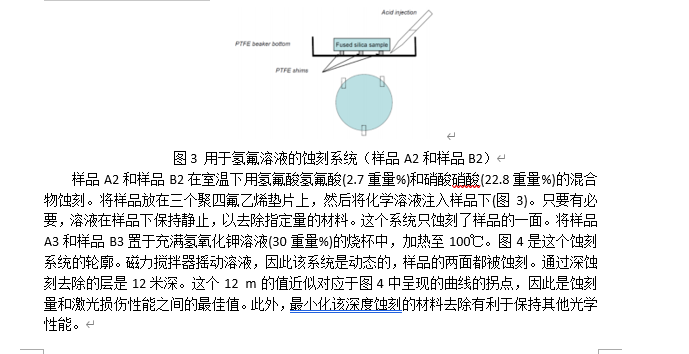



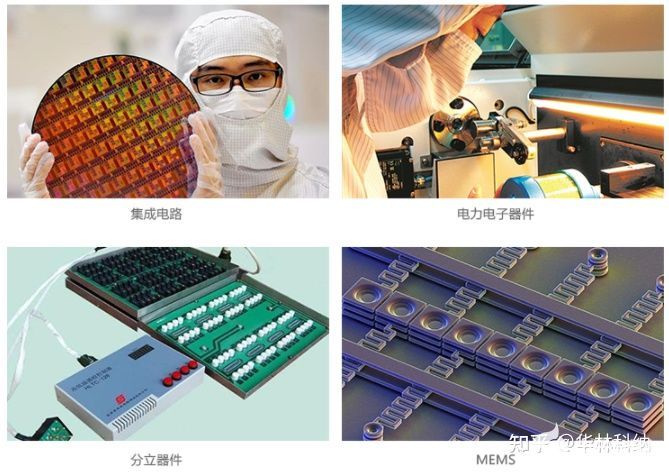
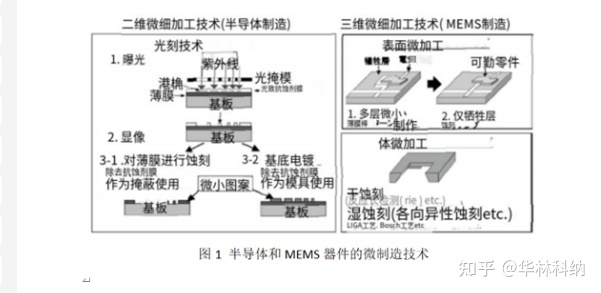
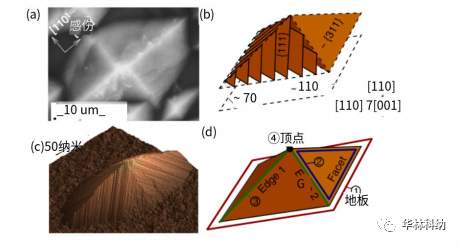
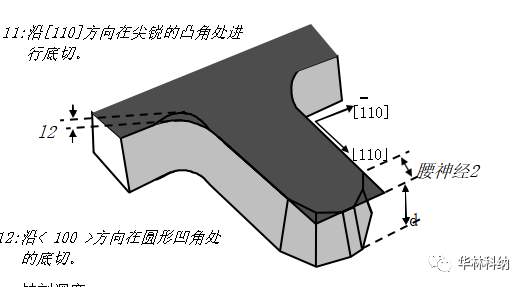

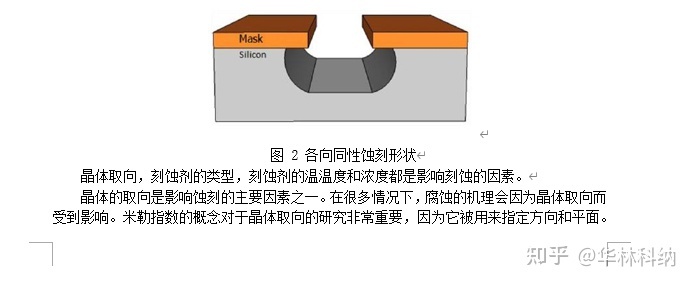

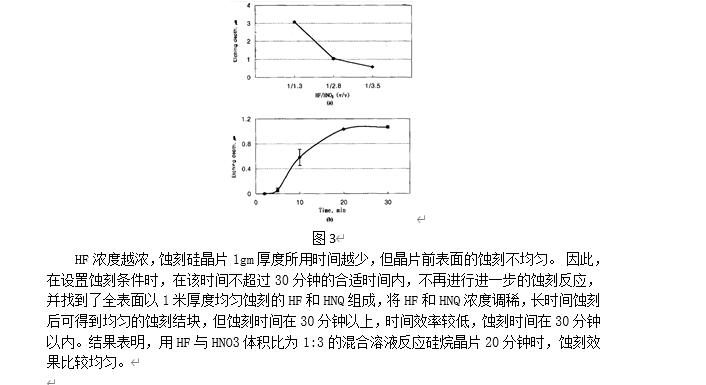

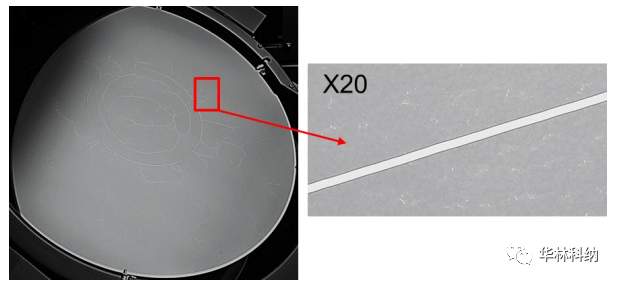
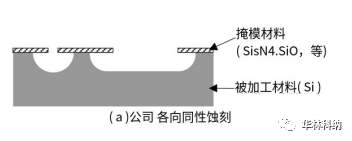

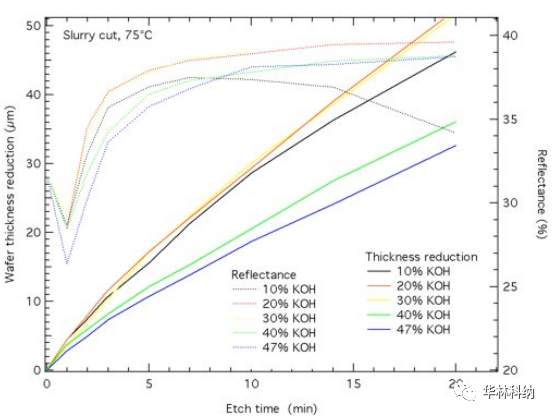

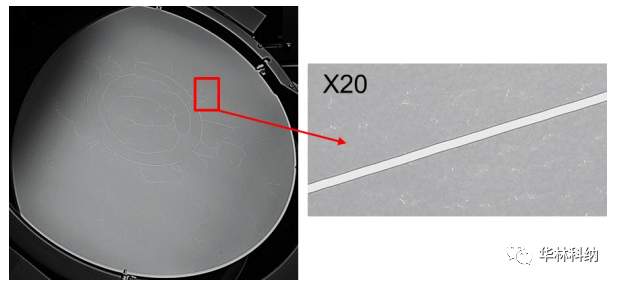
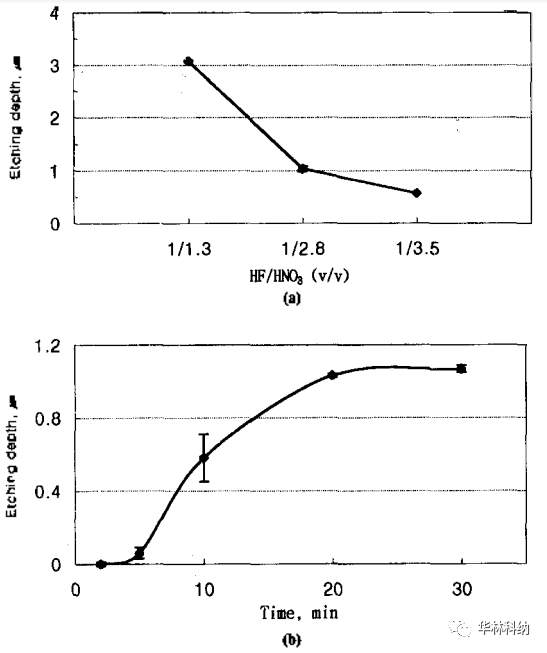
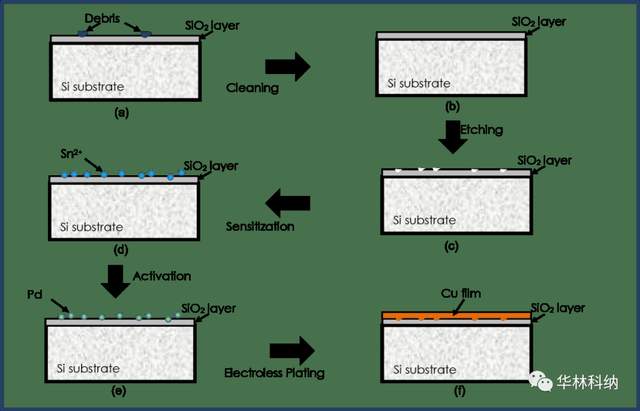
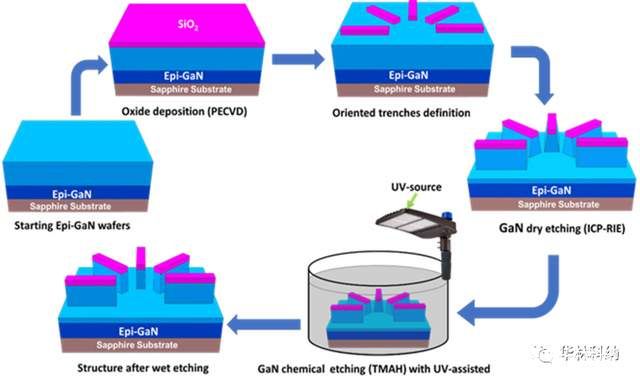
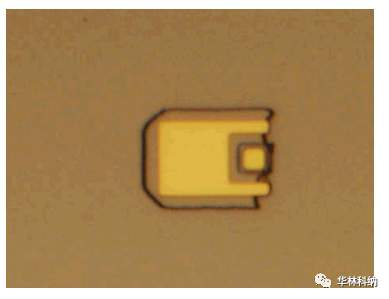
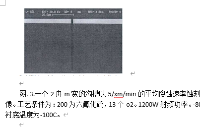
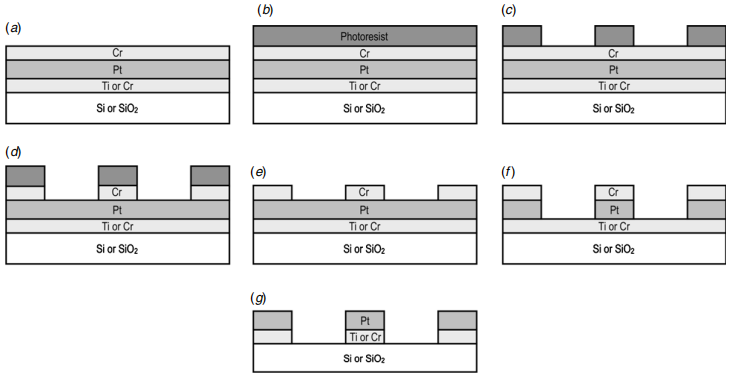

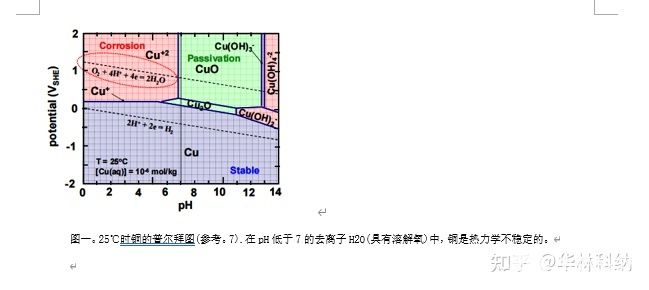
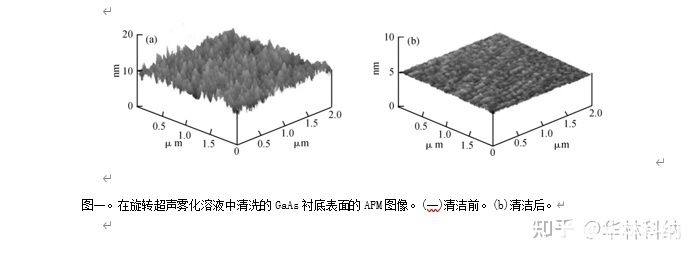





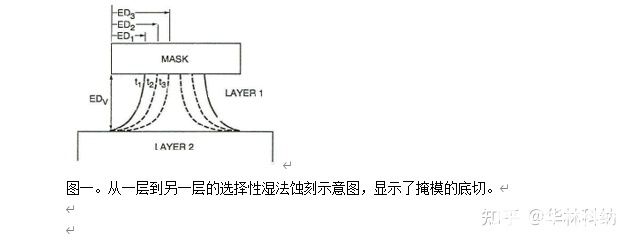




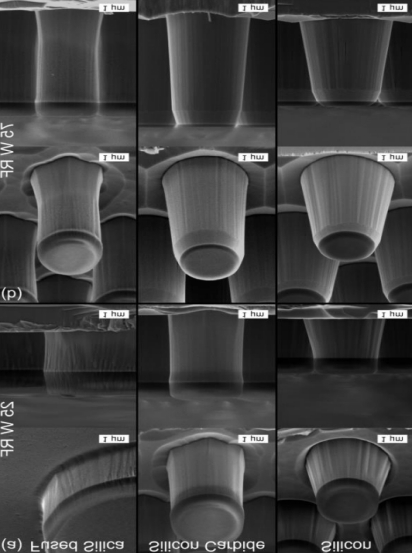
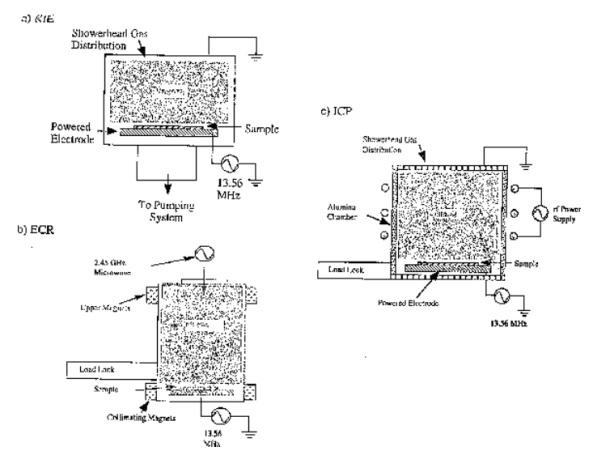










评论