在智能手机、电脑和自动驾驶汽车等高科技产品的背后,隐藏着一项至关重要的半导体制造技术——晶圆接受测试....

在我们手中的智能手机和电脑核心,躺着一块精密的芯片。芯片的核心,是数十亿个名为“晶体管”的微观开关。....
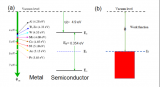
在IC芯片制造的检验工艺中,全数检查原则贯穿于关键工序的缺陷筛查,而老化测试作为可靠性验证的核心手段....

在半导体封装领域,已知合格芯片(KGD)作为多层芯片封装(MCP)的核心支撑单元,其价值在于通过封装....

热压键合(Thermal Compression Bonding,TCB)是一种先进的半导体封装工艺....

在模拟集成电路设计中,精确的MOSFET模型是确保电路性能预测准确性的基石。而沟道电荷分配原则,正是....

在集成电路制造的离子注入工艺中,完成离子注入与退火处理后,需对注入结果进行严格的质量检查,以确保掺杂....
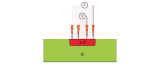
在集成电路制造中,金属淀积工艺是形成导电结构(如互连线、栅电极、接触塞)的关键环节,主要包括蒸发、溅....
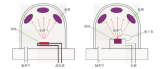
PN 结是构成二极管、双极型晶体管、MOS 晶体管等各类半导体器件的核心结构,其本质是 p 型半导体....
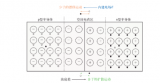
APCVD 的反应腔结构如图所示,系统通过专用传送装置实现硅片的自动化运送,反应气体从反应腔中部区域....
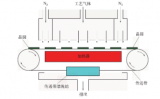
化学气相淀积(CVD)是借助混合气体发生化学反应,在硅片表面沉积一层固体薄膜的核心工艺。在集成电路制....

玻璃回流(reflow)技术是通过升温加热杂氧化硅,使其产生流动特性的工艺,常见的回流处理对象包含硼....
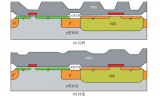
合金本质是金属与其他金属或非金属经混合熔化、冷却凝固后形成的具有金属性质的固体产物,而在集成电路工艺....
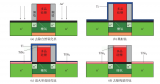
在半导体制造的精密工艺链条中,芯片切割作为晶圆级封装的关键环节,其技术演进与设备精度直接关系到芯片良....

从铝到铜,再到钌与铑,半导体布线技术的每一次革新,都是芯片性能跃升的关键引擎。随着制程进入2nm时代....

在超高纯度晶圆制造过程中,尽管晶圆本身需达到11个9(99.999999999%)以上的纯度标准以维....

光刻与刻蚀是纳米级图形转移的两大核心工艺,其分辨率、精度与一致性共同决定器件性能与良率上限。

PECVD( Plasma Enhanced Chemical Vapor Deposition ,....
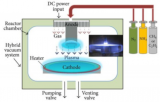
微电子技术的演进始终围绕微型化、高效性、集成度与低成本四大核心驱动力展开,封装技术亦随之从传统TSO....
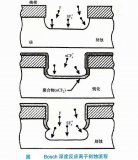
在半导体封装工艺中,芯片键合(Die Bonding)是指将晶圆芯片固定到封装基板上的关键步骤。键合....

在半导体行业持续追求更高性能、更低功耗的今天,一种名为“SOI(Silicon-On-Insulat....
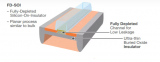
闩锁效应(Latch-up)是CMOS集成电路中一种危险的寄生效应,可能导致芯片瞬间失效甚至永久烧毁....
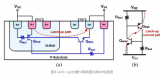
在半导体封装领域,堆叠技术作为推动高集成度与小型化的核心趋势,正通过垂直堆叠芯片或封装实现更紧凑的封....

热载流子注入效应(Hot Carrier Inject, HCI)是半导体器件(如晶体管)工作时,高....
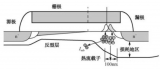
在功率半导体封装领域,晶圆级芯片规模封装技术正引领着分立功率器件向更高集成度、更低损耗及更优热性能方....

薄膜刻蚀与薄膜淀积是集成电路制造中功能相反的核心工艺:若将薄膜淀积视为 “加法工艺”(通过材料堆积形....

3D封装架构主要分为芯片对芯片集成、封装对封装集成和异构集成三大类,分别采用TSV、TCB和混合键合....

在过去的几十年里,半导体器件紧凑型模型已经从 BJT Gummel-Poon 模型中的几个参数发展到....
然而,随着纳米技术的出现,芯片制造过程越来越复杂,晶体管密度增加,导致导线短路或断路的概率增大,芯片....

硅通孔(TSV)技术借助硅晶圆内部的垂直金属通孔,达成芯片间的直接电互连。相较于传统引线键合等互连方....
