在指甲盖大小的硅片上建造包含数百亿晶体管的“纳米城市”,需要极其精密的工程规划。分层制造工艺如同建造....
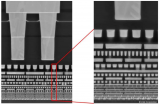
EBL就像是纳米世界里的精密画笔,能够在极其微小的尺度上"画"出任何你想要的二维图案。

本文介绍了芯片封装失效的典型现象:金线偏移、芯片开裂、界面开裂、基板裂纹和再流焊缺陷。
芯片制程从微米级进入2纳米时代,晶体管架构经历了从 Planar FET 到 MBCFET的四次关键....
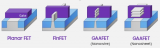
三维集成电路工艺技术因特征尺寸缩小与系统复杂度提升而发展,其核心目标在于通过垂直堆叠芯片突破二维物理....

在芯片的纳米世界中,多晶硅(Polycrystalline Silicon,简称Poly-Si) 。....
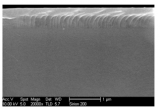
在MEMS制造工艺中,干法刻蚀是通过等离子体、离子束等气态物质对薄膜材料或衬底进行刻蚀的工艺,其评价....

在半导体工艺研发与制造过程中,精确的表征技术是保障器件性能与良率的核心环节。

从工作频段到信道的划分,再到多址方式、双工方式、调制方式、分集技术和MIMO,这些概念共同作用,使得....
热波系统通过激光诱导热效应与晶格缺陷的关联性实现掺杂浓度评估。其核心机制为:氩泵浦激光经双面镜聚焦于....

当晶体管栅长缩至20纳米以下,源漏极间可能形成隐秘的电流通道,导致晶体管无法关闭。而晕环注入(Hal....

化学机械抛光(Chemical Mechanical Polishing, 简称 CMP)技术是一种....
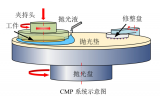
在半导体硅片生产过程中,精确调控材料的电阻率是实现器件功能的关键,而原位掺杂、扩散和离子注入正是达成....
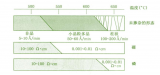
在指甲盖大小的芯片上集成数百亿晶体管,需要经历数百道严苛工艺的淬炼。每一道工序的参数波动,都可能引发....
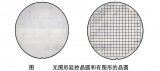
远程等离子体刻蚀技术通过非接触式能量传递实现材料加工,其中热辅助离子束刻蚀(TAIBE)作为前沿技术....

在万物互联的社会,气体感知技术已成为各领域发展的 “隐形卫士”。消费场景中,守护家居空气质量;汽车领....

随着半导体器件尺寸的不断缩小和性能要求的日益提高,应变工程半导体异质结构在现代电子器件中发挥着关键作....

本文简单介绍一下半导体镀膜的相关知识,基础的薄膜制备方法包含热蒸发和溅射法两类。

相比传统体加工技术,表面微机械加工通过“牺牲层腐蚀”工艺,可构建更复杂的三维微结构,显著扩展设计空间....
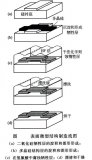
在半导体制造领域,晶体管结构的选择如同建筑中的地基设计,直接决定了芯片的性能上限与能效边界。当制程节....
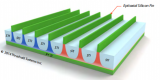
“基带”这个词,最早来源于通信理论,意思是未经调制的原始信号。比如你打电话时说话的声音、视频通话中的....
射频电路是处理高频信号的电路,在无线通信系统中发挥着至关重要的作用。它们负责接收、发射和处理射频信号....

本文是A. N. BROERS关于扫描电镜在微纳加工中应用的研究回顾,重点记录了他从1960年代开始....
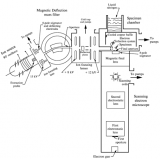
硅片键合作为微机械加工领域的核心技术,其工艺分类与应用场景的精准解析对行业实践具有重要指导意义。
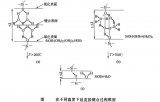
传统的透射电镜(TEM)技术往往只能提供材料在静态条件下的结构信息,无法满足科研人员对材料在实际应用....
在 MEMS(微机电系统)制造领域,光刻工艺是决定版图中的图案能否精确 “印刷” 到硅片上的核心环节....
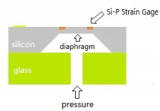
光学直角棱镜是一种常见的光学元件,它能够将光线的传播方向精确地偏转90度。这种功能看似简单,却在许多....

聚焦离子束(FIB)在材料科学和微纳加工领域内的重要性日益显现,离子束的传输过程由多个关键组件构成,....
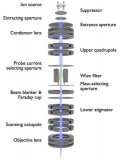
高质量的材料制备是一切器件研究的核心与基础,本篇文章主要讲述MBE的原理及制备过程。
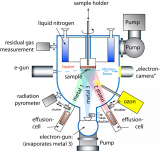
随着半导体器件特征尺寸不断微缩,对高质量薄膜材料的需求愈发迫切。外延技术作为一种在半导体工艺制造中常....