晶圆级芯片尺寸封装(WLCSP)因其“裸片即封装”的极致尺寸与成本优势,已成为移动、可穿戴及 IoT....

今天我们来聊聊工程师在仿真时比较关注的问题。众多的器件模型,我在仿真的时候到底应该怎么选择一个器件的....

在微机电系统(MEMS)领域,金属铬(Cr)因其独特的物理化学性质和工艺兼容性而被广泛应用。其物理化....
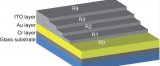
在功率半导体迈向180-250 nm先进节点、SoC与SiP并行演进、扇入/扇出晶圆级封装加速分化之....
电力电子器件作为现代能源转换与功率控制的核心载体,正经历着从传统硅基器件向SiC等宽禁带半导体器件的....
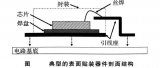
在先进封装技术向超大型、晶圆级系统集成深化演进的过程中,InFO 系列(InFO-MS、InFO-3....

芯片封装是半导体制造过程中至关重要的一步,它不仅保护了精密的硅芯片免受外界环境的影响,还提供了与外部....

汽车半导体包括:主控芯片、功率器件、模拟芯片(信号链与接口芯片、电源管理芯片)、传感器、存储芯片等。....

在三维集成电路设计中,TSV(硅通孔)技术通过垂直互连显著提升了系统集成密度与性能,但其物理尺寸效应....

自戈登·摩尔1965年提出晶体管数量每18-24个月翻倍的预言以来,摩尔定律已持续推动半导体技术跨越....

简单来说,Die(发音为/daɪ/,中文常称为裸片、裸晶、晶粒或晶片)是指从一整片圆形硅晶圆(Waf....
科技进步和对高效智能产品需求的增长进一步奠定了集成电路产业在国家发展中的核心地位。而半导体硅单晶作为....

在三维集成电路设计中,TSV技术通过垂直互连显著优化了互连线长分布特性。基于伦特定律的经典分析框架,....

解释: 这是数字芯片设计永恒的“铁三角”。Power指芯片功耗,越低越好;Performance通常....
在半导体产业的精密制造与检测体系中,超声波扫描电子显微镜(SAT)设备作为一种核心的无损检测工具,正....
塑封是微电子封装中的核心环节,主要作用是保护封装内部的焊线、芯片、布线及其他组件免受外界热量、水分、....

在日常生活和工业场景中,我们时常会接触到“跳闸”这一现象,比如家中突然断电后,电箱内的开关自动弹开了....
当前,尽管针对 MEMS 器件的制备工艺与相关设备已开展了大量研究,但仍有不少 MEMS 传感器未能....
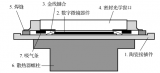
积层多层板的制作方式是在绝缘基板或传统板件(双面板、多层板)表面交替制作绝缘层、导电层及层间连接孔,....
近年来,随着移动通信和便携式智能设备需求的飞速增长及性能的不断提升,对半导体集成电路性能的要求日益提....

半加成法双面 PCB 工艺具有很强的代表性,其他类型的 PCB 工艺可参考该工艺,并通过对部分工艺步....

在 MEMS(微机电系统)中,铜(Cu)因优异的电学、热学和机械性能,成为一种重要的金属材料,广泛应....
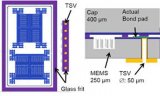
本文介绍了CoWoP(Chip‑on‑Wafer‑on‑Substrate)封装的概念、流程与优势。
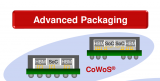
目前,在太赫兹(远红外)频段最透明的绝缘材料就是高阻的浮区(FZ)单晶硅。这是科研人员不断的经过实验....
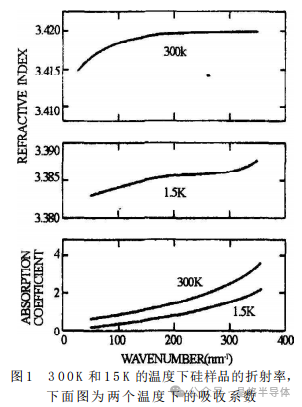
晶棒需要经过一系列加工,才能形成符合半导体制造要求的硅衬底,即晶圆。加工的基本流程为:滚磨、切断、切....

SEM是一种功能强大的工具,在材料科学、生物学、纳米技术和医学研究等科学领域得到广泛应用,其常见用途....

本文主要讲述TSV工艺中的硅晶圆减薄与铜平坦化。 硅晶圆减薄与铜平坦化作为 TSV 三维集成技术的核....

本文主要讲述什么是系统级封装技术。 从封装内部的互连方式来看,主要包含引线键合、倒装、硅通孔(TSV....

共晶焊接的核心是通过形成异种金属间的共晶组织,实现可靠牢固的金属连接。在半导体封装的芯片安装过程中,....

2.5D/3D封装技术作为当前前沿的先进封装工艺,实现方案丰富多样,会根据不同应用需求和技术发展动态....